使用分子束外延法制备锗铋薄膜及其光学特性
摘要
Ge基合金作为一种有前途的材料,因其优越的可见光至红外光电性能而引起了极大的兴趣。在这项研究中,我们报告了使用分子束外延 (MBE) 制备锗铋 (Ge1-xBix) 薄膜的制备和光学性能。 GeBi薄膜属于n型导电半导体,鲜有报道。随着Bi掺杂量从2%增加到22.2%,得到了一系列Ge1-xBix薄膜样品,并通过X射线衍射、扫描电子显微镜和原子力显微镜对其进行了表征。随着Bi含量的增加,晶格常数的失配增加,GeBi薄膜从直接能带隙转变为间接能带隙。 Bi含量的适度增加降低了光学反射率并提高了消光系数在红外波长的透射率。 GeBi薄膜在太赫兹波段的吸收和透射率随着Bi含量的增加而增加。
背景
在光通信领域,密集波分复用技术中的光波长目前已经从C波段(1.53-1.56μm)扩展到L波段(1.56-1.62μm)。所以光电探测器的波长应该包括C波段和L波段。然而,由于中红外领域的新兴应用,检测器的响应截止波长应长于 2 μm。制备近红外和远红外波段2~10μm波长范围内的半导体光电探测器具有重要意义[1,2,3,4]。
迄今为止,Ge基合金被证明是用于红外光电探测器的有前途的材料。 1984 年,AT&T.Bell 实验室采用分子束外延 (MBE) 方法制备了 GeSi 薄膜 n-i-p 器件,工作波长为 1.45 μm [5, 6]。 2010 年,斯图加特大学使用低生长温度和工作波长为 1.2-1.6-μm 的 pin 探测器制备了 0.5-3% Sn 含量的 GeSn 薄膜 [7,8,9,10]。 2011年,中科院王启明院士制备了Sn含量为1.0-3.5%的GeSn合金,成功制备了工作波长在1.3-1.6-μm范围内的pin探测器[11,12,13]。 2014 年,M. Oehme 开发了具有垂直结构的 GeSn/Ge 多量子阱光电探测器,pin 截止频率在 1.6 μm 以上 [14]。 2015 年,S. Wirths 成功制备了具有直接带隙的 GeSn 薄膜,并制备了 1.5-μm 波长的 GeSn 薄膜探测器 [15]。 K. Toko 通过射频磁控溅射技术在柔性基板上制备了 1.2-1.6-μm 波长的光电器件 [16]。然而,GeSi和GeSn半导体红外探测器的截止波长仍然小于2.0μm,应用波长不能包括整个C波段和L波段。寻找具有更长截止波长的新材料将有助于解决这个问题。
在这里,我们报告了使用 MBE 方法制备具有更长截止波长的 n 型 GeBi 半导体薄膜的制备和光学性能。截止频率为 2.3 微米,应用波长范围为 1.44 至 1.93 微米,包括 C 波段和 L 波段。本研究详细研究了Bi合金化对Ge1 − xBix薄膜红外和太赫兹(THz)性能的影响。
实验流程
GeBi薄膜采用MBE法生长,真空压力范围为4 × 10 -9 到 5 × 10 −10 托尔斯。 Ge原子和Bi原子分别从Ge源(1200°C)和Bi源(400-550°C)射出,到达p型Si单晶晶片的(100)衬底表面,并且最终形成薄膜。基板温度为 150 °C,生长速率范围为 1.66 至 2.50 nm/min。 GeBi薄膜的详细生长参数总结在表1中。
GeBi 薄膜的相形成通过掠入射 X 射线衍射 (XRD) 进行表征。 GeBi 薄膜的形态通过扫描电子显微镜(SEM;JMS6490LV,JEOL,东京,日本)进行分析。通过原子力显微镜(AFM,300 HV,SEIKO,日本)测试样品的粗糙度。拉曼光谱由拉曼光谱仪(LabRAM HR,Edison,NJ,USA)测试。 GeBi 薄膜的近红外和远红外特性通过光谱仪 (Lambda 75UV/VIS/NIR) 和远红外光谱仪测量。采用太赫兹时域光谱法测量了太赫兹波的传输特性。
结果与讨论
图 1 显示了所制备的 Ge1 − xBix 薄膜的 XRD 谱。可以看出,在所有 MBE 生长样品中都可以找到可归因于 GeBi 合金的特征衍射峰。图 1 显示了未经热处理的 MBE 生长的 Ge1 − xBix 薄膜的 XRD 结果。所有样品均显示出GeBi薄膜的衍射峰,而随着Bi含量(x ) 从 0.020 变为 0.222。当 Bi 含量较低时 (x =0.020),发现 Ge0.980Bi0.02 薄膜沿 (014) 方向取向,见图 1。随着 Bi 含量增加到 x =0.102,在位于 2θ 附近的 (104) 峰旁边 =38.2 o , GeBi薄膜的(012)峰位于2θ附近 =27.2 o 开始出现。随着 Bi 含量的增加 (x ) 从 0.183 到 0.222,(012) 峰的强度急剧增加,而 (104) 峰几乎消失。这表明具有较高 Bi 含量的 Ge1 - xBix 薄膜优选沿 (012) 方向而不是 (104) 方向取向。 Bi的不同含量对薄膜的微观结构有影响。对于具有不同 Bi 含量的 GeBi 薄膜,改变生长参数会影响生长的择优取向。我们推测,由于Bi原子的熔点低,Bi原子与Ge原子形成基团,进入晶格,形成Ge-Bi晶胞。 XRD结果表明,MBE法成功制备了GeBi薄膜,其结晶性能可以通过改变Ge1 − xBix薄膜中的Bi含量来调控。
<图片>
Ge1 − xBix 薄膜的 XRD 图谱 =0.020 到 x =0.222
Ge1 − xBix 薄膜样品的典型 SEM 图像如图 2 所示。当 Bi 含量为 2.0% (x =0.02),GeBi 薄膜生长良好,表面非常光滑,见图 2a。当 Bi 含量增加到 10.2% 时,均质介质中出现一些小点,这是新相的初始形成过程的表现,见图 2b。由于最低能量原则,表面的 Bi 原子分离并聚集成组(大小为 33-42 nm)。当 Bi 含量达到 18.3% 以上时,薄膜中至少存在三相,如 GeBi、非晶 Bi 和 Ge,见图 2c、d。 GeBi 薄膜的晶粒尺寸非常大,可达 1000 纳米左右。在 GeBi 晶粒的晶界之间发现了偏析的 Bi 和 Ge 颗粒,晶粒尺寸在 30.7 到 118.0 nm 的范围内。我们发现,当Bi含量超过GeBi合金中的固溶度时,低温下会在大晶界处沉积过量的Bi原子并形成Bi相。一些受低温限制不能与Bi原子反应的Ge原子也在大晶界处形成Ge相。尽管如此,Bi含量的增加可能促进了GeBi晶粒的优先生长,晶粒尺寸从42nm变为100nm,见图2b,d。
<图片>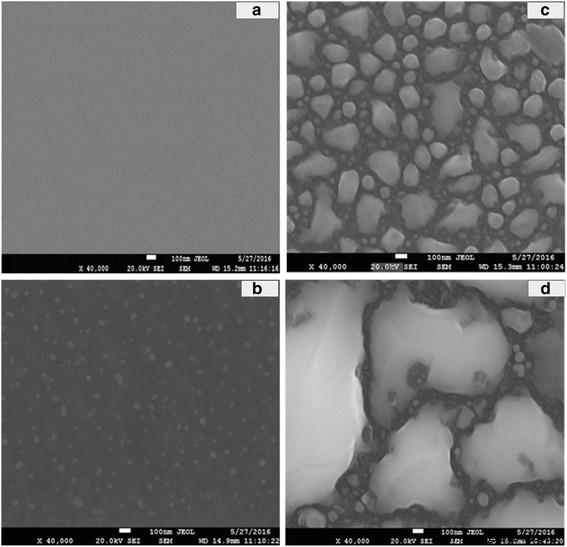
不同Bi含量GeBi薄膜的典型SEM图:a 2.0%; b 10.2%; c 18.3%;和 d 20.3%
图 3 显示了不同 Bi 含量的 Ge1 − xBix 薄膜的典型 AFM 图像,Ra 值和 RMS 值总结在表 2 中。随着 Bi 含量的增加,Ra 值和 RMS 值急剧增加,表明表面粗糙度Ge1 − xBix 薄膜的数量增加。同时,由于晶粒尺寸不均匀和晶界中的小晶粒,图 3b-d 中存在一些不规则的峰。当Bi的含量过多时,由于Bi在GeBi合金中的固溶度的限制,被Ge原子取代的Bi原子的数量受到限制。大量沉积在薄膜上的Bi原子使薄膜变得粗糙,对GeBi薄膜的微观结构有很大影响,这与SEM结果一致。
<图片>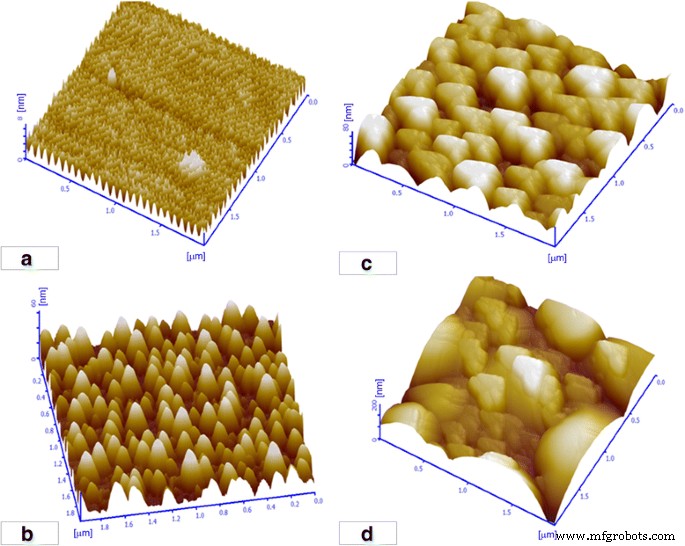
不同Bi含量GeBi薄膜的AFM测试结果:a 2.0%; b 10.2%; c 18.3%;和 d 20.3%
图 4 显示了通过 MBE 制备的具有不同 Bi 含量的生长状态的 Ge1 − xBix 薄膜的室温拉曼光谱。位于 190 cm −1 附近的一系列峰 可归因于 Ge-Bi 振动模式。随着Bi含量的增加,Ge-Bi峰变得更强并向更高波数(cm -1 )。向更高波数的转变表明,随着Bi含量的增加,薄膜晶格常数的失配率和GeBi薄膜的晶格应变增加。可以得出结论,Bi掺杂是调节Ge1 − xBix合金薄膜晶格应变的有效方法。
<图片>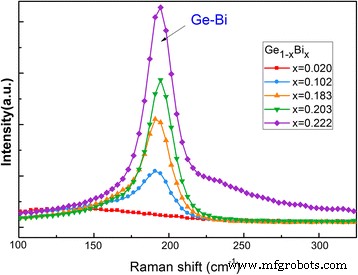
不同Bi含量GeBi薄膜的拉曼光谱
图 5 显示了具有不同 Bi 含量的 GeBi 薄膜的近红外特性。薄膜的吸收行为是从它们的反射率和透射率中获得的。如图 5a 所示,随着 Bi 含量的增加,GeBi 薄膜的反射率在 1014-2500 nm 范围内降低,这表明薄膜的吸收增加。 1932-1938 nm 范围内的谷值可归因于 GeBi 薄膜的间接带隙吸收。随着Bi含量的增加,能量吸收谷的深度减小。当 Bi 含量超过 20% 时,谷值在 1932-1938 nm 范围内消失。 GeBi 薄膜的直接带隙在 1446-1452 nm 范围内;随着Bi含量的增加,能量吸收谷的深度也减小。当 Bi 含量高于 20.3% 时,谷值在 1446-1452 nm 范围内消失。总之,Bi含量的增加降低了GeBi薄膜的反射率,增加了消光系数,最终使反射幅度减小。如图 5b 所示,在 1020 nm (1.22 eV) 附近有一个拐点,这归因于 Si 在 1.12 eV 处的禁带隙。当波长小于拐点值时,GeBi薄膜和Si衬底的透射率小。在 1020-2500 nm 范围内,透射率随着波长的增加而增加。然而,当 Bi 含量从 18.3% 增加到 22.2% 时,透射率降低。在 800-1600 nm 范围内,折射率、消光系数和过量 Bi 含量的巨大变化对薄膜的吸收有影响 [17, 18]。
<图片>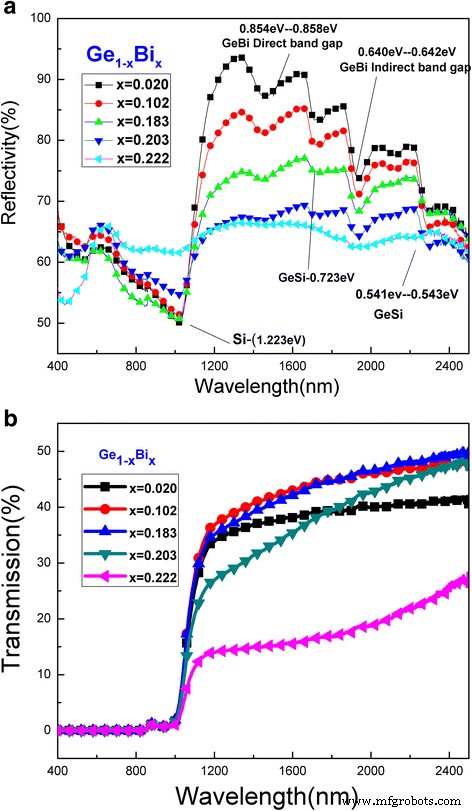
反射光谱 (a ) 和透射光谱 (b )近红外波段不同Bi含量的GeBi薄膜
图 6 显示了在远红外波段具有不同 Bi 含量的 GeBi 薄膜的特性。 GeBi 薄膜在 4-15-μm 波段有一个高且稳定的吸收窗口,见图 6a、b。由于反射率和透射率的原理不同,我们无法从图 6a、b 中直接得到 GeBi 薄膜的吸收。我们分析了Ge薄膜在1-25-μm波段的折射和消光系数的实验结果[17],考虑了Bi含量对Ge薄膜的影响,得到了GeBi薄膜在远距离的吸收光谱。最后是红外波段,见图 6c。随着 Bi 含量从 2% 增加到 10.2%,1 到 25 μm 范围内的吸收率从 9.3% 增加到 22.6%。随着Bi含量的进一步增加,吸收具有相同的趋势。然而,当 Bi 含量增加时,Ge1 − xBix 薄膜的吸收在 1.0 到 7.5 微米范围内增加,然后在 7.5-25 微米范围内减少。 Bi含量超过10%导致Bi原子沉积在GeBi薄膜中,表面粗糙度增加,然后吸收降低。图 7 显示了具有不同 Bi 含量的 GeBi 薄膜的 THz 透射率与频率的函数关系。当 Bi 含量从 2% 增加到 10.2% 时,透光率下降 10%。随着 Bi 含量从 18.3% 增加到 22.2%,透射率略有增加。透射测量表明,Ge1 − xBix薄膜的太赫兹特性可以通过改变Bi含量来调节,这对于太赫兹波调制器等应用非常重要[19]。
<图片>
透射光谱 (a ), 反射光谱 (b ), 和吸收光谱 (c )远红外波段不同Bi含量的GeBi薄膜
<图片>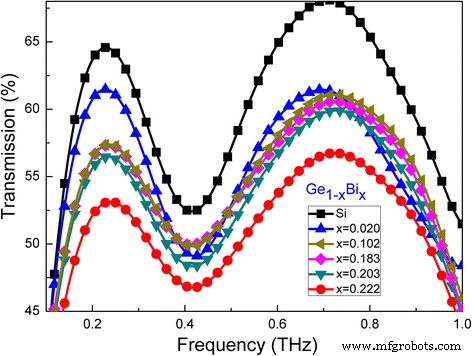
不同Bi含量GeBi薄膜的太赫兹透射光谱
结论
总之,Ge1 − xBix 薄膜与 Bi 分数 x =0 到 0.222 通过使用低温 MBE 在 p-Si (100) 衬底上成功生长。 XRD 和 SEM 结果表明,可以通过改变 Ge1 − xBix 薄膜中的 Bi 含量来控制它们的结晶和形态特性。系统地研究了 Bi 含量对 Ge1 − xBix 薄膜光学性能的影响,包括红外和太赫兹性能。 Bi 含量的适度增加降低了反射率并改变了红外波长的透射率。 GeBi薄膜在太赫兹波段的透射率随着Bi含量的适度增加而降低。因此,可以得出结论,MBE Ge1 − xBix薄膜对于红外和太赫兹应用都是很有前景的材料。
缩写
- 原子力显微镜:
-
原子力显微镜
- MBE:
-
分子束外延
- SEM:
-
扫描电子显微镜
- 太赫兹:
-
太赫兹
- XRD:
-
X射线衍射
纳米材料
- 钴掺杂 FeMn2O4 尖晶石纳米粒子的制备和磁性
- 走向 TiO2 纳米流体——第 1 部分:制备和性质
- 垂直电场对 ML-GaS 的电子和光学各向异性特性的调制
- 小型硒纳米晶体和纳米棒的简便合成和光学特性
- 化学蚀刻制备的硅纳米线的光学和电学特性
- 分子束外延生长的 MoSe2 中带隙的温度依赖性
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 磁性聚(N-异丙基丙烯酰胺)纳米复合材料:制备方法对抗菌性能的影响
- 具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
- Al-Doped ZnO 薄膜在红外区域的光学特性及其吸收应用
- 碱金属吸附的 g-GaN 单层:超低功函数和光学特性


