一种基于掺铝 HfO2 薄膜的多级忆阻器
摘要
非易失性存储器 (NVM) 将在包括物联网在内的下一代数字技术中发挥非常重要的作用。金属氧化物忆阻器,特别是基于HfO2的忆阻器,以其结构简单、集成度高、运行速度快、功耗低、与先进(互补金属氧化物硅)CMOS技术的兼容性好等优点受到了众多研究人员的青睐。在本文中,提出了一种 20 级稳定电阻状态的基于 Al 掺杂的 HfO2 忆阻器。其循环寿命、数据保持时间和电阻比大于10 3 ,> 10 4 s, 和> 10,分别。
背景
虽然负电阻现象是Hickmott在1962年首先在Al/Al2O3/Au结构中发现的[1],而Chua则在1971年提出了忆阻器的概念[2]。直到2008年Strukov等人制备出TiO2基忆阻器[3],人们才开始关注忆阻器的研究。目前,研究人员已经制备了数十种活性电阻材料的忆阻器,包括多种复合氧化物[4、5]、ZnO[6]、TiOx[7]、TaOx[8]等金属氧化物,以及二维材料[9, 10]。 HfO2 因其可靠性高、运行速度快和功耗低而被用作 CMOS 器件中的高 k 栅极电介质 [11, 12]。它也被研究人员首选作为忆阻材料[13,14,15]。
多级忆阻器可广泛用作数据存储[16,17,18]、逻辑计算[19]、电子突触装置[20,21,22,23]等。 Wang Y. [16] 和 Gao B. 等。 [24] 分别用 Cu 和 Gd 掺杂 HfO2 制备了多级忆阻器,但它们只能产生 4 级存储状态,难以满足应用需求。因此,对HfO2多级忆阻器的研究具有重要意义。
方法
Ti/Al:HfO2/Pt 器件的制造如图 1a 所示。有源电池区域由方形 Ti 顶部电极 (TE) 定义。通过直流 (DC) 溅射在硅基板上沉积 20 nm Ti 粘合剂层,然后沉积 100 nm Pt 膜作为底部电极 (BE)。通过原子层沉积 (ALD) 反应器 (R-150, Picosun, Espoo, Finland) 在 300 °C 下以 MeCp2HfMe(OMe)(表示为 HfD-04)作为 Hf 沉积 20-nm Al 掺杂的 HfO2 功能层前体,H2O 作为氧源 [25]。前体由高纯度 N2 (> 99.999%) 携带到反应室中。通过以三甲基铝 (TMA) 作为铝源和 H2O 作为氧源,每 8 次 HfO2 循环沉积 1 次 Al2O3 循环,获得 Al 掺杂薄膜。在 Thermo Fisher 的 Theta 300 XPS 系统上通过 X 射线光电子能谱(XPS,Axis Ultra DLD,Kratos Analytical,Manchester,UK)检测到 6.2% 的铝原子浓度。通过直流溅射沉积 50 nm Ti 膜作为 TE 和 100 nm Pt 作为覆盖层。通过光刻和剥离工艺图案化 TE 获得器件。图 1b 是器件的光学显微照片。我们制备了5 μm×5 μm到500 μm×500 μm不同面积的器件。
<图片>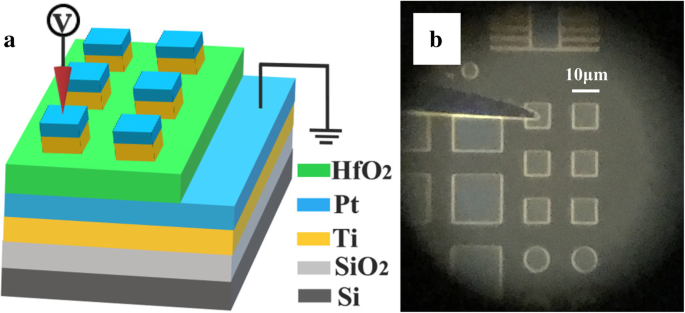
设备的结构。 一 忆阻器的 3D 模型。 b 器件的光学显微镜
结果与讨论
图 2 显示了 Al 掺杂和非掺杂器件的 XPS。与未掺杂器件的光谱图相比,Al 掺杂器件在图 2a 中显示出明显的 74.1 eV Al 2p 峰,图 2b 中 Hf 4f 的结合能有一定的增加。对于掺杂器件,Hf 4f5/2 与Hf 4f7/2 的比率也增加了。这与其他报告一致 [14, 26, 27]。 Al原子与HfO2结构键合形成Hf-Al-O,Hf-O键较弱,更容易断裂。
<图片>
Al 掺杂和非掺杂器件的 XPS。 一 Al 2p 和 b Hf 4f 比较
对于所有电气测量,Ti TE 偏置,而 Pt BE 接地。直流扫描是通过使用带有源/测量单元的 B1500A 参数分析仪(美国加利福尼亚州圣克拉拉)进行的,并且还使用了带有波形发生器/快速测量单元的脉冲电测量。所有器件在必要的电成型过程之前都显示出高电阻状态 (HRS)。图 3a 显示了 10 μm × 10 μm Al 掺杂和非掺杂器件的成形特性。成型期间的电流顺应性对于保护器件免受损坏是必要的。非掺杂器件的初始电阻和形成电压较大。非掺杂器件在低电压区的振荡是因为电流低于仪器的测量极限。形成步骤后的复位过程是通过施加负电压来激发的,如图 3a 所示,然后是第一次置位过程。随着复位电压幅值的增加,两个器件的电流都增加到大于形成限制电流的最大值然后减小。在相同电压下,两个器件的 HRS 电流比初始状态的电流大几个数量级。说明复位后仍有导电丝不能完全熔合。图 3b 中的典型设置/复位 I-V 曲线显示这两种器件的类型都是双极操作模式 [28]。 Al掺杂器件的开关比和置位/复位电压比非掺杂器件小,但其阻态转变过程更温和,适合作为多值存储器件。
<图片>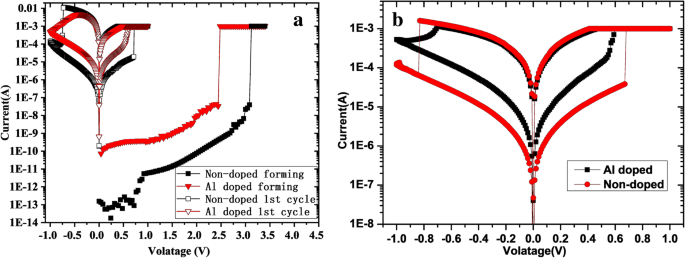
器件的 I/V 特性。 一 成型过程和第一个循环。 b 典型的设置/复位过程
为了阐明器件的开关机制,在图 4 中以双对数标度重新绘制了 I-V 曲线。对于这两种器件,低电阻曲线都表现出线性欧姆行为,这表明在设置期间的 HfO2 薄膜 [29, 30]。但是,这两种器件的高阻曲线差异很大。对于掺杂器件,它由三个区域组成:欧姆区(I∝V)、儿童定律区(I∝V 2 ),以及陡峭的电流增加区域,这符合陷阱控制空间电荷限制电流 (SCLC) 的典型 I-V 特性 [31, 32]。非掺杂器件的高阻曲线由两个区域组成:低电压区的欧姆传导(I∝V)和lnI-V 1/2 在高压区(图4的插图),证实了肖特基发射机制[15, 33]。
<图片>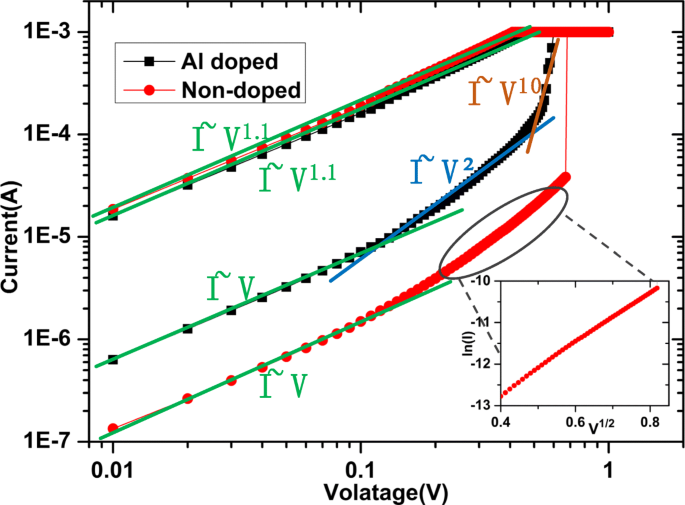
双对数坐标下SET过程的曲线拟合
根据上述特点,忆阻器的微观机理总结如下。对于未掺杂的器件,随着施加到钛电极的正电压增加,越来越多的氧离子在 HfO2 中产生并向钛电极移动 [34],产生氧化钛 [35]。同时,氧空位在铂电极和 HfO2 之间的界面处积累,逐渐形成导电细丝 [36]。因此,电流随着电压逐渐增加。当氧空位导电细丝连接 TE 和 BE 时,器件会转变为低电阻状态 (LRS)。当钛电极施加负电压时,氧离子与 HfO2/Pt 界面处的氧空位结合 [37],导致较低的氧空位浓度和较高的肖特基势垒。当达到复位电压时,导电丝断裂,器件变为HRS。
对于 Al 掺杂器件,Al 原子与 HfO2 结构键合形成 Hf-Al-O,导致 Hf-O 键较弱且更容易断裂。氧空位的形成能降低。因此,掺杂器件具有较小的电阻和较低的过渡电压。在未掺杂的薄膜中,氧空位倾向于沿晶界积累 [38, 39]。结果,导电细丝少而粗。器件的电阻随导电细丝的导通和断裂而变化很大。在掺杂薄膜中,在杂质原子附近很容易形成氧空位 [35, 40, 41]。大量杂质在薄膜中的均匀分布使得由氧空位形成的导电细丝更加可控。因此,更容易实现多个电阻值。
通过改变设置过程的电流顺应性,可以将器件设置为不同的稳定电阻状态。通过在图 5a 中以 0.5 mA 的步长将电流顺从性设置为 0.5 mA 至 10 mA,可以获得 20 个稳定的电阻状态。由于直流扫频设置电阻状态,能耗大,操作复杂。另一方面,当使用大电流顺应性时,电阻值很容易锁定在 LRS 中。此方法也无法调整 HRS。通过改变置位和复位脉冲的电压幅值实现二十级电阻状态。为避免电流过冲和设置/复位失败的可能性,设置电压幅值限制在 1 V~1.9 V 之间,用于复位,- 1 V~- 1.9 V 用于复位。从方框图(图5b)可以看出,允许电压范围分为20个值,器件的良率远远超过3σ水平(99.73%)。这是生产中的常见要求。这种方法的缺点是设备不能直接从一个HRS(LRS)设置到另一个HRS(LRS),而需要先reset(set)到LRS(HRS),然后再设置到目标HRS(LRS) .这增加了操作的复杂性和功耗。
<图片>
设备的多值存储。 一 通过设置顺从电流来转换电阻状态。 b 通过设置脉冲电压幅值获得的20种稳定电阻状态脉冲宽度和间隔均为500 μs
图 6 显示了一种更好的方法。器件电导通过连续脉冲递增或递减。脉冲持续时间和间隔均为 10 μs。电导由每个设置/复位脉冲后的 0.1 V 读取脉冲测量。如图 6 所示,将设备设置/重置为不同电平所需的脉冲数取决于施加的电压。分别选择0.5 V作为SET电压和- 0.7 V作为复位电压,通过置位和复位得到20个电平的不同电阻状态(图7)。在设置为目标状态之前,设备每次通过 10 - 0.9V 连续脉冲复位到 HRS 或在调整前通过 10 个 0.8-V 连续脉冲设置为 LRS。考虑到在设置和复位过程中都存在相同的状态,总共有 35 种不同的状态。设置(复位)的两个相邻电阻状态所需的脉冲数偏差超过3σ水平。缺点是如果器件的电阻值变化很大,需要的脉冲数会很大,运算速度会很慢。
<图片>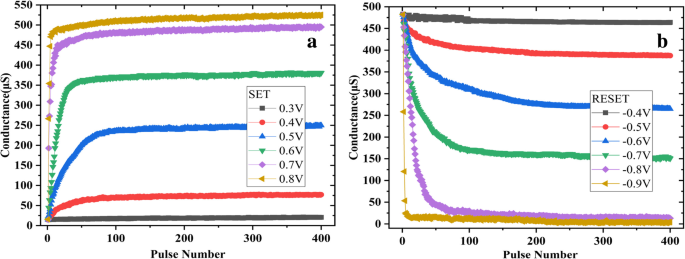
由连续脉冲调整的电阻。 一 设置进程和b 重置过程
<图片>
需要设置的脉冲数 (a ) 或重置 (b ) 设备到 20 个不同的级别
为了测试设备的数据保留情况,将 20 个设备设置/重置为一系列不同的电阻值,并将它们放在 85 °C 的加热台上 [42]。每 100 秒以 0.1 V 的电压测量电阻值。从图8a可以看出,器件的电阻在10 4 后保持稳定 s。为了测试器件的循环可靠性,我们以1.8 V/500 μs的置位脉冲和- 1.8 V/500 μs的复位脉冲重复置位和复位操作。 10 3 后 周期,器件的开关比仍然大于图 8b 中的 10。
<图片>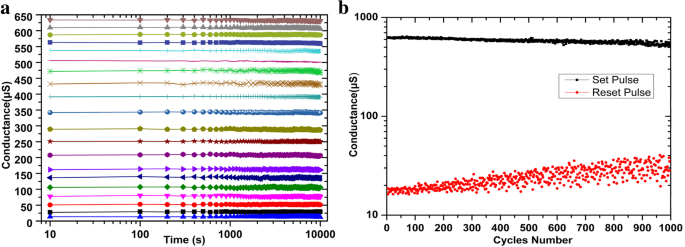
器件的可靠性测试。 一 设置/复位脉冲操作后的数据保留特性。 b 设置/复位脉冲操作的循环耐久曲线
结论
所提出的掺铝 HfO2 忆阻器显示出渐进且稳定的设置/复位性能。通过拟合Al掺杂和未掺杂器件的设定过程曲线,发现在HRS中,未掺杂器件遵循肖特基发射机制,而Al掺杂器件遵循SCLC导电机制。还讨论了电阻变化的微观物理机制。此外,通过改变顺从电流、调整设置/复位脉冲电压幅度和使用连续短脉冲来确认器件的多值存储。最后,我们测试了设备的可靠性,证明它的数据保留超过10 4 s (85 °C) 和 10 3 后开关比大于 10 循环。
数据和材料的可用性
本研究期间生成或分析的所有数据均包含在这篇已发表的文章中。
缩写
- ALD:
-
原子层沉积
- 基础:
-
底部电极
- CMOS:
-
互补金属氧化硅
- HfD-04:
-
MeCp2HfMe(OMe)Hf
- HRS:
-
高阻态
- LRS:
-
低阻态
- NVM:
-
非易失性存储器
- SCLC:
-
空间电荷限制电流
- TE:
-
顶部电极
- TMA:
-
三甲基铝
- XPS:
-
X射线光电子能谱
纳米材料
- Eclipse Hono 中基于 X.509 的设备身份验证
- 纳米字素,基于硅的柔性透明存储器
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 使用基于 AFM 尖端的动态犁式光刻在聚合物薄膜上制造具有高通量的纳米级凹坑
- ITO/PtRh:PtRh 薄膜热电偶的制备和热电特性
- 基于柔性聚(偏二氟乙烯)压电薄膜的超灵敏应变传感器
- 基于与铝/聚四氟乙烯纳米层压板集成的增强能量性能
- 基于薄膜摩擦纳米发电机的频率选择性仿生耳蜗基底膜声学传感器设计
- 基于石墨烯量子点装饰的 ZnO 纳米棒/GaN 薄膜同种型异质结的高性能紫外光电探测器
- 一种通过 PECVD 沉积低缺陷密度 nc-Si:H 薄膜的便捷有效方法
- Ambarella、Lumentum 和 ON Semiconductor 合作为下一代 AIoT 设备开发基于 AI 处理的 3D 传感
- 铌钛氮化薄膜涂层


