全新三星 H-Cube 2.5D 技术为 HPC 应用集成了 6 个 HBM
三星电子宣布推出其混合基板立方体 (H-Cube) 技术,这是一种 2.5D 封装解决方案,专门用于需要高性能和大面积封装技术的高性能计算、人工智能、数据中心和网络产品的半导体。
H-Cube 由三星电机 (SEMCO) 和 Amkor Technology 联合开发,适用于需要集成大量硅芯片的高性能半导体。三星表示,它扩展和丰富了代工生态系统,提供各种封装解决方案来应对客户面临的挑战。
Amkor Technology 全球研发中心高级副总裁 JinYoung Kim 表示:“在当今越来越需要系统集成且基板供应受限的环境中,三星代工厂和 Amkor Technology 已成功联合开发 H-Cube 以克服这些挑战。 “这一发展降低了进入 HPC/AI 市场的门槛,并展示了代工厂与外包半导体组装和测试 (OSAT) 公司之间成功的合作与伙伴关系。”
H-Cube 结构和特点
2.5D 封装使逻辑芯片或高带宽存储器 (HBM) 能够以小尺寸放置在硅中介层的顶部。三星的 H-Cube 技术采用混合基板,结合能够进行精细凸块连接的细间距基板和高密度互连 (HDI) 基板,以实现大尺寸的 2.5D 封装。
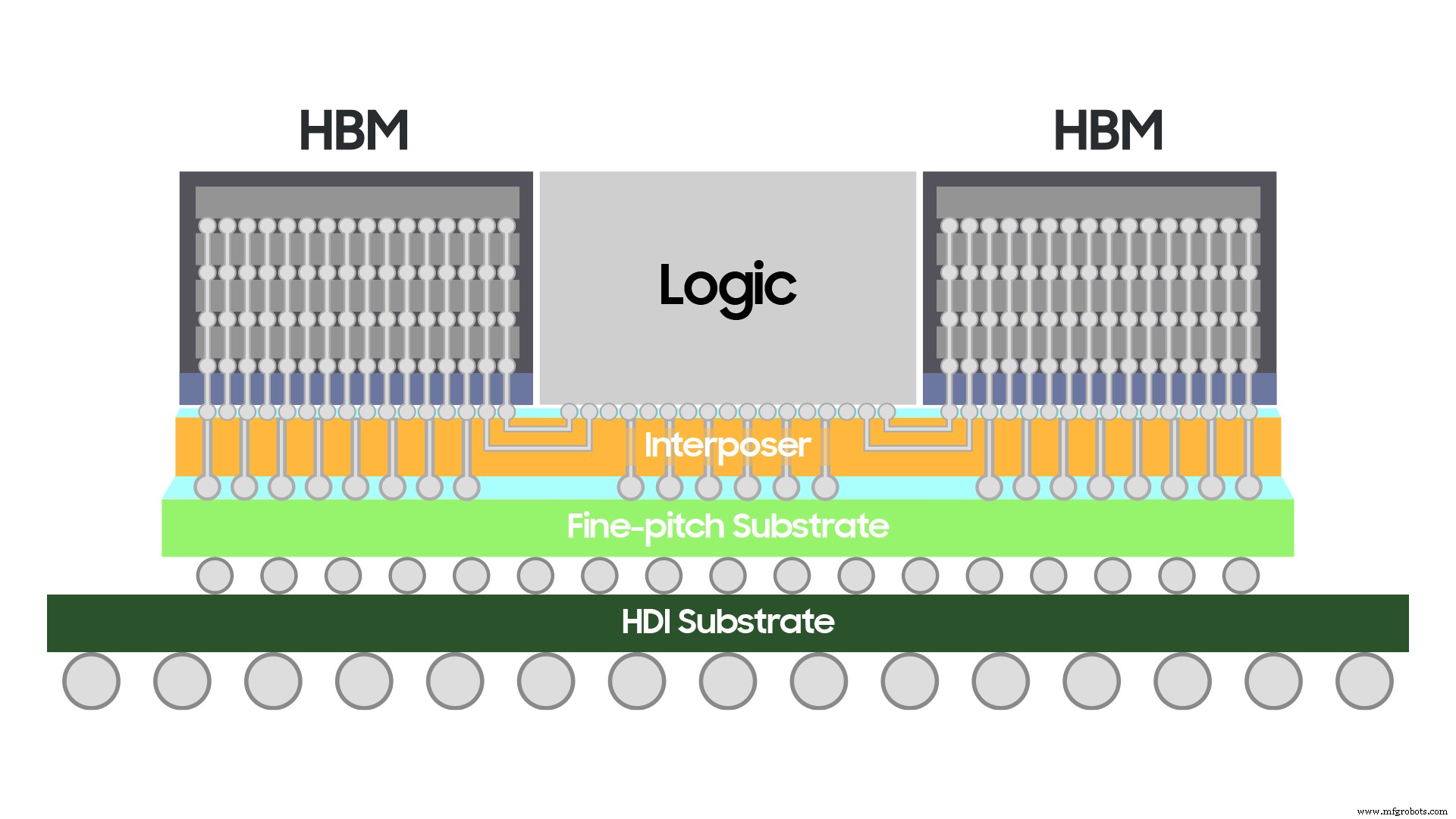
随着最近 HPC、AI 和网络应用细分市场所需规格的增加,随着安装在一个封装中的芯片数量和尺寸的增加或需要高带宽通信,大面积封装变得越来越重要。对于包括中介层在内的硅芯片的附着和连接,细间距基板是必不可少的,但随着尺寸的增加,价格会大幅上涨。
当集成六个或更多 HBM 时,大面积基板的制造难度迅速增加,导致效率下降。三星通过采用混合基板结构解决了这个问题,其中易于大面积实施的HDI基板重叠在高端细间距基板下。
通过将连接芯片和基板的焊球间距比传统焊球间距减少 35%,可以将细间距基板的尺寸最小化,同时在细间距基板下方添加 HDI 基板(模块 PCB)间距基板以确保与系统板的连接。
此外,为了提高H-Cube方案的可靠性,三星应用了其专有的信号/电源完整性分析技术,在堆叠多个逻辑芯片和HBM时,可以稳定供电,同时最大限度地减少信号损失或失真。
嵌入式
- 工业技术的新黄金时代
- 考虑新金属印刷技术对 AM 的意义
- 零售应用中社交距离的技术选择
- 英飞凌、赛灵思和 Xylon 联手在安全关键应用中开发新的微控制器解决方案
- 英飞凌:适用于工业应用的新型电流传感器覆盖 ±25 A 至 ±120 A 范围
- DATA MODUL:用于大批量项目的新键合技术
- DUAGON-MEN-GROUP 集成 OEM Technology Solutions Australia
- GE 推出用于控制和监控应用的新产品
- SMI 为军事应用提供最高质量的复合技术
- 巴斯夫与 Paxis 合作开发新型 3D 打印技术材料
- 帝斯曼和 Nedcam 为大尺寸 3D 打印开发新应用
- 自动化:适用于卫生应用的新型防尘防水协作机器人


