Samsung I-Cube4 将 4 个 HBM 和逻辑芯片放在纸薄的硅中介层上
三星电子宣布推出其最新的集成 2.5D 封装解决方案 Interposer-Cube4 (I-Cube4),在 100 ㎛ 厚的硅中介层上集成了四个高带宽内存 (HBM) 芯片和一个逻辑芯片。
该公司的 I-Cube 是一种异构集成技术,可将一个或多个逻辑芯片(CPU、GPU 和其他块)和多个 HBM 芯片水平放置在硅中介层上,使多个芯片在一个封装中作为单个芯片运行。
其新的 I-Cube4 包含四个 HBM 和一个逻辑芯片,于 3 月作为 I-Cube2 的继任者开发。从高性能计算(HPC)到人工智能、5G、云和大型数据中心应用,I-Cube4有望通过异构集成在逻辑和内存之间带来更高层次的快速通信和电源效率。
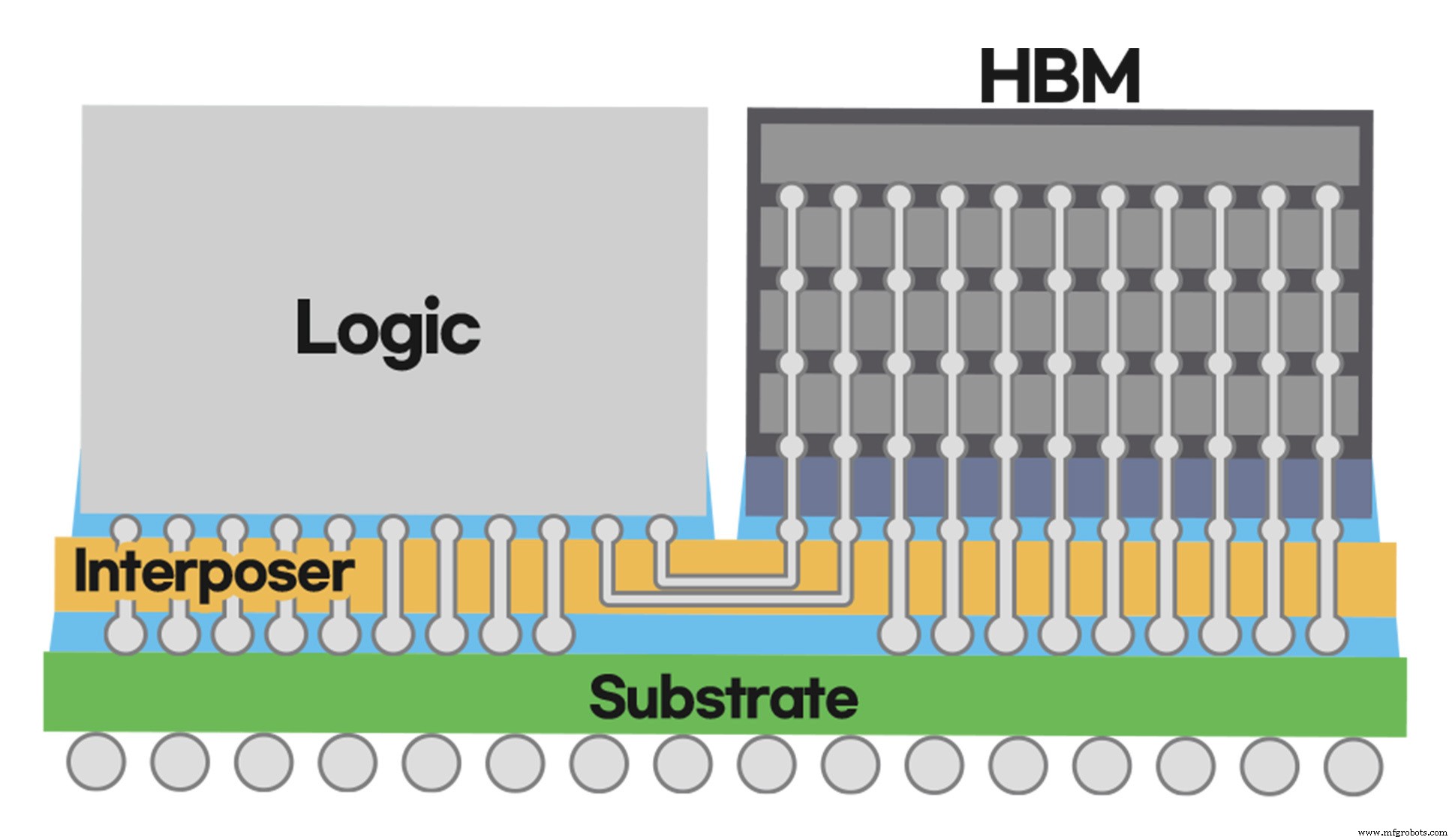
通常,硅中介层面积按比例增加以容纳更多的逻辑芯片和 HBM。由于 I-Cube 中的硅中介层比纸更薄(约 100 ㎛ 厚),因此较大的中介层弯曲或翘曲的机会变得更高,从而对产品质量产生负面影响。三星表示,其在半导体方面的专业知识和知识使其能够研究如何通过改变材料和厚度来控制中介层翘曲和热膨胀,从而成功地将 I-Cube4 解决方案商业化。
此外,三星为 I-Cube4 开发了自己的无模具结构,通过进行预筛选测试,可以在制造过程中过滤掉有缺陷的产品,从而有效地去除热量并提高其产量。这种方法提供了额外的好处,例如减少了流程步骤的数量,从而节省了成本并缩短了周转时间。
三星电子代工市场战略高级副总裁 Moonsoo Kang 表示:“随着高性能应用的爆炸式增长,必须提供具有异构集成技术的整体代工解决方案,以提高芯片的整体性能和能效。 “凭借I-Cube2积累的量产经验和I-Cube4的商业突破,三星将全力支持客户的产品实施。”
自 2018 年推出 I-Cube2 和 2020 年推出 eXtended-Cube (X-Cube) 以来,三星表示,其异构集成技术标志着高性能计算 (HPC) 市场进入了一个新时代。公司目前正在结合先进的工艺节点、高速接口IP和先进的2.5/3D封装技术,开发更先进的I-Cube6及更高封装技术,帮助客户以最有效的方式设计他们的产品。
相关内容 :
- 机器学习算法利用 ReRAM 可变性
- 西门子将 Veloce 添加到无缝硬件辅助验证中
- 边缘人工智能挑战内存技术
- Synopsys 通过统一的电路仿真流程解决超融合 IC
- 新的 EDA 设计工具可解决异构系统集成问题
嵌入式


