增强型近红外吸收体:两步制造结构化黑硅及其器件应用
摘要
硅被广泛应用于半导体工业,但由于其高反射率和带隙限制,在近红外光电子器件中性能较差。在这项研究中,两步工艺,深反应离子蚀刻(DRIE)方法结合等离子体浸入离子注入(PIII),用于在 C-Si 表面制造微结构黑硅。这些掺杂硫元素的改进表面实现了更窄的带隙和光吸收率的增强,尤其是在近红外范围(800 到 2000 纳米)。同时,最大吸光率显着增加至 83%。背面带有微结构黑硅的 Si-PIN 光电探测器表现出卓越的器件性能,在 1060 nm 处的响应率为 0.53 A/W。这种新型微结构黑硅结合窄带隙特性,在近红外光电检测方面具有潜在的应用前景。
背景
迄今为止,许多微米和纳米结构的黑硅材料也可以通过使用 DRIE 处理和离子注入来制造,旨在降低光反射并提高近红外吸收率 [1,2,3,4,5]。 DRIE 工艺通常以循环蚀刻-钝化步骤的模式进行,使用光刻胶掩模,可以实现高深宽比结构的硅微加工。通常,这种方法利用 F 基等离子体(例如 SF6)进行快速各向同性蚀刻,然后切换到使用 C4F8 的侧壁钝化循环 [6,7,8]。在随后的蚀刻周期中,由于离子轰击,钝化膜优先从凹槽底部去除,同时防止蚀刻侧壁[9]。最后,蚀刻和钝化循环的交替可以形成蚀刻硅结构的特定几何形状,这主要取决于掩模尺寸、气流、电极功率、工艺时间、循环时间等。为了增强硅在近红外波长的吸收,在DRIE工艺之后通过离子注入对蚀刻的硅结构进行掺杂。在一定条件下,可以获得黑硅阵列,由此产生的硅晶格中含有的硫掺杂物最终会导致显着的带隙以下辐射吸收[10, 11]。
黑硅作为半导体工业中最重要的材料之一,已广泛应用于敏感光电探测器、太阳能电池、生化传感器、显示器件和光通信对象 [12,13,14,15,16,17,18, 19,20]。由于其广泛的器件应用,黑硅的微纳米结构近年来一直是研究热点。在我们的早期研究中,已经研究了在前表面带有黑硅的 Si-PIN 光电探测器 [21]。这种器件结构具有较宽的耗尽层,可以减少载流子扩散运动的影响,达到提高器件灵敏度和响应速度的目的。还需要注意的是,使用黑硅作为光敏表面,产生的载流子很难被 P 层收集并通过电极输出光电流,与传统的 Si-PIN 探测器相比,可见光响应相对较低。那么,一个背面采用黑硅的Si-PIN光电探测器是否可以同时完成两项任务,即不仅在近红外波段而且在可见光波段提高器件灵敏度? /P>
在本文中,我们报告了通过两步工艺制造的微结构黑硅的吸光率增强和更窄的带隙特性:DRIE 与 PIII 相结合。研究了不同蚀刻工艺对 400 到 2000 nm 波长范围内光吸收率的影响,还研究了基于背面微结构黑硅的检测器,重点是器件在波长范围内的响应度。 400~1100 纳米。
方法
如图 1a 所示,选择均匀和周期性分布的圆柱阵列,通过 FDTD Simulation 软件研究微结构硅的光学特性。图 1b 表示优化模拟后微结构硅的吸光度与四种不同模型尺寸之间的关系,其中四种模型具有相同的圆柱直径 (D =4 μm) 但中心距不同 (T 1 =12 μm,T 2 =10 微米,T 3 =8 μm,T 4 =6 μm)。
<图片>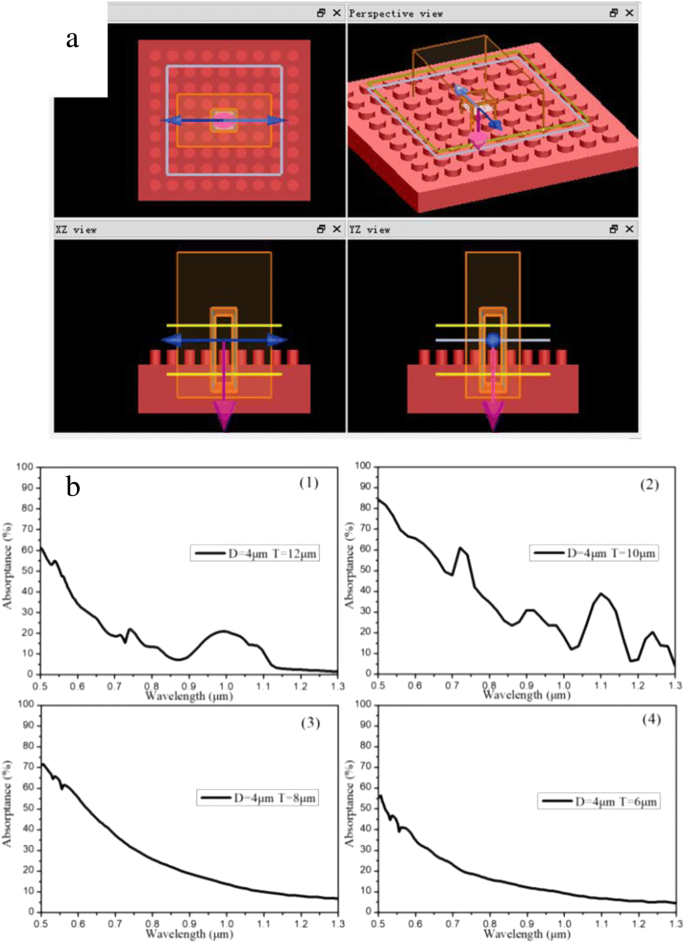
光学仿真模型 (a ) 和模拟结果 (b )的微结构硅
如图 2 所示,基于上述优化的模拟结果,通过改变掩模尺寸设计了三种不同的光刻掩模,命名为掩模 I (D =4 μm,T =6 μm),掩模 II (D =4 μm,T =8 μm) 和掩膜 III (D =4 μm,T =10 μm),分别。然后用光刻胶NR9-1500PY在硅片的抛光面(15 × 15 cm 2 ),它们是从厚度为 500 微米、电阻率为 2500 到 3000 Ω·cm 的 n 型硅晶片上切割下来的。为了研究蚀刻工艺对微结构硅光吸收率的影响,我们将掩模 III 产生的测试样品移入工艺腔(DRIE、ICP-100D)并改变循环时间,其中使用 SF6 作为蚀刻气体和C4F8 作为钝化气体,30 次、70 次、100 次,各不相同。蚀刻工艺后,在氧气气氛下去除硅片上的任何残留光刻胶,以确保硅表面清洁光滑。为了提高微结构硅的吸收率,尤其是近红外波段的吸收率,在1.0E + 15 cm − 2 分别为注入剂量和 800 eV 注入能量。
<图片>
掩模尺寸示意图
黑硅的形貌通过场发射扫描电子显微镜(SEM,JSM-7500F)表征。使用配备有积分球(Idea Optics,IS-20-5)的光纤光谱仪(NIR2500)在室温下获得光吸收率。在暗室环境下使用光功率计(OPHIR,Vega)、光斩波器(Scitec Instruments,Model-300CD)和Keithley2636B装置测量探测器响应度。为了保证测量的准确性,我们在测试前进行了校准,每次测量都是在几个样品上进行的(通常是4到6个)。
结果与讨论
图 3 给出了对齐的微结构硅阵列的典型 SEM 图像,这些阵列垂直于三种不同掩模尺寸的基板表面。由于DRIE工艺主要取决于掩模尺寸和光刻技术的质量,可以清楚地表明微结构硅的顶视图实际上不是标准圆圈。然后,为了研究刻蚀工艺对微结构硅光吸收率的影响,我们将掩模 III 测试样品的循环次数改为 30、70 和 100 次,条件是在 SF6 刻蚀 3 秒,然后用钝化剂钝化。 C4F8 2 秒,每个循环时间。
<图片>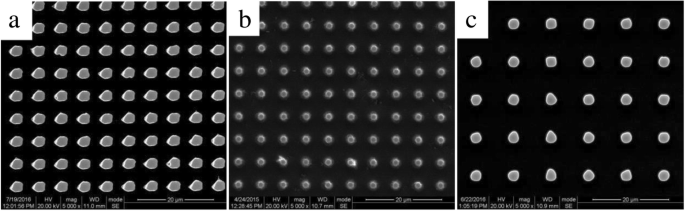
DRIE 为不同掩模尺寸制造的典型微结构硅阵列。 一 面具 I.b 面具二。 c 面具三
根据光刻胶和硅的不同刻蚀速率比,只要光刻胶足够厚作为掩膜,刻蚀深度可以通过工艺参数控制。从图 4 可以看出,圆柱体的高度随着循环次数的增加而增加,其中从顶部到基板的高度分别约为 1.87 μm、2.35 μm 和 3.15 μm。众所周知,在DRIE工艺中,虽然有钝化气体保护蚀刻靶材的侧壁,但还是或多或少伴随着横向蚀刻。这就是所得到的形态不是理想的圆柱阵列的原因。显然,这些微结构硅阵列的形貌可以通过改变光刻工艺和蚀刻周期时间来很好地控制。
<图片>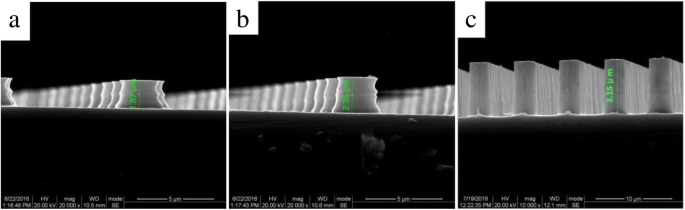
为不同循环时间制造的掩模 III 样品的截面图。 (a ) 30, (b ) 70, 和 (c ) 100
图 5a 表示在没有 PIII 工艺的情况下,微结构圆柱阵列在不同循环时间的光吸收率。结果表明,与普通 C-Si 相比,带有蚀刻硅阵列的 C-Si 可以在一定程度上提高 400 至 2000 nm 波长范围内的光吸收率。蚀刻 100 次循环次数的样品呈现出最高的吸收率,在 NIR 范围(800 至 2000 nm)内高达 70%,并且该样品在 400 至 2000 nm 波长范围内的平均吸收率达到 55%。这是由于微结构硅的多次反射和吸收(如图 6 所示)。入射光在圆柱侧面连续反射的过程中,入射光的吸收路径长度增加,导致吸收率增强。尽管如此,当波长超过 1000 nm 时,吸收率仍然不够高。因此,为了进一步提高微结构硅的吸收率,特别是在近红外波段,相同样品在1.0E + 15 cm − 2 条件下,通过PIII工艺掺杂硫元素 分别为注入剂量和 800 eV 注入能量。如图 5b 所示,离子注入后,在 400 到 2000 nm 的波长范围内,光吸收率明显增加。在此,蚀刻 100 个循环次数的样品的光吸收率远高于 C-Si。最大和平均光吸收率分别显着增加至 83% 和 62%。此外,可以很容易地观察到(如图 5c 所示),在硫元素掺杂前后,100 个循环样品的吸收率在 800 到 2000 nm 的波长范围内发生了显着变化,其中最大值和平均值增加了 13%和 7%。
<图片>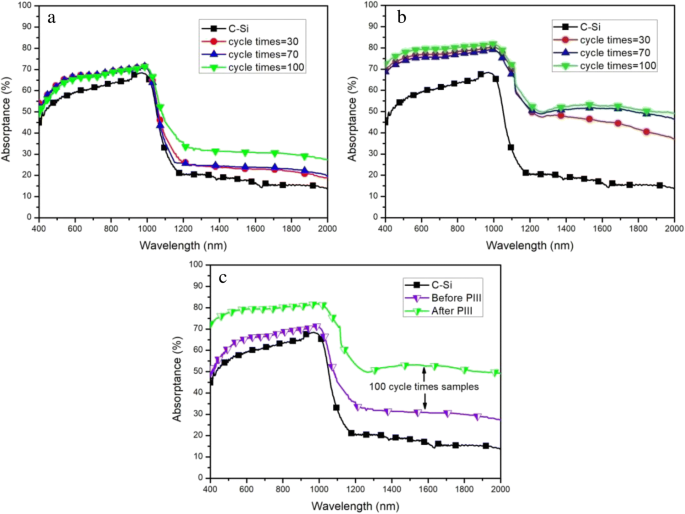
之前不同循环时间制备的C-Si和黑硅的吸收率(a ) 和 PIII (b ) 和 100 个循环样本的比较 (c )
<图片>
微结构硅表面入射光的传输路径
这种高吸收率主要来自微结构柱状阵列之间的硫掺杂,在 C-Si 的能带结构中形成多个杂质能级。结果,当这些诱导的多个杂质能级重叠时,加宽后形成新的杂质带,最终减小C-Si的带隙。带隙可以通过Tauc映射从样品的吸收光谱中获得。采取的具体步骤如下:
(i) 反射光谱转换为 K-M 函数 F (R ∞) 使用 Kubelka-Munk 理论:
$$ F\left(R\infty \right)\approx \frac{A^2}{2R} $$ (1)其中 R 和 A 分别为样品的反射光谱和吸收光谱。
(ii) K-M 函数 F (R ∞) 代入 Tauc 公式如下:
$$ {\left( hv\alpha \right)}^{1/n}=K\left( hv- Eg\right) $$ (2) $$ hv=\frac{1239.7}{\lambda } $$ (3)其中索引n的值与样本的过渡类型有关:直接过渡,n =1/2;间接过渡,n =2.F (R ∞) 与吸收系数 α 成正比,可以用 F 代替 (R ∞) 和 n =2代入式(2)得:
$$ {\left( hv F\left(R\infty \right)\right)}^{1/2}=K\left( hv- Eg\right) $$ (4)(iii) 将样品的反射率和吸收率光谱数据代入方程。 (1) 和等式。 (1) 代入方程。 (4)、带有hv 作为横坐标 (X 轴) 和 (hvF(R ∞ )) 1/2 作为纵坐标 (Y 轴)。
(iv) 通过计算hv的一阶导数得到拐点(一阶导数的最大点) -(hvF(R ∞ )) 1/2 曲线,曲线的切线就在这一点上。切线与X的交点的横坐标值 轴为样品的带隙。
图 7 显示了具有不同循环时间的 C-Si 和黑硅的最终计算带隙。可以很容易地发现,与 C-Si 的 1.12 eV 带隙相比,黑硅的三个较低带隙分别为 1.045 eV、1.033 eV 和 1.025 eV。
<图片>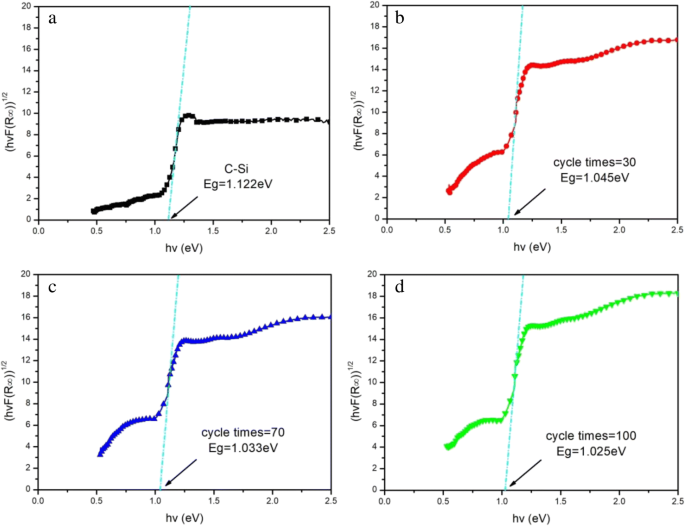
C-Si 的带隙 (a ) 和由不同循环时间制成的黑硅:(b ) 30, (c ) 70, (d ) 100
基于上述具有增强光学特性的黑硅,制作了背面形成黑硅的Si-PIN探测器。首先,纯本征单晶硅晶片(n 型)在两侧被氧化,形成 SiO2 层。其次,通过光刻工艺蚀刻晶圆正面的SiO2层,在早期形成的感光区域上通过硼扩散制造P层。第三,在P层上沉积一层Si3N4渗透膜,然后将晶片背面抛光研磨至约200μm厚。四、P掺杂N + 在研磨表面沉积一层,然后在N + 的顶部形成微结构黑硅 层。最后,通过光刻工艺蚀刻电极窗口,并在晶片的两侧沉积金属电极。图 8 给出了真实设备图像 (a)、暗电流 (b)、1060 nm 波长照明下的 I-V 曲线 (c) 以及两种不同检测器的响应度比较 (d)。特此声明,设备 1(S1336-44BK,商用 Si-PIN 探测器)的响应度是基于滨松光电公司的公共网站 [22] 重新绘制的,并且设备 2 的响应度是在我们新获得的制造了背面形成黑硅的 Si-PIN 探测器,其中光敏面是一个直径为 2 毫米的圆。可以清楚地看到,器件 2 的响应度显着增加,尤其是在近红外波长下,即分别在 1060 nm 和 0.31 A/W 处 1060 nm 处为 0.53 A/W。
<图片>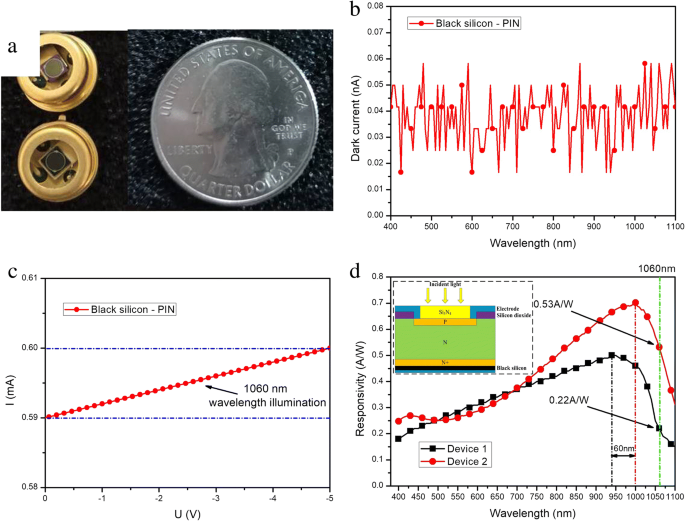
检测器图像 (a ), 暗电流 (b ), 1060 nm 波长照射下的 I-V 曲线 (c ),以及两个不同检测器的响应度 (d ):参考文献中的设备 1。 [22] 和设备 2 基于本文的结果。 d 的插图 显示设备结构
从图 8b 可以看出,虽然背面形成黑硅的 Si-PIN 探测器(器件 2)在可见光谱中显示出相对较小的响应度提高,但它的响应光谱在波长上给出了更高的响应度与商用 Si-PIN 检测器(设备 1)相比,范围从 680 到 1100 nm,峰值响应度红移约 60 nm。造成这种区别的主要原因是这两种探测器(装置1和2)的装置结构不同。当光子能量大于 C-Si 的带隙时,入射光主要被 P 层吸收,因此产生的载流子有足够的能量通过 N 层。大部分生成的载体可以通过N + 收集 层通过电极输出光电流。在这种情况下,检测器背面是否引入黑硅,对可见光波长的器件响应影响有限。与前表面带有黑硅的检测器不同 [21],设备 2 在可见光波长中表现出更好的响应。这就是为什么根据测得的响应曲线,可见光响应的改善相对较小的原因。再次在器件2中,由于背面设置了黑硅层,即使光子能量小于C-Si的带隙,近红外光也能穿透P层并被N层吸收,并且那么N + 就可以收集到大量生成的载波 层在反向偏置的作用下。结果,将有一个可计数的光电流输出,并且器件在近红外波长范围内表现出显着的响应度增加。
根据以上结果,我们目前的研究可为近红外光电探测领域提供一种可行的策略,但仍有很多方面需要考虑。例如,应探索更好的微结构黑硅制造工艺和离子注入技术,以精确控制结构硅的形貌和带隙。此外,还应设计一些其他新颖的基于黑硅的光电探测器器件结构,以实现更好的器件性能。
结论
总之,微结构黑硅材料是通过两步工艺制造的:深反应离子蚀刻结合等离子体浸入离子注入。硅片表面的微结构圆柱阵列具有三种不同的尺寸:掩模I(D =4 μm,T =6 μm),掩模 II (D =4 μm,T =8 μm) 和掩膜 III (D =4 μm,T =10 μm),高度分别为 1.87 μm、2.35 μm 和 3.15 μm。黑硅在400~2000nm的宽波长范围内吸光率明显增强,最大和平均吸光率分别达到83%和62%。这些改进基于多次反射、增加的吸收路径长度和窄带隙进行了广泛的讨论。制造了一种背面形成黑硅的新型 Si-PIN 光电探测器,并与一种名为 S1336-44BK 的商用器件进行了器件响应度的比较。得出的结论是,我们的背面形成黑硅的 Si-PIN 光电探测器的响应度显着增加,尤其是在近红外波长,在 1060 nm 上升到 0.53 A/W,在 1100 nm 上升到 0.31 A/W , 分别。
纳米材料
- 钼金属及其合金的应用
- 如何通过移动应用程序实现流畅有效的设备引导
- 物联网设备管理及其在促进物联网大规模部署方面的作用
- Coin Paradox 自旋-轨道相互作用增强磁光效应及其在片上集成光隔离器中的应用
- 掺杂氧的纳米晶体的电子态和由 ns-Laser 制备的黑硅上的可见光发射
- 超窄带完美吸收体及其在可见光区域中作为等离子体传感器的应用
- Fe3+ 的可恢复荧光探针 BHN-Fe3O4@SiO2 混合纳米结构及其在生物成像中的应用
- 纳米结构黑硅的应用回顾
- 磁性金纳米粒子标记乙酰肝素酶单克隆抗体及其在肿瘤磁共振成像中的后续应用
- 超长细铜纳米线的简便合成及其在高性能柔性透明导电电极中的应用
- 可回收灵活的淀粉-银网络及其在联合传感器中的应用
- 晶体纳米多孔硅的电离热合成及其作为锂离子电池负极材料的用途


