具有氩注入边缘终止的高压 β-Ga2O3 肖特基二极管
摘要
边缘端接的 Au/Ni/β-Ga2O3 肖特基势垒二极管是通过使用氩注入在阳极触点的外围形成高电阻率层来制造的。注入能量为 50 keV,剂量为 5 × 10 14 cm −2 和 1 × 10 16 cm −2 ,反向击穿电压从 209 增加到 252 和 451 V(最高可达 550 V)和 Baliga 品质因数 (VBR 2 /Ron) 也从 25.7 增加到 30.2 和 61.6 MW cm −2 ,分别提高了 17.5% 和 140%。根据二维模拟,氩注入后结角处的电场被平滑,最大击穿电场的位置,5.05 MV/cm,从界面处的阳极角变为注入正下方的重叠角地区。还研究了正向特性的温度依赖性。
背景
近年来,使用Ga2O3、AlN、金刚石等超宽带隙半导体材料的大功率器件的发展正在加速。 β-Ga2O3 的带隙高达 4.8-4.9 eV,β-Ga2O3 的击穿场估计为 8 MV/cm,大约是 4H-SiC 和 GaN 的三倍。 Baliga 的品质因数 3400 至少是 4H-SiC 的十倍,是 GaN 的四倍 [1]。此外,大单晶和低成本 β-Ga2O3 衬底可以通过熔体生长方法制造,例如浮区 (FZ) [2] 和边缘限定薄膜生长 (EFG) [3, 4]。电子密度可在10 16 的大范围内控制 到 10 19 厘米 −3 通过掺杂 Sn、Si 或 Ge [5,6,7]。这些优异的特性使 β-Ga2O3 成为低损耗、高电压开关和高功率应用的理想选择,包括高击穿电压肖特基势垒二极管 (SBD) 和金属氧化物半导体场效应晶体管 (MOSFET) [8,9 ,10,11,12]。肖特基势垒二极管与p-n结二极管相比,具有开关速度快、正向压降低等优点,可以降低功率损耗,提高电源效率。
虽然在没有边缘终止的 β-Ga2O3 肖特基势垒二极管中获得了 1016 V、2300 V 和 1600 V 的大击穿电压,但它们都约为理想值的 34%、8% 和 10% [10, 13, 14]。为了缓解电场拥挤效应并充分实现β-Ga2O3的电压电位,必须设计合适的边缘终端。有许多边缘终端技术可以提高器件击穿电压,例如场板、浮动金属环、沟槽 MOS 结构、注入保护环和结终端扩展 (JTE) [12, 15,16,17]。然而,由于缺乏 p 型掺杂,注入的保护环和 JTE 结构不适用于 Ga2O3 肖特基二极管。 H. Matsunami 和 BJ Baliga 提出了一种边缘终止结构,利用氩气注入在阳极边缘形成一个高电阻率的非晶层,以减少电场拥挤 [18,19,20,21,22],即一种简单的技术,不需要多次光刻或深沟槽蚀刻步骤,广泛用于 SiC 和 GaN 整流器,以平滑整流接触周边周围的电场分布 [15, 23, 24]。
在本文中,垂直边缘端接的 β-Ga2O3 肖特基二极管是通过在肖特基触点边缘注入氩气来制造的。使用Keithley 4200半导体表征系统记录电容-电压(C-V)和温度相关的电流密度-电压(J-V)特性,并分析电场分布。
方法/实验
通过机械剥离从高质量 Sn 掺杂 (100) 取向的 β-Ga2O3 体衬底获得厚度为 10 μm 的漂移层。 β-Ga2O3 块体是通过 EFG 技术以 4 N 纯 Ga2O3 粉末作为起始材料生长的。高分辨率 X 射线衍射 (HRXRD) 和原子力显微镜 (AFM) 测量证实了优异的晶体质量和光滑的表面,如图 1a、b 所示。半高全宽 (FWHM) 和均方根 (RMS) 估计分别为 37.4 弧秒和 0.203 纳米。图 1c 显示了通过四点探针测量的 10 μm 厚度的 β-Ga2O3 衬底薄层电阻的分布。使用载流子浓度(1.3 ± 0.04) × 10 17 厘米 −3 薄层电阻为 (563 ± 18.5)Ω/□,电子迁移率计算为 85.3~95.2 cm 2 /Vs by μn =1/(RSheet × n × q × t ), 其中 μn, RSheet, n , q , 和 t 是电子迁移率、薄层电阻、电子浓度、电子电荷和 β-Ga2O3 衬底的厚度,类似于报告的结果 [25]。氩离子注入能量为50 keV,剂量为2.5 × 10 14 cm −2 ,并首先在背面在 N2 气氛中在 950°C 下高温退火 60 分钟,然后电子束蒸发 Ti/Au(20 纳米/100 纳米)欧姆金属叠层,并在 600 ℃下快速热退火在 N2 环境中保持 °C 60 秒。然后用2μm厚的光刻胶作为掩膜在室温下注入氩气,能量为50 keV,剂量为5 × 10 14 cm −2 (样本B)和1 × 10 16 cm −2 (样品 C),分别。为了修复注入损伤并减少反向偏压下的漏电流,注入的样品在 N2 环境下在 400°C 下进行 60 秒的快速热退火 [13, 26]。最后,通过标准光刻图案化、Ni/Au (30 nm/200 nm) 堆叠蒸发和剥离在正面制造直径为 100 μm 的圆形肖特基阳极电极。还制作了没有注入氩气的参考装置(样品 A)。图 2a 描绘了具有氩注入边缘终端的制造 Ga2O3 肖特基二极管的横截面 TEM。在注入区中产生了几乎表面的非晶 β-Ga2O3 层。端接 β-Ga2O3 肖特基二极管的实际照片如图 2b 所示。图 2c 表示正向电流-电压 (I -V ) β-Ga2O3 SBD 的特性,而测量电压范围在 0 到 3 V 之间,步长为 10 mV。图 2d 描述了反向电流-电压 (I -V ) β-Ga2O3 肖特基整流器的特性以获得击穿电压,而测量电压范围在 0 到 − 500 V 之间,步长为 − 1 V。
<图片>
一 XRD摇摆曲线和b 从 (100) β-Ga2O3 衬底机械剥离的 β-Ga2O3 漂移层的 AFM 图像c 测得的 10 mm × 10 mm β-Ga2O3 衬底的薄层电阻
<图片>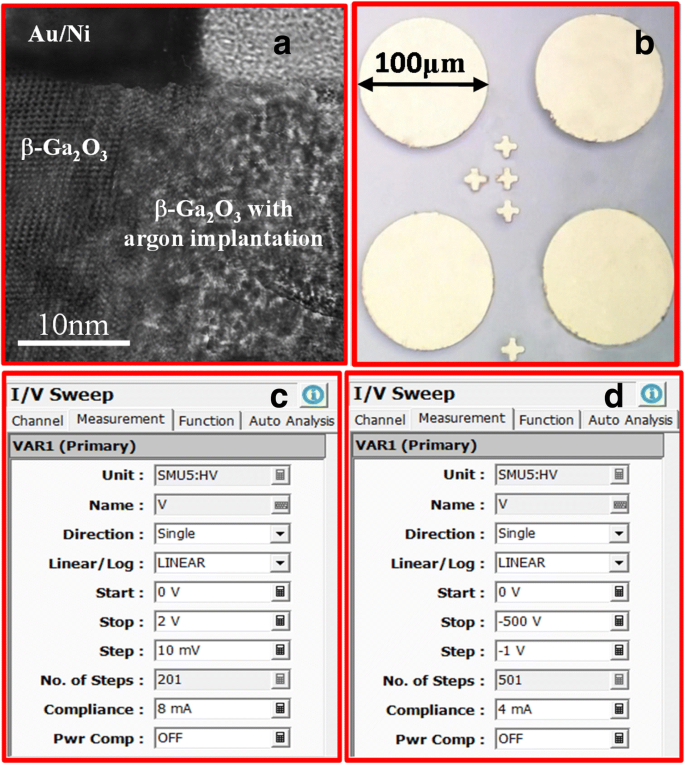
一 样品 C 和 b 的 TEM 图像 端接 β-Ga2O3 肖特基二极管 c 的照片 正向电流和d的测量设置 β-Ga2O3 SBD的反向电流-电压(I-V)特性获得击穿电压
结果与讨论
图 3 显示了实验 1/C 2 对比 V 三个 SBD 样品在室温下的特性。有效载流子浓度N d -N 一 β-Ga2O3 漂移层和内置电位 (eV 双 ) 提取为 (1.3 ± 0.04) × 10 17 厘米 −3 和 (1.30 ± 0.08) eV。根据以下等式,肖特基势垒高度φ b_CV 计算为 (1.32 ± 0.08) eV。
$$ \frac{1}{C^2}=\frac{2}{q\varepsilon {A}^2\left({N}_d-{N}_{\mathrm{a}}\right)} \left({V}_{bi}-V\right) $$ (1) $$ e{\varphi}_b={eV}_{bi}+\left({E}_c-{E}_f\ right)-e\Delta \varphi $$ (2) $$ {E}_c-{E}_f=kT\ln \left(\frac{N_c}{N_d-{N}_a}\right) $$ ( 3) $$ e\Delta \varphi ={\left\{\frac{e}{4\pi \varepsilon}{\left[\frac{2{eV}_{bi}\left({N}_d- {N}_a\right)}{\varepsilon}\right]}^{1/2}\right\}}^{1/2} $$ (4)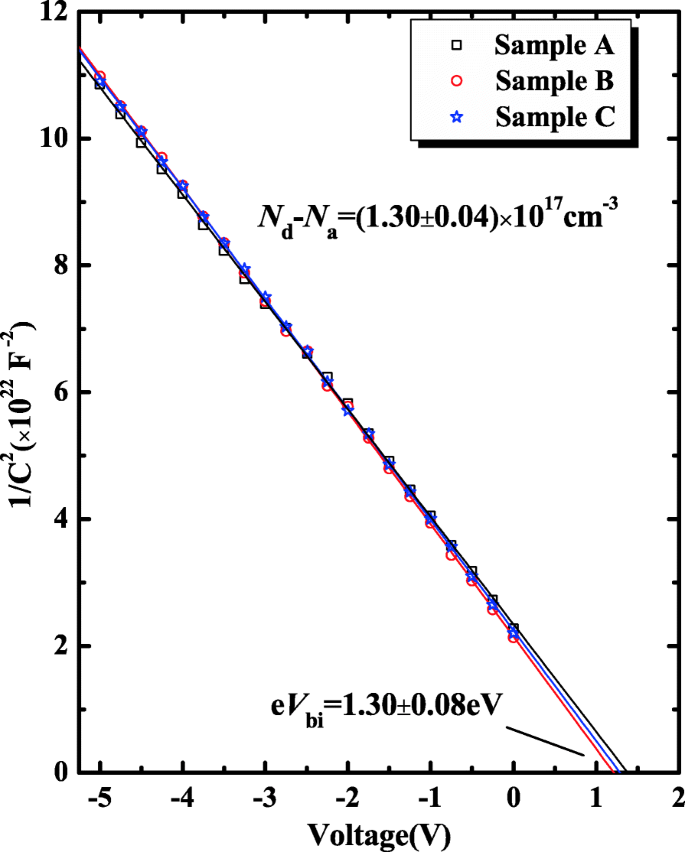
1/C 2 -V 三个β-Ga2O3 SBD样品的绘图
其中 A , q , 和 ε 是肖特基接触面积、电子电荷和 β-Ga2O3 的介电常数。 E c , E f , eΔφ , k , T , 和 N c 分别为导带最小值、费米能级、镜像力引起的势垒降低、玻尔兹曼常数、K绝对温度和导带有效态密度。
图 4a 表示正向电流密度-电压(J -V ) β-Ga2O3 SBD 的特性。在正向偏压下,氩气注入对电气特性没有显着影响。三个样品的阈值电压确定为 0.91 V、0.92 V 和 0.95 V,I 在/我 关闭比率均大于 10 9 在室温下,通过拟合线性区域,比导通电阻 (R on) 分别为 1.7、2.1 和 3.3 mΩ cm 2 ,2 V 时的正向电流密度分别为 857、699 和 621 A/cm 2 分别用于三个样品,如图 4a 插图所示。电流密度较高,比导通电阻低于或与漂移层中较高电导率和载流子密度的报道值相当 [12, 13, 26,27,28,29,30]。
<图片>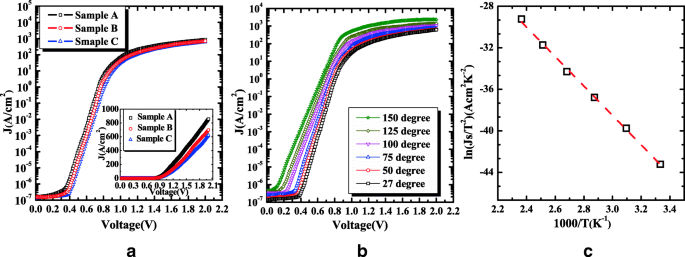
一 前锋 J -V 封端和未封端 β-Ga2O3 在室温和 b 下的特性 温度相关的前向J -V 从 300 到 423 K 的样本 C 的特征。c Richardson 的 ln(J s/T 2 ) 与 1000/T 样本C
为了研究氩注入对正向特性的温度依赖性的影响,正向 J -V 样品 C 的测量在 300 到 423 K 之间进行,如图 4b 所示。理想因子 n 和肖特基势垒高度φ b_JV 在室温下被确定为 1.06 和 1.22 eV,低于 φ 根据热电子发射 (TE) 模型 [31, 32],b_CV 为 (1.32 ± 0.08) eV。随着温度的升高,n 从 1.06 降低到 1.02,势垒高度略有降低,但在整个温度范围内几乎恒定在 1.21 ± 0.01 eV,这与理想肖特基二极管随温度升高的势垒高度降低相反,但已在制造的 β-Ga2O3 中观察到SBD [26]。使用等式 ln(J s/T 2 ) =ln(A*)-qφ b/kT , 势垒高度 ϕ b 和有效理查森常数 A* 确定为 1.22 eV 和 48.5 A/cm 2 K 2 对于来自斜率和 y 的样本 C - 绘图线性区域的轴截距,如图 4c 所示。此外,三个样本上数十个设备的提取 A* 值介于 24 到 58 A/cm 2 K 2 , 与之前的实验结果和理论值一致,24-58 A/cm 2 K 2 , 有效电子质量 m * =0.23–0.34 m0 的 β-Ga2O3 [33,34,35,36,37]。
图 5a 描绘了反向 J -V 样本的特征。注入氩气后,击穿电压从 209 增加到 252 和 451 V,并且 Baliga 品质因数 (VBR 2 /Ron) 的三个样品约为 25.7、30.2 和 61.6 MW cm −2 , 分别。在注入过程中,可能会引入一些缺陷并导致泄漏电流显着且不受欢迎的增加,这在 SiC 和 GaN 肖特基二极管器件中也有报道 [18,19,20]。虽然在注入氩气后进行了热退火,但样品 B 和 C 仍然存在稍大的漏电流。因此,后退火温度和持续时间对正向和反向电特性的研究细节应在下一篇论文中讨论。
<图片>
一 反向J -V β-Ga2O3 样品在室温下的特性。 b 和 c 注入和未注入氩气的β-Ga2O3 SBDs击穿电压分布
图 5b、c 显示了有和没有氩注入的 β-Ga2O3 肖特基整流器的击穿电压分布。这些器件的理想平面并联击穿电压确定为 553 ~598 V,使用 5.1~5.3 MV/cm [11, 39] 的临界电场。未注入氩气的击穿电压约为 110 ~ 310 V,约为理想值的 50%。然而,氩注入剂量为 5 × 10 14 cm −2 , 击穿电压增加到 150~350 V,不比参考器件大多少,而剂量为 1 × 10 16 cm −2 ,击穿电压接近理想值。在这项工作中,可以获得 550 V 的最大击穿电压。此外,还模拟了击穿电压下的电场分布。为简化起见,添加单个中带隙受体水平,注入深度为 50 nm,由 TRIM 模拟确定,并且还考虑了不完全电离模型 [38],如图 6 所示。显然,高电阻率层有效地平滑与参考样品相比,结角处的外电场大大提高了击穿电压。击穿电压下的最大电场均约为 5.05 MV/cm,与报道的结果相似 [11, 39],而位置从界面处的阳极角变为注入区正下方的重叠角,如图 6d, e.
<图片>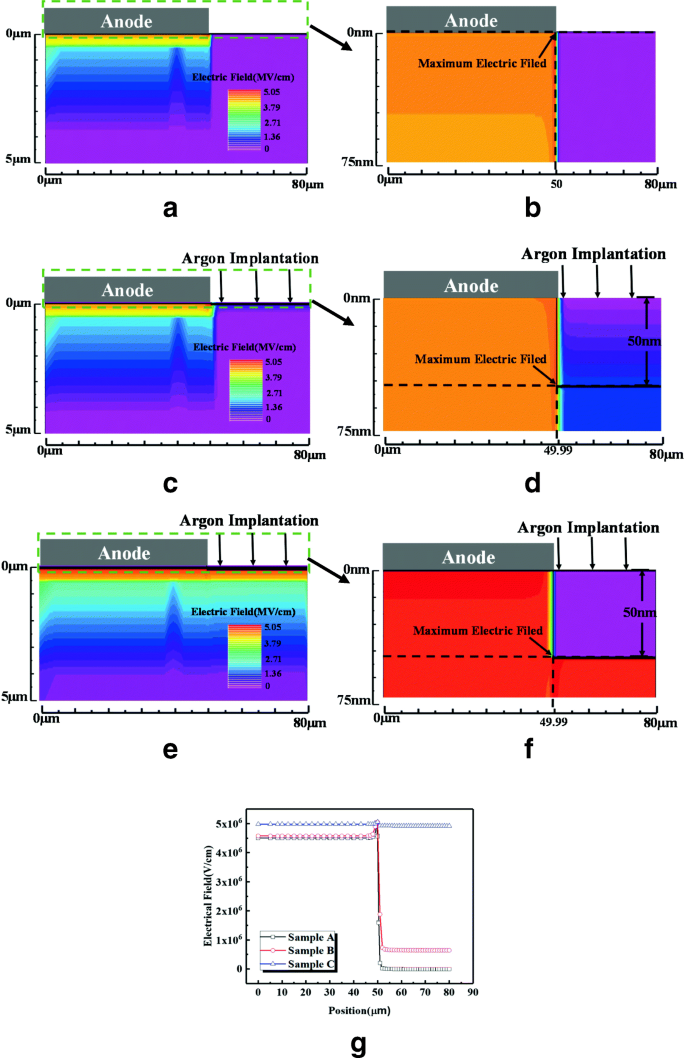
样品 A–C (a , c , e ), 虚线框内选定区域的放大图像 (b , d , f , g ),模拟电场与 (b , d , f ) 对于三个样品,样品 A 的 Au/Ni/β-Ga2O3 界面,分别比样品 B 和 C 的界面下方 50 nm。最大视场为 5.05 MV/cm
结论
在从高质量 (100) 取向的 β-Ga2O3 体衬底机械剥离的 β-Ga2O3 漂移层上制造了通过氩注入形成边缘终止的垂直 Au/Ni/β-Ga2O3 肖特基势垒二极管。与控制装置相比,比导通电阻 (R on) 从 1.7 增加到 2.1 和 3.3 mΩ cm 2 当注入剂量为 5 × 10 14 时,击穿电压从 209 增加到 252 和 451 V cm −2 和 1 × 10 16 cm −2 ,分别具有较大的反向漏电流。击穿电压下的最大电场约为 5.05 MV/cm,远大于 SiC 和 GaN。
缩写
- 原子力显微镜:
-
原子力显微镜
- EFG:
-
边缘定义的薄膜喂养增长
- FWHM:
-
半高全宽
- FZ:
-
浮动区域
- HRXRD:
-
高分辨率X射线衍射
- JTE:
-
结端延长
- MOSFET:
-
金属氧化物半导体场效应晶体管
- RMS:
-
均方根
- SBD:
-
肖特基势垒二极管
- TE:
-
热电子发射
纳米材料
- 研华与 Allxon 和 Trend Micro 合作提供边缘 AI 解决方案
- ST 使用 STM32 神经网络开发人员工具箱将 AI 驱动到边缘和节点嵌入式设备
- ept:0.8 毫米间距的高速 SMT 边缘卡连接器
- Future Electronics:来自 CUI 的 MEMS 麦克风,具有更高的音频质量
- 研华通过 NVIDIA
- 凌华科技:利用 Edge AI Solutions 和 NVIDIA EGX 平台将 AI 从边缘部署到云端
- 凌华科技推出 Edge IoT Smart Pallet Experience 更快、更准确的物流
- 思科通过新路由器将企业和工业边缘连接在一起
- 通过边缘分析升级工业 4.0
- 推进边缘计算,IIC 加入 OpenFog
- 配备研华边缘计算机的智能 5G 巡逻机器人用于抗击冠状病毒
- 如何开始在边缘进行 AI 推理


