Cu 掺杂对 La 基 RRAM 器件性能的影响
摘要
在本文中,研究了 Cu 插入层和快速热退火对 La 基电阻开关存取存储器 (RRAM) 器件的电阻开关行为的影响。与未掺杂的对照样品(Cu/LaAlO3/Pt)相比,Cu嵌入器件表现出更高的器件良率和复位停止电压,这表明La基RRAM的可靠性得到了有效提高。然而,未退火的 Cu/LaAlO3:Cu/Pt RRAM 器件仍然存在参数严重分散的问题。结果证明,经过Cu插入层和退火处理的RRAM器件表现出最佳的电阻开关特性,如低形成电压、高开/关比和良好的电气均匀性。这些改进可归因于Cu原子的扩散和退火过程后Cu纳米晶体(Cu-NCs)的形成,因为扩散的Cu原子和Cu-NCs可以增强局部电场并削弱形成的随机性/导电丝断裂。
介绍
电阻式随机存取存储器(RRAM)被认为是下一代非易失性存储器件的发展方向,由于其结构简单、功耗低、可扩展性高、运算速度快、多值等特点而备受关注。存储容量 [1]。 RRAM通常被制成金属-绝缘体-金属(M-I-M)夹层结构,中间介电层对其阻变(RS)性能有显着影响。因此,各种各样的材料,包括许多常用的高介电常数 (high-k ) 材料(例如 HfO2 [2]、Al2O3 [3] 和 ZrO2 [4]),已被广泛研究用于 RRAM 应用。在所有氧化物材料中,镧基氧化物是最有前景的高k 介电材料因其高k而引起了人们极大的研究兴趣 值、大带隙和良好的热稳定性 [5]。近年来,在La基RRAM中发现了良好的电阻开关特性,如低工作电压、高电阻窗口、长保持时间、长循环耐久性和良好的一致性,表明La基高k RRAM 中的材料 [6, 7]。
此外,由于具有优异的均匀性、精确的厚度控制和与 CMOS 工艺的兼容性等优点,原子层沉积 (ALD) 技术已成为生产 La 基介电薄膜的最常用的生长方法之一 [8]。不幸的是,由于质量好的介电薄膜,ALD 沉积的 RRAM 器件总是需要不希望的高形成电压,这可能导致高故障率、低开/关比、耐久性差和器件的广泛分散 [9] .为了获得具有更好 RS 性能的 RRAM 器件,需要在 ALD 制备的 La基于 RRAM。
在最近的报道中,用于改善传统高k的RS行为的不同掺杂技术 材料(HfO2 [13]、ZrO2 [14] 等)已被广泛研究。然而,迄今为止,尚未报道基于 La 的 RRAM 器件的 NC 改进的 RS 行为。因此,制备了一种具有 Cu/LaAlO3/Cu/LaAlO3/Pt 结构的 Cu 嵌入 LaAlO3 器件用于存储器应用,并关注 Cu 掺杂对 La 基 RRAM 的性能和开关机制的影响设备。
方法
制备的Cu/LaAlO3/Cu/LaAlO3/Pt结构器件示意图如图1所示。La基RRAM器件的制备工艺如下: 双层金属,100-nm Pt/10 -nm Ti,首先沉积在 2-in. SiO2/Si 晶片作为底部电极 (BE) 通过电子束蒸发。随后,将 Picosun R-150 ALD 反应器的温度设置为 300 °C,并在 Pt/Ti/SiO2/Si 衬底上沉积 ~ 10-nm LaAlO3(La/Al 比为 3:1)薄膜,使用La( i- PrCp)3 作为 La 前体,Al(CH3)3 作为 Al 前体,O3 作为氧化剂。然后,使用电子束蒸发器(EBE)以 0.1 Å/s 的速率在 LaAlO3 上生长~2nm 的 Cu 层。同样,~10 nm LaAlO3(La/Al 比为 3:1)薄膜通过 ALD 在 300 °C 下沉积。在使用 ALD-EBE-ALD 工艺制备 LaAlO3/Cu/LaAlO3 转换层后,在 N2 环境中在 600 °C 下进行快速热退火 (RTA) 工艺 30 s。 10 nm Au/150 nm Cu的顶部电极(TE)在光刻后通过电子束蒸发沉积在LaAlO3电介质上,然后剥离以制造尺寸为50×50 μm 2 到 250 × 250 μm 2 .为了进一步了解 Cu 掺杂对 La 基 RRAM 器件性能的影响,两个对照样品,S1:Au/Cu/LaAlO3/Pt(未退火)和 S2:Au/Cu/LaAlO3:Cu/Pt(未退火),被设置。而具有Au/Cu/LaAlO3:Cu-NC/Pt结构的样品被指定为S3。
<图片>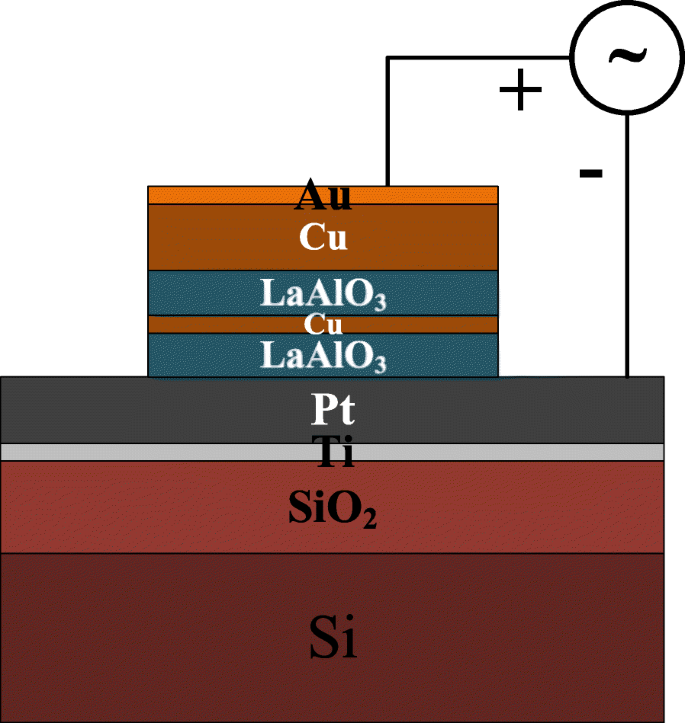
Cu/LaAlO3/Cu/LaAlO3/Pt结构的Cu包埋LaAlO3器件示意图
X 射线光电子能谱 (XPS) 用于分析掺杂 Cu 原子的分布,横截面透射电子显微镜 (TEM) 用于观察制造的 RRAM 器件的微观结构。使用 Agilent B1500A 半导体参数分析仪在不同模式下测量 RS 特性。施加1 mA的电流顺应性以保护制造的器件单元在成型和设置过程中免受大电流的损坏。
结果与讨论
图 2 显示了掺杂 Cu 的 LaAlO3 薄膜中 Cu 2p 光谱的 X 射线光电子能谱 (XPS) 深度分析(蚀刻参数:2 KVM Ar 离子,~ 1 Å/s 蚀刻速率)。从图 2 中可以看出,未退火样品(S2)在蚀刻 30 s 或 60 s 后几乎看不到 Cu 2p 峰,而在蚀刻 90 s 后,出现显着的 Cu 2p 峰,表明 Cu原子主要集中在Cu嵌入层中。不同的是,在退火处理后的整个LaAlO3薄膜中都观察到了Cu原子,即刻蚀30 s、60 s和90 s后,在S3中可以观察到明显的Cu 2p 峰。 XPS结果证实高温退火会导致掺杂Cu原子的重新分布,这可能有助于改善La基RRAM的电学特性。
<图片>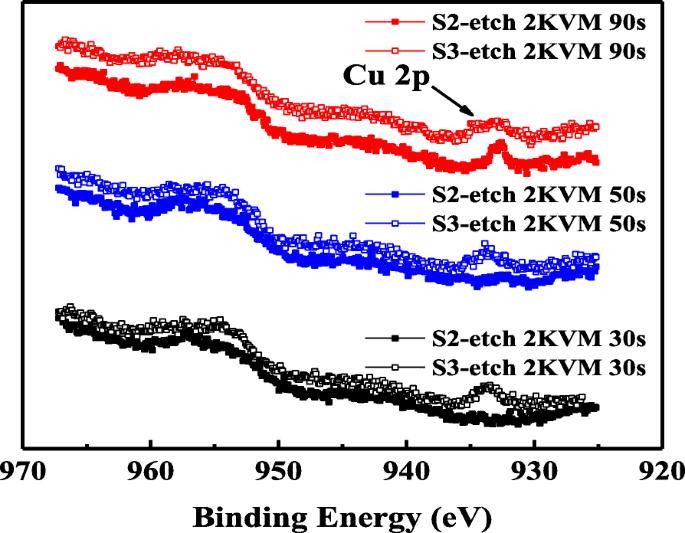
Ar离子蚀刻30 s、60 s和90 s后S2和S3的Cu 2p光谱XPS结果
图 3 显示了两个嵌入 Cu 的 LaAlO3 RRAM(即 S2 和 S3)的典型横截面透射电子显微镜 (TEM) 图像。如图 3a 所示,未退火的 Cu/LaAlO3/Cu/LaAlO3/Pt 器件的层叠结构在 S2 的 TEM 图像中可以清楚地识别。值得注意的是,在 ALD 工艺的 300 °C 下沉积上层 LaAlO3 后,嵌入的 ~ 2-nm Cu 纳米层受到热扩散的轻微影响。因此,从图 3b 的高分辨率图像中,可以清楚地观察到嵌入 LaAlO3 层中的大小为 2~6 nm 的不规则且分离的 Cu 纳米粒子。 ALD工艺后的额外退火处理会进一步增强Cu原子的热扩散,使得难以区分Cu纳米层的存在,如图3c所示。借助图 3d 所示的更高分辨率 TEM 图像,可以观察到大约 25 nm 厚的 LaAlO3 层嵌入了几个球形和分离的 Cu-NC,表明部分 Cu 纳米层已经扩散到600 °C退火处理后留下一些较小尺寸的Cu-NCs的LaAlO3电介质。
<图片>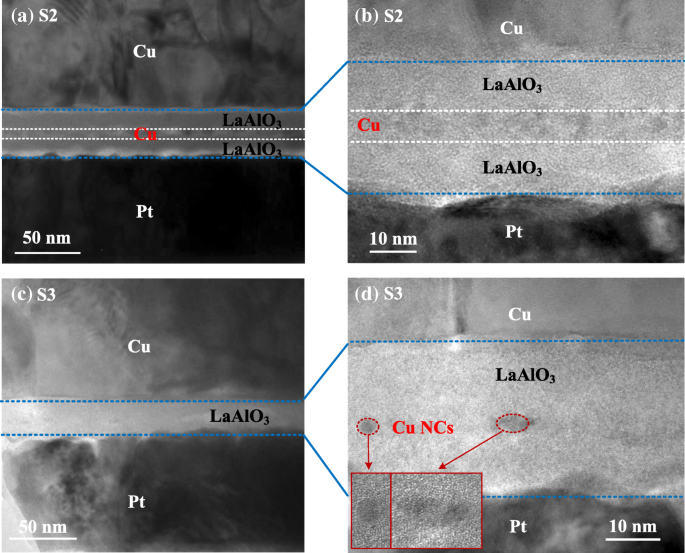
嵌入铜的 RRAM 器件的 TEM 图像。 一 S2 的典型横截面 TEM 图像。 b S2 的 HRTEM 图像。 c S3 的横截面 TEM 图像。 d S3的HRTEM图像
样品S1、S2、S3的电成型过程如图4所示,从图4中可以看出,S1的成型过程需要12 V左右的高电压,而成型电压要低得多(~ 7 V) 在 S2 和 S3 中需要,表明通过在介电膜中插入 Cu 纳米层可以有效降低 La 基器件的形成电压。此外,与S1的初始电阻值相比(2.51×10 12 Ω,读数为 1 V),S2 的电阻要低得多(2.65 × 10 6 Ω,在 1 V 处读取),并且该值在退火过程后增加(S3,2.83 × 10 12 Ω,读数为 1 V)。上述形成电压和初始电阻的变化可归因于通过材料/器件结构工程的LaAlO3薄膜介电性能的变化。由于通过 ALD 方法制备的 La 基介电薄膜的优良品质,需要极高的电场强度来击穿绝缘体(即 S1)。 Cu纳米层插入介电薄膜后,ALD生长的高质量开关层会受到这个金属纳米层的影响,这会使介电更容易击穿,最终导致S2形成电压低得多。此外,由于 Cu 和 LaAlO3 材料之间的结构差异(晶格匹配、热膨胀匹配等),可以有效地降低氧空位形成的能垒,并且更多的亚稳态缺陷会被带入介电膜中 [15]。 ]。因此,大量缺陷(电荷陷阱、金属离子、氧空位等)将被引入 LaAlO3 阻变层,导致 S2 的初始电阻降低 [16]。然而,通过额外的退火处理可以有效减少(或消除)S2 介电薄膜中的这些大量缺陷,从而导致 S3 的高初始电阻 [17]。此外,额外的退火处理使一些Cu-NCs和Cu原子扩散到LaAlO3介电薄膜中,这将进一步增强局部电场并导致S3的形成电压较低[18]。
<图片>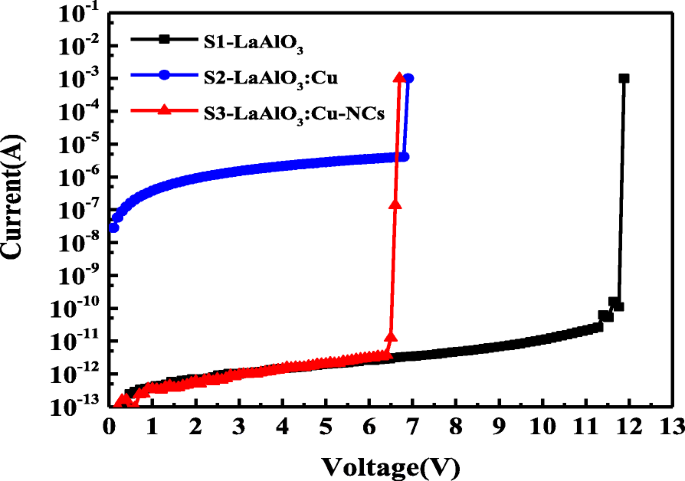
三种La基RRAM的形成工艺
典型的双极电流-电压 (I –V ) 三种基于 La 的 RRAM 器件(面积大小为 50 μm × 50 μm)的~100 个直流 (DC) 扫描周期的曲线在图 5a-c 中获得。测试电压(复位过程为 0 到 − 1.5 V 和 − 1.5 到 0 V;置位过程为 0 到 5 V 和 5 到 0 V)偏置在 TE (Cu) 上,而 BE (Pt) 接地.虽然三个基于 La 的 RRAM 器件显示了 100 个连续周期的可重复双极 RS 行为,但它们之间存在一些很大的差异。首先,与 S2 和 S3 相比,未掺杂样品 S1 在具有复位终止电压 (V stop) of − 1.5 V(如图 5a 的插入所示),这表明最大 V S1的止损低于S2和S3的止损。考虑到这一点,相对较低的 V - 1.4 V 的停止用于样品 S1。另一个区别是 I –V S1和S2的曲线在设定过程中表现出异常波动(上升和下降),这与平滑的I有很大不同 –V S3 的曲线。这种现象与复位过程后未掺杂(或掺杂但未退火)的 LaAlO3 介电薄膜中的一些导电细丝 (CF) 残留密切相关。此外,与S1和S2相比,S3具有I –V 曲线显示出更多的一致性和更小的设置/复位电压分布,这意味着通过掺杂和退火处理可以有效提高 RRAM 器件的稳定性。图 5d-f 是从图 5a-c 左侧提取的 S1-S3 的耐久性测试(~100 周期,在 -0.1 V 处读取)。 Cu/LaAlO3/Pt RRAM器件的最大电阻比,即最大高阻态(HRS)与最小低阻态(LRS)可高达6个数量级。然而,S1 和 S2 的 HRS 的广泛随机波动带来了非常低的开/关窗口(~10)。与 S1 和 S2 不同,S3 的开/关窗口比 S1 和 S2 大 100 倍左右,表明 Cu 掺杂 La 基 RRAM 器件在退火后的一致性特性得到有效改善。 S3 中的退火处理不仅使 Cu 原子在整个 LaAlO3 薄膜周围扩散,而且还在电介质中形成 Cu-NCs。因此,局部电场得到了增强; CF 形成/破裂的随机性得到控制,HRS(LRS)分布得到改善[19]。上述结果表明,将Cu纳米层嵌入La基RRAM的想法需要一定程度的热处理才能获得更好的器件性能。
<图片>
一 –c 典型的双极I –V 曲线和 d –f S1、S2、S3耐久测试
图 6a 显示了 HRS 和 LRS 电阻的累积概率(在 - 0.1 V 处读取),图 6b 记录了设置和复位电压的累积概率。在图 6a 中,平均值 (μ ) 在 S1、S2 和 S3 中获得的 LRS 和 HRS 分别为 50.7 Ω 和 1.59 MΩ、100.6 Ω 和 1.51 MΩ,以及 80.6 Ω 和 1.95 MΩ。然而,变异系数 (σ /μ ) 与 S1、S2 和 S3 中大致相似的平均值相比,LRS 和 HRS 的差异很大。其中,S3的σ/μ值最小(LRS-0.74,HRS-1.02),其次是S2(LRS-1.33,HRS-1.23),S1的σ/μ最差(LRS-1.22,HRS) - 3.00)。如图 6b 所示,样本 S1、S2 和 S3 的复位/设置电压的平均值分别约为 -0.79 V/2.36 V、-0.83 V/2.49 V 和 -1.25 V/2.59 V。标准差 (σ ) 用于评估参数分散的复位/设置电压分别为 0.20/0.82 (S1)、0.23/1.16 (S2) 和 0.13/0.45 (S3)。可以发现,HRS、LRS、V 设置,和 V S1 和 S2 的复位在退火后得到改善。与S1和S2相比,掺杂和退火的(S3)表现出更好的均匀性,表明S3在三者中具有最好的操作稳定性。如上所述,大量的缺陷很可能会被引入到S2中,这会给器件的可靠性和稳定性带来问题。对于 S3,通过热处理消除了大量缺陷,并且由于 Cu-NCs 的存在,CFs 的形成/破裂随机性降低。因此,在 S3 中获得了良好的均匀性,开关电压和电阻值的变化很小。
<图片>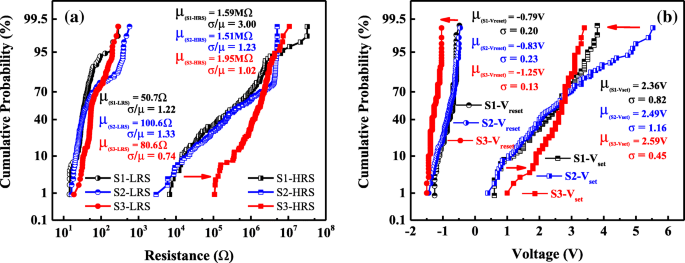
a 的累积概率 HRS 和 LRS(读数为 − 0.1 V)和 b 设置和复位电压
三种La基RRAM器件在室温下-0.1 V读出电压下的保持特性如图7所示。在保持测试期间,Cu/LaAlO3:Cu-NC/Pt器件表现出稳定超过 10 4 的保留性能 s 在室温下具有几乎恒定的 R HRS/R LRS 比率高达三个数量级,符合 La 基 RRAM 的非易失性特性。 DC SET/RESET 10 周期双极良率用于评估 S1、S2 和 S3 的开关能力。如图 8 所示,S3 的产量最好,其次是 S2,S1 最差。该结果表明嵌入Cu层有助于提高La基RRAM的良率,并且可以通过额外的热处理进一步提高器件的良率。此外,在图 8 中可以发现,器件的产量随着器件面积的减小而增加。这一现象表明,Cu/LaAlO3/Pt RRAM 器件的电阻转换机制可能与焦耳热效应密切相关,即焦耳热参与导电细丝的形成/断裂,并且在较小尺寸的器件中似乎更为突出.
<图片>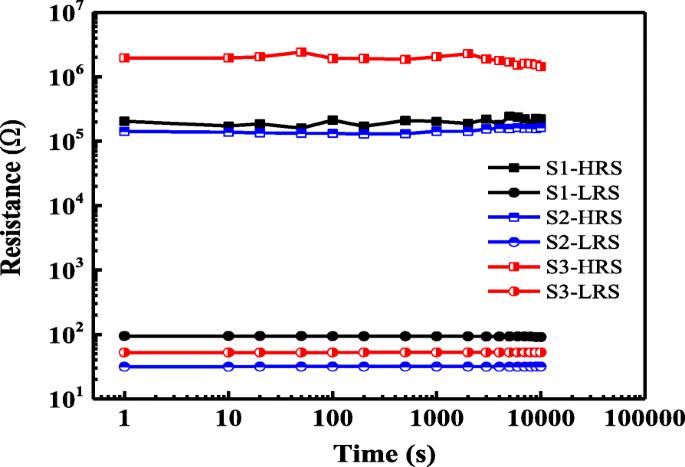
La基RRAM器件在室温下的保留行为
<图片>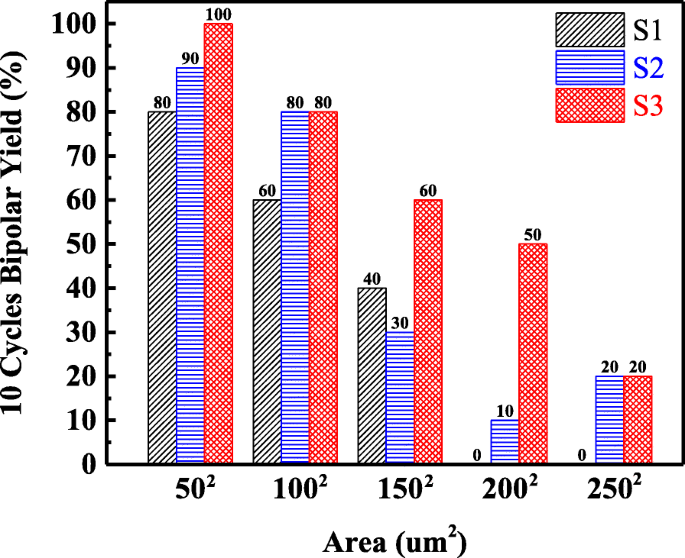
La基RRAM器件的DC SET/RESET 10周期双极良率
为了更深入地了解经过 Cu-NC 处理的 La 基 RRAM,进一步分析了 S3 的电阻转换机制。如图 9a 所示,在 I 中施加不同方向的设置和复位电压 –V S3 的测量。测试结果表明 S3 具有单极和双极电阻开关行为,表明经过 Cu-NC 处理的 La 基 RRAM 是非极性的。研究人员认为,非极性(单极性)电阻切换行为与焦耳热辅助 CF 的形成/破裂密切相关 [7]。在 La 基 RRAM 的复位过程中,观察到大电流过冲现象,然后诱发焦耳热效应,导致 CFs 熔化、烧结或热氧化。图 9b 显示了 I 的双对数绘图 –V S3 的曲线和线性拟合,插入显示 ln(I /V )–V 1/2 设定过程曲线。显然,I –V LRS 中的关系表现出欧姆传导行为,斜率约为 1,这意味着在设定过程后电介质中存在 CF。但HRS的传导机制略复杂,I –V HRS 处的曲线可以分成三个具有三个不同斜率的直线。在低电压区域(<0.8 V,橙色线),拟合线的斜率约为1.33,接近欧姆输运机制。随着电压的增加(~0.8 到~2 V,绿线),拟合线的斜率增加到 1.93 (I ~V 1.93 ),符合 Child 平方律 (I ~V 2 )。在第三个区域(> 2 V,紫色线),拟合线的斜率会继续增加(例如本例中的2.86),当V时电流会急剧增加 达到设定。 HRS 的传导模式由欧姆输运区和儿童定律区组成,与经典的空间电荷限制电流 (SCLC) 机制非常吻合 [20, 21]。 SCLC传导机制的出现表明局部传导通路的形成和破裂[22],被认为是Cu/LaAlO3:Cu-NC/Pt器件的主要RS机制。此外,还发现 HRS 传导与 Poole-Frenkel 传导机制(插入)非常吻合。 Poole-Frenkel 效应主要是由电场激发载流子跳跃穿过俘获态引起的[23],这表明即使经过退火处理,LaAlO3 薄膜中仍然存在大量缺陷。
<图片>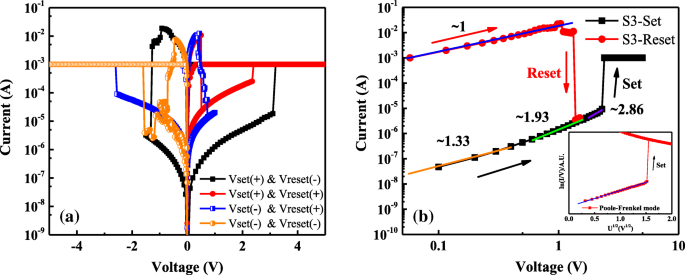
一 我 –V S3 在不同电压方向的测量。 b I 的双对数绘图 –V S3 的曲线和线性拟合,插入显示 ln(I /V )–V 1/2 设定过程的绘图
已经研究了 S3 对电极面积(图 10a)和温度(图 10b)的依赖性,以进一步了解 RS 机制。从图 10a 可以看出,LRS 电阻与电极面积无关,而 HRS 电阻(和初始电阻)随着器件面积的增加而减小,这表明 S3 的 RS 机制起源于形成和破裂的 CF。在图 10b 中,HRS 电阻随温度升高而降低,表明 S3 的关断状态可能与半导体行为相关。相比之下,LRS 电阻随着温度的升高而增加,表明在 ON 状态下具有金属特性 [24]。根据文献,通常用R方程来研究金属电阻与温度的关系 (T ) =R 0[1 + α (T - T 0)] [25]。图 10b 中的蓝色线性拟合确定了温度系数 (α ) 为 1.03 × 10 −3 K −1 .该值略小于其他文献报道的 Cu 纳米线值 (2.5 × 10 −3 K −1 [26], 2.39 × 10 −3 K −1 [27])。由于大量缺陷被引入到 Cu-NC 掺杂的 LaAlO3 薄膜中,较低的 α 本文得到了Cu CFs的值。
<图片>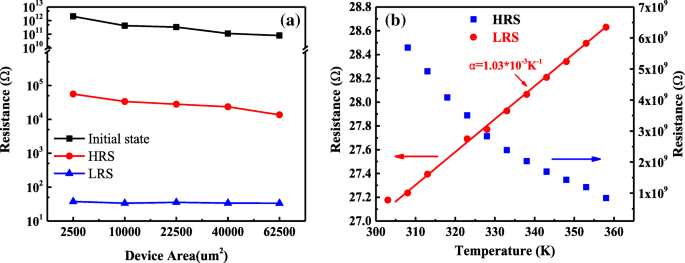
一 HRS 和 LRS 的电极面积依赖性。 b HRS和LRS的温度依赖性
因此,对我们案例中的 Cu/LaAlO3:Cu-NC/Pt 器件的 RS 效应提出了合理的解释。 Cu CFs 的形成和破裂很可能是由电化学金属化 (ECM) 和焦耳热效应介导的。图11为Cu/LaAlO3的RS机理示意图:(a)初始状态的Cu-NC/Pt器件; (b)、(c) 设定过程; (d) 开启状态; (e) 重置过程。当向 TE (Cu) 施加正电压时,会发生氧化反应,描述为 Cu → Cu 2+ + 2e − ,发生在电化学活性材料上(图 11b)。在电场作用下,移动的Cu 2+ 阳离子通过 LaAlO3 薄膜向 BE (Pt) 迁移,以及 Cu 2+ 的还原反应 + 2e − → Cu 出现在阴极(图 11c)。值得注意的是,在 S3 的 La 基电介质中存在一些 Cu-NCs 和扩散的 Cu 原子,这是形成 Cu CFs 的自然途径。因此,连续沉淀的铜金属原子将倾向于沿着这些自然路径生长并最终到达 TE 以形成导电通道(图 11d)。当施加电压的极性反转时,与电化学效应和焦耳热效应密切相关的溶解过程沿灯丝发生在某处,导致CFs几乎完全断裂,器件进入OFF状态(图11e) ).
<图片>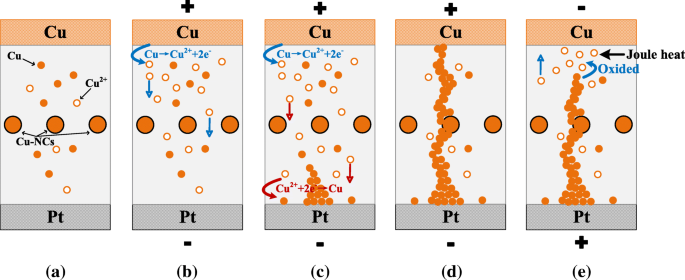
Cu/LaAlO3的RS机理示意图:a中的Cu-NC/Pt器件 初始状态; b , c 设定流程; d 开启状态;和 e 重置过程
结论
总之,引入了一种金属掺杂方法来提高基于 La 的 RRAM 器件的性能。 I 证实了电阻开关特性的明显改进,包括更低的形成电压、更高的开/关比、更好的电气均匀性和更高的器件良率 –V Cu掺杂和退火样品的测量结果。 XPS 和 TEM 分析结果证实,开关性能的提高可归因于 Cu 原子的扩散和退火过程后 Cu 纳米晶体 (Cu-NCs) 的形成。进一步的研究表明,Cu\LaAlO3:Cu-NC\Pt器件的电阻转换机制可归因于Cu导电细丝的形成和断裂,这与SCLC机制和焦耳热效应密切相关。该研究展示了一种通过嵌入Cu纳米晶体来控制RRAMs电阻开关行为的可行方法,但需要做更多的工作来理解La基RRAMs的物理机制和内在规律。
数据和材料的可用性
支持本手稿结论的数据集包含在手稿中。
缩写
- ALD:
-
原子层沉积;内存
电阻式随机存取存储器; NC
纳米晶体; M-I-M
金属-绝缘体-金属;回复
阻性开关;高k
高介电常数;回复
阻性开关;是
底部电极; RTA
快速热退火;特
顶部电极; XPS
X射线光电子能谱;直流
直流电; CFs
导电丝;人力资源部
高阻态; LRS
低电阻状态;小细胞肺癌
空间电荷限流
纳米材料


