通过对通孔长度的调制,突破常关型 GaN HEMT 的多台面沟道宽度限制
摘要
我们提出了新的常关 GaN 高电子迁移率晶体管 (HEMT),它通过调制通孔长度来调节电荷中性屏蔽效应,克服了多台面沟道 (MMC) 宽度的典型限制。基于增强的表面钉扎效应,我们已经制备了宽度高达 300 nm 的增强模式(E 模式)GaN HEMT。具有 MMC 结构和宽度以及通孔长度分别为 100 nm/2 μm 和 300 nm/6 μm 的 E 模式 GaN HEMT 表现出正阈值电压 (V th) 分别为 0.79 和 0.46 V。 MMC 和通孔长度结构的导通电阻低于典型的三栅纳米带 GaN HEMT。此外,该器件不仅实现了 E-mode,还提高了 GaN HEMT 的功率性能,有效减轻了器件热效应。我们控制通孔长度侧壁表面钉扎效应以获得 E 模式 GaN HEMT。我们的研究结果表明,通孔长度常关型 GaN HEMT 在下一代电力电子设备中具有巨大的应用潜力。
背景
宽带隙 III-V 族氮化物由于其优异的材料特性,包括大带隙、高临界电场、高饱和电子速度和高电导率,是用于频率和电压操作的有前途的半导体材料 [1, 2]。因此,它们被广泛用于各种应用,包括发光二极管 (LED) 和晶体管 [3]。此外,氮化铝镓/氮化镓 (AlGaN/GaN) 异质结构利用 III 族氮化物化合物的自发极化和压电极化形成二维电子气 (2DEG),适用于开发高性能器件 [4,5 ,6]。 2DEG 的数量受极化诱导掺杂的比例影响,直接影响器件特性 [7,8,9]。尽管它们具有许多吸引人的特性,但 AlGaN/GaN 高电子迁移率晶体管 (HEMT) 尚未得到普遍应用,因为它们的电子特性可能需要复杂的电路配置以用于数字、电源、RF 和微波电路应用。因此,常关操作对于任何未来的 III-V 半导体器件都是必不可少的 [10, 11]。尽管已经测试了一些特殊的制造技术(例如,使用凹槽栅极 [12,13,14]、在栅极下方插入 p 型覆盖层 [15、16]、隧道结结构 [17]、氟离子注入到栅极下方的势垒 [18],以及包含具有特殊金属栅极和快速热退火 (RTA) 处理的薄 AlGaN 势垒层 [19]),它们会通过加工引起的材料损坏和增加热和电场效应。
或者,北海道大学的一个团队发现,用鳍式纳米沟道制造的 AlGaN/GaN HEMT 表现出阈值电压 (V th) 在正向 [20, 21]。苏州大学的一个小组报告说V的价值 当纳米通道宽度小于 90 nm 时,th 经历了系统的正偏移 [22]。 Kyungpook 国立大学的研究人员考虑了通道侧面的部分应变松弛来解释这种行为 [23]。麻省理工学院的一个团队模拟了 GaN 基 HEMT 表面钝化后的阈值电压,并确定当沟道宽度小于 100 nm 时会出现正值 [24],这是侧壁效应和拉伸应力增加的结果这降低了通道中的电子浓度。由于 3-D 结构,鳍形结构不仅可以改变阈值电压,还可以提高栅极可控性,从而在改善关态特性的同时引入导通状态。归一化最大漏极电流 (I D/mm) 在具有鳍形结构的 AlGaN/GaN HEMT 中高于相应的平面结构 [25]。尽管这些方法已被用于制造 E 模式 HEMT,但开发高性能常关 GaN 功率晶体管仍然非常具有挑战性。首先,结合低导通电阻 (R on),当通道宽度限制在 100 nm 以下时,将实现低设备总功率。虽然 R 的值 可以通过缩短常关栅极的长度来减少沟道的开度,控制关态漏漏电流是另一个挑战,因为栅极宽度通过极化库仑场散射和栅极泄漏路径影响跨导和栅极泄漏 [26, 27]。沉积薄膜可用作栅极电介质来改善这些问题[28]。
在这封信中,我们描述了三栅极通道宽度限制的突破,并提出了一种调节通道通孔长度的方法。我们的器件实现了 E 模式,MMC 结构宽度为 300 nm,通孔长度为 6 μm,阈值电压为 0.46 V。这种方法不仅降低了器件导通电阻 (R on),但也可以减轻焦耳热效应。通过结合具有各种沟道宽度和通孔长度的 3-D 三栅极,我们实现了具有正值 V 的常关型 GaN HEMT 当通道宽度/通孔长度分别为 100 nm/2 μm 和 300 nm/6 μm 时,th 分别为 0.79 和 0.46 V。
方法
使用 Nippon Sanso SR-2000 金属有机化学气相沉积系统 (MOCVD) 在 (0001) 蓝宝石衬底上生长 AlGaN/GaN 外延晶片。外延结构的生长始于在 600°C 下沉积的 GaN 成核层。然后在 1180°C 下沉积 2 微米厚的非故意掺杂的 GaN 缓冲层、21.8 纳米厚的非故意掺杂的 AlGaN 阻挡层(标称铝成分为 23%)和 2 纳米厚的 GaN 盖层。使用电感耦合等离子体 (ICP) 反应离子蚀刻 (RIE) 系统和 BCl3/Cl2 气体混合物开始器件处理,以隔离 130 nm 深的台面并蚀刻周期性沟槽结构。随后,应用两种工艺来恢复凹槽区和台面侧壁的晶面,并降低表面缺陷和离子轰击损伤的水平。第一个涉及使用熔融 KOH 进行晶体湿化学蚀刻,以去除干蚀刻引起的表面损伤,同时产生光滑的垂直侧壁;第二个涉及使用食人鱼溶液(H2SO4 和 H2O2 的混合物)进行表面清洁和去除有机残留物。使用汞灯的传统光刻法用于定义用于 DC 测量的漏极、源极、栅极和接触垫。由钛/铝/镍/金(Ti/Al/Ni/Au,30/120/20/80 nm)组成的 AlGaN/GaN 异质结的欧姆接触通过电子束蒸发沉积到漏极/源极区,然后在 850°C 下真空退火 30 秒。为了完成晶体管通道,通过 Ni/Au (20/80 nm) 的电子束蒸发来制造栅电极。图 1 提供了 HEMT 结构横截面的示意图、器件的顶视图和器件的 3-D 结构图。栅极长度 (L g)、MMC结构宽度(W MMC), MMC 结构通孔长度 (L MMC) 和 MMC 结构高度 (H MMC) 分别为 2 μm、100-500 nm、1-6 μm 和 130 nm。鳍片并联连接。为了增强表面钉扎效应,GaN HEMT 通孔长度结构未进行钝化。图 2a 显示了源漏区金属表面的俯视扫描电子显微镜 (SEM) 图像。图 2b 中的光学显微镜 (OM) 图像显示了完整的门和通道;在计算实际电流时,观察设备中存在多少通道是有帮助的。由于退火后原子在晶格中迁移,位错数量减少,因此图像中的表面显得凹凸不平,从而有效地降低了电阻。图 2c 中的 SEM 图像证实了通道的尺寸。
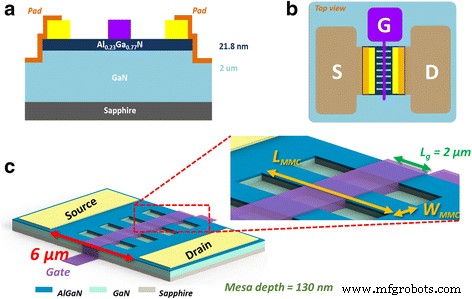
a 的示意图 HEMT结构的横截面,从平行于晶体管沟道的方向看; b HEMT结构的俯视图;和 c HEMT的3-D结构
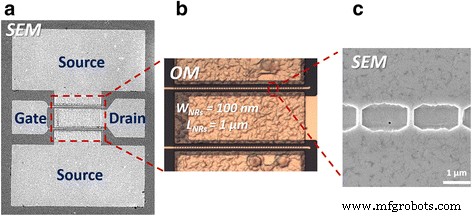
一 器件的俯视 SEM 图像; b 器件的顶视图 OM 图像,显示通道宽度和长度分别为 100 nm 和 1 μm;和 c 通道俯视SEM图
结果与讨论
迄今为止,GaN 高压晶体管的大多数技术发展都基于 AlGaN/GaN HEMT,由于 AlGaN-GaN 界面处的极化诱导二维电子气,它们本质上是耗尽型(D 模式)器件[29]。然而,如果电力电子行业要广泛采用GaN技术,则需要常关型GaN晶体管。
(Al)GaN 表面上的悬空键数约为 10 15 cm −2 ;由于表面钉扎效应,这些悬空键会导致表面耗尽带弯曲。图 3a 显示了三栅极结构中侧壁栅极的横向沟道表面耗尽区域。 Kyungpook 国立大学的研究人员报告了类似的现象 [21]。图 3b 显示了 I DS-V 具有固定值 L 的设备的 G 传递特性 2 μm 的 MMC 和 W 的值 100、300 和 500 nm 的 MMC。当漏源电压为 8 V 时,V 的值 这些器件中的 th 分别为 +0.79、-1.32 和 -2.18 V。因此,随着通道变窄,阈值电压发生正偏移。这种现象可能是由于横向沟道耗尽和通过横向沟道耗尽和通孔长度表面弯曲的影响,从 MMC 通孔长度结构中的侧壁起 2μm 通孔长度的表面钉扎.

一 具有宽通道和窄通道的 AlGaN/GaN HEMT 的示意图。 b 我 DS-V 为具有 L 值的设备测量的 G 传递特性 2 μm 的 MMC 和各种 W 值 MMC
图 4 显示了具有固定值 W 的设备的 IDS-VG 传输特性 300 nm 的 MMC 和 L 的值 1、2 和 6 μm 的 MMC。当漏源电压为 8 V 时,V 的值 th 分别为 -2.12、-1.07 和 +0.46 V。当 MMC 的长度和宽度分别为 6 μm 和 300 nm 时,该器件实现了正常关闭操作。调节通孔长度和通道宽度可以提供显示正常关闭操作的设备。表 1 列出了针对各种通孔长度和多台面沟道宽度测量的阈值电压。当通道宽度固定为 500 nm,通孔长度从 0.8 μm 增加到 6 μm 时,V 的值 th 从 -2.62 增加到 -1.62 V,饱和漏电流从 747 减少到 98 mA/mm,跨导从 270 减少到 40 mS/mm。当通道宽度固定为 300 nm,通孔长度从 0.8 μm 增加到 6 μm 时,V 的值 th 从 -2.15 增加到 +0.46 V,饱和漏极电流从 685 减少到 6.8 mA/mm,跨导从 290 减少到 7.4 mS/mm。当通道宽度固定为 100 nm,通孔长度从 0.8 μm 增加到 2 μm 时,V 的值 th 从 -0.41 增加到 +0.79 V,饱和漏极电流从 547 减少到 53 mA/mm,跨导从 400 减少到 67 mS/mm。 HEMT 电流处理能力受载流子浓度的影响很大 [20, 21]。因此,器件的饱和漏电流和跨导受到侧壁总表面状态和三栅沟道在改变 GaN HEMT 的宽度和通孔长度时的表面耗尽效应的强烈影响。与之前报道的器件 [23] 相比,我们的器件在低导通电阻、常关断 GaN HEMT 方面达到了一个新的里程碑。

我 DS-V 具有固定值 W 的设备的 G 传递特性 300 nm 的 MMC 和各种 L 值 MMC
<图>结论
我们已经制备了具有多台面沟道 (MMC) 结构的 E 模式 GaN HEMT;当通道宽度和通孔长度分别为 300 nm 和 6 μm 时,它们表现出 0.46 V 的正阈值电压。我们推断横向通道耗尽和通孔长度表面弯曲的影响。当包含具有 MMC 通孔长度结构的三栅极时,新的常关型 GaN HEMT 表现出非常低的导通电阻,即使将 MMC 结构宽度增加到 300 纳米(以前限制为小于 100 纳米)也是如此。此外,通孔长度MMC结构的调制提供了常关型GaN HEMT,由于增加了MMC结构器件宽度,从而提高了优异的功率性能。
纳米材料


