GaAs1-xBix 合金的原子分辨率 EDX、HAADF 和 EELS 研究
摘要
半导体中合金原子的分布通常偏离随机分布,这会对材料的性能产生重大影响。在这项研究中,采用扫描透射电子显微镜技术分析了几种明显 MBE 生长的 GaAs1-x 中 Bi 的分布 双x 合金。采用原子分辨率 HAADF 图像的统计量化以及数值模拟来解释在原子突变 (001) GaAs-GaAsBi 界面处含 Bi 柱的对比度和 CuPt 型排序的开始。使用单色 EELS 映射,在展示相分离域的样品中检查体等离子体能量红移。这提出了一种简单的方法来研究局部 GaAsBi 晶胞体积膨胀并补充标准的基于 X 射线的晶格应变测量。此外,在切割衬底上生长的单变体 CuPt 有序 GaAsBi 样品用原子级组成 EDX 映射表征,并估计顺序参数。最后,使用低衬底旋转速率合成具有垂直 Bi 成分调制的 GaAsBi 合金。在原子上,解析的 EDX 和 HAADF 成像表明,通常的 CuPt 型排序沿 [001] 生长轴进一步调制,周期为三个晶格常数。这些独特的 GaAsBi 样品体现了该合金中可以实现的多种 Bi 分布,揭示了 Bi 原子的掺入机制以及进一步开发含 Bi III-V 族半导体的方法。
介绍
双胺砷化镓1−x 双x 合金经历了大量的研究,代表了新兴的含铋族 III-V 族半导体 [1]。铋是最大的稳定且无毒的元素,掺入后会产生大的 GaAs 带隙减小。在 V 族亚晶格中取代 Bi 允许在具有中等晶格应变的 GaAsBi 中实现高达 90 meV/Bi% 的带隙弯曲 [1,2,3]。大的自旋轨道带分裂是 Bi 掺入晶格的另一个显着影响。这可能允许抑制 GaAs1-x 中的价带吸收和俄歇-迈特纳复合 双x 与浓度 x> 10% [4]。结合降低的带隙灵敏度,这些特性使双胺成为长波红外激光器、光电探测器和多结太阳能电池等应用的有吸引力的候选者 [1, 5,6,7]。
在 GaAs 基体中加入 Bi 需要非常规的生长条件,因为 Bi 原子往往会在典型的 GaAs 生长温度下解吸 [8,9,10]。通常需要低于 400 °C 的基板温度,以及接近化学计量的 III/V 族比率。必须小心避免形成表面 Ga 或 Bi 液滴,这些液滴在这些条件附近很容易发生,并且与生长层厚度及其成分的不均匀性有关 [11,12,13,14]。尽管使用金属有机气相外延已经取得了进展 [15,16,17],但需要在低温下加入更高浓度的 Bi 使分子束外延 (MBE) 成为首选的合成方法。 GaAsBi 合金在这些低生长温度下仍然显示出令人惊讶的高光致发光 (PL) 强度,这归因于 Bi 表面活性剂效应和通常在低温 GaAs 中形成的 As 相关点缺陷的密度降低 [18, 19]。在价带 (VB) 反交叉的图片中,掺入的单个 Bi 原子在扩展的 GaAs VB 下方产生谐振状态,导致光学带隙减小 [2, 20, 21]。第一性原理计算还表明,由附近相互作用的 Bi 原子组成的簇可以产生比孤立的 Bi 原子显着更大的带隙变窄 [22]。这些不同的 Bi 配置产生强烈的 VB 扰动,并可以引入局部电子缺陷状态。研究表明,由大 Bi 原子产生的晶格应变将导致簇更有可能与空位 VGa 和 VA 结合 [23]。富含砷的生长条件应该有利于形成 BiGa 异质反位缺陷,预计这些缺陷会导致 GaAsBi 中的深孔陷阱 [23, 24]。在 GaAsBi 合金的温度相关 PL 中通常观察到明显的激子局域化效应,这归因于这种与 Bi 相关的团簇和缺陷复合物 [25, 26]。
像许多其他三元 III-V 族半导体合金一样,GaAsBi 显示出自发有序的趋势 [27]。使用高分辨率(扫描)透射电子显微镜 (STEM/TEM) [13, 17 , 28]。人们普遍认为,III-V 合金中的 CuPtB 型调制是由表面重建动力学驱动的,并伴随着由表面二聚体行组成的 (2 × 1) 重建 [27, 29,30,31,32,33] .当沉积在平坦的 (001) GaAs 衬底上时,排序发生在四组不同的 {111} 平面中的两组上。可以通过使用邻位底物进一步选择单个 B 型排序子变体。事实上,最近的工作表明这也适用于 GaAsBi,其中使用低角度切割晶片在单组 {111}B 平面上实现了大的 CuPtB 型域 [34]。 GaInP2 中的 CuPt 型排序可能是研究最多的,因为在这种合金中可以获得具有大有序参数的高质量晶体。长程有序将闪锌矿点群对称性从四面体 Td 改变为三角 C3v [35, 36]。由于对称性降低而产生的显着影响包括带隙变窄、光致发光的偏振、双折射和各向异性应变 [37,38,39]。这些影响的大小取决于长程有序参数,η ,它显示了有序晶格平面之间元素分布的程度。在 CuPtB 有序 AB1−x Cx 合金(对于 x <=0.5),晶格在富含 B 元素的 AB1−(x−η /2)Cx−η /2 和富含 C 的 AB1-(x + η /2)Cx + η /2 单层沿 <111> B 方向。阶次参数η =0 在随机合金中,而在具有浓度 x 的完全有序合金中 因此它是 η =2x .
显然,这种有序合金中 Bi 的分布不同于随机合金,在进一步推导合金性能时应考虑到这一点 [17, 40]。对稀GaAsBi合金中CuPt有序效应的理解仍处于早期阶段,需要更系统的研究。在本文中,采用先进的像差校正 STEM 方法来分析几种明显生长的 GaAsBi 合金中的 Bi 分布模式。使用统计 STEM Z 对比度图像处理和图像模拟以及原子分辨 X 射线能量色散光谱 (EDX) 进行分析。单色电子能量损失光谱(EELS)利用体等离子体能量位移研究GaAsBi局部晶胞体积变化。
结果与讨论
第一个 GaAs1−x 双x 此处展示的样品 S1 是具有掺杂 GaAs 层和本征 420 nm 双化物的 p-i-n 异质二极管。使用 X 射线衍射(此处未显示)和室温 PL 确定样品中的铋浓度为 4.5% Bi,表明带隙为 1.10 eV(SI 图 S1)。使用参考文献 [1, 2, 4] 将 PL 频带边缘测量值转换为 Bi%。沿 GaAs-GaAsBi 界面附近 [110] 区轴的横截面原子分辨率 HAADF STEM 图像如图 1a 所示。 [001] 生长轴和其他相关的结晶方向在图 1b 中标出,也适用于图 1a。由于重 Bi 原子将探针电子散射到比 Ga 或 As 原子强得多的高角度,因此具有大内部收集角(此处为 90 mrad)的 HAADF 探测器有利于突出薄样品中的 Bi 分布。沿 <110> 方向观察的晶体表现为一组原子“哑铃”,其取向平行于生长 [001] 轴。由于它们的原子序数 (Z) 相似,Ga (31) 和 As (33) 不能仅通过检查 HAADF 图像就容易区分。然而,含 Bi 的 V 族柱显示出明显更高的对比度。从图 1a 和界面附近的放大区域可以看出,V 族柱位于 Ga 柱上方哑铃的上半部分。当沿 [110] 区轴对 GaAsBi 成像时,这是预期的。请注意,当沿正交 [\( \overline{1} \)10] 方向观察样品时,V/III 组哑铃的极性是相反的。这些平面内正交方向也可以区分,因为 CuPt 型排序发生在 {111}B 型平面上,因此只能通过沿 [110] 区轴成像才能看到。图 1b 显示了薄膜内较深的较低放大倍数的 HAADF 图像,具有明显的 CuPtB 型排序。可以看到有序域在两组 {111}B 平面之间随机交替,即 (\( \overline{1} \)11) 和 (1\( \overline{1} \)1)。按照惯例,它们被称为 B+ 和 B- 子变体。图像的傅里叶变换显示在左上角的插图中。四个主要的布拉格斑点是 [111]* 型,而四个 1/2[111]* 型超晶格斑点表明 CuPtB 在两组 {111}B 平面上具有相似的数量级排序。相分离的 GaAsBi 区域在图 1b 中可见,作为下部图像部分中的较暗条纹。该域看起来比铋化物更暗,因为它是缺铋的 GaAs 状。由于 GaAsBi 合金的亚稳定性,许多文章已经报道了旋节线分解和相分离 [11,12,13,14,41,42]。为了更清楚地描述 B+ 和 B- 子变量排序,图图 1c、d 是通过使用 1/2[111]* 超晶格反射对形成图像来呈现的。对倒易空间中的每个超晶格对应用掩码,并将傅立叶逆变换回真实空间。这些图像中(111)平面的较亮区域表明排序更明显,或者换句话说,排序参数在局部变化。由于通过聚焦离子束制备样品,还存在 TEM 样品表面厚度变化。样品制备会在表面留下无定形表面层和熔化的 Ga 原子团聚体,这会导致图像强度调制较弱。然而,Ga 对高角度的散射比 Bi 原子弱得多,不应显着影响 Bi 分布的分析。图 1d 中的箭头显示了具有有序反相边界的区域。跨越这样的边界,B+ (B-) 域通过将所有富 Bi 平面切换为富 As 平面来改变其相位。有序反相边界可以通过位错的滑动或由于生长过程中 B+ 和 B- 域之间的随机交替而形成 [43]。后者似乎是这里的情况。
<图片>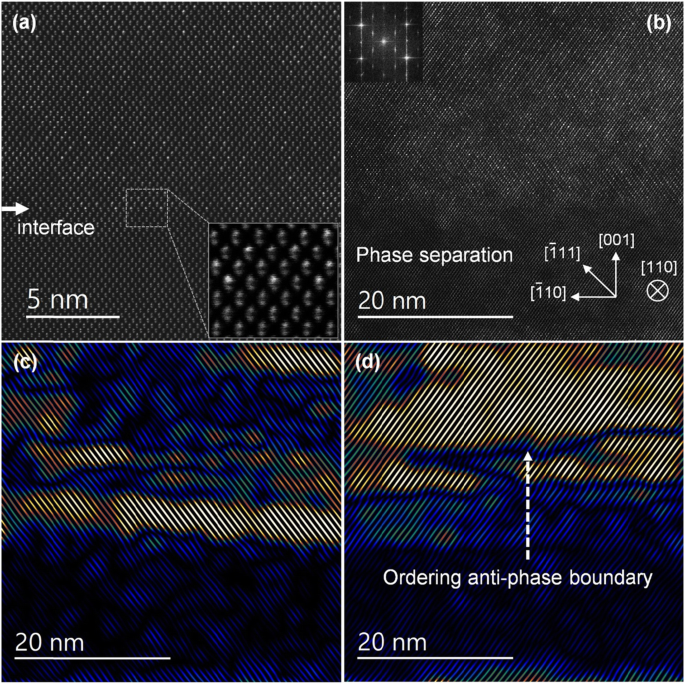
一 样品 S1 GaAs-GaAsBi 界面区域的横截面 HAADF 图像。界面的放大插图显示在右下角。结晶方向与图 1b 相同。 b 远离界面的样品的 HAADF 图像。在中间可以看到拉长的自发相分离的 GaAs 状域。插图显示了图像的傅立叶变换。 c 由 (b ) 使用 1/2[\( \overline{1} \)11]* 对超晶格反射。更亮的颜色表示更明显的排序。 d 由 (b ) 使用一对 ½[1\( \overline{1} \)1]*reflections
接下来通过考虑原子柱散射截面 (SCS) 的空间分布对图 1a 中所示的 HAADF 图像进行量化(参见方法)。 StatSTEM 算法用于拟合具有二维高斯分布的列,并且给定列的 SCS 定义为该高斯分布下的体积 [44, 45]。这是一种基于参数模型的量化,与实验图像中柱强度的直接积分相反。如果柱强度倾向于重叠,例如在 <110> GaAsBi 中,参数模型方法可能更可靠。量化图 1a 中 SCS 的分布绘制为图 2b 中的直方图,该图暂时拟合了五个高斯分布。然后将 SCS 的空间分布绘制在图 2a 中,模型结构由高斯叠加组成,使用相同的配色方案正方形放置在每列上。 Ga 和 As 柱的 SCS 强烈重叠并在直方图中产生主峰。这是由于这些原子的 Z 数相似以及额外的实验引入的展宽(参见方法)。通过绘制此主峰内的低高斯分量(深蓝色)或高斯分量(浅蓝色)表明,GaAs 缓冲层中约 60% 的例如 As 列被正确识别,这可以从哑铃极性进行检查.为了进行比较,单独的底部 GaAs 缓冲层的 SCS 量化显示在补充图 S2 中。这表明目前需要两个以上的高斯分布来更好地区分视野中的 Ga 和 As 列,并表明它们的平均 SCS 差异高达 10%。这种差异与我们下面显示的模拟以及 Beyer 等人发现的结果一致。 [17],其中 [010] GaAsBi 中的 Ga 和 As 积分柱强度分布得到解决。强烈散射 Bi 原子的存在将 SCS 扩展到 ~ 5.5 × 10 5 以上的值 e - Å 2 (参见 SI Fig. S2),这导致了图 2b 中的右手肩。它配备了三个高斯函数,以初步区分 Bi 含量较高的列。原子突变的 GaAs-GaAsBi 界面可以在图 2a 中看到。更仔细的检查表明,第一层 V 族 (001) 列包含大量 Bi 原子,沿着界面每隔两个哑铃排列。这表明在外延生长早期开始 CuPt 型排序。界面原子配置的描述显示在图 2b 的插图中。它沿第一 V 族 (001) 平面的每第二列上与 Bi 原子(橙色)的界面重新创建原子排列。图 2a 中的第一个 ~ 4-5 (001) 个原子平面显示没有对 CuPt B+ 或 B- 子变体的倾向。更明显的单变体排序从 ~ 6th (001) 族 V 原子层出现,然后切换到另一个子变体。界面处的 SCS 分布表明没有反位缺陷 BiGa,这在 III 族柱子上以正方形可见,颜色与 Bi 相关。然而,在图的右上角发现了几个 BiGa 反位点的可能性。 III 组和 V 组列都在该区域的单个哑铃上显示类 Bi 类 SCS,这也可能表明缺陷对 BiGa-BiAs 的存在。为了更好地了解参与确定 SCS 的 Bi 原子数量,请注意,在标称 20-25-nm 厚的样品中,<110> 列中有 50-60 个原子。因此,对于目前具有 4.5% Bi 的随机合金,最有可能在 V 族列中发现 2-3 个 Bi 原子。在有序的富含 Bi 的平面中,这个数字会更高,在具有最大 SCS 的列中可能达到 6-7 [40]。为了补充 StatSTEM 分析,接下来介绍了模型 GaAsBi <110> 超胞结构的多层 HAADF 图像模拟(详见方法)。
<图片>
一 图 1a 中 SCS 的分布。每个原子列上的彩色方块根据图 2b 中的 SCS 颜色方案。 b 图 1a 中 SCS 的直方图,拟合了 5 个高斯分布。插图显示了界面区域的描述。 Ga原子柱为深蓝色,As-为浅蓝色,含有Bi的柱为橙色。 c GaAsBi 结构的模拟 HAADF 图像如图 2d 所示。列中的 Bi 原子数显示在每个 V 族列右侧的橙色括号中。拟合的 SCS 值显示在每列的左侧,并归一化为超级单元中的最大 SCS 值。 d 模型 GaAsBi <110> 结构侧向旋转以突出显示 Bi 位置(橙色)、浅蓝色-As、深蓝色-Ga 原子。箭头表示入射光束方向
由于松散地称为沟道效应 [46,47,48,49],不同样品深度的 Bi 原子对 HAADF 图像强度的贡献可能是非线性的。因此,在区分成分的真实变化与掺杂剂配置的变化时,需要考虑在原子尺度上对掺杂剂进行量化 [50, 51]。为了说明沟道行为,当位于 <110> GaAs 中的 As 柱上时,平均探针强度随样品深度的变化进行了数值模拟,并显示在补充图 S3 中(参见方法)。用于 HAADF 模拟的 17 nm 厚的模型 GaAsBi 结构如图 2d 所示,横向旋转以突出显示 As 列(As-浅蓝色,Ga-深蓝色)内 Bi 原子(橙色)的位置。箭头标记了入射光束的方向。图 2c 中显示的模拟图像是使用 StatSTEM 算法拟合的,以便与实验进行比较。将获得的 SCS 值归一化为具有最大 SCS(6 个 Bi 原子)的柱的 SCS 值,并四舍五入为两位有效数字。这些标准化值显示在每列的左侧。每个 V 族列中的 Bi 原子数显示在列右侧的括号中。与之前的发现合理一致的是,发现 As 和 Ga SCS 值之间的差异约为 8%。对于不同位置的 Bi 原子,纯 As 柱和包含一个 Bi 原子的 As 柱之间的 SCS 差异在 2-4% 的范围内。可以清楚地看到,不同的 Bi 构型可能会被误解为不同的组成,例如 4 和 5 个原子或 5 和 6 个原子,它们给出几乎相同的 SCS 值。朝向底部表面的柱中的 Bi 原子对 SCS 的贡献越来越小。这里一个接一个检查的具有 2 个 Bi 原子的几种配置似乎对 SCS 值产生了很大的贡献。如果 GaAsBi 合金中的 CuPtB 排序确实产生具有 C3v 点群对称性的结构单元,即具有最近邻 1 As 和 3 Bi原子。请注意,相同的 Ga 色谱柱的 SCS 变化也高达 ~ 0.02。这表明它们的直接环境,例如附近的强散射柱,由于多次散射或通过延伸的探针尾部与它们耦合而贡献了额外的强度 [52]。最近引入的更好的缩放算法为加速量子力学多层计算提供了可能性,从而更详细地探索上述效应 [53, 54]。
为了总结样品 S1 的 STEM 分析,使用电子能量损失光谱 (EELS) 来绘制体等离子体能量。等离子体能量转移将与晶胞体积变化有关,因此与合金应变有关,如下所述。 GaAs 在 ~ 16 eV 处表现出一个主要的等离子体峰,并且与 CdTe 等不同,它没有显示来自带间跃迁的复杂干扰特征 [55]。作为解释测量的等离子体能量变化的第一个近似值,我们采用 Drude-Lorenz 模型来计算自由电子电子气,其中自由电子现在是半导体中的价电子 [56]。该模型中的体等离子体能量为 \( {E}_p=\hslash {\left(N{e}^2/ Vm{\epsilon}_0\right)}^{1/2} \),其中N 是晶胞中的价电子数,e 是电子电荷,V 是晶胞体积,m 是电子质量,ε 0 是自由空间的介电常数。简单的 Drude-Lorenz 模型通常预测半导体中几个百分点内的等离子体能量,如果寻求更好的匹配,则需要针对能带结构效应进行校正 [56]。如 InGaAs 和 III 族氮化物半导体合金所示,晶胞体积的变化是决定等离子体能量转移的主要量 [57, 58]。同样,GaAs基体中等电子Bi原子的取代主要作用是扩大晶胞体积,V ,从而使等离子体能量红移。在下文中,我们利用测量的 GaAs 和 GaAsBi 峰值能量通过它们的晶胞体积比来推断 GaAsBi 层的局部应变状态变化。
选择一个包含相分离的 GaAsBi 域的区域,如图 3 所示。从伴随同时采集的 HAADF 图像的每个像素收集 EELS 光谱(原始光谱参见方法和 SI 图 S4)。 HAADF 图像中的虚线表示本征 GaAsBi 与 p 型(底部)和 n 型(顶部)GaAs 层之间的界面。界面分界线由较低放大率的 STEM 图像(此处未显示)确定。保护性 Pt 层作为上部 n-GaAs 上方对比度较高的材料可见。 GaAs 层以及 GaAsBi 内的相分离域在 HAADF 图像中显得更暗。右侧 EELS 图上的垂直线轮廓是通过水平合并所有 EELS 数据点获得的。它显示了相对体等离子体峰值能量偏移,EGaAsBi-EGaAs,参考底部 p-GaAs 缓冲层内的 GaAs 等离子体能量(测量为 16.23 eV)。可见等离子体峰平均移动 0.08 eV,以降低 GaAsBi 层的能量。 ~ 0.01 eV 内的微小变化处于量化噪声水平。 GaAs 顶部(薄层)和底部(两个相交的域)附近的相分离域返回到 GaAs 等离子体能量值,表明它们包含可忽略的 Bi 浓度。 GaAs 层中的掺杂浓度(顺序 10 17 厘米 −3 ) 与 N 相比微不足道 /V 并且不应影响等离子体能量。我们现在考虑 GaAs1−x 的两个极限情况 双x 晶胞体积 V;一种是晶格完全松弛,另一种是完全应变到 GaAs 衬底。在完全松弛的情况下,晶胞是立方晶格常数 a ≈ 5.684 Å 在 x =4.5% 双 [1]。使用上述等离子体能量与 V 之间的平方根关系 ,相对于 GaAs 的能量偏移应该是 \( \Delta {E}_p^{GaAs Bi}=16.23\left({\left({V}_{GaAs}/{V}_{GaAs Bi}\right) }^{1/2}-1\right)=-0.132\mathrm{eV} \),明显大于实测值。根据 GaAsBi 合金的弛豫趋势,考虑到在生长顶部 n-GaAs 层时也经历了短暂的热退火,我们估计在这个 420 nm 厚的薄膜中约 30% 的晶格被弛豫。因此,在完全放松的情况下,平均 GaAsBi 晶胞将被高估,并解释了上面获得的更大的 \( \Delta {E}_p^{GaAsBi} \)。在另一个限制中,双胺晶格被认为是完全应变的,面内晶格常数等于 GaAs (a =5.653 Å)。然后找到恢复 - 0.080 eV 能量偏移所需的面外晶格常数 a z =5.709 Å。这是一个明智的a z 值,可以与 GaAsBi 压缩应变到 GaAs 衬底的 XRD-RSM 测量值进行比较 [1, 34, 59]。由于松弛,实际晶格常数预计介于这两个极限情况之间。这证明了一种很有前途的表征方法,可以提供有关这种亚稳态合金中的晶格应变的信息,与基于 X 射线的技术互补。
<图片>
p-i-n 样品 S1 的横截面 HAADF 图像(左),带有标记的 GaAs 和 GaAsBi 层。 GaAsBi 内的较暗区域是相分离域。线轮廓(右)显示 EELS 体等离子体峰值能量偏移,E GaAsBi-E GaAs,相对于 GaAs 缓冲层。该轮廓与左侧同时采集的 HAADF 图像紧密对齐。 EELS 数据像素在水平方向完全合并,因此表示空间平均值。比例尺为 100 nm,同样适用于 EELS 剖面的纵轴
第二个 GaAsBi 样品 S2 生长在 GaAs 缓冲层上,该缓冲层沉积在切割的 Ge 衬底上(参见方法)。在我们之前的工作中分析了 Ge-GaAsBi 异质外延,这也证明了 GaAsBi 中的大域单变体 CuPtB 排序 [34]。这项工作中提供了额外的数据,用于完整地讨论 Bi 原子排序。该样品中的总铋浓度约为 5.8%,由 PL 测量(SI 图 S1)[34]。这种外延中使用的边角料与 GaAs 缓冲层相结合有助于避免在 GaAsBi 中形成反相域,当它直接在非极性 Ge 上生长时,反相域的消除仍然很麻烦 [60,61,62]。图 4a 显示了 GaAs-GaAsBi 界面区域,在 HAADF 图像中 GaAsBi 层明显更亮。与之前沉积在平坦 GaAs 衬底上的 GaAsBi 膜相反,这里由于切屑选择了单个 CuPtB 排序子变体。这可以在 HAADF 图像中看到,它的傅立叶变换在右上角显示了一对 1/2[\( \overline{1} \)11]* 超晶格点。图 4b 是通过将掩模应用于一对超晶格反射而形成的,类似于图 1c、d。它在电影中显示出更加均匀和大域的排序。从该样品中获取原子分辨 EDX 图像以估计阶参数 η 根据成分分析。 EDX 化学映射通常优于替代的磁芯损耗 EELS 量化,后者在量化高能和延迟电离边缘时往往具有更差的信噪比 [56, 63,64,65]。改变 STEM 扫描方向以水平对齐有序 (\( \overline{1} \)11) 平面。图 4c-e 显示了 Wiener 过滤的 X 射线元素图。 Bi 原子在每一秒 (\( \overline{1} \)11) 平面上的顺序很清楚,它遵循 As 原子位置。对于 EDX 成分量化,使用相同的实验条件从样品的不同区域获取两个数据集,每个数据集具有 512 × 512 像素。对齐子区域,并将原始信号相加,从而产生总共 10 帧。 As-K 和 Bi-M 的水平求和原始数据垂直线轮廓如图 4f 所示。为了量化富铋和缺铋 (111) 平面中的铋成分,使用了 3 Å 宽的积分窗口,以原子平面为中心。在对所有 (111) 平面进行背景扣除和平均后,它表明在富含 Bi 的平面中 Bi X 射线计数高出 ~ 3 倍。通过 PL 和 XRD-RSM 测量获得的样品中 5.8% 的 Bi 总浓度然后用于将 Bi X 射线计数线性缩放到组成,这表明 Bi 在富含 Bi 的平面中达到 9%。因此可以估计阶次参数(见简介)为 η =0.07。请注意,具有此总 Bi 浓度的完全有序双胺的有序参数 η =0.116。与 HAADF 分析类似,由于核心电子的电离电位是高度局部化的,因此单个色谱柱的 EDX 量化会受到沟道效应的影响。正如其他作者在 Alx 中所展示的 Ga1-x 作为合金,由于不同的掺杂剂配置,这可能导致高达 ~ 5% 的 X 射线计数标准偏差 [50]。考虑到偏差,仍然发现 X 射线计数与不太厚的样品中的许多掺杂剂成线性比例。通过对每个 (111) 平面中的 ~ 11 个原子列进行有效平均,总共 ~ 130 个列,可以最大限度地减少本研究中的配置错误。此外,电子探针尾部和多重散射可以在 EDX 图像中产生信号离域 [52]。上一节中的 HAADF 图像模拟显示了 Ga SCS 值的变化,暗示了 EDX 量化中这些影响的预期幅度。由于这种稀合金中固有的低 Bi X 射线计数,散粒噪声目前似乎是主要的精度限制因素。
<图片>
一 GaAsBi 样品 S2 与 GaAs 缓冲层界面附近的 HAADF 图像,在切屑 (001) Ge 上生长。右上角的傅立叶变换显示了一对峰值,表明在单组 (\( \overline{1} \)11) 平面上的排序。 b 由 (a ) 使用一对超晶格 1/2[\( \overline{1} \)11]* 布拉格点。 c –e 维纳过滤了 GaAsBi 样品的 EDX 图像,如所示的 Bi-M、As-K 和 Ga-K X 射线发射。请注意,在 EDX 数据中,晶体方向被旋转以水平对齐有序 (\( \overline{1} \)11) 平面。 f 原始 As-K 和 Bi-M 信号的水平求和垂直 X 射线计数分布。将两个对齐的数据集组合起来得到轮廓
我们希望在这里探索的最终 GaAsBi 样品 S3 是在创建所谓的垂直成分调制 (VCM)(参见方法)[66] 的条件下合成的。与样品 S1 和 S2 相比,VCM 是在 S3 中通过利用较慢的基板旋转速率 (RPM) 实现的,这与在典型 MBE 室中到达基板的本质上不均匀的元素通量分布相耦合。样品区域内的 III/V 元素比可以通过控制 RPM 和薄膜生长速率来振荡,以获得所需的 VCM 周期。 A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens 等。 [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

一 HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. b A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. c Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
结论
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB-type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordering. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
方法
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 厘米 −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 托。 The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
数据和材料的可用性
当前研究中使用和/或分析的数据集可根据合理要求向相应作者索取。
缩写
- BEP:
-
Beam equivalent pressure ratio
- 鳗鱼:
-
Electron energy-loss spectroscopy
- FFT:
-
快速傅里叶变换
- HAADF:
-
高角度环形暗场
- MBE:
-
分子束外延
- PL:
-
光致发光
- STEM:
-
扫描透射电子显微镜
- SCS:
-
Scattering cross-section
- VCM:
-
Vertical composition modulations
- EDX:
-
X-ray energy dispersive spectroscopy
纳米材料


