与 FIND RRAM 阵列中的应力和温度相关的 RTN 和退火
摘要
在这项工作中,对 FinFET 电介质 RRAM (FIND RRAM) 器件的读取电流中的随机电报噪声 (RTN) 信号进行了观察。发现 FIND RRAM 单元的 RTN 信号在器件受到循环应力后会发生变化。在经历循环应力后,RRAM 单元更倾向于显示更频繁和更强烈的 RTN 信号。 FIND RRAM单元中噪声水平的增加通常可以通过高温退火来缓解,并基于此概念,提出并演示了片上退火方案。
介绍
在过去十年中,CMOS 技术的不断扩展极大地改善了集成电路的特性和性能。然而,随着技术节点缩小到 20 纳米以下,器件特性中由单原子/电子引起的变化会增加,例如随机掺杂波动 (RDF),从而带来无法监控的基本问题 [1]。例如,载流子数量或结构缺陷的任何变化对缩放器件的输出和性能都有更大的影响,并且器件缩放对 RDF 和栅极线边缘粗糙度 (LER) 引起的可变性的影响也已报道 [2,3,4]。随机电报噪声 (RTN) 被认为是小面积设备的另一个主要挑战,例如 NAND 闪存和 RRAM [5,6,7,8,9,10,11]。在这项工作中,我们研究了基于 n 通道 FinFET 的 FIND RRAM 单元中的 RTN 噪声,该单元已在 1kbit 阵列的标准逻辑工艺中成功实现 [12]。观察到响应循环应力和高温烘烤的 RTN 变化。本工作研究了应力和温度对FIND RRAM单元中RTN噪声的影响,并提出了一种片上退火方案来减轻循环后随时间变化的读取电流噪声。
背景和方法
FIND RRAM 由两个 FinFET 晶体管组成。一个用作串联 RRAM 节点的 WL 选择晶体管。另一个晶体管的 SiP 和 SL 之间的高 k 栅极电介质用作存储节点,如图 1a 所示。 FIND 器件由标准 FinFET 中的栅极介电膜组成,其中栅极电极为 W 为顶部电极,TaN 为底部电极。栅极叠层氧化物由 HfO2/SiO2/TiN 叠层组成 [12]。 FIND RRAM 单元的读取条件如图 1b 所示,其中 WL 被赋予 0.8 V 以开启选择晶体管,而 0.8 V 被添加到 SL 以驱动足够的读取电流以读取数据。高电阻状态 (HRS) 和低电阻状态 (LRS) 状态之间的电阻切换是通过在 FIND RRAM 单元上执行设置/复位来实现的 [13]。 FIND RRAM 在 DC 扫描下显示出相当稳定的电阻开关特性,见图 2a,而其设置时间和复位时间特性总结在图 2b 中。图 2a 中列出的操作条件表明低电压操作是可能的。为了达到目标读取电流水平,单元会经历多个脉冲周期以进行设置和重置。如果在施加多个脉冲后器件未能设置或复位,脉冲宽度将增加,如图 3a 所示。在 LRS 和 HRS FIND RRAM 单元中都可以找到独特的 RTN 信号,如图 3b 所示。由电流传导路径中的电荷俘获和释放引起的 RTN 信号会导致显着的电流波动 [14,15,16,17]。
<图片>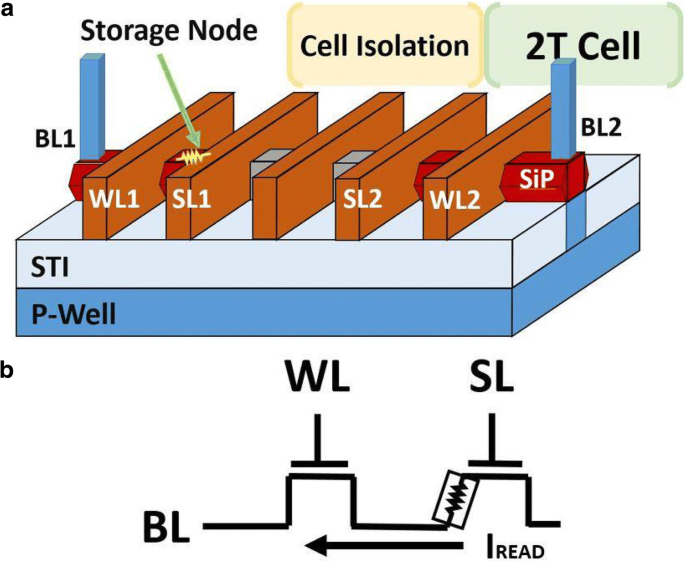
一 由 CMOS FinFET 技术和 b 实现的 2 T FIND RRAM 单元的 3D 图示 显示了读取条件下 FIND RRAM 单元的电路原理图,其中 VSL =VWL =0.8 V 且 BL 偏置为零
<图片>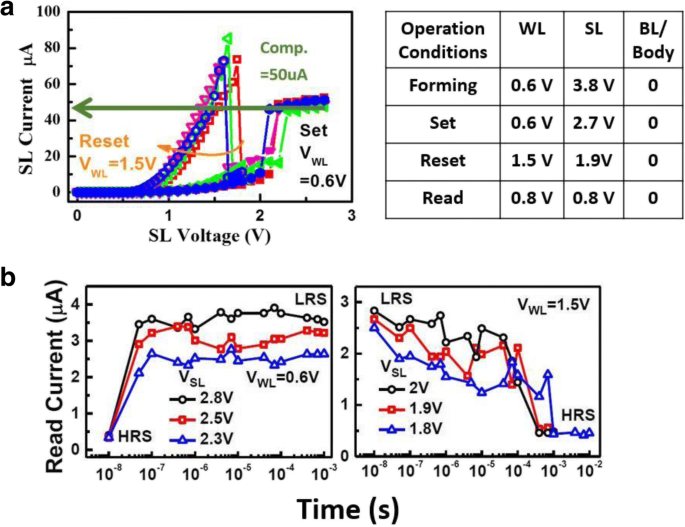
FIND RRAM 的直流电阻开关特性及其工作条件如图 (a )。其置位时间和复位时间特性总结在 (b )
<图片>
一 用于执行设置/复位操作的增加脉冲宽度的图示。在 1 μs 的第一个脉冲之后,执行读取操作以评估读取电流是否达到 LRS 的 3 μA 和 HRS 的小于 1 μA 的目标水平。如果未达到所需状态,则给出下一个脉冲。脉冲宽度每十个脉冲扩展一个数量级。 b 在 VSL =VWL =0.8 V 和 VBL =0 下采样的室温下读取电流的比较,采样率为 500 Hz,循环 100 次前后
众所周知,重复循环,即在两种状态之间切换,会在栅极介电层 FinFET 上引起应力 [18]。 FIND RRAM 单元中的应力过渡金属氧化物 (TMO) 层更倾向于显示 RTN 噪声,导致随时间变化的读取电流,这会在数据读取过程中导致读取错误和稳定性挑战。在本实验中,我们对阵列的读取电流进行了新鲜、10次循环和100次循环后的采样,以观察FIND RRAM中RTN的应力效应。
为了研究温度对受压 FIND RRAM 单元的影响,LRS 中具有不同 RTN 信号的样品首先冷却至 0°C,然后逐渐加热至 50°C。在此过程中,这些温度下的读取电流以 500 Hz 的速率连续采样 20 秒。这为我们了解 RTN 在温度变化下的行为提供了一些线索。
结果与讨论
通过广泛的测量,发现 RTN 在其 LRS 的 FIND RRAM 单元中更稳定且易于观察。因此,在研究循环和退火对 FIND RRAM 单元的 RTN 的影响时,以下部分将重点研究 LRS 上的单元。如图 4a 所示,RTN 噪声会导致随时间变化的读取电流,从而导致读取错误。这种效应可以在 1kbit 单元阵列中观察到。在经历了 10 个周期的阵列中,在 20 秒的时间间隔内对读取电流进行采样时发现了显着的读取电流波动。阵列中的归一化位电流图排列在图 4b 中,其中 LRS 中的电流波动可高达 + 5%,这与在应力后栅极漏电流中观察到的 RTN 相当[19]。为了研究压力的影响,我们跟踪了循环压力前后 50 个细胞的电流波动水平。图 5a 中的数据显示,超过 90% 的细胞在循环后表现出 ΔI/I 增加。也就是说,随着电池经历更多循环应力,FIND RRAM 中的时变噪声逐渐恶化。当我们比较新鲜细胞和循环细胞的归一化读取电流分布时,发现经过更多循环的细胞表现出更显着的 RTN 信号,并在特定状态下显示出两个或多个峰值电流分布。另一方面,新鲜细胞具有标准分布的电流分布,暗示没有涉及波动的 RTN 噪声,如图 5b [20, 21] 所示。这表明,一旦 FIND RRAM 经历了长时间的循环应力,其位单元电流会因 RTN 的加入而受到更剧烈的波动。
<图片>
一 在经历了 10 个周期的 RRAM 单元中以 500Hz 的速率采样的 25°C 下的归一化读取电流。这表明 RTN 会导致时变读取电流。 b 显示经过 10 个周期的 1kbit 阵列中的归一化电流图,在 t1 =3、t2 =7.5、t3 =14 和 t4 =17.5 s 处同时采样。通过对比不同时间的快照,读取电流在相同读取条件下的波动
<图片>
一 比较|ΔI/I|的分布应力前后 50 个样品。可以看出,细胞在应激后表现出整体较大的ΔI/I。箱线图从下到上的百分位值分别代表 25、50 和 75 个百分位点,而胡须表示最大值和最小值。 b 在新鲜和 10 次和 100 次循环后测量的细胞归一化读取电流分布的直方图。这说明FIND RRAM一旦受到长时间的循环应力,其bit cell电流会因为RTN的加入而受到更剧烈的波动
图 6 比较了不同温度阶段读取电流样本的归一化结果。已经研究了 RTN 陷阱的捕获时间和发射时间,已知它们随温度变化,两者都随着温度升高而降低 [22, 23 ]。正如预期的那样,RTN 噪声的频率随着温度的升高而升高,即 0°C 时读取电流的波动发生的频率低于 25°C 时的波动。然而,在 50°C 下测量时,两种状态之间的电流波动变得不那么明显。这可以在图 7a 中进一步揭示,该图绘制了在 0°C、50°C 和室温下测量的归一化读取电流的直方图。 0°C 和 25°C 的电流分布确实有两个分布峰,表明单俘获态 RTN 在导电路径中占主导地位 [19],而 50°C 时采样电流的离散状态变得不那么突出。这表明在较高温度下,引起RTN信号的陷阱可能会受到退火效应或缺陷复合等不稳定性影响,从而影响电子俘获概率,从而缓解RTN效应[27]。
<图片>
一个 RRAM 单元(处于 LRS 状态)的归一化读取电流的比较,该电流经过 100 个周期,RTN 噪声在 0、25 和 50 °C 下测量,采样率为 500 Hz
<图片>
一 在 0、25 和 50°C 下测量的处于 LRS 状态的细胞的归一化读取电流分布直方图的比较。 b |ΔI/I|的累积概率比较应力前、应力后和退火后分别为 30 个样品。发现大部分细胞经过退火处理后恢复到原来的ΔI/I
在进一步研究中,样品被加热到 75°C。 30 分钟后,这些电池冷却至室温,然后取样。选择了 30 个电池,它们在新鲜、压力和退火后的累积电流波动水平在图 7b 中进行了比较。这表明大多数细胞在退火过程后恢复到原来的 ΔI/I。图 8 比较了新鲜状态、压力状态和烘烤后单元的归一化读取电流。烘烤后的电流类似于新鲜状态,表明高温烘烤对引起 RTN 信号的陷阱进行了退火。图 9a 分别是 1kbit 新鲜细胞阵列、轻度应激细胞、高应激细胞和烘烤后的归一化读取电流的排列图。从图中可以看出,当 RRAM 受到高应力时,电流波动会变得更加剧烈,而在高温烘烤后则急剧减少。这种效应可以在整个阵列中观察到,这证实了高温烘烤实际上确实为引起 RTN 噪声的陷阱提供了退火效应 [24,25,26,27,28,29]。图 9b 进一步比较了连续十次不同采样获得的单元阵列中的 ΔI/I 分布。发现相同的阵列在其新鲜、应力和退火后状态表现出不同的 ΔI/I 分布。数据表明,退火确实有助于单元阵列显示出减少的电流波动,类似于阵列处于新鲜状态时的水平。该结果可用于校正和延长循环应力后显示RTN信号的FIND RRAM单元的寿命。
<图片>
读取在 25 °C、500 Hz 下采样的新鲜和受压细胞的电流与高温烘烤并在 30 分钟内冷却至室温后的细胞的电流相比。说明烘烤后,应力得到缓解,细胞表现与新鲜细胞相似
<图片>
一 在新鲜、轻度应力、高应力和退火后绘制的特定时间获取的 1kbit 阵列的归一化读取电流。可以看出,随着阵列承受更大的应力,阵列中具有强烈波动的单元数量大大增加,并在退火后消失。 b 比较|ΔI/I|的累积概率来自同一阵列的 50 个样品在新鲜、应力和退火后状态的分布,在不同的时间实例中,间隔为 1 秒。应力后样品整体ΔI/I较高,退火后恢复正常
值得一提的是,一些在循环过程中卡在中间状态的电池在经过高温处理后会复活。当 FinFET RRAM 单元通过 LRS 和 HRS 循环时,某些单元中的导电灯丝可能会形成无法轻易重置的通道。烘烤过程为这些细胞提供了重新分配其氧空位的路径,从而允许有效重置 HRS [30]。图 10 显示无法切换到 HRS 的电池在 125°C、15 分钟烘烤后恢复。考虑到这一点,提出了一种涉及局部加热 FIND RRAM 单元的片上退火机制。如图 11a 所示,通过选定 FinFET 漏极结处的正向偏压向电池施加 1.5 mA 的恒定电流,周期为 10 秒。这个大电流加热了 RRAM TMO 附近的受限区域,并提供了类似的退火效果。图 11b 中测量和分析了被测器件 (DUT) 退火前后的读取电流。连续采样的读取电流的累积分布表明在片上退火步骤后去除了单元上的 RTN。在这里,FIND RRAM 的片上退火是按顺序对单个单元进行的,以了解受压后对典型 RRAM 单元的标称响应。阵列级实验需要开发新的片上退火工艺。
<图片>
通过对卡在中间状态的细胞进行 125°C 烘烤并提供退火过程,我们将这些细胞恢复到功能状态,从而延长细胞寿命
<图片>
我们提出的片上退火方案包括在 BL 处施加 − 1 V,从而产生正向偏压和 1.5 mA 的测量电流,这会加热和退火受压电池。图中,通过对比处理前后电池归一化电流的累计百分比,可以看出RTN引起的电流波动大大降低
结论
本文讨论了应力和温度对 FIND RRAM 单元阵列中 RTN 的影响。观察到骑车应激引起的 RTN 增加。观察了高温处理对 FIND RRAM 中 TMO 降低 RTN 和释放应力的影响。最后,提出并演示了一种片上退火方案。
缩写
- 查找 RRAM:
-
鳍式场效应晶体管介质电阻随机存取存储器
- HRS:
-
高阻态
- LER:
-
线边粗糙度
- LRS:
-
低阻态
- RTN:
-
随机电报噪声
- TMO:
-
过渡金属氧化物
纳米材料


