Ga2O3 MOSFET 中通道最高温度的分析模型
摘要
在这项工作中,我们提出了一个准确的分析模型,用于估计具有原生或高导热性衬底的 Ga2O3 MOSFET 的通道最高温度。 Ga2O3 的热导率是各向异性的,并且随着温度的升高而显着降低,这两者对于 Ga2O3 MOSFET 的热行为都很重要,因此在模型中予以考虑。通过 COMSOL Multiphysics 进行数值模拟,通过改变器件几何参数和环境温度来研究通道最高温度对功率密度的依赖性,结果与分析模型吻合良好,证明了该模型的有效性。新模型对Ga2O3 MOSFET的有效热管理具有指导意义。
背景
基于氧化镓 (Ga2O3) 的金属-氧化物-半导体场效应晶体管 (MOSFET) 是下一代电力电子设备的绝佳候选,它们受益于 Ga2O3 的两大优势:显着的高带隙 (~ 4.8 eV) 和高以低成本生产的高质量块状晶体 [1]。人们付出了巨大的努力来改善其各个方面的电气性能,如电流密度 [2]、击穿电压 [3] 和功率品质因数 [4]。随着实验证实其在电力电子器件方面具有前所未有的潜力 [5,6,7,8,9],现在探索 Ga2O3 MOSFET 的性能和可靠性至关重要,例如自热效应和因此通道最高温度 (T max),由于其相对较低的热导率 (κ , 0.11–0.27 Wcm −1 K −1 室温)[1]。
近年来,各种估计T的方法 理论上和实验上都提出了 Ga2O3 MOSFET 的最大值 [10,11,12,13]。一般来说,数值模拟可以定量估计T 某个设备的最大值。然而,这是耗时的[14]。另一方面,T的提取 实验中的最大值总是被低估 [15]。因此,必须建立一个分析模型以充分模拟 T Ga2O3 MOSFET 中的最大值,可以在时间效率和定性评估中提供足够的准确度 [14]。
在本文中,我们提出了一个T的分析模型 考虑到 κ 的依赖性,采用基尔霍夫变换的 Ga2O3 MOSFET 的最大值 Ga2O3 的温度和晶向。所提出的模型可应用于具有原生或高导热性衬底的 Ga2O3 MOSFET。通过与COMSOL Multiphysics的数值模拟对比,系统地验证了解析模型的有效性和准确性。
方法和模型开发
T 的分析模型 Ga2O3 MOSFET 中的最大值是基于图 1 所示的结构提出的。结构的关键参数列于表 1 中。实际上,已经证明焦耳热集中在 Ga2O3 MOSFET 的栅极的漏极边缘 [13 ]。为了简化模型,假设来自栅极的加热效应是均匀的 [12] 并且由于其厚度可以忽略不计,可以完全穿透栅极氧化物。该模型考虑了 Ga2O3 通道下方的不同衬底材料,例如块状 Ga2O3 和高 κ 材料,针对板的可行性和兼容性。因此,该设备被视为一个两层问题。基板与理想的散热器接触,使底面等温,其温度等于环境温度(T amb,默认为 300 K)。对结构的其他表面施加绝热边界条件。这些边界条件可以概括为[14, 16]
<图片>
Ga2O3 MOSFET原理图
$${\kappa }_{y}{\left.\frac{\partial T}{\partial y}\right|}_{y={t}_{ch}+{t}_{sub}} =\left\{\begin{array}{c}\frac{P}{{L}_{g}} \left|x\right|\le \frac{{L}_{g}}{2} \\ 0 \left|x\right|>\frac{{L}_{g}}{2}\end{array}\right.,$$ (1) $${\left.T\right|} _{y=0}={T}_{amb},$$ (2) $${\left.\frac{\partial T}{\partial x}\right|}_{x=-\frac{ L}{2}}={\left.\frac{\partial T}{\partial x}\right|}_{x=\frac{L}{2}}=0,$$ (3)其中 P , T 和 κ y 分别表示 Ga2O3 的 [010] 方向的功率耗散密度、温度和热导率。需要强调的是P的单位 在本文中为 W/mm。
κ Ga2O3 的值是材料热特性的关键参数之一,它对热效应的扩散和模型的准确性起着重要的作用。也就是说,对κ的仔细描述 由于其严重的各向异性和温度依赖性 [17],因此需要值。一般来说,κ的依赖 Ga2O3 对温度 (T ) 沿两个不同的晶体取向 ([001] 和 [010]) 由
$${\kappa }_{\left[001\right]}\left(T\right)=0.137\times {\left(\frac{T}{300}\right)}^{-1.12},$ $ (4) $${\kappa }_{\left[010\right]}\left(T\right)=0.234\times {\left(\frac{T}{300}\right)}^{- 1.27}.$$ (5)T的比较研究 不同 P 处的最大值 由 COMSOL Multiphysics 进行,考虑到常数和现实 κ , 分别。我们发现在 P 1 瓦/毫米,T 分别获得了 533 K 和 622 K 的最大值(未显示)。因此,非常有必要考虑T的影响 和 κ 上的结晶方向 Ga2O3 在模型中的含量。
温度行为由热传导方程控制。 Ga2O3域稳态热传导方程为
$$\frac{\partial }{\partial x}\left({\kappa }_{x}\left(T\right)\frac{\partial T}{\partial x}\right)+\frac{ \partial }{\partial y}\left({\kappa }_{y}\left(T\right)\frac{\partial T}{\partial y}\right)=0,$$ (6)其中 κ x 表示 Ga2O3 [001] 方向的热导率。非线性热传导方程可以通过采用基尔霍夫变换求解。然而,由于 κ 的高度各向异性,基尔霍夫变换的应用可能会受到限制 在 Ga2O3 中,严格来说,这仅适用于具有各向同性 κ 的材料 [14]。鉴于上述限制,不应考虑 κ x 和 κ 是 为两个自变量。图 2 显示了热阻之间的关系,即 1/κ , 和 T 对于大 T 上的 [001] 和 [010] 方向 范围,分别。可以看出,1/κ 是 可以用 1/(cκ x ) 和 c 被选择为等于 1.64。因此,方程。 (6) 可以转化为以下等式:
<图片>
热阻与T的关系 对于 [001] 和 [010] 的方向。绿色符号和红线分别表示实际值和拟合值。蓝线代表 1/κ 的假设 y ≈ 1/(cκ x),其中 c =1.64
$$\frac{\partial }{\partial \mathrm{x}}\left({\kappa }_{x}\left(T\right)\frac{\partial T}{\partial x}\right) +\frac{\partial }{\partial \mathrm{y}}\left({c\kappa }_{x}\left(T\right)\frac{\partial T}{\partial y}\right) =0.$$ (7)基于上述 κ 的近似值 x 和 κ 是 ,基尔霍夫变换可以不受任何限制地使用。此外,还可以看出 κ 的倒数 预计与 T. 成正比 因此,为了降低计算复杂度,1/κ的表达式 x 可以简化为 1/κ x =aT + b , 如图 2. 使用 a 的原因 , b 和 c 只是为了方便编写下面的等式。
应用基尔霍夫变换和分离变量的方法,得到T的表达式 最大值可以推导出为
$$\begin{aligned} T_{{max}} =&\\ &\,\left( {T_{{amb}} + \frac{b}{a}} \right)exp\left( {\frac {{aP\left( {t_{{ch}} + t_{{sub}} } \right)}}{{cL}} + \frac{{aPSL}}{{\sqrt c \pi ^{2} L_{g} }}} \right) - \frac{b}{a}, \\ \end{aligned}$$ (8)哪里
$$S=\sum_{n=1}^{\infty }\frac{\mathrm{sin}n\pi \frac{{L}_{g}}{L}}{{n}^{2} }\frac{\mathrm{sinh}2n\pi \frac{{t}_{ch}+{t}_{sub}}{\sqrt{c}L}}{\mathrm{cosh}2n\pi \压裂{{t}_{ch}+{t}_{sub}}{\sqrt{c}L}}.$$ (9)需要指出的是S 是一个收敛无穷级数,计算中用其容易求得的近似值代替实际值。
对于具有高 κ 的 Ga2O3 MOSFET 基体,基尔霍夫变换不能在理论上直接应用。事实上,为了使转换有效,边界条件应该是等温的(常数 T 表面),或具有固定的热通量密度。然而,由于不同的κ Ga2O3 和衬底材料,这两个边界条件在 Ga2O3/衬底界面上都不能完全满足。考虑到 κ Ga2O3 远低于高 κ 衬底,假设,Ga2O3 和衬底之间的等温界面,被引入。这个假设有助于推导出表达式 T max 及其有效性将在稍后验证。在这种情况下,热阻 (R TH) 高 κ 底物,T 之间差异的比率 int 和 T amb 和 PW ,即 R TH =(T int—T amb) / (密码 ),可以计算为 R TH =LW /(κt sub),其中 W 是基材的宽度[19]。因此,Ga2O3/衬底界面温度的表达式(T int) 是
$${T}_{int}=\frac{P{t}_{sub}}{{\kappa }_{sub}L}+{T}_{amb},$$ (10)其中 κ sub 是异质衬底的热导率,假设为常数。此外,需要指出的是,模型中不包括 Ga2O3 与异质衬底之间的热边界电阻。因此,在方程的帮助下。 (8)、T的表达式 具有异质衬底的 Ga2O3 MOSFET 的最大值可以推导出为
$$\begin{aligned} T_{{max}} =&\\ &\;\left( {T_{{int}} + \frac{b}{a}} \right)exp\left( {\frac {{aPt_{{ch}} }}{{cL}} + \frac{{aPSL}}{{\sqrt c \pi ^{2} L_{g} }}} \right) - \frac{b} {a}, \\ \end{对齐}$$ (11)哪里
$$S=\sum_{n=1}^{\infty }\frac{\mathrm{sin}n\pi \frac{{L}_{g}}{L}}{{n}^{2} }\frac{\mathrm{sinh}2n\pi \frac{{t}_{ch}}{\sqrt{c}L}}{\mathrm{cosh}2n\pi \frac{{t}_{ch }}{\sqrt{c}L}}.$$ (12)结果与讨论
T 分析模型的有效性 在本节中系统地验证了 Ga2O3 MOSFET 中的最大值,同时考虑了原生衬底和具有更高热导率的对应物。测试模型有效性的最佳方法是对照实验数据。然而,一些关键的几何参数在实验文献中找不到,如t sub 和 L 在参考。 [12]。因此,有限元模拟是最准确的方法之一,用于验证我们的模型。图 3 显示了 T 的依赖性 最大功率密度 P 从 COMSOL Multiphysics 和分析模型中获得,用于具有原生衬底的 Ga2O3 MOSFET。考虑了各种关键参数,包括设备长度L , 基板厚度 t sub 和环境温度 T 安培。如图 3a 所示,T max自然随着功率密度的增加而增加,并且随着L的变小,增加率增加 .这归因于具有较大 L 的设备 允许从有源区散热,因此其整体温度低于具有较小 L 的温度 在同一 P [11]。也就是说,它的 R TH,曲线的斜率,小于后者。 此外,由于 κ Ga2O3 的含量会随着整体温度的升高而降低,其 R TH 也将比 L 更小的增加得更慢 因此,这在图 3a [19] 中很明显。同样,对T的依赖调查 t 上的最大值 sub 被执行,如图 3b 所示。观察到T的趋势 相对于 P 的最大值 与图 3a 中的相同。较薄的基板总是会导致 T 的上升得到缓解 max超过放大的功率密度,可以理解,基板越薄,整体温度越低,R越小 TH 及其增长率,就像图 3a 中的分析一样。图 3c 比较了 T 的影响 T 上的 amb 最大值为 P 增加。很明显,两条曲线之间的差异增加缓慢,这与图 3a、b 中的不同。通常,R TH 由器件的几何参数和 κ 决定 材料的价值。然而,考虑到在这种情况下结构是固定的,R的增加 TH 仅由 κ 的减少引起 Ga2O3。另一方面,所提出的模型具有高度的一致性,它考虑了 T - 和 κ 的方向依赖关系 Ga2O3,证实了模型的可扩展性。平均而言,所提出的模型与模拟的差异为 <1 K。观察到的总体良好一致性表明所提出的模型是高效和准确的。
<图片>
T 的依赖 a 上的最大值 设备L的长度 , b 衬底层厚度t 子和c 环境温度T 不同功率的安培P .符号和线分别表示模型和仿真的结果
同样,如图 4 所示,对高 κ 上的 Ga2O3 MOSFET 重复类似的比较 衬底,碳化硅。在这里,L 的步骤 和 T 我们选择的 amb 比图 3 中的大,并且不同的通道厚度 t ch 被考虑而不是 t 在这种情况下。否则,T的两条曲线之差 相对于 P 的最大值 由于 SiC 衬底的高效散热能力,在每个图中都无法区分。 κ 碳化硅 (3.7 Wcm −1 K −1 ) 应用是 COMSOL Multiphysics 软件中的默认参数。感谢高 κ 碳化硅,从各图中可以清楚地看出,T max 近似线性为 P 增加,这意味着温度对 R 的影响 设备的 TH 可以忽略不计。需要指出的是,我们的模型可以成功地描述这种线性关系。然而,很明显 T 当前模型计算的max低于仿真预测的值,并且这种差异随着功耗的增加而更加明显。为了展示这种机制,模拟了 T 随着功率的增加提取 int 并与计算的 T 进行比较 由方程 int (10) 如图 5 所示。发现焦耳热在器件中间变得更加集中,因为 P 增加。有 0.5 K 和 4 K ΔT 当 P 时,该位置的模型和仿真之间 =0.25 和 1 W/mm,分别。这就是我们的模型无法准确预测 T 的原因 最大限度。因此,一个更合理的T假设 将来需要 int 以获得更高的精度。尽管如此,T 即使在 1 W/mm 功率耗散密度下,模型预测的 max 也仅比模拟低 <4 K。也就是说,虽然统一T的假设 int 与事实不一致,我们的模型可以提供 T 的估计 具有足够精度的最大值。
<图片>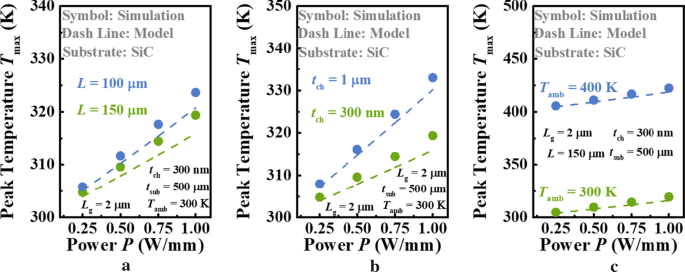
T 的依赖 a 上具有 SiC 衬底的 Ga2O3 MOSFET 的最大值 设备L的长度 , b Ga2O3层的厚度t ch 和 c 环境温度T 不同功率的安培P .符号和线分别表示模型和仿真的结果
<图片>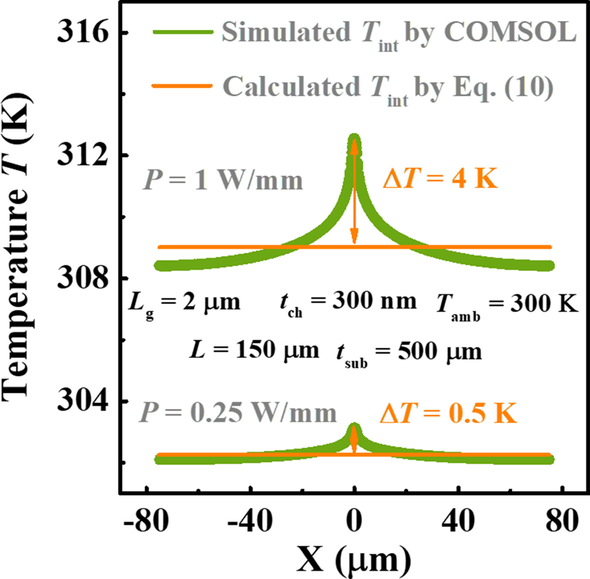
T 的比较 由方程模拟和计算之间的整数。 (10) 在不同的 P
结论
用于估计 T 的准确分析模型 介绍了与温度和方向相关的热导率的 Ga2O3 MOSFET 的最大值。已导出基于器件几何形状和材料参数的简单表达式。通过改变不同的功耗,模型与 COMSOL Multiphysics 数值模拟之间获得了极好的一致性。 T 的建议模型 max 对于有效的热管理功率器件尤其是 Ga2O3 MOSFET 具有重要意义。
数据和材料的可用性
本文包含支持本文结论的数据集。
缩写
- Ga2O3 :
-
氧化镓
- MOSFET:
-
金属氧化物半导体场效应晶体管
- AlGaN:
-
氮化铝镓
- 氮化镓:
-
氮化镓
- 碳化硅:
-
碳化硅
纳米材料


