观察 GaAs/AlGaAs 二维电子气中的外在光致逆自旋霍尔效应
摘要
在 GaAs/AlGaAs 二维电子气中观察到由圆偏振光引起的逆自旋霍尔效应。自旋横向力是通过将光致逆自旋霍尔效应 (PISHE) 电流拟合到理论模型来确定的。还在不同光功率和不同光斑分布下测量了 PISHE 电流,所有测量结果与理论计算吻合良好。我们还测量了不同温度(即 77 到 300 K)下的 PISHE 电流。 PISHE电流的温度依赖性表明外在机制起主导作用,PISHE电流对样品晶体取向的弱依赖性进一步证实了这一点。
背景
自旋电子学因其在信息技术中的潜在应用以及揭示凝聚态中电子自旋物理的基本问题而备受关注[1-4]。自旋霍尔效应 (SHE) 及其 Onsager 倒数逆自旋霍尔效应 (ISHE) 在自旋电子学中发挥着重要作用,因为它们提供了一种通过自旋轨道耦合将电荷电流转换为自旋电流,反之亦然的电方法。 SOC) [2, 5–8]。 SHE 和ISHE 已在具有重元素的金属薄膜(如 Pt、Ta、Py 和 IrMn)以及新兴的拓扑绝缘体(如 Bi2Se3 和 SnTe)中得到广泛研究,因为它们具有很强的 SOC [9-14]。这两种效应也存在于半导体中,如 GaAs、ZnO、Si、Ge、GaN/AlGaN 和 GaAs/AlGaAs 二维电子气[15-20]。
半导体中的自旋电荷电流转换是一个重要问题,因为它开辟了一条将自旋电子学与电子学相结合的途径 [5]。光致ISHE(PISHE)最近成为研究半导体中ISHE的有效实验工具,它利用具有高斯分布的圆偏振光将自旋电流引入半导体,然后利用ISHE产生充电电流。 2, 19–22]。可以在室温下观察到 PISHE 电流,它提供了一种方便的方法来研究半导体的 ISHE,而无需引入磁场和铁磁元素 [20]。此外,PISHE 还为设计新型自旋光子器件铺平了道路 [22]。 PISHE 电流已在 GaN/AlGaN、GaAs/AlGaAs 和 MgZnO/ZnO 异质结构中观察到 [2, 19, 20]。然而,PISHE电流对光功率和光分布的依赖性尚不清楚。
ISHE有两种机制,即内在和外在。内在机制仅取决于完美有序材料的能带结构 [7, 23, 24],源自 Rashba [25-27] 或 Dresselhaus SOC [26],而外在机制是指不对称莫特偏斜或侧边-自旋轨道耦合系统中杂质的跳跃散射 [16, 24, 28, 29]。尽管对ISHE的内在或外在机制进行了大量研究,但大多是理论著作,很少有经验性著作围绕这一问题[16,27,30-32],因为很难区分这两者实验机制。
在本文中,我们研究了 GaAs/AlGaAs 二维电子气 (2DEG) 中的 PISHE 电流。发现 PISHE 电流随温度升高而增加,说明 PISHE 电流主要受外在机制支配。 PISHE 电流对样品晶体取向的弱依赖性进一步证实了这一推论。此外,我们还研究了PISHE电流对光功率和光剖面的依赖性,这与理论模型非常吻合。
方法
该实验是在半绝缘 GaAs 衬底上通过分子束外延 (MBE) 生长的 (001) 取向调制掺杂 GaAs/AlGaAs 2DEG 样品进行的。样品的电子密度和霍尔迁移率测量为5.18 × 10 11 厘米 −2 和 3.97 × 10 3 厘米 2 V −1 s −1 分别在室温下。由于背景掺杂,2DEG的迁移率有点低,约为10 15 或 10 16 厘米 −3 , 在样品生长过程中引入的样品中。样品沿 [110] 和 \([1\bar {1}0]\) 方向切割成 10 × 10 mm 的正方形 2 .两对欧姆接触分别沿[110]和[100]方向相距8 mm,采用铟沉积方法制成,并在氮气气氛中420℃左右退火。
使用波长为 1064 nm 的二极管泵浦固态激光器作为辐射源。激光束通过斩波器、偏振器和四分之一波片,最后垂直照射样品。在这里,偏光片和旋转四分之一波片用于改变光螺旋度P c =sin2φ 从左手 (σ - , P c =− 1) 到右手 (σ + , P c =+ 1) 连续,其中 φ 是入射光的偏振方向与四分之一波片光轴之间的夹角。样品上的光点具有高斯分布。电流通过前置放大器和锁定放大器沿样品的 [100](或 [110])方向在两个触点之间收集,参考频率为 229 Hz,来自斩波器。图 1a 说明了用于测量 PISHE 电流的设置。
<图片>
获得 PISHE 电流的方法和在 300 K 下测量的 PISHE。a 自旋极化电子在左旋圆极化(σ)正常照明下的运动示意图 + ) 或右旋圆极化 (σ - ) 光。红色箭头表示电子的流动,蓝色箭头表示电子的自旋方向,黑色箭头表示作用在电子上的自旋横向力。 b 用于测量 PISHE 电流的几何结构。 c 在 300 K 时测得的光电流与相位角 φ 的函数关系 当光点在 A 点表示时,在法向入射情况下。实线(黑色)是使用方程的拟合曲线。 (1)、虚线(红色)代表PISHE电流,蓝绿虚线代表L 1 和 L 2 组件。点划线表示背景电流J 1. d 在 300 K 处测量的作为光斑位置函数的 PISHE 电流
对于功率相关测量,通过使用衰减器,照射在样品上的光功率从 250 到 40 mW。为了改变样品上光斑的轮廓,采用不同焦距的光学透镜。在温度相关测量中,样品安装在光学低温恒温器上,允许温度在 77 到 300 K 之间变化。
为了获得 Rashba 与 Dresselhaus SOC 的相对比率,我们测量了不同晶向的圆形光电流效应 (CPGE) 引起的光电流,即分别沿 [110] 和 [100] 方向通过触点收集 CPGE 电流,光的入射平面垂直于两个触点的连接。对于CPGE测量,采用与PISHE测量相似的实验装置,只是光沿[110]或[100]方向倾斜照射在两个触点连接的中点,入射角范围从 - 40 到 40°。通过拟合光偏振态相关光电流J,提取某一入射角的CPGE电流 沿两个接触收集到以下等式 [33]:J =J CPGE sin2φ +L 11 sin4φ +L 22 cos4φ +J 11. 这里,J CPGE 是 CPGE 电流,L 11 和 L 22为线偏振光感应的光电流,J 11是源于光伏效应或登伯效应的背景电流[33]。
结果与讨论
在具有高斯分布的圆偏振光照射下,在吸收不饱和区会产生空间上呈高斯分布的自旋偏振载流子。结果,出现了沿径向流动的扩散自旋流。然后,由于ISHE效应,自旋极化载流子受到沿切线方向的“自旋横向力”,导致轴向横向充电电流,即涡流(称为PISHE电流)[8, 20],如图1a所示。随着光的偏振态从左旋圆偏振 (σ + ) 到右手圆极化 (σ - ),电子的自旋极化从自旋向上变为自旋向下,导致自旋横向力和 PISHE 电流的反转。当四分之一波片从 0°旋转到 180°,即角度 φ 从0到180°,光的偏振态从垂直线偏振(0°)变为左旋圆偏振(45°),垂直线偏振(90°),右旋圆极化(在 135°),然后再次垂直线性极化(在 180°),如图 1c 的顶部所示。因此,当角度φ 由 45° 变为 135°,PISHE 反转,说明 PISHE 与 sin2φ 成正比 .值得注意的是,在φ 角度为 0、90 和 180°,光是线偏振的。由于光动量排列效应,线偏振光也会产生光电流[34],命名为L 1,或由于各向异性光吸收 [35, 36],命名为 L 2. 电流 L 1 和 L 线偏振光引起的2与sin4φ成正比 和 cos4φ , 分别。此外,背景光电流J 1 源于光伏效应或登伯效应也会出现,这与光的偏振态无关。因此,根据它们对角度的不同依赖φ ,我们可以通过拟合实验测量的光偏振态相关光电流 J 来提取 PISHE 电流 到下面的公式[8, 33]:
$$ J=J_{\text{PISHE}}\sin 2\varphi+L_{1}\sin 4\varphi+L_{2} \cos 4\varphi+J_{1}, $$ (1)其中 J PISHE 是左旋圆偏振光激发的 PISHE 电流,L 1 和 L 2 为线偏振光引起的光电流,J 1 是背景电流 [19]。需要注意的是,L 2 项已包含在拟合方程中,即 Eq. (1),由于样品中存在较大的光学各向异性。光学各向异性可能由各向异性界面结构[37]、原子偏析[38]或残余应力[39]引起。
为了获得 PISHE 的空间分布,我们沿着它们的垂直平分线从两个触点的左侧到右侧扫描激光点 [见图 1a]。在每个光斑位置,我们将四分之一波片从 0°旋转到 360°,并通过拟合方程获得 PISHE 电流。 (1) 对实验测量的光偏振态相关光电流 J .图 1b 显示了作为相位角 φ 的函数测量的光电流的典型结果 , 当激光光斑固定在 x =- 0.5 mm,即在点 A [见图 1a]。光电流在 300 K 下测量并沿 [110] 方向沿两个触点收集。样品上的激光光斑直径约 1.4 mm,呈高斯分布,功率为 250 mW。图 1b 中的圆圈为实验数据,实线为根据方程 1 的拟合结果。 (1).可以看出,实验测量的光电流随着四分之一波片的旋转而周期性波动。这是因为光电流是 PISHE 电流、线偏振光引起的光电流和背景电流的总和,它们对角度 φ 的依赖性不同 .虚线表示 PISHE 电流,点划线表示背景电流。蓝色和绿色虚线代表 L 1 和 L 2 分量分别由线偏振光引起。可以看出,PISHE电流远小于线偏振光引起的光电流。
获得的 PISHE 电流作为点的函数如图 1c 所示。可以看出,随着激光光斑从两个触点的左侧移动到右侧,PISHE电流的方向发生了反转。当激光光斑聚焦在两个触点的中点时,PISHE 电流几乎为零。这种现象可以通过光致逆自旋霍尔效应引起的涡流模型定量解释 [20]。具体来说,在具有高斯分布的激光照射下 G (r )=\(\frac {1}{\sqrt {2\pi }\sigma }\exp \left (-\frac {r^{2}}{2\sigma ^{2}}\right)\),会感应出沿径向流动的自旋电流,可表示为j r =τ s D ∇r G (r )。在这里,D 是自旋扩散系数,τ s 是自旋弛豫时间,r 表示径向,σ 表示与光强度的半峰全宽 (FWHM) 相关的分布方差。由于ISHE效应,自旋极化载流子将受到自旋横向力\(f(r)\propto j_{r}\times \hat {z}\) [20, 40],可以表示为\( f(r)=-f_{0}r/\sigma ^{3}\exp \left (-\frac {r^{2}}{2\sigma ^{2}}\right)\)。在这里,f 0 是与材料系统的 SOC 相关的自旋横向力常数。涡旋电场 \(\vec {E}\) 可由圆周电动势 (EMF) 确定,可写为 \(\varepsilon (r_{0})=\frac {2\pi }{q }\int _{0}^{r_{0}} f(r)rdr\),通过 \(\oint \vec {E}(r_{0})\cdot d\vec {l}=\varepsilon ( r_{0})\)。在这里,r 0为光斑半径,积分环沿光斑周长。因此,我们有
$$ \nabla\times \vec{E}(r_{0})=-\frac{f_{0}r}{q\sigma^{3}}\exp \left(-\frac{r^{2 }}{2\sigma^{2}}\right)。 $$ (2)值得注意的是,方程之间的微小差异。 (2) 和[20]中报道的是因为本文采用了归一化高斯函数,而[20]中使用了非归一化高斯函数。 f 本文中的 0 等价于 f 0/σ 在 [20] 中报道。两个触点之间的电流(命名为 a 和 b , 分别) 可以表示为
$$ {}I_{ab}\,=\,\frac{V_{ab}}{R_{ab}}\,=\,\frac{1}{R_{ab}}\!\int_{a} ^{b}\! \vec{E}\cdot d\vec{l}\,=\,\frac{1}{R_{ab}}\!\oint_{abo}\!\vec{E}\cdot d\vec{l }\,=\,\frac{1}{R_{ab}}\iint_{S}\nabla\times\vec{E} ds, $$ (3)其中 V ab (R ab ) 是触点 a 之间的电压(电阻) 和 b , o 是光斑的原点,S 表示abo的三角形面积 .需要说明的是,吸收饱和区,其中被样品吸收的光强是一个常数,达到样品的最大吸收,应从方程(1)的积分中减去。 (3).这是因为该区域的光生载流子梯度为零,因此该区域的自旋电流和PISHE电流均为零。
值得注意的是,方程。 (3) 仅当触点 a 时成立 和 b 被光点覆盖,因为在光点方程之外。 (2) 不再有效。因此,考虑到外部电流 (J f ) 和内部 (J e ) 点,即 J f =\(J_{e}\exp \left (-\frac {l}{A\cdot L_{s}}\right)\) [41],我们可以表达方程。 (3) 如:
$$ I_{ab}=\frac{1}{R_{ab}}\iint_{D}\nabla\times\vec{E}\cdot\exp \left(-\frac{l}{A\cdot L_ {s}}\right)ds。 $$ (4)在这里,l 是光斑边缘到两个触点连接处的距离,L s 是电子的扩散长度,A 是一个常数。使用方程(2) 和 (4) 拟合实验测量的 PISHE 电流,我们可以得到自旋横向力 f 0 和扩散长度 A ·L s .拟合结果如图 1c 中实线所示。可以看出,实验数据与模型拟合良好。在拟合中,采用以下实验测量参数,σ =0.2 毫米,L =4 毫米,r 0 =0.7 毫米,并且 R ab =15.5 k Ω .自旋横向力f 0/q 电子数拟合为 6.8 × 10 −6 N·m/C at 300 K, A ·L s 拟合为 2.8 × 10 −4 m, 吸收饱和区的半径拟合为 0.34 mm, 表明光的吸收饱和强度I c 对应于最大强度I的大约五分之一 米 ,即 I c =1/5 我 米 .
为了研究 PISHE 电流对光功率和光分布的依赖性,我们在不同光功率和不同光分布下进行了 PISHE 测量。图2a、b显示了在光点半径为r的不同光功率下,PISHE电流作为光点位置的函数 0 =1.5 毫米和 σ =0.5 毫米和 r 0 =1 毫米和 σ =0.3 毫米,分别。符号是实验数据,实线是根据方程的理论计算。 (2)和(4)。在计算中,除了光斑参数之外,使用了与图 1c 中采用的相同的参数,即 f 0/q =6.8 × 10 −6 N·m/C, A ·L s =2.8 × 10 −4 米,R ab =15.5 k Ω , 和 我 c =1/5 我 米 .在这里,我 米 是功率为 250 mW 时光的最大光强。可以看出 PISHE 电流的强度随着光功率的增加而增加,在 250 mW 的功率下,光斑具有更大的 FWHM(即更大的 σ ) 导致更大的 PISHE 电流。我们也可以看到,对于FWHM较大的光点,PISHE曲线的峰值会出现在较大的x值处 .在这里,x 是光斑中心到两个触点连接中点的距离。这是因为自旋电流和产生的 PISHE 电流与光剖面的梯度成正比。为了更好地比较不同光斑轮廓引起的 PISHE 电流,我们总结了图 2c 中图 2a、b 的结果,即我们总结了不同光斑下 PISHE 电流峰值对激发功率的依赖性。图2c中的光斑轮廓,其中符号表示实验数据,实线是理论计算结果。可以看出,实验结果与理论模拟非常吻合,证实了该模型。
<图片>
PISHE 电流作为不同光功率下光斑位置的函数。 一 , b 由具有 r 的高斯轮廓光点激发的 PISHE 电流 0 =1.5 毫米和 σ =0.5 毫米和 r 0 =1 毫米和 σ =0.3 毫米,分别。 c PISHE电流峰值随励磁功率的变化,其中符号和实线分别为实验数据和理论计算结果
图 2c 表明,随着功率的增加,PISHE 电流首先单调增加,然后逐渐饱和。光功率下 PISHE 电流饱和的出现是由于在高功率下存在吸收饱和。当最大光强小于吸收饱和强度时,PISHE电流随光功率线性增加。当最大光强大于吸收饱和强度时,PISHE电流随着光功率的增加趋于饱和。光斑尺寸对PISHE电流的影响可以从光斑的FWHM对PISHE电流的影响方面来理解,因为光斑尺寸和FWHM是通过光功率相关联的。具体来说,对于一定的光功率,光斑尺寸越大,FWHM值越大。在一定的光功率下,如果最大光强小于吸收饱和强度,FWHM较小的光剖面(即光斑尺寸较小)可以产生较大的PISHE电流,因为较小的FWHM会导致较大的自旋电流;而如果最大光强大于吸收饱和强度,则 FWHM 值较小的光剖面将导致较小的 PISHE 电流。这也可以在图 3 中清楚地看到,它总结了作为不同光分布下光斑位置函数的 PISHE 电流。灯的功率为 250 mW。可以看出,随着σ的值 从 0.2 mm 增加到 0.5 mm,PISHE 电流的峰值单调减小。这是因为在吸收饱和区,没有自旋电流,因此不会产生 PISHE 电流。因此,吸收饱和区域内的光对 PISHE 电流没有任何贡献。图 3 的插图显示了不同高斯光分布的光强度分布。虚线代表样品的吸收饱和强度。虚线与光强曲线的交点表示吸收饱和区域的半径,记为r s .半径为 r 的圆形区域内的光 s , 由 r 时的阴影区域表示 0 =1.5 和 σ =0.5 mm,对 PISHE 电流没有贡献。可以看出,对于250 mW的光功率,虽然FWHM较小的光剖面会导致吸收不饱和区的自旋电流较大,但这种效应被吸收饱和区浪费的能量更多。因此,σ 值较小的光剖面 (即,σ =0.2 mm) 产生的 PISHE 值小于具有较大 σ 的值 (即,σ =0.3 或 0.5 毫米)。
<图片>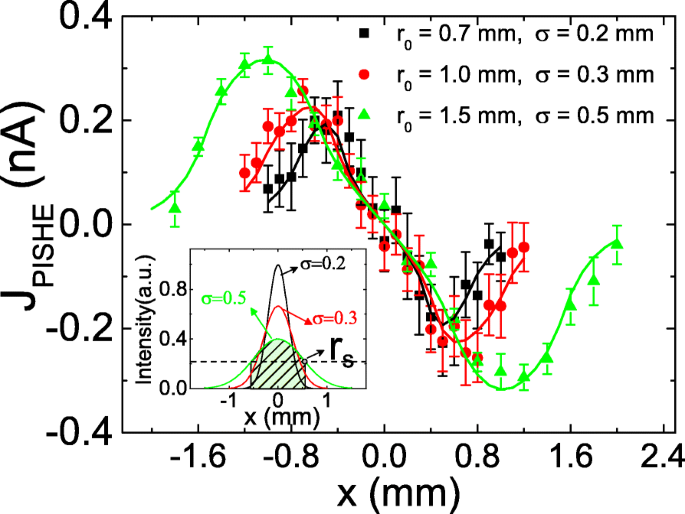
当光功率为 250 mW 时,PISHE 电流作为不同高斯光分布下光斑位置的函数。插图显示了不同高斯光剖面的光强度分布。虚线表示样品的吸收饱和强度
为了研究 PISHE 的主要机制,我们在不同温度下进行了 PISHE 测量。图 4a 显示了 PISHE 电流作为在 77、130、180 和 230 K 下测量的光斑位置的函数。激光光斑具有 r 的高斯分布 0 =0.7 毫米和 σ =0.2 mm,功率为 250 mW。方块表示实验数据,实线是使用方程的拟合结果。 (2)和(4)。可以看出,模型在所有温度下的实验数据都拟合良好。通过拟合,我们可以得到自旋横向力f 0/q ,如图4b所示,以及电子的扩散长度A ·L s 在不同温度下。图 4b 中的虚线是眼睛的指南。确定参数A的值 , 我们应该比较 A 的温度依赖性 ·L s 对电子扩散长度 L 的温度依赖性的先前结果 s .通过拟合我们的 A 值 ·L s L 的值 s 在[42]中获得,我们可以确定常数A 为 1.65 × 10 2 .我们的结果与图 4c 中显示的先前结果非常吻合,验证了我们的方法。可以看出,电子扩散长度随着温度的升高而减小,这主要是由于声子对载流子散射的增强[43]。
<图片>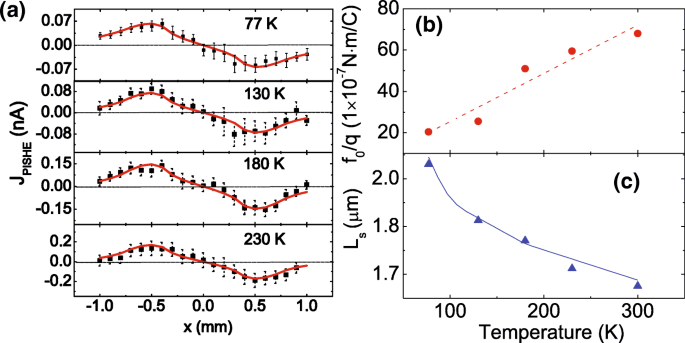
GaAs/AlGaAs 2DEG 的 PISHE 电流、自旋横向力和电子扩散长度的温度依赖性。 一 作为在不同温度下测量的光斑位置的函数的 PISHE 电流的实验和建模结果。实心方块为实验数据,实线为拟合结果。 b , c 自旋横向力和电子扩散长度分别是温度的函数。 b 中的虚线 是眼睛的指南,c中的实线 来自[42]
令人惊讶的是,自旋横向力 f 0/q 2DEG 的 随温度升高而单调增加,这显示出在 Au/InP 混合结构中观察到的 PISHE 温度的相反变化趋势 [44]。这种意想不到的现象可能与 PISHE 的机制有关。半导体 2DEG 中 PISHE 有两种机制,即内在机制和外在机制。前者主要源于能带结构,后者源于由于杂质中的 SOC 效应引起的上下自旋散射的不对称性 [7, 16]。对于C的半导体2DEG 2v 点群对称,由内在机制引起的自旋横向力可以表示为 \(f_{0}=\frac {4m^{*2}\tau _{s}D}{\hbar ^{2}}\left (\alpha ^{2}+\beta ^{2}\right)\) [20, 40],其中\(\hbar \)是约化的普朗克常数,τ s 是自旋弛豫时间,D 是自旋扩散系数,α (或β ) 是 Rashba(或 Dresselhaus)常数,它与 Rashba(或 Dresselhaus)SOC 的强度成正比。对于 GaAs/AlGaAs 2DEG,自旋弛豫时间 τ s 与 T 成正比 −1 [45]。在这里,T 代表温度。对于调制掺杂的2DEG,Rashba SOC的强度远大于Dresselhaus的强度(见下文讨论);因此,Rashba 常数 α 远大于德雷塞尔豪斯常数 β .自旋扩散系数D 与 T 成正比 −2 [46, 47]。 α的温度依赖性 可以表示为 a +b T , 其中 a 和 b 是常数,a 大约比 b 大两个订单 [48]。因此,考虑到 τ 的温度依赖性 s , D , 和 α , 我们有 f 0∝T −3 ,这表明由内在机制引起的自旋横向力应该随着温度的升高而降低。对于外在机制,自旋横向力取决于电离杂质的浓度,特别是对于外在侧跳散射 [49, 50]。由于我们的样品中存在背景掺杂,并且杂质电离随温度升高而增加,因此随着温度升高,自旋向上和自旋向下电子的不对称散射更强,导致随着温度升高而产生更大的自旋横向力。鉴于自旋横向力 f 在我们的实验中观察到的 0 随着温度的升高而增加,可以推断出 PISHE 受外在机制支配,其中杂质主要是在生长过程中通过背景掺杂引入的。
为了进一步证实 PISHE 确实受外在机制支配,我们测量了沿不同晶体方向收集的 PISHE 电流的空间分布。图 5a、b 分别显示了沿 [110] 和 [100] 晶向收集的 PISHE 电流的空间分布。为了消除不同晶向载流子迁移率和载流子密度的影响,我们通过相应的光电流J对PISHE电流进行归一化 当触点分别沿 [110] 和 [100] 方向时,在 0.3 V 的偏置下为 0。测量在室温下在功率为 60 mW 的辐射下进行。光斑半径r 0 为 1.0 mm,σ 是 0.3 毫米。符号表示实验数据,实线是根据方程拟合的结果。 (2)和(4)。可以看出,沿[110]和[100]晶向采集的归一化PISHE电流没有明显差异。
<图片>
沿不同晶体取向收集的归一化 PISHE 电流。 PISHE电流在0.3 V偏置下通过光电流归一化。实线为实验数据,实线为理论拟合结果。插图为相应测量几何的示意图
对于内在机制,沿某个晶体方向的 PISHE 电流与该方向的自旋分裂有关。为了了解 GaAs/AlGaAs 2DEG 中的各向异性自旋分裂,我们测量了室温下 CPGE 电流的晶体取向依赖性,即我们测量了当两个触点沿 [110](或 [100 ]) direction and the incident plane of light lies in [1\(\bar {1}\)0] (or [010]) direction, of which the measurement results are shown by squares (or by circles) in Fig. 6 . It is worth mentioning that when measuring the CPGE current, the light spot is located at the midpoint of the connection of the two contacts, where the PISHE is zero according to [20]. The CPGE current is also normalized by the corresponding photocurrent under a bias of 0.3 V to eliminate the influence of the carrier mobility and the carrier density in different crystal directions [51]. Then, we use the following equation to fit the normalized angle-dependent CPGE current to obtain the relative SOC strength along different crystal directions [21, 27]:
$$ \begin{aligned} J^{\lambda}/J_{0}=\frac{A_{\lambda}\sin \theta \cos^{2} \theta}{n\left[\cos\theta+\left(n^{2}-\sin^{2} \theta\right)^{1/2}\right]\left[n^{2}\cos \theta +\left(n^{2}-\sin^{2}\theta\right)^{1/2}\right]}. \end{aligned} $$ (5)
Incident angle dependence of the normalized CPGE current collected along different crystal orientations. The CPGE current is normalized by the photocurrent under a bias of 0.3 V. The solid symbols are the experimental data, and the lines are the fitting results according to Eq. (5)
这里,θ is the angle of incidence, n is the refractive index of GaAs, and A λ is a constant proportional to the SOC constant. The fitting results are shown by the solid lines in Fig. 6. When the incident plane of light lies in [1\(\bar {1}\)0] direction and the CPGE current is collected along [110] direction, the corresponding A parameter, denoted as A [110], is proportional to the sum of Rashba and Dresselhaus SOC, i.e., A [110]∝α +β [51–53]. When the incident plane of light lies in [010] direction and the CPGE current is collected along [100] direction, the corresponding A parameter, denoted as A [100], is proportional to the Rashba SOC, i.e., A [100]∝α [51–53]. Thus, by the ratio of A [110]/A [100], we can get the relative ratio of Rashba to Dresselhaus SOC, i.e., \(\beta /\alpha =\frac {A_{[110]}}{A_{[100]}}-1\) =0.32, which indicates that the spin splitting in the GaAs/AlGaAs 2DEG has crystal anisotropy [21]. Therefore, the intrinsic contribution to the PISHE should be sensitive to the crystal axis [16]. Specifically speaking, according to Eqs. (2) and (4), when the contacts are along [110] (or [100]) direction, the measured PISHE current is dominated by the inverse spin Hall current flowing nearly parallel to [110] (or [100]) direction since the PISHE current is a vortex current. If the intrinsic mechanism plays a dominant role in the 2DEG, the PISHE current collected along these two directions should be different. However, no marked difference is observed, which suggests that the extrinsic mechanism is dominant in the GaAs/AlGaAs 2DEG.
结论
In conclusion, the PISHE current in a GaAs/AlGaAs 2DEG has been investigated in a temperature range of 77 to 300 K. The spin transverse force has been determined by fitting the PISHE current to a theoretical model. The dependence of the PISHE on the light power and on the light spot profiles has been investigated, which shows a good agreement with the theoretical model. The evolution of the PISHE current with temperature suggests that the PISHE is dominated by the extrinsic mechanism, which is further confirmed by the weak dependence of the PISHE current on the crystal orientation of the sample.
缩写
- 2DEG:
-
Two-dimensional electron gas
- CPGE:
-
Circular photogalvanic effect
- EMF:
-
Circular electromotive force
- FWHM:
-
半高全宽
- ISHE:
-
Inverse spin Hall effect
- MBE:
-
分子束外延
- PISHE:
-
Photo-induced inverse spin Hall effect
- SHE:
-
Spin Hall effect
- SOC:
-
Spin-orbit coupling
纳米材料


