用于电力电子应用的基于超宽带隙 Ga2O3 半导体的肖特基势垒二极管概述
摘要
氧化镓(Ga2O3)是一种新型半导体材料,具有超宽带隙、高击穿电场和大巴利加品质因数(BFOM)等优点,是包括肖特基在内的下一代大功率器件的有希望的候选材料势垒二极管 (SBD)。本文对Ga2O3半导体的基本物理性质进行了分析。并回顾了最近对基于 Ga2O3 的 SBD 的研究。同时,总结和比较了包括击穿电压和导通电阻在内的各种提高性能的方法。最后,分析了Ga2O3基SBD在电力电子领域的应用前景。
背景
随着电力、工业控制、汽车电子、消费电子等行业的快速发展,对高性能功率半导体器件的需求巨大。宽禁带和超宽禁带半导体材料可以满足这种需求[1, 2]。 Ga2O3单晶的五种结构中,单斜β -Ga2O3 是最稳定的,它具有超宽带隙 (E g~ 4.8 eV) 和非常高的击穿电场 (E br~ 8 MV cm −1 ),相较于传统的 Si 以及后来发展起来的 SiC 和 GaN 材料。因此,β -Ga2O3 显示了一个非常大的 Baliga 品质因数 (BFOM =\( \varepsilon \mu {E}_{\mathrm{b}}^3 \); ε 是相对介电常数,μ 是电子迁移率)。 BFOM 是评估功率器件应用材料适用性的重要标准 [3,4,5,6,7,8,9,10,11]。表 1 比较了 Si、宽带隙(GaN、SiC)和超宽带隙(β -Ga2O3) 半导体材料。此外,对于单晶β的生长 -Ga2O3 衬底,在大气压下有简单、低成本和可大规模生产的熔体生长方法,例如浮动区 (FZ) [12, 13] 和边缘限定薄膜生长 (EFG) [14 ,15,16,17]。这是 Ga2O3 在高质量单晶生长方面相对于 SiC 和 GaN 的另一个优势。因此,β -Ga2O3 是肖特基势垒二极管 (SBD) [18,19,20,21,22,23,24] 和金属氧化物半导体场效应晶体管 (MOSFET) 等下一代高功率半导体器件的有希望的候选者) [25,26,27,28,29]。值得注意的是,过去几年对 Ga2O3 材料的生长和功率器件的制备和表征进行了大量的研究,因此在本文中,我们回顾了超宽带隙 Ga2O3 半导体的材料特性以及对其的研究。用于电力电子应用的基于 Ga2O3 的 SBD。在 SBD 中,最重要的性能参数是击穿电压 (V br) 和导通电阻 (R 上),因此通过总结和比较各种改进V的方法 br 和 R 在性能方面,我们希望我们的审查工作有助于Ga2O3基功率器件的发展。
氧化镓半导体的物理性质
氧化镓(Ga2O3)是一种新型氧化物半导体材料,但研究历史悠久。 Al2O3-Ga2O3-H2O 体系中相平衡的研究可以追溯到 1952 年,R. Roy 等人。确定了 Ga2O3 多晶型物的存在及其稳定性关系 [30]。 1965 年,H. H. Tippins 等人。研究了β带边的光吸收和光电导率 -Ga2O3 并确认其带隙值为 4.7 eV [6]。 20世纪90年代,开发了多种Ga2O3体单晶熔融生长和Ga2O3薄膜外延生长的方法。近5年来,Ga2O3材料由于其特殊的性能以及高质量、大尺寸单晶衬底的成功生长,引起了广泛的研究兴趣。
迄今为止,人们已经发现了 Ga2O3 的五个晶相,即 α , β , γ , δ , 和 ε 阶段。这五个阶段之间的转换关系如图 1 [30] 所示。单斜相β- Ga2O3 的热稳定性最好,而其他四相是亚稳态的,容易转变为 β- Ga2O3 在高温下。因此,目前大多数研究集中在β- Ga2O3。最近的一些研究还发现,其他相呈现出一些特殊的材料特性,这些特性β 相没有。例如,α- Ga2O3具有与蓝宝石(Al2O3)相似的刚玉晶体结构,因此比较容易外延生长高质量的α- 现有的Al2O3单晶衬底上的Ga2O3单晶薄膜。六方相ε- Ga2O3 是第二稳定相,表现出强烈的自发极化效应,有利于在异质结界面形成高密度二维电子气 [31],类似于 AlGaN/GaN 结中的条件。近年来,由于大尺寸β-的成功成长 Ga2O3 单晶衬底及其最佳稳定性,迄今为止对β-的研究 Ga2O3 远远超过其他四相。因此,在本文中,我们主要回顾了关于β-的研究工作。 Ga2O3.
<图片>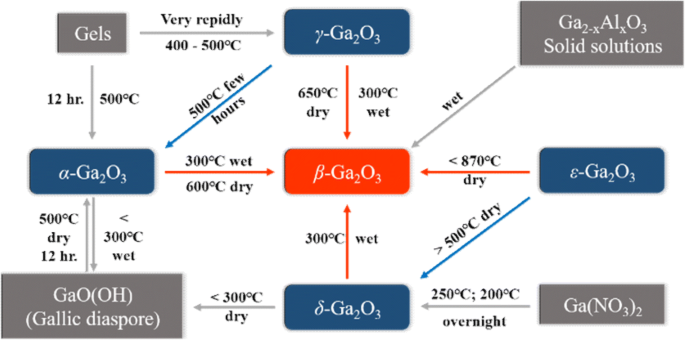
Ga2O3及其水合物晶相的转化关系[30]
β- Ga2O3属于单斜晶系,热稳定。它的晶格常数是a =1.22 纳米,b =0.30 纳米,并且 c =0.58 nm,如图2所示。β-的晶体结构 Ga2O3 决定了它具有一定的导电性,但受到其超宽带隙 (4.7-4.9 eV) 的限制,这是所有已知透明半导体材料中最宽的一种。只有带隙中存在一些缺陷能级并产生自由电子,材料才具有较强的导电性。对于大多数宽带隙半导体,导电性的形成只是因为带隙中存在缺陷能级,例如 ZnO 半导体 [32]。 β-的本征导电 Ga2O3 来源于由晶体块中形成的点缺陷引导的自由电子。大多数研究表明氧空位是导电的关键缺陷[33,34,35]。
<图片>
β-Ga2O3 晶体的晶格结构。转载自参考。 [5]
有趣的是,由于多晶β-中存在大量的氧空位 Ga2O3,很容易吸收某种气体而使电阻率发生变化,所以使用β-的报道很多 Ga2O3 用于制造用于检测 H2、CH4、CO 和 O2 的气体传感器 [36,37,38,39]。另外,由于β-的晶格常数 [100]方向的Ga2O3比[001]和[010]方向的Ga2O3大得多,很容易沿[100]方向剥离超薄膜用于器件制造[27,40,41,42,43]。同时,由于这种晶体结构特点,在β-的制备中 Ga2O3晶片,沿[100]方向切割块体可以获得粗糙度极低的平坦表面。
与 SiC 和 GaN 相比,β- Ga2O3 具有特殊的电气特性,其中超宽带隙(4.7-4.9 eV)最为突出。这使其具有非常高的临界击穿电场 (E br≈8 MV/cm),大约是 SiC 和 GaN 的两倍。材料的击穿电场是单极功率器件的一个非常重要的参数。如果材料具有较高的 E br,在单位厚度的材料中,可以保持较高的电场,有利于器件尺寸的减小和功率模块集成度的提高。图 3 显示了导通电阻 (R on) 作为击穿电压的函数 (V br) 用于几种重要的半导体,包括 Si、GaAs、SiC、GaN、Ga2O3 和金刚石 [5]。从图中我们可以发现,在相同的V下,Ga2O3器件的传导损耗比SiC和GaN器件低一个数量级 兄弟因此,Ga2O3 在单极器件中显示出巨大的潜力。作为 β- 的饱和电子迁移率 Ga2O3 相对较低 (~ 200 cm 2 V − 1 s - 1 ), β- 与 GaN 相比,Ga2O3 不适用于高频器件。然而,它的宽带隙可以弥补这一缺点,因为较薄的漂移层具有较小的耗尽宽度;因此,可以降低寄生电容以满足高频应用的要求。此外,约 4.8 eV 的带隙使 Ga2O3 具有特殊的吸收波段(250-280 nm),恰好位于日盲紫外线 (UV) 射线范围内,因此 Ga2O3 是制造紫外线探测器的天然优良材料 [44] ,45,46,47]。
<图片>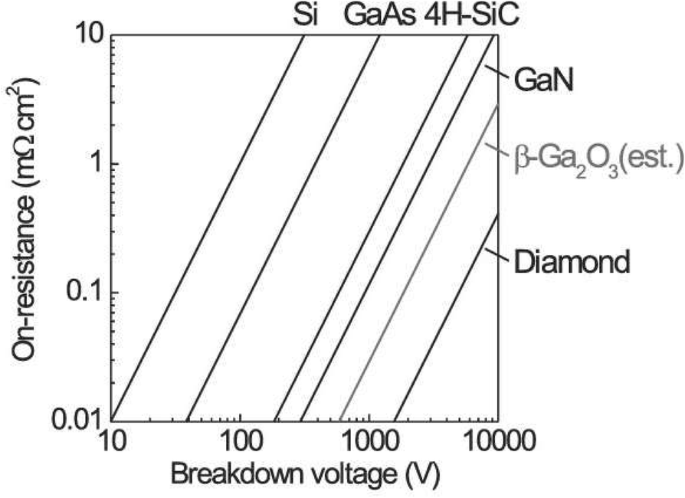
导通电阻的理论极限 (R on) 作为击穿电压的函数 (V br) 用于 β-Ga2O3 和代表性半导体。转载自参考。 [26]
近年来,β-的n型掺杂 Ga2O3已经基本实现。 Si和Sn元素作为其能级浅的施主杂质,具有低活化能。掺杂浓度可以很好地调节到10 15 –10 19 厘米 −3 [47],最高值为10 20 厘米 −3 到达。同时,随着掺杂浓度的变化,光学和电学性质也会发生变化。例如n型β-的电阻率 Ga2O3在10 -3 范围内变化 − 10 12 Ω cm 随掺杂浓度的变化 [48, 49]。带隙也随着掺杂浓度的不同而变化,因此影响Ga2O3的光吸收特性[50]。
从 Ga2O3 的发展来看,这种材料仍然存在以下一些缺点。 (1) P型掺杂是Ga2O3材料的一大挑战。因为受体能级远离β-的价带 Ga2O3,受主杂质的活化能非常高。同时,Ga2O3晶体中的n型背景杂质也会对受主杂质产生自补偿作用,导致材料的自绝缘。因此,仍然没有有效的p型做。 (2) Ga2O3的导热系数太低。实验和理论研究证明了β-的导热系数 Ga2O3 仅为 0.1–0.3 W cm −1 K −1 [51,52,53]。这对在高电压、大电流环境下使用的功率器件是不利的。过多的热量积聚会严重影响设备的性能和可靠性。 (3) 载流子迁移率低。 Ga2O3 的理论迁移率限制在大约 200 cm 2 /V s 由于散射的影响 [54]。低迁移率对频率和电流特性有负面影响。
肖特基势垒二极管的基本概念
肖特基接触、欧姆接触和电场分布是 SBD 获得高性能的关键因素,包括导通电阻 (R on) 和击穿电压 (V br),所以各种改进方法就显得尤为重要。
根据肖特基势垒的概念,势垒高度与肖特基金属的功函数和半导体的电子亲和势有关。不同金属的功函数有周期性变化,金属需要比半导体具有更大的功函数才能形成肖特基势垒。镍 (Ni) 和铂 (Pt) 是 β- 的常见肖特基金属 Ga2O3 及其势垒高度可通过多种方法得出 [55,56,57,58,59,60,61,62,63,64,65,66,67,68,69,70,71,72,73, 74,75,76,77]。半导体表面下方的耗尽区需要必要的厚度来防止载流子隧穿,这就需要限制半导体的掺杂浓度。掺杂浓度常用值为10 16 –10 17 厘米 −3 在β- Ga2O3 衬底或外延层 [56,57,58,59,60,61,62]。势垒高度实际上受界面态的影响,偏离了与功函数的简单关系。表面预处理旨在减少界面态,包括近表面氧空位和悬空键[78]。
欧姆接触是金属和半导体之间的基本联系。欧姆接触的低比电阻有助于器件降低接触电阻(R s) 和导通电阻 (R 在)。实现低接触电阻的传统方法是选择低功函数金属和重掺杂。事实上,由于界面态的钉扎,接触金属的功函数对于欧姆接触的形成总是没有影响的。半导体的重掺杂成为欧姆接触的主要技术。主要目标是提高载流子浓度和降低界面势垒。 RTA(快速热退火)改善了界面特性并有助于降低接触电阻。 Y. Yao 等人。测试了九种金属作为 β- 的欧姆接触金属 Ga2O3 并发现钛 (Ti) 和铟 (In) 在特定条件下表现出良好的欧姆行为 [79]。高温退火后,只有钛才能保持连续的形貌。与此类似,大多数研究都采用钛作为与 β- 的欧姆接触金属 Ga2O3 获得了良好的器件性能 [60,61,62,63,64,65,66,67,68,69,70]。
击穿行为与器件内部的电场分布有关,在相同条件下,圆柱结和球形结比平行平面结具有更大的电场[1]。因此,需要一些边缘终端保护方法,例如场板来提高击穿电压 [19, 23, 68]。称为界面电荷的界面态通常会影响半导体表面附近的电场并导致过早击穿。漏电流是击穿行为的指标,通常受半导体内部缺陷(包括位错)的影响。这两种情况都会引起器件的不稳定,并可能降低击穿电压,应避免。降低界面态影响的常用做法是表面钝化,同时还需要高质量的衬底来提高击穿电压。
基于β-的肖特基势垒二极管 Ga2O3
高质量低成本单晶衬底的生长困难影响了碳化硅和氮化镓器件的商业化。虽然 Ga2O3 单晶衬底可以通过低成本熔融法生长,但近年来基于 Ga2O3 单晶的功率器件备受关注。目前,Ga2O3的n型掺杂技术已经相当成熟,但p型掺杂的缺乏使得Ga2O3无法应用于双极器件。超大的带隙使其在单极器件的应用中具有很大的优势。因此,Ga2O3 功率器件的发展主要由两种单极器件主导,即肖特基势垒二极管 (SBD) 和金属氧化物半导体场效应晶体管 (MOSFET) [23, 55, 56]。
随着宽带隙(WBG)半导体材料技术的发展,基于WBG半导体的SBD器件开始取代p-n结二极管应用于电力电子系统,因为SBD不存在少数载流子存储效应,其开关损耗非常低。理论上,与 SiC 和 GaN SBD 相比,Ga2O3 SBD 可以以更薄的漂移层实现相同的击穿电压。同时,更薄的漂移层使得寄生电容更低,缩短了器件的反向恢复时间。 Ga2O3 SBD的主要发展进展如图4所示。随着外延技术的发展,SBD结构已经从最初的基于衬底的简单结构发展到基于衬底和外延膜的复杂结构。随后,通过对器件制造工艺的逐步探索,出现了场板和沟槽等先进的端子结构,进一步提升了器件性能。 Ga2O3 SBD开始在电力电子应用中展现其潜力。
<图片>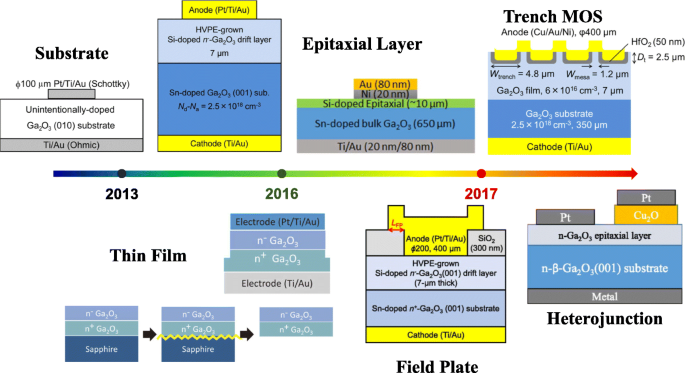
Ga2O3 SBD近年来的发展[16, 18, 62, 68-71]
作为一种新型宽带隙半导体材料,人们在Ga2O3的发展初期面临着诸多基础性问题,因此Ga2O3 SBD的发展进程很好地反映了功率SBD的演进。 SBD中最重要的部分是肖特基结,因此在Ga2O3 SBD的早期研究工作中,有相当多的人专注于肖特基结的研究,主要包括Ga2O3与不同肖特基电极(Ni、 Cu、Au、Pt、TiN) [57,58,59],肖特基结的电子传输机制,肖特基接触中存在的界面态、势垒不均匀性和镜像力问题,以及如何获得完美的方法阴极界面中的欧姆接触[60, 61]。
随着物理性能的逐渐明朗和制造工艺的不断改进,器件性能逐步增强。以下是Ga2O3 SBD开发中的一些典型作品。
2013 年,K. Sasaki 等人。在田村公司制造的基于高质量 (010) β 的 SBD –Ga2O3 单晶衬底通过浮区法生长 [62]。他们研究了衬底中不同掺杂浓度对器件性能的影响,发现较高的掺杂浓度会导致较低的导通电阻但较低的反向击穿电压和较大的反向漏电流。图 5 显示了用 (010) β 制造的两种 SBD 的反向击穿特性 –具有不同掺杂浓度的 Ga2O3 衬底。击穿电压达到150 V。两种器件的理想因子接近1。Pt/β的肖特基势垒高度 –Ga2O3 界面估计为 1.3–1.5 eV。
<图片>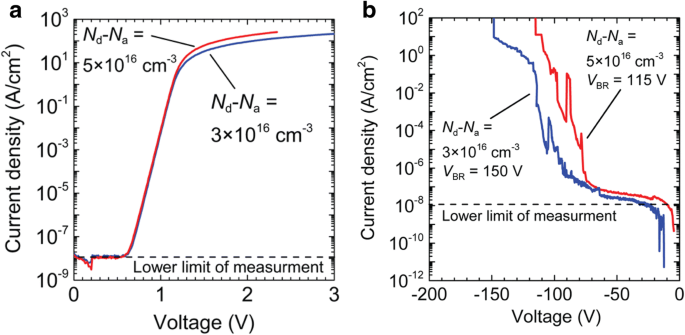
一 , b 基于(010)β的SBD正反向电特性 -Ga2O3 衬底具有不同的掺杂浓度。电流密度测量下限为 10 -8 A/cm 2 .转载自参考。 [62]
中科院微电子研究所与山东大学合作研究基于(100)面向β的SBD –Ga2O3 块状衬底。 2017 年,他们报告了 Pt/β –Ga2O3 SBD 及其随温度变化的电气特性。 X 射线衍射 (XRD) 和高分辨透射电子显微镜 (HRTEM) 分析表明 β -Ga2O3 块状单晶通过边缘限定薄膜生长 (EFG) 技术生长,呈现出良好的 (100) 取向和良好的晶体质量(图 6a、b)。通过 I-V 测量和热电子发射模型,制备的 Pt/β –Ga2O3 SBD 器件表现出良好的性能,包括整流比为 10 10 , 理想因子 (n ) 的 1.1,肖特基势垒高度 (Φ B) 1.39 eV,阈值电压 (V bi) 1.07 V,导通电阻 (R on) 12.5 mΩ cm 2 , 2 V (J @2V) 56 A/cm 2 , 和有效供体浓度 (N d − N a) 2.3 × 10 14 厘米 −3 (图 6c、d)。在该器件中还发现了良好的温度相关性能(图 6e、f)。随着温度的升高,R 在和 J @2V 变得更好,证明该设备可以在高温下正常工作。在接下来的工作中,他们进一步深入研究了理想因子和肖特基势垒高度的温度依赖性,发现这种温度特性可以用势垒高度不均匀性的高斯分布来解释[61]。 2018年进一步优化晶体生长参数,提高Sn掺杂浓度(N d − N a =2.3 × 10 14 厘米 −3 )。新的 Pt/β –Ga2O3 SBD 器件显示出显着改善的性能,包括正向电流密度 (J @2V =421 A/cm 2 ), 导通电阻 (R on =2.9 mΩ cm 2 )、较短的反向恢复时间 (20 ns) 和高于 200 V 的反向击穿电压 [63]。他们的工作表明 EFG 生长 β –Ga2O3 单晶在功率器件方面的应用前景广阔。
<图片>
一 (100) β的X射线衍射(XRD)曲线 -Ga2O3 单晶衬底,清楚地显示了 (400)、(600) 和 (800) 平面的峰。 b Pt/β 的横截面高分辨率透射电子显微镜 (HRTEM) 图像 -Ga2O3 肖特基接触和 β 的快速傅立叶变换 (FFT) 显微照片 -Ga2O3 晶体。 c Pt/β 的正向和反向 J-V 曲线 -Ga2O3 SBD 和 SBD 的示意图(插图)。 d 线性和半对数图中的正向 J-V 曲线。 e 温度相关 J-V 曲线和理查森图(插图)。 f 导通电阻和正向电流密度对温度的依赖性。转载自参考。 [60]
Q. 冯等人。西安电子科技大学教授研究了脉冲激光沉积(PLD)制备工艺和Al掺杂β的基本物理性质 –Ga2O3 薄膜 [64,65,66]。掺杂Al能够调节β的带隙 –Ga2O3 通过结合不同的铝原子比例。基于这种Al掺杂薄膜,Ni/β -(AlGa)2O3 SBD 器件被制造和表征。肖特基势垒高度为 1.33 eV。电流通断比和导通电阻达到10 11 和 2.1 mΩ cm 2 ,分别[65]。他们还研究了温度对理想因子和肖特基势垒高度的影响,并得出了n的这些温度相关特性的结论 和 Φ 通过假设势垒高度存在高斯分布[66],B被归因于肖特基势垒的不均匀性。
随着薄膜外延技术的发展,卤化物气相外延(HVPE)被用来生长Ga2O3薄膜。由于HVPE生长的Ga2O3具有外延速度快、薄膜质量高等优点,非常适合制作高压SBD的漂移层。 2015 年,M. Higashiwaki 等人。在美国国家信息和通信技术研究所 (NICT) 中生长出 7 微米厚的轻掺杂 (~ 1 × 10 16 厘米 −3 ) 重掺杂 (N d − N a =2.5 × 10 18 厘米 −3 ) (001) β- Ga2O3 衬底通过 HVPE 方法和进一步制造的 SBD 器件。研究了器件在不同温度下的 C-V 和 I-V 特性。指出了肖特基势垒高度、阈值电压、C-V 和 I-V 曲线随温度的变化趋势。图 7 显示了器件结构以及正向和反向 J-V-T 曲线 [16]。发现在 21-200°C 时,势垒高度几乎保持不变。正向和反向电流分别与热电子发射 (TE) 和热电子场发射 (TFE) 模型非常吻合。他们的研究结果证明了Ga2O3 SBD在下一代功率器件中的应用潜力。
<图片>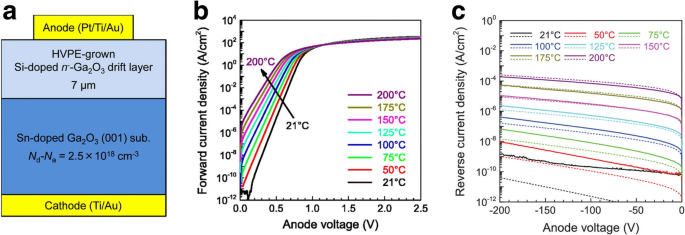
一 基于 HVPE 生长的 7 微米厚 n − 的 SBD 器件的结构 - n + 上的Ga2O3同质外延漂移层 - Ga2O3 单晶衬底。 b 器件的正向 J-V 特性在 21-200°C 下测得。 c 在 21–200 °C 时反转 J–V(实线和虚线分别代表实验和模拟结果)。转载自参考。 [16]
2016 年,M. Oda 等人。在 FLOSFIA Inc. 发表了一篇关于 α 的作品 -Ga2O3 SBD [18]。通过雾状化学气相沉积 (CVD) 技术,即 MIST EPITAXY®,它们依次生长大量(3-4 μm 厚)和轻掺杂 α 蓝宝石 (Al2O3) 衬底上的 -Ga2O3 薄膜。取下α后 来自衬底、阴极和阳极的 -Ga2O3 层沉积在 n - 的底部和顶部表面上 - Ga2O3/n + - 分别为 Ga2O3 层(图 8)。具有 2580 纳米厚 n − 的设备 - Ga2O3 层显示出 855 V 的高击穿电压和 0.4 mΩ cm 2 的导通电阻 .而具有更薄 (430 nm) n − 的设备 - Ga2O3 层 SBD 的导通电阻非常低,仅为 0.1 mΩ cm 2 和 531 V 的击穿电压。2018 年,他们进一步报道了这种采用 TO220 封装的器件 [67]。获得了 130 pF 的结电容,因此与 SiC SBD 和 Si SBD 相比,该器件显示出更好的反向恢复特性。同时,封装后器件的热阻为 13.9°C/W,与相同封装的 SiC SBD 的热阻 (12.5°C/W) 相当,表明采用薄漂移层可以有效补偿Ga2O3材料导热性差的缺点。在这份报告中,作者还指出α -(Rh,Ga)2O3 可以作为 α 的有效 p 型沟道层 -Ga2O3 器件。
<图片>
α的制作工艺 -Ga2O3 SBD 由 FLOSFIA Inc. 提出。转载自参考文献。 [18, 67]
2017 年,K. Konishi 等人。在 NICT 报告了 Pt/HVPE-n − - Ga2O3/(001)n + - Ga2O3 SBD 器件,击穿电压为 1076 V,导通电阻为 5.1 mΩ cm 2 (图 9)[68]。场板 (FP) 工程是一种边缘端接技术,最早用于 Ga2O3 SBD。通过添加连接阳极的SiO2 FP,整个器件结构中的最大电场保持在临界场以下,尤其是阳极周围的电场可以明显降低。采用这种方法,可以实现高击穿电压和低导通电阻。同年,J. Yang 等人报道了更高的击穿电压 (1600 V)。来自佛罗里达大学的 SBD 设备,采用 Ni/MOCVD-n − - Ga2O3/(− 201) n + - Ga2O3 结构 [69],但导通电阻非常大 (25 mΩ cm 2 )。没有使用边缘终止。他们的研究表明,肖特基电极的尺寸对击穿电压和导通电阻有影响,因为电极越大缺陷越多,击穿越容易。
<图片>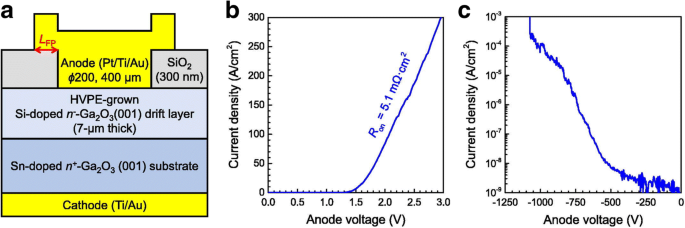
一 带场板的 SBD 结构。 b , c 正向和反向电气特性 (V br =1076 V)。转载自参考。 [68]
2017 年,K. Sasaki 等人。来自 Novel Crystal Technology Inc. 的第一个制造的 β -Ga2O3 SBD 具有沟槽终止结构(图 10)[70]。采用这种结构,可以有效降低肖特基结中的电场;因此,在很好地保持正向特性的同时,可以大大降低漏电流。器件的导通电阻为 2.9 mΩ cm 2 , and the breakdown voltage reached about 240 V. At the same time, the threshold voltage was remarkably reduced compared with the previous reports. This work is a valuable exploration on the advanced fabrication process of Ga2O3 SBD. In the 2nd International Workshop on Gallium Oxide and Related Materials (IWGO 2017) held in Italy, they further reported the improved trench SBD. The threshold voltage decreased to 0.5 V. On-resistance was 2.4 mΩ cm 2 , and breakdown voltage was over 400 V. Compared to the commercialized 600 V SiC SBD, the improved trench Ga2O3 SBD exhibited superiority in switching loss.
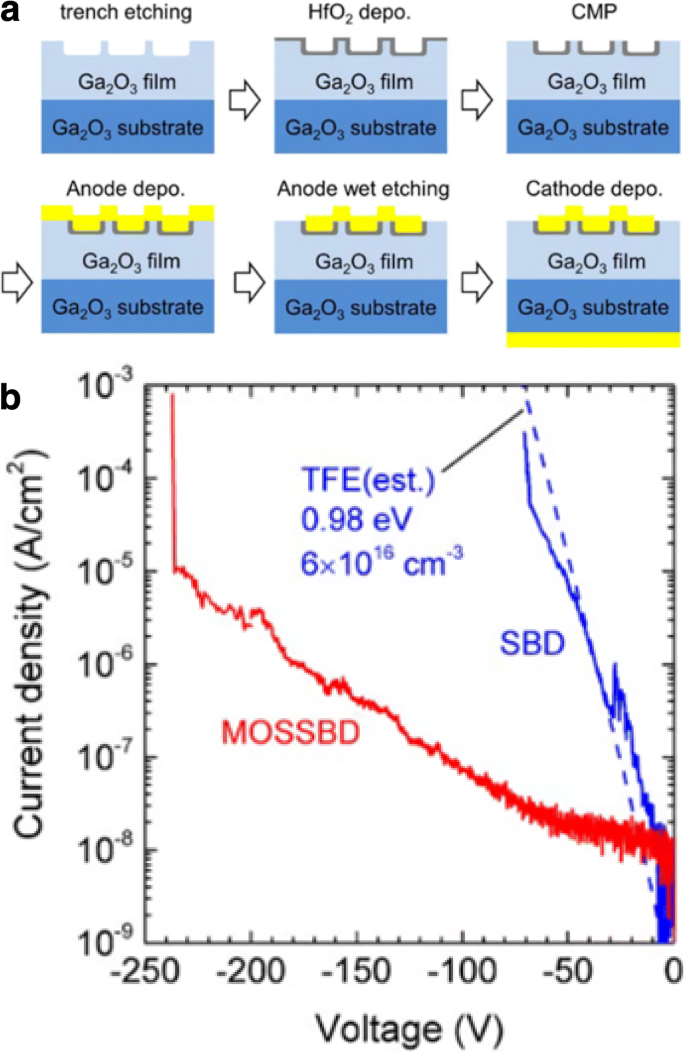
一 Fabrication processes of the MOS-type Ga2O3 SBD with trench termination structure. b Comparison of the reverse characteristics of the Ga2O3 SBDs with and without trenches. Reprinted from ref. [70]
To date, there has been no effective p-type doping in Ga2O3, so bipolar devices are not easy to be realized. In 2017, T. Watahiki et al. from Mitsubishi Electric Corporation reported a heterojunction p-Cu2O/n-Ga2O3 p-n diode without local termination structure [71]. Figure 11 shows the schematic, band diagram and J–V curves of this p-n diode. Pt/Ga2O3 SBD was simultaneously fabricated and measured for comparison. The breakdown voltage of the p-n diode reached as high as 1.49 kV. The on-resistance was 8.2 mΩ cm 2 , much lower than that of the SBD with a thick drift layer reported by J. Yang et al. [69]。 So, it can be found that bipolar Ga2O3 device has a certain advantage over unipolar device in regard to the low on-resistance. This work provides a possible solution for the design Ga2O3-based bipolar devices. However, this p-n diode exhibited a high threshold voltage (1.7 V). Moreover, in bipolar device, there is the minority carrier storage effect. With the improvement of SBD device structure, this p-n diode appears to show significant competitivity in the aspect of 600–1200 V voltage-resistant level and high frequency. It is believed that with the continuous exploration on the materials, SBD might still be a more effective approach for development of the high-voltage Ga2O3 device before the successful preparation of p-type Ga2O3.
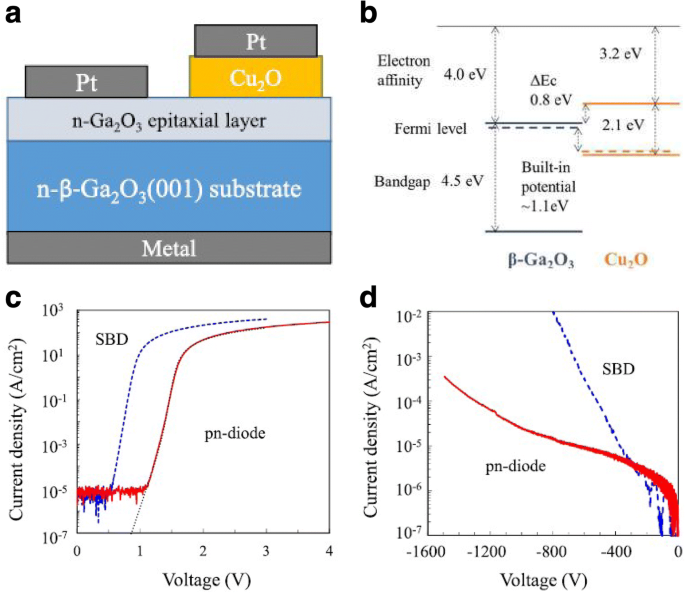
一 Schematic of the cross-sectional Pt/Ga2O3 SBD and p-Cu2O/n-Ga2O3 diode. b Band diagram of the p-Cu2O/n-Ga2O3 interface. c , d Forward and reverse J–V characteristics of the SBD and p-n diode. Reprinted from ref. [71]
In practical applications, SBD is usually used to rectify the AC or pulse signals as a rectifier in a circuit. It should work at different frequencies. Q. He et al. from IMECAS investigated the rectification characteristics of the Pt/Ga2O3 SBD under the AC frequency under 10 kHz to 1 MHz by using a half-wave rectification circuit (Fig. 12) [63]. The testing result proves that the device has the ideal working frequency of 100 kHz, which is equivalent to that of SiC. This work is beneficial for people to further explore how Ga2O3 Schottky rectifier can operate at higher frequency and also to construct power circuit modules based on Ga2O3 SBD single device.

一 Rectification circuit. b –e Rectifying effect of Pt/Ga2O3 SBD on the AC signals under frequency of 10 kHz, 100 kHz, 500 kHz, and 1 MHz. Reprinted from ref. [63]
Table 2 lists and compares the basic performance parameters of some typical Ga2O3 Schottky barrier diode reported since 2012. From this table, it is apparent that with the improvement of device structure and fabrication processes, the performances are getting better and better.
结论
Currently, Ga2O3 SBD is still in its early stage. With the continuous development of fabrication processes, device structure becomes more and more complicated. At the same time, the improvement of the quality of single-crystal substrates and epitaxial films also significantly push forward device performances. However, to date, the development process of Ga2O3 SBD is very similar to those of previous Si SBD and SiC SBD. Furthermore, the research works on the intrinsic properties of Ga2O3 materials are still very few. But it is believed that on the basis of its ultrawide bandgap of 4.7–4.9 eV and the development of device structure, Ga2O3 will better display its unique application value, which requires the joint efforts of the researchers.
缩写
- AC:
-
Alternating current
- BFOM:
-
Baliga’s figure of merit
- CVD:
-
化学气相沉积
- EFG:
-
Edge-defined film-fed growth
- FFT:
-
Fast Fourier transform
- FP:
-
Field plat
- FZ:
-
Floating zone
- HRTEM:
-
高分辨透射电子显微镜
- HVPE:
-
Halide vapor-phase epitaxy
- IMECAS:
-
Institute of Microelectronics of Chinese Academy of Sciences
- MOCVD:
-
金属有机化学气相沉积
- MOSFET:
-
Metal-oxide-semiconductor field-effect transistor
- NICT:
-
National Institute of Information and Communications Technology
- PLD:
-
脉冲激光沉积
- SBD:
-
Schottky barrier diode
- TE:
-
Thermionic emission
- TFE:
-
Thermionic field emission
- WBG:
-
Wide bandgap
- XRD:
-
X射线衍射
纳米材料


