通过像差校正 HAADF-STEM 分析外延 GaAsBi 中的 Bi 分布
摘要
GaAs/GaAs1中的Bi含量 − x 双 x 通过像差校正的高角度环形暗场技术研究了在接近 340°C 的衬底温度下通过分子束外延生长的 /GaAs 异质结构。通过 EDX 分析证实的高角度环形暗场扫描透射电子显微镜图像的低放大倍数分析揭示了平面无缺陷层和界面处和 GaAsBi 层内的非均匀 Bi 分布。在高放大倍数下,qHAADF 分析证实了在低 Bi 通量下 GaAsBi/GaAs 界面处的不均匀分布和 Bi 偏析,以及在高 Bi 含量区域中扭曲的哑铃形状。在较高的 Bi 通量下,Bi 聚集的尺寸增加,导致大致等轴的富 Bi 颗粒沿闪锌矿 {111} 面并均匀分散在基体和界面周围。 FFT 分析检查某些簇中两相的共存情况:菱形纯 Bi (rh-Bi) 被闪锌矿 GaAs1 − x 包围 双 x 矩阵。团簇可能会影响局部晶格弛豫并导致部分弛豫的 GaAsBi/GaAs 系统,与 XRD 分析一致。
背景
如今,基于 GaAsBi 的半导体作为温度稳定和中红外器件引起了人们的兴趣 [1]。在 GaAs 晶格中添加少量 Bi 会导致带隙大幅减小,这是最有趣的光电效应之一 [2, 3]。然而,由于 Ga-Bi 键能较弱、混溶间隙大以及 GaBi 和 GaAs 之间的晶格常数差异很大,因此即使将少量的 Bi 掺入 GaAs 也具有挑战性。因此,GaAsBi 必须在非平衡动态过程中生长,才能有效地掺入 Bi。尽管即使合成成功,Bi 的分布有时也是不均匀的,增加了非辐射复合中心的密度,从而影响了它们的激光操作效率。 Bi 的大尺寸和低电负性倾向于在外延生长过程中产生相分离 [4]、表面液滴 [5, 6]、原子有序 [7,8,9]、纳米级液滴 [10] 或 Bi 簇。 Ciatto 等人先前检测到 Bi 簇的存在。通过结合 X 射线吸收光谱 (XAS)、原子力显微镜和 X 射线衍射 (XRD) 技术 [11]。然后,几位作者通过使用不同的透射电子显微镜技术 [4, 12, 13] 报告了在退火的 GaAsBi 样品中存在 Bi 簇。此外,Kunzer 等人。 [14] 通过传统的电子自旋共振 (ESR) 证实,大约 10% 的掺入 Bi 占据了 GaAsBi 层中的 Ga 位点。因此,理解和控制 Bi 掺入和缺陷形成对于 GaAsBi 在器件中的成功应用至关重要。值得一提的是,新型铋基材料的开发与表征工具的进步有关。从这个意义上说,像差校正显微镜中的高角度环形暗场扫描透射电子显微镜 (HAADF-STEM) 技术在获取亚埃级信息方面发挥着重要作用 [15, 16]。在这种技术中,图像中的强度大致与平均原子序数 (Z ) 在投影的原子列中,因此它可以成功地应用于稀释的 Ga(AsBi) 异质结构,因为 Bi 的原子序数相对于 As 和 Ga。此外,HAADF 图像中的明亮特征与由于缺乏对比度反转和离域,高分辨率透射电子显微镜 (HRTEM) 可以与对齐晶体中的原子柱相关联。此外,GaAsBi 样品的像差校正 HAADF 图像显示出对样品厚度的低依赖性和对 As/Bi 成分的几乎线性依赖性 [12]。此外,通过应用由 Molina 等人开发的定量 HAADF (qHAADF) 图像分析算法。 [17],可以有效地关联 III-V 三元半导体材料 [12, 16, 18] 以及 GaAsBi 化合物中的 HAADF 强度和原子柱组成。此外,高分辨率 HAADF-STEM 图像提供了有关晶体质量的信息 [19,20,21,22]。
在这项工作中,我们通过像差校正的 HAADF-STEM 成像和互补能量色散 X 射线 (EDX) 研究了 GaAs/GaAs1 − x 中的 Bi 分布 双 x /GaAs 异质结构通过分子束外延 (MBE) 在接近 340°C 的衬底温度下生长。我们还研究了纳米和微米尺度的铋聚集效应。为此,我们使用了 qHAADF 方法、高分辨率图像的傅里叶快速变换 (FFT) 分析和 XRD 技术。
方法
我们研究了一系列由 GaAs/GaAs1 − x 组成的两个样品 双 x /GaAs 异质结构由固态源 MBE 在 2" n + 上生长 GaAs:具有不同 Bi 通量的 Si (001) 晶片,由 Bi 电池温度 S1(460°C)和 S2(505°C)给出。使用的系统是 VG V80 MBE 机器,平均静息背景压力为 ~ 5 × 10 − 10 毫巴。这些结构名义上由 130 nm GaAs 缓冲层、130 nm GaAsBi 层、5 nm GaAs 间隔层和 130 nm GaAs 帽组成。在生长之前,基板在 400°C 下脱气 20 分钟,然后在 600°C 下去除表面氧化物。 GaAs 缓冲层和盖帽在 As2 通量下在~ 580°C 下生长,而 GaAsBi 层和 GaAs 间隔层在接近化学计量的 As4 通量下在~ 340°C 下生长。因此,在 GaAs 帽的生长过程中,GaAsBi 层在 ~ 580°C 下原位退火 ~ 20 分钟。在这些生长条件下,在表面没有观察到金属液滴。使用光学测温法估计基板温度,结果根据已知温度下的表面重建转变进行校准。在 GaAsBi 生长之前,样品表面暴露在 Bi 助焊剂中 20 秒;该步骤的目的是在GaAsBi生长开始时建立Bi表面层并增强Bi掺入。
HAADF-STEM 的试样是通过机械研磨和 Ar + 制备的横截面 使用精密离子抛光系统 (PIPS) 进行离子铣削,束倾斜为 - 3° 和 + 4°,束能量在 2.8 和 3.0 kV 之间。在最后的研磨步骤中,离子能量降低到 1.5 kV 以提高表面质量。研究之前的样品经过等离子体清洗,以减少电子束沉积对样品表面的影响 [23]。使用 Titan 3 在 200 kV 下进行 HAADF-STEM 图像、零损失电子能量损失谱 (EELS) 和能量色散 X 射线谱线扫描 Themis 在 60-300 kV。泰坦 3 Themis 配备冷场发射枪 (FEG)、Cs 探针校正器和电子单色器,可在 HAADF 成像中实现原子分辨率。该显微镜还包括用于元素分析的 Super-X 四元 EDX 检测器,可同时提供有关原子位置和组成的信息。使用 FEI NOVA NANOSEM 450 显微镜在 2 kV 下进行 TEM 样品形貌研究的二次电子 (SE) 图像。
2.42 keV 的 Bi-M 线用于通过 Bruker Espirit 软件定量测定 Bi 成分。通过使用数字显微照片 (GATAN™) 软件 [23],通过对空间分辨零损耗 EELS 信号的分析来确定样品的厚度。使用可在数字显微照片上运行的 qHAADF 软件研究了逐列 Bi 分布。该软件允许通过检测 HAADF-STEM 图像中的强度峰值来测量和映射原子柱周围选定区域的积分强度 [17]。 ω-2θ (0 0 4) XRD 光谱是使用 Bruker D8 Discover X 射线衍射仪使用 Cu-Kα1 辐射测量的。使用Bede Rads Mercury软件模拟扫描。
结果与讨论
图 1 显示了在样品 S1 (a) 和 S2 (b) 的 [110] 区轴上拍摄的低倍率 HAADF-STEM 图像,以及沿 [001] 方向从标记在HAADF-STEM 图像(绿色矩形)。在两个样品的研究区域中均未检测到螺纹位错或堆垛层错。在 HAADF 中,获得的强度与平均原子序数成正比。因此,对于恒定的样品厚度,图像中较亮的对比度与较高的 Bi 含量(Z Bi =83, Z Ga =31 和 Z As =33)。这使得研究 GaAsBi/GaAs 异质结构中的 Bi 分布成为可能。正如在图 1a 中所观察到的那样,在样品 S1 中的 GaAsBi 层中没有检测到明显的对比度变化 - 具有较低的 Bi 含量 - 没有显示出明显的聚类证据,即使在具有较高样品厚度的其他区域也没有。然而,文献中已经报道了 Bi 和 As 簇,即使是 Bi 含量低至 1.44% 的 GaAsBi 样品,尽管在较低温度下生长 [11]。对于具有较高 Bi 含量的样品 S2,图 1b 描绘了层中具有较亮对比度的一些区域,具有相对均匀的尺寸和分布。这些区域沿 GaAsBi 层和界面有规律地分布,可以直接解释为含 Bi 簇,因为它们具有较高的 HAADF 强度。为了更好地可视化,相应的低通滤波图像在同一图像中显示为插图,其中黄色对应于较高的 Bi 含量区域,黑色对应于较低的区域(温度标度)。其他作者先前已经报道了在 GaAsBi 中形成 Bi 簇而不会引起结构缺陷 [7, 24, 25]。由于应变,Bi(As原子体积的1.6倍)在GaAs基体中的整合可能会导致置换能的增加,从而降低As原子的溶解度并允许Bi原子的聚集。使用场发射枪扫描电子显微镜 (FEG-SEM) 对样品进行研究,以确保 Bi 簇嵌入层内。为此,将在低电压下获得的二次电子的形貌图像(此处未显示)与从同一区域拍摄的 STEM 图像进行比较。
<图片>
一 样品 S1 的横截面 HAADF-STEM 图像显示了 GaAs/GaAsBi/GaAs 界面。 b 样品 S2 的横截面 HAADF-STEM 图像,在 GaAsBi 层中观察到沿与富铋区域相关的 GaAsBi 层分布的亮点。应用低通滤波器后使用区域温度色标的细节作为插图包含在同一图像中,以获得更好的可视化效果。 c 从HAADF-STEM图像中用绿色矩形标记的区域沿[001]方向获取的厚度梯度校正强度分布图,样品S1的蓝线和样品S2的黑线,在界面处显示出略有不同的行为
为了获得有关样品中 Bi 分布的更多信息,图 1c 显示了沿生长方向的强度分布和校正后的厚度梯度。取自图 1a、b 中的 HAADF-STEM 图像的剖面图指出了两个样品的相似行为:界面大致是突变的,GaAsBi 层的长度相似(~ 140 nm)。关于 GaAsBi/GaAs 界面,HAADF 强度在大约 10 nm 内从其最大值下降到 ~ 0(参见轮廓中的灰色虚线矩形),这表明即使没有 Bi 通量,在整个 GaAs 帽层中也有一些 Bi 掺入。配置文件还描述了有关平衡时间的信息。从曲线中可以看出,在较低 Bi 含量样品(S1)中,GaAs/GaAsBi 界面比较高 Bi 含量样品(S2)中的界面更陡峭。这可以通过两个样品的不同 Bi 掺入系数来解释。 S1 在与 S2 相同的温度下生长,但 Bi 含量要小得多。因此,S1 可能在动力学受限的条件下生长,并具有接近统一的 Bi 掺入 [26],这意味着 Bi 表面层将在比该温度下 Bi 原子的表面寿命短的时间范围内达到平衡。另一方面,S2 可能具有较低的 Bi 掺入系数 [27]。在这种情况下,Bi 表面层需要比 Bi 原子的表面寿命更长的时间才能达到平衡,导致 Bi 掺入的稳定性较慢。
为了确认 HAADF-STEM 强度分布与异质结构中 Bi 分布之间的相关性,同时拍摄了样品的 STEM-EDX Bi 成分图。它们在图 2 中显示为低 (a) 和高 (b) Bi 通量的样品。通过对大约 130 nm 区域的点 EDX 光谱进行积分确定,沿生长方向的相应 Bi 成分分布在图 2c 中分别显示为蓝线和黑线。这些成分分布显示了通过低倍率 HAADF 分析在 GaAs/GaAsBi/GaAs 界面中检测到的相同趋势。 GaAsBi 层中的平均 Bi 原子分数由相应的 EDX 光谱量化,分别为样品 S1 和 S2 中的 1.2 ± 0.4% 和 5.3 ± 0.4%,表明两个样品中 GaAsBi 层中 Bi 的分布不均匀.
<图片>
STEM/EDX 元素图表示样品 S1 (a ) 和 S2 (b )。对应于图 1b 中用白色矩形标记的簇的 Bi、Ga 和 As 元素图的详细信息显示,在高 Bi 区域处 As 和 Ga 信号下降。 c 在从样品 S1(蓝线)和 S2(黑线)的 EDX 图整合约 130 nm 的区域后,沿 [001] 方向提取的 Bi 含量分布图。在图 1c 所示的低放大倍数下的强度分布中也观察到了类似的特征
Bi 簇的存在是由于位阻效应。在这种情况下,由于 Bi 原子的原子尺寸较大,表面张力可能会增加,因此为了降低结构中的应力,Bi 原子可能会阻止 Ga 掺入,从而导致网络中的 Ga 空位。包括图 2b 中由白色方块包围的簇的 Ga 和 As 组成图,以显示两个信号如何落在有高 Bi 信号的地方。这表明,在这个特定的簇中,Bi 可能同时占据第 III 组和第 V 组子晶格。这也证明这些团簇不是在TEM样品制备过程中形成的表面团簇。
为了在原子水平上对 Bi 分布进行深入研究,在 [110] 投影中拍摄了高倍率像差校正的 HAADF-STEM 图像。在这种 III-V 族半导体合金中,哑铃的两个最大强度峰对应于 III 族和 V 族原子列。为了将原子柱中的强度与其组成正确关联,已从实验性 HAADF-STEM 图像中删除了背景水平。然后,进行了强度峰的自动定位,并仔细选择了 V 族原子柱周围的积分区域。使用 qHAADF 方法测量和映射每个哑铃的综合强度。量化 Bi 含量的程序类似于参考文献中发表的程序。 [28]。在这项工作中,每个哑铃的综合强度商 (R ) 计算为 V 组列 (I As − Bi) 和 GaAs 层中 V 族列的平均积分强度 (I 作为),作为 R =(我 (As − Bi))/I
图 3a 显示了从具有较差 Bi 含量的样品 (S1) 中获取的 GaAs/GaAsBi 界面的高倍率 HAADF-STEM 图像。 HAADF 图像的彩色归一化积分强度图如图 3b 所示。范围从 1(深蓝色)到 1.27(红色)的彩色点描绘了 V 组列中的 Bi 含量。可以看出,R 的小幅波动 在两个层中都可以找到来自平均值的值。为了比较所得结果的分散性,我们计算了相关系数Cv (定义为标准偏差与平均值的比值 R 值)在 GaAs(衬底)、GaAsBi 层和 GaAs 帽层中。 简历 值分别为 1.3、2.6 和 2.6%,因为在 GaAsBi/GaAs 界面中观察到的波动高于在作为参考的 GaAs 衬底中发现的波动;我们可以认为 R 中的这些变化 值与 Bi 列组成的变化有关。非零 Cv 的原因 基材中的因素可能是由于局部厚度波动、检测器噪声(在没有材料的区域测量为 0.6%)或在显微镜表征过程中沉积在表面样品上的碳氢化合物。
<图片>
一 样品 S1 的 GaAsBi/GaAs 界面的横截面 [110] HAADF-STEM 图像。 GaAs 层中未失真区域的细节和高倍率下富含 Bi 区域中的失真阴离子 - 阳离子哑铃作为插图包含在同一图像中。 b 代表 R 的彩色地图 图 3a 中 HAADF 图像的 V 组列周围的值。绿色对应于通过 EDX 测量的 GaAsBi 层中的平均 Bi 成分。尽管在 HAADF-STEM 图像中 Bi 分布均匀,但强度图显示了在 GaAsBi 层中纳米团簇(红点)概率较高的区域和 Bi 含量相对较差的柱(蓝点)。 c 沿着整个R的增长方向进行剖析 强度图,显示约 10 nm 处的模糊 GaAsBi/GaAs 界面
该 qHAADF 分析证实了在低放大倍数下观察到的超过 10 nm 的非突变上 GaAsBi/GaAs 界面,主要是由于生长过程中的 Bi 表面偏析,因为它可以从沿整个强度的生长方向截取的轮廓观察到R 地图,如图 3c 所示。此外,该软件还检测到 GaAsBi 层中分散的富铋柱(红点)以及 GaAsBi 层中 Bi 含量低的区域(蓝点),确认了 GaAsBi 层中的 Bi 含量波动.富含铋的柱子的存在似乎在哑铃形状中产生了明显的变形,因为它可以在图 3a 中更高放大倍数的插图中看到。在外延生长过程中用砷原子取代较大的铋原子会局部加宽基体的晶格,在保持结构的同时导致哑铃形变形。
HAADF-STEM 技术还可以对样品 S2 中在低放大倍数下检测到的簇进行结构和成分分析。这些簇几乎均匀分布,占据 GaAsBi 层表面的 20-30% 左右。为了了解发现的簇的 Bi 组成、形状和大小,在 [110] 投影中拍摄了像差校正的 HAADF-STEM 图像,并执行了 V 组列周围的 EDX 元素图和强度图比率。为了识别不同的晶相,对簇内和簇附近不同区域的高分辨率图像进行了快速傅里叶变换(FFT)研究。
图 4a 显示了 GaAsBi/GaAs 界面的高分辨率 [110] HAADF-STEM 图像,具有约 12 nm 直径的清晰 Bi 簇。图像中的红色矩形代表进行 FFT 研究的区域。众所周知,低通滤波不仅减少了数据中的噪声量,而且还去除了在原始图像中观察到的周期性特征,强调了 Bi 簇的边缘。过滤后的 HAADF-STEM 图像,遵循 Werner 等人描述的程序。 [29],如图 4b 所示。可以看出,最亮区域中的 {111} 和 (001) 面是清晰可见的。然而,强度分布表明粒子中存在两种不同的组成体积:一种富含铋的梯形形状,周围环绕着较少的富含铋的区域。 Wood等人观察到类似的簇形状。在五周期 GaAs1 − x 双 x /GaAs1 − y 双y 结构[10]。
<图片>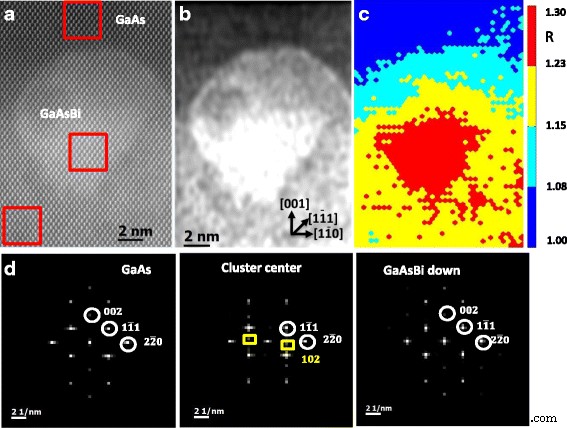
一 样品 S2 的 GaAsBi/GaAs 界面的横截面 [110] HAADF-STEM 图像,在 GaAsBi/GaAs 界面旁边捕获了大小约为 12 nm 的 Bi 簇。 b HAADF-STEM 图像的低滤波图像显示 GaAsBi 层中具有不同对比度的两个区域,富 Bi 区域沿 {111} 和 (001) 平面形成小平面,并被较低的富 Bi 区域包围。 c 代表 R 的彩色地图 V 组列周围的值描绘了集群周围的分级 Bi 分布。 d 图 1a 中用红色矩形标记的选定区域的相应傅立叶变换。在对比度最高的簇区域检测到与rh-Bi相位相关的{102}平面匹配的额外斑点
通过强度R的qHAADF分析 图 4c 中显示的图描绘了大致等轴的颗粒形状和在簇中心达到峰值的 Bi 浓度梯度。
吴等人。 [4] 报道了 GaAsBi 层中存在不同的晶体结构,研究 HRTEM 显微照片并模拟从富含 Bi 的闪锌矿到在闪锌矿 {111} 平面中成核的菱形 Bi (rh-Bi) 的形成和相变。从这个意义上说,值得一提的是,来自高分辨率 HAADF-STEM 图像的 FFT 中的亮点可以解释为来自晶面的衍射点。然后,GaAs 闪锌矿结构的常规图案中的额外斑点应被解释为附加相。为了研究簇中不同晶体结构的存在,图 4d 显示了对应于图 1a 中标记为红色方块的三个不同区域的 FFT。从右到左显示了 GaAs 帽层中的均匀区域、GaAsBi 层中最亮的区域和同一 GaAsBi 层中另一个对比度较低的区域。白色圆圈表示米勒指数为 002、\( 1\overline{1}1 \) 和\( 2\overline{2}0 \) 的衍射峰位置。可以看出,只有在簇的中心出现了清晰的斑点,用黄色方块标记,与大致平行于闪锌矿 {220} 面的 {102} 面有关,表明新的 rh-Bi 相在GaAsBi 闪锌矿层。 FFT 还描绘了与 {111} 平面相关的衍射峰的加宽。观察到的这种不对称峰可能是由于簇中rh-Bi和闪锌矿相之间的{111}面剪切而产生的微应变引起的。
对于簇组成的深入研究,值得一提的是,当电子穿过带有嵌入簇的电子透明样本时,它们不仅携带有关簇的信息,还携带来自矩阵的信息。因此,为了估计真实的集群组成,我们遵循参考文献中描述的相同程序。 [25]。结果还指出,靠近 GaAsBi/GaAs 界面的团簇往往尺寸更小 (12 nm),Bi 含量更高 (≈ 30%),这可能是由于当盖层开始时表面上存在 Bi长大。然而,位于 GaAsBi 层内的大多数簇具有更大的尺寸(16 nm),但它们的 Bi 含量较差(≈ 22%)。此外,在 GaAsBi 层中,检测到具有较高 Bi 含量 (35%) 和更大尺寸 (23 nm) 的团簇。此外,如前所述,一些星团的核心由纯rh-Bi组成。
为了研究外延膜的应变状态,记录了高分辨率 X 射线 ω-2θ 曲线。图 5 显示了样品 S1 (a) 和 S2 (b) 的蓝色 GaAsBi/GaAs 层的 (004) XRD 扫描和橙色的模拟拟合。在两个样品中,位于 0°弧秒处的最尖锐和最高强度峰值对应于 GaAs 衬底,而位于负弧秒处的较宽的较低强度峰值对应于应变 GaAsBi 层。峰之间的角度与两层之间的晶格失配量有关。 S2 光谱中 GaAs 峰右侧的肩部表示处于拉伸应变下的 GaAs 层;这意味着 S2 GaAsBi 层中的应变松弛。使用由 EDX 和 HAADF 测量给出的 Bi 分数和厚度,样品 S1 的 XRD 谱很好地拟合。在样品 S1 的 XRD 谱中没有任何应变弛豫的迹象。样品 S2 的 XRD 谱更难拟合。图 5b 显示了由 5.8% 的均匀 GaAsBi 层建模的数据,由 HAADF-STEM 分析确定,忽略富含 Bi 的簇,以及通过拟合 XRD 曲线确定的 6% 的 GaAsBi 层松弛;如果簇与 GaAsBi 矩阵的其余部分不相干,这将是合理的。这个模型不能准确地表示层;虽然衬底-GaAsBi 分裂足以解释数据,但在~ 250°弧秒处看不到拉伸GaAs峰。 GaAs 拉伸峰表明层内发生了松弛。压缩层的松弛将降低面外晶格常数,这意味着 5.8% 的模拟平均 Bi 含量低估了实际平均值;这与在层中观察到的富含 Bi 的簇是一致的。通过倒易空间映射(未显示)没有观察到对应于 ~ 22-35% GaAsBi 的峰(s),这表明簇可能与 GaAsBi 矩阵不相干。没有尝试对 S2 XRD 光谱进行进一步建模。
<图片>
样品 S1 (a) 的 X 射线衍射数据(蓝线)和模拟拟合(橙线) ) 和样本 S2 (b )。垂直虚线突出显示 0°弧秒处的 GaAs 峰和位于负弧秒处的 GaAsBi 膜峰。图 5b 中右侧 GaAs 峰的肩部表示处于拉伸应变下的 GaAs 帽层
结论
ac-HAADF-STEM 分析提供了关于 GaAs/GaAsBi/GaAs 异质结构的结构和组成的有用信息,结果与 EDX、FFT 和 XRD 研究非常一致。对低倍率 HAADF-STEM 图像的分析允许检测不均匀的 Bi 分布和非突变的 GaAsBi/GaAs 界面。在高放大倍数下,qHAADF 分析显示在低 Bi 通量 (S1) 下 GaAsBi/GaAs 界面出现明显的 Bi 偏析,并且由于 V 族子网中 Bi 原子的 As 取代位置,Bi 含量较高的区域出现了扭曲的哑铃形状.在较高的 Bi 通量 (S2) 下,Bi 聚集的尺寸增加,导致大致等轴的簇均匀分散在整个矩阵和界面周围。该研究揭示了所研究的团簇 rh-Bi 和闪锌矿剪切 {111} 面中两种不同结晶相的共存,影响局部晶格弛豫并导致部分弛豫的 GaAsBi/GaAs 系统,与 XRD 分析非常一致。
缩写
- Ac-HAADF-STEM:
-
像差校正大角度环形暗场扫描透射电子显微镜
- EDX:
-
能量色散X射线
- 鳗鱼:
-
电子能量损失谱
- ESR:
-
常规电子自旋共振
- FEG:
-
冷场发射枪
- FFT:
-
傅里叶快速变换
- HRTEM:
-
高分辨透射电子显微镜
- IMEYMAT:
-
Instituto Universitario de Investigación en Microscopía Electrónica y Materiales
- MBE:
-
分子束外延
- qHAADF:
-
定量HAADF图像分析算法
- SEM:
-
扫描电子显微镜
- XAS:
-
X射线吸收光谱
- XRD:
-
X射线衍射
纳米材料


