按比例缩小的 c-Si 和 c-SiGe Wagon-Wheels,用于可视化湿化学蚀刻剂的各向异性和选择性
摘要
湿法蚀刻提供了一种优势,它是一种柔软、无损伤的方法,可以以接近纳米的精度去除牺牲材料,这对于纳米结构的制造至关重要。为了开发这种湿蚀刻溶液,筛选蚀刻剂特性(如选择性和(非)各向同性)变得至关重要。由于这些蚀刻剂通常具有低蚀刻速率,因此需要敏感的测试结构来评估它们的蚀刻行为。因此,制造了按比例缩小的单晶 Si (c-Si) 和 SiGe (c-SiGe) 车轮。首先,证明了 c-Si 车轮检测结晶硅在碱性蚀刻剂 TMAH 和 NH4OH 中的各向异性行为的敏感性。在各向异性湿蚀刻后,通过自上而下的扫描电子显微镜 (SEM) 观察到每个材料/蚀刻剂对的独特车轮图案。对于 Si(100) 和 Si(110) 衬底,获得了与晶体平面相关的蚀刻速率的类似趋势。其次,对 c-Si 和 c-Si75Ge25 车轮在典型的选择性蚀刻剂过氧乙酸 (PAA) 中的蚀刻进行了评估。 PAA 中的 c-Si75Ge25 蚀刻导致各向同性蚀刻。选择性值的计算基于两种方法:第一种方法是测量车轮辐条的侧壁损失,第二种方法是间接方法,通过测量辐条回缩长度。两种方法都给出了可比较的值,但后一种方法只能在一定的临界蚀刻时间后使用,此后辐条尖端已演变为尖端。
介绍
传统上,集成电路半导体器件上晶体管密度的逐渐增加是通过缩小节点尺寸来实现的。这在技术和经济上不再可持续。因此,引入了新的场效应晶体管 (FET) 架构,如 Fin-FET 和环栅 GAA-FET [1,2,3]。后者提供优于前者的优势,因为它的门可以更准确地调谐频道 [4]。用于制造最先进的 FET 晶体管和存储单元中使用的这些复杂 3D 特征的某些工艺需要极具选择性和各向同性的蚀刻剂 [5, 6]。
为了制造包含一根或多根垂直堆叠的水平晶体纳米线的 GAA 架构,需要对牺牲晶体外延层进行非常有选择性和各向同性的蚀刻。例如,对于Si纳米线的释放,需要使用SixGe1-x蚀刻剂使Si纳米线完好无损。
因此,筛选和了解蚀刻剂的特性变得至关重要。在覆盖膜上筛选蚀刻剂无法提供关于材料/蚀刻剂对的(非)各向同性的可靠信息。各向异性的可视化非常重要,因为由于横向沟槽中形成缓慢蚀刻或所谓的“阻挡”平面,晶体牺牲层的蚀刻可能会延迟甚至停止。各向异性也被广泛研究用于微机电结构 (MEMS) 的制造 [7, 8] 和太阳能应用中 Si 的表面纹理化 [9,10,11]。
原则上,已经使用了两种实验方法,两者都产生了作为 Si 结晶方向函数的蚀刻速率。首先,蚀刻直径为几毫米的硅球或半球;各向异性导致小平面形成,一旦量化,就会产生不同晶面的蚀刻速率 [12,13,14]。在第二种也是最普遍的方法中,硅辐条或沟槽以径向方式在晶片上形成图案,从而形成所谓的车轮形状 [15, 16]。后一种方法的优势在于,在一次湿法蚀刻实验中可以探测到许多晶面及其放大效应。在各向异性湿蚀刻期间,辐条的尖端将以与车轮辐条侧壁的蚀刻速率成正比的速率缩回,后者是感兴趣的蚀刻速率。由于辐条的几何形状,辐条尖端的回缩速度明显高于侧壁的实际蚀刻速率。因此,这种相对较大的缩回长度比辐条的小侧壁变薄更容易可视化和量化。放大系数取决于车轮中辐条的几何布置。具有更多辐条并因此具有更小角度的车轮具有更大的放大系数。文献 [15,16,17,18] 中描述的车轮具有厘米大小的直径,通常可容纳 180 个角宽度和间距为 1° 的辐条,导致放大系数为 115。对于大多数应用,高蚀刻速率是想要的;因此,大多数作者研究了在相对热(~ 60-80°C)和相对浓缩(~ 12-25 wt.%)碱性 TMAH 和 KOH 溶液中硅的各向异性蚀刻。然而,人们对低浓度碱性溶液中的各向异性蚀刻知之甚少,在低温下甚至更少。此外,大多数情况下,在最先进的互补金属氧化物半导体 (CMOS) 应用中,在纳米尺寸结构的制造过程中只需要对半导体材料进行纳米去除。因此,对于超大规模集成 (VLSI) 中使用的大多数湿蚀刻工艺,需要低得多的湿蚀刻速率,在几纳米/分钟的范围内。因此,我们建议对上一代车轮进行小型化。
在这项工作中,不仅制造了按比例缩小的 c-Si,而且还制造了 c-SiGe 车轮。因此,可以同时高精度地评估蚀刻剂的各向同性和选择性要求。由于车轮技术的主要资产仍然是确定材料/蚀刻剂对的各向异性程度,我们首先将我们的结果与先前研究中在厘米大小的车轮上获得的结果进行基准测试。然后,我们将说明该技术在开发选择性和各向同性蚀刻剂中的应用,特别是针对 c-Si75Ge25 相对于 c-Si 的选择性蚀刻。
实验/方法
货车车轮设计
选择马车车轮的尺寸是为了观察纳米 -范围侧壁损失导致 sub -微米 缩回长度。车轮尺寸基于以下三个边界之间的平衡:
- 1.
光刻技术对最小临界尺寸 (CD) 设置了约束,即车轮(内)辐条宽度。
- 2.
成像技术定义了最大实用视场 (FoV),从而定义了最大车轮直径。
- 3.
圆形车轮花纹中可以排列的最大辐条数,或相应的最小辐条楔角,定义了最大放大系数。
考虑到这一点,内部辐条宽度设置为 90 nm (CD),车轮直径设置为 3.8 μm (FoV),32 个辐条以圆形图案排列。这种车轮设计导致辐条角为 5.6°,放大系数约为 20。为此设计了专用掩模(图 1a)。这些尺寸与 Wind 等人先前制造的车轮的尺寸进行了比较。 (见表 1)。车轮在垂直和水平方向上对齐,间距为 3.9 μm,在两个车轮之间留出 100 nm 的空间(图 1b)。这些车轮的制造将在下一节中描述。
<图片>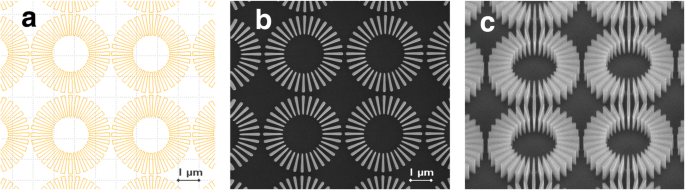
面罩上设计的车轮 (a ) 和纳米加工过程后:顶视图 SEM (b ), 倾斜视图 SEM (c )
货车车轮制造
晶体硅 (c-Si) 车轮在标准 p 型(B 掺杂,1-100 欧姆厘米)300 毫米 Si(100)和 Si(110)晶片上制造。图案化工艺包括沉积硬掩模堆栈,该堆栈由(从上到下)30 nm 氮化硅、160 nm 非晶碳 (APF)、20 nm 氮化硅和 30 nm 非晶硅组成。使用 193 nm 浸没式光刻将图案转移到光刻胶中。光刻胶显影后,使用包括光刻胶和 APF 条的等离子蚀刻法蚀刻车轮图案。硬掩模叠层的底层,即 SiN 层,使用热磷酸(6 分钟 85 重量% H3PO4,160°C)或氢氟酸(5 分钟 10 重量% HF)去除。图 1c 显示了制造的车轮的倾斜 SEM 视图。
晶体硅锗车轮 (c-Si75Ge25) 也在标准 p 型(B 掺杂,1-100 欧姆厘米)300 毫米 Si(100)或 Si(110)晶片上制造。在图案化之前,外延沉积大约 600 nm 的未掺杂 Si75Ge25 层。在此之后,遵循与 Si 车轮相同的图案化步骤,产生 c-Si75Ge25 车轮辐条。
(An)各向同性湿蚀刻实验
在(非)各向同性湿法蚀刻测试之前,进行 SPM 清洁(60 °C 下 5 分钟 H2SO4:H2O2 3:1),旨在去除有机残留物,然后在此过程中去除氧化层在 1 wt.% HF 水溶液中浸泡 2 分钟。在 SPM 和 HF 清洁过程之后,立即通过将测试图案置于室温 (RT) 下未搅拌的蚀刻剂样品中来测定蚀刻剂的各向异性。通过稀释 25 wt.% TMAH 或 29 wt.% NH4OH 来制备 TMAH 和 NH4OH 蚀刻剂溶液。通过混合 9.5 份 H2O2 (30 wt.%)、11 份乙酸 (98 wt.%) 和 0.1 份 HF (49 wt.%) 制备过乙酸 (PAA) 溶液。已知这种蚀刻溶液可以在纯 Si 上选择性地蚀刻 SixGe1-x 合金 [19, 20]。 PAA 作为 SiGe 蚀刻的氧化物质,是通过乙酸与过氧化物以 HF 作为催化剂反应形成的。但是,达到平衡需要一定的时间;因此,溶液老化 1 周。蚀刻剂各向异性和选择性是通过将测试图案置于室温下未搅拌的蚀刻剂样品中来测定的。蚀刻后立即用去离子水冲洗样品 30 s,然后用氮气干燥。
结果与讨论
在 TMAH 中 c-Si(100) 和 c-Si(110) 货车车轮的各向异性蚀刻
当在 Si(100) 晶片上制造的硅车轮在 RT 中用低浓度 TMAH (5 wt.%) 蚀刻时,可以进行以下观察(图 2):首先,Si 的特征四重对称性(100) 晶片通过车轮的各向异性蚀刻显露出来。其次,可以直观地推断出不同晶面的取向相关蚀刻速率:车轮的相对较快的蚀刻轮辐由 {110} 和邻位 {110} 侧壁平面定义,而较慢的蚀刻轮辐由下式定义{100} 和邻近的 {100} 侧壁平面。除了这个主要观察结果,低浓度和 RT TMAH 中 Si 的蚀刻速率顺序遵循 R (110)> R (100),可以看出其他各向异性效应:例如,对应于四个 {110} 平面的四个轮辐不是蚀刻速度最快的轮辐,更准确地说,是这些 {110} 平面的两个相邻轮辐.因此,{110} 附近的蚀刻速率被分成两个等效的最大值,并且 {110} 平面是局部最小值。这对应于 [21,22,23] 的类似观察,其中 {110} 面的较低蚀刻速率归因于 TMA + 的阻挡效应 离子。
<图片>
一 在 RT 和放大 (b ) 显示了更快蚀刻 {110} 平面/面的发展,如虚线所示
各向异性蚀刻的另一个结果是四个 {100} 辐条的外辐条末端的特定形状。众所周知,最快 蚀刻平面将显示为凸面。最初,辐条末端是凸面,因此经过一定的蚀刻时间后,显示出较快的蚀刻 {110} 平面,在外辐条末端形成小平面。这对于沿 <100> 方向的辐条最为明显(图 2 的放大 b)。
对于凹面 然而,表面上最慢 蚀刻平面将显露出来。在车轮辐条的蚀刻过程中,围绕辐条的 Si(100) 基板也被蚀刻。这种基底-衬底过渡是一个凹面;因此,应该显示最慢的蚀刻平面,即 {111} 平面。对于 Si(100) 衬底,这些 {111} 平面看起来与 <110> 方向对齐。事实上,从图 3b 中可以看出,{111} 面在 TMAH 中蚀刻后显露出来,形成了一个带有倾斜 {111} 面的基底,所有辐条沿 <110> 方向。
<图片>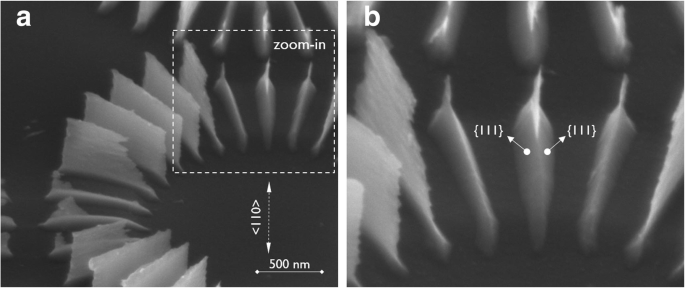
一 在 RT 和放大 (b) 中用低浓度 TMAH (5 wt.%) 蚀刻的 Si(100) 车轮的倾斜 SEM 图像 ) 显示倾斜的 {111} 平面
与 Si(100) 车轮类似,Si(110) 车轮在室温下用低浓度 TMAH (5 wt.%) 蚀刻。与 Si(100) 晶片的四重对称性不同,Si(110) 的双重对称性被揭示出来。一些 {100}、{110}、{111} 和 {211} 平面的晶体取向在图 4a 中指定。使用 Si(110) 基板评估各向异性的好处之一是存在垂直 {111} 平面,其由车轮的 {111} 轮辐的侧壁表示。从图 4 中可以看出,这些是最慢的蚀刻平面。最快的蚀刻平面似乎是 {110} 和 {211} 平面。 {100} 平面具有中等蚀刻速率。因此,R (110) ~ R (211)> R (100)> R (111), 与在 Si(100) 上获得的结果一致。
<图片>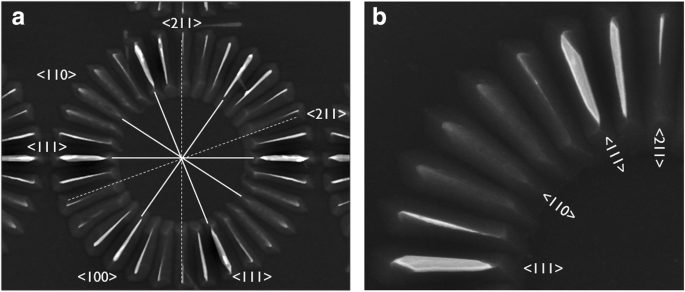
一 在 RT 和放大 (b) 中用低浓度 TMAH (5 wt.%) 蚀刻的 Si(110) 车轮的 TD-SEM ) 显示了面向 <111> 的辐条上的刻面形成。主要晶向(或等效面)用实线表示,高折射率面用虚线表示
在图 4b 中可以看出,蚀刻最慢的 {111} 辐条的末端从圆形演变为箭头状,形成不对称的平行四边形。形成这些面的根本原因是 {110} 和 {211} 面的蚀刻速度更快。
TMAH 和 TMAH/IPA 混合物是经过充分研究的常用蚀刻剂,用于制造需要高蚀刻速率和各向异性调整的 MEMS 结构。因此,大多数关于 TMAH 中 Si 蚀刻的研究都是在更高的温度和浓度下进行的。典型浓度范围为 10 至 25 wt.% TMAH,温度范围为 60 至 90 °C [12,13,14,23]。一些研究小组在 5 wt.% 左右的低浓度下进行了蚀刻测试,就像我们的工作一样,但他们仍然使用 60-90 °C 的高温 [24,25,26]。 R (110)/R (100) 比率对于高浓度和高温通常约为 2,并且似乎随着降低而增加 TMAH 温度(附加文件 1:S1)。由于这项研究侧重于纳米级蚀刻应用,因此不追求高蚀刻速率。因此,选择低 (RT) 温度是为了有一个可接受的时间窗口来观察蚀刻现象并避免结构完全溶解。相同的速度顺序,R (110)> R (100),在本研究中观察到,在 RT 和 5 wt.% TMAH 下完成,但 R 的计算值 (110)/R (100) 比率远高于 2(另见参考文献 [27])。因此,这证实了该各向异性比率随着减小而增加的趋势 TMAH 温度。对这一观察的详细机械解释,包括动力学和原子方面,超出了这项工作的范围。然而,基于以上对 TMAH 中硅蚀刻的比较,可以得出结论,按比例缩小的车轮提供了检测和比较蚀刻剂各向异性行为所需的灵敏度。
在 NH4OH 中 c-Si(100) 和 c-Si(110) 货车车轮的各向异性蚀刻
Si(100) 车轮和 Si(110) 车轮在室温下在低浓度 (0.4 wt.%) 氢氧化铵 (NH4OH) 中蚀刻。在前者(图 5,左)中,揭示了 Si(100) 晶片的四重对称性。很明显,沿 <210> 和 <310> 方向的辐条,理论上与 <110> 方向成 18.4° 和 26.6°,最好由第三个辐条表示(从顶部“北”辐条开始计数) ) 侧壁为 19.7° 和 25.3°,是蚀刻速度最快的辐条。与 {100} 相比,{110} 辐条的蚀刻速度较慢,并且在这些辐条的外端会形成刻面。这些小平面可能是快速蚀刻的 {210} 和 {310} 平面,并且可能有助于 {110} 辐条的整体表观蚀刻速率更快,尤其是对于更长的蚀刻时间。因此,观察到的蚀刻速率遵循 R (310) ~ R (210)> R (100) ~ R (110)。
<图片>
在室温下在低浓度 NH4OH (0.4 wt.%) 中蚀刻的 Si(100)(左)和 Si(110) 车轮(右)的 TD SEM 图像。具体的晶向用 [ ] 表示,一系列等价的方向用 <> 表示。主要晶向(或等效面)用实线表示,高折射率面用虚线表示
对于 Si(110) 车轮(图 5,右),围绕(100)和(110)平面的双重对称性通过在 NH4OH 中的各向异性蚀刻显示出来。沿 <111> 方向的辐条,带有 {111} 侧壁,表现为蚀刻最慢的辐条或平面。最快的蚀刻辐条由高指数 {211} 和 {311} 平面定义。 {110} 和 {100} 具有中等蚀刻速率。因此,Si(110) 结果与 NH4OH 中的 Si(100) 结果一致。同样对于 Si(110) 车轮,辐条的刻面很明显,尤其是在 {111} 和 {100} 辐条的外端。刻面可能是更快蚀刻{211}和{311}平面的发展。
在文献中,关于 NH4OH 的蚀刻速率各向异性的信息有限。然而,NH4OH 的水溶液也被用作各向异性蚀刻剂 [28],具有与其他 OH - 相似的特性 含硅蚀刻剂。好处是它不含金属(如 K + , Na + , Cs + ,……)。因此,NH4OH 是一种值得研究的 IC 兼容蚀刻剂。施纳肯伯格等人。表明 R (111)/R (100) 在 75 °C 下用 3.7 wt.% NH4OH 蚀刻的车轮型蚀刻图案的蚀刻速率比约为 0.04,R (110)/R (100) 蚀刻速率比 0.3 [28]。后面的结果与我们估计的 R 蚀刻速率比为 0.5 比较好 (110)/R (100)。
根据我们的结果,很明显,与 TMAH 相比,在 NH4OH 中蚀刻 Si 会产生不同的车轮蚀刻图案。虽然 [OH − ] 对于两种蚀刻溶液(~ 0.12 M 与~ 0.55 M),TMAH 和 NH4OH 中的蚀刻均在相同温度 (RT) 下进行。唯一剩下的区别是反阳离子:体积更大的 (CH3)4N + 与较小的 NH4 + 相比 阳离子。已经指出蚀刻剂溶液中的阳离子可以粘附在表面上,从而选择性地阻挡与不同蚀刻平面相关的不同羟基封端的 Si 表面位点 [29, 30]。每当不同平面的蚀刻速率受到不同影响时,各向异性就会发生变化。
Si75Ge25 朝向 Si 的选择性蚀刻
在本节中,我们将展示和讨论按比例缩小的车轮在评估蚀刻速率和蚀刻剂选择性方面的潜力。 Si/Si75Ge25 对被选为模型系统,因为它代表了 GAA 结构的形成,其中牺牲 c-Si75Ge25 夹层应该各向同性地并且选择性地朝向 c-Si 纳米线蚀刻。蚀刻在由 HF、H2O2 和 CH3COOH 的混合物制备的选择性蚀刻剂中进行。众所周知,由于过氧化物和乙酸之间的酸催化反应,该混合物将形成过乙酸 (CH3CO3H) [31, 32]。经过一定的老化时间后,达到平衡浓度。如此形成的 PAA 是 Si75Ge25 的有效且选择性的氧化剂。 SiGe选择性氧化后,SiGe氧化物将在第二次扩散限制反应中被HF溶解。
将 c-Si75Ge25 车轮样品浸入 PAA 溶液中以增加时间 (t 0+ 30 秒、+ 60 秒、...+ 180 秒),并且车轮辐条的蚀刻通过随后的自上而下的 SEM 测量进行监测。如果辐条的宽度不小于 10 nm,则可以通过我们的传统 SEM 可靠地测量辐条的宽度。结果显示在图 6 中的时间序列中。最初,车轮辐条由于侧壁蚀刻而变薄。所有 Si75Ge25 辐条均等量减薄,证明蚀刻是各向同性的。大约 90 秒后,辐条尖端开始缩回,表明放大效应开始。我们观察到这种放大效应只有在辐条尖端进化为尖锐尖端后才开始显现出来。在 t 0,辐条的尖端仍然是圆形的。由于在辐条的初始蚀刻阶段逐渐收敛的侧壁 (t <90 s),圆形尖端转变为仅尖锐的尖端,辐条开始缩回(另请参见附加文件 1:S2)。这个发现清楚地说明了 t 处的车轮辐条形状 =180 s:由于尖端回缩,大约一半的辐条被蚀刻(Δl 大约为 450 nm)。然而,仍然有一些 SiGe 剩余,至少在辐条的最宽端,因为侧壁仅在两侧缩回了 Δw~Δl/20 =22.5 nm。因此,在临界时间 (t 暴击 ),回缩长度 (Δl) 可用于间接计算 Si75Ge25 辐条的蚀刻速率。然而,在此之前t 暴击 ,蚀刻速率只能通过难以测量的侧壁损失(Δw)的直接测量来计算。通过直接测量侧壁损耗和间接测量辐条收缩获得的 PAA 中 Si 和 SiGe 的蚀刻速率的比较如表 2 所示。蚀刻速率由侧壁宽度随时间减小的斜率和随时间增加的辐条收缩长度的斜率。后一个斜率是使用 t 之后的数据点计算的 暴击 如图 7 所示。侧壁宽度似乎呈线性减小,至少到我们传统 SEM 观察的极限,即下降到大约 10 nm。直到这些特征尺寸,在辐条逐渐变薄的过程中,我们没有观察到蚀刻速率的任何显着变化(图 7 和图 9)。
<图片>
PAA溶液中Si75Ge25(100)车轮的蚀刻时间序列
<图片>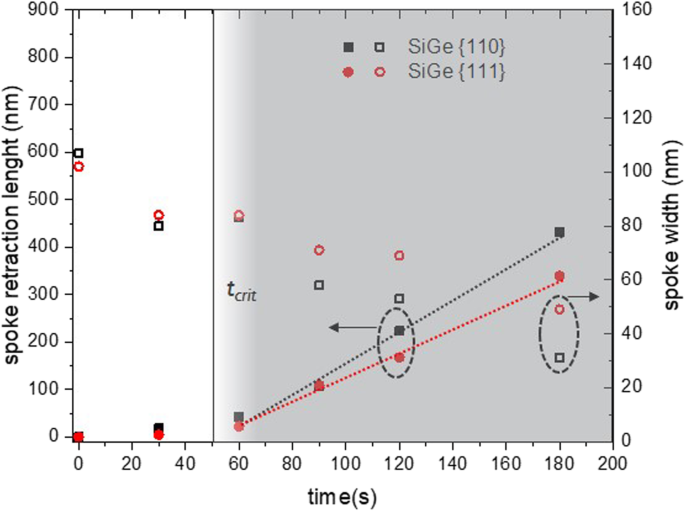
Si75Ge25 辐条的蚀刻:辐条宽度逐渐减小,但只有在一定的 tcrit. 后,辐条尖端才开始回缩,测量的回缩长度 Si75Ge25 可以线性拟合 a.f.o.蚀刻时间(灰色阴影区域)
除了获得 SiGe 蚀刻剂的蚀刻速率外,我们还验证了蚀刻剂的各向同性行为。很明显,所有不同取向的辐条都以相同的蚀刻速率进行蚀刻,即各向同性。因此,这指向一个过程,其反应速率由氧化物溶解速率而不是由 Si75Ge25 氧化速率控制。氧化物溶解受扩散限制,活化能低,不易发生各向异性行为。
在 c-Si75Ge25(100) 车轮上获得的结果用 c-Si75Ge25(110) 车轮进行了验证。就像对硅车轮的解释一样,使用 (110) 衬底的一个好处是额外存在垂直 {111} 平面,由车轮的 {111} 轮辐的侧壁表示。这些通常是最慢的蚀刻平面/辐条;因此,要获得 Si75Ge25-PAA 蚀刻剂对的各向异性的完整图像,必须仔细观察这些辐条。结果(参见附加文件 1:S3.1)与使用 Si75Ge25 (100) 车轮获得的蚀刻结果一致(图 6)。蚀刻逐渐进行,首先是变薄,然后是辐条尖端缩回。在最长蚀刻时间 (t =180 秒)。然而,由于没有明确的趋势,即 Δl 的特定角度依赖性,这不归因于各向异性。我们将此归因于制造后辐条宽度的较大变化(辐条间和辐条内)。事实上,它已经可以在参考图片中看到 (t 0) 侧壁不是完全笔直的。这种侧壁粗糙度可能是由于 (110) 衬底上外延沉积的 Si75Ge25 层的弛豫缺陷造成的。总之,c-Si75Ge25 (100) 和 (110) 车轮在 PAA 溶液中各向同性地蚀刻,有利于快速彻底去除用作牺牲材料的 c-Si75Ge25,因为它不会倾向于形成任何阻塞平面。
对 c-Si 车轮重复在 PAA 中进行湿蚀刻。这些测试的目的是验证蚀刻剂溶液对硅的选择性。将样品浸入相同的 PAA 溶液中以增加时间 (t 0+ 15 分钟,+ 30 分钟,...+ 90 分钟)。请注意,蚀刻时间以分钟为单位 而不是像 Si75Ge25 车轮那样在几秒钟内。这些延长的蚀刻时间旨在观察任何 Si 蚀刻,即使该蚀刻剂的目的是保护硅。
尽管蚀刻时间不同,但对 Si75Ge25 车轮辐条进行了类似的观察:最初,硅辐条由于侧壁蚀刻相对缓慢而逐渐变薄,然后一段时间后,t 暴击 ,在这种情况下,大约 45 分钟后,由于放大效应,辐条开始相对较快地缩回(图 8 和 9)。在所有情况下,蚀刻似乎是各向同性的。使用 c-Si(100) 车轮获得的时间序列(参见附加文件 1:S3.2)与使用 c-Si(110) 车轮获得的时间序列一致(图 8)。
<图片>
在 PAA 溶液中蚀刻 Si(110) 车轮的时间序列。注意 <111> 辐条的蚀刻速率与其他方向相比稍慢,在图像 t 中最明显 0+ 90分钟,用虚线表示
<图片>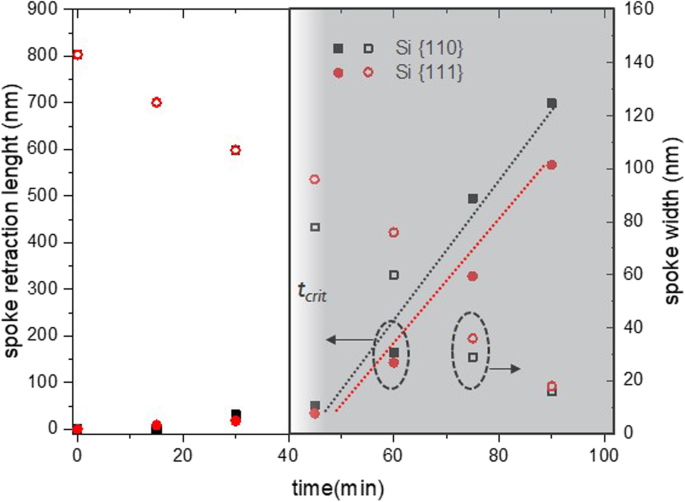
Si 辐条的蚀刻:辐条宽度逐渐减小,但只有在一定的 tcrit. 后,辐条尖端才开始回缩,并且测量的回缩长度可以线性拟合 a.f.o.蚀刻时间(灰色阴影区域)
计算出的蚀刻速率如表 2 所示。两种测量方法给出的蚀刻速率相当,{111} 和 {110} 平面的蚀刻速率值分别只有 7% 和 4% 的差异。 Si蚀刻速率的值均<1 nm/min。霍兰德等人。使用 HF:H2O2:CH3COOH 1:2:3 和 HF 浓度为 1.6 wt.% 和 Wieser 等人测量的 Si(100) 蚀刻速率为 ~ 10 nm/min。使用 BHF:H2O2:CH3COOH 1:2:3 溶液,HF 浓度为 1 wt.% [33, 34] . Our values compare well with those reported values, considering that the HF concentration in our tests are lower ([HF] =0.25 wt.%). Our results also suggest a slightly lower etching rate of the {111} planes, measured on Si(110) substrates, compared to the {110} planes, measured on Si(100) substrates. These quantitative results point toward a very low etching anisotropy of Si in PAA which is hardly observable by the top-down SEM images. For the sake of clarity, the {111} planes of the wagon-wheel at t 0+ 90 min in Fig. 8 are indicated and it can be noticed that the {111} spokes are slightly broader and longer than the surrounding spokes. This demonstrates again that these scaled-down wagon-wheels are sensitive to detect very faint differences in the crystallographic plane-dependent etch rates (‘anisotropy’) of etchants.
The selectivity ratios of the Si75Ge25/Si pair in PAA were extracted from the etching rates in Table 2. The selectivity ratios of Si75Ge25(111)/Si(111) range between 11.0 and 12.6 while the Si75Ge25(110)/Si(110) ratios are slightly higher, between 14.2 and 16.8. These values are slightly lower than the reported values from Holländer et al. who claim selectivities around ~ 20 [33]. This can be attributed to the higher SiGe etch rates (11–17 nm/min) due to the dynamic process conditions (wafer rotation) in contrast to our static process conditions (no stirring) in which case the SiGe etch rates were ranging between 7.8 and 12.3 nm/min. Interestingly, this confirms the observed isotropic etching of SiGe in PAA:since the reaction rate is kinetically controlled (by stirring or rotation), the rate determining step (RDS) is most probably the diffusion controlled SiGe-oxide dissolution by HF.
结论
Scaled-down wagon-wheels with a diameter of 4 μm and 32 spokes exposing the different crystallographic planes were fabricated on 300-mm-diameter wafers. The structures were patterned on Si(100), Si(110), Si75Ge25(100), and Si75Ge25(110) substrates allowing the observation of the etching of the three main crystallographic orientations of c-Si and c-Si75Ge25 ({111}, {110}, and {100}) as well as higher index planes. The structures proved to be valuable for the evaluation of the isotropic or anisotropic behavior of etchants by simple inspection by TD SEM. Various alkaline as well as acidic etchants were evaluated by image analysis of their characteristic wagon-wheel etching pattern. Trends in etching ratios were in good agreement with previous works. In TMAH, the plane-dependent etching rate of silicon follows the order:R (110) ~ R (211)> R (100)> R (111)。 In NH4OH, on the other hand, the etching rate follows the order:R (310) ~ R (210)> R (100) ~ R (110)> R (111)。 Besides the relative etching rates of the main crystallographic planes, other anisotropic features, like facets, were observed, indicating that the structures are very sensitive to changes in the anisotropic properties of the etchant.
In addition to their capacity for the revelation of the (an)isotropy of etchants, these wagon-wheel structures also demonstrate their benefit for the assessment of the selectivity of etchants. For this purpose, the system PAA/Si/Si75Ge25 was assessed in terms of Si75Ge25 etching, selective toward Si. Selectivity values were obtained by two methods:the first by measurement of the sidewall loss of the spokes; the second, indirect method, through measurement of the spoke retraction lengths. It was shown that the latter method could only be used after a certain critical etching time, after which the spoke tips have evolved toward a seemingly sharp tip.
In conclusion, scaled-down wagon-wheels can be used as lab-scale vehicles for the swift evaluation of anisotropy and selectivity of material/etchant pairs. The structures also have the potential to be used as high-throughput short loop test structures for the screening of etchants on 300 mm wafer wet processing tools. In addition, due to their small size, these wagon-wheels could be used for future in-situ etching studies, using liquid cell environmental electron transmission microscopy ETEM.
数据和材料的可用性
All data are fully available without restriction.
缩写
- AA:
-
acetic acid
- BHF:
-
buffered hydrofluoric acid
- CD:
-
critical Dimension
- CMOS:
-
complementary metal oxide semiconductor
- c-Si:
-
single-crystalline silicon
- c-SiGe:
-
single-crystalline silicon-germanium
- ETEM:
-
environmental electron transmission microscopy
- FinFET:
-
fin field effect transistor
- FoV:
-
field of view
- GAA:
-
gate all around
- HF:
-
hydrofluoric acid
- MEMS:
-
microelectromechanical systems
- PAA:
-
peracetic acid
- R (xyz) :
-
etch rate of a (xyz) plane
- RDS:
-
rate determining step
- SEM:
-
scanning electron microscopy
- TMAH:
-
tetramethyl ammonium hydroxide
- VLSI:
-
very large-scale integration
纳米材料


