Si、Ge 和 Si/Ge 超晶格对低能辐射的辐射响应的理论模拟
摘要
在这项研究中,通过从头分子动力学方法研究了 Si、Ge 和 Si/Ge 超晶格的低能辐射响应,并探讨了它们不同辐射行为的起源。研究发现,Si/Ge 超晶格界面周围的 Ge 原子的抗辐射能力与块体 Ge 相当,而界面周围的 Si 原子比块体 Si 更难移位,显示出增强的辐射耐受性与体硅相比。体结构和超晶格结构中缺陷产生的机制表现出略有不同的特征,超晶格中的相关缺陷更为复杂。缺陷形成和迁移计算表明,在超晶格结构中,点缺陷更难形成,空位移动性较差。 Si/Ge超晶格增强的辐射耐受性将有利于其在辐射环境下作为电子和光电器件的应用。
背景
在过去的几十年中,Si/Ge 超晶格 (SL) 因其对开发新型电子和光电器件的潜在贡献而在半导体研究中引起了广泛关注 [1,2,3,4,5,6]。例如,Si/Ge SL 的光电导性研究对于作为快速光通信的发射器和接收器的光电二极管具有显着的重要性 [5]。在空间电子元件、微电子元件、太阳能电池和空间电子学等应用中 [1, 4, 6],Si/Ge SL 的光学和电子特性可能会由于高-来自空间环境的能量离子,导致电子设备的性能下降。因此,有必要研究这种半导体材料在极端工作条件下的辐射响应。
近来,大量研究人员对Si/Ge超晶格的辐射损伤效应进行了研究[7,8,9,10,11,12,13,14,15,16]。索博列夫等人。研究了电子辐照对包含纯 Ge 单层的 Si/Ge SL 的光致发光 (PL) 的影响,并发现与体硅相比,SL 结构的耐辐射性增强 [12]。丰塞卡等。使用 2.0 MeV 质子辐照用嵌入的 Ge 量子点 (QD) 辐照 Si/Ge SL,发现 QD-in-SL 结构具有非凡的高抗辐射性 [13]。 Leitão 等人获得了类似的结果,他们报告说,与单个 Ge QW 相比,沉积在包含 Si/Ge 多层结构的二极管结构上的 Ge 量子阱 (QW) 对质子辐射的抵抗力更强 [14]。作为有前景的热电材料,Si/Ge 系统的热电特性也可能在辐射环境下受到影响 [11, 15]。郑等人。辐照Si1 − x 的多个周期性层 葛x /Si 采用 5 MeV Si 离子,他们发现热电品质因数随着 Si 离子通量的增加而增加 [11]。缺陷和结构无序通过沿晶格吸收和消散声子来降低交叉平面热导率,QD结构微带中的电子态密度增加了电导率和塞贝克系数,这些都有助于增加功劳[11]。
从理论上讲,Sayed 和 Windl 都使用经典分子动力学 (MD) 方法研究了块体 Si 的原子位移 [17, 18]。他们发现阈值位移能 (Eds) 取决于撞击方向,损坏状态主要是 Frenkel 对 (FP) 缺陷 [17, 18]。卡特拉等人。使用 MD 方法研究了离子质量和能量对体硅辐射损伤的影响 [19]。他们报告说,非晶化的产生以及孤立的点缺陷和小团簇对离子质量有很强的依赖性,而与离子能量的关系很弱 [19]。霍姆斯特伦等。使用 MD 方法计算锗的 Eds,发现稳定缺陷是 FP 缺陷 [20]。肖等人。应用 ab initio 方法研究锑和锗缺陷对 Si/Ge 异质结构的电子结构的影响,发现这些缺陷与 Si/Ge 界面相互作用,导致与界面相关的局部共振和对电子的大局部扰动结构 [21]。尽管进行了这些研究,但迄今为止,文献中还没有关于 Si/Ge SL 辐射损伤动态过程的理论模拟。对半导体超晶格中的微观结构演化和缺陷产生的潜在机制仍然缺乏原子级的理解。
从头分子动力学 (AIMD) 方法已被证明是揭示辐射损伤过程的重要工具,并且确实成功地模拟了一系列半导体和陶瓷材料的反冲事件 [22,23,24, 25,26,27]。与经典的 MD 方法相比,原子间势是通过电子结构计算而不是实验结果的经验拟合获得的。因此,可以从头算精度确定许多物理参数,如 Eds。在本研究中,AIMD 方法用于比较体硅、Ge 和 Si/Ge SL 在低能辐照下的响应行为。已经确定了阈值位移能量,并且已经提供了缺陷分布和缺陷产生的途径。还探讨了体硅 (Ge) 和 Si/Ge SL 之间辐射耐受性差异的可能起源。所提供的结果为深入了解块体Si、Ge和Si/Ge SL中位移事件的微观机制提供了基本见解,并促进了对这些材料在辐射环境下的辐射响应的理解。
方法
块体 Si、Ge 和 Si/Ge SL 的低能量位移事件由西班牙千原子电子模拟倡议 (SIESTA) 代码模拟。采用规范守恒的 Troullier-Matris 赝势 [28] 来确定离子和电子之间的相互作用,交换相关势由 Ceperly-Alder 参数化中的局部密度近似 (LDA) 描述 [29]。价波函数通过局部原子轨道的基组进行扩展,并采用单ζ基组加极化轨道(SZP),在布里渊区的K点采样为1 × 1 × 1,切割- 60 Ry 的关闭能量。在本研究中,考虑了由两层 Si 和两层 Ge 交替组成的 Si2/Ge2 SL,共 288 个原子。图 1 说明了体硅和 Si/Ge SL 的几何配置。一个特定的原子被选为主要的碰撞原子 (PKA),它被赋予动能来引发反冲事件。如果 PKA 在位移事件结束时返回其原始位置,则模拟将以更高的反冲能量重新开始,能量增量为 5 eV。一旦 PKA 从其晶格位置永久移位,就会执行额外的运行以将精度提高到 0.5 eV。对于每种原子类型,分别考虑体硅 (Ge) 和 Si/Ge SL 的四个和五个主要入射方向。模拟采用 NVE 集成进行,每次运行的最大持续时间为 1.2 ps,以避免系统不稳定。
<图片>
a的几何结构示意图 体硅和b 硅/锗超晶格。蓝色和绿色球体分别代表Si和Ge原子
结果与讨论
硅和锗的位移事件
体硅的晶格常数确定为 5.50 Å,这与 5.48 Å [30] 的理论结果和 5.43 Å [31] 的实验结果非常吻合。与块体 Si 相比,块体 Ge 的晶格常数更大,即 5.71 Å,这与 5.65 Å [30] 的计算结果和 5.77 Å [31] 的实验值一致。我们为体硅和锗计算的阈值位移能量以及位移事件后的相关缺陷总结在表 1 中。 Si 和 Ge 反冲的损坏终止状态的配置绘制在图 3 和图 5 中。分别为 2 和 3。
<图片>
一 –d 反冲事件后损伤Si的几何结构示意图。绿色和红色球体分别代表空位和间隙缺陷。 VSi:硅空位; Siint:硅间隙
<图片>
一 –d 反冲事件后损伤Ge的几何结构示意图。红色和蓝色球体分别代表空位和间隙缺陷。 VGe:锗空位; Geint:锗间隙
对于体硅,E d 值略小于 [001] [32] 的 21 eV、[110] [33] 的 ~ 47.6 eV 和 [111] [34] 方向的 ~ 12.9 eV 的实验结果,以及实验和我们的计算表明,损坏的终态是 Frenkel 对 (FP) 缺陷。还注意到 E 本研究中的 d 值通常与 Windl 等人报告的 MD 结果相当。 [18],除了 [110] 的情况,我们计算出的 47 eV 值远大于 24 eV 的 MD 结果。先前对 SiC 中离子-固体相互作用的 AIMD 模拟表明,位移事件实际上是一个电荷转移过程,往返于反冲原子的电荷转移可以改变能垒和动力学以稳定缺陷形成 [35]。 E 的较低值 AIMD 发现的 d 与经典 MD 确定的相比,可能是由于 AIMD 方法考虑了反冲事件期间发生的电荷转移,而在经典 MD 模拟中,原子的电荷是固定的。在 Windl 等人的研究中,动能被转移到 PKA 以产生一个硅空位 (VSi) 和一个硅间隙 (Siint) 缺陷 [18]。相比之下,在我们的研究中,Si[110] 位移事件的相关缺陷包含两个 VSi 和两个 Siint 缺陷,导致形成损坏态的能量更高。 E Si[111] 和 Si\( \left[\overline{1}\overline{1}\overline{1}\right] \) 的 d 值彼此非常接近,即分别为 9.5 和 10 eV。在这两种情况下,产生的缺陷都是 VSi 和 Siint(见图 2c、d),而缺陷产生的机制表现出不同的特征。在 Si[111] 的情况下,由于排斥相互作用,Si PKA 沿 \( \left[11\overline{1}\right] \) 方向移动并与其相邻的 Si 原子碰撞。然后,Si PKA 散射开,占据一个间隙位点 (Siint),被取代的 Si 移回 PKA 的晶格位点。相关的缺陷是一个 VSi 和一个 Siint 缺陷。对于 Si\( \left[\overline{1}\overline{1}\overline{1}\right] \),位移事件相对简单,即 Si PKA 移动 4.69 Å 远离其晶格位点到形成 Siint 缺陷。在 Si[001] 和 Si[110] 的情况下,Eds 分别确定为 20 和 47 eV,表明 Si 原子更难以沿 [110] 方向位移。 Si[001] 和 Si[110] 的损伤终止状态有些不同。在Si[001]的情况下,PKA接收动能并沿[001]方向移动以与其相邻的原子碰撞。被取代的 Si 原子继续移动并占据间隙位置,如图 2a 所示。至于Si[110],由于PKA与其相邻原子之间的排斥相互作用,PKA向\( \left[11\overline{1}\right] \)方向散射并撞击一个相邻的Si原子(Si1) .然后,Si PKA 向 [111] 方向反弹以取代另一个 Si 原子(Si2),Si2 原子最终占据间隙位点。 Si1 原子接收到足够的能量沿 [110] 方向移动并取代其相邻的 Si 原子 (Si3),从而形成间隙缺陷。最后,相关的缺陷是两个 VSi 和两个 Siint 缺陷,如图 2b 所示。
对于块状 Ge,E 的值 d 与实验值 ~ 18 eV [36] 和 [001] 方向的理论值 18.5 eV [20] 非常吻合。值得注意的是,9.5 eV 的现值与 Holmström 的 [111] 方向的 12.5 eV [20] 结果相当,小于 ~ 15 eV [36] 的实验值。对于 Ge[111] 和 Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \),确定的 E d 值小到 9.5 eV,表明 Ge 原子很容易沿这两个方向发生位移。在这两种情况下,相关的缺陷是锗空位和锗间隙(见图 3c、d)。对于 Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \),Ge PKA 不遵循直线路径,而是被其最近的邻居之一强烈偏转以占据一个间隙站点 (Geint)。相比之下,在 Ge[111] 的情况下,Ge PKA 沿 [111] 方向移动 4.92 Å,形成间隙缺陷 (Geint)。与 E 相比 Ge[001] 的 d,Ge[110] 的值大 10 eV,说明 Ge 原子更难沿 [110] 方向位移。尽管 Ge[001] 和 Ge[110] 的相关缺陷相似,但缺陷产生的机制有些不同。 Ge PKA 接收动能并沿 [001] 方向移动以与其相邻的原子发生碰撞。被取代的 Ge 原子继续移动并占据一个间隙位置,如图 3a 所示。对于Ge[110],Ge反冲沿[110]方向与其相邻的第一个Ge原子(Ge1)碰撞并沿[111]方向反弹,形成Geint。 Ge1 原子离开其晶格位置并取代其相邻的 Ge 原子 (Ge2)。随后,Ge2 原子移回 Ge1 的晶格位置,最终仅形成一个 VGe 和一个 Geint 缺陷,如图 3b 所示。这些结果表明,在块体 Si 和 Ge 中,Eds 强烈依赖于结晶方向,并且原子更难以沿 [110] 方向位移。体硅和锗的辐射损伤端态主要是FP缺陷,即空位和间隙缺陷。
Si/Ge 超晶格中的位移事件
在这项研究中,考虑了 Si2/Ge2 SL 的位移事件,其中包含两层 Si 与两层 Ge 交替(见图 1b)。选择与 Si/Ge 界面相邻的 Si 和 Ge 原子作为 PKA。表 2 中列出了 Si 和 Ge 反冲的 Eds 和相关缺陷。分别为 4 和 5。值得注意的是,在 Si[111] 的情况下,即使在高达 100 eV 的能量下也不会产生缺陷。由于计算限制,我们没有对能量高于 100 eV 的反冲事件进行进一步模拟,并且精确的 E Si[111]的d值未确定。
<图片>
一 –d Si反冲事件后损伤Si/Ge超晶格的几何结构示意图。蓝色和绿色球体分别代表 Si 和 Ge 原子。 V X :X 空缺 (X =Si或Ge); X 整数:X 插页式 (X =Si或Ge); X 是 :X 占领Y 点阵位点 (X 和 Y =Si 或 Ge)。紫色和红色球体分别代表空位和间隙缺陷
<图片>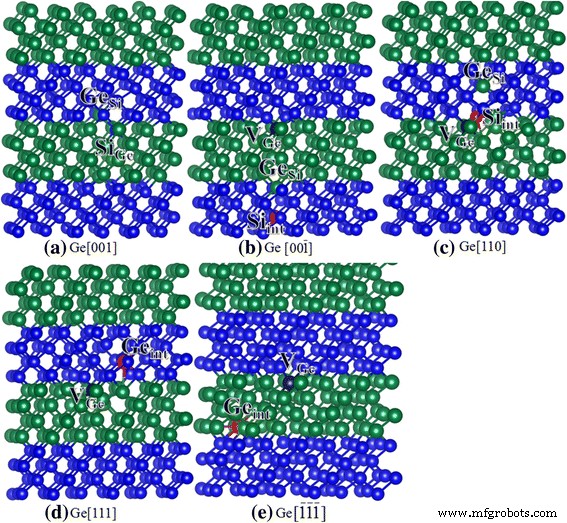
一 –e Ge反冲事件后损伤Si/Ge超晶格的几何结构示意图。蓝色和绿色球体分别代表 Si 和 Ge 原子。 V X :X 空缺 (X =Si或Ge); X 整数:X 插页式 (X =Si或Ge); X 是 :X 占领Y 点阵位点 (X 和 Y =Si 或 Ge)。紫色和红色球体分别代表空位和间隙缺陷
在 Si/Ge SL 结构中,发现 Si PKA 很容易沿 \( \left[\overline{1}\overline{1}\overline{1}\right] \) 方向位移,如小 E d 值为 10 eV。缺陷产生的途径非常简单,即 Si PKA 移动 4.61 Å 远离其晶格位点并形成 Siint 缺陷。对于 Si[001] 和 Si\( \left[00\overline{1}\right] \),Eds 分别确定为 46.5 和 42.5 eV,损坏的缺陷与预期不同。在Si[001]的情况下,Si PKA沿[001]方向移动以取代其相邻的Ge原子(SiGe),被取代的Ge原子与其相邻的Si原子碰撞并占据其晶格位点,形成GeSi反位点缺点。被取代的硅原子获得足够的能量并进一步取代另一个锗原子(SiGe),最终占据一个间隙位点。最终,相关的缺陷是一个 VSi、一个 Geint 和三个反位缺陷。至于 Si\( \left[00\overline{1}\right] \),两个相邻的 Ge 原子和一个相邻的 Si 原子也参与了位移事件,并且损伤态包含两个空位、两个间隙和两个反位缺陷,如图 4b 所示。在 Si [110] 的情况下,Si 原子移动以撞击其相邻的 Si 原子并向 \( \left[11\overline{1}\right] \) 方向散射。然后,Si PKA 替换了一个相邻的 Ge 原子,最终占据了一个间隙位点。在位移事件之后,相关的缺陷包含一个 VSi、一个 SiGe 和一个 Geint 缺陷。与块体 Si 相比,Si/Ge SL 中的 Si 原子除了 [110] 的情况外,一般更难位移,缺陷产生机制更复杂,表明块体 Si 和 Si/Ge SL 显示对辐照的不同辐射反应。我们的结果与 Fonseca 等人进行的实验一致。和 Leitão 等人。 [13, 14],他们还发现与体硅相比,SL结构的抗辐射能力有所提高。
对于 Si/Ge SL 中的 Ge 反冲,Ge 原子很容易沿 [111] 和 \( \left[\overline{1}\overline{1}\overline{1}\right] \) 方向位移,这类似于散装 Ge 中的 Ge 反冲事件。尽管 Ge[111] 和 Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \) 的辐射损伤端态非常相似,即 Ge FP 缺陷,机制缺陷的产生是不同的。在 Ge[111] 的情况下,Ge PKA 移动 4.77 Å 远离其晶格位点并形成 Geint 缺陷。对于 Ge\( \left[\overline{1}\overline{1}\overline{1}\right] \),Ge 原子沿 \( \left[\overline{1}\overline{1} \overline{1}\right] \) 方向替换其相邻的 Ge 原子。碰撞后的 Ge 原子沿这个方向移动并最终占据一个间隙位置。需要注意的是,Ge[001] 的 Ed 值为 16 eV,Ge\( \left[00\overline{1}\right] \) 的 Ed 值与 Ge[001] 的 18 eV 的值相当块状锗,而相关的缺陷显示出不同的特征。在 Ge[001] 的情况下,Ge PKA 接收到足够的能量但沿 [111] 方向散射以取代其相邻的 Si 原子,形成 GeSi 反位缺陷。然后,取代的Si原子占据Ge PKA晶格位置并形成反位缺陷(SiGe)。在 Ge\( \left[00\overline{1}\right] \) 的情况下,Ge PKA 移动 5.63 Å 以替换其相邻的 Si 原子。 Si原子沿这个方向移动并形成Siint缺陷。与块体 Ge 中的 Ge[110] 相比,Si/Ge SL 中 Ge[110] 的 Ed 小 8.5 eV,相关缺陷更复杂,如一个 VGe、一个 GeSi 和一个 Siint 缺陷所示.比较块体 Ge 和 SL 中的 Ge 反冲事件,我们发现 Si/Ge SL 中的 Ge 原子沿 [110] 方向更具抵抗力。对于其他位移事件,Eds 通常与体态的 Eds 相当。然而,块体 Ge 和 Si/Ge SL 中的辐射损伤端态不同,并且在 Si/Ge SL 结构中会产生一些反位缺陷。这些结果表明,Si/Ge SL 结构中的 Ge 反冲对辐照表现出不同的辐射响应。比较SL结构中Si和Ge的反冲,我们发现Si原子的位移事件比Ge受到的影响要大得多,即SL结构中Si原子的Eds普遍增加,这可能导致Si/葛SL。索博列夫等人。已经发现与块体 Si 相比,Si/Ge SLs 表现出非常高的辐射硬度 [12],这与我们的结果一致。
大块硅、锗和硅/锗超晶格中的缺陷形成能量和迁移势垒
在块体 Si 和 Ge 中,损坏状态主要是空位和间隙缺陷。对于 Si/Ge SL,相关缺陷包含空位、填隙和反位缺陷,并且缺陷产生的机制通常更复杂。块状组件材料和 Si/Ge SL 之间在抗缺陷形成方面的差异可能导致它们不同的辐射容限。为了进一步研究这些半导体材料不同辐射响应的起源,我们使用密度泛函理论方法计算了体态和 SL 结构中空位、填隙和反位缺陷的形成能以及最有利缺陷的迁移势垒。计算基于由 64 个原子组成的超胞,在真实空间中具有 6 × 6 × 6 k 点采样,截止能量为 500 eV。
表 3 中列出了块体 Si、Ge 和 Si/Ge SL 中的缺陷形成能以及其他计算结果。在体硅中,计算出的 VSi、Siint 和 Si FP 缺陷的形成能分别为 3.60、3.77 和 4.62 eV,这与其他计算结果相当一致 [37,38,39,40]。我们的结果表明,在体硅中更容易产生 VSi 缺陷。类似地,体 Ge 中的 VGe 缺陷在能量上比 Geint 和 Ge FP 缺陷更有利,如最小缺陷形成能量 2.23 eV 所示,这与理论值 2.09 eV [39] 相当。对于 Si/Ge SL,VGe 的形成能被确定为 2.73 eV,小于其他缺陷的形成能。下一个有利的缺陷是 VSi 缺陷,形成能被确定为 2.85 eV。值得注意的是,Geint 的 3.52 eV 值小于 Siint 缺陷的 3.77 eV 值。对于FP缺陷,形成能明显更大,即Si FP为5.19 eV,Ge FP为5.01 eV,表明FP缺陷难以产生。与体态相比,除VSi和Siint缺陷外,Si/Ge SL结构的缺陷形成能一般较大,表明在SL结构中,点缺陷一般更难形成。体态和Si/Ge SL结构之间在抗缺陷形成方面的这种差异可能导致它们对辐照的不同响应。
基于优化的结构,进一步研究了 VGe 和 VSi 缺陷的迁移行为,这些缺陷是体和 Si/Ge SL 结构中最有利的缺陷。考虑到与 Si/Ge 界面相邻的 VGe 和 VSi 缺陷,迁移势垒总结在表 4 中。注意到 VGe 缺陷沿 [100] 和 [110] 方向的迁移势垒为小于 VSi 缺陷,VGe 沿 [111] 方向迁移的能垒略大于 VSi 迁移,这与 Cowern 等人报道的结果一致。 [41].
缺陷沿 [100]、[110] 和 [111] 方向迁移的能量图谱如图 6 所示。在图 6a 中,VSi 缺陷沿 [100] 方向的迁移势垒确定为体硅和 Si/Ge SL 分别为 4.32 和 3.92 eV。至于 [110] 方向,Si/Ge SL 结构中 VSi 的 2.14 eV 迁移势垒非常接近体硅中 2.12 eV 的值。比较沿每个方向的迁移势垒,我们发现 [111] 方向是 Si 和 Ge 空位最有利的迁移方向,如迁移势垒明显较小所示。特别是,VSi 缺陷在体硅中比 Si/Ge SL 更容易沿 [111] 方向迁移,因为体状态下 0.11 eV 的能垒要小得多(见图 6e)。对于 VGe 缺陷,计算出沿 [100] 方向的迁移势垒在体 Ge 中为 3.67 eV,在 Si/Ge SL 中为 2.87 eV。在 [110] 方向的情况下,体结构和 SL 结构中的能垒分别确定为 1.94 和 1.39 eV。与 Si 空位迁移的情况类似,VGe 缺陷更容易沿 [111] 方向迁移。此外,迁移在体 Ge 中比 Si/Ge SL 更容易发生,如图 6f 所示。我们的计算表明,Si 和 Ge 空位在体态中比 SL 结构更易移动,这可能导致空隙形成甚至体积膨胀。这可能导致体结构和SL结构对辐照的不同响应。
<图片>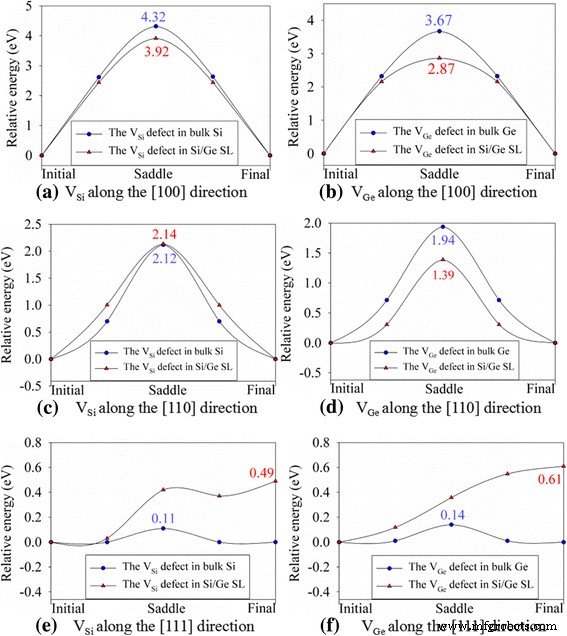
通过簇轻推弹性带方法获得的硅空位 (VSi) 和锗空位 (VGe) 缺陷的迁移势垒。 一 VSi 沿 [100] 方向; b VGe 沿 [100] 方向; c VSi 沿 [110] 方向; d VGe 沿 [110] 方向; e VSi 沿 [111] 方向; f VGe沿[111]方向
结论
总之,块体 Si、Ge 和 Si/Ge 超晶格 (SL) 中的低能位移事件已通过从头算分子动力学方法进行了研究。在块体 Si 和 Ge 中,阈值位移能量显示出取决于晶体学方向,并且原子更难以沿 [110] 方向位移。体态的损伤态主要是空位和间隙缺陷。在Si/Ge SL结构中,Si原子沿[111]方向的电阻更大,而Ge原子沿[110]方向更难位移。我们的计算表明,SL 结构中 Ge 反冲的能量通常与块状 Ge 中的能量相当,而 SL 结构中 Si 反冲的能量通常远大于块状 Si 中的能量,表明其抗辐射性增强Si/Ge SL。缺陷形成能计算表明,Si/Ge SL中的点缺陷通常具有较高的形成能,表明SL结构中的点缺陷通常更难形成。还发现 [111] 方向是 Si 和 Ge 空位最有利的迁移路径,并且这两个空位在体态中比在 SL 结构中更具移动性。我们的计算表明,Si/Ge SL增强的耐辐射性有利于其在辐射等极端工作条件下作为电子和光电器件的应用。
缩写
- AIMD:
-
从头算分子动力学
- 编辑:
-
阈位移能
- FP:
-
弗伦克尔对
- 哥:
-
锗
- Geint :
-
锗间隙
- 锗硅:
-
锗占据硅晶格位
- LDA:
-
局部密度近似
- MD:
-
分子动力学
- NVE:
-
微正则系综
- PKA:
-
初级碰撞原子
- PL:
-
光致发光
- QD:
-
量子点
- QW:
-
量子阱
- Si:
-
硅
- 午睡:
-
西班牙数千个原子电子模拟倡议
- 硅锗:
-
硅占据锗晶格位
- Siint:
-
硅间隙
- SL:
-
超晶格
- SZP:
-
单ζ基组加极化轨道
- VGe :
-
锗空位
- VSi :
-
硅空位
纳米材料


