通过低温快速热退火工艺控制高均匀度硒化铟 (In2Se3) 纳米线的生长
摘要
高均匀性 Au 催化的硒化铟 (In2Se3) 纳米线通过气-液-固 (VLS) 机制通过快速热退火 (RTA) 处理生长。 Au催化的In2Se3纳米线的直径可以通过不同厚度的Au薄膜进行控制,并且通过100°C/s的快速预退火速率提高了纳米线的均匀性。与较慢的加热速率 0.1°C/s 相比,采用和不采用 RTA 工艺的 In2Se3 纳米线的平均直径和分布(标准偏差,SD)分别为 97.14 ± 22.95 nm (23.63%) 和 119.06 ± 48.75 nm (40.95%) ), 分别。原位退火 TEM 用于研究加热速率对从沉积的 Au 薄膜形成 Au 纳米颗粒的影响。结果表明,采用和不采用 RTA 工艺的 Au 纳米颗粒的平均直径和分布分别为 19.84 ± 5.96 nm (30.00%) 和约 22.06 ± 9.00 nm (40.80%)。这证明通过 RTA 预处理,Au 催化的 In2Se3 纳米线的直径尺寸、分布和均匀性得到减小和改善。系统研究可以通过调节退火速率、前驱体温度和生长基质来控制其他纳米材料的尺寸分布,从而控制其他纳米材料的尺寸分布。
<图片>
快速热退火 (RTA) 工艺证明它可以使 Au 纳米粒子的尺寸分布均匀,然后可用于通过气-液-固 (VLS) 机制生长高均匀性的 Au 催化的 In2Se3 纳米线。与一般生长条件相比,升温速度较慢,为0.1°C/s,生长温度为较高的生长温度,> 650°C。 RTA 预处理的生长衬底可以形成更小且均匀的 Au 纳米粒子与 In2Se3 蒸气反应并产生高均匀性的 In2Se3 纳米线。原位退火TEM用于实现加热速率对沉积的Au薄膜形成Au纳米颗粒的影响。降低前驱体和生长温度可以抑制自催化In2Se3纳米片的副产物。
背景
在过去的十年中,一维 (1D) 纳米结构管、线、棒和带由于其高性能和表面体积比而成为全球纳米技术研究的焦点,本质上与低维相关,这可能会导致在各种纳米级设备中的独特应用 [1, 2]。尤其是一维半导体纳米线(NWs),与其块体或薄膜相比,表现出不同的特性,在数据存储、计算和传感设备中显示出巨大的潜在应用[2,3,4]。
硒化铟 (In2Se3) 是一种黑色晶体,是一种非常有趣的 A III 化合物半导体 B VI 具有层状结构的组,至少具有 α(两层六方,2H)、β(三层菱形,3R)、γ(六方中的缺陷纤锌矿,H)、δ 和 κ [5, 6]。由于其多态性和相关的金属离子缺陷结构,In2Se3 作为一种有前途的半导体材料已引起广泛关注,例如光伏太阳能电池 [7, 8]、光电子学 [9] 和离子电池 [10]。
In2Se3 的层状结构通常由 [Se-In-Se-In-Se] 片组成,其中 Se 原子沿 c 方向堆叠 -轴 [11,12,13,14,15]。强层内键合和弱层间范德华相互作用导致高度各向异性的结构、电学、光学和机械性能 [16, 17]。层状结构的 In2Se3 纳米线和纳米带已通过使用金属纳米粒子作为催化剂通过气-液-固 (VLS) 工艺合成 [2, 18,19,20]。 NW 的特性不仅取决于它们的形状各向异性,还取决于它们的晶体各向异性 [21]。汽-液-固生长机制已被证明可以控制纳米线的直径和生长方向 [20,21,22,23,24]。多项研究结果表明,催化剂是控制纳米线形貌的重要组成部分之一。并且 NW 的晶体取向是在初始成核过程中在给定尺寸和几何形状的共晶液滴内的液固 (LS) 界面处通过热力学确定的 [25, 26]。此外,先前的研究表明,可以通过在 VLS 生长过程中使用明确定义的纳米团簇作为催化剂来合成高度均匀的半导体纳米线 [25]。控制 Au-In 合金液滴催化剂的生长温度可以确定 Au-In 合金液滴中 In 和 Se 原子的偏析浓度,进而影响纳米线的直径。然而,Au 催化的 In2Se3 纳米线通常在相对较高的温度下生长,> 650°C。根据 Au-In 相图,共晶温度约为 530°C,In 和/或 Se 将从 Au-In 液态合金中析出,然后与 Se 反应以生长 In2Se3 纳米线 [27]。在这项工作中,快速热退火 (RTA) 用于使 Au 膜转移到均匀的 Au 纳米颗粒。此外,选择较低的前体和生长温度来减小纳米线的直径并防止 VS 生长的 In2Se3 副产物。有趣的是,更薄的 In2Se3 NW 可以通过控制低至 550°C 的生长温度来获得直径。采用原位退火透射电子显微镜(TEM)研究了加热速率对沉积态Au薄膜形成Au纳米颗粒的影响。
实验
In2Se3 NWs 在具有两个温度区的石英管炉系统中合成。传统上,In2Se3 粉末(99.9%,CERAC)用作前体,然后在 800°C(加热速率为 0.01°C/s)下放置在管中间的上游。 SiO2/Si(100) 衬底涂有 2.0 nm 厚的金膜,该膜位于下游。将涂有 2.0 nm 厚金膜的 SiO2/Si(100) 通过 RTA 在 550°C(加热速率为 100°C/s)下退火,然后将衬底装入生长炉管中生长 In2Se3具有 25 sccm 氩气流速和 1 Torr 压力的纳米线。上游的 In2Se3 前驱体粉末和下游(生长区)的 Au 涂层基板的温度分别上升至 800°C(1.2°C/s)和 550°C(0.1°C/s) ,并保持 30 分钟。通过扫描电子显微镜(SEM,JEOL JSM-6500F)和透射电子显微镜(TEM,FEI Tecnai™ G 2 )对 In2Se3 纳米线的形貌和微观结构进行了表征 F20 场发射枪)在 200 kV 下运行。 TEM 配备了由能量色散 X 射线光谱仪 (EDS) 确认的化学成分。 In2Se3 NW 的相用 X 射线衍射仪(XRD,D8 DISCOVER SSS Multi-Function High Power)确认。原位退火 TEM 用于研究加热对 Au 纳米颗粒形成的影响。为了制备原位加热 TEM 样品,在 SiO2/Si3N4 薄膜的方形开口上沉积 2.0 nm Au 膜。 SiO2 和 Si3N4 膜的厚度分别为 30 和 60 nm。将2.0 nm Au薄膜沉积在SiO2侧,然后装入TEM中,用TEM中的加热架(Gatan 652双倾斜加热架)加热。
结果与讨论
图 1a 是用于生长 In2Se3 NW 的石英管炉系统的示意图。通常,Au 催化的 In2Se3 NW 的生长窗口为 650-750°C,前体 In2Se3 在 900-950°C 下加热以通过 VLS 机制提供 In 和 Se 的来源 [19]。然而,Au-In 相图显示 Au-In 的共晶温度可能低至 450-550°C,具体取决于 AuInx 合金的成分 [28, 29]。预计 NW 的直径可以通过 Au 厚度、生长温度和炉子环境来控制。在这项工作中,生长温度和 In2Se3 前驱体粉末的温度分别设置为 550 和 800°C。图 1b、c 是 In2Se3 NW 的 SEM 图像,它们分别生长在 200 nm SiO2/硅晶片上沉积的 2.0 nm Au 膜上,分别采用和不采用快速热退火 (RTA) 工艺。从图 1b、c 中的插图可以观察到 NW 顶部的明亮纳米颗粒,这表明 In2Se3 NW 是通过 VLS 机制通过 AuInx 纳米颗粒生长的。使用和不使用 RTA 工艺的 In2Se3 NW(50 纳米线)的平均直径分别为 97.14 ± 22.95 nm (23.63%) 和 119.06 ± 48.75 nm (40.95%)。使用和不使用 RTA 工艺的 In2Se3 NW 直径的平均值和分布明显不同。它清楚地表明 RTA 工艺可以提高均匀性并可以减小 In2Se3 NW 的直径 [30,31,32]。图 1d 是 In2Se3 NWs 的 XRD 结果,所有峰都可以指向 α-In2Se3 NWs 的六方晶体结构,其中晶格常数为 a =4.025 Å 和 c =19.235 Å(JCPDS 卡,编号#34–1279)。
<图片>
一 两区石英管炉的图示。使用 In2Se3 粉末作为前驱体并在 800°C 下将其置于管中部的上游,将涂有 2.0 nm 厚 Au 膜的 SiO2/Si(100) 置于下游,氩气作为载气。 b 和 c 分别是在使用和不使用 RTA 工艺的情况下在衬底上生长的 In2Se3 纳米线的 SEM 图像。 d Au催化的α-In2Se3纳米线的典型XRD谱。晶格常数为 a =4.025 Å 和 c =19.235 Å(JCPDS 卡,编号 34–1279)
一般将镀金的基体装入炉内,升温速率通常为1~2℃/s,然后与前驱体反应形成低熔点AuInx合金,In偏析为共晶合金过饱和与 Se 反应并生长 In2Se3 NW。较慢的加热速率导致金纳米颗粒的均匀性较差。不仅基底上金膜的厚度和加热速率,生长温度也是控制纳米线形貌的重要因素。图 2a-c 是 In2Se3 NW 在经过 RTA 处理然后分别在 550、600 和 650°C 下生长后的 SEM 图像。图 2a-c 中相应的插图显示 In2Se3 NW 直径分别为 80-100、100-200 和 300-500 nm。结果表明,可以通过控制生长温度来调节 In2Se3 纳米线的直径。由于生长温度升高,In在Au催化剂中的溶解度会增加;这意味着 In 原子需要更多的量才能达到过饱和浓度。同时,更厚的 In2Se3 NW 将通过更大的 AuInx 液滴生长。图 2d 显示了在 850°C (1.3°C/s) 的前体温度下生长的 In2Se3 纳米线。将同时获得金催化气-液-固生长和自催化气-固 (VS) 生长 In2Se3 纳米材料,包括纳米线、纳米片和薄膜。较高的前驱体温度会导致较高的前驱体蒸气,过量的前驱体会导致 In2Se3 产物,其倾向于自成核和生长。与其他研究相比,550°C 的生长温度可能远低于一般报道的 650-750°C。此外,前体温度可以降低到 800°C 以防止自催化生长。表 1 列出了生长 In2Se3 纳米线参数的比较,包括生长衬底温度(加热速率)、生长衬底退火处理、前驱体温度和纳米线直径。由于较低的生长温度,副产物受到抑制,从而可以在相对较低的温度下获得均匀的 In2Se3 NW。它清楚地表明 In2Se3 NWs 可以在这项工作中的最低生长温度和前体温度下生长。此外,由于金颗粒的直径受到限制,RTA 工艺的结果表明 In2Se3 NWs 的直径均匀性优于传统系统。
<图片>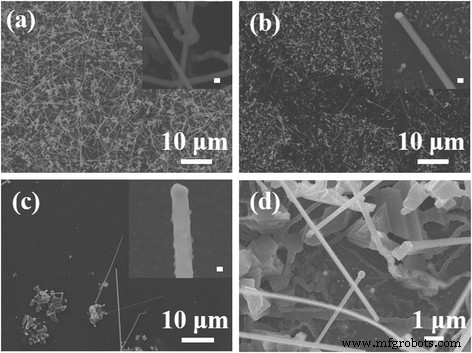
在a生长的In2Se3纳米线的SEM图像 550°C,b 600 °C 和 c 分别为 650°C;插入图像的比例尺 (a –c ) 是 100 纳米。 d In2Se3 纳米线在前驱体和生长温度分别为 850 和 600°C 下生长
原位退火 TEM 用于研究加热速率对 Au 纳米颗粒形成和纳米线生长的影响。图 3a 是 SiO2/Si3N4 窗口上沉积的 2nm Au 膜的 TEM 图像,以 0.1°C/s 和 100°C/s 的速度退火至 550°C 并保持 30 分钟。图 3b、c 是 Au 纳米颗粒形成的结果,加热速率分别为 100°C/s 和 0.1°C/s。根据原位退火TEM结果,分析了Au纳米颗粒的平均尺寸和分布并列于表2中。简而言之,通过更快的加热速率可以实现更小的Au纳米颗粒的平均尺寸和更好的均匀性。图 3d 是经过 RTA 处理然后在 550°C 下生长的代表性 In2Se3 纳米线的 TEM 图像。结果表明,纳米线的典型直径约为 100 nm,插图是相应的选区电子衍射 (SAED) 图案。图 3e 显示了相应 In2Se3 NW 的高分辨率透射电子显微镜 (HRTEM) 图像,该图像取自 [010] 区轴,其晶格间距为 0.35 和 0.48 nm,并且可以索引到 ( 100) 和 (004) 平面,这表明 In2Se3 NW 沿 [001] 方向生长。 EDS 分析取自顶部和茎部;结果如图 3f、g 所示。 Cu 和 C 信号来自碳涂层铜 TEM 网格。取自茎的图 3f 仅由 In 和 Se 组成,In/Se 的原子比约为 2/3。图 3g 是顶级纳米颗粒组合物的 EDS 结果,包括 In 和 Au。额外的 Au 信号证明 In2Se3 纳米线是通过气-液-固 (VLS) 机制生长的。根据TEM、SEAD和HRTEM分析,VLS生长的纳米线可以识别为In2Se3的α相。
<图片>
一 室温下 2.0 nm Au 薄膜。 b 在 550°C 下以 100°C/s 的速度通过 RTA 获得金膜。 c 金膜以 0.1°C/s 的速度升温至 550°C。 d 合成后的单个 α-In2Se3 纳米线的 TEM 图像,带有 Au 纳米颗粒尖端。 α-In2Se3 纳米线的 SAED 图案(插图)。 e d 对应的 HRTEM 图像 显示纳米线的生长方向是沿着[001]。 f 和 g 分别为所选α-In2Se3纳米线的主体部分和尖端部分的EDS光谱
结论
分别提供较低的前体和生长温度 800 和 550°C,以通过 VLS 机制生长 Au 催化的 In2Se3 纳米线。此外,通过 RTA 处理可以改善 In2Se3 纳米线的均匀性,以减少 Au 纳米颗粒的尺寸和分布。原位退火TEM用于研究加热速率对Au膜转移到Au纳米颗粒的影响。较低的前体和生长温度可以减少自催化 In2Se3 纳米片的形成。较低的温度会导致较低的前驱体浓度和较低的能量,从而抑制自催化 In2Se3 纳米片的成核作用。
纳米材料


