在氧化铟锡涂层二氧化硅上直接生长单晶 GaN 纳米线
摘要
在这项工作中,我们展示了 GaN 纳米线在氧化铟锡 (ITO) 涂层的熔融石英衬底上的直接生长。纳米线是使用等离子体辅助分子束外延 (PA-MBE) 无催化剂生长的。系统地研究了生长条件对纳米线形态和质量的影响。结构表征表明纳米线直接在垂直于衬底平面的 ITO 层顶部沿 (0001) 方向生长。纳米线的光学表征表明,由于缺陷数量少,纳米线的光致发光响应中不存在黄色发光。 n 掺杂 GaN 纳米线的导电原子力显微镜 (C-AFM) 测量显示单个纳米线具有良好的导电性,这证实了将该平台用于新型设备应用的潜力。通过使用相对低温的生长工艺,我们能够成功地生长出高质量的单晶 GaN 材料,而不会造成底层 ITO 层的退化。
介绍
市售的基于 III 族氮化物的器件大多依赖蓝宝石作为生长衬底,因为它们可以以可接受的材料质量适应 GaN 的生长。然而,在生产大直径蓝宝石衬底的同时保持可接受的衬底表面质量的挑战仍然是扩大生产规模的障碍 [1, 2]。蓝宝石作为 III 族氮化物生长衬底的一种可行替代方案是使用基于二氧化硅的衬底,因为它们在经济上更便宜并且广泛用于工业和消费应用。然而,由于基于二氧化硅的基材本身不导电,因此必须使用不透明的导电层来实现导电性 [3, 4]。因此,在二氧化硅基底上同时提供导电性和透明度的方法变得非常重要。我们以前曾采用薄 Ti 夹层作为纳米线成核位点,以同时提供透明度和导电性 [5]。然而,由于需要薄层Ti,样品的导电性受到限制。
透明导电基板的另一种可能方法是采用氧化铟锡 (ITO) 作为 GaN 成核位点,因为它透明且导电,并且可以沉积在大表面积上。 ITO技术已经成熟,已经广泛应用于各个行业的透明电极。然而,目前用于制造 GaN 的常规技术与 ITO 不兼容。分解金属有机化学气相沉积 (MOCVD) 生长中使用的前体所需的高温会导致 ITO 层退化。因此,需要能够生产高质量材料的低温GaN生长方法。之前曾尝试使用溅射和等离子体增强化学气相沉积 (PECVD) 在 ITO 上低温生长 GaN [6-12]。然而,低温生长方法通常会导致多晶材料和大量缺陷。
在这项工作中,我们试图通过使用等离子体辅助分子束外延 (PA-MBE) 在 ITO 涂层熔融石英上直接生长晶体 GaN 纳米线来解决这个问题。在 PA-MBE 中,通过使用射频功率断开纯 N2 气体之间的键,将活性氮物质提供给系统。因此,与其他 GaN 外延生长方法相比,生长温度可以显着降低,从而防止 ITO 层退化。通过使用 GaN 纳米线,可以在多晶 ITO 层的顶部生长高质量的 GaN。由于纳米线的高表面积与体积比引起的应变松弛和穿透位错过滤 [13, 14],尽管纳米线和下面的纳米线之间缺乏晶格匹配,但 GaN 纳米线通常表现出单晶和无穿透位错成核层[15]。
我们研究了纳米线的形态及其与底层 ITO 层的关系、纳米线的光学特性以及将该平台用于设备应用的可行性。使用电子显微镜的结构表征表明,纳米线直接在 C 面 (0001) 方向垂直于基板平面的 ITO 层上生长。光致发光测量给出了良好的内量子效率 (IQE) 值,而发射光谱中不存在与缺陷相关的黄色发光。最后,n 掺杂 GaN 纳米线的导电原子力显微镜 (C-AFM) 证实纳米线具有导电性,突出了在 ITO 平台上使用 GaN 纳米线制造新型器件的可能性。从我们的工作中,我们开辟了在 ITO 顶部生长 III 族氮化物纳米线的潜力,用于需要基板透明度和导电性的设备应用。
方法
ITO 薄膜沉积
本实验中使用的 ITO 薄膜是使用射频磁控溅射方法沉积的。沉积是在环境温度下用氩等离子体在 60 W RF 功率、2.5 mTorr 室压力和 25 标准立方厘米每分钟 (sccm) 气体流速下完成的。在沉积之前,使用丙酮和异丙醇通过标准溶剂清洁对样品进行清洁。直接在裸硅上沉积约 100 nm 厚的 ITO 薄膜。
III-氮化物纳米线生长
GaN 纳米线样品使用 Veeco Gen 930 等离子体辅助分子束外延 (PA-MBE) 反应器生长。在 MBE 生长之前,ITO 涂层的二氧化硅衬底在快速热退火 (RTA) 炉内在 650°C 下在 Ar 环境下退火 5 分钟,以提高 ITO 层的结晶度。在装入腔室之前,使用标准溶剂清洁方法清洁样品。样品在 MBE 负载锁和制备室内进行 200 °C 和 650 °C 的后续热清洗,以分别去除水分和其他污染物。
在纳米线生长过程中,我们使用了 1×10 -7 的 Ga 束等效压力 (BEP) 值 Torr 根据 BFM 离子规读数。使用热电偶测量所有基板温度。为了促进纳米线生长,在 500 °C 下沉积了初始种子层。初始晶种层沉积后,衬底温度升至 700 °C 以生长纳米线。
结构、光学和电气特性
使用 Agilent 5500 SPM 原子力显微镜 (AFM) 系统研究 ITO 层的表面形态。通过在接触模式下使用导电 AFM (C-AFM) 测量样品的电特性。为了改善纳米线和 C-AFM 尖端之间的电接触,使用电子束蒸发在纳米线顶部沉积了 5/5 nm 厚的 Ni/Au 层,然后在大气环境中在 600°C 下进行快速热退火。 C-AFM 测量是通过使用 Pt/Ir 涂层的 AFM 尖端并对样品的 ITO 层施加偏压来完成的。由于在我们的 C-AFM 配置中偏压施加在基板上,正电流表示电流从样品流向 AFM 尖端。
使用透射电子显微镜 (TEM) 表征研究了在 ITO 顶部生长的 GaN 纳米线的结构质量。使用 FEI Helios Nanolab 400s 双束聚焦离子束 (FIB) SEM 制备横截面 TEM 样品。 SEM 成像使用 FEI Nova Nano 和 Zeiss Merlin SEM 系统完成。使用 Titan 80-300 ST 透射电子显微镜(FEI Company)进行高分辨率透射电子显微镜(HRTEM)和高分辨率高角度环形暗场 STEM(HAADF-STEM)表征。通过电子能量损失谱(EELS)获得元素组成图。
为了研究纳米线的极性,我们使用了基于 KOH 的蚀刻。据报道,使用 KOH 的湿化学蚀刻显示出对 N 面 GaN 的优先蚀刻。因此,可以通过比较 KOH 蚀刻前后纳米线的形貌来确定极性。我们在室温下将ITO样品上的GaN纳米线浸入40% KOH溶液中1小时,并比较化学浸入前后的形貌,以确定纳米线的生长极性。
我们通过使用温度相关和功率相关的光致发光 (PL) 测量装置研究了直接生长在 ITO 顶部的 GaN 纳米线的光学特性。将样品装入氦冷却的低温恒温器中,并使用 266 nm 激光器(Teem photonics SNU-20F-10x)激发。温度从 10 到 290 K。我们首先研究了功率相关的光致发光响应,在 10 K 下进行。使用紫外-可见-近红外分光光度计(Shimadzu UV-3600)进行透射率测量。
使用Bruker D2 Phaser粉末XRD系统进行X射线衍射(XRD)测量。
结果与讨论
由于 GaN 纳米线的高温生长可能导致下面的 ITO 层退化,我们首先研究了热退火对沉积在二氧化硅衬底顶部的裸 ITO 的影响。实验在 MBE 的缓冲室内进行,通常在 10 -8 Torr 压力以模拟实际生长条件。退火后,使用四点探针测量法测量裸 ITO 的电导率,并使用原子力显微镜 (AFM) 研究表面粗糙度。从退火实验中,如图 1a 所示,我们发现 ITO 薄膜的薄层电阻值保持在 10 \(Ω / \square \) 以下。然而,在更高的退火温度下,ITO 薄膜变得更粗糙,晶粒尺寸更大,如图 1b-d 所示。
<图片>
退火温度对沉积ITO薄膜电学和物理特性的影响。 一 在不同温度下退火后,用四点探针测量的薄层电阻。样品在b退火后获得的ITO薄膜的AFM表面形貌 500 °C,c 600 °C 和 d 700℃
纳米线生长过程如图 2
<图片>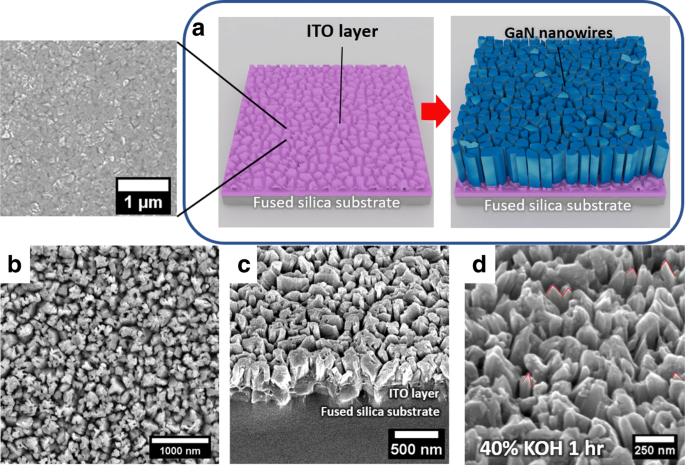
一 说明在粗糙的 ITO 表面上生长 GaN 纳米线的示意图。插图显示了热退火后粗糙 ITO 表面的 SEM 平面图。 b 在 ITO 上生长的 GaN 纳米线的平面图。 c 在 ITO 上生长的 GaN 纳米线的俯视图。 d KOH蚀刻1小时后GaN纳米线的立面图,暴露蚀刻后的GaN纳米线尖端
一个。如 AFM 结果所示,在升高的温度下对 ITO 层进行退火会导致粗糙的 ITO 表面具有大晶粒尺寸。在 MBE 生长过程中,在单个晶粒表面上生长的相邻 GaN 纳米线往往会聚结并形成由纳米线簇组成的较大纳米线。因此,底层 ITO 的形态将直接影响其上生长的纳米线的形态。扫描电子显微镜 (SEM) 显微照片的平面图如图 2b 所示。从平面图来看,纳米线密度统计估计为9.3×10 9 厘米 −2 填充因子为 73%。样品的横截面图如图 2c 所示。纳米线垂直于衬底平面生长,并直接在 ITO 层顶部有一定程度的倾斜。
纳米线样品在 40% KOH 溶液中浸泡 1 小时后的 SEM 图像如图 2d 所示。可以看出,经过化学处理后,纳米线的尖端部分被蚀刻掉,这表明N极性。这一发现与先前报道的结果一致,即自发生长的 III 族氮化物纳米线通常为 N 极性 [16–19]。
图 3a 显示了纳米线的高角度环形暗场扫描透射电子显微镜 (HAADF-STEM)。纳米线直接生长在 ITO 层的顶部。为了研究纳米线和 ITO 层之间界面的元素组成,我们利用 EELS 在红色框内的区域中对 Ga、In、N 和 O 进行了元素映射线扫描。线扫描轮廓如图 3b 所示。线轮廓表示 GaN 纳米线和 ITO 之间的清晰边界。图 3c 中单根纳米线的高分辨率 TEM 图像显示了纳米线的晶格排列,证实了材料的单结晶度。图 3d 中 GaN 纳米线和 ITO 层之间界面上的高分辨率 TEM 显示了中间层 (IL),由纳米线底部和 ITO 之间约 4 nm 厚的多晶和非晶层混合物组成.该薄层被建议为过渡 GaN 层,形成在多晶 ITO 层和晶体 GaN 层之间。之前已经报道过类似的层,其中 GaN 纳米线直接生长在非晶熔融石英层的顶部 [15]。
<图片>
在 ITO 层上生长的 GaN 纳米线的 TEM 和元素映射。 一 直接生长在 ITO 层顶部的 GaN 纳米线的 HAADF 图像。红色框表示执行 EELS 线扫描的位置。 b GaN 纳米线基底和 ITO 层之间界面的 EELS 线扫描轮廓。 Ga、In、N 和 O 的元素映射如图所示。 c GaN 纳米线的高分辨率 TEM,显示单晶。红色箭头表示增长方向。面间距对应于 GaN c 面。 d GaN 纳米线和 ITO 层之间界面的高分辨率 TEM 图像。在 GaN 纳米线和 ITO 层之间可以看到部分非晶中间层 (IL),由红色虚线包围
温度相关的光致发光结果如图 4a 所示。从测量结果可以看出,通常与 GaN 材料中的缺陷相关的黄色发光比 GaN 带边发射低约三个数量级,突出了高质量的 GaN 材料生长。温度相关的光致发光如图 4b 所示。结果显示红移随温度升高通常与 Varshni 带隙收缩有关。由于非辐射复合中心的激活,峰值发射的强度随着温度的升高而降低。 Arrhenius 拟合是对 PL 积分强度随温度的变化进行的,如图 4c 所示。该拟合给出了 195 meV 的活化能。通过使用290 K和10 K的积分强度比,我们估计纳米线的内量子效率约为67%。
<图片>
一 在 10 K 下对在氧化铟锡上生长的 GaN 纳米线进行功率相关测量。b 在 ITO 层上生长的 GaN 纳米线的温度相关 PL。 c 基于温度相关 PL 测量计算的活化能。 d 熔融石英衬底、熔融石英上退火的 ITO 层和生长在 ITO 层上的 GaN 纳米线的透明度; e 裸熔融石英、沉积态 ITO 薄膜、退火 ITO 薄膜和在 ITO 上生长的 GaN 纳米线的 XRD 谱
图 4d 显示了退火的 ITO、熔融石英和 ITO/二氧化硅上的 GaN 纳米线的透射率变化。 GaN纳米线生长后样品的透射率降低。由于 GaN 纳米线在可见光波长范围内不具有吸收性,因此透射率降低的原因可能是纳米线本身引起的光散射。
图 4e 显示了裸二氧化硅衬底、具有沉积态 ITO 的二氧化硅衬底、RTP 退火的 ITO/二氧化硅和在 ITO/二氧化硅上生长的 GaN 纳米线的 XRD 结果。在沉积的 ITO 层中没有观察到 XRD 峰,表明几乎是非晶层。 RTP退火后,可以观察到ITO(211)、ITO(222)、ITO(400)、ITO(440)和ITO(622)峰,表明退火提高了ITO层的结晶度,这与之前的报道一致[20]。显示最主要的峰是 ITO(222) 峰和 ITO(400) 峰。在 2 θ 处测得的 GaN(0002) 峰 扫描表明该平面与ITO平面平行,说明GaN纳米线生长在多晶ITO层上。
为了测试 ITO 平台上的 GaN 纳米线是否适用于器件应用,我们使用硅作为掺杂剂生长了具有 n 掺杂 GaN 纳米线的 GaN 纳米线,并使用 C-AFM 测量单个纳米线的 I-V 特性。通过这种方法,我们从样本中获得了统计 I-V 数据。测量结果如图 5 所示。
<图片>
一 纳米线拓扑的 C-AFM 映射。 b 相应的尖端电流,对样品施加 -8V 偏置。 c 单根纳米线的 I-V 曲线,样品电压偏置从 -10 V 到 10 V,显示初始和第二次扫描之间不同的 I-V 特性。 d 初始穿通扫描后多条纳米线的 I-V 曲线分布
图 5b 中的电流映射显示图 5a 中的纳米线最初是不导电的,只有几个点显示电流流动。为了更好地研究纳米线不导电的原因,我们对单个纳米线进行了 I-V 表征。采样电压扫描范围为 − 10 至 10 V,产生的尖端电流范围为 − 10 至 10 nA,这受到 AFM 系统规范的限制。结果如图 5c 所示。对于第一次扫描,我们发现纳米线表现出非常高的开启电压,表明 n-GaN 和 ITO 层之间存在肖特基接触行为。然而,在重复测量后,我们发现 I-V 曲线的导通电压已显着降低,这归因于肖特基势垒高度的降低。我们在图 5d 所示的 AFM 扫描区域中的多个纳米线的初始穿通电压扫描后观察到这种降低的开启电压趋势,证实这适用于在 ITO 上生长的所有纳米线。降低开启电压的确切机制仍有待进一步研究。之前的报告表明,对材料施加高电压可能会通过电击穿诱导载流路径 [21, 22],或修改 GaN 纳米线本身的结构 [23],从而提高导通电压。
结论
总之,我们已经在沉积在熔融石英衬底上的 ITO 薄膜上生长了 GaN 纳米线。使用电子显微镜的物理表征表明,纳米线垂直于衬底平面生长,同时保持高晶体质量。通过光致发光表征检测到强 GaN 带边发射,而通常与缺陷相关的黄色发光不存在。纳米线具有优选的 N 极性,这通过在 KOH 溶液中优先蚀刻晶面来表明。 n掺杂纳米线的C-AFM测量显示出良好的导电性,突出了该平台用于器件应用的可能性。
缩写
- 原子力显微镜:
-
原子力显微镜
- BEP:
-
梁等效压力
- C-AFM:
-
导电原子力显微镜
- 鳗鱼:
-
电子能量损失谱
- FIB:
-
聚焦离子束
- IQE:
-
内量子效率
- HAADF:
-
高角度环形暗场
- HRTEM:
-
高分辨透射电子显微镜
- ITO:
-
氧化铟锡
- MOCVD:
-
金属有机化学气相沉积
- PA-MBE:
-
等离子体辅助分子束外延
- PECVD:
-
等离子体增强化学气相沉积
- PL:
-
光致发光
- RF:
-
射频
- RTA:
-
快速热退火
- sccm:
-
标准立方厘米每分钟
- SEM:
-
扫描电镜
- STEM:
-
扫描透射电子显微镜
- TEM:
-
透射电子显微镜
- XRD:
-
X射线衍射
纳米材料
- 材料科学家教纳米线如何“跳舞”
- 检测单个原子核的磁性
- 用于未来电池的锡纳米晶体
- 关于半导体纳米粒子
- 通过金属有机化学气相沉积在 InAs 茎上自催化生长垂直 GaSb 纳米线
- 通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
- 走向具有剥离碲的单原子链
- 通过用于光检测应用的简便解决方案技术直接生长羽毛状 ZnO 结构
- 通过低温快速热退火工艺控制高均匀度硒化铟 (In2Se3) 纳米线的生长
- 生长序列中量子势垒的最佳硅掺杂层形成八周期 In0.2Ga0.8N/GaN 蓝色量子阱的软限制势LED
- 使用薄 Ti 中间层在非晶石英上直接生长基于 III 族氮化物纳米线的黄色发光二极管
- 基于 Epsilon 近零氧化铟锡的对极化不敏感的表面等离子体极化电吸收调制器


