在 MoS2/HfO2 界面的能带对准上的氮化调查
摘要
通过 X 射线光电子能谱研究了氮化处理对少层 MoS2 和 HfO2 之间的能带排列的影响。经和未经氮化处理的 MoS2/HfO2 的价(传导)带偏移分别确定为 2.09 ± 0.1 (2.41 ± 0.1) 和 2.34 ± 0.1 (2.16 ± 0.1) eV。可调带对齐可归因于由氮化触发的 HfO2 的 Mo-N 键形成和表面带弯曲。这项关于 MoS2/HfO2 异质结能带工程的研究也可以扩展到其他高 k 电介质,以与二维材料集成以设计和优化其电子器件。
背景
目前,层状过渡金属二硫属化物 (TMDC) 因其在现代电子学和光电子学中具有潜在应用的迷人特性而引起了极大的兴趣 [1, 2]。特别是,二硫化钼 (MoS2) 作为一种有前途的通道材料,在 7 纳米技术节点之外继续进行缩放,已经吸引了相当多的关注 [3, 4]。在结构上,MoS2 晶体由一个六边形排列的 Mo 平面构成,中间夹着两个六边形排列的 S 平面。三棱柱排列是通过共价键合的 S-Mo-S 单元形成的 [5, 6]。 MoS2 具有层相关的带隙,从单层 (SL) MoS2 的直接带隙 (1.8 eV) 到块状 MoS2 的间接带隙 (1.2 eV) [7]。与具有零带隙的石墨烯不同,带隙的厚度相关调制激发了 MoS2 在光学和电气设备中的探索 [3, 8]。基于 MoS2 的物理学,少层 MoS2 的态密度是单层 MoS2 的三倍,导致弹道极限 [8] 中的高驱动电流。在这种情况下,少层 MoS2 可能比 SL MoS2 [3] 在晶体管应用方面具有显着优势。
另一方面,基于传统二氧化硅电介质的电子设备因其低介电常数而接近物理极限[9]。为了获得薄的等效氧化物厚度 (EOT),将高 k 电介质与 MoS2 集成至关重要。迄今为止,已经使用 MoS2 研究了许多高 k 电介质,包括 Al2O3、ZrO2、HfO2 和 h-BN [10,11,12,13,14]。迪斯蒂法诺等人。对于通过氧化物气相沉积在非晶 BN 上生长的少层 MoS2,分别获得了 3.3±0.2 和 1.4±0.2 eV 的导带和价带偏移 [13]。陶等人。据报道,单层 MoS2/Al2O3 (ZrO2) 异质结的导带偏移 (CBO) 推导出为 3.56 eV (1.22 eV),而价带偏移 (VBO) 为 3.31 eV (2.76 eV) [15]。 McDonnell 等人报道了 MoS2/HfO2 界面处的 CBO 为 2.09±0.35 eV,VBO 为 2.67±0.11 eV。 [12]。在这些栅极电介质中,HfO2 被认为是最有前途的候选材料之一,因为它具有高介电常数 (k ∼ 20),与多晶 SiGe、TaN 栅极和多晶硅栅极的兼容性 [16]。然而,HfO2 具有热稳定性差、漏电流大、氧化物陷阱密度高、界面陷阱密度高等优点[17]。这些限制激发了对钝化技术的广泛研究,例如界面氮化或氟化处理技术 [18, 19]。在这项工作中,我们研究了有和没有等离子体氮化的HfO2电介质上少层MoS2的能带排列,其中表面氮化的影响通过X射线光电子能谱(XPS)表征。
方法
SiO2 (280 nm)/Si 晶片用丙酮和异丙醇交替清洗,超声波清洗每 10 分钟,然后去离子水冲洗和 N2 干燥。使用 MoO3(0.08 mg,99%,Alfa Aesar)和 S 粉末(1 g,99%)的前体,通过化学气相沉积 (CVD) 在 SiO2/Si 衬底上沉积少层 MoS2 薄膜 [20, 21]。在生长过程之后,MoS2 薄膜将通过聚(甲基丙烯酸甲酯)(PMMA)方法转移到 HfO2/Si 衬底上 [22],如图 1a 所示。在此过程中,首先将 PMMA 旋涂在 MoS2/SiO2/Si 样品上作为支撑层。然后,将样品浸入 KOH 溶液中以蚀刻掉 SiO2,之后带有 PMMA 的 MoS2 层将漂浮到溶液的顶部。最后,将样品转移到 HfO2/Si 衬底上后,PMMA 层将溶解在丙酮中。 HfO2 薄膜通过原子层沉积 (ALD) 在 200 °C 的温度下使用 Hf [N (CH3)(C2H5)]4 [四(乙基甲基酰胺)铪,TEMAH] 和 H2O 蒸气作为前体在硅晶片上生长 [ 23, 24]。在等离子体处理时间的优化过程中,通过SIMS测量发现,在氮化处理70 s后,氮会大量扩散到氧化物中,这将严重恶化氧化物质量。虽然等离子体处理时间为 30 s,但从 SIMS 结果中未观察到氧化物表面的明显 N 峰。对于对照样品,在转移 MoS2 之前,在 3 Pa 的压力下对 HfO2/Si 衬底进行 50 秒 N2 等离子体处理。在等离子体条件下,合成的N剂量约为8.4×10 14 原子数/cm 2 根据二次离子质谱 (SIMS) 结果估计。根据 XPS 数据计算出氮化后的氮浓度约为 1.5%。为 XPS 测量准备了四个样品 1–4#:1# SiO2/Si 衬底上的少层 MoS2 膜(少层 MoS2),Si 衬底上的 2# 厚 HfO2 膜(块状 HfO2),3# 转移的 MoS2 膜在as-grown HfO2/Si衬底(as-grown MoS2/HfO2异质结),以及在N2等离子体处理的HfO2/Si衬底上的4#转移MoS2薄膜(氮化MoS2/HfO2异质结)。
<图片>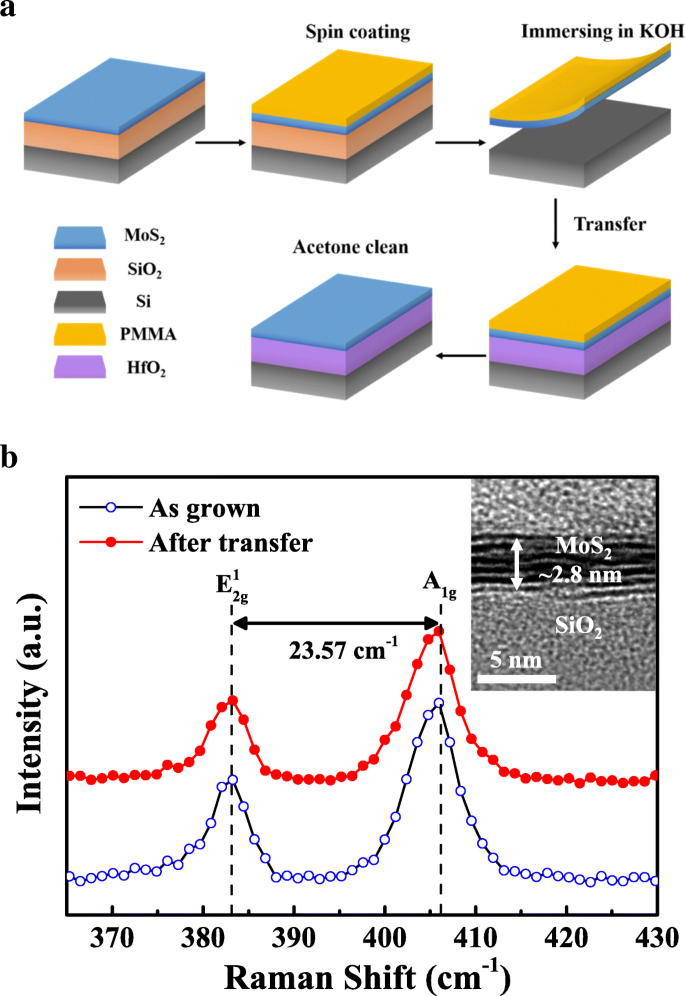
一 用于形成 MoS2/ALD-HfO2 异质结的 PMMA 辅助湿转移方法的工艺流程。 b 生长和转移的 MoS2 薄膜的各自拉曼光谱。插图是在 SiO2/Si 衬底上生长的 MoS2 的横截面透射电子显微镜图像
结果和讨论
RENISHAW inVia 拉曼光谱用于表征转移过程前后少层二硫化钼薄膜的拉曼光谱,如图 1b 所示。在 382.86 cm −1 附近可以看到两个拉曼峰 和 406.43 cm −1 , 对应于面内 (\( {E}_{2g}^1 \)) 和面外 (A 1g ) 模式,分别为 [25, 26]。发现\( {E}_{2g}^1 \) 和A 几乎没有拉曼位移 1g 转移过程后的模式频率,表明结构修改最小。频率差 (∆k ) 在 \( {E}_{2g}^1 \) 和 A 之间 1g 推导出模式约为 23.57 cm −1 ,指定大约四到五层 MoS2 薄膜 [27]。如图1b的插图所示,通过高分辨率透射电子显微镜(HRTEM)证实MoS2薄膜的厚度约为2.8 nm,这与上述拉曼光谱一致。此外,我们展示了在氮化 HfO2/Si 衬底上转移的 MoS2 膜的 SIMS 深度分布。 SIMS 测量在 Physical Electronics ADEPT 1010 SIMS 仪器上进行,Cs 初级离子束的能量为 1 keV,其中收集正离子并进行电荷补偿。在此 SIMS 测量中,氮元素被量化,而其他元素(Mo、Hf 和 Si)仅作为层标记而未量化。如图 2a 所示,氮化 HfO2/Si 衬底上转移的 MoS2 膜的深度分布由 SIMS 确定,其中以 Mo、N、Hf 和 Si 表示的主要成分的信号与深度作图。观察到 N 扩散到 HfO2 层中,这可能是由于在初级束轰击或等离子体处理过程中将 N 注入下层而引起的。还值得注意的是,由于表面污染和表面效应,例如表面附近 N 元素的异常强度 [28],表面层附近的深度剖面通常是复杂和无意义的。 HfO2/Si 界面附近 N 分布的较高信号可归因于氮倾向于扩散到 HfO2/Si 界面,导致 N 在界面附近积累 [29]。 HfO2 薄膜中的 Mo 拖尾可能主要由 SIMS 测量中的初级光束轰击引起 [30]。图2b说明了样品3#和4#各自的N 1s XPS光谱;两种异质结的高强度峰均为 Mo 3p3/2,而氮化异质结的低强度峰为~ 395.80 eV,表明形成了 Mo-N 键 [31]。
<图片>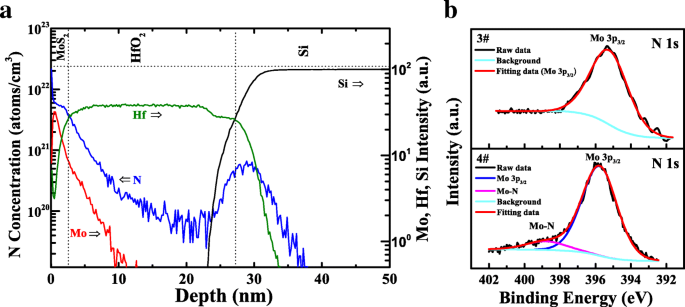
一 氮化 HfO2/Si 衬底上转移的 MoS2 薄膜的 SIMS 深度分布。 b MoS2/HfO2异质结经和未经氮化处理的N 1s XPS光谱
为了获得经过和未经氮化处理的少层 MoS2 和 HfO2 之间的能带排列,在 VG ESCALAB 220i-XL 系统上使用单色 Al Kα X 射线源(hv =1486.6 eV)进行 XPS 测量,步长为 0.05 eV )。恒定通过能量设置为 20 eV。此外,标准 C 1s (284.8 eV) 用于结合能 (BE) 校准 [32]。为了评估 MoS2/HfO2 异质结的 VBO 值,分别为样品 1-4# 选择了 Mo 3d 和 Hf 4f 核心水平 (CL)。图 3a 显示了来自样品 1# [33] 的 Mo 3d 和价带光谱的 XPS 窄扫描。因此,计算出样品 1# 的 Mo 3d5/2 核心能级和价带最大值 (VBM) 之间的结合能差 (BED) 为 228.49 ± 0.1 eV。图 3b 说明了样品 2# 的 Hf 4f7/2 和 VBM 的 CL;相应的 BED 确定为 14.10 ± 0.1 eV。图 3c 描绘了 MoS2/HfO2 异质结的 Mo 3d 和 Hf 4f CLs 经/未经氮化处理的 XPS 光谱测量值。值得注意的是,Mo 3d5/2 CL 从样品 3# 的 229.45±0.05 eV 转变为样品 4# 的 229.90±0.05 eV。这可能是由于等离子处理后在 MoS2/HfO2 界面处引入了氮化界面层,导致了上述 Mo-N 键合。随着 Mo-N 键的存在,Mo 和 N 元素之间随之发生的电荷转移有助于测量的 Mo 3d5/2 CL 位移。此外,样品 3# 的 17.40 ± 0.05 eV 的 Hf 4f7/2 CL 转变为样品 4# 的更高结合能 17.60 ± 0.05 eV,而 O 1s 也显示了 0.20 eV 的转变,以达到更高的 BED,如图所示在图 3d 中。这些峰移意味着 HfO2 表面的带向下弯曲,这可以解释为氮等离子体引起 HfO2 的供体样缺陷 [34]。基于 Kraut 方法 [35],VBO (∆E V ) 值可以通过以下等式计算:
$$ \Delta {E}_V=\left({E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S }}_2}-{E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2}\right)-\left({E}_{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2}-{E}_{\mathrm{VBM}}^{{\mathrm{Hf }\mathrm{O}}_2}\right)-{\Delta E}_{\mathrm{CL}} $$ (1)其中 \( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2} \) 和 \( {E}_{\mathrm{VBM}}^{\mathrm{Mo}{\mathrm{S}}_2} \) 是 Mo 3d5/2 CL 和 VBM 对 MoS2 的结合能,\( {E}_{ \mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) 和 \( {E}_{\mathrm{ VBM}}^{{\mathrm{HfO}}_2} \) 是 Hf 4f7/2 CL 和 VBM 对 ALD-HfO2 的结合能,∆E CL =\( {E}_{\mathrm{Mo}\ 3{\mathrm{d}}_{5/2}}^{\mathrm{Mo}{\mathrm{S}}_2}-{E} _{\mathrm{Hf}\ 4{\mathrm{f}}_{7/2}}^{{\mathrm{Hf}\mathrm{O}}_2} \) 指的是 Mo 3d5/2 之间的 BED和 Hf 4f7/2 CLs 用于 ALD-HfO2/MoS2 异质结。因此,∆E V 经氮化处理和未经氮化处理的 ALD-HfO2 上的 MoS2 含量分别为 2.09±0.1 和 2.34±0.1 eV。
<图片>
一 Mo 3d CL 的 XPS 光谱和少层 MoS2 的价带。 b Hf 4f CL 的 XPS 光谱和大量 HfO2 的价带。 c 的 XPS 光谱 Mo 3d、Hf 4f 和 d O 1s CLs在经过/未经氮化处理的HfO2上转移MoS2薄膜
评估 N2 等离子体处理对导带偏移的影响 (CBO, ∆E C ) 在 ALD-HfO2 和少层 MoS2 之间,HfO2 的带隙为 5.9±0.1 eV,MoS2 的带隙为 1.4±0.1 eV [7, 36]。因此,CBO 可以通过以下等式获得:
$$ {\Delta E}_C={E}_g^{{\mathrm{HfO}}_2}-{E}_g^{\mathrm{Mo}{\mathrm{S}}_2}-{\Delta E }_V $$ (2)其中 \( {E}_g^{{\mathrm{HfO}}_2} \) 和 \( {E}_g^{\mathrm{Mo}{\mathrm{S}}_2} \) 是 HfO2 的带隙和 MoS2,分别。根据方程。 (2)、∆E C 经和未经氮化处理的 MoS2 和 ALD-HfO2 之间的计算分别为 2.41±0.1 和 2.16±0.1 eV。相应的能带图如图 4 所示。值得注意的是,这两个异质结的 VBO 和 CBO 值都提供了出色的电子和空穴限制,确保它们适用于基于 MoS2 的 FET [37]。此外,与未氮化的异质结相比,氮化的异质结具有更高的CBO,更适合n沟道FET应用。
<图片>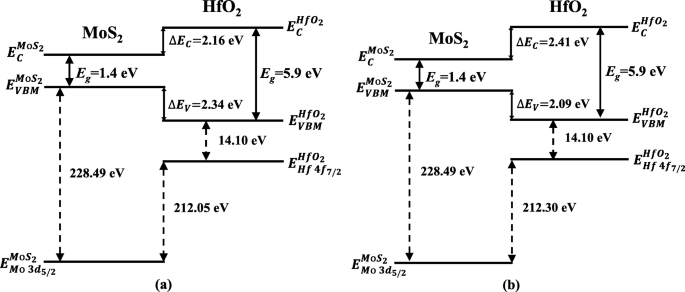
MoS2/HfO2异质结的能带图a 未经氮化处理和b 氮化处理
结论
总之,XPS 测量表明,在堆叠 MoS2 薄膜之前,可以通过在 HfO2 表面引入氮化来改变 MoS2/HfO2 界面处的能带排列。对于未氮化的 MoS2/HfO2 异质结,CBO 和 VBO 被确定为 2.16 ± 0.1 和 2.34 ± 0.1 eV,而对于氮化物,MoS2/HfO2 异质结 CBO 的变化幅度高达 2.41 ± 0.1 eV,而 VBO 的变化幅度降至 2.09 ± 0.1 eV,而对于氮化物 MoS S d /HfO2 异质结。在界面处引入了氮化界面层,发现这导致了 Mo-N 键的形成。此外,氮等离子体会引起类似供体的缺陷,导致 HfO2 的表面带弯曲。这样,界面带对准工程将为现代电子产品的灵活设计和优化提供有前景的途径。
数据和材料的可用性
支持本手稿结论的数据集包含在手稿中。
缩写
- ALD:
-
原子层沉积
- 基础:
-
结合能
- 床:
-
结合能差
- CBO:
-
导带偏移
- CL:
-
核心层
- CVD:
-
化学气相沉积
- FET:
-
场效应晶体管
- HfO2:
-
氧化铪
- HRTEM:
-
高分辨透射电子显微镜
- MoS2:
-
二硫化钼
- PMMA:
-
聚(甲基丙烯酸甲酯)
- SIMS:
-
二次离子质谱
- SL:
-
单层
- TEMAH:
-
四(乙基甲基酰胺基)铪
- TMDC:
-
过渡金属二硫属化物
- VBM:
-
价带最大值
- VBO:
-
价带偏移
- XPS:
-
X射线光电子能谱
纳米材料


