界面粗糙度散射对 GaN 太赫兹量子级联激光器性能的主要影响
摘要
已经通过非平衡格林函数的形式研究了量子阱界面粗糙度、非故意掺杂和合金无序对 GaN 基太赫兹量子级联激光器 (QCL) 性能的影响。发现合金无序对光学增益的影响可以忽略不计,非故意掺杂应保持在10 17 的合理浓度以下 厘米 −3 以防止电子杂质散射降解和自由载流子吸收。更重要的是,发现界面粗糙度散射是光学增益退化的主要因素。因此,其在制造过程中的精确控制至关重要。最后,增益为 60 cm −1 可以在300 K下获得,表明制备室温GaN太赫兹QCL的可能性。
介绍
太赫兹 (THz) 光谱区域因其在质量和安全控制、医疗诊断和电信方面的潜在应用而成为深入研究的主题。然而,由于缺乏可用的紧凑型设备,它的发展受到了阻碍。量子级联激光器 (QCL) 是开发强大的太赫兹固态源的有前途的候选者 [1, 2]。到目前为止,最好的 THz QCL 是基于 GaAs,由于 GaAs 的低 LO 声子能量 (36 meV),其最高工作温度约为 200 K [3, 4]。在磁场的帮助下,这个温度可以升高到 225 K。但是,这种方法不适合广泛的应用 [5, 6]。当温度升高时,处于高能级状态的电子可以获得足够的热能,通过向低能级状态发射 LO 声子来激活非辐射弛豫,从而破坏粒子数反转。与 GaAs 相比,GaN 具有更高的 LO 声子能量 (92 meV),因此提供了在室温下生产 THz QCL 的可能性 [7,8,9]。此外,基于 GaAs 的 QCL 不能在 4.6-12 THz 频率范围内工作,因为它们的 Reststrahlen 波段,由于光声子的吸收,材料在该光谱区域完全不透明。 GaN 中光声子的更大能量为 THz 量子级联器件开辟了前景,该器件可以在 1 到 15 THz 之间的更宽光谱范围内工作。
GaN THz QCL 的第一步研究是子带间 (ISB) 过渡到远红外域的调谐。已在极性 [10, 11] 和非极性氮化物基量子阱 (QW) [12,13,14,15,16,17] 中观察到太赫兹频率下的 ISB 吸收。分别在 13 THz [18] 和 10 THz [19] 下演示了 THz 操作的 ISB GaN 基探测器。迄今为止,除了平山小组关于 QCL 结构的自发电致发光的一些有争议的报告 [20, 21] 之外,尚未实现该范围内的电致发光演示。一些理论研究已经发表 [7, 9, 22,23,24,25,26],其中一些研究了 GaN THz QCL 性能的限制因素,例如由于电子和 LO 声子之间非常强的相互作用而导致的增益谱展宽。氮化镓[23]。
在本文中,我们建议通过分析可能损害 THz GaN QCL 光学增益的其他因素(例如量子阱的界面粗糙度、非故意掺杂和合金无序)来完成这些研究。发现合金无序对光学增益的影响可以忽略不计,非故意掺杂应保持在10 17 的合理浓度以下 厘米 −3 以防止电子杂质散射降解和自由载流子吸收 [27]。最后,我们发现界面粗糙度散射是光学增益退化的主要因素。并且增益为 60 cm −1 可以在 300 K 下获得,远高于双金属波导的理论损耗,表明制造室温 GaN THz QCL 的可能性。
方法
众所周知,GaN THz QCL 器件的制造需要生长具有低位错密度的厚有源区。由于 GaN 和 AlGaN 之间的晶格失配 [28],这项任务具有挑战性。来自外延的其他不利因素也可能出现:取决于生长条件的界面粗糙度 (IFR)、来自生长过程中杂质(主要是氧)掺入的 n 型非有意掺杂 (nid) 和源自 Ga 表面的合金无序 (AD)偏析和铝吸附原子的低迁移率。为了研究这些现象如何影响 THz GaN QCL 性能,我们使用了非平衡格林函数 (NEGF) 的形式。使用 Nextnano QCL 软件进行计算 [29,30,31]。该模型包括由界面粗糙度、电离杂质、合金无序、LO 声子、声学声子或电子-电子相互作用引起的弛豫。我们采用了具有共振声子消减方案的三量子阱 QCL,因为 THz QCL 设计提供了迄今为止的最高工作温度 [3, 32]。图 1a 显示了设计的有源区结构。一个AlGaN量子结构/AlGaN量子结构的层序为1.6 /6.2/1.6 /3.4/1.0 /3.4 nm,其中斜体表示阻挡层的厚度。图 1b 显示了设计的 QCL 结构在偏压为 - 84.5 kV/cm 时的导带图。从右侧的前一周期开始,电子通过共振隧穿在上部激光状态中注入,标记为 1。然后,它们经历辐射跃迁到下部激光状态 2。该下部激光状态通过隧穿而减少到状态 3。最后,电子通过 LO 声子发射弛豫进入状态 4。对每个时期重复该过程。
<图片>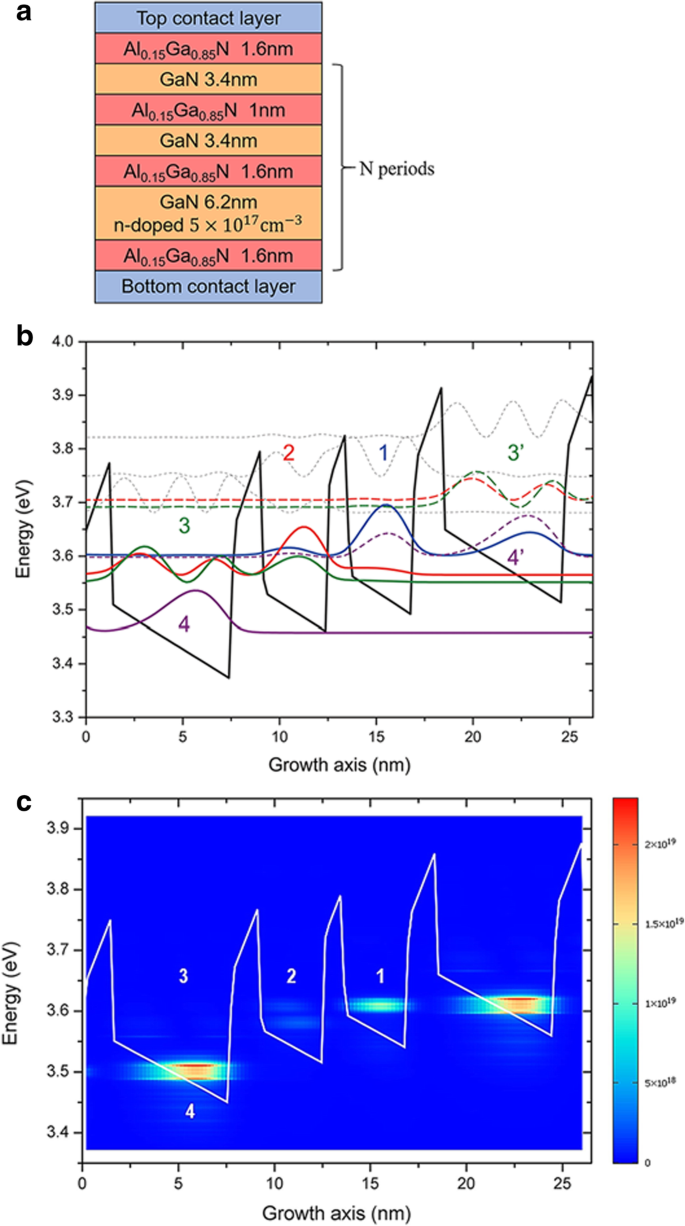
设计有源区结构、导带剖面、平方包络函数和载流子密度。 一 一个周期的层序为1.6 /6.2/1.6 /3.4/1.0 /3.4 海里。障碍以斜体字表示。 6.2 nm 厚的阱是 n 掺杂的 n =5 × 10 17 厘米 −3 . b 本研究中考虑的 GaN/Al0.15Ga0.85N QCL 的导带分布和平方包络函数。施加- 84.5 kV/cm的电场。 c 在 NEGF 模型中计算的 QCL 的载流子密度和导带。施加的电场为- 84.5 kV/cm。温度设置为 10 K。
在计算中,我们使用通常在具有等离子体辅助分子束外延 (PAMBE) 的 GaN/AlGaN 生长结构中发现的参数:界面粗糙度为 0.25 nm [33],相关长度为 1 nm,非故意 n-掺杂载流子浓度为 10 17 厘米 −3 .合金无序散射也包含在模拟中。
结果与讨论
图 1c 显示了在 - 84.5 kV/cm 的操作偏压下该结构的计算载流子密度。我们观察到前一周期和上激光状态 1 之间的反交叉。我们还看到下激光状态 2 被状态 3 和 4 的共振声子减少。为了分析和比较 IFR 的影响,nid,和 AD,我们计算了几种配置的 GaN THz QCL 光学增益和电流特性:参考配置考虑了 IFR、nid 和 AD,一个没有 IFR 的配置,另一个没有 nid 的配置,以及最后一个没有 AD 的配置。图 2 显示了在 10 K 温度下计算的每种配置的最大光学增益与频率 (a) 和电流密度与施加的电场 (b)。参考结构显示峰值增益为 142 cm -1 在 8.7 THz,砷化物材料无法达到的频率。让我们看看 n.i.d 如何影响我们的 QCL 性能。没有 n.i.d,峰值增益为 127 cm −1 在 8.46 太赫兹。增益下降是由于在带走来自 n.i.d. 的电子后,载流子浓度在上激光态中下降。实际上,在参考配置中,上下激射态的电子浓度为 ∆N =N 1 – N 2 =5.43 ×10 12 cm −2 , 而没有 n.i.d 它变成 ∆N =N 1 – N 2 =5.06 ×10 12 cm −2 .外加电场从 - 84.5 移至 - 81.6 kV/cm。电流阈值从 25.11 kA/cm 2 下降和偏移 在 − 84.49 kV/cm 至 17.11 kA/cm 2 - 93.24 kV/cm。电流密度下降可归因于电子杂质散射的减少,这在没有 n.i.d 的情况下增加了计算中的电子传输。这个假设的另一个暗示是我们在没有 n.i.d 电流密度特性的情况下看到的 - 64 kV/cm 的峰值。这是 4' 和 3 之间的周期间共振隧道(此处未显示)。这种现象被电流特性中的电子杂质散射所掩盖,考虑到 n.i.d。电流阈值和施加的电场位移归因于具有或不具有 n.i.d. 的配置之间的导带未对准。有趣的是,即使在 n.i.d 情况下增益峰值更大,我们观察到增益谱变宽,带电杂质影响的特征 [31] 非故意掺杂应保持在合理的浓度 10 17 厘米 −3 以防止电子杂质散射降解和自由载流子吸收。在没有 AD 散射的配置中,峰值增益为 147 cm −1 在 8.7 太赫兹。我们观察到峰值增益在有或没有 AD 散射的情况下处于相同的频率。当计算中不包括 AD 散射时,光学增益仅获得 3% 的边际增加。电流特性也几乎相同。由于我们的设计使用了 15% 的低铝含量和相当薄的势垒(1-1.5 nm),因此该 QCL 中的 AD 散射影响可以忽略不计。
<图片>
针对不同散射过程的模拟最大光学增益与频率和电流-电场模拟。 一 考虑到不同的散射过程,模拟光学增益与频率的关系。 b 考虑不同散射参数的 GaN THz QCL 电流-电场模拟。温度设定为10 K
相反,IFR 散射对器件性能的影响很重要。在没有 IFR 散射的情况下,我们观察到峰值增益为 191 cm −1 在 8.7 太赫兹。电流密度阈值为 24.08 kA/cm 2 . 34% 的增益增加和电流密度阈值下降反映了大量电子通过 IFR 散射传输的事实。 IFR 散射越多,激光产生的辐射散射就越少。比较上下激光态的参考配置电子布居时∆N =N 1 – N 2 =6.6 ×10 12 – 1.27 ×10 12 =5.43 ×10 12 cm −2 到没有 IFR ∆N 的那个 =N 1 – N 2 =7.4 ×10 12 – 1.17 ×10 12 =6.23 ×10 12 cm −2 ,可以看出上能态电子数量更高。这是由于没有 IFR 散射导致上激光态寿命增加。与没有 nid 的情况相比,在没有 IFR 散射的器件的电流密度特性中,我们观察到 - 67 kV/cm 处的峰值,这是 4' 和 3 之间的周期间共振隧道的特征。这种现象更加明显在不考虑 IFR 散射过程的情况下。这证明了它优于共振隧道效应。通过这些观察,我们强调了 IFR 散射对 THz GaN QCL 性能的影响。
在注意到 IFR 散射在太赫兹性能中的重要性之后。我们通过改变 IFR 大小进一步调查。我们将 IFR =0.5 nm 和 0.75 nm 的情况添加到我们的研究中。相关长度保持在 1 nm。在图 3 中,我们显示了最大增益与频率 (a) 以及电流密度与外加电场特性 (b)。首先,我们观察到对于 IFR =0.5 nm,最大光学增益降低到 47.9 cm -1 甚至急剧下降到− 8.8 cm −1 IFR =0.75 nm的光学增益损失。作为 IFR 长度的函数的增益展宽也很明显。正如我们在 I-V 特性中所见,随着 IFR 尺寸的增加,它在电子散射中的作用增加,电流密度增加,器件中的谐振隧道和辐射散射过程减弱。当将 IFR =0.25 nm 的参考配置与 IFR =0.75 nm 的极端情况进行比较时,这种效应变得明显,上部和下部激光状态的电子数量从 ∆N 下降 =5.43 ×10 12 cm −2 ΔN =N 1 – N 2 =3.71 ×10 12 cm −2 .
<图片>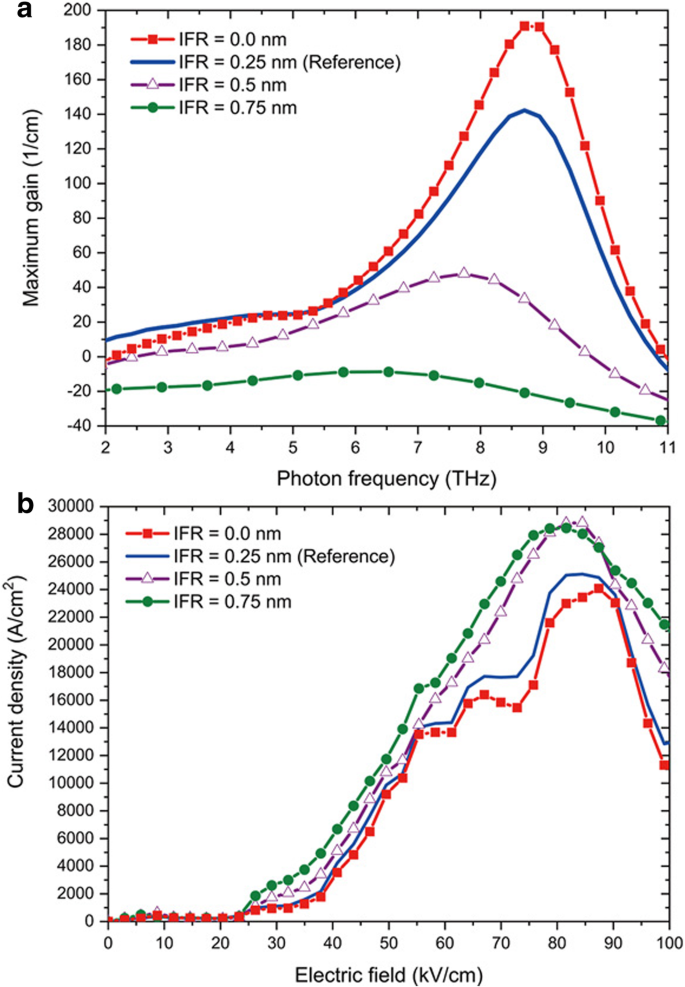
针对不同 IFR 的模拟最大光学增益与频率和电流-电场模拟。 一 模拟不同 IFR 的最大光学增益与频率。 b 考虑不同 IFR 的 GaN THz QCL 的电流-电场模拟。温度设定为10 K
后者减少到我们再也看不到设备中的激光。正如之前使用基于 GaAs 的 THz QCL [25, 34,35,36] 的研究中已经指出的那样,我们强调了在外延过程中考虑 IFR 尺寸并将其保持小于 0.5 nm 以制造 GaN THz QCL 的重要性,以便能够提供正光学增益。
GaN THz QCL 的一个优势是它有可能在比基于 GaAs 的 THz QCL 更高的温度下运行。在这一部分,我们分析了我们的器件性能与工作温度的关系。我们继续使用我们的参考设备,其中 IFR =0.25 nm、n.i.d 和 AD 包含在计算中。图 4 显示了不同晶格温度的最大光学增益。增益值在 142 cm −1 附近稳定在 10 到 150 K 之间 ,它在 150 到 250 K 之间开始下降,下降到 61 cm −1 在 300 K。事实上,随着温度的升高,由于热回填和 LO 声子散射增加导致增益展宽,粒子数反转减少。这个光增益值为61 cm −1 仍然高于 GaN THz QCL 双金属波导的损耗 (30 cm −1 ),表明该 GaN THz QCL 设计应该能够在室温下运行。我们还提到,除了能够在室温下工作之外,基于 GaN 的 THz QCL 还具有另一个优势:由于它们具有更高的掺杂浓度、更低的折射率和更短的周期长度,它们有可能提供比他们的 GaAs 对应物。我们的设计提供了相当高的光学增益值 142 cm −1 在 10 K,这是一个很好的例子。
<图片>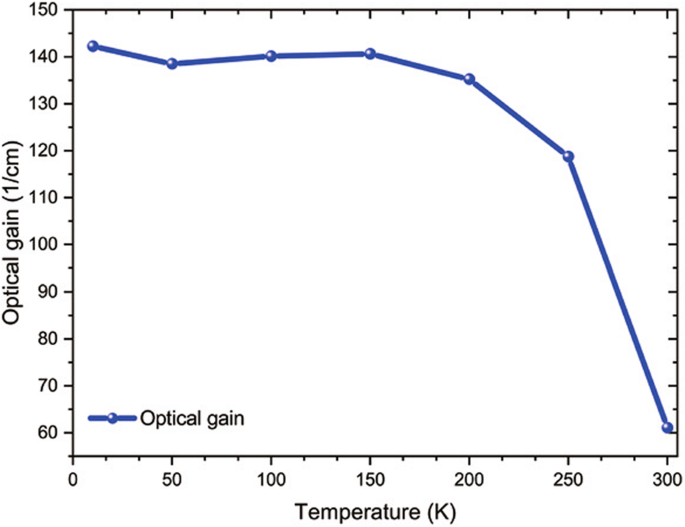
计算的最大增益与晶格温度的特性
结论
总之,我们报告了在 8.7 THz 下运行的 GaN THz QCL 设计。模拟显示光增益为 142 cm -1 在 10 K 和 60 cm −1 在室温下。在源自外延的不良现象中,我们计算了界面粗糙度、非故意掺杂和合金无序对 GaN THz QCL 增益性能的影响。合金无序影响可忽略:光学增益仅从 147 下降到 142 cm −1 在模拟中添加合金无序散射时。设计中应考虑非故意掺杂,以防止导带未对准。在我们的研究中,我们确实观察到了由 n.i.d 引起的外加电场从 - 84.5 到 - 81.6 kV/cm 的偏移。最后,我们观察到不同界面粗糙度值的光学增益存在很大差异:191、142、47.9 和 - 8.8 cm -1 界面粗糙度分别等于 0、0.25、0.5 和 0.75 nm。这就是为什么我们确定界面粗糙度散射对光学增益退化的主要影响。该工作为最终未来GaN THz QCL制造的性能优化提供了途径。
数据和材料的可用性
在当前研究期间生成和/或分析的数据集可根据合理要求从相应作者处获得。
缩写
- 广告:
-
合金紊乱
- IFR:
-
界面粗糙度
- ISB:
-
子带间
- n.i.d:
-
非故意掺杂
- NEGF:
-
非平衡格林函数
- QCL:
-
量子级联激光器
纳米材料


