1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
摘要
变质 InAs/In x 的光电特性 Ga1 − x 由于在室温下研究了量子点 (QD) 纳米结构,因此采用光电导 (PC) 和光致发光光谱、电学测量和理论建模。具有不同化学计量的 In x 的四个样品 Ga1 − x 随着包层的生长:铟含量x 为 0.15、0.24、0.28 和 0.31。发现 InAs/In0.15Ga0.85As QD 结构在 1.3 μm 的电信范围内具有光敏性。作为 x 增加,所有样品都观察到红移,具有 x 的结构 =0.31 被发现在 1.55 μm 附近敏感,即在第三个电信窗口。同时,随着 x 的增加,QD PC 仅略有下降 ,从而证实了与 In0.15Ga0.75As 结构和基于 GaAs 的 QD 纳米结构之一相当的良好光响应。此外,PC 减少与光致发光强度的类似减少相关。通过从理论上模拟量子点中的量子能量系统和载流子定域,我们深入了解 PC 机制,并能够通过将它们与此类结构中缺陷的特殊行为相关联来提出光电流降低的原因。所有这些都意味着具有高 x 的变质量子点 是光电红外光敏器件的有效结构。
背景
变形 InAs/In x Ga1 − x 由于 QD 纳米结构具有许多优点,因此在过去十年中引起了极大的兴趣 [1,2,3,4,5,6,7]。它们最吸引人的特点是,通过在 InGaAs 变质缓冲层 (MB) 上生长 QD,相对于传统的 In(Ga)As/GaAs QD 结构,可以显着降低 QD 能级之间的跃迁能 [8] .这是由于 InAs QD 和 InGaAs 缓冲液之间的晶格失配降低导致 InAs QD 带隙的减小,从而导致 QD 中的应变 [9,10,11]。因此,将 MB 作为限制材料的应用允许将发射波长值更深地转移到红外 (IR) 范围内,特别是转移到 1.3 和 1.55 μm 的电信窗口,同时保持高效率 [4, 12, 13]。此外,变质量子点已经显示出有趣的特性,例如 (i) 高量子点密度 [14],(ii) 广泛调整量子点和润湿层 (WL) 水平的可能性 [10, 15],以及 (iii) 良好的性能发光器件中的活性元素 [16]。然而,最近对变质 QD 中深能级的研究表明,尽管 InAs/In0.15Ga0.85As QD 结构的总缺陷密度接近 QD 层与 InGaAs/GaAs 假晶 QD 相当,但具有更高 x 表现出更高的缺陷密度[17, 18]。
变质 InAs QD 结构已成功应用于设计和制造红外光子和光敏器件,例如激光器 [19, 20]、单光子源 [3, 7, 21, 22] 和太阳能电池 [23] ,24,25]。基于带间和子带间跃迁的 In(Ga)As QD 光电探测器目前正在积极研究以增强从近红外到长波红外范围的探测,因为它们对法向入射辐射的响应 [26,27,28,29,30] .例如,可以通过在 InGaAs 层中嵌入 InAs QD 来设计电子在量子限制能级和连续态之间的子带间跃迁 [29,30,31,32],因为这种设计允许调整检测峰值波长,以控制通过外部施加的偏压来响应并减少暗电流 [33, 34]。迄今为止,还没有关于在光电探测器中实现变质量子点结构的论文。
该领域发展的关键作用是保持变质 QD 结构的高发射效率和光敏性,这些结构至少需要与传统 InAs/GaAs QD 结构相媲美 [1, 5, 35]。在基础和应用领域进行了大量研究,以开发结构设计 [6, 14, 21],改善光电性能 [5, 13],以及控制/减少异质结构中与应变相关的缺陷 [4, 36, 37]。
因此,InAs/In x Ga1 − x 由于变质 QD 纳米结构是有趣的纳米结构,它允许在 1.3 和 1.55 微米红外范围内具有发射或光响应性 [1,2,3,4,5,6,7]。此外,我们之前报道过垂直 InAs/In0.15Ga0.75As QD 结构可以保持与 GaAs 基结构相当的光敏性 [5]。然而,在横向几何的光电测量中很少研究这种变质结构,其中光电流通过载流子跨两个顶部触点之间的通道的面内传输进行。通常,QD 层连同相关的 WL 在横向几何设计的基于 GaAs 的结构中形成这些导电通道 [38]。由于这种特殊类型的导电性,具有横向传输的 QD 光电探测器被认为具有高光响应性的潜力 [39, 40]。深入研究横向配置中的变质 InAs/InGaAs QD 纳米结构可以提供有关光电导 (PC) 机制和平面载流子传输效率的基础知识。在我们最近关于变质 QD 结构缺陷的论文中 [17],我们报告了低温下的横向 PC 测量,仅考虑源自缺陷的红外光谱边缘。然而,我们相信,在室温下对结构进行适当的表征和基础研究可以通过实施变质量子点为进一步改进新型光敏器件(如近红外光电探测器、线性阵列和相机矩阵)提供宝贵的见解。
在目前的工作中,我们研究了变质 InAs/In x 的面内光电特性 Ga1 − x 不同In组成的分子束外延生长QD纳米结构x ,采用 PC 和光致发光 (PL) 光谱、横向电测量和建模计算。特别是,我们专注于观察 QD 层光响应可能向 IR 超过 1.3 μm 的红移,同时保持 In0.15Ga0.85As 和 GaAs QD 光敏结构的光敏性。室温下近红外波长范围内的高光敏性表明,这些纳米结构不仅可用于基于带间跃迁的器件,还可用于工作在 10 μm 以上的子带间光电探测器。
方法
样品准备和说明
图 1 中示意性显示的研究结构是通过分子束外延生长的。首先,半绝缘 (100) GaAs 衬底在 600 °C 下被 100 nm 厚的 GaAs 缓冲液覆盖,然后在 490 °C 下沉积 500 nm 厚的未掺杂 InGaAs MB。然后,在预先中断 210 秒的生长以冷却衬底后,在 460°C 下生长 3.0 ML(单层)InAs。最后,这些自组装 QD 被 20 nm 的未掺杂 In x 覆盖 Ga1 − x 与相同的 MB 化学计量一样。具有不同化学计量的 In x 的四个样品 Ga1 − x 由于已制造包层:在内容x 分别为 0.15、0.24、0.28 和 0.31。
<图片>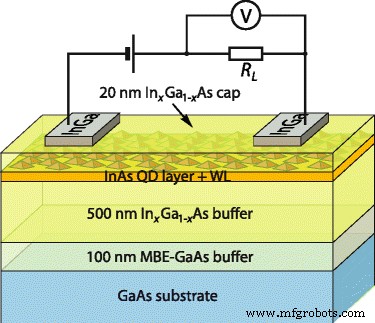
颜色在线。变质 InAs/In x 的方案 Ga1 − x 用于光电测量的量子点结构及其连接
理论建模
为了变质结构设计以及对能量分布的理解,使用我们证明的 Tibercad 软件 [41] 进行了由 In(Ga)As QD、未掺杂的 MB 和帽层组成的量子能量系统的计算足以模拟半导体低维纳米结构的光学特性[2, 15, 42]。
我们考虑从实验原子力显微镜数据中获取的具有截锥形形状和尺寸的 InAs QD [14];我们包括 InAs WL 的存在,其参数取决于 In x Ga1 − x 作为变质层特性[15]。
首先,通过计算由错配 f 引起的 QD 的应变张量分量,对结构进行应变计算 QD和MB之间的QD,定义为
$$ {f}_{\mathrm{QD}}=\left[{a}_{\mathrm{InAs}}\hbox{--} {a}_{\mathrm{MB}}(x)\right ]/{a}_{\mathrm{MB}}(x) $$ (1)其中 a MB(x ) 是 In x 的晶格参数 Ga1 − x 作为 MB 和 a InAs 是 InAs 的晶格参数。然后,QDs 和嵌入层的能带分布取决于相关材料(QDs 和 WLs 的 InAs 和 MB 的松弛 InGaAs)的变形潜力。
最后,薛定谔方程
$$ \boldsymbol{H}\psi =E\psi $$ (2)通过对电子的单能带有效质量方法和对空穴的 6 能带 k•p 方法在包络函数近似中求解,其中 3D 哈密顿量是
$$ \widehat{H}=-\frac{\upeta^2}{2}{\nabla}_{\mathbf{r}}\left(\frac{1}{m\left(E,\mathbf{ r}\right)}\right){\nabla}_{\mathbf{r}}+V\left(\mathbf{r}\right), $$ (3)V (r ) 是 3D 潜力。
在进行 QD 基态计算时,这种近似被认为是令人满意的 [2]。从而获得电子和重空穴的地电平以及它们的概率密度。光致发光发射能量取自电子和重空穴的受限能级之间的能量差,考虑激子效应减少20 meV。
模型计算的更详细描述可以在参考文献中找到。 [2].
光电表征
对于横向光电测量,两个 InGa 共晶表面触点沉积在 5 × 2 毫米的结构件上。测量线性I –V 图 2 中给出的特性证实了接触电阻。通过 Siglent SDM3055 万用表测量流过样品的电流,使用标准直流技术 [43, 44] 作为串联负载电阻 R 上的电压降 L 1 MΩ,远小于样品电阻。光电流由带有棱镜单色器的 250 瓦卤素灯激发,PC 光谱记录在 0.6 到 1.6 eV [44,45,46] 的范围内。光谱被归一化为光源的激发量子数。 PL 光谱是使用 532 nm 激光作为激发源获得的,功率密度为 5 W/cm 2 .所有测量均在室温 (300 K) 下进行。
<图片>
颜色在线。 我 –V InAs/In x 的特性 Ga1 − x 作为带有 x 的结构 =0.15 (a ), 0.24 (b ), 0.28 (c ) 和 0.31 (d ) 用于黑暗(黑色)和 350 μW/cm 2 (颜色)处于 PL 光谱峰值(QD 激发)和 1.3 eV(InGaAs 中的有效吸收)的能量。插图:光电流对偏置电压的依赖性
结果与讨论
研究的变质 InAs/In x 的 PC 光谱 Ga1 − x 由于室温下的 QD 结构与 PL 带一起在图 3 中给出,其显示了 QD 基态之间的光学跃迁。 PL 带的相对强度和位置也显示在图 4b 中。在 PC 曲线上观察到 QD、InGaAs 限制层和 GaAs 底层的特征。 PL 波段起始能量以下的光电流信号可能与早期检测到的结构缺陷有关 [17]。
<图片>
颜色在线。变质 InAs/In x 的 PC 光谱 Ga1 − x 作为室温下的结构,x 的偏置电压为 11 V =0.15 (a ), 0.24 (b ), 0.28 (c ) 和 0.31 (d )。 1.3 eV 下黑色、红色和蓝色曲线的激发强度分别对应于 88、350 和 1400 μW/cm 2 , 分别。为 QD 基态跃迁的能量定位给出了任意单位的 PL 谱。垂直箭头标记 InGaAs 带隙 (ε g ) 按照 Paul 等人计算。 [48] 和光谱位置,其中测量了 PC 对激发强度的依赖性(图 5 中给出)
<图片>
颜色在线。变质 InAs/In x 的建模计算 Ga1 − x 作为 QD 结构:a 具有不同x的结构中的能带分布 沿增长轴; b 真实的 QD PL 波段及其计算出的峰值位置(垂直虚线);和 c InAs/In0.15Ga0.85As QD 的受限电子和空穴的概率密度。模拟结构的所有计算均在 300 K
发现研究的变质 InAs/In0.15Ga0.85As QD 结构在电信范围内具有 0.95 eV (1.3 μm) 的光敏性(图 3a)。作为 x 增加,所有样品都观察到红移:具有 x 的结构 =0.31 被发现在 0.8 eV (1.55 μm) 附近敏感(图 3d),即在第三个电信窗口 [47]。这种转变与 InAs QD 和 In x 材料之间晶格失配的减少有关 Ga1 − x 作为缓冲区增加 x 因此,量子点的应变减少。这导致 InAs QD 带隙变窄,进而导致 PL 带红移以及光响应开始向 IR [1,2,3,4,5,6,19,35]。
同时,记录到的 QD 光电流信号仅略有下降,从而证实了良好的光响应性的保持,与 In0.15Ga0.75As 样品的光响应性相当。正如我们最近讨论的 [5],带有 x 的变质 QD 结构 =0.15 显示与假晶 InAs/GaAs QD 纳米结构非常相似的光响应。此外,PC 减少与 PL 相关,如图 3 所示。
我们的样本的这种效果在图 2 中最为显着,其中 I –V 显示了在黑暗和光照下不同特征光谱点对偏置电压的依赖性,以及插图中的光电流依赖性。与图 3 一样,光电流值仅表示通过减去暗电流值从光照下的总电流中获得的光感应电流部分。这些光谱点是 PL 波段最大值和 1.3 eV,其中 InGaAs MB 中出现有效的带间吸收。以及黑暗我 –V 特征,这些依赖关系在实验误差范围内是线性的。
最好的光响应是在限制层中具有最小 In 含量的结构中测量的。它还具有最低的暗电流。外加激发水平下的光电流值 (350 μW/cm 2 ) 在 InAs/In0.15Ga0.85As 结构中,当 MB 泵浦时,暗电流是暗电流的两到三倍。 QD 激发下的光响应与暗电流相当;然而,应该考虑到我们的结构只有一个 QD 层。多层 QD 结构的制造肯定会导致红外光响应的显着增加。 x 较高的其他结构 显示较低的光电流信号;在很宽的施加电压范围内,在两个光谱点检测到的幅度都比暗电流值低大约一个数量级。发现具有最大MB In含量的InAs/In0.31Ga0.69As结构的光响应最低。
最有可能的是,这种光响应性降低与随着 x 的 MB 缺陷密度的增加有关 ,这是早期为这些结构确定的,采用深能级热刺激电流光谱 [17],与此类纳米结构的结构分析密切相关 [1]。我们已经报道了 InAs/In0.15Ga0.85As QD 结构的总缺陷密度接近 QD 层,与 InGaAs/GaAs 相当,而其他具有较高 In 含量的结构表现出更高的缺陷密度,如已知的 GaAs 相关点缺陷复合物 EL2、EL6、EL7、EL9 和 EL10 在 QD 层附近以及归因于通过缓冲区传播的扩展缺陷的三个能级。
关于光谱形状(图 3),在 QD 激发上方,光吸收以及因此,载流子生成主要发生在能量高于 InGaAs 限制层带隙 ε g 的 MB 中 , 不同 x 的值 由经验公式估计 [48]。然而,值得注意的是,超过 ε g 的光子能量增加 导致光响应略有下降。自然地,这证实了变质量子点尽管是有效的复合中心 [1, 2, 12, 22],但比 MB [5, 6, 23] 更有效地贡献了光电流。
要了解这种特性的 PC 机制,我们应该查看图 4a,我们在其中显示了沿样品生长方向计算的 QD 带分布图。计算通过电子和空穴的量子能级结果进行验证:预期的 PL 发射能量与实验测量的 PL QD 基态跃迁一致(图 4b)。在图 4c 中,我们显示了受限电子和空穴的模拟概率密度,该概率密度是通过使用 Tibercad 模型计算的载流子波函数获得的,表明与电子相比,重空穴具有更高的局域化水平。
为了有助于光电流信号,由 QD 带间吸收产生的电子 - 空穴对必须通过热发射从 QD 中逸出。在之前的一项研究 [49] 中,已经确定在变质 QD 中,电子和重空穴作为相关对同时从 QD 中逸出。此外,还证明了该过程的活化能对应于两个粒子的活化能之和[50]。
在研究变质 QD 的 PL 发射热猝灭时 [10, 51],我们证明这种激活能等于 WL 能级和 QD 状态的能量距离之和,对于 x x =0.15 至 150 meV =0.31。正如参考文献中广泛讨论的那样。 [51],这些值通过受限载流子的热逃逸导致室温下PL发射的强烈猝灭。
在此基础上,我们可以推断在 QD 中激发的载流子可以热逃逸到 WL 和 MB:在那里,电子和重空穴被 QD 附近的带弯曲分开(图 4a),这促进了空穴捕获回 QD并且,同时作为电子的屏障,从而有效地抑制它们的辐射复合。因此,重空穴集中在 QD 外围(图 4c),而电子可以沿着 WL 和 MB 的势阱自由移动,从而有助于导电。值得注意的是,在 Ref. [49] 讨论了尽管在逃逸过程中相关,但载流子在室温下不能被视为激子;今后,可以很容易地通过量子点附近的能带弯曲将它们分开。
否则,当激发 MB 时,会在限制层中产生非平衡空穴并与电子复合。这里应该提到的是,已知 WL 是基于 GaAs 的纳米结构的导电通道 [52],并且在我们设计有表面接触的横向结构中,没有异质结,因此载流子在表面附近被有效地收集。
在图 3 中,PC 信号刚好高于 ε g 转化为更高能量下的上升,例如,对于具有 x 的样品,高于 1.3 或 1.1 eV 分别为 0.15 或 0.31。可以想象,这是由更靠近表面和 QD 层的光吸收引起的,因此涉及较浅的陷阱。正如通过热刺激电流光谱和深能级瞬态光谱 [17, 18] 为这些结构建立的那样,较深的电子陷阱主要位于 InGaAs MB 层中,而较浅的电子陷阱集中在表面附近(与这些样品有关, QD 层附近)。在室温下,被困在较浅陷阱中的电子可以更容易地逃回导带。因此,QD 层附近的自由电子比在 MB 中更深激发的自由电子更易移动,因此对电荷转移有更高的贡献。此外,在表面附近产生的电子可以自由地转移到WL导电通道。
在 GaAs 带隙(接近 1.4 eV)以上增加后,观察到类似的光电流下降。这种效应可能是由于靠近 InGaAs/GaAs 界面的载流子生成造成的,已知该界面具有更高的缺陷态密度,即陷阱和复合中心。
不同光学跃迁对结构光响应的相对贡献随泵浦强度而变化。这在图 5 中可以更好地观察到,它显示了光电流值作为不同特征光谱点激发强度的函数:PL 带的开始(QD 系综的共振激发)或 InGaAs 中的有效带间吸收(1.3 eV) 和 GaAs (1.5 eV)。
<图片>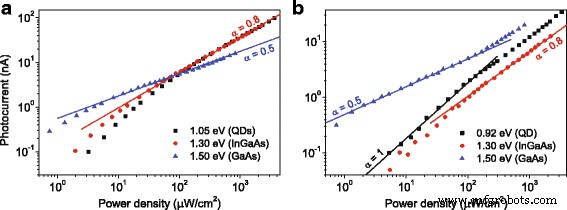
颜色在线。 InAs/In x 的光电流与激发强度的关系 Ga1 − x 作为带有 a 的结构 x =0.15 和 b 0.31。这些线是函数 f 的拟合 (x ) ~ x α
限制层中具有不同 In 含量的结构在等效光谱范围内表现出相似的依赖性。因此,GaAs (1.5 eV) 中的带间激发在大多数强度值下显示出二次相关性。这对于非平衡载流子的带间复合是典型的,例如当它们在平衡载流子下高度占主导地位时 [53]:这在我们的未掺杂结构中是可以预料的。 QD 和 InGaAs 限制层中激发的相关性彼此非常相似,但与 GaAs 的相关性不同。它们在低激发强度下呈线性,在较高强度下变为亚线性。这种行为显然表明了涉及肖克利读取中心的载波重组:线性相关性变为次线性,因为一些中心在更高的载波生成率下饱和 [54]。这些强度相关测量结果清楚地表明,在 QD 嵌入层中以相对低的复合率有效生成主要电荷载流子,而在 GaAs 层中复合中心的密度要高得多。例如,在类似表征中的 QD 激发期间,InGaAs/GaAs QD 光敏结构表现出对强度的依赖性为 PC (我 ) ~ 我 0.25 ,这是由于通过缺陷水平的高非辐射复合率以及 QD 辐射复合 [40, 55] 而发生的。然而,值得注意的是,InGaAs/GaAs 结构是多层的,具有七个 QD 层。
从这些测量及其解释中,可以突出显示使用变质 QD 进行 IR 检测的一些迹象:(i) 当使用 x> 0.15,应该使用允许控制应变相关缺陷的先进设计,类似于为开发变质量子点所做的[19,20,37]; (ii) 需要多层量子点堆叠(至少 10 层)才能获得高于暗电流的量子点 PC [27, 56]; (iii) 由于重空穴的更高限制有利于激发 QD 时获得的光电流,因此可以考虑对重空穴具有更高间隙势垒的先进设计 [51, 57]。因此,这些发现对于以红外检测为目标的变质量子点的设计和变质量子点光电探测器的开发具有重要意义。
结论
变质 InAs/In x 的光电特性 Ga1 − x 由于 QD 纳米结构是在室温下研究的,因此采用 PC 和 PL 光谱、电测量和理论模型模拟。研究的变质 InAs/In x Ga1 − x 由于发现 QD 纳米结构在 1.3 (x =0.15) 和 1.55 μm (x =0.31)。然而,估计 MB 中具有较高 In 含量的结构的 QD PC 和 PL 效率较低,但与 InAs/In0.15Ga0.85As 结构相当,其灵敏度与 InGaAs/ GaAs QD 结构。这种光响应性降低与 MB 缺陷密度随 x 的增加有关 .此外,由于建模计算,我们深入了解了所研究的 QD 结构类型中的 PC 机制。所有这些都意味着具有高 x 的变质量子点 是光电红外光敏器件的有效结构,前提是通过优化纳米结构的设计来解决一些问题。
缩写
- ε g :
-
InGaAs限制层的带隙
- E c 和 E :
-
电导率和价带能量
- IR:
-
红外线
- MB:
-
变质缓冲液
- ML:
-
单层
- PC:
-
光电导
- PL:
-
光致发光
- QD:
-
量子点
- R :
-
负载电阻
- WL:
-
润湿层
纳米材料
- N,N-二甲基甲酰胺调节 MXene 量子点的荧光,用于灵敏测定 Fe3+
- 基于微柱中 InAs 双层量子点的 1.3 μm 明亮单光子源
- 合成富含吡啶的 N、S 共掺杂碳量子点作为有效的酶模拟物
- 检测自组织 InAs/InGaAs 量子点超晶格中的空间局域激子:提高光伏效率的一种方法
- 退火 GaAsBi/AlAs 量子阱中的铋量子点
- 变质 InAs/InGaAs/GaAs 量子点异质结构光电压的双极效应:光敏器件的表征和设计解决方案
- 从豆腐废水中合成荧光碳量子点的简单方法
- 水溶性硫化锑量子点的合成及其光电特性
- 石墨烯/Ag3PO4 量子点复合材料的简便一步声化学合成和光催化性能
- 消除 InAs/GaAs 量子点中的双峰尺寸,用于制备 1.3-μm 量子点激光器
- 水溶性蓝色发光锰合金碲化碲化镉量子点的合成和性质
- 数据总线的完整概述:连接点!


