一种通过 PECVD 沉积低缺陷密度 nc-Si:H 薄膜的便捷有效方法
摘要
氢化纳米晶硅 (nc-Si:H) 薄膜作为一种有前途的平板显示晶体管、太阳能电池等材料受到了广泛关注。然而,nc-Si:H 的多相结构导致了许多缺陷。主要挑战之一是如何方便地减少缺陷。在这项工作中,我们开发了一种简单有效的方法来沉积低缺陷密度 nc-Si:H 薄膜。这种方法只是通过在等离子体增强化学气相沉积 (PECVD) 工艺中在高压范围内调整沉积压力。 nc-Si:H 的微观结构通过拉曼、AFM 和 SEM 进行表征。此外,我们专注于作为光伏材料关键特性的缺陷密度,并实现了 3.766 × 10 16 厘米 −3 .该缺陷密度低于之前在 PECVD 工艺中通过其他复杂方法制造低缺陷密度 nc-Si:H 的研究。 nc-Si:H 的少数载流子寿命因此大大提高。此外,我们还论证了沉积压力对离子轰击的影响机制,并证明了缺陷密度是nc-Si:H光伏材料的关键特性。
背景
薄膜硅技术进步的一个重要里程碑是高质量氢化纳米晶硅(nc-Si:H)的开发。与氢化非晶硅 (a-Si:H) 相比,nc-Si:H 具有更高的迁移率,在大于 800 nm 的波长下具有更好的响应,并且更不容易受到 Staebler-Wronski 降解的影响 [1, 2]。 nc-Si:H 薄膜可以使用等离子体增强化学气相沉积 (PECVD) 进行沉积,这使其与发达的集成电路行业兼容。因此,nc-Si:H薄膜在薄膜晶体管[3]、光电探测器[4]、太阳能电池[5]等各种器件中有着广泛的应用。
然而,作为一种多相材料,nc-Si:H薄膜在晶体/非晶相界面和晶体之间存在空隙和悬空键等缺陷。众所周知,原子氢是沉积高质量nc-Si:H的关键,缺陷较少[6]。原子氢可以使悬空键饱和,并且已经指出 [7] 生长表面上的原子氢在比熔化温度低得多的温度下引起晶体生长。因此,更多的原子氢有利于高质量 nc-Si:H 的沉积。为了增加生长表面上的原子氢通量,高氢稀释或硅烷耗尽对于nc-Si:H生长至关重要。
在 PECVD 中减少硅烷产量是为了提高射频 (RF) 功率 [7]。但是简单地增加功率会显着增加对生长表面的离子轰击,这可能会导致更多的缺陷。因此,应使用直流 (DC) 偏压来抑制离子轰击。然而,如果增加射频功率以获得更多的原子氢,直流偏置也应该改变。否则,直流偏置不能有效地减轻离子轰击。而在一定的射频功率下,合适的直流偏置必须经过大量的实验才能找到。提高原子氢含量的另一种方法是增加沉积压力。电子-分子碰撞频率随着沉积压力而增加。它使SiH4和H2的解离率上升。 SiH4 和H2 的分解产生原子氢[8]。因此,增加沉积压力可以提高原子氢含量。
因此,在本文中,我们建议在高压范围内调整沉积压力以获得更多的原子氢(常规沉积压力为 50-100 Pa)。在PECVD工艺中是一种方便有效的方法。通过使用这种方法,与先前关于制造低缺陷密度 nc-Si:H [5, 9, 10] 的研究相比,在一定压力下沉积的薄膜具有更低的缺陷密度。并且已经实现了高少数载流子寿命。此外,与之前关于不同沉积压力对样品宏观或一般性能影响的报道相比[11, 12],我们显着扩展了沉积压力的范围,并不仅关注其对样品一般性能的影响(例如,结晶度)以及缺陷密度和少数载流子寿命,这是高质量光伏材料的关键特性。此外,我们已经证明了沉积压力对离子轰击影响的机制,而之前的报道只是进行了一般性讨论。并且我们进一步证明了离子轰击并不是越弱对膜的生长越好(离子轰击的程度要合适)。最后,我们证明了缺陷密度是nc-Si:H光伏材料的关键特性。
方法/实验
通过电容耦合PECVD系统(反应器示意图如图1a所示)在不同的沉积压力下,nc-Si:H薄膜在康宁玻璃上生长。沉积压力从 150 Pa 增加到 1050 Pa,步长为 150 Pa。所有样品都使用 13.56 MHz 的射频和 0.32 W/cm 2 的功率密度沉积 ,总气体(SiH4 和 H2)流速为 110 sccm(SiH4 浓度为 0.727%)。衬底温度保持在250 ℃,沉积时间为2 h。
<图片>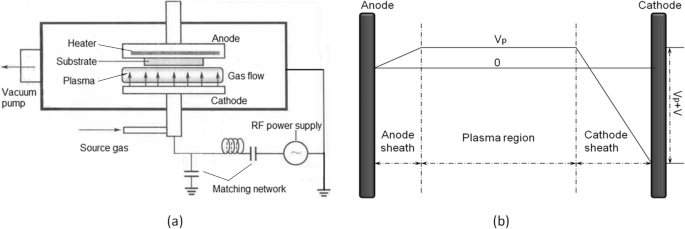
a的示意图 PECVD反应器和b 电极间电位分布 (V p ,等离子体电位; V , 均方根 RF 电位)
结晶度X c 由使用紫外微拉曼光谱仪(Jobin Yvon LabRam,HR800)在反向散射模式下使用 514.5 nm 的 Ar 离子激光器测量的拉曼光谱计算得出。激光功率密度保持在1 mW/mm 2 以避免任何光束诱导结晶。样品的缺陷密度由自旋密度 Ns 表征,其由电子自旋共振 (ESR) 光谱仪 (Bruker, EMX-8X-band) 在 9.8 GHz 和 5 mW 下测量的结果计算。有效少数载流子寿命τ 使用 Semilab WT-1200A 测量。这些薄膜的表面形貌用原子力显微镜(AFM,SII Nanonavi E-Sweep)观察,微观形貌用扫描电子显微镜(SEM,Sirion 200)观察。
结果与讨论
通过拉曼分析进行结构调查
为了对在各种压力下沉积的 nc-Si:H 薄膜进行结构研究,进行了微拉曼测量。在图 2 中,选择了四个代表性样品来显示拉曼光谱。它们分别在 300 Pa、450 Pa、750 Pa 和 1050 Pa 下沉积。每个光谱(空心圆圈)在一定压力下可以解卷积成三个高斯峰:(1)480 cm −1 附近的宽高斯分布 ,这归因于非晶硅的横向光学 (TO1) 模式; (2) 520 cm −1 附近的一个峰 ,属于晶体硅的非对称 TO2 振动模式 [13, 14]; (3) 506 cm −1 附近的峰值 这归因于中间范围顺序 [1, 15]。结晶度 (X c ) 在 nc-Si:H 中可以通过 [16, 17] 计算:
$$ {X}_c=\left({I}_{520}+{I}_{506}\right)/\left({I}_{520}+{I}_{506}+\gamma {I}_{480}\right) $$ (1)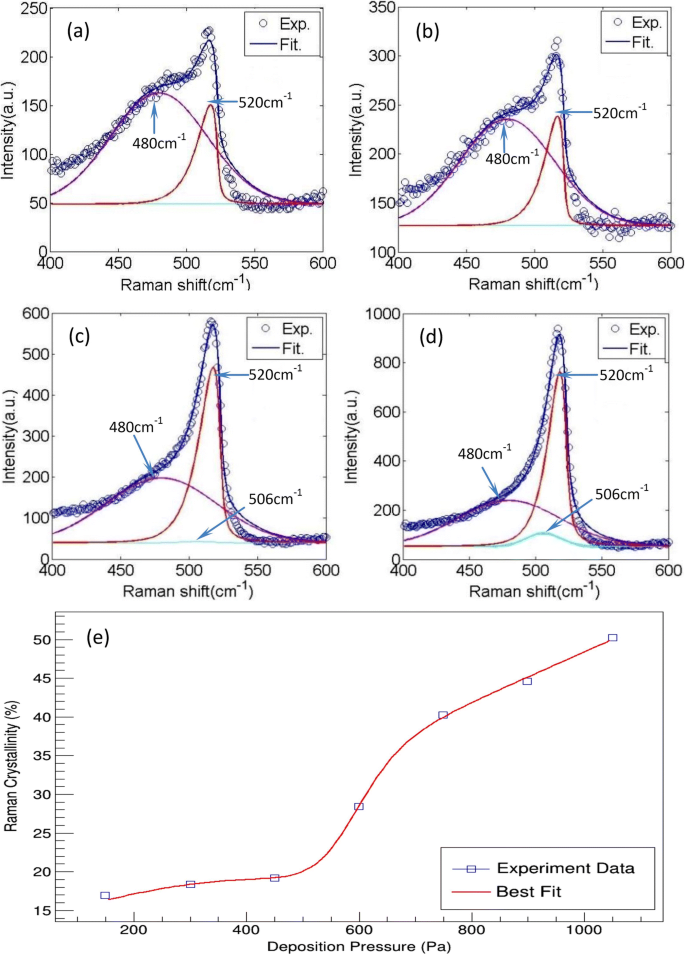
300 Pa下沉积的典型样品的拉曼光谱及其解卷积 (a ), 450 帕 (b ), 750 帕 (c ) 和 1050 Pa (d ) 以及在不同压力下沉积的 nc-Si:H 薄膜的计算结晶度 (e )
其中 γ 是 c-Si 与 a-Si (γ =1 [17, 18]) 和 I 520,我 506、我 480 是在 520、506、480 cm -1 处观察到的峰的积分强度 , 分别。结晶度随不同沉积压力的变化如图 2e 所示。
已知原子氢(H)主要由氢稀释的硅烷等离子体中的以下两次碰撞产生[8]:
-
初级电子-硅烷反应
- B.
电子-氢反应
根据附加文件1中的公式S(1)和S(2),我们可以得到\( {n}_e=\frac{P}{RT}\bullet \mu \) (P ,沉积压力; R ,理想气体常数; T , 排放前气体的绝对温度; μ ,电离率;和 n e ,电子密度)。 μ 由于射频功率不变,所以是常数,T 也是恒定的。电子密度n e 因此随着沉积压力P而增加 .根据化学方程式。 (2)和(3),等离子体中产生的H的密度随着n而增加 e .这是理想条件下的理论分析。放电过程非常复杂,以至于放电过程的分析(即等离子体诊断)成为一门独立的学科。实际条件下H随沉积压力的变化应通过等离子体诊断来测量。杨等人。通过光发射光谱 (OES) 测量了 \( {H}_{\alpha}^{\ast } \) (\( {I}_{H_{\alpha}^{\ast }} \)) 的强度并证明 \( {I}_{H_{\alpha}^{\ast }} \) 先增加然后减少 [19]。根据之前的等离子体诊断报告,\( {H}_{\alpha}^{\ast } \) 的强度表示原子氢的数量[20, 21]。因此,当沉积压力继续增加时,等离子体中 H 的密度先增加然后减少。这种趋势与我们的理论分析略有不同。差异与H的二次反应有关:
$$ \mathrm{H}+{\mathrm{SiH}}_4\to {\mathrm{H}}_2+{\mathrm{SiH}}_3 $$ (4)其中 SiH4 是未分解的,即剩余的 SiH4。在我们的实验中,通过减少包括 SiH4 在内的气体的流出来增加沉积压力。也就是说,相当于增加了SiH4的补充。当沉积压力上升到一定程度时,SiH4的补充速度超过了其分解速度。因此,剩下更多的 SiH4。从离开等离子体到到达薄膜生长表面,H 有一段距离。 H 将与该距离内剩余的 SiH4 反应,如二级化学方程式所示。 (4). H的密度因此降低。结果,当沉积压力继续增加时,原子氢密度先增加然后减小。众所周知,更多的 H 量有利于低缺陷密度 nc-Si:H 的沉积。因此,我们实验中沉积的 nc-Si:H 的缺陷密度显示出与原子氢密度相同的趋势,即缺陷密度先减小后增大。后面部分详细讨论了缺陷密度的趋势。
在图 2e 中,可以清楚地看到 nc-Si:H, X 的结晶度 c , 随沉积压力增加。这表明增加压力可以提高 X c .结晶度不仅受原子氢的影响,还受生长前驱体SiHn含量的影响 (n =1,2,3,主要是n =3) 可以用SiH * 表示 在 OES 测量中 [21, 22]。谢等人。已经证明 \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ (强度比 \( {H}_{\alpha}^{\ast } \)/SiH * ) 随沉积压力增加 [20]。一般认为 \( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ 是 X 的索引 c ,即 X c 随着 \( {I}_{H_{\alpha}^{\ast }} \)/I 的增加而增加 SiH ∗ [21, 23]。因此,\( {I}_{H_{\alpha}^{\ast }} \)/I SiH ∗ 趋势强烈支持我们关于 X 趋势的结果 c .
平均晶粒尺寸d 也可以由拉曼光谱推导出,根据公式[24, 25]:
$$ d=2\pi \sqrt{B/\Delta \upnu} $$ (5)其中 Δν 是以cm −1 为单位的频率 位移,其定义为观察到的峰值频率值与体硅的峰值频率值之间的差异。使用 B 的通常值 2.0 厘米 −1 纳米 2 [25], d =4.07~4.50纳米。
表面形态及沉积压力对离子轰击影响的机制
除了拉曼光谱的结构分析外,样品的形态也通过 AFM 表征,如图 3 所示。为了检测薄膜表面的粗糙度演变,均方根 (RMS) 作为沉积压力的函数是如图 3h 所示(RMS 值在每个薄膜的几个不同位置上取平均值)。在图 3h 中,RMS 随着沉积压力的增加而降低。当这些颗粒到达薄膜生长表面时,增加的压力导致颗粒之间的剧烈碰撞和随后的动能损失。到达薄膜生长表面的较低能量离子导致较弱的离子轰击。这表明增加压力有利于抑制离子轰击,这在之前的报告中也有提到[7]。然而,沉积压力对离子轰击的影响机制尚未得到证实。将调查如下。
<图片>
nc-Si:H 薄膜的 AFM 图像显示了不同沉积压力下的表面形态变化。 一 150 帕,b 300 帕,c 450 帕,d 600 帕,e 750 帕,f 900 帕和 g 1050 Pa。a 中的陨石坑 和 b 用虚线圆圈标记,不同沉积压力下薄膜表面的均方根(RMS)粗糙度标记为h
两个电极之间的电位分布可分为三个区域:中心的等离子体区域、阳极护套和阴极护套(见图 1b)。导致离子轰击的离子必须扩散出等离子体区域并穿过阳极护套。等离子体的电位高于反应器的任何其他部分,因为电子比离子扩散得更快。当我们的反应器壁接地时,等离子体的电位为正(见图 1)。阴离子因此被捕获在等离子体区域中;只有中性粒子和阳离子才能扩散到阳极鞘,最终到达成膜表面。换句话说,我们实验中的离子轰击仅由阳离子引起。阳离子穿过阳极鞘而不会发生碰撞,因为鞘的宽度非常小(详细证据见附加文件 1)。结果,当阳离子进入鞘时,它们仅被阳极鞘的电场加速。因此,离子轰击的强度仅取决于阳离子刚进入阳极鞘时的初始速度(v 0) 以及之后阳极护套电场的加速程度。
首先,v的相关性 0 与沉积压力将被分析。当沉积压力增加时,由于碰撞加剧,包括阳离子的粒子在等离子体区域失去其动能。所以,v 0 随着压力的增加而下降。然后,将说明护套的电场引起的加速程度随沉积压力的变化。据了解,[22]:
$$ {V}_p-{V}_f=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$其中 m e 是电子的质量; 米 我 是离子的质量; T e 和 T 我 分别是电子和离子的温度; V p 是等离子体电位;和 V f 是浮动电位。当底物悬浮在我们的反应器中时,阳极护套的电压 V 鞘等于 V p − V f ,那么我们有:
$$ {V}_{\mathrm{sheath}}=\frac{k{T}_e}{2e}\left(\frac{m_i{T}_e}{m_e{T}_i}\right) $$ (6)在等离子体区域,T e 随着沉积压力的增加加剧粒子(包括电子和离子)之间的碰撞而降低。谢等人。已经证明 T e 通过 OES 测量 [20],随着沉积压力的增加而降低。这表明 T 的趋势 e 经我们的理论分析是完全正确的。与T相比 e , T 我 减少如此之少,以至于可以认为它没有变化。结果,V 根据公式(6),压力增加时护套下降。它削弱了阳极护套的加速程度。再加上下降v 0,我们可以得出结论,当压力增加时,到达薄膜生长表面的阳离子的动能变得更小。换句话说,增加沉积压力会使离子轰击效应变弱。因此,薄膜表面的 RMS 从 150 Pa 持续下降到 1050 Pa。根据之前的报道,离子能量越低,结晶度越好 [7]。这也支持了我们已经得出的关于结晶度和沉积压力之间相关性的结论。此外,在低得多的压力(150 Pa 和 300 Pa)下沉积的薄膜表面更加粗糙,我们也可以看到这些表面包含大量的凹坑,如图 4a、b 所示。这是强离子轰击的结果。根据图 3,我们可以明显地得出结论,在 450 Pa 下沉积的薄膜是最致密的(尤其是图 5c 和 6d)和均匀的。
<图片>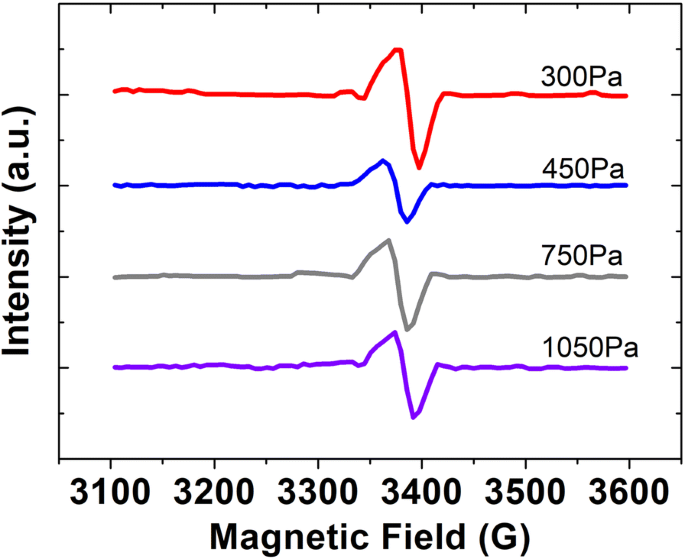
300 Pa、450 Pa、750 Pa、1050 Pa下沉积的典型样品的ESR谱
<图片>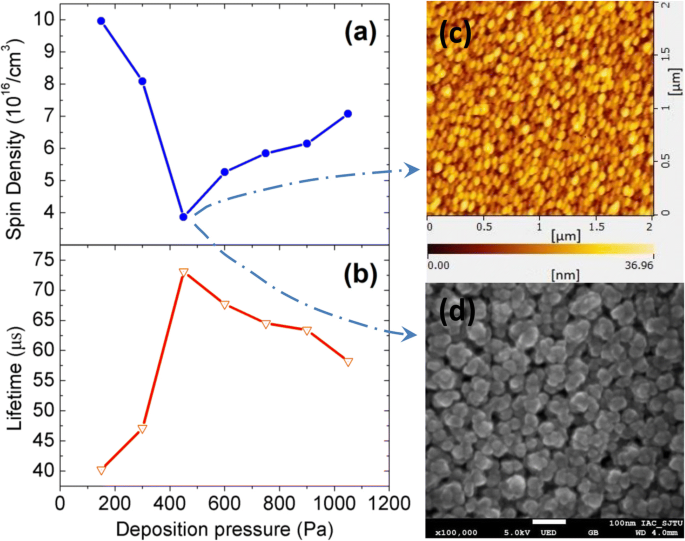
自旋密度的相关性 (a ) 和有效少数载流子寿命 (b ) 在不同的沉积压力下。高分辨率 AFM 图像 (c ) 和 SEM 图像 (d ) nc-Si:H 薄膜在 450 Pa 下沉积
<图片>
生长表面颗粒扩散示意图
缺陷密度和电气特性
采用ESR技术研究了沉积压力对nc-Si:H薄膜缺陷密度的影响。图 4 显示了分别在 300 Pa、450 Pa、750 Pa、1050 Pa 下沉积的典型样品的四个 ESR 谱。图 5a 的数据是根据每个样品的 ESR 谱计算的。如图 5a 所示,当压力增大时,自旋密度先减小后增大。在 450 Pa 处有最小值。根据 ESR 原理,未配对自旋的数量与中性悬键的密度成正比。这些键大多存在于薄膜生长表面,构成薄膜生长表面的稳态缺陷,而所得薄膜中的缺陷密度基本上由这些稳态缺陷密度决定[26]。因此,从 ESR 光谱计算的结果确实是所得薄膜的缺陷密度。图 5a 中的这些结果表明 nc-Si:H 中的缺陷密度在 450 Pa 时达到最小值,即 3.766 × 10 16 厘米 −3 .乔杜里等人。研究了如何制造低缺陷密度的 nc-Si:H。当他们使用 13.56 MHz 射频源时,他们尽最大努力实现低缺陷密度。值为 1.1 × 10 17 和 7.0 × 10 16 厘米 −3 .当他们使用甚高频 (VHF) 激发源 (54.24 MHz) 时,他们实现了最低缺陷密度 4.3 × 10 16 厘米 −3 [10]。众所周知,VHF等离子体中的离子能量低,离子流密度高。由于这两个因素,VHF-PECVD 沉积的薄膜缺陷密度低,因此具有高质量 [27]。然而,缺陷密度高于我们的,并且 54.24 MHz 激发源比其 13.56 MHz 对应物贵得多。为了实现低缺陷密度,Wen 等人。另外施加直流偏置。但是,最小值为 4.0 × 10 16 厘米 −3 [9]。找到合适的射频功率并不容易,更不用说合适的直流偏置了。原因是一旦 RF 功率发生变化,就应该调整 DC 偏置。否则,直流偏置不能有效地减轻离子轰击。相比之下,我们的方法很简单。最近,Jadhavar 等人。已经通过 PECVD 沉积了具有低缺陷密度的高质量 nc-Si:H。缺陷密度约为8.75 × 10 16 厘米 −3 [5]。因此,我们实现低缺陷密度薄膜的方法既方便又有效。考虑到缺陷密度越低,少数载流子寿命应该越高,我们直接进行了少数载流子寿命的测量。如图 5b 所示,有效少数载流子寿命在 450 Pa 时达到最大值。少数载流子寿命的趋势与根据 ESR 谱计算的缺陷密度的趋势同步。这说明ESR可以绝对测量薄膜的缺陷密度。
离子轰击与缺陷密度的关系
增加压力可以抑制离子轰击。从某种意义上说,缺陷密度应该从 150 Pa 持续下降到 1050 Pa。实际上,它先减小后增大。还有一个不容忽视的因素——H 和 SiH3 的扩散(在等离子体中,主要的薄膜前驱体是 SiH3 [26])。颗粒在生长表面的扩散示意图如图6所示。从150到1050 Pa,颗粒的动能减小。离子轰击效果肯定越来越低。然而,由于粒子碰撞频率的增加,粒子的动能从 450 Pa 显着降低到 1050 Pa。原子氢是高质量 nc-Si:H 沉积的关键,它失去了太多的动能,以至于无法进一步扩散以饱和更多的悬空键,更不用说它的密度开始下降了,如图所示“通过拉曼分析进行结构调查。”另一方面,包括原子氢在内的粒子会急剧失去动能,因此它们无法将更多能量转移到生长表面。因此,SiH3 前驱体的扩散长度不能增加。众所周知,如果吸附在表面的 SiH3 能够找到能量有利的生长位点,就会形成原子级更有序的结构。但是现在,SiH3 没有足够的扩散长度来找到它们充满活力的有利生长位点。因此,无法形成有序结构。换言之,沉积膜具有更多的缺陷。结果,相反,图 5a 中的自旋密度从 450 Pa 开始上升。但值得注意的是,600~1050 Pa的自旋密度仍低于150~300 Pa的自旋密度,这是较弱的离子轰击的结果。此外,由于其扩散长度缩短,SiH3 前驱体倾向于堆积形成聚集体。如图 3 所示,在 750 Pa 时开始出现团聚体,随着沉积压力的不断增加,团聚体逐渐集中。综上所述,离子轰击并不是越弱对薄膜生长越好。离子轰击的程度要适当。
缺陷密度:nc-Si:H光伏材料的关键特性
结晶度和缺陷密度都是 nc-Si:H 太阳能电池材料的特性。前者随着沉积压力的增加而增加。从某种意义上说,后者应该会继续下降。然而,事实并非如此。根据拉曼表征,虽然结晶度增加,但晶粒尺寸的变化非常小(4.07~4.50 nm)。它表明只有晶粒数量增加而不是晶粒尺寸增加。在这些条件下,晶界体积增加。众所周知,晶界是体缺陷和复合中心。更多的晶界会增加缺陷密度。当结晶度上升到一定程度时,晶界体积增加对缺陷密度的负面影响克服了晶粒数量增加的正面影响。因此,缺陷密度不会随着结晶度的增加而不断降低;反之,结晶度达到一定程度后上升。这一结果表明,具有更高结晶度的 nc-Si:H 薄膜不一定具有更好的质量,这一点得到了另一个研究小组的证实。近年来,据报道,太阳能电池的最佳 nc-Si:H 层是在相变边界附近获得的,即在 a-Si:H-to-nc-Si:H 之后获得最佳过渡。最佳 nc-Si:H 层的结晶度不高 [28,29,30]。 Mukhopadhyay 等。已经进一步证明,具有高结晶度的 nc-Si:H 层,因此光诱导降解低,不能生产高质量的太阳能电池。在 a-Si:H 到 nc-Si:H 转变之后沉积的电池的稳定效率高于其中 i 层具有高结晶度的电池,尽管前者在稳定之前比后者降解得更多[31]。韩等人。已经进一步证明 nc-Si:H 层的光诱导降解是通过形成亚稳态悬键引入的。而光诱导的结构变化是亚稳态悬空键形成的先导过程 [30]。亚稳态悬空键是缺陷之一[32]。因此,高质量nc-Si:H光伏材料的关键特性是缺陷密度,而不是结晶度、光稳定性或其他特性。
结论
通过在 150 到 1050 Pa 之间改变压力来沉积 nc-Si:H 薄膜。沉积压力范围高于 PECVD 工艺中的常规沉积。发现随着沉积压力的增加,结晶度增加,薄膜表面的粗糙度降低。平均晶粒尺寸d =4.07~4.50nm。此外,我们专注于沉积压力的影响,不仅对样品的宏观或通常性质的影响,而且对缺陷密度和少数载流子寿命的影响也是更重要的特征。发现随着沉积压力的升高,样品的缺陷密度先减小后增大。缺陷密度达到最小值(3.766 × 10 16 厘米 −3 ) 在 450 Pa。它低于先前关于制造低缺陷密度 nc-Si:H 薄膜的研究。这项工作为通过 PECVD 沉积低缺陷密度 nc-Si:H 提供了一种方便有效的方法。我们已经证明了沉积压力对离子轰击的影响机制。而且,证明了离子轰击并不是越弱对薄膜生长越好。离子轰击的程度要适当。
缩写
- 原子力显微镜:
-
原子力显微镜
- DC:
-
直流电
- H:
-
原子氢
- nc-Si:H:
-
氢化纳米晶硅
- PECVD:
-
等离子体增强化学气相沉积
- SEM:
-
扫描电镜
- 甚高频:
-
甚高频
纳米材料


