关于用于基于 AlGaN 的深紫外发光二极管的 p-AlGaN/n-AlGaN/p-AlGaN 电流扩展层
摘要
在本报告中,描述和研究了具有不同 p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN) 结构的电流扩展层的基于 AlGaN 的深紫外发光二极管 (DUV LED)。根据我们的研究结果,采用的 PNP-AlGaN 结构可以在空穴注入层中产生能量势垒,可以调节横向电流分布。我们还发现电流扩散效应会受到厚度、掺杂浓度、PNP 回路和插入的 n-AlGaN 层的 AlN 成分的强烈影响。因此,如果 PNP-AlGaN 结构设计得当,与没有 PNP 的传统 DUV LED 相比,所提出的 DUV LED 的正向电压、外部量子效率、光功率和壁挂效率可以显着提高-AlGaN结构。
介绍
自 2003 年首次出现以来,基于 AlGaN 的深紫外发光二极管 (DUV LED) 因其广泛的应用,如水杀菌和空气净化而备受关注 [1,2,3,4,5, 6,7]。然而,当发射波长小于 300 nm 时,DUV LED 的外部量子效率 (EQE) 低于 10% [8],这极大地限制了它们的进一步应用。低 EQE 部分源于较差的内部量子效率 (IQE)。 IQE 受到载流子注入和扩展位错的显着影响已经引起了极大的关注 [8]。在绝缘蓝宝石衬底上生长的基于 AlGaN 的 DUV LED 采用倒装芯片结构,以获得更好的光提取效率。然而,倒装芯片 DUV LED 结构要求 n 电极和 p 电极位于同一侧。因此,很容易出现不均匀的横向电流分布,即电流拥挤效应[9]。电流拥挤效应很容易造成局部焦耳热效应和发光不均匀[10,11,12]。值得一提的是,局部过热严重降低了DUV LED的使用寿命。此外,富铝 p-AlGaN 基空穴注入层的 Mg 掺杂效率非常差,导致其导电性较差 [13],这进一步表明了改善 DUV LED 电流扩展的重要性。尽管汗等人。已经在他们的评论文章[14]中指出当前的拥挤应该被关注,目前对于DUV LEDs的当前拥挤和解决方法的详细分析很少讨论。
已经报道了用于 GaN 基蓝色 LED 的大量促进电流扩展的技术,并且可以通过例如选择性离子注入 p-GaN 层 [15, 16]、插入电流阻挡层 (CBL) 来改善电流扩展[17,18,19],选择性地产生氮空位以补偿 p-GaN 层中的空穴 [20],优化欧姆接触的退火工艺 [21]。除了使用后加工方法,电流扩展层也可以通过金属有机化学气相沉积 (MOCVD) 系统中的原位外延生长获得。重要的例子如下:多量子阱 (MQW) 结构和 p-GaN 层之间的短周期 p-GaN/i-InGaN 超晶格结构 [22, 23]、隧道结 [24, 25] 和势垒交界处 [10]。然而,很少有关于改善 DUV LED 电流扩散的外延结构的报告。在这封信中,我们建议使用 p-AlGaN/n-AlGaN/p-AlGaN (PNP-AlGaN) 层来更好地分散 DUV LED 的横向电流。 PNP-AlGaN结构可以在p型空穴注入层的价带中产生能垒。能量势垒可以调节 p 型空穴注入层的电阻率,因此可以调整电流路径。通过适当设计 PNP-AlGaN 电流扩展层,可以提高 EQE、壁插效率 (WPE) 和正向电压。此外,这项工作还综合研究了电流扩展、EQE、WPE 和正向电压对 PNP-AlGaN 回路的敏感性、Si 掺杂浓度、厚度和插入的 n-AlGaN 层的 AlN 成分PNP-AlGaN 架构。
研究方法和物理模型
为了更好地阐明基于 AlGaN 的 DUV LED 的电流扩散机制,设计了不同的 DUV LED 器件(见图 1a)。所有 DUV LED 均由 4 μm 厚的 n 型 Al0.60Ga0.40N 层组成,Si 掺杂浓度为 5 × 10 18 厘米 −3 .接下来是 5 个 3-nm Al0.45Ga0.55N/12nm Al0.56Ga0.44N MQW 周期。然后我们用 18 纳米厚的 p 型 Al0.60Ga0.40N 电子阻挡层 (p-EBL) 覆盖 MQW,在其上有 198 纳米厚的 p 型 Al0.40Ga0.60N 层和 50- nm 厚的 p 型 GaN 盖层用作空穴注入层。 p型层的空穴浓度设置为3 × 10 17 厘米 −3 .对于具有所提出的 PNP-AlGaN 结构的 DUV LED,传统的 p 型体 Al0.40Ga0.60N 层被 p-Al0.40Ga0.60N/n-Alx 取代 Ga1-x N/p-Al0.40Ga0.60N 层。图 1b 显示了 PNP-AlGaN 层的结构示意图。图 1c 显示了 PNP-AlGaN 结构的示意价带图,从中我们可以看到空穴的势垒。由于薄 n-Alx 中 Si 掺杂剂的耗尽而产生势垒 Ga1-x N层[26]。该障碍对于确定 DUV LED 的电流路径和器件性能非常重要。后续会详细分析。
<图片>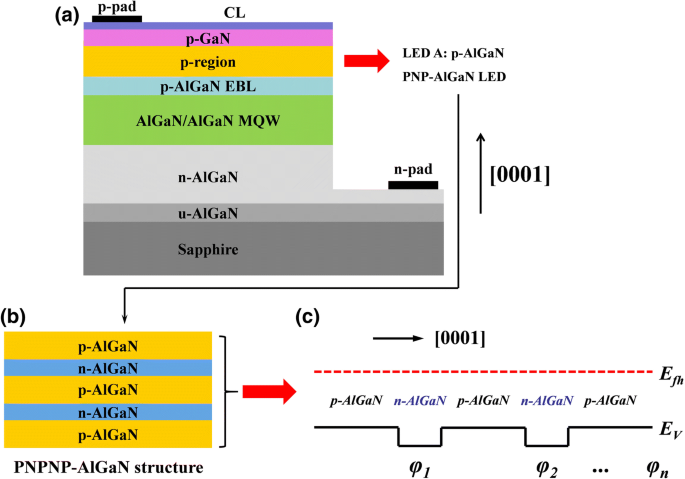
一 所研究器件的示意图(参考 LED A 和 PNPNP-AlGaN LED),b 具有两个 PNP-AlGaN 结的 PNP-AlGaN 结构示意图,c 具有多个 PNP-AlGaN 结的 PNP-AlGaN 结构的价带示意图,其中 φ 1、φ 2、φ n 表示沿 [0001] 方向和 n 的每个 PNP-AlGaN 结的势垒高度 代表PNP-AlGaN结数
为了进一步说明 PNP-AlGaN 结构传播电流的机制,我们在图 2a 中展示了在蓝宝石衬底上生长的 DUV LED 的简化等效电路和电流路径。电流从 p-AlGaN 区域垂直和横向流向 n-AlGaN 区域。通常,电流扩展层 (CL) 的厚度(即我们的器件为 200 nm)远小于 n-AlGaN 层的厚度(即我们的器件为 4 µm)。因此,CL 的电阻远大于 n-AlGaN 电子注入层的电阻。然后,电流趋向于聚集在 p 电极下方,即 J 1> J 2> J 3> J 4> .....> J n ,这被称为电流拥挤效应 [27]。幸运的是,可以通过在 p 型空穴注入层中加入 PNP-AlGaN 结来抑制电流拥挤效应,并且可以通过使用图 2b 来解释潜在机制,这样我们将总电流分成垂直部分( J 1 ) 和水平部分 (J 2 )。根据参考文献。 [27]、J之间的关系 1 和 J 2 可以通过方程链接。 (1)如下,
$$ \frac{J_1}{J_2}\cong \frac{l}{\frac{\rho_p}{\rho_{\mathrm{CL}}}{t}_p+\frac{N\cdot {\rho}_ {\mathrm{PNP}}}{\rho_{\mathrm{CL}}}}, $$ (1)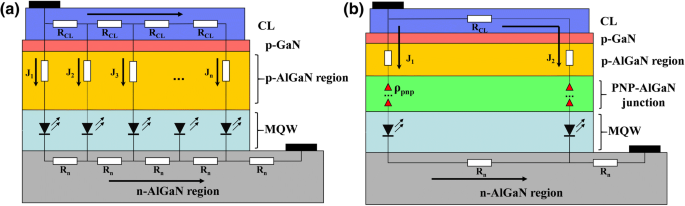
一 采用横向电流注入方案的 DUV LED 等效电路 (J 1> J 2> J 3> J 4> ……> J n ) 和 b PNP-AlGaN 结构 LED 的简化等效电路,电流路径 (J 1 和 J 2) 也显示
其中 l 是水平电流路径的长度,t p 是厚度,ρ p 代表 p 型空穴注入层的垂直电阻率,ρ CL 表示异位沉积电流扩散层的电阻率,ρ PNP 表示在每个 PNP-AlGaN 结中引起的特定界面电阻率,N 表示 PNP-AlGaN 结的数量。基于方程。 (1),我们推断我们可以增加J 2 通过减少 ρ CL。等式(1)还表明,适当增加垂直阻力(即 ρ p × t p ) 也有助于增强 J 2 .或者,通过包含 N·ρ 可以使垂直阻力变大 PNP。然而,N·ρ的值 PNP 会受到 PNP-AlGaN 结数量的影响。此外,ρ 的值 PNP受n-Alx的掺杂浓度、厚度和AlN组成的影响 Ga1-x N层。因此,有关不同 PNP-AlGaN 结的详细信息将在后续讨论。
使用 APSYS [28] 对器件物理进行研究。 AlGaN/AlGaN 异质结的导带偏移和价带偏移之间的能带偏移比设置为 50:50 [29]。极化水平设置为 40%,用于计算晶格失配界面处的极化诱导电荷 [30, 31]。 Auger复合系数和Shockley-Read-Hall(SRH)复合寿命设置为1.0 × 10 -30 厘米 6 /s [27] 和 10 ns [32],分别。 DUV LED 的光提取效率设置为 ~ 8% [33]。含氮 III-V 族半导体的其他参数可以在别处找到 [34]。
结果和讨论
PNP-AlGaN 结在 DUV LED 电流扩散方面的有效性证明
为了显示 PNP-AlGaN 结构对 DUV LED 电流扩散的有效性,没有 PNP-AlGaN 结构的参考 DUV LED(即 LED A)和具有 PNP-AlGaN 结构的 DUV LED(即 LED B)分别为学习了。请注意,除 LED B 的 PNP-AlGaN 配置外,DUV LED 的架构信息已在研究方法和物理模型部分给出。LED B 具有两个 PNP-AlGaN 回路,即 PNPNP-AlGaN 结构。每个 PNP-AlGaN 结包括 p-Al0.40Ga0.60N/n-Al0.40Ga0.60N/p-Al0.40Ga0.60N 结构,为此,20nm 厚的 n-Al0.40Ga0 中的 Si 掺杂浓度.60N插入层为5.3 × 10 17 厘米 −3 .我们计算并显示了 LED B 在电流密度为 170 A/cm 2 的能带图 在图 3a 中。我们可以看到,与 LED A(此处未显示能带)相比,空穴在注入 MQW 之前会遇到两个势垒。这里价带中的势垒可以有效地分散电流并更好地横向均匀化空穴。为了进一步说明我们的观点并出于演示的目的,我们在图 3b 中展示了最接近 p-EBL [即最后一个量子阱 (LQW)] 的量子阱中的横向空穴浓度分布,其中发现LED B 中的孔分布确实在 LQW 中显示出更均匀的分布。图 2b 中的观察结果与图 3a 中的能带图和我们之前的分析非常吻合,因此证明 PNP-AlGaN 结构可用于改善电流扩展效应。
<图片>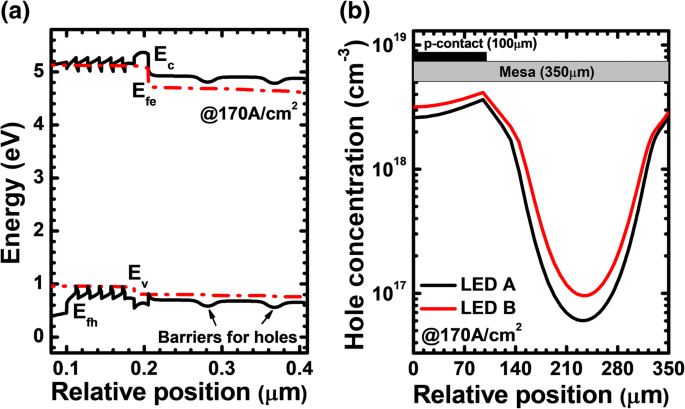
一 电流密度为 170 A/cm 2 时 LED B 的能带图 . E c , E v , E fe 和 E fh 分别表示电子和空穴的导带、价带和准费米能级,b LED A 和 B 在电流密度为 170 A/cm 2 时最后一个量子阱中的横向空穴分布 , 分别
接下来,我们分别显示了图 4a、b 中 LED A 和 B 的 MQW 区域中空穴浓度和辐射复合率的分布。请注意,为了监测电流扩散效果,图 4a、b 中的数据是在距左台面边缘 230 μm 的位置收集的。发现改进的 LED B 电流扩展也能够促进空穴注入 MQW。根据图 4b,MQW 中空穴浓度的提高导致 LED B 的辐射复合率提高。
<图片>
一 空穴浓度分布和b 电流密度为 170 A/cm 2 时 LED A 和 B 在 MQW 区域的辐射复合率 , 分别
然后,图 5a 根据 LED A 和 B 的注入电流密度水平展示了 EQE 和光功率密度。LED A 和 B 的 EQE 水平分别为 3.38% 和 4.13%,在170 A/cm 2 的电流密度 .这些观察到的改进归因于更好的电流扩展效应和增强的空穴注入 LED B 的 MQW 区域。 正如前面提到的,采用 PNP-AlGaN 结构可以导致价带中的能垒,这可能会影响正向电压。参考图 5b 证明了这一推测,该图表明 LED B 的正向电压略有增加。尽管 LED B 的正向电压更高,但根据图 5c,LED 的插墙效率仍然大于 LED A 的效率。 ,因此在电流密度水平为 170 A/cm 2 时,LED A 和 B 的数字分别为 3.56% 和 4.27% , 分别。如果我们进一步比较图 5a、c,我们可以发现 LED B 的 WPE 下垂更明显,这归因于 PNP-AlGaN 结处的额外电压降。因此,开展更全面的研究,揭示 EQE、正向电压和 WPE 对不同 PNP-AlGaN 设计的敏感性至关重要。
<图片>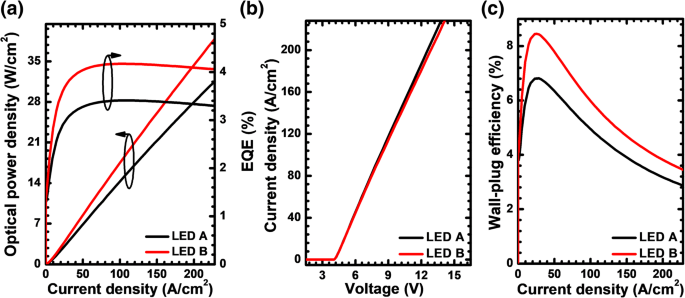
一 光输出功率密度和 EQE 作为注入电流的函数,b 电流-电压特性,c 分别以 LED A 和 B 的注入电流表示的 WPE
n-AlGaN 层厚度对器件性能的影响
根据方程。 (1),我们可以得出结论,通过增加N·ρ的值可以获得增强的水平电流 PNP。当 n-Al0.40Ga0.60N 层变厚时,PNP-AlGaN 结中的势垒高度增加,使得 ρ 可以获得PNP,有利于提高电流扩散效果。然而,一旦n-Al0.40Ga0.60N层太厚,p-Al0.40Ga0.60N层中的更多空穴可能被耗尽,这可能会牺牲导电性。因此,为了更好地说明 N-Al0.40Ga0.60N 层厚度与 DUV LED 性能之间的关系,有必要研究 N-Al0.40Ga0.60N 层厚度对 PNP-AlGaN 结的影响。电流扩展、空穴注入、EQE、正向电压和 WPE。为此,我们将 n-Al0.40Ga0.60N 层厚度的值在 6、13、20、27 和 34 纳米之间变化,这些器件分别称为 LED T1、T2、T3、T4 和 T5 .表 1 总结了每个 PNP-AlGaN 结的价带势垒高度,表明势垒高度随着 n-Al0.40Ga0.60N 层厚度的增加而增加,证明 n-Al0.40Ga0.60N 层厚度的增加启用大 N·ρ PNP , 从而增加水平电流 J 2 .然后,图 6a 显示了没有 PNP-AlGaN 结构的电流扩展层的 LED A 和具有各种 n-Al0.40Ga0.60N 层厚度的 LED 在 170 A/cm 电流密度下的最后一个量子阱中的横向空穴浓度分布 2 .可以明显看出,随着n-Al0.40Ga0.60N插入层厚度的增加,空穴在最后一个量子阱中的分布更加均匀。
<图片>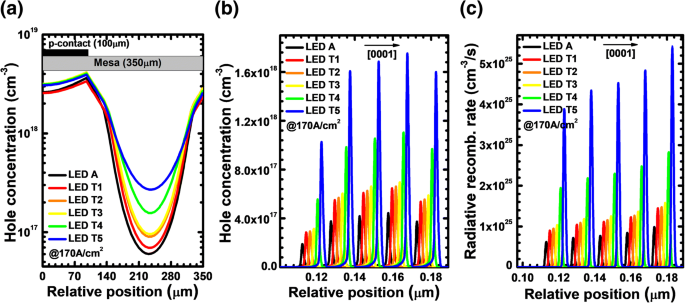
一 最后一个量子阱中的横向空穴分布,b 空穴浓度分布和c LED A、T1、T2、T3、T4 和 T5 在 MQW 区域中的辐射复合率分布,电流密度为 170 A/cm 2 .面板 b 的绘制曲线 和 c 故意偏移 2 纳米以获得更好的分辨率
然后,我们展示了所有研究器件在 MQW 区域在 170 A/cm 2 电流密度下的空穴浓度分布和辐射复合率分布 分别在图 6b、c 中。在距离左侧台面边缘 230 μm 的位置收集空穴浓度和辐射率分布。为了获得更好的视觉分辨率,图 6b、c 中 LED A、T1、T2、T3、T4 和 T5 的空穴浓度和辐射复合率曲线分别在空间上偏移了 2 nm。清楚地表明,LED A 具有最低的空穴浓度,因此在 MQW 区域具有最低的辐射复合率。 MQW区空穴浓度和辐射复合率随着n-Al0.40Ga0.60N层厚度的增加而增加。
图 6c 中显示的观察结果与 EQE 和图 7a 中显示的光功率密度非常吻合,因此 PNP-AlGaN 结中 n-Al0.40Ga0.60N 层的厚度增加可以改善EQE 和光功率密度。然而,一旦根据表 1 增厚 n-Al0.40Ga0.60N 层,每个 PNP-AlGaN 结中空穴的价带势垒高度就会变大,这相应地增加了所提出的 DUV LED 的正向电压,如图 3 所示。 7b.因此,应通过证明 WPE 与注入电流密度之间的关系来评估 n-Al0.40Ga0.60N 层厚度对 PNP-AlGaN 电流扩展对 LED 性能的影响(见图 8)。我们可以看到 WPE 不会随着 n-Al0.40Ga0.60N 层厚度的增加而单调增加。 EQE 和 WPE 在 n-Al0.40Ga0.60N 层厚度方面如图 8 的插图所示。对于本工作中提出的器件架构,当 n-Al0.40Ga0 .60N 插入层的厚度为 20 纳米,并且随着 n-Al0.40Ga0.60N 插入层变厚而减小。我们将此现象归因于当 n-Al0.40Ga0.60N 层厚度变厚时垂直电阻增加,这会消耗更多电能。因此,应仔细优化 PNP-AlGaN 结的 n-AlGaN 插入层厚度。在本节中,我们将 AlN 成分设置为 40%,即 n-Al0.40Ga0.60N 用于演示,我们认为如果增加 AlN 成分,n-AlGaN 插入层的优化厚度会变小.
<图片>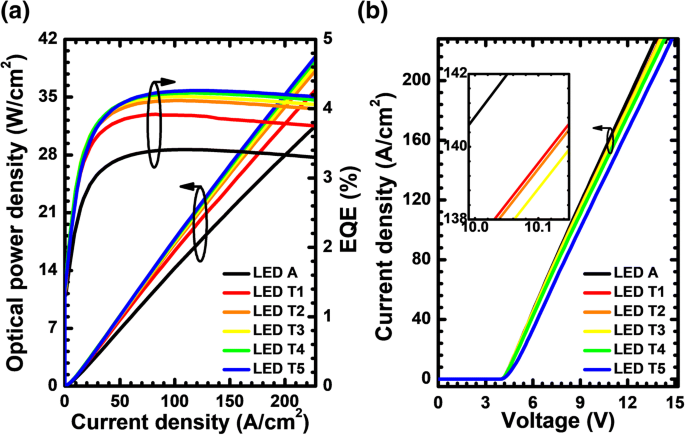
一 光输出功率密度,b LED A、T1、T2、T3、T4和T5的电流-电压特性。插图为放大电流-电压曲线
<图片>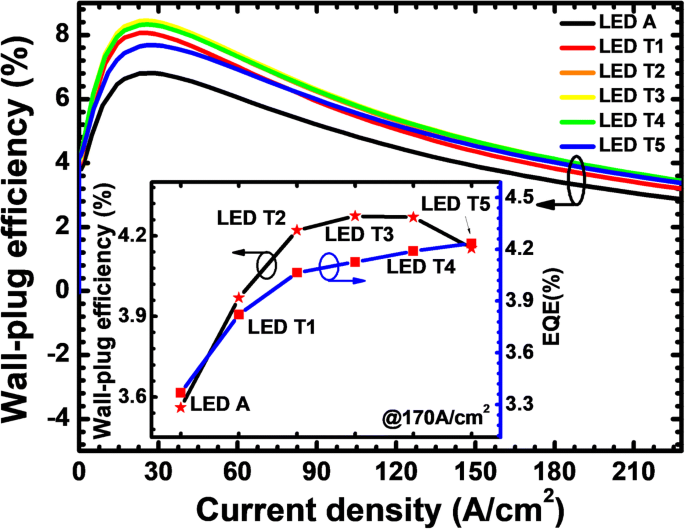
WPE 作为 LED A、T1、T2、T3、T4 和 T5 的注入电流的函数。插图显示了 PNP-AlGaN 结的 n-Al0.40Ga0.60N 层的不同厚度所研究 LED 在电流密度为 170 A/cm 2 的 WPE 和 EQE
n-AlGaN 层的掺杂浓度对器件性能的影响
除了 n-AlGaN 层的厚度外,n-AlGaN 层的掺杂浓度也会改变空穴的价带势垒高度,从而影响 N·ρ PNP。为了更准确地研究 n-AlGaN 层的掺杂浓度对具有 PNP-AlGaN 结的 DUV LED 的电流扩展效应和光学性能的影响,我们将掺杂浓度设置为 1.3 × 10 17 , 5.3 × 10 17 , 9.3 × 10 17 , 1.33 × 10 18 , 和 1.73 × 10 18 厘米 −3 分别用于 LED D1、D2、D3、D4 和 D5 的 n-AlGaN 层。 n-AlGaN 层的厚度设置为 20 nm,采用两个 PNP-AlGaN 结。 AlN成分为40%,即n-Al0.40Ga0.60N。
表 2 显示,当 PNP-AlGaN 结的 n-Al0.40Ga0.60N 层的 Si 掺杂浓度变高时,空穴的价带势垒高度增加。价带势垒高度的增加表明 N·ρ PNP,同时产生 J 的高水平电流 2 .根据方程。 (1),增加的电流扩展伴随着更均匀的横向空穴浓度分布,因此,我们在图 9a 中表明,一旦 PNP-AlGaN与LED A相比,DUV LED结掺杂。此外,一旦PNP-AlGaN结的n-Al0.40Ga0.60N层的Si掺杂浓度增加,横向空穴分布更均匀。
<图片>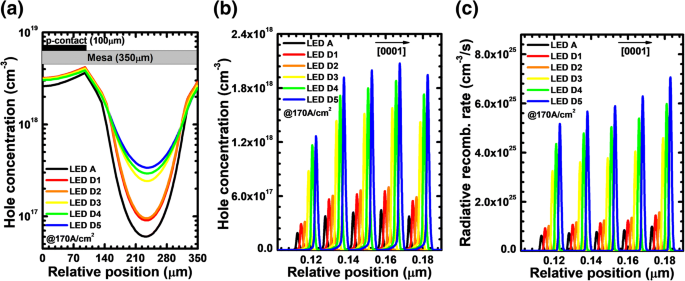
一 最后一个量子阱中的横向空穴分布,b 空穴浓度分布和 c MQW 区域或 LED A、D1、D2、D3、D4 和 D5 在 170 A/cm 2 电流密度下的辐射复合率分布 .面板 b 的绘制曲线 和 c 故意偏移 2 纳米以获得更好的分辨率
然后,我们展示了所有研究器件在 MQW 区域在 170 A/cm 2 电流密度下的空穴浓度分布和辐射复合率分布 分别在图 9b、c 中,它们是在距左台面边缘 230 μm 的位置收集的。清楚地表明,LED A 在 MQW 区域具有最低的空穴浓度和最差的辐射复合率。对于具有 PNP-AlGaN 结的 LED,MQW 区域中的空穴浓度和辐射复合率随着 n-Al0.40Ga0.60N 层掺杂浓度的增加而增加。 LED D1、D2、D2、D3、D4和D5的MQW中空穴浓度水平的提高归因于PNP-AlGaN结更好的电流扩散效果。
然后,我们根据图 10a 中研究的器件的注入电流密度进一步计算和呈现 EQE 和光功率密度。观察到的 EQE 与图 9b、c 中的结果一致,因此一旦采用 PNP-AlGaN 结,EQE 可以得到改善。不仅如此,随着用于 PNP-AlGaN 结的 n-Al0.40Ga0.60N 层中 Si 掺杂浓度的增加,由于更好的电流扩展,可以进一步促进 EQE。图 10b 比较了所研究器件的正向工作电压。结果表明,随着n-Al0.40Ga0.60N层中掺杂浓度的增加,正向工作电压增加。注意由于Si掺杂浓度为1.33 × 10 18 和 1.73 × 10 18 厘米 −3 ,导通电压显示出显着增加,这表明当n-Al0.40Ga0.60N层中的Si掺杂增加到非常高的水平时,PNP-AlGaN内置结表现为寄生二极管。为了更准确地评估具有不同 PNP-AlGaN 结的 DUV LED 的性能,图 11 展示了 WPE 作为 LED A、D1、D2、D3、D4 和 D5 的注入电流密度的函数。很明显,我们可以看到 LED D5 的 WPE 最低,这是因为正向电压消耗最大。图 11 的插图还表明 WPE 对 n-Al0.40Ga0.60N 层的 Si 掺杂浓度比 EQE 更敏感。值得总结的是,n-Al0.40Ga0.60N层的高Si掺杂浓度确实可以改善电流扩散层并提高光子产生率。尽管如此,PNP-AlGaN 结处的额外正向压降会消耗更多的电能,从而限制了 WPE。本节的研究结果还说明了 n-Alx 中的 Si 掺杂浓度 Ga1-x 如果增加AlN成分和/或n-Alx的厚度,应适当减少N层 Ga1-x PNP-AlGaN结的N层,因为这样做可以同时获得改善的EQE和不错的WPE。
<图片>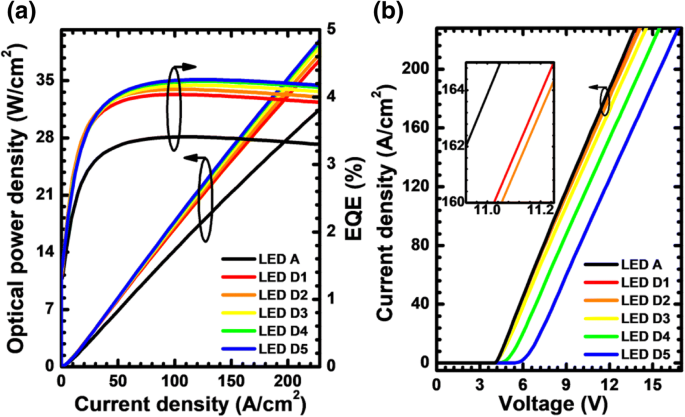
一 光输出功率密度和 EQE 作为注入电流的函数,b LED A、D1、D2、D3、D4和D5的电流-电压特性。插图为放大电流-电压曲线
<图片>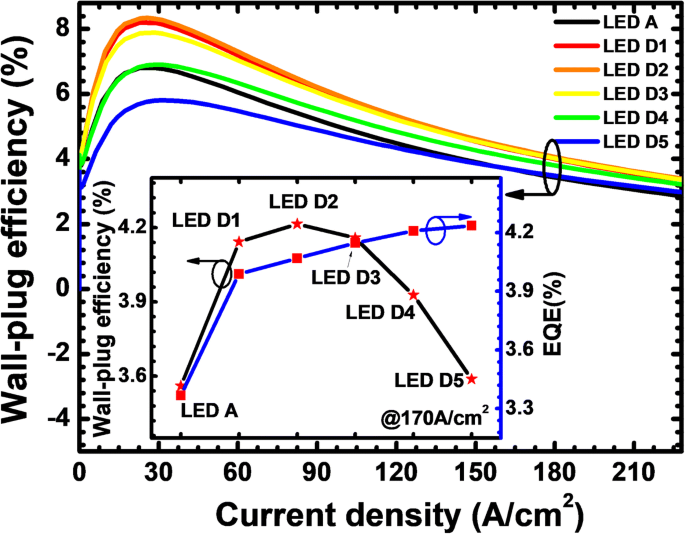
WPE 作为 LED A、D1、D2、D3、D4 和 D5 的注入电流的函数。插图显示了不同掺杂浓度的 n-Al0.40Ga0.60N 层在 170 A/cm 2 电流密度下所研究 LED 的 WPE 和 EQE
PNP-AlGaN 结数对器件性能的影响
在本节中,研究了 PNP-AlGaN 结的数量对 DUV LED 电学和光学性能的影响。为了演示,我们将 n-AlGaN 层的掺杂浓度和厚度固定为 5.3 × 10 17 厘米 −3 和 20 纳米,分别。 AlN成分选择为0.40,例如n-Al0.40Ga0.60N。我们对 PNP-AlGaN 结采用不同的回路,即 LED N1、N2、N3 和 N4 的回路数分别设置为 1、2、3 和 4。我们首先计算并在表 3 中给出了每个 PNP-AlGaN 结的价带势垒高度。可以明显看出,PNP-AlGaN 结数的增加使得整体 N·ρ PNP 高。然后,我们计算并证明了 LED A、N1、N2、N3 和 N4 在电流密度为 170 A/cm 2 的最后一个量子阱中空穴的横向分布 (见图 12a)。它表明随着更多 PNP-AlGaN 结的加入,最后一个量子阱中的空穴分布变得更加均匀。图 12a 中的结果进一步支持了方程 12 的预测。 (1).
<图片>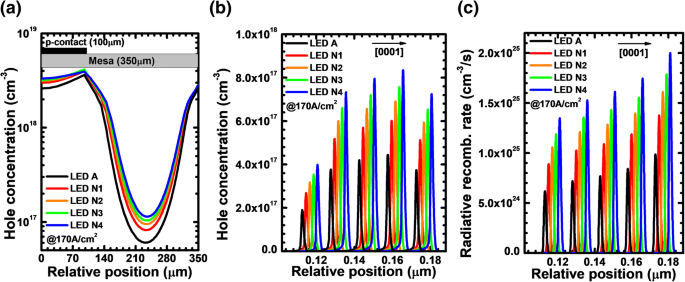
一 最后一个量子阱中的横向空穴分布,b 空穴浓度分布和 c LED A、N1、N2、N3 和 N4 在 MQW 区域在 170 A/cm 2 电流密度下的辐射复合率分布 .面板 b 的绘制曲线 和 c 故意偏移 2 纳米以获得更好的分辨率
然后,我们展示了 LED A、N1、N2、N3 和 N4 在 MQW 区域在 170 A/cm 2 电流密度下的空穴浓度和辐射复合率分布 分别在图 12b、c 中。在距左台面边缘 230 μm 的位置探测孔和辐射复合率曲线。表明PNP-AlGaN结数量越多,空穴浓度和辐射复合率越高。这里值得一提的是,我们没有增加N的值 超过 4,因为当 N 进一步增加,剩余的p-Al0.40Ga0.60N层的厚度变得很薄,以至于空穴可能被电离的Si掺杂剂耗尽,空穴供应不足。
由于改进的电流扩展效应,与 LED A 相比,MQW 区域中空穴浓度的提高,LED N1、N2、N3 和 N4 因此提高了 EQE 和光功率密度(见图 13a)。图 13b 表明,如果包含更多 PNP-AlGaN 结,建议的 DUV LED 的正向工作电压也会增加。 Fortunately, the increase of the forward voltage for LEDs N1, N2, N3, and N4 does not reduce the WPE according to Fig. 14. Further investigations into the inset of Fig. 14 can illustrate that both the EQE and WPE tend to approach a saturation level as the number of the PNP-AlGaN junction increases. Therefore, we believe that, as has also been pointed out previously, further increase of the number for the PNP-AlGaN junction may deplete the holes and correspondingly degrade the hole supply capability, hence making little contribution in enhancing the EQE and the WPE for the proposed device architectures in this work.
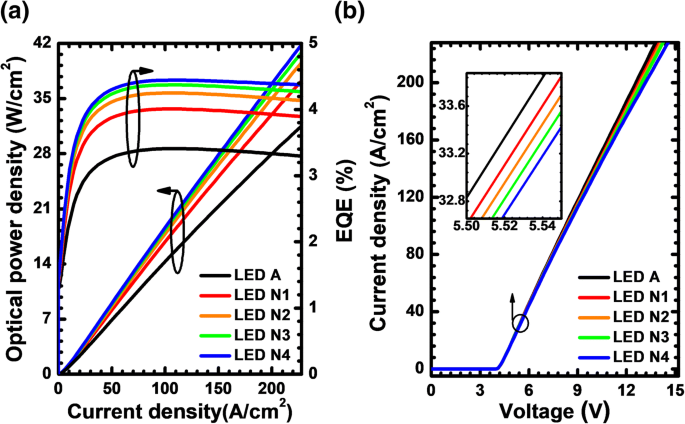
一 Optical output power density and EQE as a function of the injection current, b current-voltage characteristic for LEDs A, N1, N2, N3, and N4. Inset figure shows the zoom-in current-voltage curves
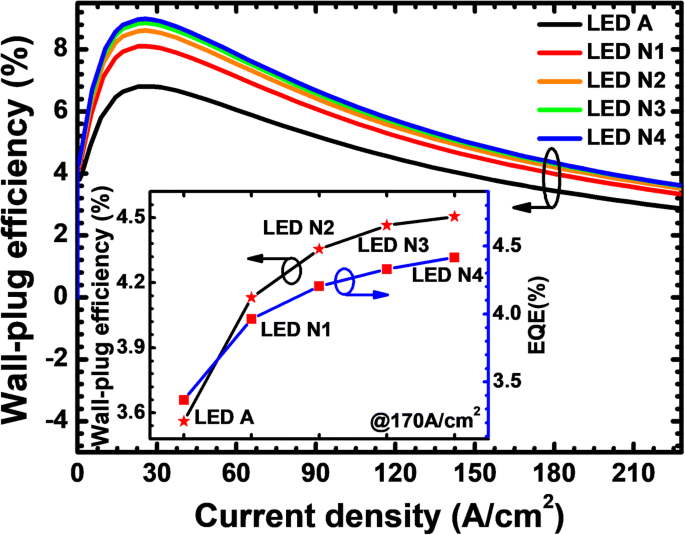
WPE as a function of the injection current for LEDs A, N1, N2, N3, and N4. Inset figure shows the WPE and EQE for LEDs with various number of PNP-AlGaN junction at the current density of 170 A/cm 2
Impact of the AlN Composition for n-AlGaN Layer on the Device Performance
Lastly, we modify the ρ PNP by varying the AlN composition of the n-AlGaN layer for the PNP-AlGaN junction. The values for the AlN composition of the n-AlGaN layer are set to 0.40, 0.43, 0.46, 0.49, and 0.51 for LEDs C1, C2, C3, C4, and C5, respectively. The thickness and the Si doping concentration of the n-AlGaN layer are set to 20 nm and 5.3 × 10 17 厘米 −3 , 分别。 We adopt two PNP-AlGaN junctions for LEDs C1, C2, C3, C4, and C5. The AlN composition for the rest p-AlGaN layers is fixed to 0.40. Table 4 demonstrates the valence band barrier height for the PNP-AlGaN junction with different AlN compositions in the n-AlGaN insertion layer. It is easily understandable that the increased AlN composition in the n-AlGaN layer gives rise to the larger valence band barrier height for holes. Figure 15a exhibits the lateral distributions for holes in the last quantum well for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The current spreading effect is significantly improved as the AlN composition of the n-AlGaN layer increased up to 0.43. It seems that the holes cannot be further soundly spreaded when the AlN composition of the n-AlGaN layer exceeds 0.43 for our structures, because a too much high AlN composition in the n-AlGaN may block the hole injection.

一 Lateral hole distribution in the last quantum well, b hole concentration profiles, and c radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 . The plotted curves for panels b 和 c are purposely shifted by 2 nm for better resolution
The hole concentration and radiative recombination rate profiles in the MQW region for LEDs A, C1, C2, C3, C4, and C5 at the current density of 170 A/cm 2 are presented in Fig. 15b, c, respectively. The data are also collected at the position of 230 μm apart from the left mesa edge. The conclusions here are similar to that for Fig. 6b, Fig. 9b and Fig. 12b, i.e., the adoption of the PNP-AlGaN current spreading layer increases the hole injection, and the hole concentration in the MQW region becomes even more improved once the AlN composition in the n-AlGaN layer increases. We then further calculate and present the EQE and the optical power density in terms of the injection current for the investigated devices in Fig. 16a. Clearly, we can see that the EQE can be improved once the PNP-AlGaN junction is employed. In addition, as the AlN composition in the n-AlGaN layer for the PNP-AlGaN junction increases, the EQE can be further promoted, thanks to the better current spreading, which homogenizes the hole concentration in each quantum well plane as has been shown previously.
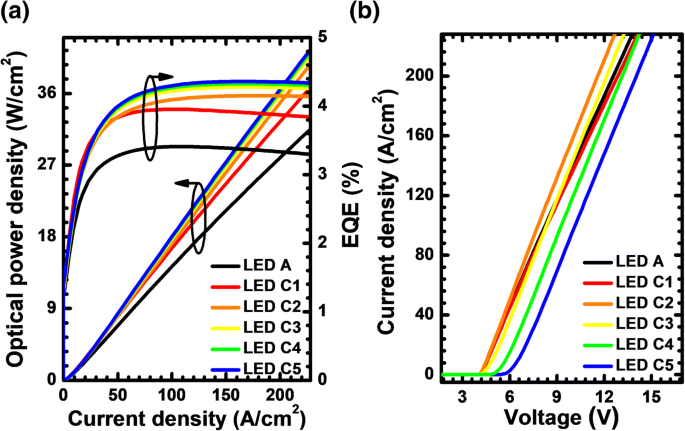
一 Optical output power density and EQE as a function of the injection current and b current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5
Figure 16b investigates the current-voltage characteristics for LEDs A, C1, C2, C3, C4, and C5. The device exhibits a slight increase in the forward operating voltage for LED C1 with the PNP-Al0.40Ga0.60N junction when compared to the LED A. Meanwhile, the device consumes more forward voltage for LEDs C4 and C5. The observation here is consistent with that in Fig. 7b, Fig. 10b and Fig. 13b, such that the adoption of the PNP-AlGaN junction causes the additional valence band barrier height for holes, which, as a result, increases the forward voltage and even the turn-on voltage (e.g., LEDs C4 and C5). However, it is worth mentioning that the forward operating voltage for LEDs C2 and C3 decreases when compared to LED A. The underlying mechanism is not clear at this moment. However, we tentatively attribute the reduced forward voltage for LEDs C2 and C3 to the hole acceleration effect [35].
Figure 17 shows the relationship between the WPE and the injection current density for the tested LEDs. We can get that the WPE can be enhanced for all the proposed LEDs especially when the injection current density is beyond 89 A/cm 2 . Insightful study into LED C5 shows that the WPE for LED C5 is lower than that for LED A when the current density is smaller than 89 A/cm 2 . Nevertheless, the WPE for LED C5 overwhelms that for LED A when the injection current density become higher (i.e.,> 89 A/cm 2 )。 As is well known, the current easily gets crowded when the LED device is biased at a high current level. The WPE for LED C5 reflects that the PNP-Al0.51Ga0.49N junction is indeed effective in improving the current spreading effect. However, considering the additional voltage consumption in the PNP-AlGaN junction, one shall be very careful when setting the AlN composition for the n-AlGaN layer so that the WPE can be maximized according to the inset in Fig. 17.
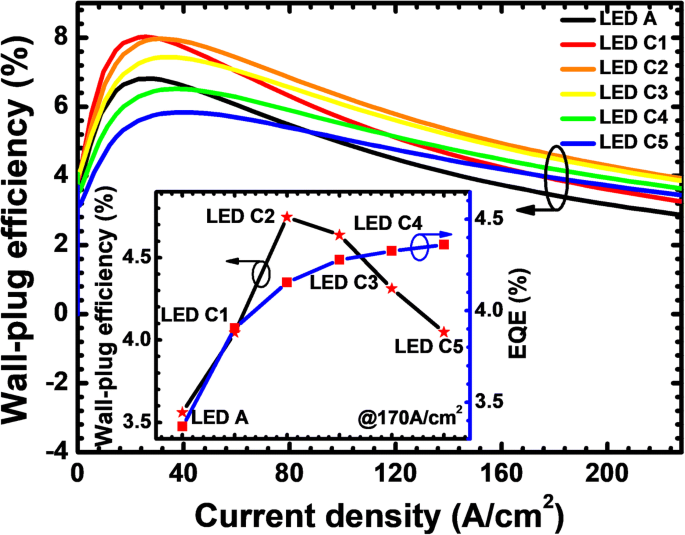
WPE as a function of the injection current for LEDs A, C1, C2, C3, C4, and C5. Inset figure shows the WPE and the EQE for the studied LEDs with various AlN compositions for the n-AlGaN layer at the current density of 170 A/cm 2
结论
To summarize, the PNP-AlGaN junction for DUV LEDs are explored and demonstrated. Assisted by the proposed PNP-AlGaN junctions, the current spreading effect can be improved. The improved current spreading effect is well attributed to increased the vertical resistance and the enhanced horizontal current flow. Moreover, we have also conducted the parametric study to reveal different PNP-junctions on the current spreading effect, the EQE and the WPE. We find that by properly increasing the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction, the current spreading effect can be improved. On the other hand, we also find that the current spreading effect can indeed enhance the EQE. However, the forward voltage may be increased if the PNP-AlGaN junction is not fully optimized, the cost of which is the reduced WPE. It is also worthy pointing out that the current spreading feature is the cooperative function of the thickness, the doping concentration, the AlN composition for the n-AlGaN insertion layer, and the number for the PNP-AlGaN junction. As a result, there is no unique answer for the best design of the PNP-AlGaN current spreading layer for DUV LEDs. However, we strongly believe that the findings in this work introduce the additional physical understanding to the PNP-AlGaN current spreading layer and the current spreading effect for DUV LEDs. Hence, this work is very useful for the community of optical semiconductor devices.
缩写
- APSYS:
-
半导体器件的先进物理模型
- CBL:
-
Current blocking layer
- CL:
-
Current spreading layer
- DUV LEDs:
-
深紫外发光二极管
- EQE:
-
外量子效率
- IQE:
-
内量子效率
- LQW:
-
Last quantum well
- MOCVD:
-
金属有机化学气相沉积
- MQW:
-
多量子阱
- PNP-AlGaN:
-
p-AlGaN/n-AlGaN/p-AlGaN
- SRH:
-
肖克利-雷德-霍尔
- WPE:
-
Wall-plug efficiency
纳米材料
- 为 AI 计算的神经形态芯片提供理由
- IBM 科学家发明了纳米级温度计
- 电子倍增器发射层的设计
- InP/ZnS 核/壳量子点的绿色合成在无重金属发光二极管中的应用
- 制备钙钛矿太阳能电池二氧化钛致密层的最佳钛前驱体
- 具有专门设计的超晶格 p 型电子阻挡层以实现高 Mg 掺杂效率的几乎无效率下降的基于 AlGaN 的紫外发光二极管
- 采用高极性醇溶剂处理 PEDOT:PSS 作为空穴传输层的高亮度钙钛矿发光二极管
- 不同温度下量子阱宽度对 AlGaN 深紫外发光二极管电致发光特性的影响
- 集成环保钙钛矿用于高效白光发光二极管
- 网状p型接触结构对深紫外倒装芯片发光二极管光提取效果的影响
- 用于垂直排列碳纳米管阵列生长的缓冲层的原子层沉积
- 交流电最常见的应用是什么?


