绝缘栅场效应晶体管 (MOSFET)
绝缘栅场效应晶体管 (IGFET),也称为金属氧化物场效应晶体管 (MOSFET),是场效应晶体管(FET)的衍生物。今天,大多数晶体管都是作为数字集成电路组件的 MOSFET 类型。虽然分立 BJT 比分立 MOSFET 多。集成电路内的 MOSFET 晶体管数量可能接近数亿。单个 MOSFET 器件的尺寸小于一微米,每 18 个月减小一次。更大的 MOSFET 能够在低电压下切换近 100 安培的电流;有些可以在较低的电流下处理接近 1000 V 的电压。这些设备占据一平方厘米硅的很大一部分。 MOSFET 的应用比 JFET 广泛得多。然而,目前MOSFET功率器件的应用还没有双极结型晶体管那么广泛。
MOSFET 操作
MOSFET 与 FET 一样具有源极、栅极和漏极端子。然而,与 FET 的情况相比,栅极引线不会直接连接到硅。 MOSFET 栅极是二氧化硅绝缘体顶部的金属或多晶硅层。栅极与金属氧化物半导体相似 (MOS)电容如下图。充电时,电容器的极板采用相应电池端子的充电极性。下极板是 P 型硅,其中电子被负极 (-) 电池端子排斥到氧化物,并被正极 (+) 顶极板吸引。氧化物附近的这种过量电子会在氧化物下方产生反向(过量电子)通道。该沟道还伴随有耗尽区,将沟道与体硅衬底隔离。
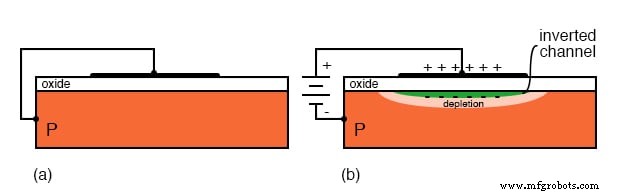
N沟道MOS电容:(a)不充电,(b)充电。
在下图 (a) 中,MOS 电容器放置在 P 型衬底中的一对 N 型扩散之间。由于电容器上没有电荷,栅极上没有偏置,N 型扩散、源极和漏极保持电隔离。
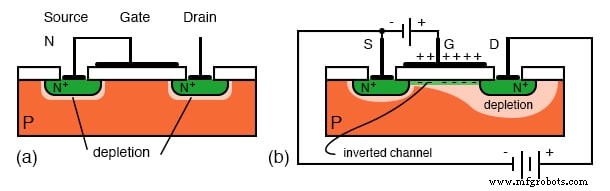
N沟道MOSFET(增强型):(a) 0 V 栅极偏置,(b) 正栅极偏置。
施加到栅极的正偏压为电容器(栅极)充电。氧化物顶部的栅极从栅极偏置电池中获得正电荷。栅极下方的 P 型衬底带负电荷。在栅极氧化物下方形成具有过量电子的反型区。该区域现在连接源极和漏极 N 型区,形成从源极到漏极的连续 N 区。因此,MOSFET 与 FET 一样是单极器件。一种电荷载体负责传导。这个例子是一个 N 沟道 MOSFET。通过在这些连接之间施加电压,大电流从源极到漏极的传导是可能的。一个实际的电路将有一个负载与上图 (b) 中的耗尽电池串联。
E-MOSFET
上面图中描述的 MOSFET 被称为增强模式 MOSFET。通过施加偏置来增强栅极下方的通道,从而开启非导电、关闭的通道。这是最常见的一种设备。另一种MOSFET在此不再赘述。有关耗尽模式,请参阅绝缘栅场效应晶体管章节 装置。
与 FET 一样,MOSFET 是一种电压控制器件。栅极的电压输入控制电流从源极到漏极的流动。栅极不汲取连续电流。但是,栅极会吸收浪涌电流为栅极电容充电。
N 沟道分立式 MOSFET 的横截面如下图 (a) 所示。分立器件通常针对高功率开关进行优化。 N+ 表示源极和漏极是重 N 型掺杂。这最大限度地减少了从源极到漏极的高电流路径中的电阻损耗。 N- 表示轻掺杂。栅极下方、源极和漏极之间的 P 区可以通过施加正偏压来反转。掺杂分布是横截面,其可以以蛇形图案布置在硅管芯上。这大大增加了面积,从而提高了电流处理能力。
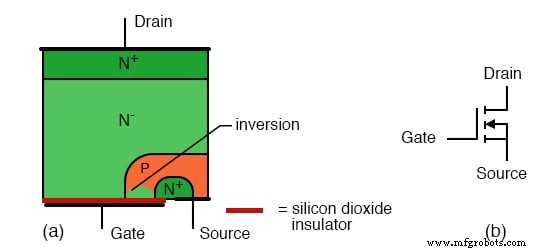
N 沟道 MOSFET(增强型):(a) 横截面,(b) 原理图符号。
上图 (b) 中的 MOSFET 原理图符号显示了一个“浮动”栅极,表明与硅衬底没有直接连接。从源极到漏极的虚线表示该器件处于关闭状态,不导电,栅极上的偏置为零。通常“关断”的 MOSFET 是一种增强型器件。必须通过向栅极施加偏压来增强沟道以进行传导。衬底箭头的“指向”端对应于指向 N 型沟道的 P 型材料,即“非指向”端。这是 N 沟道 MOSFET 的符号。对于 P 沟道器件(未显示),箭头指向相反的方向。 MOSFET 是四个终端器件:源极、栅极、漏极和衬底。基板通过分立式 MOSFET 连接到源极,使封装部件成为三端器件。 MOSFET 是集成电路的一部分,除非有意隔离,否则所有器件的基板都是通用的。这种公共连接可以在芯片外焊接,用于连接到地或电源偏置电压。
V-MOS
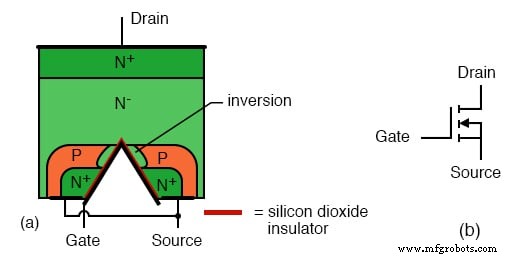
N 沟道“V-MOS”晶体管:(a) 横截面,(b) 示意图符号。
V-MOS (上图)中的器件是改进的功率 MOSFET,其掺杂分布用于降低导通状态的源漏电阻。 VMOS 得名于 V 形栅极区域,它增加了源漏路径的横截面积。这最大限度地减少了损失并允许切换更高级别的功率。 UMOS是一种使用U形槽的变体,在制造上更具可重复性。
评论:
- MOSFET 是单极传导器件,通过一种电荷载流子传导,如 FET,但与 BJT 不同。
- MOSFET 是一种电压控制器件,类似于 FET。栅极电压输入控制源漏电流。
- MOSFET 栅极不吸收持续电流,但漏电流除外。然而,需要相当大的初始电流浪涌来为栅极电容充电。
相关工作表:
- 常规晶体管概述和特殊晶体管工作表
工业技术


