具有由臭氧和等离子体后氧化形成的 GeOx 钝化的 Ge pMOSFET
摘要
GeOx对Ge pMOSFETs电性能的比较研究 执行由臭氧后氧化(OPO)和等离子体后氧化(PPO)形成的钝化层。 PPO 和 OPO 在 Al2O3/n-Ge (001) 衬底上进行,然后在 ALD 室中原位沉积 5-nm HfO2 栅极电介质。通过 X 射线光电子能谱和透射电子显微镜表征介电/Ge 界面层的质量。 PPO 处理导致正阈值电压 (V TH) 移位和较低的 I ON/I OFF 比率,表示接口质量差。具有 OPO 的 Ge pMOSFET 表现出更高的 I ON/I 与 PPO 器件相比,OFF 比(高达四个数量级)、改进的亚阈值摆动和增强的载流子迁移率特性。 OPO 工艺中更厚的 Al2O3 阻挡层导致 Ge 晶体管的迁移率更高。通过比较两种不同的氧化方法,结果表明OPO是提高界面层质量的有效途径,有助于提高Ge pMOSFET的有效迁移率。
背景
随着传统互补金属氧化物半导体 (CMOS) 器件接近其物理极限,以硅 (Si) 作为沟道材料的高速半导体器件难以实现性能增强。用其他具有高迁移率的材料替换衬底或通道材料是一个必要的选择。由于载流子迁移率高于硅,锗 (Ge) 被认为是一种有前途的替代沟道材料。 MOSFET 通常需要高质量的氧化物/半导体界面才能达到高有效迁移率。然而,在相当长的历史中,Ge MOSFET 受到高界面态密度(D 它)是由 GeO2 和悬空键的热稳定性差引起的 [1]。因此,人们对Ge界面钝化进行了大量研究。
已经报道了几种实现高质量 Ge/介电界面层的方法,例如通过在介电外延之前在 Ge 衬底上均匀沉积几个 Si 单层的 Si 钝化或通过有意形成 GeO2 进行自钝化 [2, 3]。为了形成高质量的GeO2层,有许多氧化过程来减少D 并提高热稳定性,包括高压氧化[4]、臭氧氧化[5]、H2O等离子体[6]和电子回旋共振(ECR)等离子体后氧化[7]。
近年来,大量研究表明,通过 Al2O3/Ge 界面后氧化可以实现高性能 Ge MOSFET。 2014年,在GeOx的Ge-on-insulator (GeOI)衬底上实现了Ge CMOS反相器 在 1 nm 的 Al2O3 沉积在 Ge 上之后,通过在纯氧环境中快速热退火生长 [8]。在参考。 [7], Ge pMOSFETs 和 nMOSFETs with GeOx 通过氧等离子体后氧化和GeOx的温度依赖性制造钝化 还讨论了厚度和电气性能。臭氧对 Ge 的热氧化可以在较低温度下进行,因为臭氧比氧气更具反应性 [5]。温度对GeOx的影响 证明了臭氧在 Ge 表面上生长的厚度。具有 GeOx 的 Ge pMOSFET 臭氧后氧化钝化也有报道[9]。
在这项工作中,Ge pMOSFETs with GeOx 钝化是使用 Al2O3/n-Ge 界面的臭氧后氧化 (OPO) 和氧等离子体后氧化 (PPO) 制造的。对 Ge pMOSFET 与 OPO 和 PPO 的电气性能进行了比较研究。除钝化外的所有工艺都精确控制为相同。后氧化是在 Al2O3 阻挡层沉积之后进行的,这不同于 [9],其中后氧化是在 HfO2 沉积之后。 Coulomb的迁移率退化机制 并对粗糙度散射进行了研究。还讨论了 Al2O3 阻挡层的厚度对器件性能的影响。总的来说,我们证明了 OPO 是未来 Ge MOSFET 制造的一种很有前途的钝化技术。
方法
Ge pMOSFET 是在 4 英寸上制造的。 n-Ge (001) 晶片的电阻率为 0.14–0.183 Ω cm。执行了三种不同的钝化工艺,关键工艺步骤如图 1a 所示。晶片用稀释的 HF (1:50) 和去离子水清洗几个循环以去除天然氧化物,然后立即转移到等离子体增强原子层沉积 PEALD (Picosun R200 Advanced) 室。然后,分别以三甲基铝 (TMA) 和去离子水 (H2O) 作为 Al 和 O 的前体,在 300 °C 下沉积一层薄的 Al2O3 膜(~ 1 nm)。由于 Al2O3/GeO2 层太薄而无法获得精确的氧原子比,因此我们将这两层标记为 AlOx /GeOx .使用 Litmas 远程等离子体源进行 PPO 60 秒。输入氧气流量为 750 sccm 的臭氧发生器(美国 AC 系列臭氧发生器)用于在 50% O3/O2 环境中进行 OPO 处理。在不破坏真空的情况下,将 60 个循环的 HfO2 沉积在 AlOx 的顶部 /GeOx 分别使用四二甲基氨基铪 (TDMAHf) 和 H2O 作为 Hf 和 O 的前体,在 300 °C 下进行 PPO 或 OPO 处理。然后通过反应溅射沉积 100 nm TaN 作为栅极金属。栅极构图和蚀刻后,自对准BF 2+ 以20 keV的能量和1 × 10 15 的剂量注入源/漏(S/D)区 cm − 2 进行了。通过剥离工艺沉积和图案化 20 纳米的 Ni S/D 金属。最后,在 450 °C 下快速热退火 30 s 以进行掺杂激活和 S/D 欧姆接触。制造的Ge pMOSFET的示意图和显微图像分别如图1b和c所示。
<图片>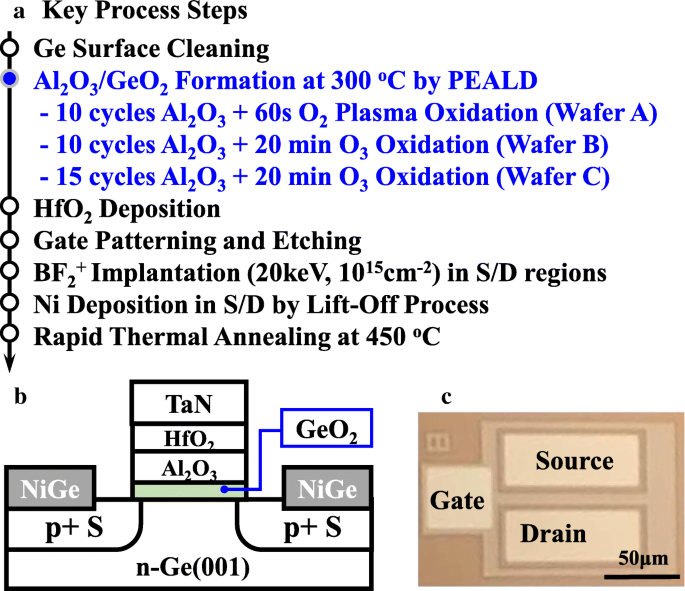
一 使用三种不同钝化方法制造具有 GeO2 表面钝化的 Ge pMOSFET 的关键工艺流程。 b 原理图和c 制备的Ge晶体管的显微图像
TaN/HfO2/AlOx的横截面 /GeOx /Ge 栅极堆叠使用透射电子显微镜 (TEM) 进行描绘,以比较氧等离子体或臭氧对 GeOx 的影响 形成。图 2a 和 b 显示了 TaN/HfO2/AlOx 的横截面 TEM 图像 /GeOx /Ge 栅极堆栈分别带有 PPO 和 OPO。两种器件中非晶 HfO2 层的厚度均为 6 nm。经过 60 秒 PPO 处理的晶圆 A 具有明显的 AlOx /GeOx HfO2 和 Ge 基板之间的层。这个AlOx /GeOx 由 20 min OPO 形成的晶片 B 中的层具有不整齐的边缘。 GeOx 的厚度 层与[10]中的数据一致。
<图片>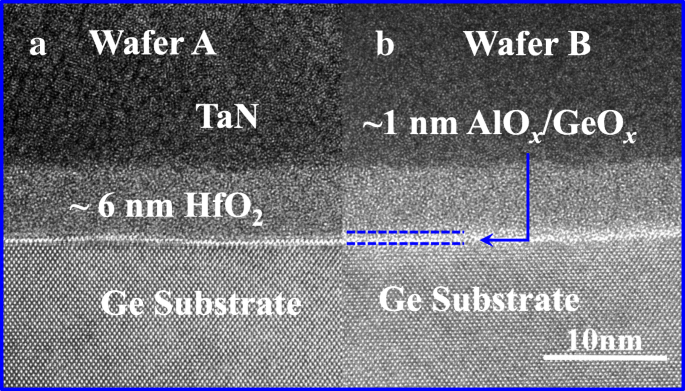
具有 Al2Ox 的高 k/金属栅叠层的横截面 TEM 图像 /GeOx a 制造的界面层 (IL) OPO 和 b n-Ge (001) 通道上的 PPO
结果与讨论
Keithley 4200-SCS 测量了输出和传输特性以及高频栅源电容电压 (CV)。图 3 显示了三种不同 AlOx 形成条件下 Ge pMOSFET 的传输和输出特性的比较 /GeOx 钝化层。各种晶圆上的所有器件都有一个栅极长度 (L G) 3 μm。晶圆 A 上的器件表现出更高的饱和漏极电流 (I DS) 与其他两个晶圆相比。但是带有 OPO 的晶圆 B 和 C 显示出低得多的关态电流 (I OFF) 与带有 PPO 的晶片 A 相比。还可以看出,带有 OPO 的晶片 B 和 C 在增强模式下工作,而晶片 A 在耗尽模式下工作。据推测,经过 PPO 处理后,n-Ge 表面由于 D 仍然保持为 p 型 它的值已在[11]中讨论过。具有较厚 Al2O3 阻挡层的晶圆 C 显示出正 V 与晶圆 B 和更高的 D 相比,TH 偏移 它比晶片 B。从图 3b 所示的输出特性观察到,在低栅极电压 (V GS),晶片 A 具有较低的 I 由于不太陡的亚阈值摆动 (SS),DS 在晶圆 B 和 C 上。当 V GS 增加,I 与其他两种器件相比,晶圆 A 的 DS 越来越高。因此,从图 3 和图 2 中的 TEM 图像,AlOx 的扩散 /GeOx 层可能会抑制 I OFF,从而提高钝化效果。
<图片>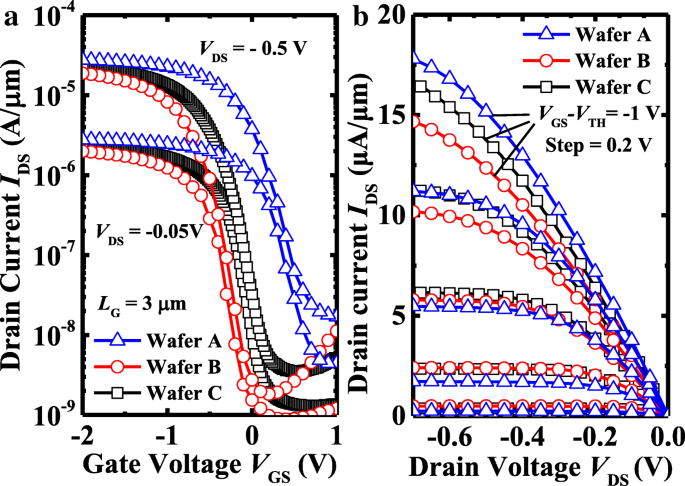
一 我 DS–V GS 和 b 我 DS–V 由PPO(晶圆A)和OPO(晶圆B和C)制造的具有Al2O3/GeO2钝化层的Ge pMOSFET的DS特性
图 4 总结了 I 的统计结果 ON/I 不同晶圆上器件的关断比和亚阈值摆动。具有 OPO 的 Ge pMOSFET 表现出更高的 I ON/I 与 PPO 器件相比,关断比(~ 4 个数量级)和显着改善的 SS,表明介电/通道界面的质量更高。与晶圆 B 相比,晶圆 C 表现出更高的导通电流 (I ON) 但较低的 I ON/I 关闭率。
<图片>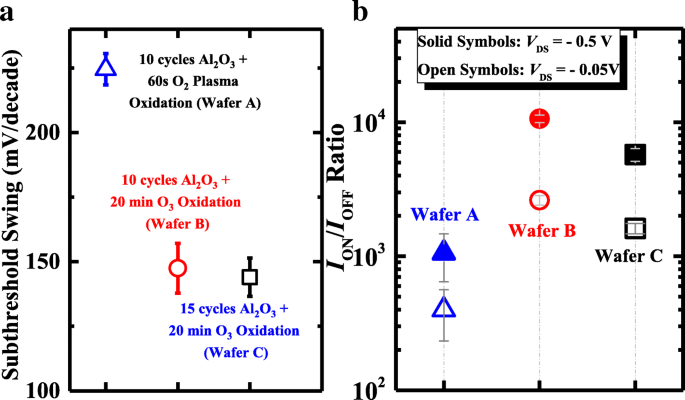
a 的统计图 SS 和 b 我 ON/I 不同钝化条件下Ge pMOSFET的关断率
为了进一步表示不同后氧化方法的界面层质量,通过 X 射线光电子能谱 (XPS) 测试晶片 A、B 和 C(不含 HfO2 和栅极金属的虚拟样品)。 XPS 测量是在没有 HfO2 沉积和 TaN 溅射的 PPO 或 OPO 处理后对三个氧化后虚拟样品进行的。 GeOx的化学计量 用单色软 Al Kα (1486.6 eV) X 射线源研究 Al2O3/GeO/Ge 样品中的Ge 3d 峰和峰分化分析如图 5 所示。Ge 3d 三个样品的5/2峰统一在29.7 eV,Ge 3d的化学位移 3/2, Ge 1+ , Ge 2+ , Ge 3+ , 和 Ge 4+ 到 Ge 3d 5/2 分别设置为 0.6、0.8、1.8、2.75 和 3.4 eV [12]。在图 5b 中,晶片 A 显示在 60 秒 PPO 后,GeOx 中的主要 Ge 价 是 Ge 1+ 和 Ge 3+ .在晶片 C 中观察到类似的 Ge 价态分布,并且 Ge 3+ 成分略有增加。在图 5b 中,晶片 B 显示具有更薄(10 循环)Al2O3 的 OPO 器件将进一步氧化 Ge 1+ 进入Ge 2+ , Ge 3+ , 和 Ge 4+ , 而 Ge 1+ 明显减少。
<图片>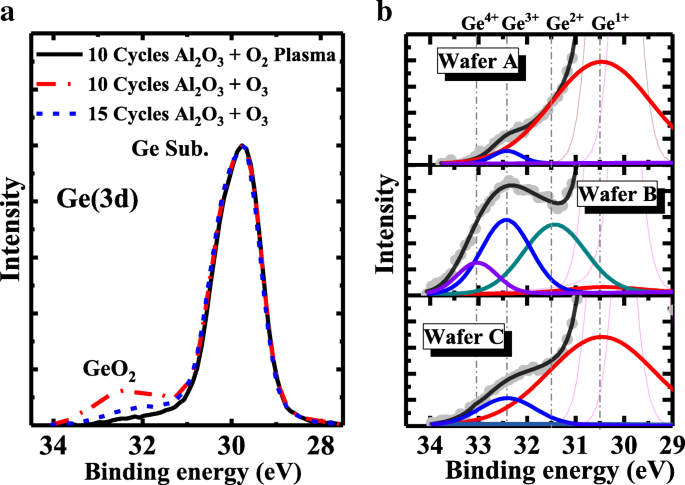
一 Ge 3d Al2O3/GeOx的XPS光谱 /Ge 由不同条件形成。 b Ge 3d 的峰拟合 三个样品的GeO2层的XPS光谱
栅源 CV 特性如图 6 所示。从 1-MHz CV 曲线,D Terman's 估计在 midgap 附近 方法 [13],并且还评估了等效氧化物厚度 (EOT) 值,如表 1 中所列。与 PPO(晶片 A)相比,20 分钟的 OPO(晶片 B 和 C)导致更高的 EOT。由于更厚的 Al2O3 作为阻挡层,晶片 C 表现出比晶片 B 更高的 EOT。据报道,GeOx 的厚度 在 O3 环境中的裸 Ge 表面在几分钟内达到饱和,饱和厚度由温度而不是氧化时间决定[10]。所以在本文中,GeOx 的厚度 臭氧后氧化几分钟后饱和,剩余氧化时间仅用于退火。
<图片>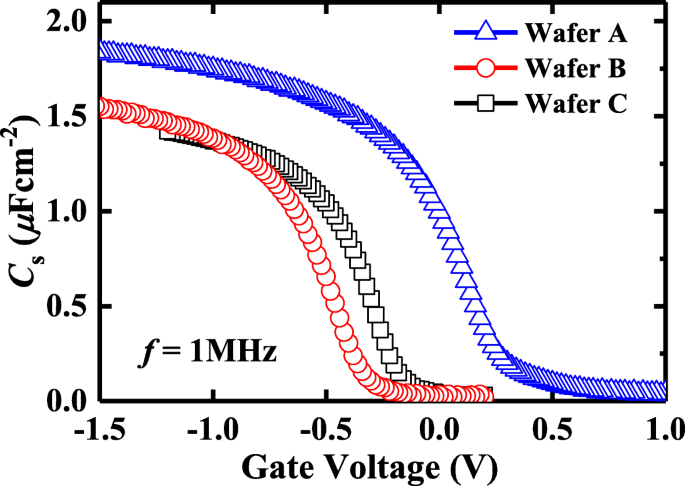
栅源电容与 V GS PPO(晶圆 A)和 OPO(晶圆 B 和 C)钝化的 Ge pMOSFET 的特性
图 7 总结了总电阻 (R T) 与 L G 在这项工作中的每个设备。在这里,R T 定义为 V DS/我 V 处的 DS DS =0.05 V 和 V GS - V TH =1 V.源/漏(S/D)串联电阻(R SD) 和通道电阻 (R CH) 可以从 R 的线性拟合的截距和斜率中提取 T–L G 线如图 7 所示。提取的 R SD 和 R CH 结果汇总在表 1 中。图 7 显示具有 PPO 的 Ge pMOSFET 表现出较低的 R SD 和 R CH 与图 6 所示的电容结果一致。
<图片>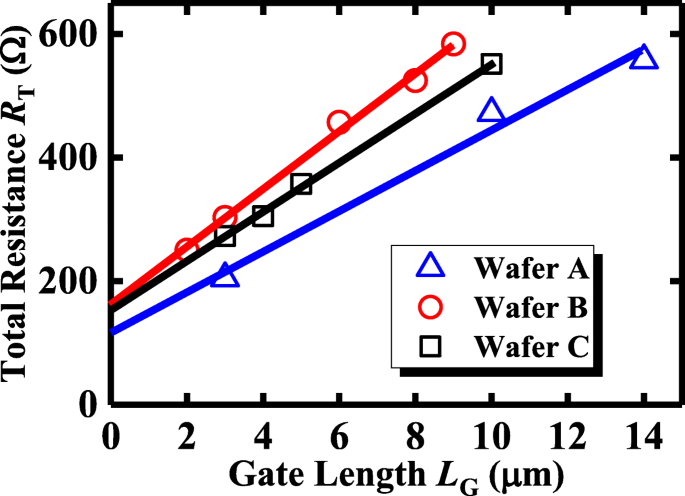
总电阻 (R T) 与栅极长度 (L G) Ge pMOSFETs
有效空穴迁移率μ eff 是基于基于总阻力斜率的方法提取的。在图 8 中,我们比较了 μ 我们采用 PPO 和 OPO 处理的 Ge pMOSFET 的 eff 与其他报道的 Ge pMOSFET [9, 14]。 问 inv 是器件通道中的反转电荷密度。具有 OPO 的 Ge pMOSFET 表现出更高的峰值 μ eff 与具有 PPO 的设备相比。具有较厚 Al2O3 阻挡层的晶圆 C 具有更高的峰值空穴迁移率,为 283 cm 2 /V s 与具有较薄 Al2O3 的晶片 B 相比。具有 PPO 的晶圆 A 表现出较低的高场孔 μ 具有 OPO 的器件的 eff,这归因于较低的粗糙度散射。但是,在低场下,带有 PPO 的晶圆 A 上的晶体管实现了较低的 μ 由于更高的库仑散射,效率高于 OPO 设备 [15]。只有少数关于通过臭氧钝化制造的 Ge pMOSFET 的工作被报道。在这里,我们的器件与已报道的用 OPO [9, 14] 处理的 Ge pMOSFET 之间的关键器件性能进行了比较,结果如表 2 所示。得出的结论是,本工作中的晶片 C 达到了高-field μ eff 增强和更高的 I ON/I 与报告的用 OPO 处理的设备相比,关闭。此外,在 Q 5 × 10 12 的倒数 cm − 2 , 晶圆 C 表现出高 2.37 倍的 μ eff 与 Si 通用迁移率相比。 我 晶片 C 的 ON 略低于参考中的 ON。 [9] 这是由于较大的 EOT。
<图片>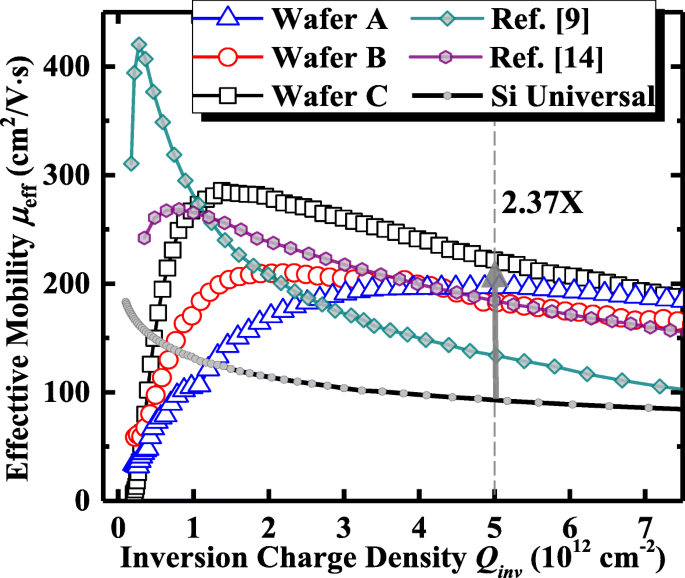
μ eff 与 Q 具有不同钝化条件的 Ge pMOSFET 的 inv。 15 循环Al2O3 + 20 分钟O3氧化的Ge晶体管(晶圆C)表现出峰值μ 283 cm 2 的效果 /对。 S/D电阻对μ的影响 基于总电阻斜率的有效沟道迁移率提取方法去除eff提取[16]
结论
Ge pMOSFET 是用 GeOx 实现的 钝化,它是在 PEALD 中通过 OPO 或 PPO 处理 Al2O3/n-Ge 形成的。 OPO 器件表现出更好的传输和输出特性,更高的 I ON/I OFF 比、改进的亚阈值摆幅和更高的峰值 μ eff 与 PPO 设备相比。对于 15 周期 OPO 工艺,较厚的 Al2O3 层导致更高的 EOT 值和改进的 μ 与 10 周期情况相比,设备中的 eff。这项工作的所有结果表明,OPO是实现高质量Ge/介电界面的有效钝化方式,因此可以成为未来Ge MOSFET制造的一种有前途的候选钝化技术。
缩写
- Al2O3 :
-
氧化铝
- ALD:
-
原子层沉积
- BF2 + :
-
硼氟离子
- EOT:
-
等效氧化层厚度
- 哥:
-
锗
- GeOx :
-
氧化锗
- 高频:
-
氢氟酸
- HfO2 :
-
二氧化铪
- TEM:
-
透射电子显微镜
- MOSFET:
-
金属氧化物半导体场效应晶体管
- OPO:
-
臭氧后氧化
- PPO:
-
等离子后氧化
- Q 输入:
-
反转电荷密度
- SS:
-
亚阈值摆动
- XPS:
-
X射线光电子能谱
- μ 效果:
-
有效空穴迁移率
纳米材料
- 使用 Raspberry Pi 和 Python 构建机器人
- 坚持不懈地领导
- Portenta 和热电偶传感器(带 MAX6675)
- 带有示例的 C++ 类和对象
- 具有高级农业化学活性的智能纳米材料和纳米复合材料
- 通过镀金和等离子处理调整聚醚醚酮的表面化学
- 通过氩等离子体处理插入 ZnO 降低金属和 n-Ge 之间的接触电阻
- 具有非晶 Si 钝化的高迁移率 Ge pMOSFET:表面取向的影响
- 通过原子层沉积氧化铝和两步后退火提高 Si 钝化和 PERC 太阳能电池效率
- 具有 ZrO2 电介质的高迁移率 Ge pMOSFET:后退火的影响
- 什么是等离子切割以及等离子切割的工作原理?
- Node-RED 和 Docker 入门


