具有 ZrO2 电介质的高迁移率 Ge pMOSFET:后退火的影响
摘要
本文研究了金属后退火 (PMA) 和沉积后退火 (PDA) 对具有 ZrO2 电介质的 Ge p 型金属氧化物半导体场效应晶体管 (pMOSFET) 电性能的影响。对于没有 PDA 的晶体管,导通电流 (I ON)、亚阈值摆幅 (SS) 和电容等效厚度 (CET) 特性随着 PMA 温度从 350 增加到 500 °C 而得到改善。在较高 PMA 温度下 ZrO2 电介质的结晶有助于 ZrO2 介电常数的增加和界面态密度的降低 (D 它),导致 CET 降低和高有效空穴迁移率(μ eff)。结果表明,在 400 °C 下进行 PDA 处理的 Ge pMOSFET 具有较低的 CET 和较陡的 SS,但具有较低的 μ 与没有 PDA 的设备相比,效率更高。
背景
锗 (Ge) 已被视为先进 CMOS 的有吸引力的 p 沟道材料之一,因为它提供比 Si 高得多的空穴迁移率 [1,2,3]。高质量的栅极电介质和 Ge 表面的有效钝化是实现卓越的有效载流子迁移率 (μ eff) 和 Ge 晶体管中的高驱动电流 [4,5,6,7]。已经研究了几种高 κ 材料,例如 HfO2 [8]、ZrO2 [7, 9]、La2O3 [10] 和 Y2O3 [11],作为 Ge p 型金属氧化物半导体场效应的替代栅极电介质晶体管 (pMOSFET) 以实现电容等效厚度 (CET) 向亚 1 nm 的可扩展性。其中,与基于 Hf 的电介质相比,ZrO2 电介质具有更高的 κ 值 [12, 13] 和更好的界面质量 [14],因此备受关注。据广泛报道,ZrO2 的结晶可以进一步提高 Ge pMOSFET 的电性能,例如降低 CET 和提高 μ 效果 [15, 16]。然而,目前缺乏ZrO2结晶工艺步骤对Ge晶体管器件性能影响的研究。
在本文中,我们研究了金属后退火 (PMA) 和沉积后退火 (PDA) 对具有 ZrO2 电介质的 Ge pMOSFET 电性能的影响。显着改善μ 在更高的 PMA 温度下,器件可以实现更高的效率和更低的 CET。
方法
图 1a 显示了制造具有 ZrO2 电介质的 Ge pMOSFET 的关键工艺步骤。 Ge pMOSFET 在 n 型 Ge(001) 晶片上制造,电阻率为 0.088–0.14 Ω∙cm。在稀释的 HF (1:50) 溶液中进行化学清洗和去离子水冲洗的几个循环之后。 Ge 晶片被装入原子层沉积 (ALD) 室。 Ge 表面通过臭氧后氧化 (OPO) 钝化,即在 300 °C 下沉积超薄 Al2O3 层,然后在 300 °C 下进行原位 OPO 15 分钟。之后,分别使用 TDMAZr 和 H2O 作为 Zr 和 O 的前体,在同一 ALD 室中在 250 °C 下沉积 5 纳米厚的 ZrO2。在沉积过程中,Zr[N(CH3)2]4 源被加热到 85 °C。使用快速热退火在 400 °C 下对某些样品进行 PDA 工艺 60 s。带有和不带有 PDA 的样品分别表示为晶片 II 和 I。然后,通过反应溅射沉积 100 nm 厚的 TaN 栅电极。栅极构图和蚀刻后,通过BF2 + 形成源/漏(S/D)区 注入能量为 30 keV,剂量为 1 × 10 15 cm −2 . 15 纳米镍 S/D 触点是通过剥离工艺形成的。最后,在350、400、450和500 °C下进行30 s的PMA进行掺杂活化和S/D金属化。
<图片>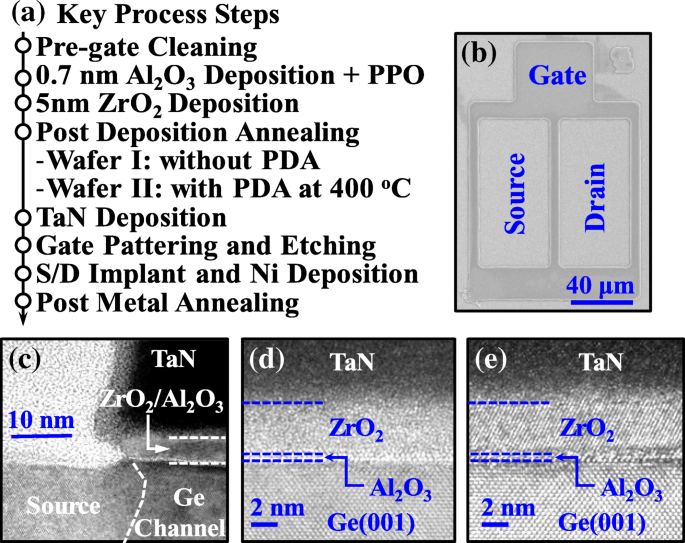
一 制造具有 ZrO2 电介质的 Ge pMOSFET 的关键工艺步骤。 b 制造的晶体管的SEM图像。 c Ge pMOSFET 的 XTEM 图像显示了栅极和 S/D 区域。 d , e 分别在 400 °C 和 500 °C 下退火的晶圆 I 上 Ge pMOSFET 栅极堆叠的 HRTEM 图像
图 1b 显示了制造的 Ge pMOSFET 的扫描电子显微镜 (SEM) 图像。图 1c 显示了 Ge pMOSFET 的横截面透射电子显微镜 (XTEM) 图像,显示了源极/漏极区、金属栅极和 ZrO2 电介质。图 1d 和 e 分别显示了在 400 和 500 °C 时在晶圆 I 上具有 PMA 的 Ge pMOSFET 栅极堆叠的高分辨率 TEM (HRTEM) 图像。观察到 ZrO2 电介质完全结晶并经历了PMA 在 500 °C。 Al2O3界面层厚度约为0.7 nm。
结果与讨论
反相电容C inv 与 V 晶片 I 上的器件在 300 kHz 频率下测量的 GS 曲线如图 2 所示。对于 PMA 为 350、400、450 的器件,CET 值提取为 ~ 1.95、1.80、1.67 和 1.52 nm , 和 500 °C,分别。由于 ZrO2 的结晶,在较高的 PMA 温度下实现了较小的 CET。一般来说,无定形和结晶 ZrO2 的 κ 值分别约为 20-23 和 28-30。 5 纳米厚的结晶 ZrO2 贡献了 ~ 0.7 nm 的 EOT。 C-V 的转变 不同 PMA 温度下的曲线是由于结晶降低了 ZrO2 电介质中体陷阱的密度。
<图片>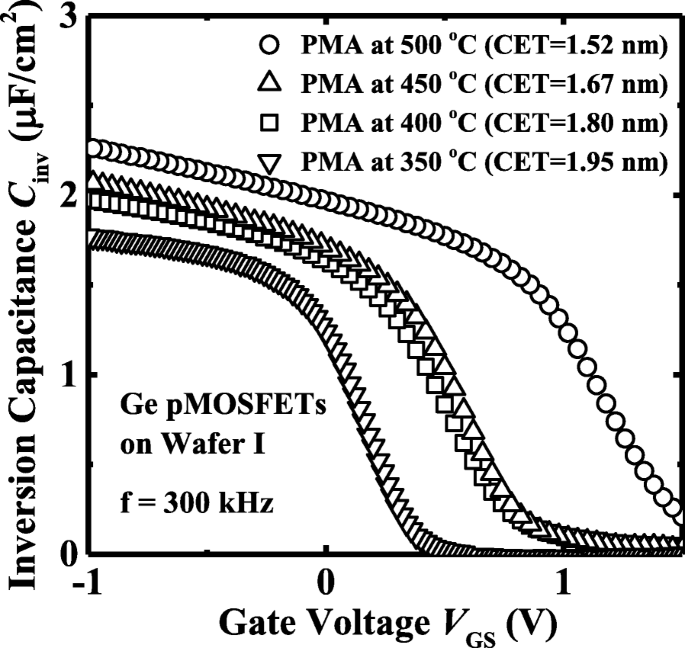
反转 C inv-V 具有 PMA 的晶圆 I 上的 Ge pMOSFET 在 350 °C、400 °C、450 °C 和 500 °C 下的 GS 曲线
图 3a 显示了测量的传输特性和栅极漏电流 I 晶片 I 上具有不同 PMA 温度的 Ge pMOSFET 的 G。所有器件的栅极长度为 L 4 μm的G和栅极宽度W 100 μm。 Ge pMOSFET 表现出低得多的 I G 与 I 相比 DS 适用于所有 PMA 温度。一个我 ON/I OFF 比率高于 10 4 PMA 在 500 °C 下实现的器件。 我 DS-V 在不同栅极过驱动下测量的器件的 DS 曲线 |V GS-V TH|如图 3b 所示。需要注意的是,阈值电压V TH 定义为 V I 处的 GS DS 为 10 −7 A/微米。与分别在 450 °C 和 350 °C 和 V 下退火的器件相比,在 500 °C 下具有 PMA 的 Ge 晶体管获得了 ~ 47% 和 118% 的驱动电流改进 DS of − 1.0 V 和 |V GS-V TH| 0.8 V。图3c显示了I的统计图 在 V 时开启 DS of − 0.5 V 和 V GS-V 对于具有各种 PMA 温度的 Ge pMOSFET,TH 为 − 1 V。该图中的所有晶体管都有一个 L G 4 μm 和 W 100 μm。 PMA 在 500 °C 时的器件表现出改进的 I 与具有较低 PMA 温度的那些相比,ON 是由于 S/D 电阻降低、CET 降低和 μ 较高 eff,后面会讲到。
<图片>
一 测量 I D、我 S 和 I G 对比V 在 350、400、450 和 500℃ °C 下,带有 PMA 的晶圆 I 上的 Ge pMOSFET 的 GS 曲线。 b 我 DS-V 在不同 V 下测得的 DS 曲线 GS-V TH 为设备。 c 在 500 °C 下退火的器件具有更高的导通电流 I 在较低温度下与带有 PMA 的晶体管相比导通
图 4 显示了 midgap D 的统计图 它、SS 和 V 具有不同 PMA 温度的器件的 TH 特性。如图 4a 所示,基于最大电导法[17],midgap D 它的值被提取为 1.3 × 10 13 , 9.5 × 10 12 , 9.2 × 10 12 , 和 6.3 × 10 12 cm −2 eV −1 对于 PMA 分别为 350、400、450 和 500 °C 的器件。图 4b 显示了在 500 °C 下退火的 Ge pMOSFET 比在较低温度下退火的晶体管具有更好的 SS 特性,这是由于较小的中隙 D 它和 CET。 D 的值 它和带有 PMA 的 Ge pMOSFET 的 SS 仍然高于报道最好的 Ge 晶体管。它可以通过优化 OPO 钝化模块来减少,例如 Al2O3 厚度和臭氧氧化温度和持续时间。 V TH 移至正 V GS随着PMA温度的升高,源于CET和D的降低 它。得出的结论是,在 500 °C 时,具有 PMA 的 Ge pMOSFET 可实现最佳电气性能。
<图片>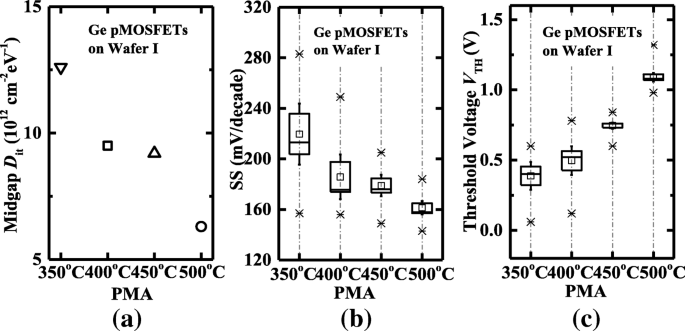
a 的比较 中差D 它,b SS 和 c V 晶圆 I 上的 Ge pMOSFET 的 TH,PMA 在 350、400、450 和 500 °C
μ eff 作为影响 Ge pMOSFET 中器件驱动电流和跨导的关键因素,使用 ΔR 进行测量 总/ΔL G方法[18]。使用L测量了大量设备 G 范围从 1.5 到 9 μm。图 5a 说明了总电阻 R 在 |V 处提取 tot GS-V TH| − 1 V 和一个 V DS of - 0.05 V 作为 L 的函数 G. R SD 是拟合线在 y 处相交的值 -轴。 R 对于在 350、400、450 和 500 °C 下具有 PMA 的器件,估计 SD 值分别约为 7.85、7.15、6.10 和 4.35 kΩ ·μm。这表明在较高 PMA 温度下 S/D 的掺杂剂激活效果更好。 μ 可以通过 μ 提取 eff eff =1/[WQ inv(ΔR 总/ΔL G)],其中 Q inv 是 Ge 通道中的反转电荷密度和 ΔR 总/ΔL G 是 R 的斜率 tot vs. L G 如图 5a 所示。较小的ΔR 总/ΔL PMA 在 500 °C 时的 G 表示 μ 的增强 eff 与在 450 °C 下使用 PMA 的晶体管相比。图 5b 显示了 μ eff 作为 Q 的函数 inv 曲线,使用分割 C 提取 -V 方法。空穴迁移率峰值为384 cm 2 /V ·s 对于 PMA 在 500 °C 的器件,比 PMA 在 400 °C 的器件高 31%。在高 Q 1 × 10 13 的倒数 cm −2 ,与在 400 °C 下退火的器件相比,在 500 °C 下进行 PMA 的 Ge pMOSFET 实现了迁移率增强。与具有非晶 ZrO2 的器件相比,具有晶体 ZrO2 的 Ge 晶体管具有较低的体陷阱电荷密度,从而导致空穴的远程库仑散射较低。由于结晶 ZrO2 和 Ge 之间的光滑界面,在 500 °C 下退火的 Ge 器件具有较低的表面粗糙度散射,并显示峰值迁移率向较高的 Q 移动 反诉
<图片>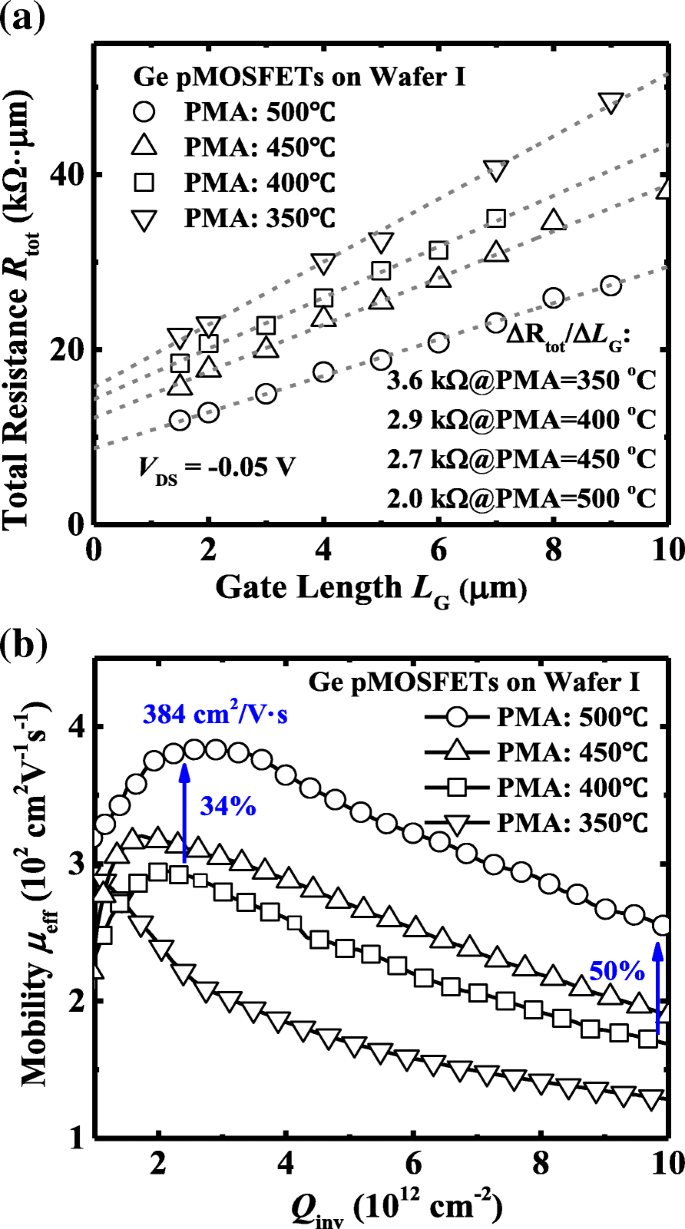
一 R 作为 L 的函数的 tot G 在 V GS-V - 1 V 和 V 的 TH 对于具有不同 PMA 温度的晶圆 I 上的器件,DS 为 − 0.05 V。 b μ 效果 对比问 由拆分 C 提取的 inv -V 方法。在 500 °C 时使用 PMA 的器件获得最高迁移率
接下来,我们将讨论 PDA 对 Ge pMOSFET 电气特性的影响。图 6 显示了测得的 C inv 与 V 晶片 I 和晶片 II 上的 Ge pMOSFET 的 GS,在 400 °C 下具有 PMA。与没有 PDA 的设备(1.80 nm)相比,在 400 °C 下使用 PDA 的设备的 CET 值要低得多,为 1.29 nm。图 7a 显示了 I D、我 S 和 I G-V 晶圆 I 和晶圆 II 上 Ge pMOSFET 的 GS 特性曲线,以及在 400 °C 下进行 PMA 的器件。与不带 PDA 的晶体管相比,带 PDA 的器件获得更大的栅极漏电流,这是由于较低的 CET。对应的I DS-V 在不同的栅极过驱动 V 下测量的器件的 DS 曲线 GS-V TH如图7b所示。在 400 °C 下,与 PDA 相比,没有 PDA 的 Ge 晶体管的驱动电流提高了 ~ 24%,同时饱和区的过驱动为 - 0.8 V。
<图片>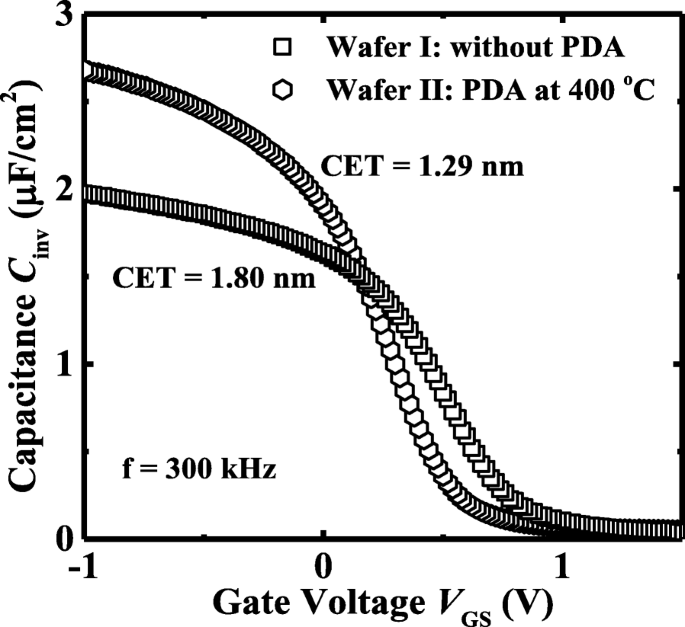
C inv-V 在 400 °C 下使用 PMA 的晶圆 I 和 II 上的器件的 GS 图
<图片>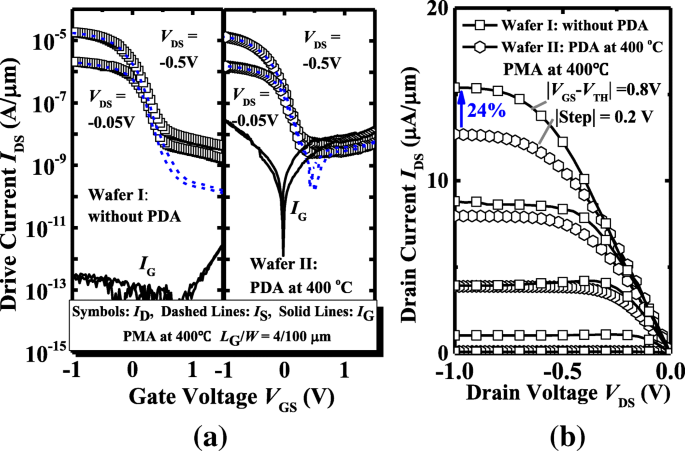
一 我 D、我 S 和 I G 对比V 在 400 °C 下使用 PMA 在晶圆 I 和 II 上的 Ge pMOSFET 的 GS 曲线。 b 我 DS-V 在不同 V 下测得的 DS 曲线 GS-V 设备的 TH
图 8 绘制了 midgap D 的统计结果 它、SS 和 V 带有和不带有 PDA 的 Ge pMOSFET 的 TH。图 8a 显示了较小的 D 与不带 PDA 的器件相比,它是在 400 °C 的带有 PDA 的 Ge pMOSFET 中实现的。在图 8b 中,PDA 在 400 °C 时的平均亚阈值摆幅为 142 mV/decade 的较低值,对应于较低的 CET 和较低的 D 它。这表明在 400 °C 下具有 PDA 的器件具有优异的 ZrO2/Ge 界面。图 8c 显示有和没有 PDA 的设备具有不同的 V;这可能归因于 V 中占主导地位的较低带隙一半中的陷阱密度
<图片>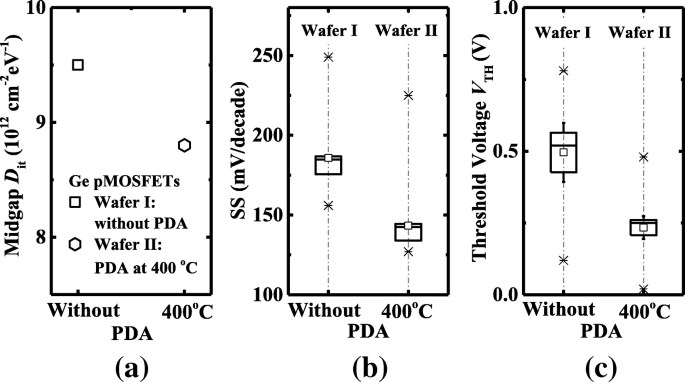
a 的比较 中差D 它,b SS 和 c V 晶片 I 和 II 上的 Ge pMOSFET 的 TH,PMA 为 400 °C
图 9a 显示了 R tot vs. L G 曲线在栅极过驱动为 − 1 V 和 V 对于在 400 °C 下具有 PMA 的器件,DS 为 − 0.05 V。 R 在 400 °C 下,没有和有 PDA 的设备的 SD 值估计分别为 7.15 和 7.30 kΩ·μm。如图 9b 所示,显着更高的峰值 μ 没有 PDA 的 Ge pMOSFET 实现了 eff,对应较小的 ΔR 总/ΔL 图 9a 中的 G,与带有 PDA 的设备相比。 PDA 装置在 400 °C 时表现出峰值 μ 211 cm 2 的效果 /V·s;较低的空穴迁移率可能主要归因于ZrO2电介质中固定电荷导致的强远程库仑散射。
<图片>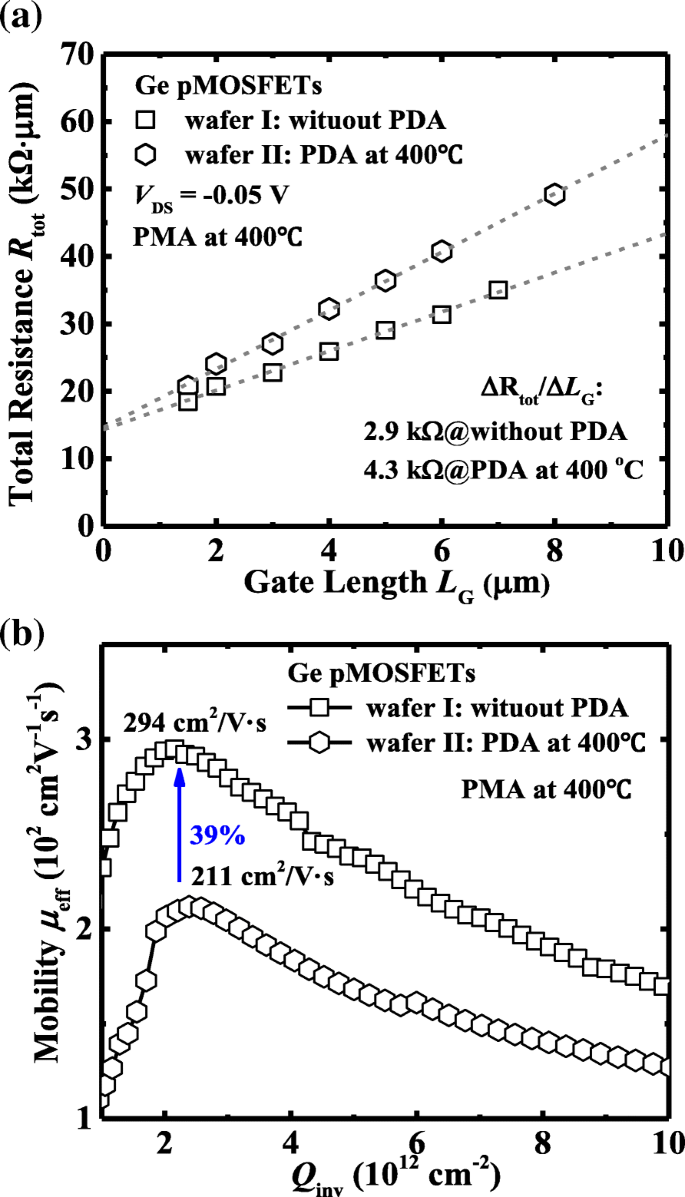
一 R tot vs. L 在 400 °C 下使用 PMA 的晶圆 I 和晶圆 II 上的器件的 G 曲线。 b 空穴迁移率μ eff vs. Q 带和不带 PDA 的设备的 inv
结论
总之,广泛研究了 PMA 和 PDA 对具有 ZrO2 电介质的 Ge pMOSFET 的影响。与较低 PMA 温度下的器件相比,ZrO2 栅极电介质的结晶提供了显着增强的空穴迁移率和降低的 CET。空穴迁移率峰值为 384 cm 2 在 500 °C 下使用 PMA 的器件已实现 /V·s 和增强的驱动电流。 PDA 温度为 400 °C 的器件表现出较低的 CET 和较小的 D 与没有PDA的晶体管相比,它具有较差的空穴迁移率和较大的漏电流。
数据和材料的可用性
本文包含支持本文结论的数据集。
缩写
- ALD:
-
原子层沉积
- BF2 + :
-
硼氟离子
- CET:
-
电容有效厚度
- 哥:
-
锗
- 高频:
-
氢氟酸
- HRTEM:
-
高分辨透射电子显微镜
- IL:
-
界面层
- MOSFET:
-
金属氧化物半导体场效应晶体管
- Ni:
-
镍
- PDA:
-
沉积后退火
- PMA:
-
后金属退火
- SS:
-
亚阈值摆动
- TaN:
-
氮化钽
- TDMAZr:
-
四(二甲基酰胺基)铪
- 氧化锆:
-
二氧化锆
- μ 效果:
-
有效载流子迁移率
纳米材料
- KUHMUTE 通过 SLS 3D 打印重新设计移动性
- 使用 AFPM 进行高速 3D 打印
- 使用 AION500MK3 进行高速 3D 打印
- 通过介电超表面扩大带宽完成太赫兹偏振控制
- 无合规性 ZrO2/ZrO2 − x /ZrO2 具有可控界面多态切换行为的电阻式存储器
- 基于混合全介电-石墨烯超表面的可控双折射偏振转换器
- 具有改良表面结构的高性能有机-纳米结构硅混合太阳能电池
- 通过微波退火增强原子层沉积的 Al2O3/ZrO2/Al2O3 MIM 电容器的介电增强
- 具有高 PSRR 的纳米级低功耗无电阻电压基准
- 具有非晶 Si 钝化的高迁移率 Ge pMOSFET:表面取向的影响
- 通过原子层沉积氧化铝和两步后退火提高 Si 钝化和 PERC 太阳能电池效率
- 具有由臭氧和等离子体后氧化形成的 GeOx 钝化的 Ge pMOSFET


