紫外线照射对 4H-SiC PiN 二极管特性的影响
摘要
在本文中,研究了紫外线 (UV) 照射对高压 4H-SiC PiN 静态特性的影响。在紫外光照射前后,4H-SiC PiN二极管的正向导通状态特性没有观察到显着变化。然而,发现阻挡电压随着UV照射显着增加,这是由于在表面负电荷密度增加的情况下耗尽区宽度随着正电荷的收集而扩展。深能级瞬态光谱表明,紫外辐照引起的深能级缺陷对捕获的负电荷起主导作用,因此导致4H-SiC PiN二极管的阻断电压增加。
介绍
碳化硅(SiC)由于其宽带隙、高临界电场强度、高电子饱和速度和优异的导热性,有望成为下一代高功率和高温电子器件的有前途的候选材料[1]。 ,2,3,4]。正在开发 SiC 器件以取代目前在硅中使用的许多器件,特别是在需要在高电压和电流水平以及高于 200°C 的温度下运行的要求中。与单极器件相比,SiC 双极器件由于近年来的电导调制效应,在超高电压应用中引起了极大的兴趣。作为典型的双极器件,高压 4H-SiC PiN 二极管已被证明是高压整流器应用的潜在选择,包括先进的智能电网、储能和脉冲电源 [5,6,7,8]。在碳化硅功率器件的制造过程中,干法刻蚀和溅射沉积等几种等离子体工艺被广泛使用。已经报道了一些关于 SiC 器件中工艺引起的损坏导致电气退化的工作 [9, 10]。此外,先前的研究表明,紫外线照射通过高能离子轰击和等离子体光发射显着降低了 SiC 金属氧化物半导体场效应晶体管 (MOSFET) 的性能 [11, 12]。最近,据报道,脉冲紫外激光照射 4H-SiC 金属-氧化物-半导体 (MOS) 会诱发近界面氧化物陷阱并导致器件性能漂移和可靠性降低 [13]。然而,据我们所知,到目前为止,还没有研究过紫外线对 SiC PiN 器件的照射,有必要了解其对 SiC PiN 器件特性的影响。
在这项研究中,我们使用 184.9 nm 波长的紫外线照射研究了紫外线照射对 4H-SiC PiN 二极管正向和反向阻断特性的影响。使用技术计算机辅助设计 (TCAD) 模拟展示了表面电荷积累对 SiC PiN 二极管击穿电压的影响。辐照前后的 SiO2/SiC 态密度通过 SiC MOS 上的深能级瞬态光谱 (DLTS) 系统进行表征。 DLTS被广泛用于研究MOS电容器的界面态密度(Dit)分布和深部缺陷[14, 15]。
方法
本文报道的4H-SiC PiN二极管的结构示意图如图1所示。2μm厚的缓冲层掺杂为1 × 10 18 厘米 −3 和 60 μm 厚的 n-漂移层,掺杂浓度为 2 × 10 14 厘米 −3 在 4°离轴重掺杂 n 型 4H-SiC(0001) 衬底上连续生长。然后,顶层是p + 阳极,厚度为2μm,掺杂浓度为2 × 10 19 厘米 −3 .在外延生长之后,使用电感耦合等离子体通过 p + 阳极层反应进入 n-漂移层,图案化具有 2.5 μm 高度和 300 μm 直径的圆形隔离台面结构。蚀刻气体和掩模材料为SF6/O2,分别通过等离子体增强化学气相沉积法沉积。在台面隔离之后,1 × 10 17 的双铝植入物 厘米 −3 形成基于结终端扩展 (JTE) 以减轻台面边缘附近的电场拥挤。通过在 Ar 中在 1650°C 下退火 30 分钟来激活植入物。牺牲 SiO2 层在 1100°C 下生长 1 小时并浸入 HF 以提供用于热氧化的新鲜表面。然后,在干燥 O2 环境中在 1100°C 下进行热氧化 3 小时,SiO2 层厚度约为 40nm,然后在 Ar 环境中在 1100°C 下退火 1 小时。阳极接触材料为 Ni/Ti/Al,阴极接触材料为 Ni。这些金属分别在 800°C 和 1000°C 下退火 2 分钟以获得高质量的欧姆接触。线性转移长度法表征的接触电阻率为1 × 10 -5 Ω cm 2 和 3.75 × 10 −5 Ω cm 2 分别用于 Ni n 型和 Ni/Ti/Al p 型欧姆接触。具有厚铝的覆盖层金属沉积在阳极和阴极上。二氧化硅层和厚的聚酰亚胺层在正面进行了图案化,以避免在高压测量过程中产生表面火花。此外,在高质量的 n 型 (7 × 10 15 厘米 −3 ) 重掺杂 4H-SiC 衬底上的外延层。 40 nm 热氧化物是基于 SiC PiN 的标准工艺生长的。栅电极和背面欧姆接触分别用Al和Ni形成。
<图片>
4H-SiC PiN二极管截面示意图
4H-SiC PiN 二极管和 SiC-MOS 电容器在空气中使用波长为 184.9 nm 的汞灯在没有偏置应力的情况下通过紫外光照射 72 小时。通过温特沃斯探针和 Agilent B1505A 半导体表征系统评估了紫外线照射前后 4H-SiC PiN 的电特性。然后通过 PhysTech 傅立叶变换 DLTS 系统表征 SiC-MOS 电容器的界面态和固定电荷。施加的反向偏压 V R 和填充脉冲电压 V P 分别为 15 V 和 2 V。采样周期t 来自 V 的偏置脉冲的 w R 到 V P 为 1.5 秒。
结果与讨论
UV 照射对 SiC PiN 静态特性的影响如图 1 和图 5 所示。图 2 和 3 比较了设备 1 (D1) 和设备 2 (D2) 辐照前后测量的特性。圆形 SiC PiN 二极管的直径为 3.5 毫米,有效面积约为 10 毫米 2 .在 100 A/cm 的电流密度下,SiC PiN 的正向压降约为 3.95 V 2 用于紫外线照射前的两个设备。在图 2 中可以清楚地观察到,两个器件的正向导通状态特性没有显着变化,在紫外线照射后从 3.95 V 变为 4.0 V。在 60 μm 厚的 n 漂移外延层上制造的器件 1 和器件 2 实现的阻断电压分别为 7 kV 和 7.2 kV,漏电流小于 1μA。需要注意的是,对于 60 μm 厚的漂移层,PiN 二极管的阻断效率约为 9.7 kV 理论值的 70%,杂质激活的不准确可能导致偏离最佳 JTE 注入窗口。 UV 照射后,器件 1 的阻断电压从 7 kV 显着增加到 9.2 kV,提高 2.2 kV,接近理想的平行平面值。相应地,UV照射后器件2的性能提高了1.7 kV。
<图片>
UV照射前后4H-SiC PiN二极管的正向导通特性
<图片>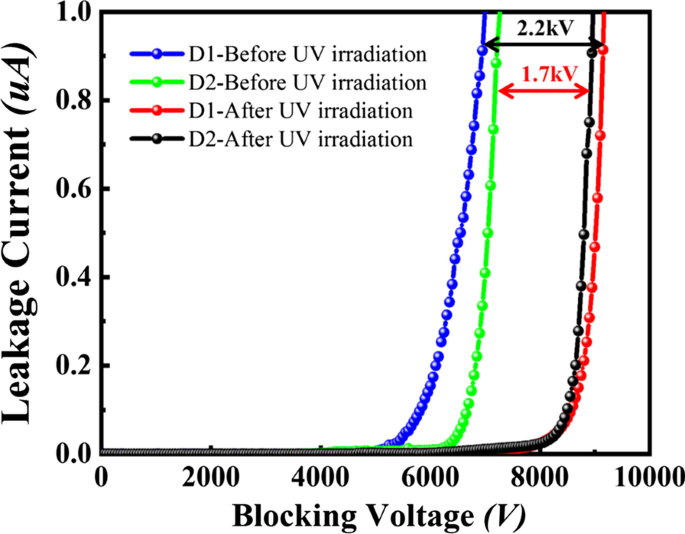
UV照射前后4H-SiC PiN二极管的反向特性
众所周知,表面陷阱对端区电场分布有显着影响,进而影响 SiC 功率器件的反向阻断特性。池口等。已经表明光子能量 ≥ 5 eV的高能UV照射可以将预先存在的应变C-C双键转化为活性电子陷阱,从而导致产生由正V<观察到的带负电荷的界面缺陷/i> C/V 曲线的 FB 偏移 [11, 12]。同时,紫外线照射产生的电子可能会被深陷阱界面缺陷捕获,从而随着固定电荷密度的增加而带负电。图 4 说明了模拟阻塞特性对具有各种表面负电荷的双注入 JTE SiC PiN 二极管的注入浓度的依赖性。很明显,JTE 区域的表面电荷对反向阻断性能有显着影响,尤其是当 JTE 注入浓度偏离最佳窗口时。对于给定的双注入终止结构,随着表面负电荷的增加,可以实现更宽的目标阻断值最佳窗口。很明显,JTE结构对低于1 × 10 11 的界面电荷不太敏感 cm −2 阻断电压无明显变化。表面电荷密度大于5 × 10 11 cm −2 ,击穿电压会急剧增加。令人惊讶的是,击穿电压近似达到理论值,注入窗口为 2 × 10 16 厘米 −3 到 8 × 10 17 厘米 −3 表面电荷密度为1 × 10 13 cm −2 .
<图片>
表面负电荷的模拟击穿电压与 JTE 注入浓度的关系,包括无电荷,1 × 10 11 cm −2 , 5 × 10 11 cm −2 , 1 × 10 12 cm −2 , 5 × 10 12 cm −2 , 和 1 × 10 13 cm −2 分别
图 5 比较了负表面电荷积累对阻塞特性的电场分布的影响。 4H-SiC PiN 二极管中随着耗尽区演变的电场分布如图 5a 所示。当负电荷增加到5 × 10 12 cm −2 在 SiC PiN 的 SiO2/SiC(JTE 结构区域)界面处,N 漂移层的正电荷被收集到界面表面,导致耗尽区显着扩展 [16]。图 5b 显示了 JTE/n-漂移区结下方的电场切割线,表面负电荷密度为 1 × 10 11 和 5 × 10 12 cm −2 .在1 × 10 11 的低表面电荷的情况下 cm −2 ,边缘终端区域出现严重的电场拥挤,最大值为 2.5 MV/cm,击穿电压约为 8 kV。随着电荷密度增加到5 × 10 12 cm −2 ,峰值电场下降到 2.2 MV/cm,相比之下,边缘终止区的电场拥挤得到抑制。同时,电场分布更加均匀,击穿电压明显增加。因此,表面负电荷可以引起耗尽层的扩展,缓解电场拥挤,从而提高击穿电压。
<图片>
表面负电荷密度为1 × 10 11 的SiC PiN模拟电场分布 cm −2 和 5 × 10 12 cm −2 :a 电场分布随耗尽区演化b JTE/n 漂移区结下方的电场切割线。注入浓度采用6 × 10 16 厘米 −3
为了进一步验证辐射引起的电子缺陷产生的物理机制,需要对 SiO2/SiC 界面进行更好的电学表征以进行更详细的研究。 4H-SiC SiC-MOS 电容器的 DLTS 光谱在紫外线照射前后从 15 V 到 2 V 耗尽,如图 6 所示。从 DLTS 光谱,在 4H-SiC MOS 电容器中观察到两个峰紫外线照射后,分别位于 210 K 和 490 K。负 DLTS 峰表明 P1 和 P2 能级是电子陷阱。广泛而显着的 P2 水平显示峰值幅度显着增加,这意味着电子陷阱的浓度因紫外线照射而增加。此外,发现 DLTS 信号与填充时间成正比增加,表现出扩展缺陷的陷阱填充动力学特征,例如界面缺陷而不是点缺陷。插图显示了界面态密度与活化能 ET 的分布。界面态密度的计算公式为 \(D_{{{\text{it}}}} =\varepsilon_{{{\text{sic}}}} C_{{{\text{ACC}}}} AN_{{ \text{D}}} \Delta C/\left[ {C_{R}^{3} kT} \right]\) [17]。从图中可以看出,界面缺陷从E在带隙中产生了一个能带 C − 0.65 eV 到 E C − 1.25 eV 及其密度从 2 × 10 12 显着增加 cm −2 eV −1 到 6 × 10 12 cm −2 eV −1 紫外线照射后。 Dong 等人结合瞬态电容测量、高分辨率透射电子显微镜和密度泛函理论计算。表明这种界面缺陷源于界面处带负电的过量分裂间隙碳 [18]。 210 k 处的 P1 峰对应于 E 处的电子陷阱 C − 0.41 eV。它的浓度在紫外线照射后没有发生本质变化,并且暂时将 P1 陷阱分配给 SiC 外延层中的点缺陷。然而,其原子构型仍不清楚,需要在未来的研究中澄清。
<图片>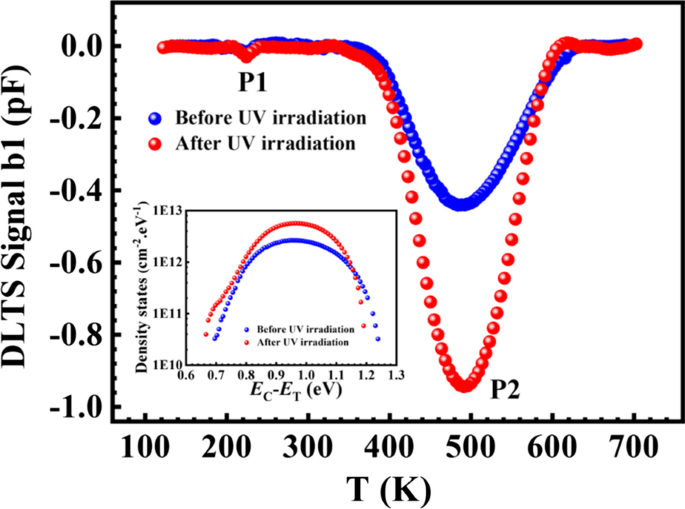
紫外线照射前后 4H-SiC PiN 二极管的 DLTS 光谱。插入显示 D UV照射前后4H-SiC PiN二极管的分布
结论
研究了紫外线照射对 4H-SiC PiN 二极管电特性的影响。从电学实验的结果来看,在紫外线照射后,正向电流的变化不大。然而,UV照射出现阻断电压的显着增加。发现紫外线照射在PiN二极管的界面产生深能级缺陷,导致带隙中的深受主能级增加。这些深能级缺陷作为电子捕获的中心,导致 SiO2/SiC 界面的负电荷显着增加。 N漂移层的正电荷被聚集到界面表面,进一步促进耗尽区的扩展,电场分布更加均匀,从而带来阻断电压的增加。
数据和材料的可用性
所有数据均可无限制使用。
纳米材料


