通过 MBE
在 Si (111) 上生长的纳米壁网络、纳米柱和致密薄膜中 GaN 的结构转变
摘要
通过等离子体辅助分子束外延 (MBE) 在 Si (111) 上成功获得了 GaN 纳米壁网络、纳米柱和致密薄膜的结构位移。正如预期的那样,在裸硅上的富氮条件下观察到 GaN 纳米柱的生长,并且当 Ga 通量提高时,生长转移到致密的薄膜。有趣的是,如果在 GaN 生长之前进行 40 秒的铝 (Al) 预沉积,GaN 将以纳米壁网络的形式生长。结果表明,预沉积的铝以典型直径和高度分别为 ~ 80 和 ~ 6.7 nm 的液滴形式离开。提出了纳米壁网络的生长模型并讨论了生长机制。 GaN在没有Al液滴的区域生长,而Al液滴上方的生长受到阻碍,形成连续的GaN纳米壁网络,消除了纳米器件制造的障碍。
背景
作为直接宽带隙半导体,GaN 和相关化合物在发光二极管 [1,2,3]、激光二极管 [4] 和高电子迁移率晶体管 [5, 6] 中取得了巨大成功。然而,蓝宝石、碳化硅或单晶硅上的 GaN 膜的异质外延会引起高密度的位错。人们认为,由于无位错、无应变和大表面积体积比,它们的纳米结构具有优异的性能 [7, 8]。对 GaN 纳米柱和纳米线的研究已经深入开展 [9,10,11,12]。 GaN 纳米柱形核通过 Volmer-Weber 生长机制自发发生 [13],而富氮 (N-rich) 条件可防止成核位点聚结。在 GaN 纳米线或纳米柱上制造电子器件受到了很多关注。 GaN 纳米线机械分散在 SiO2/Si 衬底上,欧姆接触随机形成在单个纳米线的两侧 [14]。在另一种情况下[15],纳米线的一侧固定在与负极相连的平台上,另一侧通过扫描电子显微镜(SEM)对准正极,形成用于科学研究的电子装置。
或者,一种特殊的纳米结构,即面内导电的 GaN 纳米壁网络是有前途的,因为纳米器件制造不需要复杂的工艺。 2007 年,Kishino 的团队使用通过电子束光刻法图案化的 Ti 层作为掩模,获得了 GaN 纳米壁网络的生长 [16]。几年前,在没有任何光刻的情况下,在蓝宝石和硅衬底上成功地获得了 GaN 纳米壁网络的生长 [17,18,19]。 GaN纳米壁网络的带边发射强度与GaN纳米柱相似,黄色发光不明显,说明GaN纳米壁网络质量高。与纳米柱等分离的纳米结构不同,纳米壁网络是面内导电的[18,20,21],它可以像薄膜一样容易地制造成纳米器件[22]。因此,纳米壁网络的面内导电可以消除在分离的纳米柱上制造器件的障碍。研究纳米壁网络的生长机制至关重要。位错诱导自发形成的纳米壁网络被认为是 GaN 纳米壁网络在裸 c 上的生长机制 -平面蓝宝石 [23]。由于位错诱导的纳米壁网络的形成是低控制的,因此在具有 Al 缓冲层的 Si (111) 衬底上进行了纳米壁网络的生长 [18]。 Si(111)上纳米壁的生长机制与裸蓝宝石衬底上的生长机制显着不同;然而,尽管Si(111)的生长机制是纳米壁网络生长的关键,但尚未进行研究。
在这项工作中,系统地研究了 GaN 在各种结构中的生长,包括纳米壁网络、纳米柱和致密薄膜。使用等离子体辅助分子束外延 (MBE) 在 Si (111) 上生长上述各种 GaN 结构。结果表明,通过调整Ga/N比和添加预沉积的Al液滴可以实现GaN生长的结构转变。 GaN 纳米壁网络的形貌和光致发光通过场发射扫描电子显微镜 (FESEM) 和光致发光光谱分析仪以 He-Cd 激光器 (325 nm, 200 mW) 作为激发源进行测量。原子力显微镜 (AFM) 用于表征预沉积的铝层。提出了金属Al液滴在Si(111)上生长GaN纳米壁网络的机理。
实验
通过配备 N2 RF 等离子体源 (Veeco, RFS-N/TH) 的 Riber 32 MBE 系统在 Si (111) 衬底上生长 GaN 结构。将生长室的压力抽至3.0 × 10 - 10 Torr 在增长之前。本实验使用纯度为 99.9999% 的 N2 气、Ga 和 Al。 Si (111) 衬底(无掺杂,一侧抛光用于生长,380 ±20 μm,由 Sigma-Aldrich 提供)通过标准 RCA 工艺清洁电阻率> 5000 Ωcm,然后浸入 HF:H2O =1:50几秒钟去除Si衬底表面的氧化硅层,并形成一个氢端表面。
为了生长 GaN 纳米柱,同时打开 N2 等离子体和 Ga 源的挡板,将裸硅(111)加热到 973 K。本研究中所有样品使用的 N2 等离子体源的功率和压力工作固定在 400 W 和 4.2 × 10 − 5 托,分别。在 GaN 纳米壁网络生长之前,直径约为 80 nm 的 Al 液滴沉积在加热至 973 K 的裸硅 (111) 上。Al 源保持在 1323 K。Al 液滴的预沉积导致 GaN 的不同成核和生长,导致纳米壁网络的生长。用于纳米壁网络生长的 Ga 通量与纳米柱相同(φ Ga =1.2 × 10 − 7 Torr 为 1169 K)。对于GaN薄膜的生长,Ga通量增加到5.3 × 10 - 7 Torr 而 N 通量保持恒定。
结果与讨论
当 N2 等离子体和 Ga 的挡板同时打开时,GaN(S1)在裸硅(111)上以纳米柱的形式生长,如图 1a 所示。 Ga通量为1.2 × 10 - 7 Torr 和 Si (111) 衬底保持在 973 K,如表 1 所示。观察到 GaN 纳米柱的直径范围为 52 到 125 nm,长度为 ~ 460 nm。从SEM图像中计算出的纳米柱密度为~ 10 7 mm − 2 .显然,从图 1b 中观察到的大多数纳米柱并不垂直于基板,而是以 ~ 30° 的角度倾斜。纳米柱的顶面是光滑的,与 Bertness 的报告 [9] 一致。据信纳米柱自发成核然后传播,因为 (0 0 01) c 上的粘附系数 -平面高于 {110 0} m -飞机。扩散长度L 吸收的 Ga 原子 (Gaab) 对纳米柱的生长至关重要。如方程式中所述。 (1)、扩散长度L 取决于平均跳跃距离a , Gaab 解吸能 Q des 和表面扩散跳跃的活化能 Q d [13].
$$ L=\sqrt{2}a\ \exp \left(\frac{Q_{\mathrm{d}\mathrm{es}}-{Q}_{\mathrm{d}}}{2 kT}\右) $$ (1)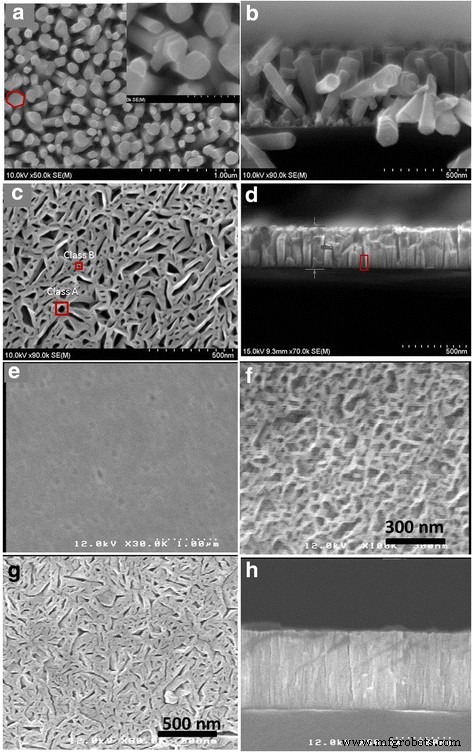
在不同条件下生长的样品的 FESEM 图像。 一 , b 对应于 GaN 纳米柱(样品 S1)。 c , d 对应于GaN纳米壁网络(样品S2),e 对应于压缩膜(样品 S3),f 对应于开始生长阶段的 GaN 纳米壁网络(样品 S4)。 g , h 对应于在较低温度 900 K 下生长的 GaN 纳米壁网络(样品 S5)
由于原子级平坦的纳米柱侧壁提供很少的吸附位点,因此假设 Gaab 扩散长度 L 在 m 上 -侧壁平面远高于c 平面,导致 GaN 垂直生长到纳米柱。如果这个假设成立,那么当 Ga/N 比提高时,强的增长率各向异性会发生变化。事实上,当Ga通量增加到5.3 × 10 - 7 时,GaN(S3)结构从纳米柱变为致密薄膜(图1e) 托。因此,可以通过调节Ш/V比来控制以纳米柱或致密薄膜形式生长的GaN。
尽管 GaN 纳米柱表现出比薄膜优越的性能,但由于分离的纳米柱在电接触制造之前需要对齐,因此电器件的制造难度很大。因此,平面内导电纳米结构是有利的。对于样品 S2 的生长,金属铝预沉积在 MBE 生长室中进行 40 秒。然后,同时打开 N2 等离子体和 Ga 源。 S2 生长的 Ga 通量总结在表 1 中,与 S1 相同。图 1c 显示了样品 S2 的俯视 FESEM 图像。有趣的是,GaN 在 Al/Si (111) 上以纳米壁网络的形式生长。直径为50~100nm的纳米壁相互重叠交错,形成面内连续网络,即纳米壁网络。可观察到两类孔洞,分别命名为A类和B类。A类和B类孔的直径通常分别为50~100和10~ 49 nm。面内连续特性使纳米壁网络在窗格内导电[18],在一定程度上消除了纳米器件制造的障碍。纳米壁的顶面相对平坦,与参考文献中报道的多面 GaN 矩阵不同。 [13]。可以观察到,顶视图中显示的孔洞延伸到基板附近,如图 1d 中的矩形所示。
大家可能会好奇,上面提到的这些洞是怎么产生的。我们在 900 K 的较低生长温度下生长了样品 S5。其他生长参数与样品 S2 相同,如表 1 所示。从图 1g 中,我们观察到样品 S5 也以具有较小孔的纳米壁网络。图 1h 是 S5 的横截面图像,显示了比 S2 更紧凑的层。为了看到 GaN 纳米壁网络的开始生长,我们在短时间内用铝预沉积生长了另一个样品 S4。除了生长时间(20 对 120 分钟)外,S4 的所有生长参数都与样品 S2 的相同。 S4 的厚度约为 50 nm,其俯视图如图 1f 所示。观察到在这个阶段已经形成了孔洞,原始的 GaN 是一个面内连续网络,而不是 GaN 纳米线或岛。从样品S1、S2、S4和S5的研究可以看出,Al层的预沉积改变了GaN最初的生长行为,从纳米柱到面内连续纳米壁网络。
请注意,除了预沉积 Al 外,S2 的所有生长条件都与 S1 相同。那么,我们可能想知道预沉积的 Al 的结构是什么,它如何影响 GaN 的后续生长。为了找到这些答案,FESEM 和 AFM 研究了在裸硅 (111) 上预沉积 40 秒的铝。图 2a 显示了预沉积铝的俯视图。发现Si基板上的Al以薄膜以外的液滴(白点)的形式存在。密度为~ 4 × 10 7 的金属Al液滴 mm − 2 分布相对均匀,无明显积累。最近,Li 等人使用 MBE 成功地生长了 Al 液滴。以提高生长的 GaN 的质量并降低应力 [24]。为了进一步研究铝液滴的形态,利用 AFM 测量它们的三维图像和相关参数,如图 2b、c 所示。液滴是球形的,如图 2b 所示,与 SEM 结果一致。测得的铝液滴的高度和直径分别为 6.7 和 80 纳米。波皮茨等人。 [25] 研究了通过铁束辅助 MBE 在裸 6H-SiC (0001) 上生长 GaN 纳米壁网络。他们的结果表明,极端富含 N 的生长条件与高衬底温度和生长过程中的高能 N 离子辐射相结合,是在裸 6H-SiC(0001)上形成纳米壁网络的主要原因。作为先驱,Kesaria 等人。 [17] 使用 PA-MBE 研究了裸蓝宝石衬底上的 GaN 纳米壁网络。在他们的研究中,认为GaN纳米壁在边缘成核,螺旋位错在富N气氛下生长。
<图片>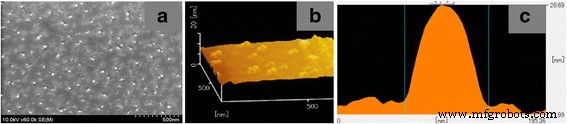
FESEM (a ) 和原子力显微镜 (b ) 在 Si 衬底上预沉积的 Al 的图像。 c 一粒铝液滴的原子力显微镜参数测量
在我们的例子中,GaN 纳米壁网络的生长机制应该是不同的,因为纳米壁随着金属铝预沉积的要求而生长。当然,据我们所知,包括我们实验在内的所有 GaN 纳米壁网络都是在富氮气氛下生长的。需要富含 N 来减少纳米壁的聚结。现在,让我们关注铝液滴在纳米壁网络形成中的作用。与充当催化剂的 Au 液滴类似 [26],如果 Al 液滴充当催化剂,则 GaN 应该生长到纳米柱而不是纳米壁网络。因此,Al 液滴的作用不是我们研究中的催化剂。铝金属的熔化温度为 933 K,而衬底温度在生长过程中保持在 973 K。因此,在 GaN 生长开始时,Al 液滴是液滴。根据之前的报告,在具有 Ga 液滴的 Si (111) 上的 GaN [13] 的情况下,Ga 液滴充当向其附近供应 Ga 原子的储层。然而,Ga 液滴本身会阻碍 GaN 在其上的生长,因为原始的 Ga 液滴位置是空心圆。在我们的例子中,Al 液滴的直径为 ~ 80 nm,类似于图 1a 中 A 类孔的大小。因此,Al 液滴可能会阻碍 GaN 在其上的生长,导致在 GaN 纳米壁网络中观察到的 A 类空穴的形成。由于样品 S1 和 S2 的 Ш/V 比相同,Ga 扩散长度 L Si 上的纳米壁网络生长预计与纳米柱相同。裸硅衬底(没有 Al 液滴的区域)的典型尺寸为 ~ 80 nm,在图 1a 中纳米柱直径的值范围内。换句话说,Ga扩散长度L 覆盖裸Si衬底的尺寸,导致GaN在没有Al液滴的区域连续生长,即GaN纳米壁网络。
基于上述分析,提出了 GaN 纳米壁网络的生长模型,如图 3 所示。GaN 在裸硅衬底上成核,如图 3a 所示。由于 Gaab 扩散长度 L 覆盖裸Si衬底,GaN在整个裸Si衬底中生长,而Al液滴上方的GaN生长受到阻碍(图3b)。此外,在富 N 条件下,GaN 倾向于垂直生长,如图 3c 所示。由于裸 Si 衬底是平面内的连续网络,因此上面 GaN 的生长也是一个连续网络,称为纳米壁网络,如图 3d 所示。图 1f 中样品 S4 的俯视图证实了这一假设。由于样品 S2 生长的富氮条件,横向生长受到限制,孔能够在随后的生长中保留。请注意,Al 液滴和富 N 条件对于 GaN 纳米壁网络的生长都是必不可少的。
<图片>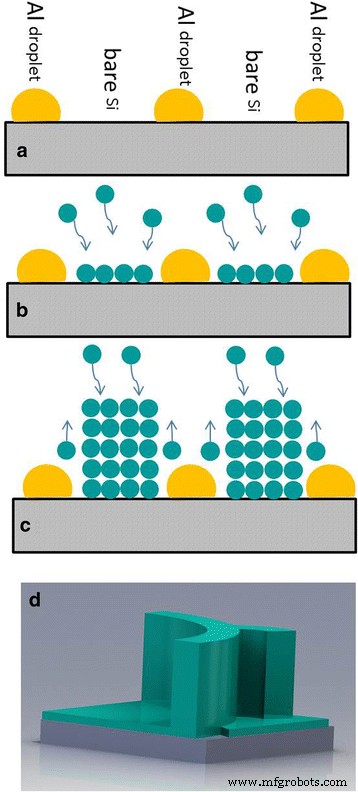
GaN 纳米壁网络的生长模型。 一 预先沉积在 Si 基板上的 Al 液滴。 b 裸硅上 GaN 纳米壁网络的成核。 c 在富氮条件下垂直生长的 GaN 纳米壁网络的横截面图。 d GaN纳米壁网络的倾斜图
X 射线衍射用于 GaN 纳米壁网络的晶体结构表征,如图 4 所示。观察到 GaN(002) 和 GaN(004) 的两个衍射峰以及来自硅衬底。结果表明,GaN纳米壁网络是六边形的,并且沿C高度取向 轴。除了 XRD 图案,还测量了 GaN(002) 的 ω 扫描摇摆曲线,如图 4 的插图所示。半峰全宽为 52.2 弧分,类似于之前在蓝宝石上生长的报告底物[27]。还使用范德堡霍尔测量系统(HL5500PC,Nanometrics)在 293 K 下测量了电特性。 GaN 纳米壁网络的电导率、霍尔迁移率和电子浓度为 10.2 S/cm,31 cm 2 /Vs 和 2.1×10 18 cm − 3 , 分别。对于 GaN 薄膜,由于 2.2×10 20 的较高电子浓度,其电导率增加到 666.7 S/cm cm − 3 .薄膜中的高载流子浓度可能归因于非优化的 Ga/N 比产生的高本征缺陷浓度。至于薄膜的霍尔迁移率,值为 18.7 cm 2 /Vs.
<图片>
GaN 纳米壁网络 (S2) 的 X 射线衍射图。插图为样品S2的ω扫描摇摆曲线
图 5 显示了使用 He-Cd 激光器作为激发源的 GaN 纳米壁网络的光致发光光谱。根据 Kesaria 等人的报告 [17],直接比较了在裸蓝宝石衬底上生长的 GaN 膜、纳米壁网络和纳米柱之间的阴极发光。他们的结果表明,纳米壁网络的带边发射略高于纳米柱,远高于薄膜。对于纳米壁网络,可以观察到以 520 到 620 为中心的广泛缺陷发射,而对于纳米柱则没有观察到缺陷发射。在图 5 中,观察到以 363.7 nm 为中心的强带边发射,半峰全宽为 14.1 nm。与 Kesaria 等人的报告 [17] 一致,在 520 至 620 nm 范围内,可检测到归因于点缺陷 [28] 的广泛的绿黄色发射,但非常微弱,表明 GaN 纳米壁的质量很高网络。因此,在裸蓝宝石衬底上生长的GaN纳米壁网络和带有Al液滴的Si衬底上生长的GaN纳米壁网络的发光几乎相同,但生长机制不同。
<图片>
室温下测量的GaN纳米壁网络的光致发光(PL)光谱
结论
在这项工作中,使用 MBE 在 Si (111) 衬底上成功实现了纳米柱、纳米壁网络和致密薄膜之间 GaN 生长的结构转移。 GaN 纳米柱在富 N 条件下生长在裸硅衬底上,而致密薄膜则用改进的 Ga 通量生长。通过添加预沉积的 Al 层,GaN 的生长从纳米柱转移到面内连续纳米壁网络。预沉积的 Al 层以液滴的形式存在,典型的高度和直径分别为 6.7 和 80 纳米。解决了纳米壁网络的生长机制。 GaN 在裸硅衬底上不断生长,而 Al 液滴上的 GaN 生长受到阻碍,从而形成纳米壁网络。 Al液滴和富N条件对于纳米壁网络的生长都是必不可少的。
纳米材料


