轻松制造自组装 ZnO 纳米线网络通道及其门控紫外检测
摘要
我们展示了一种简单的方法来制造基于组装氧化锌纳米线 (ZnO NW) 网络场效应晶体管 (FET) 的门控紫外线传感器阵列。这是通过在极性区域结合分子表面程序化图案化和选择性 NW 组装来实现的,避免非极性区域,然后在 300°C 下进行热处理以确保 NW 之间的稳定接触。 ZnO NW 网络 FET 器件表现出典型的 n 型特性,开关比为 10 5 ,跨导约为 47 nS,迁移率约为 0.175 cm 2 V − 1 s − 1 .此外,这些器件对紫外光表现出光响应行为,可以通过施加的栅极电压进行控制。发现光响应度与通道电压 V 成线性比例 ds,在 V 处显示最大光响应度 ds =7 V。
背景
众所周知,一维纳米材料比其他薄膜类型或大块材料具有各种优势,因为它们具有高比表面积、定向良好的均匀晶体结构和定向电荷传输路径,可实现高器件性能和易于器件制造 [1] , 2]。特别是,由于其独特的维度,半导体纳米线 (NW) 已被用于多种应用,例如能量转换、存储器、光学设备和传感器 [3,4,5,6,7,8,9]。其中,氧化锌 (ZnO) NW 显示出优异的半导体特性,在室温下具有 3.37 eV 的大直接带隙和 60 meV 的高精确结合能 [10]。此外,众所周知,ZnO 对环境友好、天然丰富且生产成本低 [11]。因此,ZnO 已应用于广泛的领域,包括发光二极管 [12, 13]、激光二极管 [14]、太阳能电池 [15,16,17,18]、光电探测器 [19,20,21,22] ,23]、透明场效应晶体管 [24,25,26]、发生器 [27, 28] 和化学传感器 [29, 30]。同时,基于 ZnO 纳米线的紫外线传感器已经得到证明 [31,32,33],但这些设备难以制造。这些制造 ZnO NW 网络器件的方法通常包括电极沉积的 ZnO NW 涂层膜,然后是蚀刻工艺以定义通道。这种方法很难控制物理尺寸,例如调整 ZnO 通道宽度。为了克服这些问题,已经研究了一种在预图案化层上水热生长 ZnO NW 的方法,但需要额外的蚀刻和/或水热生长工艺。目前提出的 ZnO 纳米线图案化方法,例如激光诱导的选择性生长 [34, 35] 或具有局部加热器的 ZnO 纳米线的水热生长 [36],涉及高成本和高温工艺。还有一种情况是,垂直生长的 ZnO 纳米线阵列网络用于使用对齐的纳米线阵列网络,器件性能可控[37],但这也需要付出很多努力,需要 CVD 等真空设备,不适合用于大面积低成本生产。提出了一些基于微接触印刷[38]或喷墨印刷的低成本低温工艺[39],但纳米线密度和相应器件性能的控制仍然是一个挑战。
在这项工作中,我们展示了一种高度可重复且简便的方法,通过在分子图案化基板上使用自组装和热处理来制造基于 ZnO NW 网络场效应晶体管 (FET) 的门控紫外线传感器阵列。 ZnO NW 网络通道的器件成品率为 90%,平均电阻值为几百 kΩ。据信,后热处理具有去除残留有机溶剂和增强 NW 之间电接触的效果。基于 ZnO NW 的 FET 器件表现出 n 型特性,开关比为 10 5 ,跨导约为 47 nS,迁移率约为 0.175 cm 2 V −1 s −1 .物理性质可以通过改变分子模式、溶液中的 NW 密度、拉速等 NW 组装条件来控制。最后,我们通过施加的栅极电压成功实现了具有可控光响应性和响应时间的 ZnO 紫外传感器阵列。由于 ZnO NW 沟道的耗尽,施加到 n 型 FET 的负栅极电压最小化了初始电流。实际上,在低于 - 55 V 的栅极电压下发现了对紫外线的最大光响应性,并且发现光响应性与通道电压 V 成正比 ds,在 V 处显示最大光响应度 ds =7 V。此外,负栅极电压有利于紫外光照射后的器件恢复。应该注意的是,虽然之前关于 ZnO NW 网络器件的报道已经报道 [34, 35],但我们的 ZnO NW 器件具有 ZnO NW 结构,其通道宽度和厚度可控,无需使用任何化学或等离子蚀刻工艺。这种温和的工艺结合低于 ZnO 再结晶温度(~ 400°C)的热处理,可以轻松大规模制造具有高开关比和光响应性的门控紫外线传感器。我们预计我们的工艺和器件性能将加速基于 ZnO NW 应用的商业化进程。
方法
ZnO NW 网络 FET 制造
长度为 2~3 μm,直径为 200 nm 的 ZnO NW 购自美国 Sigma-Aldrich, Inc.。通过超声处理 3 秒,将 NW 分散到二氯苯 (DCB) 中的 1wt% 浓度。为了制备分子图案化基板,通过典型的光刻方法在 SiO2(300nm 厚的 SiO2 在 500μm 厚的 p 掺杂硅晶片上)基板上图案化光刻胶(AZ 5214E)。然后,将基板浸入 1:500 v /v 十八烷基三氯硅烷 (OTS) 在己烷中反应约 3 分钟 [40]。在此过程中,单层 OTS 分子在暴露的 SiO2 区域表面自组装,以创建非极性 OTS 区域。 OTS 处理后,将基板浸入丙酮中 2 分钟以去除受光刻胶保护的区域,暴露出要组装 ZnO 纳米线的极性 SiO2 区域。自组装的 OTS 单层具有甲基终止,使其成为非极性区域。另一方面,SiO2 表面作为其羟基 (OH) 的极性区域。对于 ZnO NW 组件,将基板浸入 NW 溶液中,并以 0.5~10 mm min -1 范围内的受控拉动速度拉动 .在提拉过程中以 100 rpm 的速度搅拌 ZnO NW 溶液,以防止 NW 聚集和沉淀。当衬底被拉动时,蒸发在空气-悬浮液-衬底界面附近进行得最快,导致 ZnO 纳米线由于范德华力选择性吸附在极性 SiO2 区域,同时避开非极性 OTS 区域。在基板上组装 ZnO NW 后,通过热沉积和剥离工艺沉积电极(Ti/Al,10/300 nm)。
热处理工艺
热处理在炉内的 Ar 环境中在 1 托压力下进行。在 3 分钟内将温度升至 110°C 并保持恒定 10 分钟以蒸发任何剩余的溶剂。然后,在 3 分钟内将温度升至 300°C 并保持恒定 10 分钟,以改善 NW 间界面并降低 NW 之间的势垒和接触电阻 [41]。之后,将样品在 1 h 内冷却至室温,然后从炉中取出。
测量 ZnO NW 网络 FET 的电学和光响应特性
使用配备半导体参数分析仪(4200A-SCS,Keithley,USA)的探针台测量电气特性,例如 I-V 特性和栅极特性。源漏电压从 0 V 扫描到 7 V。栅极电压从 − 60 V 扫描到 + 60 V。根据与栅极相关的 I-V 特性,我们计算了跨导和迁移率值 [42, 43] .为避免环境对 NW 通道的电阻产生任何影响,在测量过程中,温度和相对湿度分别保持恒定在 23 ± 1°C 和 35 ± 1%。对于紫外光响应测量,源漏电压 V ds 保持在 7 V。UV 源是手持式 UV 灯(Spectroline ENF-260C/FE,美国),激发波长为 365 nm,功率密度为 350 μW cm -2 .
结果与讨论
图 1 显示了描述渗滤 ZnO NW 网络通道的制备和后续热处理的示意图。首先,将 OTS 图案基板浸入 ZnO NW 悬浮液(二氯苯中 1wt%)中,并使用自制的牵引系统以 0.5 mm min -1 的不同牵引速度从 ZnO NW 悬浮液中拉出 到 10 毫米分钟 −1 (附加文件 1:图 S1)。在拉动过程中,含有 ZnO 纳米线的液体弯月面被拖到 OTS 图案的基板上。 ZnO 纳米线专门组装在暴露的 SiO2 通道区域上。如图 2a 的插图所示,使用我们的制造方法在 4 英寸晶圆上制造了总共 100 个器件。图 2a 显示了渗透的 ZnO NW 网络通道的光学图像,插图显示了 FET 器件阵列。 ZnO NW 的平均直径为 200 nm,NW 长度为 2~3 μm,通道长度和宽度分别为 6 μm 和 20 μm。 ZnO NW组装后,通过传统光刻技术、金属热沉积(10 nm Ti、300 nm Al)和剥离工艺制成源漏电极。
<图片>
ZnO NW网络FET的制造过程示意图。使用拉伸工艺在分子图案衬底上组装 ZnO 纳米线
<图片>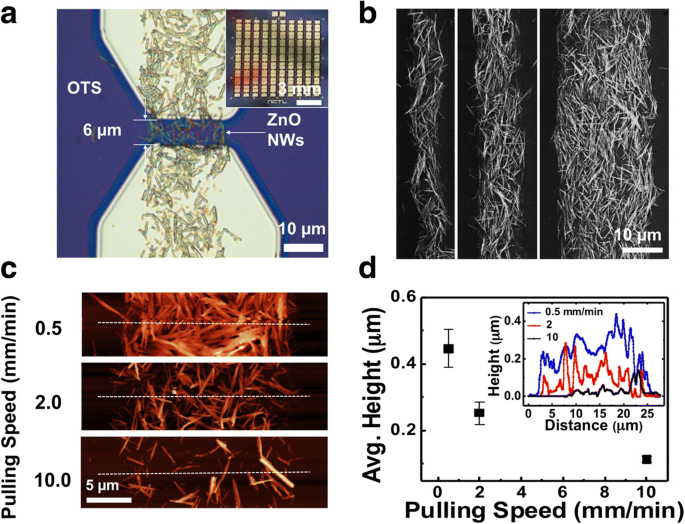
ZnO NW 网络 FET 器件的沟道形成和厚度控制。 一 6 μm 长 NW 网络通道和铝电极的放大光学图像。插图是具有微图案通道的 10 × 10 阵列器件的光学显微照片。 b 扫描电子显微镜 (SEM) 图像显示了 ZnO 纳米线选择性组装成具有 5、10 和 20 μm 不同线宽的线图案。 c ZnO NWs 网络的 AFM 图像。 d 0.5~ 10 mm min −1 不同拉速下高度与拉速的平均分布 .插图显示了 0.5、2、10 毫米 min -1 不同拉速的 AFM 高度分布
如图 2b 所示,通过改变 SiO2 区域图案尺寸,我们能够获得具有 5、10 和 20 μm 不同线宽的 ZnO NW 图案。由于 OTS 分子的甲基末端,周围的 OTS 区域是非极性的。 NW 被认为仅通过范德瓦尔斯相互作用吸附在极性 SiO2 区域 [40]。 ZnO 纳米线的选择性组装也通过能量色散 X 射线光谱 (EDS) 得到证实(参见附加文件 1:图 S2)。此处,Zn 信号仅限于具有 ZnO 纳米线的区域。
通过在 NW 组装过程中调节从 NW 溶液中拉出衬底的速度,可以控制渗透 ZnO NW 网络通道的物理特性,例如厚度和密度。图 2c 显示了在 0.5、2 和 10 毫米 min -1 的不同拉速下组装的 ZnO NW 网络的 AFM(原子力显微镜)图像 .图 2d 显示了平均高度曲线与拉动速度的关系。 NW密度为1.21 NW μm -2 在拉速 0.5 mm min −1 , 和 0.09 NW μm −2 在 10 毫米分钟 −1 . NW 通道厚度通过降低拉速而增加。在最慢的速度 0.5 mm min -1 下,NW 通道的高度通常比单个 NW 平均直径 200 nm 高约 1.5~2 倍 (图 2d,插图)。拉速为 10 mm min −1 ,网络连接达到渗透限制,超过该限制网络显示无连接。当前制造 ZnO NW 网络器件的方法通常涉及电极沉积 ZnO NW 涂层薄膜,然后是某种蚀刻工艺来定义通道 [38, 39]。这种方法很难控制物理尺寸,例如调整 ZnO 通道宽度。为了克服这些问题,已经研究了一种在预图案化层上使用 ZnO 纳米线水热生长的方法 [44, 45],但它也需要额外的蚀刻工艺和/或水热生长工艺,这需要时间和成本。相比之下,我们的方法可以通过预先用 OTS 分子图案化通道,然后通过拉动系统组装 NW 来轻松控制通道的宽度和长度。
还可以通过调节牵引速度来控制电性能。图 3 显示了热处理前的电气特性。图 3a 显示了不同拉速下 I-V 特性的变化。当拉速从 2 降低到 0.5 mm min -1 ,初始电流在 1 V 时从 5 nA 增加到 50 nA。这可能是由于随着通道中 NW 密度的增加,网络连接性增加了。在 2 mm min -1 制造的 ZnO NW FET 的典型栅极相关 I-V 特性曲线 牵引速度如图 3b、c 所示。图 3b 显示了不同栅极电压 V 下的 I-V 特性 g 值(从 − 60 V 到 60 V,步长为 20 V)。 我 ds-V g 图 3c 中的栅极特性显示了典型的 n 型特性,当拉速从 0.5 毫米增加到 2 毫米时,开关比从 3 pA 到 556 nA 的关断电流增加了五个数量级,并降低了关断电流min −1 (参见附加文件 1:图 S3)。这种随着薄膜密度降低而增加的开关比可以通过注意到当我们使 NW 沟道更薄时沟道受到来自背栅的电场的影响更大 [46] 来解释。此外,拉动速度对器件产量和双探针电阻频率分布有影响(附加文件 1:图 S4)。电阻显示平均值为 28.2 ± 4 MΩ 和 ~ 92% 在 0.5 mm min -1 .然而,分布转移到 877 ± 280 MΩ 和 ~ 78% 的产量在 2 mm min -1 牵引速度。此处,良率定义为可测量电阻值高于设备噪声的器件数量。
<图片>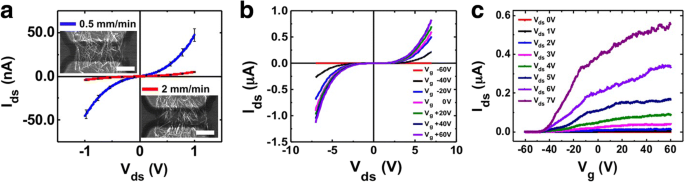
通过控制拉速来研究 ZnO NW 网络的连接性和电学特性。 一 ZnO NWs 网络 FET 电学特性在拉速 0.5 和 2 mm min -1 .在 0.5 和 2 mm min -1 的不同提拉速度下制造的器件的典型电流-电压特性 .网络通道显示从 - 1 到 1 V 的肖特基接触。插图是网络通道在 0.5(左上)和 2(右下)mm min -1 的 SEM 图像 .两种情况下的比例尺都是 10 μm。 b 各种背栅电压的电流-电压特性。 V g 的范围从 − 60 V 到 60 V,步长为 20 V。 c 我 ds 与 V 在各种V下制备的ZnO NWs网络通道的g关系 ds。 V ds 范围为 0 到 7 V,步长为 1 V
在这里,FET 的栅极特性不具有干净的饱和状态。根据之前的报告,ZnO NW 网络没有表现出干净的饱和状态,这可能是由于复杂的 NW 网络路径、大表面积和 NW 结处的晶界增加了载流子散射 [47]。我们的 ZnO NW 网络在源极和漏极之间形成了许多路径。此外,ZnO NW 网络通道的厚度高达约 0.4 μm(图 2d)。纳米线的厚度不均匀导致每条纳米线到栅极的距离不同,调制程度略有不同。因此,FET特性不像单纳米线FET那样具有干净的饱和状态。
通过随后的热处理工艺可以提高所生产器件的电性能,以提高电性能的均匀性并进一步降低 NW 之间的接触电阻 [41]。热处理在低压条件下在 300°C 下进行 10 分钟,同时以 100 sccm 的速度流动 Ar 气体(参见附加文件 1:图 S5)。图 4 显示了在 2 mm min -1 处制造的样品的电性能变化 牵引速度。热处理后,1 V 偏压下的电流从 600 nA 增加到 6.5 μA(图 4a)。图 4b 中的电阻频率分布显示平均电阻从 877 ± 280 MΩ 下降到 207 ± 37 kΩ,大约下降了 3 个数量级。此外,器件产量从 78% 增加到 90%,大概是由于 NW 之间增强的电接触。我们专注于通过热处理来利用 NW 连接增强的优势。出于这个原因,温度不会升高到 400°C 以上,此时 ZnO 会重结晶。据报道,这种重结晶会影响紫外线照射期间氧化锌表面的氧解吸和吸附特性[41]。因此,为了仅通过热处理获得 NW 之间连接的改善,进行了高达 300°C 的热处理以改善 NW 之间的界面。这导致增强了电稳定性和特性。我们相信我们的热处理工艺可能会去除水分或六亚甲基四胺 (HMTA) 等吸附分子,因为我们的工艺温度高于 HMTA 的熔点 (290 °C)。这提高了 NW FET 的性能,因为它改善了 NW 之间的结并去除了其他会降低 NW 性能的吸附分子,例如水分。
<图片>
热处理后的 ZnO NWs 网络电性能。 一 2 mm min −1 拉拔速度退火前后的典型电流-电压特性 .网络通道表现出肖特基接触行为。 (插图)退火前的 I-V 特性,放大。 b 以 2 mm min −1 的速度拉动 ZnO NWs 网络的电阻频率分布 .平均阻力下降了大约三个数量级。 (c ) 不同背栅电压下的 I-V 特性。 V g 的范围从 − 60 V 到 60 V,步长为 20 V。 d I 的电学特性 ds 与 V g 热处理后。 e I的比较 /我 不同 V 下的关断比 g 值,热处理前后(V g step =5 V)。 f 通过热处理提高跨导
典型的I ds-V ds 和 I ds-V g ZnO NW FET 的特性曲线如图 4c、d 所示。图 4e 显示 I ds-V g 热处理前后的特性曲线相似,最大I 在/I 关闭比率为~ 2 × 10 5 .这表明热处理仅改善了 NW 之间的连接以降低电阻,而不会引起本征电性能的变化。图 4f 显示了跨导 dI 的改进 ds/dV g 热处理后,这可归因于 ZnO NW 器件中增强的电子迁移率。最大跨导 (g 米 =dI ds/dV g ) 是从 I 的最大斜率中提取的 ds-V g Vds 为 7 V 时的特性和最大开关比。 (附加文件 1:图 S6)。计算的最大跨导在 V 处为 ~ 47 nS g =− 30 V。我们使用公式 μ =g 米 ·L /(W ·C d ·V ds) 用于估计的移动性计算 [48]。计算出的迁移率为 0.175 cm 2 V −1 s −1 .这与之前报告的 0.018 cm 2 值相当 V −1 s −1 使用ZnO NWs器件阵列[49]。
最后,我们观察了 ZnO 网络 FET 的紫外光响应及其对栅极电压的依赖性。图 5a 显示了在不同栅极电压(从 - 60 V 到 60 V,以 20 V 为步长)的 UV 照射下的 I-V 特性。 我 ds-V g 图 5b 中紫外线照射下的特性显示开关比降低。紫外光通过产生光激发载流子来增加 n 型 FET 器件的截止电流。图 5c 显示了 UV 灯开启和关闭条件下测量电流的差异。紫外光响应度 (I 光/I 暗:光电流与暗电流的比值)随施加的栅极电压而变化,显示出最大比值 8.6 × 10 5 在 Vg − 55 V 或更小。图 5c 的插图显示了 I ds-V 当 Vds =7 V (V ds-I ds 特征显示在附加文件 1:图 S7)中。图 5d 显示了 I 之间的线性关系 光/I 暗和开关电流比 (I 在/I 离开)。 我 在/I off 的增加导致紫外光响应性的提高。显示随着电流值V的增加而改善 ds ,我们根据电流(插图)将图 5d 的数据绘制为开关值。然后,V g =− 60 V 和 V ds =7 V 条件是最佳条件,其中 I 光/I 紫外光照射前后暗比最大。
<图片>
ZnO NW FET 的紫外传感特性。 一 不同背栅电压下紫外线照射下的 I-V 特性。 V g 的范围从 − 60 V 到 60 V,步长为 20 V。 b 紫外线照射下 Ids 与 Vg 的电特性。 c 我 lignt/我 随着栅极电压的变化而变暗。最大 I lignt/我 在 V 附近获得黑暗 g ~ − 55 V。插图,I ds-V g 在紫外线照射和黑暗下的特性。 d 光/暗电流比之间的线性关系 (I lignt/我 暗)和初始开关电流比(I 在/我 off) 的 ZnO NW FET。插图显示了初始的 I 在/我 各种 V 的关断比 ds。最大I 在/我 关闭比率为 V ds =7 V。e 在空气中有和没有紫外线照射的情况下,ZnO NW 网络 FET 光电探测器的光响应。插图显示紫外线关闭后的指数衰减特性。 f 开关紫外光记录的ZnO NW网络通道器件的时间分辨光响应
我 ds-V g 紫外光下的特性表明晶体管从半导体状态(图 4c)变为导电(积累)状态(图 5b)。预计这种变化会在紫外光下将光激发载流子浓度增加到简并水平 [50]。 我 光/我 我们设备的暗比约为 2 × 10 4 、10 和 6,栅极电压分别为 - 60 V、0 V 和 60 V(图 5e)。这表明可以通过栅极电压调节紫外光响应度。作为 V g 减小,光响应度增加。
我们比较了其他研究中基于 ZnO NW 网络的光电探测器的光响应性能。例如,CVD 生长的 ZnO 纳米线阵列显示出紫外光响应性 (I 光/我 暗) ~ 10 4 [33, 51]。在我们的例子中,我们可以实现类似的光电探测器响应度 2 × 10 4 不使用任何高温和/或高真空工艺。使用喷墨打印 [47] 或垂直排列的纳米线 [52] 等方法的其他研究表明,光响应率为 10 3 到 10 4 ,与我们的研究相当或略低(参见附加文件 1:图 S8)。此外,我们的研究显示出栅极可控特性,这有利于根据光照条件调整器件灵敏度。
ZnO 纳米线的紫外响应可以通过氧解吸和吸附引起的耗尽区调制来解释 [53]。紫外光导致吸附在 ZnO NW 表面上的氧离子解吸。氧解吸增加了有效通道厚度,导致通过 NW 的电流增加。此外,由于紫外线对氧的解吸导致解吸区域的减少降低了 NW 之间的结势垒高度,这使得电流漂移更有效 [54, 55]。由于我们的器件表现出 n 型半导体行为,因此在较大的负 V 下暗电流被最小化 G。因此,在大负栅极电压下的光响应性最大化(参见附加文件 1:图 S9)。
此外,当 UV 灯关闭时,栅极电压会影响到初始状态的恢复时间。 V 时的下降(衰减)时间 g =− 60 V 和 + 60 V 分别为 52 秒和 141 秒,显示了三倍的差异(插图,图 5e)。电流从 10% 增加(上升时间)或减少(下降时间)到 90% 的时间被定义为恢复时间。由栅极偏压引起的电场会影响被紫外光解吸的氧分子吸收过程中电子和空穴复合的可能性[56, 57]。这涉及返回设备初始状态的时间。因此,恢复时间可能会延迟或缩短,具体取决于电场。图 5f 显示了通过应用 V 的重复光响应 g =− 60 V。这显示了通过打开和关闭紫外光记录的 ZnO NW 网络通道设备的时间分辨光响应。我们确认重复紫外线响应不会发生光响应性下降。
结论
我们展示了一种使用 ZnO NW FET 的栅极控制 UV 传感器阵列的有效制造方法。我们的 ZnO NW 器件具有 ZnO NW 结构,其沟道宽度和厚度可控,无需使用任何化学或等离子蚀刻工艺,这种温和的工艺结合低于 ZnO 再结晶温度(~ 400 °C)的热处理,实现了栅极的大规模简易制造具有高开关比和光响应性的受控紫外传感器,器件良率达 90%。制备的 ZnO NWs 网络紫外线传感器显示出 n 型栅极特性,开关比为 10 5 ,跨导约为 47 nS,迁移率约为 0.175 cm 2 V −1 s −1 .这些电性能可以通过拉制方法中的工艺参数如拉制速度来调节。通过热处理方法可以进一步提高电性能。该器件对紫外光表现出高灵敏度,光响应性和响应时间可以通过栅极电压控制。我们预计我们的工艺和器件性能将加速基于 ZnO NW 应用的商业化进程。
缩写
- 原子力显微镜:
-
原子力显微镜
- DCB:
-
二氯苯
- EDS:
-
能量色散X射线光谱
- FET:
-
场效应晶体管
- HMTA:
-
六亚甲基四胺
- 西北:
-
纳米线
- OTS:
-
十八烷基三氯硅烷
- SEM:
-
扫描电子显微镜
- 氧化锌:
-
氧化锌
纳米材料
- 基本入侵检测系统
- Team Chemistry and Industrie 4.0
- 小型硒纳米晶体和纳米棒的简便合成和光学特性
- 使用溶液衍生的 ZnO 通过模板工艺制造基于纳米壳的 3D 周期结构
- 轻松制造多层多孔聚苯胺复合材料作为具有可调灵敏度的压力传感器和气体传感器
- Au@TiO2 蛋黄-壳纳米结构的制备及其在亚甲基蓝降解和检测中的应用
- ZnO 纳米晶体的合成及其在倒置聚合物太阳能电池中的应用
- 在 Ge (100)、(110) 和 (111) 衬底上制造 SrGe2 薄膜
- 通过多元醇介导工艺制备和表征 ZnO 纳米夹
- CA/TPU 螺旋纳米纤维的制备及其机理分析
- 超长细铜纳米线的简便合成及其在高性能柔性透明导电电极中的应用
- 水射流切割及其在加工和制造中的多种用途


