独立式 GaN 衬底上的 Mg 注入和 Mg 掺杂 GaN 层缺陷的比较分析
摘要
低效的 Mg 诱导 p 型掺杂一直是开发用于固态照明和电源应用的基于 GaN 的电子器件的主要障碍。该研究报告了对独立式 GaN 衬底上 GaN 层中缺陷的比较结构分析,其中通过两种方法进行 Mg 掺入:离子注入和外延掺杂。扫描透射电子显微镜显示仅在注入镁的样品中存在金字塔形和线形缺陷,而掺杂镁的样品没有显示这些缺陷的存在,这表明缺陷的性质取决于掺入方法。从二次离子质谱法中,观察到 Mg 浓度与这些缺陷的位置和类型之间存在直接对应关系。我们的研究表明,这些金字塔形和线形缺陷是富含镁的物质,它们的形成可能导致自由空穴密度降低,这仍然是基于 p-GaN 的材料和器件的主要问题。由于独立的 GaN 衬底为实现基于 pn 结的垂直器件提供了平台,因此对此类衬底上 GaN 层中不同 Mg 掺入工艺引起的缺陷的比较结构研究可能会更深入地了解 Mg 自补偿机制,然后优化 Mg 掺杂和/或注入工艺以促进 GaN 基器件技术的进步。
介绍
在过去的三年中,GaN 已成为全世界研究最多的化合物半导体之一。这主要是由于其不仅在固态照明应用中而且在大功率、高频和高温操作方面的巨大潜力 [1,2,3,4,5,6,7,8]。为了将基于 GaN 和相关异质结构的器件成功应用于此类应用和操作,可控的 n 型和 p 型掺杂是关键要求。在这方面,与仍然是学术界和工业界瓶颈的 p 型对应物相比,实现和控制 GaN 外延层或单晶中的 n 型掺杂现在在很大程度上得到了优化。到目前为止,尽管 Mg 的活化能高,需要大量的 Mg 浓度(大约 10 19 厘米 −3 或更多)以达到接近 10 18 的合理自由空穴浓度 厘米 −3 . Mg 原子浓度的任何增加超过 10 19 厘米 −3 导致自由空穴浓度降低 [9,10,11]。这种现象主要归因于 N 空位 [12,13,14]、Mg 相关点缺陷 [10, 15] 或 Mg 空位相关的带电和/或中性配合物的产生,它们降低了费米能级并使自由空穴饱和浓度 [16, 17]。根据在 2.9 eV 处产生峰值的光致发光测量结果,深供体缺陷复合物 Mg-VN 也被认为是自补偿机制的主要原因之一。 [17,18,19]。因此,尽管为理解 GaN 中的 Mg 掺入进行了大量重要的研究尝试,但该问题仍不清楚,需要进一步分析。
大多数使用原子级显微研究进行缺陷分析的早期报告都是基于使用金属有机化学气相沉积 (MOCVD) 或分子束外延 (MBE) 在蓝宝石上生长的 Mg 掺杂 GaN 层。据我们所知,关于 Mg 掺杂的独立式 GaN 衬底中缺陷分析的报告很少,并且没有关于通过离子注入掺入 Mg 的独立式 GaN 衬底中基于透射电子显微镜的缺陷分析的报告。现在人们普遍认为,由于位错密度水平的降低及其在高效垂直器件中的应用,独立式 GaN 衬底与在异质衬底上的 MOCVD/MBE 生长的 GaN 层相比具有若干优势。需要探索通过离子注入在此类衬底中实现足够的 p 型掺杂剂活性,以实现基于 GaN 的固态照明和高功率器件的商业化和开发。以所有这些问题为主要目标,我们对 GaN 独立层中的 Mg 掺入缺陷进行了详细的结构分析,其中 Mg 掺入是通过掺杂和离子注入实现的。
实验方法
在我们的研究中使用了使用氢化物气相外延生长的独立 n-GaN 衬底。此后,通过 MOCVD 在这些衬底上生长外延层。 Mg 掺入通过两种方法进行:离子注入和外延掺杂。在第一种情况下,将 Mg 注入 4 μm 厚的未掺杂 GaN 外延层,而未在未掺杂的 GaN 层上沉积任何保护层,而在第二种情况下,将 1 μm 厚的 Mg 掺杂 GaN 外延生长在 4 μm 上- 厚的未掺杂 GaN 层连续。为了进行可靠的比较,Mg 掺入水平保持与 4 × 10 19 相同 厘米 −3 在这两种情况下。 Mg 注入在 500 °C 下进行,然后在 1350 °C 下退火以激活掺杂剂。注入能量取为15、30、55、95和180 keV,剂量分别为3.0 × 10 13 , 5.5 × 10 15 , 1.1 × 10 14 , 1.9 × 10 14 , 和 8 × 10 14 cm −2 , 以获得 200 纳米深的盒子轮廓。进行霍尔测量以评估掺杂 Mg 和注入 Mg 的 GaN 样品的电性能。对于掺杂 Mg 的 GaN 样品,发现空穴浓度和迁移率是 3.4 × 10 17 厘米 −3 和 9.5 cm 2 /V-s。另一方面,Mg 注入样品的电性能由于其高电阻性质而无法正确评估。使用二次离子质谱法 (SIMS) 研究镁作为深度函数的分布,而扫描透射电子显微镜 (STEM) 分析用于镁诱导缺陷的结构研究。为此,JEOL JEM-ARM200F 在 200 和 80 kV 下进行了 STEM 和电子能量色散 X 射线光谱 (EDS)。在这些研究中,通过使用 Ga 束的聚焦离子束铣削和液氮冷却的低能 Ar 离子铣削制备 TEM 样品。
结果与讨论
Mg 注入 GaN 层的缺陷分析
图 1(a) 显示了注入 Mg 的 GaN 的明场 (BF)-STEM 图像,而 (b) 显示了相应的 SIMS 轮廓。图 1(a) 中的箭头表示正 [0001] 方向,沿 [11\( \overline{2} \)0] 区域轴查看图像。可以看出,缺陷作为深度的函数并不是均匀分布的,事实上,Mg 的浓度与缺陷之间存在直接相关性。大多数缺陷在距表面约 150 nm 处积累,其中 Mg 浓度超过 10 19 厘米 −3 从 SIMS 测量中观察到。为了更好地理解由于 GaN 中的 Mg 注入引起的缺陷及其可视化,通过将样品从 [11\( \overline{2} \)0] 轴围绕 c 轴倾斜 10°,在离区轴条件下进行成像.由于完美的晶体,这种条件减弱了衍射对比度,并增强了缺陷对比度,与周围环境相比,可以更好地显示缺陷。在这种离区轴条件下拍摄的 Mg 注入 GaN 样品的 BF-STEM 图像如图 1(c)所示,其中在距表面约 200 nm 的深度处可以看到一些线缺陷。相应的 Mg SIMS 分布以线性标度显示在 (d) 中,其中观察到这些线缺陷的存在与 Mg 浓度之间存在直接对应关系。发现这些缺陷位于 Mg 浓度约为 10 19 中间的狭窄区域 厘米 −3 范围。
<图片>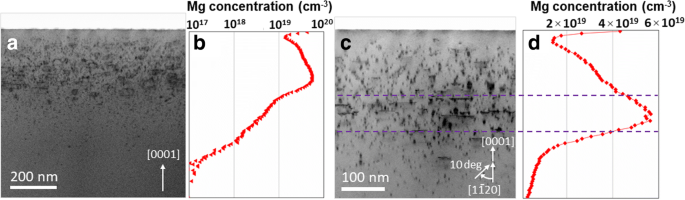
一 沿 [11\( \overline{2} \)0] 轴和 b 获得的 Mg 注入 GaN 样品的横截面明场 STEM 图像 使用 SIMS 获得的 Mg 的相应深度剖面。为了更好地可视化缺陷及其与 Mg 浓度的关系,成像在离区轴条件下进行,如 c 所示 .对应于 c 的 Mg 剖面 显示在 d 在线性尺度中,在具有最高 Mg 浓度的狭窄区域中观察到线缺陷
此外,高倍率 BF-STEM 成像是在离区轴条件下进行的,如图 2(a)所示,(b)以更高的放大倍数显示(a)的选定区域。如(b)所示,观察到标记为A、B、C和D的四种结构。标记为“A”的缺陷为金字塔形,而标记为“B”的缺陷为线缺陷。
<图片>
一 在离区轴条件下获得的镁注入 GaN 样品的横截面明场 STEM 图像,以加强缺陷对比度。 (a 中标记区域的放大视图 ) 出现在 (b ) 其中观察到标记为 A、B、C 和 D 的四种不同类型的缺陷。在 (b 中标记为 A 的锥体域的高分辨率 TEM 图像 ) 显示在 (c ) 在右下角有示意图。锥体域上扭曲的晶格通过挤压 (c ) 如 (d )。一种典型 C 或 D 型缺陷的高分辨率 TEM 图像显示在 (e ) 压缩图像 (f ),显示缺陷周围的应变场对比
从理解镁补偿机制的角度来看,这些缺陷的结构观察很重要,手稿的下一部分主要致力于“A”和“B”型缺陷的结构分析。显示为“A”的结构是金字塔缺陷,正[0001]方向指向它们的头部,它们的基部在[0001]平面上,在[11\(\overline{2}\)3]平面上有六个壁倾斜,如图所示图 2(c) 中一个此类缺陷的高分辨率 TEM 图像。这种金字塔结构域的示意图也显示在图 2(c) 中。图 2 (c) 垂直于 [0001] 方向挤压,如 (d) 所示,其中与周围的 GaN 矩阵相比,金字塔域中的晶格似乎发生了扭曲,表明这些金字塔域内外的 Ga 和 N 亚晶格之间存在位移.这与 Vennegues 等人的研究结果一致。 [20] 观察到类似类型的金字塔结构域。在掺镁的 GaN 薄膜中较早地观察到类似的金字塔形缺陷,它们的存在通常是通过引入 Mg 导致 GaN 原子结构的改变来解释的 [19,20,21,22,23,24]。 Liliental-Weber 等人。 [25, 26] 提出这种金字塔缺陷源于这些金字塔顶部附近存在的富镁簇。纤锌矿相的 GaN 结构通常通过 N 平面的六边形堆叠来描述,其中一半的 N 亚晶格四面体位置被 Ga 原子填充。文内格斯等人。 [27] 根据他们的研究,在 GaN 中引入更高含量的 Mg 会导致 Ga 被 Mg 取代,形成 Mg3N2,据报道是一种具有抗方铁锰矿结构的 Mg-N 化合物。 Mg3N2 的 antibixbyte 结构对应于 N 亚晶格四面体位点被 Mg 填充,Mg 占据了每四个位点中的三个。根据 Vennegues 等人提出的模型。 [27],金字塔形域可以被认为是两个极性相反的 GaN 晶体,被单层 Mg3N2 隔开。 Hansen 等人的研究进一步支持了这一点。 [28] 其中这些金字塔形域被提议为 Mg3N2 夹杂物。文内格斯等人。 [27] 和 Leroux 等人。 [23] 还报道了这种具有纳米尺寸的锥体域的形成也需要低至中 10 19 的 Mg 掺入 厘米 −3 范围。这与我们的发现一致,即在 10 19 下至中段观察到金字塔形缺陷 厘米 −3 从 STEM 图像(图 1(c))和相应的 SIMS 分布图(图 1(d))之间的相关性可以看出 Mg 浓度。因此,我们研究的图 2(b)中标记为结构“A”的金字塔形状缺陷被认为是富镁的金字塔形域,它们的形成可以直接与 p-GaN 层中的 Mg 补偿机制相关联。如图 2(b) 所示的其他类型的缺陷是“C”型和“D”型缺陷,它们本质上是相似的结构,但它们的尺寸有所不同。当从 [11\( \overline{2} \)0] 轴观察时,对比度似乎沿着 [0001] 方向被拉长,很可能是应变起源的。为了进一步阐明这一点,图 2(e)中展示了一个此类类似缺陷的高分辨率 TEM 图像,(f)显示了垂直于 [0001] 方向挤压的相同图像。由于沿[0001]方向的应变场不同,沿[0001]方向扭曲的晶格表明不同的晶格常数。由于与 Ga 相比,Mg 的尺寸更小,因此它在 Ga 位点上的结合预计会在晶格中产生应变,这可能会导致这些缺陷周围的这种对比。
另一种类型的缺陷,在图 2 (b) 中标记为“B”,当从 [11\( \overline{2} \)0] 轴观察时,它似乎是垂直于 [0001] 方向的线缺陷。重要的是要注意,这种类型的缺陷似乎累积在具有较高 Mg 浓度的狭窄区域中(从 BF-STEM 图像和图 1(c)和(d)中所示的 Mg SIMS 轮廓之间的对应关系中观察到),表明它们的形成与镁的过度结合有关。另一个观察结果是在这些线缺陷的边缘存在锥体域,这表明这些域的积累可能导致它们的形成。然而,不应该排除它可能只是金字塔和线缺陷的随机重叠,并且需要在这个方向上进一步研究。 BF-STEM 图像显示了这些类型的缺陷,如图 3(a)所示。为了更好地理解这些缺陷,将样品围绕垂直于 [0001] 方向的轴倾斜约 10°,获得的 BF-STEM 图像如图 3(b)所示。样品的这种倾斜强烈地激发了沿 1-100 方向的衍射点,从而增强了缺陷周围方向上应变场的对比度。从这个应变场对比来看,作为线出现的缺陷(见图 2(a)和(b))实际上由一对相距几纳米的线组成,在 [0001] 方向更深。
<图片>
一 注入镁的块状 GaN 样品的横截面明场 STEM 图像,用于分析看起来像截棱锥或梯形形状的 B 型缺陷。 b 表示通过将样品围绕垂直于 c 的轴倾斜 10° 所拍摄的图像 -轴,在这些缺陷的边缘观察到不同的对比度
这些缺陷中可能存在 Mg,因为它们出现在 Mg 浓度高于 10 19 的较窄区域 厘米 −3 从 STEM 图像(图 1(c))和 Mg SIMS 轮廓(图 1(d))之间的对应关系观察到的。为了验证这些类型的缺陷具有 Mg 的这种信念,我们在两个不同的区域进行了扫描透射电子显微镜 - 能量色散光谱 (STEM-EDS) 测量,EDS 探针直径小于 0.2 nm:“远离缺陷”和“在缺陷处”分别标记为点 1 和 2,如图 4(a)所示。在 1.19 keV 到 1.35 keV 能量范围内的点 1 和 2 的比较 EDS 光谱绘制在图 4(b)中,插图显示了完整的 EDS 光谱。在缺陷处(点 2)可以清楚地看到 Mg 的存在。为了进一步证明这一点,我们对类似的 Mg 注入 GaN 样品进行了 STEM-EDS 映射。图 4 (c) 显示了注入 Mg 的 GaN 样品的 STEM 图像,向下箭头显示了这些线缺陷,相应的 Mg 的 EDS 图显示在图 4 (d) 中。在这些缺陷中可以清楚地看到 Mg 的存在。因此,这些缺陷含有 Mg 并在 Mg 浓度高于 10 19 时形成。 厘米 −3 可能是镁补偿的另一个原因。
<图片>
一 Mg 注入 GaN 样品的横截面 STEM 图像显示了单个“B”型缺陷。点 1 和 2 表示进行 EDS 测量的区域,结果 EDS 光谱显示在 b 中 .在 1.19–1.40 keV 能量范围内的 EDS 光谱绘制在 b 插图显示带有 Ga 和 N 峰的完整 EDS 光谱。 c 和 d 目前的 STEM 图像和类似的 Mg 注入块状样品的相应 Mg 图显示在这些类型的缺陷中存在 Mg
Mg 掺杂 GaN 层缺陷分析
接下来,我们对 GaN 样品进行了结构研究,其中 1 μm 厚的 Mg 掺杂 GaN 层外延生长在 4 μm 厚的未掺杂 GaN 外延层上。再次值得一提的是,Mg的水平保持不变,即4 × 10 19 厘米 −3 用于对两种 Mg 掺入方法进行有意义的比较:外延掺杂和离子注入。图 5(a) 显示了在独立 GaN 衬底上外延生长的 Mg 掺杂 GaN 的 BF-STEM 图像,沿 [11\( \overline{2} \)0] 观察,而 (b) 显示了作为 GaN 深度函数的 Mg 分布使用 SIMS 获得。请注意,Mg 浓度几乎保持不变,约为 4 × 10 19 厘米 −3 在图 5(a) 的视野范围内(高达 700 nm),这与早期的 Mg 注入 GaN 情况不同,其中发现 Mg 浓度是 GaN 深度的函数(见图 1(a)-(d) )).
<图片>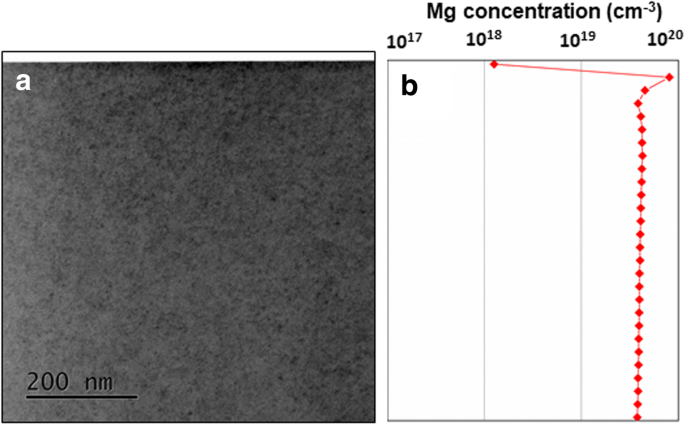
一 沿 [112 ̅0] 轴和 b 获得的 Mg 掺杂体 GaN 样品的横截面明场 STEM 图像 使用 SIMS 获得的 Mg 的相应深度剖面。发现点状缺陷均匀分布在整个样品中
为了对掺杂 Mg 的 GaN 样品进行缺陷分析,通过将样品围绕 c 倾斜 10°,在离区轴条件下进行 STEM 成像 -axis from [11\( \overline{2} \)0] 轴被执行。图 6 (a) 和 (b) 表示 BF-STEM 和 DF-STEM 图像,其中观察到具有约 5 nm 尺寸的点状缺陷均匀分布在整个样品中。请注意,在这种情况下,从 SIMS 剖面观察到的 Mg 剖面似乎也是均匀的(见图 5(b))。 Mg 和这些缺陷在 GaN 样品中的均匀分布表明这些缺陷与 Mg 掺入之间存在直接关联。这些大约 5 nm 的点状缺陷很可能是 Mg 的沉淀物(并可能由此引发堆垛层错)。由于尺寸小,EDS 测量无法直接确认 Mg 沉淀本身(Ga 和 Mg 峰彼此非常接近,这使得绘制小浓度差异非常困难)。
<图片>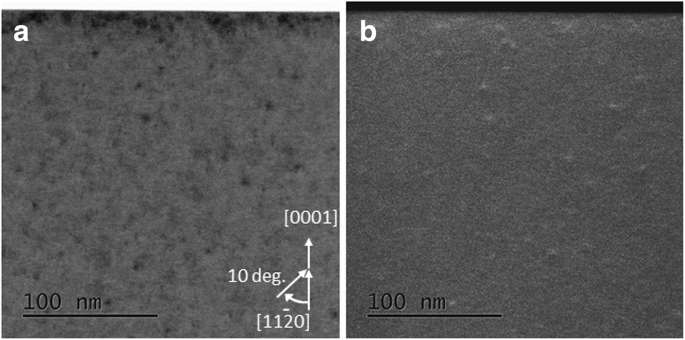
横截面 a STEM-BF 和 b 在离区轴条件下获得的Mg掺杂块体GaN样品的STEM-ADF图像以加强缺陷对比
这一观察结果与早期的 Mg 注入样品完全不同,其中发现缺陷在距离 Mg 浓度最大的表面 200 nm 处积累。此外,与 Mg 注入的样品不同,我们在 Mg 掺杂的 GaN 样品中没有观察到任何金字塔形和双线缺陷(在图 2(b)中标记为 A 和 B)。有趣的是,在 GaN 样品中也报道了金字塔形和线形缺陷,其中通过离子注入以外的技术掺入了镁。例如,Khromov 等人。 [29] 报道了通过 MOCVD 生长的 Mg 掺杂 GaN 样品中存在金字塔形缺陷。然而,他们仅在Mg浓度约为~ 5 × 10 19 的高掺杂GaN样品中观察到此类缺陷。 厘米 −3 .然而,在样品中含有 Mg ~ 2 × 10 18 厘米 −3 ,没有观察到这些金字塔结构域。文内格斯等人。 [27] 还在 MOCVD 生长的掺杂 Mg 的 GaN 样品中观察到了这种金字塔形域,其中 Mg 浓度位于 10 19 厘米 −3 范围。他们没有在Mg浓度低于10 19 的样品中观察到这种缺陷 厘米 −3 .在我们的工作中,Mg的相似水平~ 4 × 10 19 厘米 −3 通过离子注入和外延掺杂来分析这些缺陷的存在。这些缺陷仅在注入 Mg 的样品中观察到,而不在 Mg 掺杂的样品中观察到,这表明还应考虑 Mg 分布来解释它们的存在。从 SIMS 测量中,发现 Mg 不均匀分布在 Mg 注入样品中(图 1(b)和(d)),而 Mg 掺杂样品显示出均匀分布的 Mg(图 5(b))。此外,在注入 Mg 的样品中,发现这些缺陷仅存在于与周围基质相比具有更高 Mg 浓度的狭窄窗口中。因此,这些缺陷的形成与Mg的掺入量和Mg的分布有关,它们很可能形成于Mg在10 19 范围内的区域。 厘米 −3 .看来,Mg 注入样品中不均匀的 Mg 分布导致缺陷的不均匀分布。然而,不应否认不均匀分布的缺陷导致不均匀的Mg分布或Mg注入轮廓依赖于这种缺陷的存在的可能性;因此,需要朝这个方向进一步调查。我们对掺镁氮化镓缺陷的比较分析表明,缺陷的性质和类型取决于掺入方法。
结论
总而言之,基于扫描透射电子显微镜对独立 GaN 衬底上的 Mg 注入和 Mg 掺杂的外延层中的缺陷进行的结构研究表明,缺陷的性质在很大程度上取决于 Mg 的掺入方法。 Mg 注入的 GaN 显示存在指向 [0001] 方向的金字塔形域和具有在 [0001] 方向上相隔几纳米深的特征的两线缺陷。金字塔域被认为是基于 Mg3N2 的结构,而从能量色散光谱观察到的线缺陷也被发现具有 Mg。发现这些线缺陷位于距表面约 200 nm 的深度处,在一个狭窄的区域中,Mg 浓度约为 10 19 厘米 −3 这表明它们的形成与注入的镁浓度水平有关。预计在 Mg 注入的 GaN 中形成这些缺陷将显着促进 Mg 自补偿机制,从而导致 p 型掺杂效率低下。相反,Mg 掺杂的 GaN 样品仅显示存在点状缺陷,发现这些缺陷均匀分布在整个样品上。目前的研究强调了 Mg 掺入方法及其浓度对缺陷性质和类型的依赖性,这可能证明有助于选择适当的 Mg 掺入量,从而在 GaN 基材料中实现高 p 型电导率,从而实现有效的器件操作。
缩写
- ADF:
-
环形暗场
- BF:
-
明场
- EDS:
-
能量色散光谱
- MBE:
-
分子束外延
- MOCVD:
-
金属有机化学气相沉积
- SIMS:
-
二次离子质谱
- STEM:
-
扫描透射电子显微镜
纳米材料


