原子层沉积 ZnO/β-Ga2O3 (\( \overline{2}01 \)) 异质结处的能带调查
摘要
ZnO/β-Ga2O3 (\( \overline{2}01 \)) 异质结的能带排列通过 X 射线光电子能谱 (XPS) 表征。通过在不同温度下使用原子层沉积来生长 ZnO 薄膜。所有 ZnO/β-Ga2O3 异质结都具有 I 型能带排列。随着生长温度从 150°C 增加到 250°C,导(价)带偏移从 1.26 (0.20) eV 变化到 1.47 (0.01) eV。随温度增加的导带偏移主要是由 ZnO 薄膜中的 Zn 间隙引起的。同时,受主型复合缺陷 Vzn + OH 可以解释降低的价带偏移。这些发现将有助于ZnO/β-Ga2O3相关电子器件的设计和物理分析。
介绍
氧化镓 (Ga2O3) 因其独特的特性而被广泛研究作为下一代电力电子器件的有前途的超宽带隙半导体材料 [1]。在各种多晶型物(α、β、γ、δ 和 ε)中,单斜晶系 β-Ga2O3 具有最高的热稳定性 [2]。此外,β-Ga2O3 的室温带隙为 4.5~4.9 eV,化学稳定性优异[3]。特别是,β-Ga2O3 具有高达 100 cm 2 的体电子迁移率 /V·s,8 MV/cm 的击穿场比 SiC (3.18 MV/cm) 或 GaN (3 MV/cm) [4] 高得多,并且可以通过掺杂 Sn 和 Si 轻松调节载流子浓度 [ 5, 6]。因此,已经报道了基于 β-Ga2O3 的器件,包括日盲光电探测器 [7] 和金属氧化物半导体场效应晶体管 (MOSFET) [8]。然而,基于β-Ga2O3 的器件仍然存在局限性,例如金属和β-Ga2O3 之间的欧姆接触不良[9]。近年来,在金属和 Ga2O3 之间插入一个高电子浓度的金属-氧化物-半导体中间层,即中间半导体层 (ISL),已被证明是一种有效的分辨率,因为界面处的能垒的调制[10, 11,12]。
氧化锌(ZnO)因其具有60 meV的大激子结合能、> 10 19 的高电子浓度而备受关注。 厘米 −3 ,以及 1.89 eV 的强大内聚能。 [13, 14] 此外,ZnO 和 Ga2O3 之间的晶格失配在 5% 以内 [15]。已经开发了各种沉积技术来制备 ZnO 薄膜,包括水热法 [16, 17] 和化学气相沉积 (CVD)。 [18] 然而,水热法工艺复杂,生长速度缓慢,而CVD一般需要900°C以上的安静高生长温度。这些缺点使得在设备中应用具有挑战性。最近,原子层沉积(ALD)已成为一种很有前途的技术,它表现出优异的阶梯覆盖、原子级厚度可控性、良好的均匀性和相对较低的沉积温度。因此,在宽带隙半导体上沉积原子层的 ZnO 可以减少界面无序并产生更可控的样品来检查能带排列,这在载流子传输过程中起着重要作用 [19]。到目前为止,虽然有一些关于 ZnO 和 Ga2O3 的理论能带排列的报道,但目前还没有实验研究 Ga2O3 和原子层沉积 ZnO 之间的能带排列。 [20] 因此,了解原子层沉积的 ZnO/β-Ga2O3 异质结的能带排列对于未来相关器件的设计和物理分析非常有必要。在这项工作中,通过 X 射线光电子能谱(XPS)表征了原子层沉积 ZnO 在 β-Ga2O3 上的能带排列。此外,还讨论了ZnO生长温度对能带排列的影响。
方法
β-Ga2O3 (\( \overline{2}01 \)) 衬底,Sn掺杂浓度为~ 3 × 10 18 /cm 3 切成6 × 6毫米的小块 2 .切块的样品在丙酮、异丙醇中交替清洗,超声波清洗每 10 分钟,随后用去离子水冲洗以去除残留的有机溶剂。之后,将 Ga2O3 衬底转移到 ALD 反应器(无锡 MNT 微纳米技术有限公司,中国)中。 ZnO 薄膜的生长速率为~ 1.6 Å/循环。分别在 150、200 和 250 °C 的温度下使用 Zn (C2H5)2 (DEZ) 和 H2O 在清洁的 β-Ga2O3 上生长 40 和 5 nm ZnO 薄膜。制备的 ZnO 薄膜的厚度通过椭圆偏光计 (Sopra GES-5E) 测量。以 ZnO(40 nm)/β-Ga2O3 作为块体标准品,使用 ZnO(5 nm)/β-Ga2O3 来确定能带排列,同时以裸块体 β-Ga2O3 作为对照样品.以 0.05 eV 的步长进行 XPS(AXIS Ultra DLD,Shimadzu)测量以测量价带最大值 (VBM)、Ga 2p 和 Zn 2p 光谱。为避免表面氧化和污染的干扰,所有样品在 XPS 测量前用 Ar 离子蚀刻 3 分钟,电压为 2 kV。请注意,所有 XPS 光谱均通过 284.8 eV 的 C 1s 峰进行校准,以补偿充电效应。为了识别带隙,采用紫外-可见(UV-VIS)光谱(Lambda 750,PerkinElmer,USA)测量了Ga2O3和ZnO的透光率光谱。
结果与讨论
图 1 显示了 (αhv ) 1/n 作为块体 β-Ga2O3 和在 200°C 下沉积的生长的 ZnO 膜的光子能量的函数。光学带隙 (E g ) 的 ZnO 薄膜和 β-Ga2O3 可以由 Tauc 关系确定 [21]:(αhv ) 1/n =A (hv − E g ),其中α为吸收系数,A为常数,hv 是入射光子能量,E g 是光能带隙,n 直接带隙为 1/2,间接带隙为 2。这里,ZnO 和 β-Ga2O3 都具有典型的直接带隙,使得 n 的值 是 1/2。随后,E g 可以通过将直线部分外推到 α =0 处的能量偏差来提取。因此,提取的 E g ZnO 和 β-Ga2O3 分别为 3.20 eV 和 4.65 eV,与报道的一致。 [22, 23]
<图片>
(αhv ) 2 对比 hv 对于 a 在石英玻璃上生长的 ZnO 薄膜 b β-Ga2O3 衬底。插图分别为ZnO和β-Ga2O3的光透射光谱
价带偏移(VBO)可以通过克劳特的方法使用以下公式确定[24]
$$ \Delta {E}_V=\left({E}_{Ga\ 2p}^{Ga_2{O}_3}-{E}_{VBM}^{Ga_2{O}_3}\right)-\ left({E}_{Zn\ 2p}^{Zn O}-{E}_{VBM}^{Zn O}\right)-\left({E}_{Ga\ 2p}^{Ga_2{O }_3}-{E}_{Zn\ 2p}^{Zn O}\right), $$ (1)其中 \( {E}_{Ga\ 2p}^{Ga_2{O}_3}-{E}_{VBM}^{Ga_2{O}_3} \) \( \Big({E}_{Zn\ 2p}^{Zn O}-{E}_{VBM}^{Zn O} \)) 表示 Ga 2p (Zn 2p) 核心能级 (CL) 与块体 β-Ga2O3 (ZnO) 的 VBM 之间的能量差, 而 \( {E}_{Ga\ 2p}^{Ga_2{O}_3}-{E}_{Zn\ 2p}^{Zn O} \) 表示为 Ga 2p 和 Zn 2p 核的能量差水平。图 2 显示了所有 CL 光谱,包括 ZnO (40 nm)/β-Ga2O3 和 ZnO (5 nm)/β-Ga2O3 的 Zn 2p、块状 Ga2O3 和 ZnO (5 nm)/β-Ga2O3 的 Ga 2p,以及价态块状 Ga2O3 和 ZnO (40 nm)/β-Ga2O3 的带光谱。图 2a 显示了 ZnO (40 nm)/β-Ga2O3 上 Zn 2p 的 CL 光谱,它是安静对称的,表明键合状态均匀,峰值位于 1021.09 eV,对应于 Zn-O 键 [25]。 VBM 可以使用线性外推法确定[26]。 ZnO 的 VBM 位于 2.11 eV。在图 2b 中,位于 1117.78 eV 的峰对应于 Ga-O 键 [27],根据上述方法推导出 Ga2O3 的 VBM 为 2.74 eV。 ZnO (5 nm)/β-Ga2O3 中Zn 2p 和Ga 2p 的CLs 如图2c 所示。根据方程。 (1) ZnO/Ga2O3界面处的VBO确定为0.06 eV。
<图片>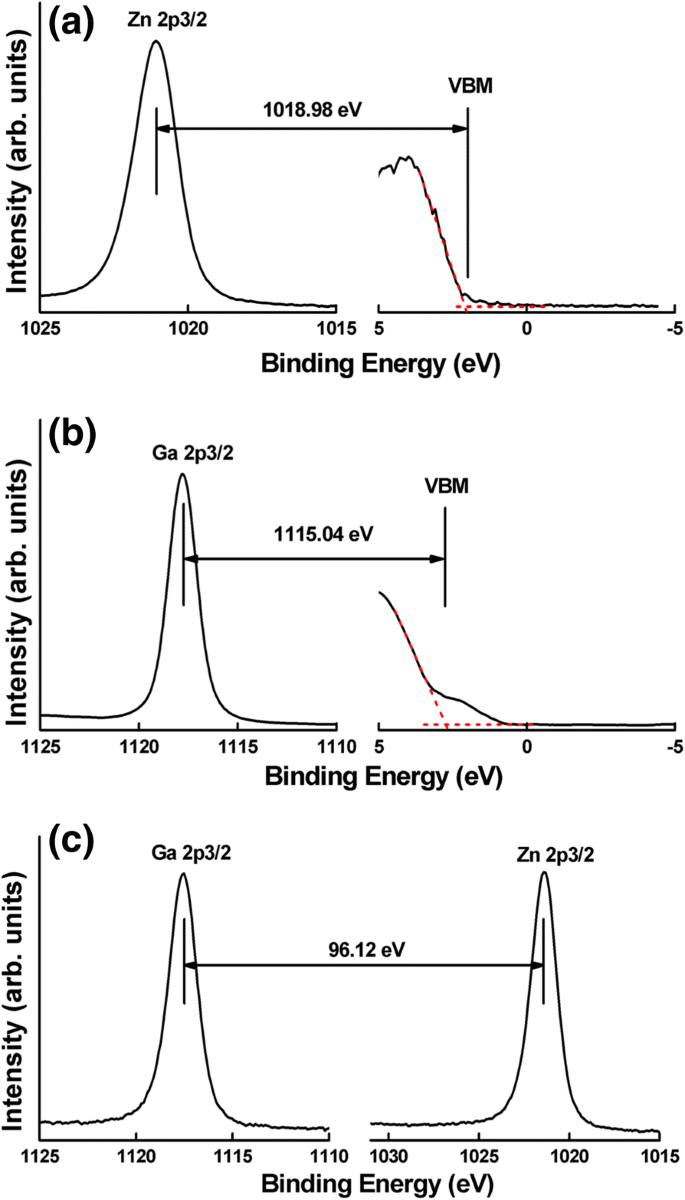
a 的核心能级和价带最大值 (VBM) 的高分辨率 XPS 光谱 来自 40 nm ZnO/β-Ga2O3 的 Zn 2p 核心能级光谱和 VBM,b Ga 2p 核心能级谱和来自裸 β-Ga2O3 和 c 的 VBM Ga 2p和Zn 2p的核心能级光谱由5 nm ZnO/β-Ga2O3的高分辨率XPS光谱得到
基于计算的 E g 和 ∆E V , ZnO/Ga2O3 界面的导带偏移 (CBO) 可以很容易地从以下方程推导出:
$$ \Delta {E}_C={E}_g^{Ga_2{O}_3}-{E}_g^{ZnO}-\Delta {E}_V, $$ (2)其中\( {E}_g^{Ga_2{O}_3} \) 和\( {E}_g^{ZnO} \) 分别是β-Ga2O3 和ZnO 的能带隙。 ZnO/β-Ga2O3 的详细能带图如图 3 所示。界面具有 I 型能带排列,其中 ZnO 的导带和价带边缘均位于 β-Ga2O3 的带隙内。
<图片>
ZnO (200 °C)/β-Ga2O3异质结能带排列示意图
为了进一步检查生长温度对 ZnO 和 β-Ga2O3 能带排列的影响,ZnO 薄膜也在 150 和 250°C 下生长。请注意,通过 ALD 在 150-250 °C 的温度下制备的 ZnO 薄膜具有多晶性质。图 4 显示了在不同温度下生长的 ZnO 薄膜的高分辨率 O 1s XPS 光谱。使用 Gaussian-Lorentzian 函数可以将每个 O 1s 光谱很好地分为三个分量。以 530.0 (O1)、531.6 (O2) 和 532.4 (O3) eV 为中心的峰分别对应于 Zn-O 带、氧空位和 –OH 基团 [28, 29]。还根据峰面积计算了不同组分的相对百分比,如图 4 所示。它表明,由于前驱体的分解和 Zn 间隙的增加,氧空位的相对含量从 10.7% 增加到 15.0%。然而,由于在该温度范围内 DEZ 前体与表面 -OH 基团之间的反应更加完全,因此 -OH 对应物从 5.1% 减少到 1.9% [30]。
<图片>
在a生长的ZnO薄膜的高分辨率O 1 s XPS光谱 150°C,b 200 °C 和 c 分别为250℃
图 5 显示了作为生长温度函数的 ZnO/β-Ga2O3 异质结的能带偏移。随着生长温度从 150 到 250 °C,CBO 从 1.26 eV 增加到 1.47 eV。天然供体缺陷包括 Zn 反位、氧空位和 Zn 间隙。然而,反位原子的形成能如此之高,以至于其浓度极低。与氧空位相比,Zn 间隙对导带最小值 (CBM) 的影响更大,因为 CBM 主要由 Zn 原子的 4s 轨道支配。 [31] 因此,增加的 0.21 eV 的 CBO 可能主要由 Zn 间隙贡献。另一方面,随着生长温度从 150 °C 升高到 250 °C,VBO 从 0.20 eV 降低到 0.01 eV。天然受体缺陷包括 O 反位、Zn 空位和氧间隙 [32],它们的形成能很高,它们的数量甚至可以忽略不计。此外,最天然的受主能级位于 ZnO 带隙深处,因此它们对 VBM 影响很小 [33]。然而,由于形成能低,Vzn + OH 有利于呈现,[34] Vzn + OH 可能与属于 OH 键的电子一起出现。晶格氢H + 离子充当补偿中心,它可以与位错和堆垛层错核周围的 VZn 结合,确保 p 型导电性的受主型复杂缺陷 [35]。在较低的生长温度(即 150 °C)下,在 ZnO 膜中获得更多残留的 -OH 基团 [36]。 VBM 附近的受体水平随着温度的升高而降低,导致 E 的有效下降 V ZnO,因此 ∆E V 变得更低。因此,低温沉积的ZnO可以更有效地降低金属与Ga2O3界面的势垒高度。
<图片>
不同温度下制备的原子层沉积ZnO/β-Ga2O3异质结的导带和价带偏移
结论
总之,原子层沉积的 ZnO/β-Ga2O3 (\( \overline{2}01 \)) 的能带排列由 XPS 表征。在 ZnO/β-Ga2O3 界面形成的 I 型能带排列。随着温度从 150 °C 升高到 250 °C,导带偏移从 1.26 eV 增加到 1.47 eV,而价带偏移从 0.20 eV 减少到 0.01 eV。这些观察结果表明,在较低温度下沉积的 ZnO 有利于成为一种有前景的 ISL,以降低 ZnO/β-Ga2O3 界面的电子势垒高度。
缩写
- ALD:
-
原子层沉积
- CBM:
-
导带最小值
- CBO:
-
导带偏移。
- CVD:
-
化学气相沉积
- DEZ:
-
锌(C2H5)2
- Ga2O3 :
-
氧化镓
- 氮化镓:
-
氮化镓
- ISL:
-
中间半导体层
- MOSFET:
-
金属氧化物半导体场效应晶体管
- 哦:
-
羟基
- 碳化硅:
-
碳化硅
- 紫外可见光:
-
紫外可见光谱
- VBM:
-
价带最大值
- VBO:
-
价带偏移
- XPS:
-
X射线光谱
- 氧化锌:
-
氧化锌
纳米材料


