具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
摘要
已获得二维到三维生长 (2D-3D) 临界转变厚度对具有固定 Ge 含量和 0 至 16% 的 Sn 含量的 GeSiSn 薄膜在 150°С 生长温度下的组成的依赖性.已经建立了在 Si 和 Ge(100) 上外延生长 Sn 过程中超结构变化的相图。使用相图数据,可以识别 Si 表面上的 Sn 覆盖层并控制在反射高能电子衍射 (RHEED) 图案上观察到的超结构上的 Sn 偏析。 GeSiSn 伪晶层和密度高达 1.8 × 10 12 的岛阵列的多层结构 cm −2 已经考虑到通过降低 GeSiSn 和 Si 生长温度抑制 Sn 偏析来生长。在 GeSiSn 层上生长 Si 期间,首先在多层周期性结构中观察到与表面存在 Sn 相关的双畴 (10 × 1) 超结构。周期性 GeSiSn/Si 结构展示了 0.6-0.85 eV 范围内的光致发光,对应于 1.45-2 μm 的波长范围。具有伪晶 Ge0.315Si0.65Sn0.035 层的结构的能带图的计算允许假设光致发光峰对应于 X 之间的带间跃迁 Si中的谷或GeSiSn中的Δ4谷和GeSiSn层中的重空穴子带。
背景
尽管成功地制造了波导[1]、光电探测器[2]和调制器[3]等硅光子器件,但由于Si是具有间接带隙的半导体,因此没有提出有效的发光器件。
在Ge、Si或GeSi固溶体的基体中添加Sn是获得基于IV族材料的直接带隙半导体的途径之一。 Ge晶格中包含Sn减少了Г的最小值之间的差异 和 L 谷,GeSn 可以成为直接带隙材料。如图所示,GeSn 立方晶格的直接性出现在 Sn 含量约为 9% 时 [4, 5]。在存在拉伸应变的情况下,该值可能低于 6%,而对于具有压缩应变的薄膜,预计 Sn 含量超过 11% 时会发生转变 [6]。由于包含 Sn 导致的带隙减小允许将工作波长从近红外范围增加到中红外范围,这在光互连领域、新一代光纤通信系统、传感器、信号处理、能量转换和光存储设备[7]。因此,近年来,人们对Ge-Si-Sn类材料的兴趣显着增加。
为获得仪器质量的外延 GeSn 薄膜付出了巨大的努力 [8, 9]。严重的问题之一是在 GeSn 层生长过程中形成的 Sn 夹杂物(沉淀物)[10, 11]。除了沉淀,在 GeSn、GeSiSn 层生长和 GeSn 膜氧化过程中观察到 Sn 偏析 [11, 12]。非平衡生长技术,如分子束外延 (MBE) 和化学气相沉积 (CVD),提供可靠的沉淀和偏析抑制方法。为了减少 Sn 析出和偏析的影响,可以降低生长温度 [13] 或变形夹杂物,或添加第三种元素,例如 Si,降低 Sn 原子周围的局部应力。
尽管基于 IV 族化合物的材料前景广阔,但关于形态和表面结构或单晶 GeSiSn 薄膜形成机制的数据实际上并未在文献中找到。这些数据对于创建具有应变和松弛 GeSiSn 层的纳米异质结构是必要的。在本文中,首次展示了与创建多层结构相关的数据,超晶格不仅具有假晶 GeSiSn 层,而且还具有 GeSiSn 纳米岛,它们不包含位错并允许在很宽的范围内改变材料的带隙宽度覆盖了GeSi以前无法实现的红外波长范围。
本文旨在研究弹性应力假晶GeSiSn薄膜的生长、三维纳米岛的形成,获得含有假晶GeSiSn层和纳米岛的多层周期性结构。
在我们之前的论文 [14,15,16] 中,使用反射高能电子衍射构建了 GeSiSn 和 Si 之间的各种晶格参数失配的形态学 GeSiSn 膜态动力学图,Sn 含量范围为 0% 到 8%。瑞德)。本文包括新的关键二维到三维生长 (2D-3D) 过渡厚度对 GeSiSn 薄膜成分的依赖关系,其中 Sn 含量范围为 0 到 16%,具有固定的 Ge 含量。获得了在 Si 和 Ge(100) 上生长 Sn 过程中超结构变化的相图。尽管在 [17,18,19] 中,在不同的锡覆盖层上研究了 Si 上的 Sn 表面重建,但我们的数据证明了新的超结构。此外,在 Ge(100) 上 Sn 生长过程中上层结构变化的相图之前没有在任何地方出现。首先通过光致发光方法对具有不同Sn含量的样品研究了包括假晶GeSiSn层在内的多层周期性结构的光学性质。 GeSiSn/Si异质结的能带图计算采用模型实体理论方法[20]。
实验
所有具有假晶 GeSiSn 层和 GeSiSn 纳米岛的样品均在超高真空条件下生长 10 -7 –10 -8 分子束外延 (MBE) 设备“Katun C”上的 Pa。外延生长室具有用于 Si 的电子束蒸发器和用于 Ge 和 Sn 的 Knudsen 渗出池。 GeSiSn 层生长速率从 0.015 到 0.05 nm/s 变化。外延生长在 Si(100) 衬底上在 150-450°С 的温度范围内进行,Sn 含量为 0% 到 20%。不仅获得了单个 GeSiSn 层,还获得了包含 GeSiSn/Si 异质结的多层周期性结构。首先,沉积 GeSiSn 层,然后在 400-500°С 的生长温度下覆盖 10 纳米的 Si 层。控制形态和表面结构变化以及研究生长机制的主要技术是高能电子衍射(RHEED)的反射。 RHEED 模式在生长过程中记录在摄像机上。然后,选择一个轮廓以及其中一个晶体学方向,并创建该轮廓在时空坐标中的强度变化。 RHEED 时空强度分布分析使我们能够研究二维生长、上层结构变化和三维岛屿形成的机制。从二维到三维生长(2D-3D 过渡)的转变时刻由 RHEED 图案强度以及其中一根杆在体积反射出现的方向上的时间依赖性确定。基于 2D-3D 过渡确定方法创建了临界 2D-3D 过渡厚度对具有固定 Ge 含量的 GeSiSn 含量的依赖性。基于这些依赖性,GeSiSn 假晶层厚度设置在多层结构中,并创建了具有 GeSiSn 纳米岛阵列的层。在超高真空设备 Omicron-Riber 上通过扫描隧道显微镜 (STM) 分析形态和表面结构。使用 ACTON 2300i 单色器和基于 InGaAs 光电二极管阵列的冷却 OMA-V 检测器通过光致发光 (PL) 光谱研究样品光学特性,灵敏度带为 1.1 至 2.2 μm。为了激发光致发光,使用了 Nd:YAG 激光辐射 (532 nm)。
结果与讨论
研究了在 150°С 的温度下在 0 到 16% 的 Sn 含量范围内生长的薄 GeSiSn 膜。由于 GeSiSn 和 Si 晶格参数之间的不匹配,在 GeSiSn 层沉积过程中会发生应变积累。在一定厚度处观察到从 2D 到 3D 过渡的过渡。在 Ge0.6Si0.28Sn0.12 生长示例中确定 2D-3D 转变的程序如图 1 所示。在 Ge0.6Si0.28Sn0.12 薄膜之前,有来自 Si 表面的初始 RHEED 图案沉积(图 1a),由 Ge0.6Si0.28Sn0.12 岛阵列和润湿层形成的最终 RHEED 图案(图 1c),以及箭头所指垂直剖面的时空强度分布图 1a 中的水平剖面强度(图 1b 中时空强度分布上指示的水平剖面)对 Ge0.6Si0.28Sn0.12 膜厚度的依赖性(图 1b)。 2D-3D 过渡矩是通过在强度急剧增加的区域绘制强度图的切线(图 1b)来确定的。这种方法被普遍接受[21]。
<图片>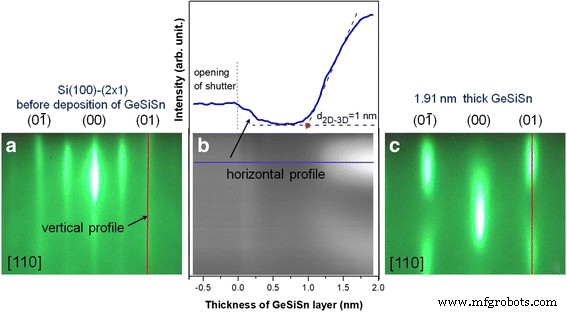
GeSiSn 薄膜生长过程中 2D-3D 过渡矩的确定:a 显示了 Ge0.6Si0.28Sn0.12 生长之前 Si(100)-(2×1) 表面的 RHEED 图案,b 灰度中垂直轮廓的时空强度分布和水平轮廓对沉积的 Ge0.6Si0.28Sn0.12 薄膜厚度的强度依赖性。配置文件由 (a ) 和 (b ) 和 c 1.91nm厚的Ge0.6Si0.28Sn0.12沉积后的最终RHEED图案
使用上述 2D-3D 过渡技术构建了具有固定 Ge 含量和 0 至 16% 的 Sn 含量的 GeSiSn 薄膜的关键 2D-3D 过渡厚度对组成的依赖性(图 2)。早些时候,发表了 GeSiSn 薄膜在 150-450°С 温度范围内,在 GeSiSn 和 Si 之间不同晶格失配的情况下的动力学图 [14]。在动力学图分析的基础上,确定了 150°С 的最佳温度,在该温度下,临界 2D-3D 转变厚度达到最大值并且 Sn 偏析得到抑制。曲线下方对应于温度和成分的临界 2D-3D 转变厚度的 GeSiSn 膜厚度值决定了伪晶膜的存在区域。在曲线上观察到临界 2D-3D 过渡厚度随着 Sn 含量从 0% 增加到 16% 的减少(图 2)。这种行为可以用应变效应来解释。 Sn 含量从 0 增加到 16%,例如 Ge0.6Si0.28Sn0.12 生长,导致 Ge0.6Si0.28Sn0.12 和 Si 之间的晶格参数失配从 2.5% 增加到 5.6%,分别减少了时间,从而减少了向三维纳米岛的过渡厚度。 Ge含量为30%的曲线上出现的、Sn含量为3%~10%到最后观察到的特征的性质完全不清楚。知道临界 2D-3D 过渡厚度的大小,就有可能获得假晶 GeSiSn 薄膜并将它们用于具有 GeSiSn/Si 异质结的多层周期性结构中。在我们的实验中,确定临界 2D-3D 过渡厚度的精度为 0.06 nm,这主要是由源操作不稳定导致的 Si 流速保持不准确决定的。
<图片>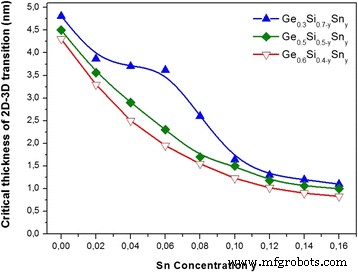
临界 2D-3D 过渡厚度取决于 GeSiSn 膜成分的几个固定值,Sn 含量从 0 到 16%,生长温度为 150°С
根据之前获得的动力学图选择假晶层厚度 [16] 以及临界 2D-3D 过渡厚度对组成的依赖性(图 2)不仅允许生长单个 GeSiSn 层,还允许使用这些层在多层周期结构中。在周期性的 GeSiSn/Si 结构中,GeSiSn 层被 Si 层覆盖,问题是由于 Sn 偏析到 Si 表面而产生的。取决于 Sn 表面浓度,Sn 偏析导致表面重建和整个系列超结构的出现。有必要对 Si(100) 和 Ge(100) 上的 Sn 生长过程中的表面重建进行研究,以便了解哪种 Sn 涂层对应于 RHEED 图片中观察到的超结构。上部结构变化的相图建立在 100-750°С 的温度范围内。在 [17] 中首次提出了类似的 Si(100) 上的 Sn 生长图。上田等人。在室温下沉积锡,然后退火。他们仅在对薄膜进行退火后才观察到上部结构。在我们的实验中,Sn 在 100°С 的温度下沉积,并在重建的 Si(100–(2 × 1) 表面上获得。温度升高至 750°С 导致在表面形成超结构系列表面(图 3)。在 [18] 中通过光电子能谱研究了吸附在 Si(100)表面上的 Sn 原子对 Sn-Si 结合能的位置影响。观察到 Sn-Si 结合能降低与Sn 覆盖增加。因此,在 Si(100) 上 Sn 生长过程中发生的所有重建都可以用表面系统能的减少来解释。向三维生长的转变与应变的积累有关Sn 和 Si 之间的晶格参数失配为 19%。在 [17] 中观察到 3.2 ML(单层)Sn 厚膜的多晶膜外观。多晶膜的形成是由 Sn 膜的低沉积温度引起的。同样的推理与 Sn 有关Ge(100) 表面的生长。目前,关于Ge(100)上Sn超结构的贡献尚未见文献报道。
<图片>
生长过程中上层建筑变化的相图:a Si(100) 和 b 上的锡 Ge(100)上的Sn
图中所示的上部结构随着温度的升高和降低而出现。这些相图有助于确定 GeSiSn 层上 Si 生长时表面的 Sn 浓度。在与相图中显示的温度不同的温度下,可以观察到在周期性结构生长期间出现在 Si 表面上的超结构。在 400-500°С 的温度下,Si 层沉积在 GeSiSn 表面上;然而,可能会出现图 3 所示的整个温度范围内具有特征的上部结构。使用 GeSiSn/Si 异质结创建结构需要防止双域 (5 × 1) 超结构的形成,这与 Sn 偏析和具有假晶层的多层周期性结构形成中的障碍有关(图 4a) )。在 GeSiSn 层上的 Si 生长中抑制 Sn 偏析的最简单方法是分两个阶段的 Si 生长。第一阶段涉及室温下 1-2 纳米厚的硅层沉积。在 400-500°С 的温度下,Si 的进一步生长继续。该温度由 GeSiSn 层中的 Sn 含量决定。多层周期结构中GeSiSn层上Si生长过程中发生的主要超结构系列包括(2 × 1) + (2 × N)、c(8 × 4)、(4 × 1)、(6 × 1) , 和 (5 × 1)。此外,在硅表面观察到双域(10 × 1)超结构(图4b)。这种超结构没有出现在 Si 和 Ge 上 Sn 生长的实验中,但可以说它对应于最小的 Sn 涂层,因为它在 400-500°С 的温度下短暂退火时消失了,并且 (2 × 1)超结构出现,这是Si表面的特征。
<图片>
在方位角[110]方向多层周期结构中在GeSiSn层上生长Si时观察到的超结构:a (5 × 1) 和 b (10 × 1)
获得了包含假晶层或 GeSiSn 纳米岛阵列的周期性结构。使用GeSiSn薄膜形态状态的动力学图,研究了多层周期结构中的GeSiSn岛阵列。展示了 Ge0.75Si0.2Sn0.05 表面的 STM 图片,其中纳米岛阵列在第一期(图 5a)和第五期(图 5b)中,扫描尺寸为 400 nm × 400 nm。岛阵列是在 250°С 的生长温度下获得的。岛数大小分布的直方图也如图5所示。密度为5.18 × 10 11 的岛 cm −2 和平均尺寸 8.95 nm 显示在图 5c 中。沉积的 Ge0.75Si0.2Sn0.05 膜厚为 1.78 nm。第5期平均岛大小约为4 nm,岛密度达到1.8 × 10 12 sm −2 在 Ge0.75Si0.2Sn0.05 膜的有效厚度为 1.89 nm 时,它遵循图 5d 中的直方图。密度增加 3.5 倍而岛尺寸减小 2 倍可能与随着周期数增加在 Si 表面上的 Sn 分数增加有关。这一说法通过在 GeSiSn 层上的 Si 膜生长过程中通过 RHEED 图案观察到的超结构变化得到证实,从 (2 × 1) 和 (2 × N) 到 c(8 × 4) 表面结构。 c(8 × 4) 超结构的形成发生在 Sn 在 Si 上生长的过程中,从 0.4 单层 (ML) 的覆盖厚度开始,生长温度为 400°С。随着生长温度降低到 100°С,我们可以增加岛密度,但表面质量更差。生长温度增加到超过 250°С 会增强 Sn 偏析。因此,具有岛阵列的GeSiSn层的最佳生长温度范围为150-250°С,在GeSiSn润湿层生长处观察到镜面反射振荡,对应于2D生长机制。
<图片>
Ge0.75Si0.2Sn0.05 表面扫描尺寸为 400 nm × 400 nm 的 STM 图像:a 第一期Ge0.75Si0.2Sn0.05表面,b 第五期Ge0.75Si0.2Sn0.05表面; Ge0.75Si0.2Sn0.05薄膜基片尺寸上岛数分布直方图:c 在第一阶段(Ge0.75Si0.2Sn0.05 膜厚等于 1.78 nm)和 d 第五期(Ge0.75Si0.2Sn0.05膜厚为1.89 nm)
通过透射电子显微镜(TEM)研究了多层结构的结晶完善性。具有 Ge0.5Si0.45Sn0.05/Si 异质结和 25 nm 周期的多层结构的 TEM 图像如图 6 所示。从 TEM 数据可以得出结论,我们的样品不包含穿透位错和是完美的结晶,具有尖锐的界面。多层周期性结构中的假晶 GeSiSn 薄膜状态、晶格和应变在 [14] 中基于借助 TEM 获得的数据分析进行了讨论。 GeSiSn 膜的组成是通过设定 Si、Ge 和 Sn 的流动来确定的。 Si、Ge和Sn的生长速率用石英厚度计测量。 GeSiSn 膜成分通过 X 射线衍射法确定。分析表明设定成分与实测成分一致。
<图片>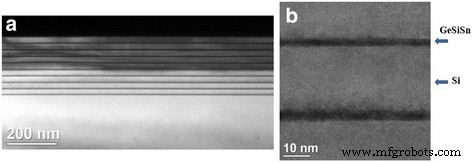
一 来自多层结构的 TEM 图像,包括周期为 25 纳米的 Ge0.5Si0.45Sn0.05 异质转变。 b 相同结构的高分辨率TEM图像
通过具有不同 Sn 含量的结构的光致发光研究了具有 GeSiSn 层的多层周期性结构的光学性质。这些结构在 0.6-0.8 eV 范围内展示了它们的光致发光,这对应于 1.45-2 μm 的波长范围(图 7)。获得强度最大值为 0.78、0.69 和 0.65 eV 的光致发光光谱。它们对应于 1.59、1.8 和 1.9 微米的波长,分别在 3.5、4.5 和 6% 的 Sn 下观察到。 GeSiSn 层中 Sn 含量的增加导致光学跃迁的能量减少和光致发光强度增加。对于 GeSiSn 固溶体层中较高的 Sn 含量,强度增加可能是由量子阱的深度增加引起的。为了在超过 2 μm 的波长范围内前进,需要增加 GeSiSn 层中的 Sn 含量。为了确定在发光光谱中观察到的光学跃迁,需要计算GeSiSn/Si异质结构的能带图。
<图片>
假晶GeSiSn层中Sn含量为3.5%、4.5%和6%的多层周期性结构的光致发光光谱
GeSiSn/Si 异质结构带图是使用模型实体理论的方法计算的 [20]。在这个模型中,形成异质结的两种半导体都需要将其置于单一“能量”尺度上,以确定异质结中的能带位置。异质结中 Ge/Si 异质结构的价带隙值是众所周知的 [22],等于 0.54 eV;此外,Ge价带的能量高于Si价带。 Ge 和 Sn 之间的带隙从 [23] 中提供的模型中得知,为 0.69 eV [24]。因此,Si/Si 1-x-y 异质界面上的带隙值 葛x Sn y 异质结构可以写成:
$$ {E}_{v, av}=0.54x+1.23y $$由于半导体价带是由重空穴和轻空穴的子带形成的,也是由自旋轨道相互作用分裂出来的子带形成的;然后,价带的位置 (E v,av ) 在三个子带中取平均值用于确定异质结构带图的带隙和构造。为了确定重空穴子带位置和轻空穴子带位置,以及由自旋轨道相互作用分裂出的子带,使用以下表达式:
$$ {\displaystyle \begin{array}{l}{E}_{\mathrm{HH}\left(\mathrm{LH}\right)}={E}_{v, av}+{\Delta} _0/3\\ {}{E}_{\mathrm{SO}}={E}_{v, av}-2/3{\Delta}_0\end{array}}, $$其中 HH、LH 和 SO 指数表示重空穴子带和轻空穴子带,以及自旋分裂子带。 Δ0 值表示半导体中的自旋轨道分裂能。确定异质结中的价带子带位置后,相应导带谷的位置由下式确定:
$$ {E}^n={E}_{\mathrm{Ge}}^n\left(1-xy\right)+{E}_{\mathrm{Si}}^nx+{E}_{\ mathrm{Sn}}^ny-{b}_{\mathrm{Si}\mathrm{Ge}}^nx\left(1-xy\right)-{b}_{\mathrm{Sn}\mathrm{Ge }}^ny\left(1-xy\right)-{b}_{\mathrm{Si}\mathrm{Sn}}^n xy, $$其中索引 n =Γ , L , 和 X 表示相应的谷\( {b}_{\mathrm{SiGe}}^n \)、\( {b}_{\mathrm{SnGe}}^n \) 和\( {b}_{\mathrm {SiSn}}^n \)––“弯曲”参数,考虑到带隙宽度与线性定律的偏差,\( {E}_{\mathrm{Ge}}^n \),\( { E}_{\mathrm{Si}}^n \) 和 \( {E}_{\mathrm{Sn}}^n \)––Ge、Si 和 Sn 在相应谷中的带隙。几乎所有参数都取自 [24]。波谷 L 的弯曲参数 和 Г 摘自[25]。
在确定异质结中所有感兴趣带的位置后,我们考虑了它们在变形影响下的位移。变形对带隙的影响通过变形势常数来考虑[26]。由于二维层是假晶的,在我们的例子中,标准方法用于确定变形,例如,在 [26] 中描述:量子阱平面中的应变可以从 ε xx(yy) =ε ǀǀ =(a GeSiSn - a Si)/a Si,其中 a ——相应材料的晶格常数。在垂直于量子阱平面的方向上,应变值 ε zz =−2(С 12/С 11)ε xx 可以通过C确定 12 和 C 结晶化合物的 11 个弹性模块。由二次关系确定固溶体晶格常数:
$$ {a}_{\mathrm{Ge}\mathrm{SiSn}}={a}_{\mathrm{Ge}}\left(1-xy\right)+{a}_{\mathrm{Si} }x+{a}_{\mathrm{Sn}}y+{b}_{\mathrm{Si}\mathrm{Ge}}^{\hbox{'}}x\left(1-x\right)+{ b}_{\mathrm{Sn}\mathrm{Ge}}^{\hbox{'}}y\left(1-y\right), $$其中 a 哥,a 硅,a Sn––Ge、Si 和 Sn 晶格参数 [24], \( {b}_{\mathrm{SiGe}}^{\hbox{'}} \)=− 0.026 Å, \( {b}_{ \mathrm{SnGe}}^{\hbox{'}} \) =0.166 Å––«bowing» 参数,考虑到与 Vegard 定律的偏差。
根据能带图计算,PL峰对应于Si的X谷或GeSiSn的Δ4谷与GeSiSn层中的重空穴能带之间的带间跃迁(图8)。
<图片>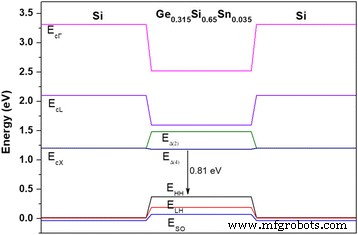
Si/Ge0.315Si0.65Sn0.035/Si异质复合带图
结论
确定了具有固定 Ge 含量和 Sn 含量的 GeSiSn 层组成的关键 2D-3D 过渡厚度依赖性,在 150°С 的生长温度下从 0 到 16% 不等。制作了 Sn 在 Si(100) 和 Ge(100) 上外延生长的超结构相图。具有伪晶层和密度高达1.8 × 10 12 的GeSiSn岛阵列的多层周期性结构 sm −2 获得了。在 GeSiSn 层上 Si 生长期间的多层周期性结构中,首次观察到 (10 × 1) 双畴超结构,在轻微退火后转变为 (2 × 1) 超结构。 GeSiSn/Si 周期性结构在 0.6-0.8 eV 范围内展示了它们的光致发光,这对应于 1.45-2 μm 的波长范围。基于具有假晶 Ge0.315Si0.65Sn0.035 层的结构的能带图计算,PL 峰对应于 Si 的 X 谷或 GeSiSn 的 Δ4 谷与重空穴带之间的带间跃迁GeSiSn 层。长波领域的进一步研究需要研究具有大Sn含量的结构的光学特性。
缩写
- CVD:
-
化学气相沉积
- MBE:
-
分子束外延
- ML:
-
单层
- PL:
-
光致发光
- RHEED:
-
反射高能电子衍射
- STM:
-
扫描隧道显微镜
- TEM:
-
透射电子显微镜
纳米材料


