关于限制具有高霍尔迁移率的非常薄的非晶态 Sn 掺杂 In2O3 薄膜中载流子传输的因素的新见解
摘要
我们证明了质量密度和尺寸效应是限制非常薄的非晶 Sn 掺杂 In2O3 (a -ITO) 电影。 一 - 各种厚度的 ITO 薄膜 (t ) 范围从 5 到 50 nm 被沉积在无碱玻璃基板上,而没有通过直流电弧放电的反应等离子体沉积有意加热基板。 一 -带有 t 的 ITO 薄膜 超过 10 nm 显示出高霍尔迁移率 (μ H) 大于 50 cm 2 /V s。对于 5 纳米厚的 a -ITO薄膜,我们发现μ H高达40 cm 2 /V s。 X 射线反射率测量结果表明,质量密度 (d m) 确定a中的载体运输 -ITO 薄膜。对于 a -带有 t 的 ITO 薄膜 大于 10 nm,d m 值高达 7.2 g/cm 3 , 而 a -带有 t 的 ITO 薄膜 小于 10 nm 具有低 d m 范围从 6.6 到 6.8 g/cm 3 .对 a 给出了从尺寸效应对载体传输的定量新见解 -带有 t 的 ITO 薄膜 小于 10 nm。本研究表明t的比值 表示载流子电子的自由程μ H.
介绍
Sn掺杂的氧化铟(ITO)主要应用于透明导电氧化物(TCO)薄膜。氧化铟 (In2O3) 具有方方锰矿晶体结构(空间群 Ia- 3, number 206),它包括含有一些氧缺陷的扭曲的 InO6 八面体。这是一种产生结构空位 (Vstr) 的周期性结构。相邻多面体之间共享氧(O)和结构空位,结果多面体在由O占据的角处连接,此后称为角共享。另一方面,相邻多面体之间共享两个O原子,结果多面体沿整个边缘连接,以下称为边缘共享。边缘共享结构允许 5s 的波函数之间有很大的重叠 和 5p 由于 In 原子之间约 0.334 nm 的短原子间距离,In 原子的价电子的轨道可以提供高载流子迁移率 [1, 2]。特别是,为了将光学透明范围从可见光到近红外光谱范围扩大到太阳能电池等应用,高霍尔迁移率 (μ H) 超过 100 cm 2 最近报道了氢化[3]和Ce掺杂的氢化[4] In2O3基多晶TCO薄膜的/V s 。
大多数关于 ITO 薄膜的论文都集中在它们作为典型厚度 (t ) 大于 50 nm [5]。事实上,由于在太阳能电池中使用了 TCO 层作为抗反射层,t 固定为大约 75 nm [2]。对于这个值,载体传输特性可以描述为散装材料的特性。另一方面,关于具有 t 的非常薄的 ITO 薄膜的论文很少 小于 50 nm,因为较薄的 TCO 薄膜具有高薄层电阻,使其不适用于应用。重里等人。报告了非常薄的非晶相 ITO (a -ITO) 薄膜在生长的初始阶段通过溅射沉积 [6]。最大μ H 为 40 cm 2 /V s 代表 a -带有 t 的 ITO 薄膜 20 nm,μ H 随着 t 的减少 .还报道了脉冲激光沉积(PLD)沉积薄膜生长的初始阶段[7],该文章侧重于临界厚度,没有讨论详细的传输机制。
已经讨论了退化多晶ITO薄膜的散射机制,包括晶界和晶内散射机制,这些散射机制由各种散射中心如声子、电离杂质和中性杂质引起[8]。相反,对于 a -没有晶界的 ITO 薄膜,应考虑基于 In-O 多面体的短程有序网络的随机性。非晶锌掺杂 In2O3 (a -IZO) 薄膜 [9] 是基于缺陷模型 [10] 的报道。宇都野等人。研究了 a 的键合状态 - 并通过掠入射 X 射线散射的模拟分析使 In2O3 结晶 [11]。布赫霍尔茨等人。关注 a 的质量密度 -In2O3 薄膜 [12]。然而,全面了解a中限制载体运输的主要因素 -In2O3相关系统,特别是非常薄的薄膜,仍然缺乏,因为没有直接显示散射因子来源的报告。
在这项工作中,我们使用带有直流 (DC) 电弧放电的离子镀,其产品名称为已商业化使用的反应性等离子体沉积 (RPD) [13]。具有高增长率 [14, 15] 的 RPD 能够制造具有 t 均匀空间分布的薄膜 在尺寸为 1.5 × 1.5 m 2 的大型基板上制备 .此外,我们最近制造了厚度为 10 nm 的致密 ZnO 薄膜 [16]。因此,预计 RPD 的使用能够可靠地研究极薄 a 中的载流子传输 -ITO薄膜实现高μ H TCO。
在本文中,我们报告了非常薄的 TCO 薄膜(t <50 nm) 基于 a -具有高μ的ITO薄膜 H 通过使用 RPD。我们发现质量密度 (d m) 是描述 a 载体传输特性的最重要因素 -ITO系统。我们还揭示了 μ 之间的关系 H 和 d 米。
方法
使用图 1 所示的 RPD 设备(住友重工有限公司)在无碱玻璃基板(Corning Eagle XG)上生长 ITO 薄膜。 正电氩(Ar + ) 压力梯度 Uramoto 枪 [17] 产生的离子和电子到由 In2O3 制成的源材料,其中 5 wt.% 对应于 4.6 at.% 的 SnO2 含量,导致源升华。随后,一些蒸发的原子如 In、Sn 和 O 变成带正电的离子,如 In + , Sn + , 和 O + 离子,分别作为与电子相互作用的结果。使用以圆柱形形式(高度为 40 mm,直径为 30 mm)压制并烧结的源材料。引入沉积室和等离子体枪的氩气流速分别为 25 和 40sccm。 a -带有 t 的 ITO 薄膜 使用 20 或 30 sccm 的氧气 (O2) 气体流速 (OFR) 制造范围从 5 到 50 nm 的材料,而无需有意加热基板(由于电弧等离子体暴露,基板温度低于 70 °C )。生长过程中的总压力为0.3 Pa。典型的生长速率为3.6 nm/s。厚度t 通过改变基板的移动速度来控制[18]。
<图片>
带直流电弧放电的RPD示意图
X 射线衍射 (XRD) 和 X 射线反射率 (XRR) 测量是使用具有 Cu-Kα X 射线源(波长为 0.15405 nm)的 Rigaku ATX-G 衍射仪进行的,以确定 的结构特性一个 -ITO 薄膜。 XRD 和 XRR 测量均采用相同的 2θ /ω 配置。通过对 XRR 测量结果的分析来评估样品的粗糙度和厚度。通过使用 Dektak 6M stylus 表面轮廓仪(Bruker Corporation)进行厚度的辅助测量。使用Nanometrics HL5500PC测量系统在van der Pauw几何中评估室温下的电性能。
这项工作中使用的 RPD 设备已被用作大规模生产用途。制造的薄膜的空间均匀性和物理特性(包括传输和厚度)的可重复性已经确保在 ± 5% 以内 [19, 20]。需要注意的是,单次测量得到的所有数据点都具有足够的可靠性。
结果与讨论
a 的质量密度 -ITO 薄膜
所有样品薄膜的 XRD 测量均未检测到峰,这表明非晶相薄膜。 XRR 是一种强大的无损技术,用于研究 t 和 d m 代表 a -ITO 薄膜。在这项工作中,t 和 d m 是通过使用基于具有 a 的两层模型的 XRR 测量结果来估计的 -ITO 薄膜表面和粗糙界面(ITO/玻璃)[12]。考虑到 d 从 XRR 剖面的临界角导出的 m 对应于薄膜表面附近的质量密度,在这项工作中,我们确定了 d m 值来自全反射的振荡幅度。结果使我们能够研究 d 之间的关系 m 和通过霍尔效应测量确定的整个薄膜的平均载流子迁移率。
图 2 显示了 a 的 XRR 光谱 -带有 t 的 ITO 薄膜 5.1、20.9 和 47.6 nm 的生长在 20 sccm 的 OFR 下。对于所有 a -ITO 薄膜,测得的 XRR 曲线与两层模型非常吻合,如图 2 中的黑色实线曲线所示。表 1 总结了 t , d m,表面粗糙度r s 和界面粗糙度 r i 代表 a -通过 XRR 测量确定的 ITO 薄膜。厚度 t 的所有 ITO 薄膜与触针表面轮廓仪估计的那些具有很好的一致性。 r 的值 s 和 r 无论 t,我都在 1 nm 左右 和 OFR。图 3 还显示了 d m,精度为± 0.1 g/cm 3 [21] 作为 t 的函数 ,这是从 XRR 测量中评估出来的。 a -带有 t 的 ITO 薄膜 超过 10 nm 表现出 d 米约 7.2 g/cm 3 ,这与块状 ITO 几乎相同 [12]。 d m 代表 a -带有 t 的 ITO 薄膜 低于 7 nm 随着 t 的减小而突然减小 无论 OFR 是什么; d 5 纳米厚 a 的 m 值 -OFR 为 20 和 30 sccm 的 ITO 薄膜分别为 6.6 和 6.8 g/cm 3 , 分别。
<图片>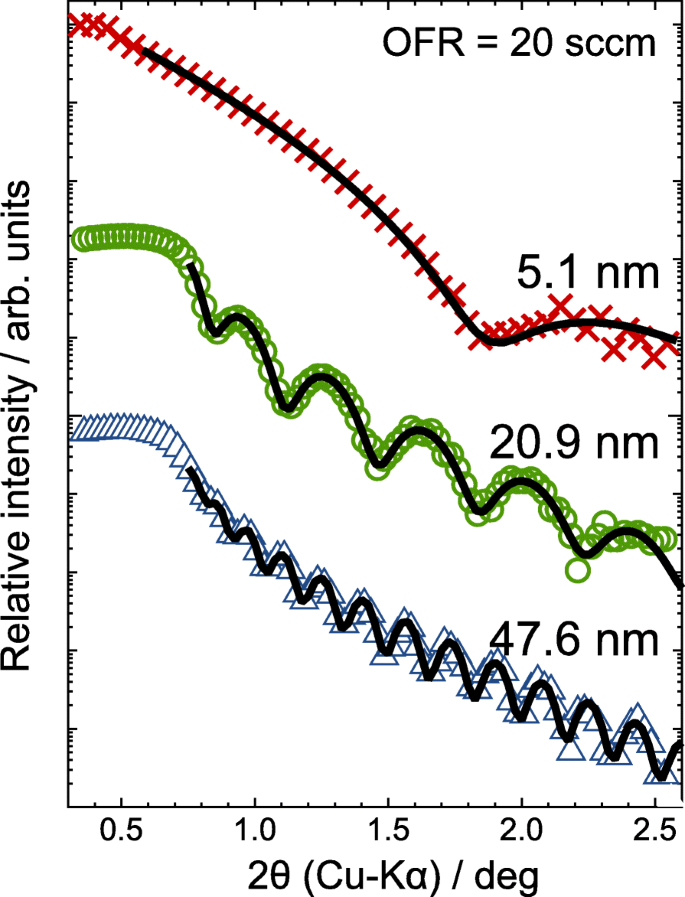
a 的 XRR 数据(十字、圆形和三角形)和拟合曲线(实线) -在20 sccm的OFR下生长的厚度为5.1、20.9和47.6 nm的ITO薄膜
<图片>
质量密度d m 来自 a 的 XRR 测量结果 -在 20 sccm(三角形)或 30 sccm(圆形)的 OFR 下生长的 ITO 薄膜作为薄膜厚度的函数t
传输属性
图4显示(a)电阻率ρ , (b) 载流子密度 n e, 和 (c) μ H 代表 a -ITO 薄膜在室温下通过霍尔效应测量确定的 OFR 为 20 和 30 sccm。在任何给定的 t , n e 代表 a -OFR 为 20 sccm 的 ITO 薄膜比 a 大 -ITO 薄膜的 OFR 为 30 sccm,而 μ H 代表 a -OFR 为 20 sccm 的 ITO 薄膜小于 a -OFR 为 30 sccm 的 ITO 薄膜。这表明电离杂质散射机制是决定n的因素之一。 e依赖μ H 代表 a -ITO 薄膜。以上建议 n 的 OFR 依赖 e 意味着在以下假设下氧空位可以作为施主缺陷发挥作用:(1)与密度的 OFR 依赖性相比,Sn 掺杂剂的残留量和 Sn 施主的掺杂效率的 OFR 依赖性非常小氧空位的数量和(2)产生浅供体能级的氧空位的密度随着 OFR 的增加而降低。注意对于 t 小于 30 nm,发现 μ H 随 n 增加 e,不能用常规的电离散射来解释。这意味着载体运输受另一个因素控制,例如尺寸效应,这将在后面讨论,对于 a -ITO 薄膜。
<图片>
一 电阻率ρ , b 载流子浓度n e 和 c 霍尔迁移率μ a 的 H -在 20 sccm(三角形)或 30 sccm(圆形)的 OFR 下生长的 ITO 薄膜作为厚度的函数 t .所有值均在室温下获得
在溅射 [6] 和 PLD [7] 的情况下,报告的临界厚度为 4 nm,其中三维 (3D) 工艺占主导地位,并且岛的聚结没有完成。在这样的薄膜中,μ H 在临界厚度附近会非常小。对于 a -RPD沉积的ITO薄膜,相对减少μ H 在 t 与a相比,5 nm的小于30% -带有 t 的 ITO 薄膜 大于 10 nm。这表明 RPD 生产的 ITO 薄膜通过二维 (2D) 工艺表现出生长,这已经在 ZnO 薄膜中得到证实 [16]。
决定μ的主要特征 薄膜的 H:质量密度和平均自由程
图 5 显示了 μ 的依赖性 H on d m 代表 a -OFR 为 20 和 30 sccm 的 ITO 薄膜。我们发现 μ H 和 d m 与 0.73 的高相关系数具有很强的正相关性。掠入射X射线散射模拟分析结果表明a -In2O3 比晶体 In2O3 具有更多的角共享 In-O-In 键(图 6a)[11, 12, 22]。如果我们假设 a -ITO 薄膜还具有比结晶 ITO 薄膜更多的角共享 In-O-In 键(模型见图 6b),在两个边缘共享的 O- 中产生一个 O 原子(Vadd)的附加空缺缺陷O促进了多面体从边共享到角共享的变化。随后,多面体可以沿边旋转,从而分离相邻的多面体,导致不相交的角共享多面体(参见图 6c 获得的模型)。这将导致 a -具有低 d 的 ITO 薄膜 m 连同减少的 In-O 配位数,对应于非常薄的 a - 厚度小于 10 nm 的 ITO 薄膜。在此类薄膜中,角共享 In-O 多面体之间的 In-In 原子间距离增加。这减少了 In valence 5s 的波函数的重叠 和 5p 轨道,导致低载流子传输以及由 n 提供的多余电子的转换 型缺陷,例如 Sn 取代 In 原子和 O 空位,从离域状态到局部状态。我们确认减少了 n e 和 μ H 表示 5 纳米厚的 a -ITO 薄膜分别如图4b 和 c。上述讨论结合实验结果得出的结论是a的载流子输运 -In2O3 薄膜受 d 的强烈控制 m,决定了角共享 In-O 多面体的比例。
<图片>
霍尔迁移率μ之间的关系 H 和质量密度 d a 中的 m -ITO 薄膜以 20 sccm(三角形)或 30 sccm(圆形)的 OFR 生长。实线表示对所有数据的线性拟合及其相关系数 R 指定
<图片>
a的局部结构模型 结晶 ITO,b 一 -ITO 和 c 很薄a -ITO添加了O空位缺陷(Vadd),导致边缘共享到角共享的转变
除了上述d的作用 m 关于载体运输,垂直尺寸的影响,即 t , a 应考虑载流子移动性 -带有 t 的 ITO 薄膜 小于 10 nm。我们估计了载波的平均自由程 (MFP; λ ) 由图 4 所示的输运性质得出。在费米气体模型的基础上,载流子的费米速度 v F, 可以写成 v F =(h /2米 *)(3n e/π ) 1/3 [23],其中 h 和 m * 分别表示普朗克常数和自由电子的有效质量。使用载流子迁移率公式 (μ =eτ /米 *,其中 e 和 τ 分别为载流子的元素电荷和散射时间),λ 可以通过
$$ \lambda ={v}_{\mathrm{F}}\tau =\frac{\mu h}{2e}{\left(\frac{3{n}_{\mathrm{e}}}{ \pi}\right)}^{1/3}。 $$在本研究中,我们取 μ H 为 μ 并假设该模型可以用于 a -ITO 薄膜。图 7a 显示了 λ 作为 t 的函数 .随着 t 的增加 高达 10 nm,λ 急剧增加。随着t的进一步增加 , λ 缓慢增加,然后趋于保持几乎恒定。 λ 的这种行为 由于 n 之间的效应补偿,不依赖于 OFR e 和 μ H. 为了阐明上述尺寸效应,μ H 被绘制为 t/λ 的函数 ,在图 7b 中。这种关系清楚地表明在 t/λ 处有一个斜率的弯曲 ~ 2,对应于t =10 nm。图 7b 中的斜率 [A] 是所有具有 t 的数据的拟合线 ≤ 10 nm 和 [B 20 sccm] 和 [B 30 sccm] 这两个是 t 的数据 ≥ 10 nm,分别在 20 和 30 sccm 的 OFR 下生长。很明显,这些斜率具有大于 0.75 的高相关系数。这表明 λ 的依赖 关于 a 的传输特性 -发现 ITO 薄膜在 t 发生变化 10 nm。考虑到 λ 与 t 相当 对于非常薄的a -ITO 薄膜,我们得出结论,载流子在表面和界面上的反射也应该是决定 μ 的主要因素 H.
<图片>
一 平均自由程λ 作为薄膜厚度的函数 t 和 b 霍尔迁移率μ之间的关系 H与厚度之比t λ , t/λ , 对于 a -以 20 sccm(三角形)或 30 sccm(圆形)的 OFR 生长的 ITO 薄膜。实线[A]和点划线[B;对于每个 OFR] 表示 t 数据的线性拟合 =5–10 nm 和 t =10–50 nm,分别。相关系数R 为所有拟合线指定
结论
我们成功制造了非常薄的a -具有高μ的ITO薄膜 使用 RPD 在玻璃基板上 H。相对较高的 d m 与高 μ H 表示小的 t 表明几乎是二维的初始增长。我们发现 d m 是限制 a 载体传输的主要因素 -ITO 系统,这被认为是由于在基于边缘共享 In-O 多面体的网络矩阵中存在角共享 In-O 多面体造成的。对于 a -带有 t 的 ITO 薄膜 小于 10 nm,载流子传输的特性可以用 d 来表征 m 和 λ 对于运营商。另一方面,对于 a -带有 t 的 ITO 薄膜 大于 10 nm 时,载流子传输可以主要在体 ITO 框架内描述,而没有载流子的表面或界面散射。作为下一步,我们将确定 a 的晶格结构 -各种厚度的ITO薄膜。
缩写
- 二维:
-
二维
- 3D:
-
三维
- a -In2O3 :
-
非晶相氧化铟(III)
- a -ITO:
-
非晶相掺锡氧化铟
- a -IZO:
-
非晶相掺锌氧化铟
- DC:
-
直流电
- ITO:
-
锡掺杂氧化铟
- 多功能一体机:
-
载流子的平均自由程
- OFR:
-
沉积过程中的氧气流速
- PLD:
-
脉冲激光沉积
- RPD:
-
反应等离子体沉积
- TCO:
-
透明导电氧化物
- Vadd :
-
新增O空位缺陷
- Vstr :
-
结构空缺
- XRD:
-
X射线衍射
- XRR:
-
X射线反射率
纳米材料
- 集装箱 4.0:公海上的智能运输
- 使用新草稿树脂进行快速 SLA 原型制作
- 与铜原子的心脏协调一致
- 物联网预示着商业街的新时代
- 使用基于 AFM 尖端的动态犁式光刻在聚合物薄膜上制造具有高通量的纳米级凹坑
- 大面积、高灵敏度 SERS 基板,采用微升级溶液工艺涂覆银纳米线薄膜
- 通过原子力显微镜研究聚苯乙烯薄膜的附着力和玻璃化转变
- 控制微观结构的有机-无机钙钛矿 CH3NH3PbI3 薄膜的阻抗分析
- GaAs/AlAs 超晶格点缺陷的第一性原理研究:相稳定性以及对能带结构和载流子迁移率的影响
- 具有高电导率的拓扑绝缘体纳米片中极其增强的光电流响应
- 作为锂和钠离子电池性能稳定阴极的无定形氧化钒薄膜
- 来自第一性原理研究的 SiAs 和 SiAs2 单层中的应变可调带隙和高载流子迁移率


