具有嵌入式载流子复合结构的新型高保持电压 SCR,具有闩锁免疫和稳健的 ESD 保护
摘要
提出了一种用于静电放电 (ESD) 保护的新型 CMOS 工艺兼容高保持电压可控硅整流器 (HHV-SCR),并通过仿真和传输线脉冲 (TLP) 测试进行了演示。新引入的空穴(或电子)复合区 H-RR(或 E-RR)不仅通过 N+(或 P+)层重组寄生 PNP(或 NPN)晶体管基极中的少数载流子,而且提供额外的复合以消除通过在H-RR(或E-RR)中新增P+(或N+)层表面雪崩载流子,进一步提高保持电压(V H)。与实测的V相比 h 的 1.8 V 低压触发可控硅整流器 (LVTSCR),V HHV-SCR 的 h 可以增加到 8.1 V,同时保持足够高的故障电流 (I t2> 2.6 A)。品质因数(FOM)提高了四倍以上。
介绍
随着半导体集成技术的发展和半导体器件特征尺寸的不断小型化,ESD引起的器件损坏越来越严重。以大芯片面积为代价,报道了具有正常 ESD 稳健性的二极管和栅极接地 N 沟道 MOSFET (ggNMOS) 等传统器件 [1]。为了以更小的器件尺寸实现更高的 ESD 能力,低压触发可控硅整流器 (LVTSCR) 因其单位面积的高电流能力而被认为是一种有吸引力的器件 [2]。对于低电压应用,由于嵌入式低触发电压 (V t1) ggNMOS,具有出色ESD鲁棒性的LVTSCR能够提供比传统SCR更快的ESD响应速度。然而,强烈的内在正反馈导致极低的V h (1~2 V),负责闩锁和瞬态误触发 [3]。只需增加V即可有效抑制此类负面影响 h [3,4,5,6,7,8,9,10,11]。器件将不受闩锁和瞬态误触发的影响,而 V h 高于电源电压 (VDD)。因此,N+ESD 区和 P+LDD 区被添加到 SCR 中,并通过额外的掩膜和离子注入步骤来提高 V [3]。然而,由于额外的功耗以及增加的 V,ESD 鲁棒性可能会恶化 H。此外,V的发射极电压钳位技术 h 在可接受的故障电流 (I t2) 也被提出 [5]。尽管如此,V 上述方法中的h是不可调整的,这在通用应用中仍然存在不便和限制。
在这封信中,提出了一种新型高保持电压可控硅整流器 (HHV-SCR),并通过 TCAD 仿真和 TLP 测试进行了演示。该器件同时实现高 V h,高 I t2 和可调 V h 没有任何额外的面具和步骤。进行 TLP 测试以验证 V h可以在保持足够高的I的同时得到有效改进 t2。根据测试结果,HHV-SCR 具有四倍以上的 V h 与 LVTSCR 中的相比,I 中的退化可以忽略不计 t2.
方法
在这项工作中,研究了一种具有嵌入式载流子复合结构的新型高保持电压 SCR。物理模型 IMPACT.I、BGN、CONMOB、FLDMOB、SRH 和 SRFMOB 用于数值模拟。基于该模型,优化H-RR和E-RR以实现高V h 和高 P M. 制作的HHV-SCRs和LVTSCRs通过TLP系统测试。
结构与机制
所提出的 HHV-SCR 的横截面示意图和布局图分别如图 1a、b 所示。由浮动 N+ 和 P+ 形成的新引入的 H-RR 和 E-RR 分别与阳极和阴极区域的 N+ 和 P+ 相同。 H-RR 中的浮动 N+(或 E-RR 中的浮动 P+)紧邻阳极中的 P+ 区域(或阴极中的 N+ 区域)。此外,H-RR 中新的浮动 P+(或 E-RR 中的浮动 N+)也位于前面提到的 H-RR 中的浮动 N+(或 E-RR 中的浮动 P+)旁边。 H-RR (TN+) 中的低触发 N+ 和 E-RR (TP+) 中的低触发 P+ 也采用与阳极(或阴极)中的 N+(或 P+)区域相同的工艺制造,以确保 <我>V t1 在可接受的范围内。作为正 ESD 电压 (V ESD) 上升到一定水平,具有低击穿电压的 TN+/P-well/TP+ 结将首先击穿,然后由雪崩电流触发寄生晶体管的回弹。寄生 BJT 的强正反馈是导致 V 相当低的原因 LVTSCR 的 h。在 HHV-SCR 中,H-RR 中的 N+(或 E-RR 中的 P+)将重新结合从阳极 P+(或阴极 N+)边缘注入的少数载流子,从而降低电流增益(β ) 的寄生 PNP(或 NPN)并消除了表面双极效应。重要的是,H-RR 中的 P+(或 E-RR 中的 N+)通过重新组合表面电子(或空穴)来阻挡表面低电阻路径。与没有P+的H-RR(或没有N+的E-RR)相比,H-RR中的新P+(或E-RR中的N+)提供了额外的复合以消除从阴极注入的表面电子(或空穴)(或阳极)和由碰撞电离引起的那些(如图3a所示),这导致V的进一步增加 H。通过结合这些修改,FOM 的显着改进 被验证。品质因数 (FOM) 引自 [7],定义为 FOM=(V h·我 t2)/(N ·W ) 来评估 V h 和 I 单台设备的t2性能。一般伴随着V的提高 h 性能,它仍然导致 I 的退化 t2 由于更高的功耗。因此,更高的 FOM 意味着单个器件可以在更高的 V 上实现更高的电流能力 h 级 (N 是堆垛装置的编号; W 是设备宽度)。
<图片>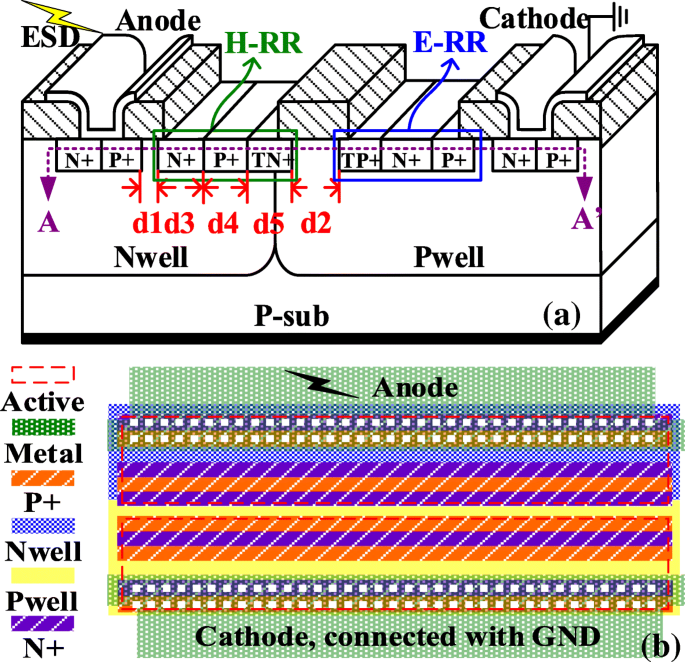
一 拟议的 HHV-SCR 的横截面示意图。 b 拟议的HHV-SCR布局图
结果与讨论
模拟结果
通过TCAD Medici对器件特性进行研究和模拟,其中使用了相应的模型,例如碰撞电离和浓度依赖迁移率模型。 LVTSCR 和 HHV-SCRs 的模拟 I-V 曲线如图 2 所示。V LVTSCR 的 h 低至 1.8 V,而 V HHV-SCR 的 h 从 4.6 V 提高到 8.1 V,d1 从 0.6 μm 降低到 0 μm,d2 =0.5 μm。事实上,较小的 d1 有利于提高 H-RR 中 N+(或 E-RR 中 P+)的重组能力以获得较低的 β ,这解释了 HHV-SCR 总是达到最高的 V d1 =0 μm 时的 h。图 2b 中的模拟结果表明 V 由于器件长度的增加,HHV-SCR 的 h 进一步提高,d2 从 0.5 增加到 1 μm。为了演示,H-RR中的P+(或E-RR中的N+)也是提高V的关键因素 H。模拟结果如图 2c 所示。当具有固定 d3 + d4 的 H-RR(或 E-RR)完全由重掺杂 N+(或 P+)(例如,d3 =3.5 μm,d4 =0 μm)形成时,模拟的 V h 为 7.1 V。通过在 H-RR 内插入 P+ 和在 E-RR 内插入 N+ 并具有固定的 d3 + d4(例如,d3 =2.5 μm,d4 =1.0 μm),模拟 V h 可以增加到大约 9.5 V。可以推断,H-RR 中的新 P+(或 H-RR 中的 N+)可以有效地重新组合表面雪崩电子(或空穴)以阻止表面电流路径。因此,较高的 V HHV-SCR 需要 h 维持相同的保持电流 (I H)。图 3a 中单独的 AA' 线的重组曲线表明 H-RR 中的新 P+(或 E-RR 中的 N+)诱导的重组率增加。采用TN+和TP+保证V t1 在可接受的范围内。通过在固定的 d5 + d2 + d5 处调整 d2 和 d5,V HHV-SCR 的 t1 可以从 12 V 显着降低到 9.0 V,以满足 5 V 电路的设计窗口,并且对 V 的影响可以忽略不计 h,如图 2d 所示。模拟器件在保持点的电流分布图也分别如图3b、c所示。与 d3 =3.5 μm、d4 =0 μm 的 HHV-SCR 中的电流分布相比,由于 H-RR 中的 P+ 和 E 中的 N+ 带来的额外复合率,所提出的 HHV-SCR 中的表面电流路径被阻塞-RR。
<图片>
在 a 处,d1 从 0 μm 增加到 0.6 μm 时,模拟了传统 LVTSCR 和提出的 HHV-SCR 的回弹 I-V 特性 d2 =0.5μm 和 b d2 =1μm。 c 对于固定的 d3 + d4 (d3 + d4 =3.5 μm),具有不同 d3 和 d4 的 HHV-SCR 的 I-V 曲线。 d 不同V的HHV-SCR的I-V曲线 t1
<图片>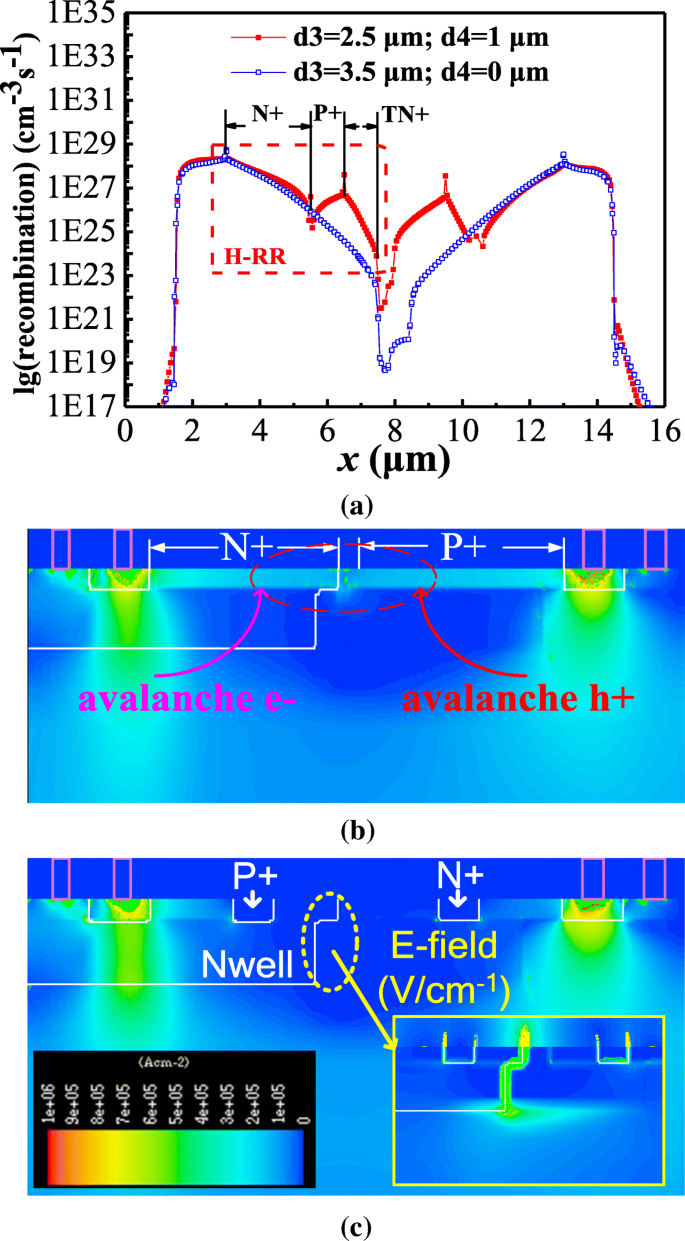
一 重组分布曲线,以及 HHV-SCR 与 (b ) d3 =3.5 μm,d4 =0 μm,并且 (c ) d3 =2.5 μm, d4 =1 μm
实验结果
制造的器件通过 TLP 系统进行测试。所有测试 SCR 的总宽度 (W) 为 50 μm,并使用单指进行参数比较(表 1)。所有被测器件占据相似的布局区域。器件参数如表 2 所示。图 4a 显示了 d2 =0.5 μm 的 HHV-SCR(称为器件 B1)和 LVTSCR 的 TLP 测量曲线。根据实验结果,V HHV-SCR 的 h 从 5.5 V 增加到 8.0 V,d1 从 0.6 μm 减少到 0.0 μm,远高于传统 LVTSCR 中获得的 1.8 V。随着 d2 从 0.5 增加到 1 μm,相应的 HHV-SCR(称为器件 B2)获得更高的 V h 如图 4b 所示。考虑到设计窗口,钳位电压 (V CL)在给定指标下也是评估夹紧能力的关键参数。从测试结果来看,V 在 HBM =2 kV (I TLP=1.3 A) 虽然手指宽度只有 50 μm。但是,所有设备都不能提供符合条件的 V 由于 V 高,CL 在更强的 ESD 应力下 h 和大动态电阻 (R dy) 由尺寸过小的器件宽度引起。为了满足更高的片上 ESD 要求,对于 d1 =0.6 μm、d4 =0.5 μm 和 d1 =0.6 μm、d4 =0 μm,手指宽度扩展到可接受的 300 μm。图 5 所示的 TLP 测试表明,d4 =0.5 μm 的 HHV-SCR 具有极低的 R dy (约 0.7 Ω),出色的 ESD 稳健性 (I t2> 10 A) 和高 V h 为 6.7 V。可以观察到 V I 处的 CL 低至 6.7 V TLP =5.4 A(HBM =8 KV)。此外,较高的 V 与 d4 =0 μm 的 SCR 的 TLP 曲线相比,还证明了 h 受益于 H-RR 中的 P+(或 E-RR 中的 N+)。 50 μm单指器件的测试结果如表1所示。
<图片>
常规LVTSCR和具有a的HHV-SCR的单位宽度上的实验失效电流和相应的TLP I-V特性 d2 =0.5 μm 和 b d2 =1 μm 在 W =50 微米
<图片>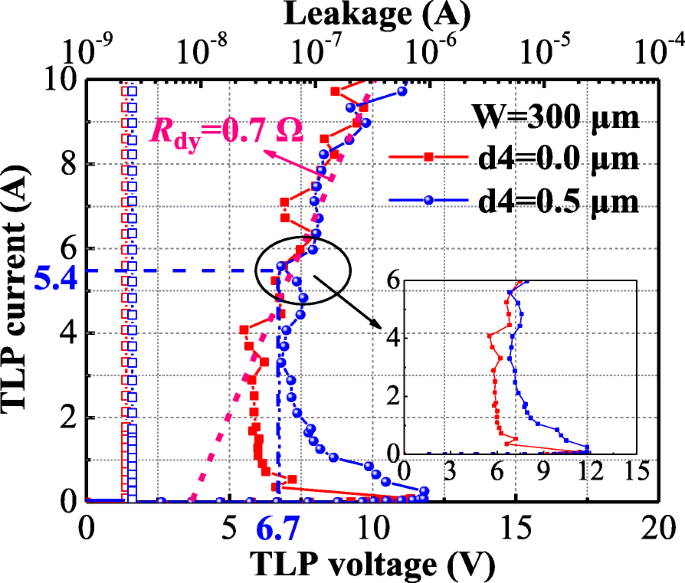
d4 =0.0 μm 和 d4 =1.0 μm 时 HHV-SCR 的实验 TLP 特性,d1 =0.6 μm,W =300 微米
结论
通过TCAD仿真和TLP系统研究和测量了一种新型CMOS工艺兼容HHV-SCR。与传统LVTSCR相比,HHV-SCR显着提高了V h(V 提高了 450% 以上 h 实现)并且不牺牲芯片面积。此外,V HHV-SCR 的 h 可以从 5.5 V 调整到 8.1 V 以满足不同的 V h 要求在 I 中的退化可以忽略不计 t2。在 P 方面 M,与传统的LVTSCR相比,也实现了200%以上的改进。
数据和材料的可用性
本研究期间生成或分析的所有数据均包含在这篇已发表的文章中。
纳米材料
- 微控制器和嵌入式系统的 IC 技术简介
- Maxim:具有 DC-DC 稳压器和浪涌保护的双 IO-Link 收发器
- TRS-STAR:来自 avalue
- 用于体内 CT 成像和肾脏清除特性的新型生物相容性 Au Nanostars@PEG 纳米颗粒
- 具有分层多孔结构的单分散碳纳米球作为超级电容器的电极材料
- 螺旋型天线微桥结构太赫兹微测辐射热计的调频和吸收改进
- 用于氧化还原刺激触发释放的新型双线粒体和 CD44 受体靶向纳米颗粒
- 具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
- 支持直接甲醇燃料电池的新型阳极催化剂:表征和单电池性能
- 用于染料降解的新型 p-Ag3PO4/n-BiFeO3 异质结复合材料的简便合成和增强的可见光光催化活性
- 自动化和网络安全:全面保护客户
- 高压PCB材料和设计


