具有 Hf1-xZrxO2 栅极结构的低电压操作 2D MoS2 铁电存储晶体管
摘要
铁电场效应晶体管 (FeFET) 因其良好的运行速度和耐用性而成为一种有趣的非易失性存储技术。然而,与读取相比,翻转极化需要更高的电压,从而影响写入单元的功耗。在这里,我们报告了一种具有低工作电压的 CMOS 兼容 FeFET 单元。我们设计了铁电 Hf1-xZrxO2 (HZO) 薄膜以形成负电容 (NC) 栅极电介质,从而在几层二硫化钼 (MoS2) FeFET 中产生极化域的逆时钟磁滞回线。不稳定的负电容器固有地支持亚热电子摆动率,因此能够以远小于工作电压一半的滞后窗口来切换铁电极化。 FeFET 显示出超过 10 7 的高开/关电流比 在最小编程 (P)/擦除 (E) 电压为 3 V 时,逆时针存储窗口 (MW) 为 0.1 V。 坚固耐用 (10 3 周期)和留存率(10 4 s) 属性也被证明。我们的研究结果表明,HZO/MoS2 铁电存储晶体管可以在尺寸和电压可扩展的非易失性存储器应用中实现新的机遇。
背景
片上系统(SoC)嵌入式存储器市场目前正处于一个巨大增长的时代,这要求存储器能够实现更快的运行、更小的单元尺寸和更低的功耗[1,2,3,4,5,6 ]。铁电存储器是最有前途的候选材料之一,由于 2011 年发现了铁电氧化铪[7],因此被重新考虑。
在过去的几十年里,FeFET 在所有这些方面都表现不佳,包括存储器操作的低电压要求、工艺步骤的简单性、最低限度的互补金属氧化物半导体 (CMOS) 集成工艺和有限的污染问题 [8,9,10, 11]。为了解决这个问题,最近,基于各种铁电材料,包括 PbZrTiO3 (PZT) 和 [P(VDF-TrFE)] 聚合物 [12,13,14,15, 16,17,18],这是由于二维材料在“超越摩尔时代”具有良好的特性。在 FeFET 中,结合到晶体管栅极堆栈中的铁电材料的两种稳定自发极化状态通过施加的收缩 P/E 栅极电压启用的可控阈值电压用于数据存储。据报道,可重现的滞后行为,10 4 的高开/关比 , 良好的保持性能可达 10 4 在 PZT/MoS2 FeFET [19] 中已经实现了稳定的开关操作。值得注意的是,最大机动性为 625 cm 2 /V∙s,对于 ± 26 V 栅极电压范围和 8 × 10 5 的高开/关比,具有 16 V 的大 MW n 型 [P(VDF-TrFE)] 聚合物/MoS2 FeFET [15] 也得到了证明。然而,有许多基本问题阻碍了其实际应用,例如 CMOS 兼容性、缩放能力以及 Fe 和 2D 材料之间的界面态。铁电氧化铪是一种新型铁电材料,具有优异的 CMOS 兼容性和缩放能力,可在未来 5-10 年用于亚 5 nm 技术节点的先进 FeFET NVM [20]。因此,一批基于 HfO2 的电介质堆栈已被纳入 2D FeFET,旨在通过低于 60 mV/十倍频程的斜率和无滞后特性实现具有陡峭 ON/OFF 开关的负电容场效应晶体管 (NCFET) [21,22,23,24,25,26],尽管基于 NC 电介质堆栈和替代 2D 通道材料的大规模实验得出了极好的结论,但他们强调了区分 NCFET 和 FeFET 的浪涌要求。基于MoS2和铁电HZO的单晶体管铁电存储器器件技术的物理和可行性仍缺乏系统研究。
在这项工作中,提出了具有几层 HZO MoS2 晶体管的 FeFET。它能够在 P/E 电压缩小的情况下,通过栅堆叠工程引起的 NC 效应来调整 P/E 电压。我们通过实验证明,在 HZO MoS2 FeFET 中实现了 0.1 V 的逆时针 MW,具有亚 60 mV/decade 的斜率,这可以归因于通过铁电偶极子的快速翻转在 2D 通道中进行局部载流子密度调制。我们将 HZO/MoS2 FeFET 滞后的降低归因于漏极电压增加的负漏极诱导势垒降低 (DIBL) 效应。此外,还系统研究了HZO MoS2 FeFET NVM的保持特性、耐久性特性以及阈值电压对漏极电压的依赖性,为HZO MoS2 FeFET NVM的设计及其实际应用开辟了可行的途径。
方法
6 nm Hf1-xZrxO2薄膜和2 nm Al2O3沉积在p + 上 Si 衬底在 300 °C 下使用 ALD,分别使用 [(CH3)2N]4Hf(TDMAHf)、[(CH3)2N]4Zr(TDMAZr) 和 H2O 蒸气作为 Hf 前体、Zr 前体和氧化剂前体。随后,衬底在 N2 环境中在 450 °C 下经历了 30 秒的快速热退火 (RTA)。之后,几层的 MoS2 薄片被机械剥离并转移到基板上。 p + 的直径 用于沉积 HZO (6 nm)/Al2O3 (2 nm) 的 Si 衬底为 6 英寸。我们采用电子束光刻 (EBL) 对聚甲基丙烯酸甲酯 (PMMA) A5 抗蚀剂中的接触垫进行图案化。自旋参数、烘烤参数、成像参数分别为500 r/min(9 s)+4000 r/min(40 s)、170 °C(5 min)、MIBK:IPA=1:3(15 s) .然后,使用电子束蒸发(EBE)系统蒸发源/漏电极(Ti/Au,5/65 nm 厚度)并用丙酮溶液蚀刻。剥离后,器件在 300 °C 下退火 2 小时以增强接触。我们使用带有显微操作器的探针台对我们制造的 MoS2/HZO 场效应晶体管进行了电气表征。背栅电压 (V GS)应用于p型重掺杂Si衬底。使用半导体表征系统 (PDA) 测量源漏电压 (V DS), 背栅电压 (V GS) 和源漏电流 (I DS)。
结果与讨论
我们通过大块晶体的机械剥离制备了几层 MoS2,并将 MoS2 纳米薄片转移到 2 nm Al2O3/6 nm HZO/p + Si 衬底(请参阅“实验”部分中的更多详细信息)。图 1a 和 b 分别显示了 HZO/MoS2 FeFET 结构的 3D 示意图和横截面。 HZO/MoS2 FeFET 的俯视扫描电子显微镜 (SEM) 图像如图 1c 所示。 MoS2 通道的宽度和长度分别为 2 μm 和 12 μm。如图 1d 所示,使用原子力显微镜(AFM)确认了 MoS2 通道的厚度。测得的厚度为 1.57 nm,表明存在 4 层 MoS2 [26]。
<图片>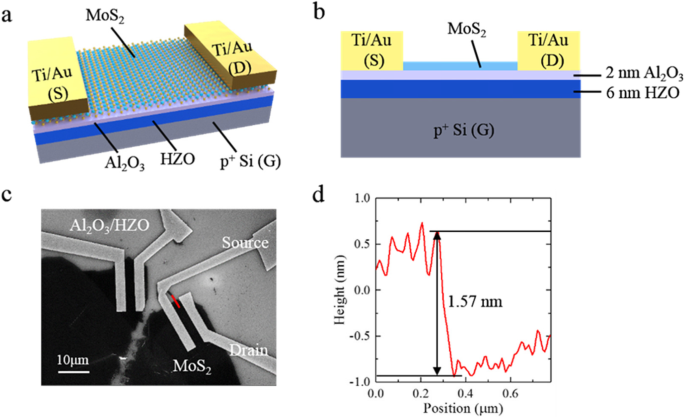
MoS2/HZO FeFET 的器件结构和基本特性。 一 MoS2/HZO FeFET 的三维示意图。 b MoS2/HZO FeFET 的横截面示意图。 c 具有 Ti/Au 源极/漏极电极、HZO 铁电栅极绝缘体和 MoS2 通道的制造的 MoS2/HZO FeFET 的俯视 SEM 图像。 d 沿 c 中红线使用接触模式 AFM 的高度剖面 , 验证 MoS2 通道的高度。
如图 S1c 和 d 所示,通过 X 射线光电子(XPS)测量检查 HZO 的元素和键组成。发现峰值为 19.05 eV、17.6 eV、185.5 eV 和 183.2 eV,分别对应于 Hf 4f5/2、Hf 4f7/2、Zr 3d3/2 和 Zr 3d5/2]。图 S1e 中沿深度剖面的原子浓度进一步证实了 Al2O3/HZO/p + 的分布 Si三层结构。以上都证实了通过我们的原子层沉积(ALD)系统生长的HZO薄膜是高度结晶的。
在研究 HZO/MoS2 FeFET 的表征之前,Au/2 nm Al2O3/6 nm HZO/p + 的铁电行为 使用极化电压测量的硅栅叠层如图 2a 所示。显然,我们制造的 6 nm HZO/2 nm Al2O3 电容器表现出极化电压滞后回线(在 1 kHz 下测量)。同时,剩余极化P r 和矫顽电压 V c 随着最大扫描电压的增加而增加,这意味着 P-V 磁滞回线从小回线转变为大回线。随着最大扫描电压从 2 增加到 4 V,P r 达到 0.66 μC/cm 2 , 0.86 μC/cm 2 , 和 1.1 μC/cm 2 , 分别和 V c 分别达到 1.12 V、1.9 V 和 2.04 V。提取的 P r 和 V c 10 5 持久的 DC 扫描周期如图 2b 和 c 所示。很明显,10 5 内有显着的唤醒和疲劳效果 在 6 nm HZO/2 nm Al2O3 电容器中观察到循环。唤醒和疲劳可归因于电场下氧空位的扩散和重新分布。疲劳效应通常与氧空位相关的缺陷位置处的电荷俘获有关 [28]。 PRphase 的滞后行为 PRampl 的蝴蝶形环 使用压电响应力显微镜(PFM)显示在图 S1b 和 c 中,表明极化切换是扫描偏置电压的函数。考虑极化电压测量和压电响应电压测量之间的不同接触电阻,测得的V 图 S1b 中的 c 和 c 与图 2a 中获得的值不太一致。
<图片>
一 具有不同电压扫描范围的 HZO (6 nm)/Al2O3 (2 nm) 电容器的 P-V 磁滞回线。 (b 的依赖 ) P r 和 c V c 在 ±4 V/1 kHz 循环下 HZO (6 nm)/Al2O3 (2 nm) 电容器的循环
此外,观察到随着栅极电压(V GS,范围)。通常,多晶HZO薄膜以多畴状态存在[29],这些畴的矫顽场分布满足高斯分布。因此,必须增加对升高的 V 的依赖 GS,范围。强制归档 E C 对应于可以将剩余极化降低为零的外部电场值。因此,V GS,HZO薄膜中用于切换极化的范围随着相关矫顽电压V而变大 C .这就是为什么 HZO 薄膜的极化电压回路以更大的 V 扩展的原因 GS,范围,这已在图 2a 中得到证明。换句话说,随着 V 的升高,极化强度和铁电开关发生增强 GS,范围,导致上述由增加的 V 产生的逆时针 MW 扩展的现象 GS,范围。在 V GS,range =(-2, 2 V),MW几乎消失,几乎没有滞后特性出现,这意味着铁电开关和电荷俘获/去俘获效应之间几乎完全补偿。
为了进一步研究铁电开关的影响,V GS,range 已连续增加到 (-6, 6 V) 和 (-6.5, 6.5 V)。测量的 I DS-V HZO MoS2 FeFET 在 V 处的 GS 曲线 GS,range =(-6, 6 V) 和 (-6.5, 6.5 V) 如图 3a 所示。同样,逆时针内存窗口随着扩展的V而增加 GS,范围。在 V GS,range =(−6.5, 6.5 V),逆时针MW在4 V以上,开/关比也增加到10 7 ,这是由于在更大的外部施加电压下增强的极化切换。通常,I 中显示的滞后行为背后的机制 DS-V V 双向扫描过程中的 GS 曲线 GS 是阈值电压偏移,它可以通过极化切换的主要效应进行修改,即 NC 效应 [30,31,32],导致逆时针滞后。在缩小的 V 下,在另一个设备中进一步研究了改进的亚阈值特性 GS,范围。测量的 I DS-V GS 和提取点 SS—I V 下其他器件的 DS 曲线 GS,range =(-3, 3 V) 绘制在图 3b 中。证明在 V GS,range =(-3, 3 V),HZO/MoS2 FeFET 分别表现出 SSFor =51.2 mV/decade 和 SSRev =66.5 mV/decade。也就是说,室温下HZO/MoS2 FeFET可以同时实现sub-60 mV/decade的SS和0.48 V的MW,这将是区分NCFET和FeFET的提示。
<图片>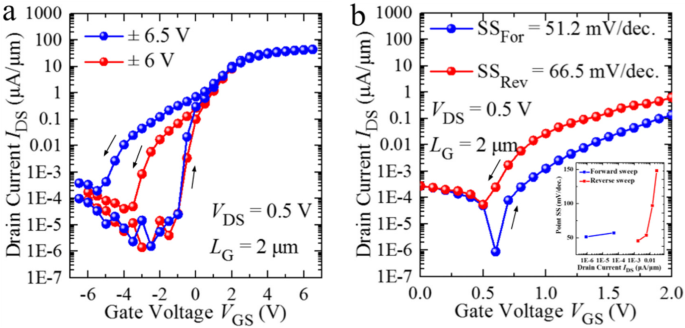
HZO/MoS2 FeFET 在漏极电压 (V DS) 为 0.5 V。a 背栅电压最大值为 6 V 和 6.5 V 时的转移曲线比较。 b V 的 0 到 -2 V 区间的传递曲线放大图 GS,range =(-3, 3 V)。点亚阈值斜率 (SS) 作为漏极电流的函数 (I HZO/MoS2 FeFET 的 DS) 是 (b ) 插入。该器件表现出 SSFor =51.2 mV/dec
众所周知,在 NCFET 中,由于引入了负栅极介电电容 (C ins),可以通过 dP 的负斜率段获得 /dE <0 由铁电薄膜引起,有助于栅极堆叠因子 (m) <1。NC 效应的基础机制 [33] 是铁电薄膜产生的去极化场 [34,35,36,37,38]。据实验报道,由于铁电薄膜界面的不完全屏蔽[39],残余极化电荷会在铁电薄膜上产生一个与外加电压方向相反的内部电场,导致重新栅叠层两端电压的分布和放大的沟道表面电位,称为“电压放大效应”[40,41,42]。电压放大通常可以分为两部分,通道表面电位的加速变化和随后的提升值,提供陡峭的ON/OFF切换和改进的I ON/I 关,分别。然而,对于 FeFET,还有另外一个故事。根据铁电电容(C FE) 和金属氧化物半导体电容 (C MOS) [43,44,45],当 |C FE|> C MOS,理论总电容(C total) 为正,系统稳定,在 V 的双向扫描过程中产生相同的极化行为 GS 和稳定的无滞后 NCFET。然而,导致 SS 和跨导改善的良好匹配很难实现,因为 C MOS 和 C FE 是非常非线性的、依赖于偏置的电容器。此外,|C FE|> C 需要在所有工作电压范围内确保 MOS 以避免滞后。相反,一次 |C FE| <C MOS,理论上的C total 为负且系统不稳定,在 V 的双向切换过程中必须发生分离的极化行为 GS 保持 C 总正值,这可能会在 NVM 应用的 FeFET 中产生逆时针滞后。这里提到迟滞行为是分离极化切换的后续效应,这意味着迟滞窗口的宽度可以根据电容匹配的概念轻松修改,例如,可以通过 <我>V DS。具有适当的电容匹配,即使 V 大幅缩小 GS,range =(-3, 3 V), HZO/MoS2 FeFET 仍然表现出明显的滞后窗口,同时 SSFor =51.2 mV/dec 的陡峭切换,这进一步表明 NC 效应(铁电极化效应)在亚阈值区域也是如此。虽然 NCFET 和 FeFET 不同,但 FeFET 也可以用作逻辑器件,具有可比的较小 MW,保持深低于 60 mV/dec SS 和更高的 I ON/I 由于NC效应,OFF比率也一样。
V 的影响 DS 对 MW 的宽度进行了仔细研究。 我 DS-V 不同V下对数尺度上的GS曲线 DS 的特征在图 S3 中。结果表明,在固定的 V GS,range =(−2, 2 V),V 的值 在 I 处提取的 GS 对于 V 的双向扫描,DS =70 nA GS 都向负方向移动。同时,也证明了 V 的前向扫描变化 GS比反向扫描更明显,表明负DIBL的显着现象。需要指出的是,负DIBL效应总是伴随着NC效应发生[46, 47]。
在对 HZO/MoS2 FeFET 进行上述直流 (DC) 测试后,我们进一步对不同 P/E V 进行了测量 图 4a 中宽度为 10 ms 的 GS 脉冲。 MW 定义为最大变化 ΔV 市盈率 V 后的 TH GS 脉冲。在脉冲V期间 GS应用,其他终端固定为V S =V D =0 V。对于读 (R) 操作,V GS 的范围从 -1 V 到 1 V,其中 V D =0.5 V 和 V S =0 V。如图 4a 所示,提取的 MW 随着 P/E V 变大 GS 脉冲增加。当施加的市盈率 V GS脉冲为±3 V,提取的MW为0.1 V。当施加P/EV GS脉冲为±5.5 V,提取的MW为0.275 V。与图3a和b中逆时针4 V和0.48 V的MW相比,P/E后的提取MWV GS 脉冲大大减少。这可能是由于空气中的高湿度引起的更高密度的俘获状态 [48]。因此,电荷俘获/去俘获机制得到增强并且逆时针磁滞回线最终减小。此外,我们研究了 HZO/MoS2 FeFET 在图 4b 中 ± 5.5 V 高度的 P/E 脉冲下的循环耐久性和数据保留。程序V GS 脉冲宽度为 10 ms,V S =V D =0 V。图 4b 说明了作为耐久性循环函数的测量 MW。耐久周期由背栅电压周期性 P/R/E/R 脉冲形成。施加到P、E、R高度的背栅的电压分别为+5.5 V、-5.5 V和0 V。 P和E的脉冲宽度为10 ms。显然,在 10 3 后可以保持 0.3 V 的 MW 而不会显着降低 市盈率周期。随着耐久循环次数的增加,MW在10 循环后增加到0.38 V,然后在600 循环后又回到0.28 V。第一个扩大的 MW 称为唤醒效应,随后缩小的 MW 称为疲劳效应。唤醒效应对应于畴壁去钉扎,导致 HZO 膜的可切换偏振域增加 [49]。疲劳效应对应于新注入的电荷,在大量 P/E 循环后固定畴壁 [50]。室温下的数据保留如图 4c 所示。在这里,10 4 后 MW 的衰减可以忽略不计 s。因此,通过虚线外推线,可以预期约 0.3 V 的 MW 可持续超过 10 年。如图 4d 所示,器件在 10 3 后稳定 在具有 ± 3 V 高度的 P/E 脉冲下循环。 HZO/MoS2 FeFET的稳定性表明其在非易失性存储技术中具有广阔的应用前景。
<图片>
HZO/MoS2 FeFET 在 P/E 脉冲下的存储性能。 一 在具有 ±3 V、±4 V、±5 V、±5.5 V 和 ±6 V 高度的 P/E 脉冲下提取的 MW (MW)。 b P/E 脉冲条件下的耐久性测量。 c HZO/MoS2 FeFET 的保留特性。 d HZO/MoS2 FeFET 10 3 的耐久性 在具有 ± 3 V 高度的 P/E 脉冲下循环
表 1 中提供了结合 MoS2 和铁电栅极电介质的基于 FeFET 的器件的品质因数比较。 这里,器件结构、剩余极化、矫顽电场、磁滞回线方向、MW、工作电压、耐久循环、和保留时间被列出。很明显,与其他工作相比,我们制造的器件表现出最薄的 6 nm HZO 铁电层和最低的工作电压 [12,13,14,15,16,17,18],这对未来的 2 nm 很重要或 3 nm 工艺节点的后端 (BEOL) 存储器。通过缩放铁电层的厚度,在±3 V的低工作电压下实现了约0.1 V的MW。如此低的工作电压可归因于HZO层与其对应物(如P)相比的固有特性(VDF-TrFE) 或 HfO2,其厚度要高得多。此外,我们的器件具有较低的剩余极化P r 为 1.1 μC/cm 2 与其他报道的 FeFET 相比。 FeFET中保留损失的快速衰减是由于去极化场E的存在 dep,这是由于 Al2O3 层的存在导致电荷补偿不完全。在这里,E dep 与剩余极化成正比 P r [51]。因此,高 E c 和低 P r 使比率 E 深度/E MoS2/HZO FeFET 中的 c 小得多,导致与去极化场效应相关的保留损失小得多。虽然基于 HZO 和 P(VDF-TrFE) 的 MoS2 FeFETs 的保留性能都在 10 4 s,P(VDF-TrFE)薄膜需要150 nm [17]。
结论
总之,我们研究了使用 HZO 背栅电介质的少层、基于 MoS2 的铁电存储晶体管器件。我们制造的器件表现出由铁电极化引起的逆时针滞后。此外,我们的 HZO/MoS2 铁电存储晶体管显示出优异的器件性能:超过 10 7 的高开/关电流比 逆时针 MW 为 0.1 V,P/E 电压为 3 V,具有 (10 3 周期)和留存率(10 4 s) 性能。因此,我们相信我们基于 MoS2 的非易失性铁电存储器晶体管的结果为二维低功耗非易失性存储器应用的未来展示了广阔的前景。
数据和材料的可用性
作者声明材料、数据和相关协议可供读者使用,用于分析的所有数据均包含在本文中。
纳米材料
- 晶体管额定值和封装 (BJT)
- 交流电路的一些例子
- American Control Electronics:带卡入式可编程板选项的低压直流驱动
- 具有可控厚度的二硫化钼用于电催化析氢
- 具有分层多孔结构的单分散碳纳米球作为超级电容器的电极材料
- 具有低电阻率的紫外线固化喷墨印刷银栅电极
- 螺旋型天线微桥结构太赫兹微测辐射热计的调频和吸收改进
- 具有 GeSiSn 纳米岛和应变层的半导体薄膜的形态、结构和光学特性
- 具有 HfO2 缺陷控制层的单壁碳纳米管主导的微米宽条纹图案化铁电场效应晶体管
- T 形栅极双源隧道场效应晶体管的模拟/射频性能
- 具有改良表面结构的高性能有机-纳米结构硅混合太阳能电池
- 低压控制市场增长


