具有 HfO2 缺陷控制层的单壁碳纳米管主导的微米宽条纹图案化铁电场效应晶体管
摘要
开发并制造了具有单壁碳纳米管 (SWCNT) 主导的微米宽条纹图案作为通道、(Bi,Nd)4Ti3O12 薄膜作为绝缘体和 HfO2 薄膜作为缺陷控制层的铁电场效应晶体管 (FeFET)。制备的 SWCNT-FeFETs 具有优异的性能,如大通道电导、高开/关电流比、高通道载流子迁移率、良好的耐疲劳性能和数据保持能力。尽管其电容等效厚度很薄,但具有 HfO2 缺陷控制层的栅极绝缘体显示出 3.1 × 10 -9 的低漏电流密度 A/cm 2 栅极电压为 − 3 V。
背景
铁电场效应晶体管 (FeFET) 因其高速、单一器件结构、低功耗和无损读出操作而成为非易失性存储器件和集成电路的有前途的候选者 [1,2,3]。 (Bi,Nd)4Ti3O12 (BNT) 是一种无铅铁电薄膜,具有稳定的化学性能和疲劳耐久性能。因此,使用 BNT 作为栅极电介质的 FeFET 将具有较小的阈值电压、较大的沟道电导等。碳纳米管 (CNT) 因其高电导率和大载流子迁移率而被广泛应用于 FeFET [4,5,6,7]。众所周知,理想的碳纳米管表面没有悬空键,这导致铁电薄膜和碳纳米管之间的界面反应很小[8, 9]。然而,在实验中很难在源极和漏极之间实现单个 CNT 生长。此外,由于在 CNT 网络中混合了金属纳米管,因此 CNT 纳米线网络 FeFET 的开/关电流比通常较低 [7, 10]。宋等人。提出使用多壁CNT微米宽条纹图案作为FeFET的沟道材料来解决上述问题,但CNT FeFET的疲劳耐久性能和物理特性的保留尚不清楚[9]。与多壁碳纳米管 (MWCNT) 相比,单壁碳纳米管 (SWCNT) 是无缝包裹的单个石墨烯片,形成圆柱形管 [11]。此外,在铁电薄膜的制备过程中存在一些难以控制的缺陷(如离子杂质、氧空位和位错)[12,13,14]。这些缺陷的扩散会影响开/关电流比、疲劳耐久性能和数据保留 [15, 16]。因此,我们在 SWCNT-FeFET 中注入 HfO2 层,用于阻止点缺陷的扩散,并可用作缓冲层以缓解 BNT 和 Si 之间的错配,从而降低 BNT 膜中的位错密度。它可以控制SWCNT-FeFET中的缺陷,进而显着提高开/关电流比、疲劳特性和数据保持率。
在这项研究中,我们制造了规则和对齐的微米宽条纹图案网络 SWCNT 作为沟道层,BNT 薄膜作为绝缘体,HfO2 薄膜作为缺陷控制层来制造底栅型 FeFET,并期望获得良好的开/关电流比,疲劳特性和数据保留。 SWCNT-FeFET 的结构及其制备过程如图 1a、b 所示。此外,我们还制作了MWCNT-FeFET作为对比。
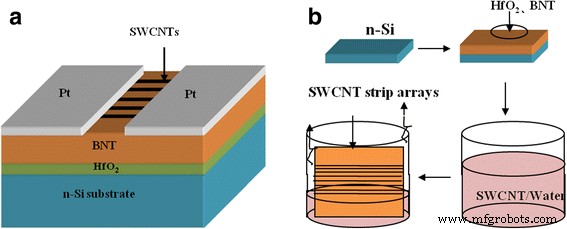
一 条纹图案的 SWCNT-FeFET 的结构图。 b 条纹图案SWCNT/BNT/HfO2-FeFET制作流程图
方法
在 FeFET 器件中,SWCNT 微米宽条纹图案用作沟道,BNT 薄膜用作栅极电介质,HfO2 薄膜用作缺陷控制层,重掺杂 n 型 Si 用作衬底和背面FeFET 的栅电极。 n 型硅的电阻率为 0.0015 Ω cm。使用波长为 248 nm 的 KrF 准分子激光器通过脉冲激光沉积 (PLD) 在 Si 衬底上沉积 HfO2,其厚度约为 20 nm。如早期工作 [17] 中所述,BNT 薄膜通过 PLD 沉积在 Si 衬底上,其厚度约为 300 nm。原始电弧放电单壁碳纳米管购自成都有机化学研究所(中国科学院);长度和直径分别为 10-30 μm 和 0.8-1.1 nm。它的纯度为 85%,这意味着 SWCNT 占主导地位。 SWCNTs是通过蒸发诱导自组装制造的。 SWCNT/水分散体的浓度为 100 mg/L,蒸发速率在 9-21 μL/min 的范围内变化,温度为 80 °C。通过控制溶剂蒸发温度,在 BNT/HfO2/Si 衬底上的固-液-气界面形成明确的条纹图案。接下来,使用掩模板通过离子束溅射将 Pt 源极/漏极电极沉积在 SWCNT/BNT 上。金属掩模板的总面积为 1 cm 2 , 源漏面积均为 4.5 mm 2 .通道长度 (L ) 和宽度 (W ) 的 FeFET 分别为 200 和 1500 μm。制造的 SWCNT-FeFET 然后在 500°C 下进行 2 小时的后退火,以改善源极/漏极电极和 SWCNT 之间的接触。据报道,碳纳米管网络包含金属和半导体纳米管。通过施加大的栅极电压来处理 CNT 网络。金属单壁碳纳米管几乎被烧蚀,半导体单壁碳纳米管被负载电流保留[18]。为了比较,SWCNT/SiO2-FET采用相同的方法和条件制造; MWCNTs/BNT-FET 也是通过早期工作 [9] 中描述的方法制造的。 FeFET 特性是使用 Keithley 4200 参数分析仪测量的。使用RT Precision Workstation铁电分析仪测量FeFET的磁滞回线和极化。
结果与讨论
图 2 显示了条纹图案的 SWCNT 的典型 SEM 图像。规则和对齐的 SWCNT 微米宽条纹图案显示在图 2a 中。突出和浅色条纹是 SWCNT 条纹,其中 SWCNT 密集排列,如图 2b 中条纹的放大图像所示。凹陷和灰色条纹对应于 SWCNT 微米宽条纹之间的空间中裸露的 BNT/HfO2/Si 衬底。单壁碳纳米管前驱体溶液的浓度随着蒸发而增加,渐变条纹的宽度随着单壁碳纳米管/水液位的下降而略有增加。 Si 衬底上的 BNT/HfO2 膜和 BNT 膜如图 2c、d 所示。可以看出,BNT/HfO2 薄膜的表面由许多晶粒和孔隙组成,表明其粗糙度比 BNT 薄膜大。图 2e 显示了 P -V BNT 和 BNT/HfO2 薄膜的磁滞回线,分别。在相同电压下,BNT/HfO2 薄膜的磁滞回线极化大于 BNT 薄膜。尽管 HfO2 层共享 BNT/HfO2 膜的部分电压,但 BNT 膜仍显示出比在 Si 衬底上生长的 BNT 更好的极化值。这是因为在HfO2层上生长的BNT薄膜比直接在Si衬底上生长的BNT薄膜具有更低的扩散缺陷浓度。

一 在 SWCNT/BNT/HfO2-FeFET 中图案化的 SWCNT 条纹的 SEM 显微照片。 b SWCNT 的网格结构。 c BNT/HfO2 薄膜表面的 SEM 图像。 d BNT薄膜表面的SEM图像。 e BNT和BNT/HfO2薄膜的磁滞回线
图 3 显示了输出特性 (I DS-V DS) SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的曲线。 SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 显示典型的 p 沟道晶体管特性和低源漏电压下的饱和源漏电流。它们的通道长度 (L ) 是 200 微米。由于SWCNT微米宽条纹图案,SWCNT/BNT/HfO2-FeFET和SWCNT/BNT-FeFET的“导通”电流和沟道电导均达到3.8×10 -2 A、3.6×10 −2 A 和 9.5×10 −3 S, 9×10 −3 S 在 V GS =− 4 V 和 V DS =4 V。然而,SWCNT/BNT/HfO2-FeFET 的关断电流比 SWCNT/BNT-FeFET 低,SWCNT/BNT-FeFET 在 V 处出现严重的漏电流现象 GS =0 V。这是因为 HfO2 层有效地阻止了缺陷的扩散。

SWCNT/BNT/HfO2-FeFET(letf)和SWCNT/BNT-FeFET(右)的输出特性曲线
传输特性 (I D-V G) 具有 L 的 SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET =200 μm 和 V DS =0.6 V 如图 4 所示。阈值电压 (V th) SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 为 V th =0.2 V 和 V th =0.8 V 通过 (I D ) 1/2 对比 V 晶体管工作在饱和区的 GS 曲线。通道迁移率 (μ sat) 是根据 (I DS) 1/2 对比 V GS曲线以及场效应晶体管的饱和区表达式[19],
$$ {I}_{\mathrm{DS}}=\left(\frac{\varepsilon_0{\varepsilon}_r{\mu}_{\mathrm{sat}}W}{t_{\mathrm{ins}} 2L}\right){\left({V}_{\mathrm{GS}}\hbox{-} {V}_{\mathrm{th}}\right)}^2 for\kern0.5em {V_{ \mathrm{DS}}}^{{}^3}{V}_{\mathrm{GS}}\hbox{-} {V}_{\mathrm{th}}, $$其中 ε r 是相对介电常数和 t ins 是 BNT 厚度。相对介电常数 (ε r ) 的 BNT 薄膜是 350,这是通过 HP4156 参数分析仪在 1 MHz 下测量的。 μ SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的饱和度分别为 395 和 300 cm 2 /V 秒。图 5 显示了 I DS-V 在双扫描模式下制造的 SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET 和 SWCNT/SiO2/HfO2-FET 的 GS 对数转移曲线。栅极电压扫描在 V DS 为 0.6 V,在 V GS 范围从 − 7 至 4 V,− 6 至 3 V,和 − 4 到 1 V。I SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET和SWCNT/SiO2/HfO2-FET的DS开/关比为2 × 10 5 , 2 × 10 4 , 和 2.3 × 10 2 在 V GS 范围从 − 7 到 4 V。I SWCNT/BNT/HfO2-FeFET 的 DS 开/关比高于 MWCNT/BNT-FeFET [9] 和 SWCNT/BNT-FeFET。这是因为在 SWCNT-FeFET 中注入了 HfO2 缺陷控制层,有效地阻止了缺陷的扩散。对于我 DS-V GS 特性,由于 BNT 膜的铁电极化反转,我们获得了顺时针磁滞回线,获得的 SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的存储窗口(MW)宽度约为 4.2 和 4.1 V,其中比以 CNT 网络作为通道层的 CNT/PZT-FeFET (1.1 V) 大 [20]。较大的 MW 表明该 FeFET 系统中的介电耦合良好。从图 4c,我们可以看到 SWCNT/SiO2/HfO2-FET 获得的窗口宽度约为 1 V,这主要是由 SWCNT 的缺陷密度引起的 [21]。这些结果表明,铁电 FeFET 的存储器窗口滞后 (4.2 V) 是由 BNT 极化和 SWCNT 缺陷的密度引起的。
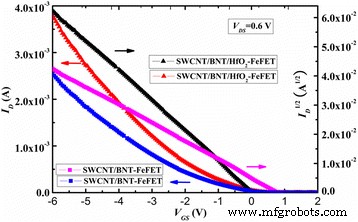
线性传递特性曲线和拟合I DS 1/2 -V V 处的 G 曲线 对于 SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的条纹图案,DS =0.6 V

条纹图案a的对数传递曲线 SWCNT/BNT/HfO2-FeFET,b SWCNT/BNT-FeFET 和 c V 的 SWCNT/SiO2/HfO2-FET DS =0.6 V。箭头表示逆时针滞后回线,实线表示内存窗口宽度
图 6a 显示了 BNT/HfO2 和 BNT 薄膜的漏电流-电压特性。可以看出,漏电流为 1.2 × 10 −9 A 和 1.5 × 10 −8 当电压达到- 3 V时,BNT/HfO2和BNT薄膜分别为A。通过拟合I,研究了BNT/HfO2和BNT薄膜的漏电流-电压特性以进行比较 -V 数据。肖特基接触的漏电流特性用Ln(J ) =b (V + V bi * ) 1/4 [9, 22, 23] 以及 BNT/HfO2 和 BNT 薄膜在 0 至 3.8 V 电压范围内的相应曲线如图 6b 所示。内置电压 V bi * 和斜率 b 式中可以通过拟合实验得到I-V 数据。计算出的空间电荷密度 N 由深捕获中心和氧空位组成的 eff 约为 2.132 × 10 17 厘米 −3 和 1.438 × 10 19 厘米 −3 分别用于 BNT/HfO2 和 BNT 薄膜。根据界面势垒高度公式[24],表明在Si衬底上沉积的BNT薄膜是n型半导体。这与 HfO2 降低 I 关断电流的效果一致 D-V 图 4a、b 中的 G 曲线,因为 n 型 BNT 产生电子增加了负电压下的截止电流。 BNT薄膜导电表现出体控机制,这进一步表明n型BNT主要由导电缺陷或杂质诱导[9, 22]。
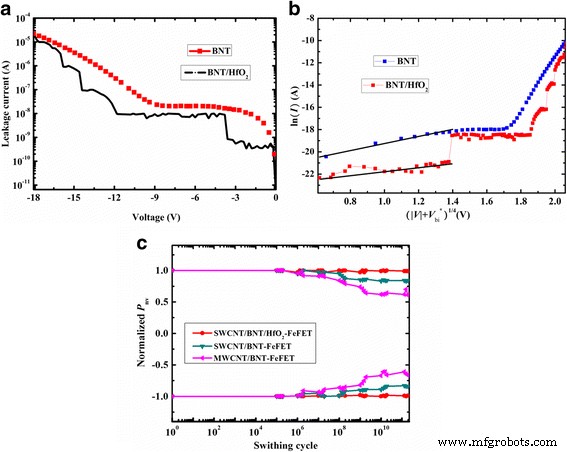
一 BNT/HfO2 和 BNT 薄膜的漏电流-电压特性。 b BNT/HfO2和BNT薄膜漏电流-电压特性拟合曲线。 c SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET和MWCNT/BNT-FeFET的耐疲劳性能
图 6c 显示了 SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET 和 MWCNT/BNT-FeFET 在 V 处具有 100-KHz 双极脉冲的疲劳耐久性能 GS 范围从 − 7 到 4 V。FeFET 的疲劳耐久性能表现在可切换极化随着重复切换循环的损失。非挥发性极化值 (P nv) 由等式 P 获得 nv =P r * − P r ^ 然后,用 P 标准化 nv/P r0 * [25],其中 P r * 是 FeFET 的两倍剩余极化,P r ^ 是下一个脉冲后的极化损失,P r0 * 是 FeFET 的两倍初始剩余极化。归一化 P 的部分损失 10 11 之后的 nv 观察到 FeFET 的读/写切换周期,对于 SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET 和 MWCNT/BNT-FeFET,分别约为 3%、10% 和 25%。当 BNT 直接在底部电极 Si 上生长时,由于 BNT 和 Si 衬底之间通过晶界扩散,SWCNT/BNT-FeFET 的疲劳性能非常差 [12,13,14]。这些结果表明HfO2层有效地阻止了Si衬底的扩散并减少了离子杂质,从而具有优异的疲劳耐久性能。
为了评估 FeFET 在 NVRAM 应用中的器件可靠性,我们检查了数据保留。图 7 显示了 SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET 和 MWCNT/BNT-FeFET 在室温下的源漏电流保持曲线。 V的电压脉冲 GS =− 4 V 和 V GS =1 V 在 V DS =1 V 被施加到栅极和源漏电极,分别将 FeFET 的电压切换到关断或导通状态。测得的开/关状态电流比接近3 × 10 4 , 7 × 10 3 , 和 6 × 10 2 对于 SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET 和 MWCNT/BNT-FeFET 后 10 6 s,分别。保持时间为1 × 10 6 后,开/关状态电流比没有显着损失(3.2%) s 为 SWCNT/BNT/HfO2-FeFET。通过将曲线外推到 10 8 s 对于 SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET 和 MWCNT/BNT-FeFET,开/关状态电流比接近 1.9 × 10 4 , 3 × 10 3 , 和 2 × 10 2 , 分别。 SWCNT/BNT/HfO2-FeFET 的开/关状态比对于存储器功能来说仍然足够高,证明了本存储器器件的理想保持特性。保持力受栅极漏电流的影响 [26, 27]。较长的保留时间表明 HfO2 缺陷控制层可以有效降低关态电流和栅极漏电流,从而稳定开/关电流比。此外,我们还对表 1 中基于铁电的 FET 和不同 CNT 进行了比较,表明本研究中制造的 SWCNT/BNT/HfO2-FeFET 可以提供高开/关电流比、良好的疲劳耐久性能和数据保留。
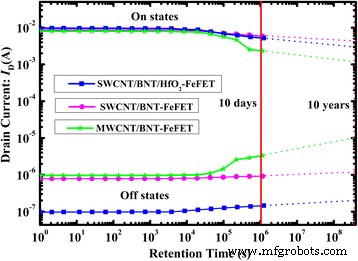
SWCNT/BNT/HfO2-FeFET、SWCNT/BNT-FeFET和MWCNT/BNT-FeFET在室温下的保留特性
<图>为了进一步了解缺陷如何影响器件的物理特性,P -E 磁滞回线和 I DS-V SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的 GS 曲线是通过使用我们之前的模型 [12, 28] 考虑由缺陷引起的不对称电荷来模拟的。由缺陷引起的不对称电荷被认为是模拟P -E 磁滞回线和 I DS-V BNT 的 GS 曲线,对称电荷被认为是模拟 BNT/HfO2 的曲线。模拟结果如图 8a、b 所示,与图 8 的实验结果相似。分别为 2e 和 5a、b。仿真结果表明,HfO2层有效地降低了缺陷引起的铁电薄膜的不对称电荷,进一步增加了断态电流。因此,可以证明HfO2缺陷控制层有效地控制了铁电薄膜的缺陷。
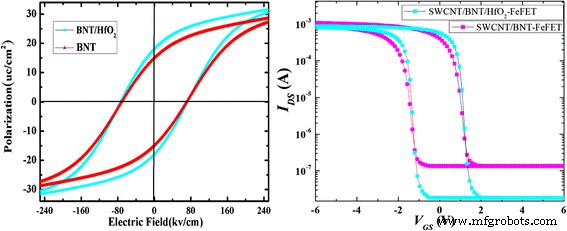
a 的模拟 P -E BNT和BNT/HfO2薄膜和b的磁滞回线 我 DS-V SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的 GS 曲线
结论
总之,研究了 HfO2 材料作为缺陷控制层对 SWCNT/BNT-FeFET 的开/关电流比、疲劳耐久性能和数据保留的影响,其中铁电薄膜的缺陷由 HfO2 控制作为缺陷控制层。由于 HfO2 的缺陷控制层很薄,所制造的 SWCNT/BNT/HfO2-FeFET 显示出 1.2 × 10 -9 的低漏电流 A 当电压达到- 3 V时,开/关电流比大为2 × 10 5 , V th of 0.2 V, and a μ 395 厘米 2 /V 秒。此外,由于薄的 HfO2 缺陷控制层,SWCNT/BNT/HfO2-FeFET 表现出优异的疲劳耐久性能和良好的数据保留。磁滞回线 P -E 和我 DS-V 模拟了 SWCNT/BNT/HfO2-FeFET 和 SWCNT/BNT-FeFET 的 GS 曲线,以了解缺陷如何影响器件的物理特性。模拟结果进一步表明,HfO2 可以减少 SWCNT/BNT/HfO2-FeFET 中的不对称电荷以控制缺陷。
缩写
- BNT:
-
(Bi,Nd)4Ti3O12
- FeFET:
-
铁电场效应晶体管
- MWCNT:
-
多壁碳纳米管
- PLD:
-
脉冲激光沉积
- SWCNT:
-
单壁碳纳米管
纳米材料
- 最近的论文详细介绍了碳纳米管的可扩展性、集成突破
- 碳纳米管纱线、肌肉和透明片
- 通过介电超表面扩大带宽完成太赫兹偏振控制
- HfO2/TiO2/HfO2 三层结构 RRAM 器件在原子层沉积制备的 Pt 和 TiN 涂层衬底上的双极电阻开关特性
- 具有低电阻 Au 欧姆接触的多层 SnSe 纳米片场效应晶体管
- 通过等离子体增强原子层沉积原位形成 SiO2 中间层的 HfO2/Ge 叠层的界面、电学和能带对准特性
- 用于超高密度对齐单壁碳纳米管膜的加热增强介电泳
- 具有分层多孔结构的单分散碳纳米球作为超级电容器的电极材料
- 通过孔隙率表征设计纯碳纳米管材料
- 背面有黑硅层的晶体硅太阳能电池的研究
- 氧化铝支撑层热稳定性增强对垂直排列单壁碳纳米管生长的影响及其在纳滤膜中的应用
- 具有 HfO2 缺陷控制层的单壁碳纳米管主导的微米宽条纹图案化铁电场效应晶体管


