具有低于 60 亚阈值摆动行为的 ZrOx 负电容场效应晶体管
摘要
这里我们报告了 ZrOx 基于负电容 (NC) FET,在 ± 1 V V 下具有 45.06 mV/十倍频程亚阈值摆幅 (SS) GS 系列,可在未来电压可扩展 NCFET 应用中实现新机遇。 Ge/ZrOx的类铁电行为 提出 /TaN 电容器源自氧空位偶极子。非晶态 HfO2 和 ZrOx 的 NC 效应 薄膜器件可以通过栅极泄漏的突然下降、负微分电阻 (NDR) 现象、I 的增强来证明 DS 和亚 60 亚阈值摆动。 5 纳米 ZrOx 基于 NCFET 的顺时针滞后为 0.24 V,低于 60 mV/decade SS 和 12% I 与不含 ZrOx 的控制装置相比,DS 增强 .与 ZrOx 相比,Al2O3/HfO2 NCFET 的抑制 NC 效应 由于Al2O3/HfO2界面处的负界面偶极子,NCFET与正向扫描中氧空位偶极子的部分转换有关。
背景
随着互补金属氧化物半导体(CMOS)器件的不断缩小,集成电路(IC)技术已进入“超越摩尔时代”。 IC产业和技术的驱动力不是晶体管的小型化,而是功耗的降低[1, 2]。然而,MOSFET 的玻尔兹曼暴政,超过 60 mV/decade SS 限制了能量/功率效率 [3]。近年来,许多提出的新型器件能够实现低于 60 mV/decade 的阈值摆幅,包括碰撞电离 MOSFET、隧道 FET 和 NCFET [4,5,6,7]。由于简单的结构、陡峭的 SS 和改进的驱动电流,具有铁电 (FE) 膜的 NCFET 被认为是这些新兴器件中有吸引力的替代品 [8,9,10]。已报道的 NCFET 实验主要包括 PbZrTiO3 (PZT)、P(VDF-TrFE) 和 HfZrOx (HZO) [11,12,13,14,15,16,17]。然而,沿多晶铁电材料晶界的高工艺温度和不希望的栅极漏电流限制了它们在最先进技术节点上的发展 [18,19,20,21,22,23,24,25 ,26]。最近,非晶 Al2O3 和 ZrOx 中的铁电性 已经研究了由电压调制的氧空位偶极子启用的薄膜 [27,28,29]。与晶体对应物相比,非晶类铁电薄膜在降低工艺温度和漏电流方面具有显着优势。因此,针对非易失性存储器和模拟突触应用的具有非晶栅极绝缘体的 FeFET 进行了大量研究 [27, 30,31,32,33,34]。然而,单晶体管ZrOx的系统研究 基于的NCFET尚未开展。
在这项工作中,Ge NCFETs 与 5 nm ZrOx 已经分别提出了铁电介电层和 5 nm Al2O3/HfO2 铁电介电层。我们通过实验观察到 ZrOx 中低于 60 mV/decade 的陡坡 (5 nm) NCFET,这可归因于 ZrOx 的 NC 效应 铁电层。我们分析了极化P 作为施加电压的函数 V 对于 Ge/ZrOx /TaN 电容器。 Ge/ZrOx的类铁电行为 /TaN 电容器由电压感应氧空位偶极子感应。此外,我们归因于改进的 I DS 和 I 的突然下降 Al2O3/HfO2 NCFETs 和 ZrOx 中的 G NCFETs 到 NC 效应。我们还在 Al2O3/HfO2 NCFET 和 ZrOx 中观察到了 NDR 现象 NCFET。此外,我们进一步分析了 Al2O3/HfO2 NCFET 中界面偶极子引起的 NC 效应降低的物理机制。 ZrOx 具有低于 60 mV/decade 的陡坡、改进的漏极电压和低工作电压的 NCFET 将适合“超越摩尔时代”的低功耗 NCFET 设计。
方法
具有 ZrOx 的 NCFET 的关键工艺步骤 和 Al2O3/HfO2 制造如图 1a 所示。不同的栅极介电绝缘体,包括 Al2O3/非晶 HfO2 (5 nm) 薄膜和非晶 ZrOx (4.2 nm) 薄膜通过原子层沉积 (ALD) 在 300 °C 下生长在 n-Ge (001) 衬底上。 TMA、TDMAHf、TDMAZr 和 H2O 蒸气分别用作 Al、Hf、Zr 和 O 的前体。 Hf 和 Zr 前驱体的脉冲时间和吹扫时间分别为 1.6 秒和 8 秒。 Al 前驱体的脉冲时间和吹扫时间分别为 0.2 秒和 8 秒。然后在 HfO2 或 ZrOx 上沉积 TaN 顶栅电极 通过反应溅射表面。源/漏 (S/D) 区由光刻图案化和干法蚀刻定义。之后,硼 (B + ) 和镍 (Ni) 沉积在源极/漏极 (S/D) 区域。最后,在 10 8 中在 350°C 下进行 30 秒的快速热退火 (RTA) 在 Pa 氮气环境下进行。图 1b、d 显示了制造的 Al2O3/HfO2 NCFET 和 ZrOx 的示意图 NCFET。图 1c 中的高分辨率透射电子显微镜 (HRTEM) 图像描绘了 Ge (001) 上具有 Al2O3 界面层的非晶 HfO2 (5 nm) 膜。图 1e 中的 HRTEM 图像描绘了无定形 ZrOx Ge (001) 上的 (4.2 nm) 薄膜。 ZrOx NCFET 的 C-V 曲线和 TaN/ZrOx(4.2 nm)/Ge 电容器的 X 射线光电子能谱(XPS)在附加文件 1:图 S1 中测量。
<图片>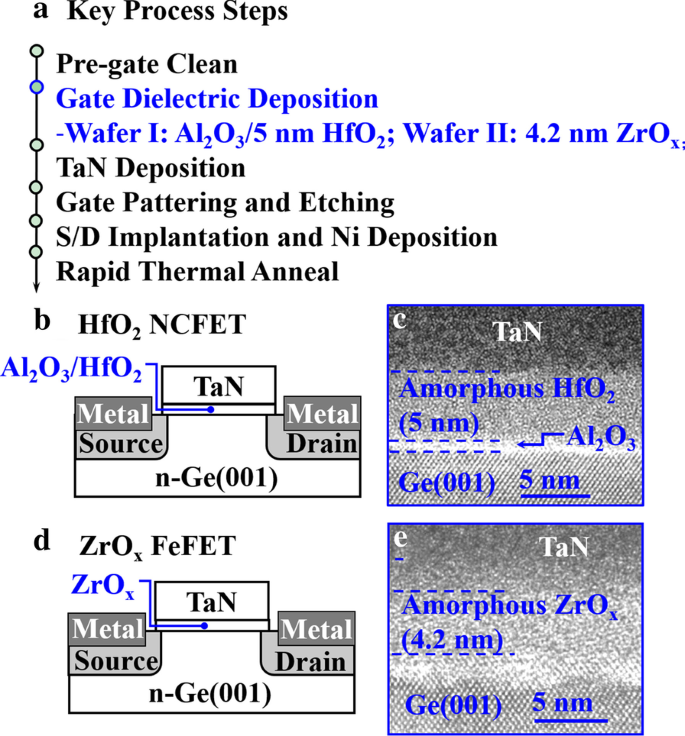
一 制造 Al2O3/5 nm HfO2 NCFET 和 4.2 nm ZrOx 的关键工艺步骤 NCFET。 b 原理图和c 制备的 ZrOx 的 HRTEM 图像 NCFET。 d 原理图和e 制备的 Al2O3/HfO2 NCFETs 的 HRTEM 图像
结果与讨论
图 2a 显示了测量的极化曲线 P v.s. 施加电压V Ge/ZrOx 的特性 /TaN 电容器,频率为 3.3 kHz。栅极长度 (L G) 的电容器为 8 μm。观察到剩余极化 P Ge/ZrOx 的 r /TaN 电容器可以通过更大的 V 扫描范围来增强 .非晶态 ZrOx 的类铁电行为 建议图 2a 中的薄膜源自电压驱动的氧空位偶极子 [35]。图 2b 显示了测量的 P–V Ge/ZrOx 的曲线 /TaN 电容器在 200 到 10 kHz 的不同频率下。我们可以看到非晶 ZrOx 的类铁电行为 薄膜在所有频率下保持稳定。然而,P 无定形 ZrOx 的 r 薄膜随着频率的增加而减少。这种现象可以用高测量频率下不完整的偶极子切换来解释 [36, 37]。随着测量频率的增加,非晶ZrOx中电场方向改变的时间 薄膜减少。因此,部分氧空位偶极子转换不完整,提供了降低的P
<图片>
测量的 P 对比 V 4.2 nm ZrOx 的特性 a 的电容器 V 的不同扫描范围 和 b 不同的测量频率
图 3a 显示了测量的 I DS-V V下铁电Al2O3/HfO2 NCFET的GS曲线 DS 为 − 0.05 V 和 − 0.5 V。L 器件的 G 为 3 μm。 0.14 V (V DS =− 0.05 V, I ds =1 nA/μm) 和 0.08 V (V DS =− 0.5 V, I ds =1 nA/μm) 分别被证明。顺时针磁滞回线归因于氧空位的迁移并伴随着负电荷。氧空位偶极子在正(负)V下在Ge/Al2O3界面积累(耗尽) GS。因此,阈值电压 (V TH)在栅极电压的正向(反向)扫描下增加(减少)。如图 3b 所示,比较了 Al2O3/HfO2 NCFET 和控制 FET 的输出特性。 Al2O3/HfO2 NCFET 的饱和电流超过 26 μA/μm,在 |V 时比对照 FET 的饱和电流上升 23% GS-V TH| =|V DS|=0.8 V。电流增强是由增加的反转电荷强度引起的(Q inv) 在反向极化电场和表面电位的放大 [38, 39]。除了电流增强外,获得的明显 NDR 证明了非晶 HfO2 薄膜的 NC 效应。 NDR 效应是由于漏极到沟道的耦合导致氧空位偶极子的不完全转换引起的 V DS 增加 [40, 41]。图 3c 比较了测量的栅极泄漏 I G–V V 处 5 nm Al2O3/HfO2 NCFET 的 GS 曲线 DS 为 − 0.05 V 和 − 0.5 V。I 的突然下降 G 仅在反向扫描期间表明非晶 HfO2 膜中的电压降低和表面电位的放大 [42]。在前向扫描期间没有 NC 效应是由非晶 HfO2 膜中氧空位偶极子的部分转换引起的 [43]。 Al2O3 和 HfO2 层之间含有氧原子的不同能力导致氧重新分布和 Al2O3/HfO2 界面处的负界面偶极子 [44, 45]。由于负界面偶极子的存在,非晶HfO2薄膜很难在前向扫描中实现完全的偏振切换(NC效应)(附加文件1)。
<图片>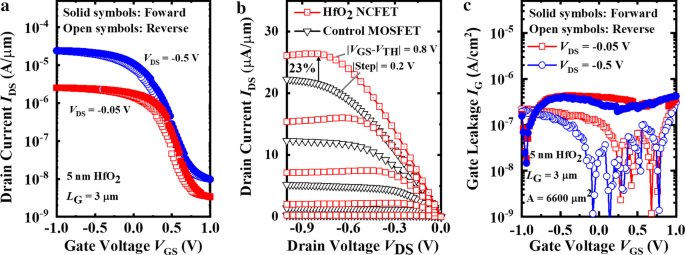
一 测量 I DS-V V 时 5 nm HfO2 NCFET 的 GS 曲线 DS =− 0.5 V 和 V DS =− 0.05 V。b 测量 I DS-V HfO2 NCFET 和控制 MOSFET 的 DS 曲线。 c 测量 I G–V V 时 5 nm HfO2 NCFET 的 GS 曲线 DS =− 0.5 V 和 V DS =− 0.05 V
图 4a 显示了铁电 ZrOx 的测量转移曲线 V 处的 NCFET DS 为 − 0.05 V 和 − 0.5 V。L 两个器件的 G 为 4 μm。 0.24 V (V DS =− 0.05 V, I ds =1 nA/μm) 和 0.14 V (V DS =− 0.5 V, I 分别证明了 DS =1 nA/μm)。如图 4b 所示,ZrOx 的输出特性 比较了 NCFET 和控制 FET。 ZrOx的饱和电流 NCFET 超过 30 μA/μm,在 |V 处与控制 FET 相比上升 12% GS-V TH| =|V DS|=1 V。提高的电流增强和更明显的NDR表明非晶ZrOx的NC效应增强 薄膜(5 纳米)与 5 纳米 HfO2 薄膜的对比。图 4c 比较了测量的栅极泄漏 I G–V 5 nm ZrOx 的 GS 曲线 V 处的 NCFET DS 为 − 0.05 V 和 − 0.5 V。与突然的 I 相比 仅在图 3c 中的反向扫描期间,Al2O3/HfO2 NCFET 的 G 下降,I 的突然下降 图 4c 中正向和反向扫描中的 G 也证明了非晶 ZrOx 中增强的 NC 效应 电影。
<图片>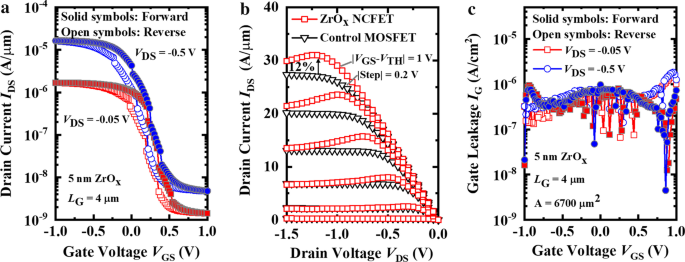
一 测量 I DS-V 5 nm ZrOx 的 GS 曲线 V 时的 NCFET DS =− 0.5 V 和 V DS =− 0.05 V。b 测量 I DS-V ZrOx的DS曲线 NCFET 和控制 MOSFET 显示出明显的 NDR 现象。 c 测量 I G–V 5 nm ZrOx 的 GS 曲线 V 时的 NCFET DS =− 0.5 V 和 V DS =− 0.05 V
图 5a、b 显示了点 SS 作为 I 的函数 Al2O3/HfO2 和 ZrOx 的 DS V 处的 NCFET - 0.05 V 和 - 0.5 V 的 DS。如图 5b 所示,在 V 的正向或反向扫描期间可以实现低于 60 mV/decade 亚阈值摆幅 (SS) V 处的 GS DS of− 0.05 V 和− 0.5 V。当 V DS 是- 0.05 V,实现了 45.1 mV/dec 的点正向 SS 和 55.2 mV/dec 的点反向 SS。当 V DS 是- 0.5 V,实现了 51.16 mV/dec 的点正向 SS 和 46.52 mV/dec 的点反向 SS。由于对Al2O3/HfO2和ZrOx的清除能力不同 层,粒子偶极子切换是在 Al2O3/HfO2 NCFET 中引起的。因此,在 5 nm ZrOx 下实现了更明显的 NC 效应,低于 60 mV/decade SS NCFET。
<图片>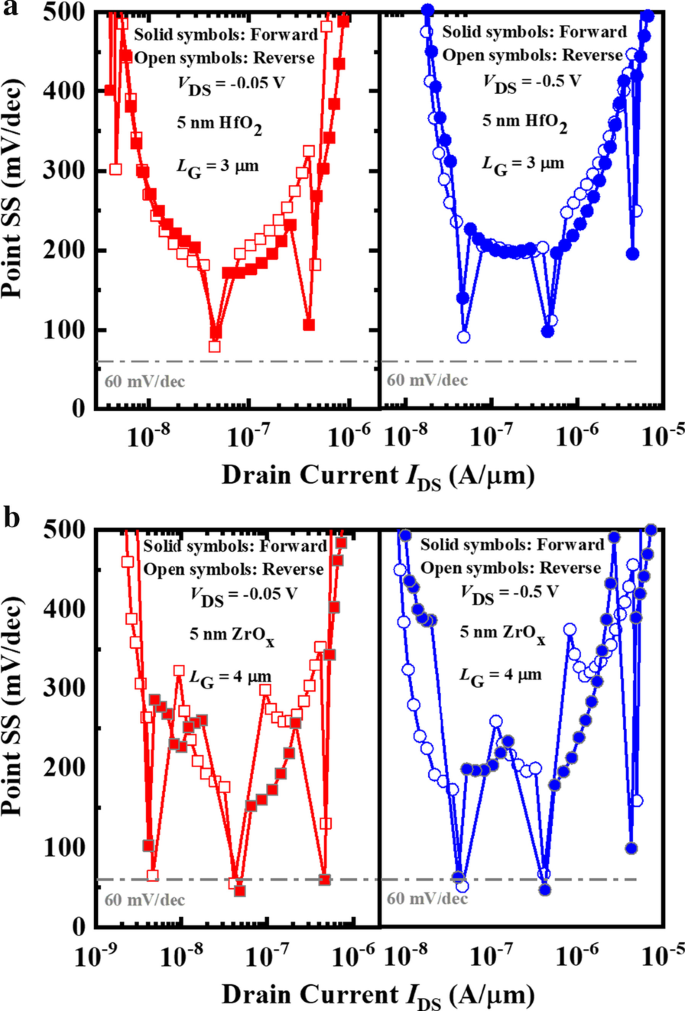
点 SS 作为 I 的函数 a 的 DS Al2O3/5 nm HfO2 NCFET 和 b 5 纳米 ZrOx NCFETs
结论
我们报告了铁电 NC ZrOx 的演示 pFET 具有低于 60 mV/decade SS、1 V 的低工作电压和小于 60 mV 的滞后。无定形 ZrOx 的影响 铁电行为的薄膜由氧空位偶极子解释。改进的I 在 Al2O3/HfO2 NCFET 和 ZrOx 中也获得了 DS 和 NDR 现象 NCFET 与控制设备相比。 Al2O3/HfO2 NCFET 抑制的 NC 效应可归因于 Al2O3/HfO2 界面处的界面偶极子导致的局部偶极子切换。 ZrOx 具有低于 60 mV/decade 的陡坡、改进的漏极电压和低工作电压的 NCFET 为未来的低功耗 NCFET 设计开辟了新途径。
数据和材料的可用性
本文包含支持本文结论的数据集。
缩写
- TaN:
-
氮化钽
- ZrOx :
-
二氧化锆
- TDMAZr:
-
四(二甲基酰胺基)锆
- P r :
-
剩余极化
- E :
-
矫顽电场
- MOSFET:
-
金属氧化物半导体场效应晶体管
- 哥:
-
锗
- ALD:
-
原子层沉积
- B + :
-
硼离子
- Al2O3 :
-
氧化铝
- HRTEM:
-
高分辨透射电子显微镜
- Ni:
-
镍
- RTA:
-
回热退火
- I DS :
-
漏电流
- V 高:
-
栅极电压
- V :
-
阈值电压
- NCFET:
-
负电容场效应晶体管
纳米材料
- 结型场效应晶体管 (JFET) 作为开关
- 材料:具有改进表面特性和优化填充行为的 EPP 泡沫
- 具有低电阻 Au 欧姆接触的多层 SnSe 纳米片场效应晶体管
- 火花等离子体烧结 SiC 与通过热直流等离子体工艺制备的 Si-SiC 复合纳米颗粒的烧结行为
- 具有超弹性和高电容的石墨烯/聚苯胺气凝胶作为高抗压超级电容器电极
- 具有 HfO2 缺陷控制层的单壁碳纳米管主导的微米宽条纹图案化铁电场效应晶体管
- T 形栅极双源隧道场效应晶体管的模拟/射频性能
- 基于石墨烯的纳米级真空通道晶体管
- 具有增强型双栅极和部分 P 埋层的超低导通电阻横向双扩散金属氧化物半导体晶体管
- 具有高开/关比和极性可切换光电导性的 SnSe2 场效应晶体管
- 通过原子层沉积制造的用于具有增强电容的超级电容器电极的 TiO2 纳米膜
- 高性能车削能力,占地面积小


