弱光下端键合 InAsSb 纳米线阵列探测器的光电特性
摘要
本研究展示了一种简单的末端键合接触 InAsSb NW(纳米线)阵列检测器的制造,用于弱光。该探测器使用通过分子束外延在 GaAs 衬底上生长的 InAsSb NW 阵列制造。金属诱导的间隙状态是由末端键合接触引起的,它抑制了各种温度下的暗电流。由于界面间隙态的界面偶极子的存在增强了局部场周围的光激发,从而提高了对弱光的光响应性和光电探测性。本报告中红外光源的光强为 14 nW/cm 2 这比激光源小约 3 到 4 个数量级。探测器在室温下对光(945 nm)辐射的响应度达到了28.57 A/W,而探测率为4.81 × 10 11 cm·Hz 1/2 W −1 .在变温实验中出现了异常的温度相关性能,我们讨论了器件光响应与温度之间非线性关系背后的详细机制。此外,探测器的光电特性阐明了纳米线的光捕获效应和光门控效应可以增强对紫外到近红外弱光的光响应。这些结果突出了InAsSb NW阵列探测器在没有冷却系统的情况下检测红外弱光的可行性。
介绍
作为窄带隙 III-V 族半导体的重要分支,InAsSb 具有继承 InAs 的优点,例如电子有效质量小和电子迁移率高 [1, 2]。当 Sb 元素被引入 InAs 时,由于带隙弓形效应,三元 InAsSb 的截止波长响应可以扩展到长波长红外范围[3]。因此,InAsSb 被认为是红外检测领域的理想候选者 [4,5,6]。在光电领域,一维 (1D) 纳米结构 [7] 具有巨大的独特性质,包括具有众多陷阱态的大表面积、长光子吸收路径长度和由于其巨大的纵横比而具有机械柔性的结构 [8]。此外,在其开发过程中,一维纳米结构可以轻松地将晶格失配释放到基板上,从而实现高晶体质量 [9]。在此,基于一维纳米结构的光电探测器 [10]、太阳能电池 [11] 等光电子学的应用引起了巨大的研究兴趣。其中,提出了定制的器件结构[12],以实现优化的光吸收和宽带光收集,使一维纳米结构适用于各种应用场景,并实现与硅基集成电路的兼容组件。最近,基于单个 InAs NW 的光电探测器已经证明了它们在红外探测中的潜力 [13]。随着 Sb 的加入,三元 InAsSb 可以在室温检测的广谱范围内获得 [14]。随着 Al2O3 的钝化,基于 InAsSb NW 的探测器已经实现了对中波长红外光谱的非冷探测 [15]。然而,在这些研究中广泛应用的常规光源是高强度激光器,并且这些设备中的大多数不能在室温下工作 [16]。此外,传统的基于纳米线的器件结构不利于兼容集成电路的大规模应用。基于 InAsSb NW 的传统探测器主要有三种类型,包括单个 NW 器件 [17]、嵌入 InAs NW 中的量子阱 [3] 和垂直单个 NW 器件 [14]。所有这些都需要昂贵的纳米制造工艺,例如电子束光刻 (EBL) 和反应离子蚀刻 (RIE)。因此,器件结构的创新是纳米线应用的迫切需要。
尽管尺寸有限,但接口始终在设备的光学和电气性能中起着至关重要的作用,这使得基于 NW 的设备中的接触工程成为另一个重要因素 [18]。例如,利用石墨烯量子点和聚苯乙烯磺酸盐之间的界面,在混合结构中实现了对弱光具有优异的全向光电探测特性的太阳能电池[19]。在这项研究中,我们使用电极和半导体之间界面的能带结构来调节器件的光电性能。电荷重新分布发生在金属-半导体界面,电荷转移发生在金属和金属波函数尾部进入半导体之间。这种重新分布被称为 MIGS,它可以在界面态引起间隙态和界面偶极子 [20]。然而,MIGS 模型的模拟结果在实验之间仍然存在偏差,这被认为是由界面缺陷、制造诱导缺陷和费米能级钉扎造成的 [21]。特别是对于具有丰富表面态的 InAsSb NW,费米能级钉扎是不可避免的,因此感应的间隙态会过滤电荷转移。这样可以将器件的暗电流抑制在可接受的范围内。此外,界面偶极子可以增强局部场中的光激发,这对于弱光检测至关重要。根据楚的讨论。等人,末端键合结比平面键合结更有可能实现金属和半导体之间的状态重叠 [18]。然而,通过单个 NW 的末端键合器件在制造过程中面临着障碍。在这里,我们提出了一个解决方案,通过使用 NW 阵列来实现 NW 和金属之间的末端键合接触。与传统的光电探测器相比,三明治结构的 NW 阵列器件具有制造容易和环境适应性强的优点 [22, 23]。填料 (AZ5214) 在制造过程中在 NW 周围旋涂和烘烤,使设备更稳定,对环境具有抗氧化性。当光被引入 NW 阵列时,它会在不同方向多次反射和折射,从而增强内部对光的吸收 [24, 25]。 NW 阵列中延长的光路被称为光捕获效应 [26, 27],它广泛用于基于 NW 的阵列设备。能带结构和器件结构都为器件在室温下进行弱光检测提供了潜力。
在这项研究中,我们制造了基于通过 MBE(分子束外延)生长的 InAsSb NW 的 NW 阵列器件。由金属-半导体接触引起的间隙态和界面偶极子可以分别抑制暗电流和增强光检测[28]。 NW 阵列夹层结构的光捕获效应有助于弱光检测[29]。室温下抑制的暗电流极大地减少了检测噪声,并使室温下的检测成为可能[30]。固化装置结构使装置能够在周围环境中工作。此外,由于预计会出现复杂的界面态,因此器件的光响应会随温度而波动。在恒定温度下,光电流值随入射光强度线性增加,显示出光功率计的潜力。
方法/实验
InAsSb NW 使用 MBE 系统(Riber 32 R&D)和原位 Au 蒸发系统在 GaAs {111}B 衬底上生长。对外延基板进行预处理以去除污染物。然后,在 540°C 下沉积 GaAs 缓冲层 15 分钟,并通过蒸发和退火工艺形成 Au 纳米颗粒。 InAs 茎在温度恒定保持在 380°C 的情况下生长 20 分钟,然后将 Sb 源引入生长室 60 分钟。在 NW 生长过程中,In BEP(束流等效压力)保持为 2.7 × 10 –7 mbar,As BEP 为 2.2 × 10 –6 mbar,Sb BEP 为 7 × 10 –7 mbar,导致 V/III 通量比为 ~ 11,Sb/As 比为 ~ 0.3。
对于器件制造,AZ5214(光刻胶)用作支撑剂以保持 NW 的方向。然后将带有基板的 NW 阵列用 AZ5214 以 3000 rpm 的速度旋涂 30 秒,并在 120°C 下烘烤 2 分钟。凝胶 AZ5214 是透明的,可最大限度地减少测量过程中的光损失。为了暴露 NW 的尖端,阵列的表面通过精密剪切规 (Logitech) 进行抛光。在 NW 生长过程中通过 VS(汽-固)机制在衬底表面形成的 InAsSb 层可以作为漏电极。根据 InAsSb 外延层的霍尔测量(如附加文件 1:图 S1 所示),室温载流子浓度约为 2 × 10 17 厘米 −3 , 而迁移率约为 1.6 × 10 4 厘米 2 /(V·s) 在室温下。之后,在选定区域上沉积标称厚度为 8 nm 的 Au 膜,其中一个在阵列顶部,另一个在外延层上。沉积的Au厚度小,保证了电极的透光性和测量过程中可接受的光损失。
使用SEM(FE-SEM,JEOL 7800F)和TEM [TEM,Philips Tecnai F20,配备能量色散光谱(EDS)进行成分分析]研究了获得的InAsSb NW的形态,化学和结构特征。通过在乙醇中超声处理 NW 样品并将它们分散到由碳膜支撑的 Cu 网格上制备用于 TEM 分析的单个 NW。
光电导率测量是在配备 LED 作为光源的氦闭循环低温恒温器中进行的。该系统中的温度可以在 2 K 和室温之间连续调制,而 LED 的光强度可以通过输入电流轻松调节。本研究采用了包括 260 nm、620 nm 和 945 nm 在内的各种波长的 LED。 LED 的光强与温度和输入电流有关。强度随电流线性增加并随温度降低。本次测量的室温光强值为4000 nW/cm 2 260 纳米,558 nW/cm 2 用于 620 纳米和 14 nW/cm 2 945 纳米。相关的光强信息可以在参考文献中找到。 [30]。在源极和漏极之间施加恒定电压 VDS =100 mV。通过调节LED的开/关可以获得光电导响应。
结果与讨论
图 1 显示了 InAsSb 纳米线的电子显微镜研究。图 1a 是倾斜视图 SEM 图像,显示 NW 的直径范围为 100 至 200 纳米,长度范围为 6 至 8 微米。图 1b 显示了典型单个 NW 的明场 (BF) TEM 图像,表明典型的锥形结构。根据我们的定量 EDS 分析,沿着其轴向,NW 的成分显示出适度的渐变,平均 Sb 浓度高达 30%(详细信息可在附加文件 1:图 S2 中获得)。图 1c 显示了 NW 中间部分的 HRTEM 图像,证实了双平面的存在。图 1d 中显示的选区电子衍射 (SAED) 图案也验证了孪晶结构,并且可以区分两组 ZB(闪锌矿)结构的衍射。 Sb 元素可用作表面活性剂并抑制 InAs NW 的 WZ(纤锌矿)相 [31],有利于从 WZ 到 ZB 的结构相变。在我们的例子中,V/III 比率为 ~ 11,导致富含 V 的环境,这有利于 ZB 结构的成核 [32],但留下一些孪晶面。 InAsSb NWs孪晶结构的研究表明,边界处的位移会导致局部Sb分布不均匀[12],有利于电子散射或载流子俘获[33]。
<图片>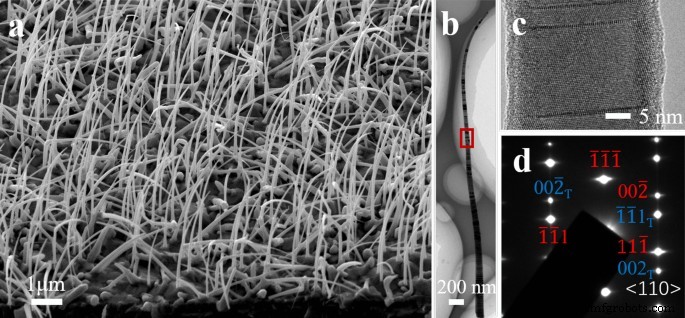
InAsSb NW 的高级电子显微镜研究。 一 NW 的倾斜视图 SEM 图像。 b 单个 NW 的明场 (BF) TEM 图像。 c 从 b 中标记区域的 NW 中部拍摄的高分辨率 TEM (HRTEM) 图像 . d 取自 c 的相应 SAED(选区电子衍射)图
器件结构如图 2a 所示,其中 Au 膜覆盖阵列的顶部和底部。设备的 SEM 图像显示在附加文件 1:图 S3 中,其中剩余长度约为 3 µm,几乎所有 NW 都已集成。光刻胶用于保持 NWs 定向并将 NWs 集成到固化设备中;这样,器件更抗氧化,更适合应用。锥形结构用于非晶硅 NWs 阵列器件,表现出增强吸收并且对入射角不敏感 [34]。图 2b 是 MIGS 模型确定的 Au-InAsSb 界面的示意图。图 2c、d 证实了与温度无关的几乎恒定的电导,并且电导的值约为 1 × 10 –7 Ω −1 .在没有入射光的情况下,2 K 和 300 K 的 I-V 曲线如图 2d 所示。单个纳米线具有更大的电导值,如附加文件 1:图 S4 所示。阵列器件相当于一个并联电路,由数千个单独的 NW 连接,因此理论电导应该是一个更可观的值。此外,我们对电导相关问题有两个基本知识:(1)单个 NW 的电导表现出对温度的强烈依赖性; (2) 我们研究中由 InAs NW 制成的阵列器件也具有恒定的电导。因此,我们得出结论,该器件中金属和半导体之间的接触具有决定整体输出特性的可观电阻。
<图片>
InAsSb NW 阵列器件的结构和电学特性。 一 设备的示意图,插图中显示了 SEM 图像。 b Au-InAsSb 界面态的能量图。 c 器件的温度相关电导。 d 分别在 2 K 和 300 K 无光下的 I-V 曲线
当 Au 通过端键合接触加入 InAsSb NW 时,电荷转移通过金属电子波函数的尾部在界面处发生,这被称为 MIGS 的连续体 [18]。一旦接触形式会导致界面偶极子发展,界面处的电荷重新分布就会发生[35]。根据 MIGS 模型,界面势垒高度由 \({\Phi }_{\mathrm{Au}}\)(金属的功函数)、\({\Phi }_{\mathrm{NW }}\)(InAsSb NW 的电子亲和力)和 \({\Delta }_{i}\)(由于界面偶极子在界面形成时发生的电压降)。 \({\delta }_{i}\) 是金属引起的间隙状态的距离。电子状态显示在图 2b 中。界面偶极子可以为电子创造一个额外的势垒[36],但该效应被限制在 \({\delta }_{i}\) 的区域内。最重要的是,器件的固有特性受大寄生接触电阻的调节 [37]。在我们的器件中,大接触电阻有效地降低了暗电流,而该值与温度无关。这样,可以将载流子浓度限制在对光检测有利的范围内。然而,界面偶极子随温度变化而保持恒定的接触电阻机制仍有待更深入的研究。
在图 3a 中,我们显示了从 2 到 120 K 的设备电流,有和没有光照,其余部分显示在附加文件 1:图 S5 中。 LED 的状态随时间调整,其中“ON”和“OFF”状态将分别保持 60 秒。 LED在“ON”状态下显示的具体电流值分别为10、20、50、100、200、500、1000、2000和3000 uA。测量是在 2 到 300 K 的不同温度下进行的。图 3a 中的插图显示了三种最弱光(约 4–10 nW/cm 2 ) 照明,表明与图 3a 类似的趋势。然而,用最弱的光可以说明明显不同的光学行为,特别是对于较慢的响应速度和稍微持久的光电导。图 3b 显示了设备在 20 K 时的响应时间,而 LED 的电流为 2000 μA。值得注意的是,图 3c 是在室温下的周围环境中获得的。更重要的是,我们这里使用的光源都是LED,光强值为4000 nW/cm 2 (260 纳米),558 纳米瓦/厘米 2 (620 nm) 和 14 nW/cm 2 (945 nm),分别。除了光响应性外,从不同光波长的响应速度来看,InAsSb纳米线对红外光的响应更好。
<图片>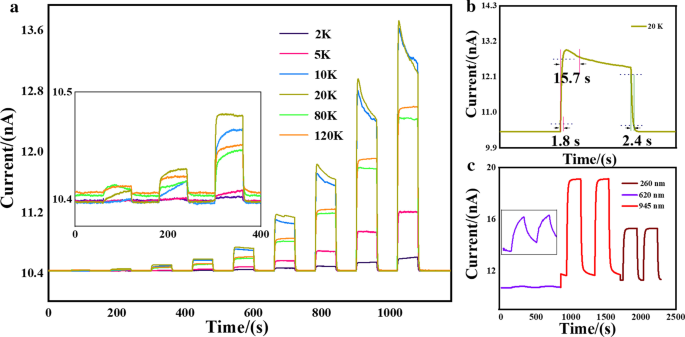
不同温度下源漏电导的时间依赖性。 一 器件在不同温度下对具有不同输入电流的 620 nm LED 的光响应。 b 器件在 20 K 时的响应时间,而 LED 的输入电流为 2000 μA。 c 器件在室温下在 260 nm、620 nm 和 945 nm 光照下的波长依赖性光电性能。插图显示了对 260 nm LED 的光响应的放大版本
图 3a 显示我们的器件对不同温度下 LED 状态的变化具有快速而明显的正响应,并且光电导随 LED 电流的增加而增加。在没有光照的情况下,器件的电导约为1.04 × 10 –7 Ω −1 ,这与图 2c 所示的输出测试一致。在固定温度下,ΔG的值 (定义为电导减去暗电导)与代表光强度的 LED 电流几乎呈线性增加。当光源被遮挡时,器件电流立即恢复到初始状态。 ΔG的最大值 在这个图中是 3.2 × 10 –8 Ω −1 在 10 K。应该注意的是,在此图中可以区分两种光响应:
- 1.
在大多数温度下,一旦LED开启,电流会迅速增加,只要LED开启,电流就稳定;
- 2.
在 10 K 和 20 K 时,电流也随着光照度快速增加。然而,随着 LED 开启,电流略有下降,在图中留下一条尾巴,这在其他温度下是没有的。
为了阐明两种不同光响应的内在机制,提取了 LED 电流为 2000 μA 时在 20 K 时的响应速度信息作为证据,具体值如图 3b 所示。响应时间 [38, 39] (τ ris 表示从 90% 电流峰值到 10% 电流峰值的时间间隔)被确定为 1.8 秒,而恢复时间(τ rec 定义相反)是 2.4 秒,这在整个温度范围内几乎是一个常数。对于 10 K 和 20 K,“尾部”结构的延迟时间约为 15.7 秒,这在 LED 电流小于 500 μA 时令人惊讶地没有。结合图 3a 插图中的弱光条件,可以展示 10 K 和 20 K 下的三种光响应。对于最弱的光 (10–50 μA),电流会随着时间缓慢增加。当 LED 电流增加到 100–500 μA 时,响应会变快。一旦电流超过 1000 μA,就会形成尾部。换句话说,只有足够的光强度才能触发瞬态“尾巴”结构。 InAs NW 中已经广泛报道了类似的“尾部”结构 [40, 41]。这些报道中的光源都是高光强的激光器,这与我们的“尾巴”结构只出现在高光区的结果一致。他们声称“尾巴”来自滞后效应,该效应对应于载流子在表面态上的俘获和解俘[42]。在我们的案例中,对于 InAsSb NW,由于与 Sb 结合的严重表面活性剂效应,表面状态更加不可避免[43]。因此,我们预计“尾部”结构起源于孪晶结构的缺陷态,仅在足够强的光辅助下在某些温度下俘获电子。
对于给定的光电探测器,光响应度可以表示为 [44]
$$\mathrm{R}=\frac{{I}_{\mathrm{p}}}{PA}$$ (1)其中\({I}_{\mathrm{p}}\)是器件的光电流,\(P\)是器件的光功率,\(A\)代表器件的有效面积。对于我们的设备,设备的有效面积为 1 mm 2 由电极蒸发时使用的掩膜决定,光度计的受光面积为0.9 cm 2 .在这种情况下,可以确定器件的光响应度分别为 4.25 mA/W (260 nm)、1.27 A/W (620 nm) 和 28.57 A/W (945 nm),进一步证实了 InAsSb 的潜力红外探测中的NW三明治结构装置。
器件的光电探测可以表示为 [14]
$${D}^{*}=R{A}^\frac{1}{2}/{(2e{I}_{\mathrm{dark}})}^\frac{1}{2}$ $ (2)其中 R 是设备的光响应度和 e 是电子电荷。 我 dark 表示设备的暗电流,值为 10.8 nA。在InAsSb NW三明治结构中抑制暗电流后,光电探测器\({D}^{*}\)的值达到7.28 × 10 7 (260 nm), 2 × 10 10 (620 nm) 和 4.81 × 10 11 cm·Hz 1/2 W −1 (945 nm),分别。值得注意的是,这种阵列结构中 NW 的占空比小于 50%,这使得实际的 R 并且 \({D}^{*}\) 比我们计算的结果大。高 R 和 \({D}^{*}\) 不仅归因于阵列器件的光捕获效应,还源于界面结构[2]。与参考文献中总结的基于纳米线的光电探测器相比。 [45],我们设备的 300 K 工作温度在现实世界中具有卓越的应用潜力 [6]。此外,在室温范围内,我们易于制造的 InAsSb NW 阵列器件(945 nm 时为 28.57 A/W)的光响应率可能超过最复杂的基于 NW 的器件(WSe2/Bi2Te3:980 nm 时为 20 A/W [46], PtSe2/钙钛矿:800 nm 处为 0.12 A/W [47])。尽管界面偶极子在实验上无法达到,但图 2 中的输出特性可以为其在我们的设备中的存在提供可靠的证据。正如在前面的讨论中所建议的那样,该器件的界面层可以作为具有光照射的光学偶极子晶格,这可以有助于更大的场增强因子。这种效应在之前的研究中被称为界面偶极子增强效应 (IDEE) [48]。与仅存在于共振波长范围内的表面等离子体增强效应相比,IDEE 适用于更大的波长范围。界面态周围的增强效应和阵列器件的光捕获效应共同作用于我们器件中的弱光检测。
图 4 显示了 InAsSb NW 器件的光响应与温度(图 4a)和光强度(图 4b)之间的关系。 \({I}_{p}\) 的值是光电流可以在光照下获得的极值。光响应通过精确的光强度进行归一化,以屏蔽其对趋势的影响。首先,我们可以得出类似的趋势,不同的光照强度。在所有图中,绝对光电导从 2 增加到 20 K,然后下降到 80 K,在 20 K 附近留下第一个峰,在 100-120 K 附近留下第二个峰。该峰的温度范围与特定温度一致瞬态光电流“尾部”存在的范围。另一个峰值在 100-120 K 左右,其特定位置随着光强度的增加而移动到更高的温度区域。
<图片>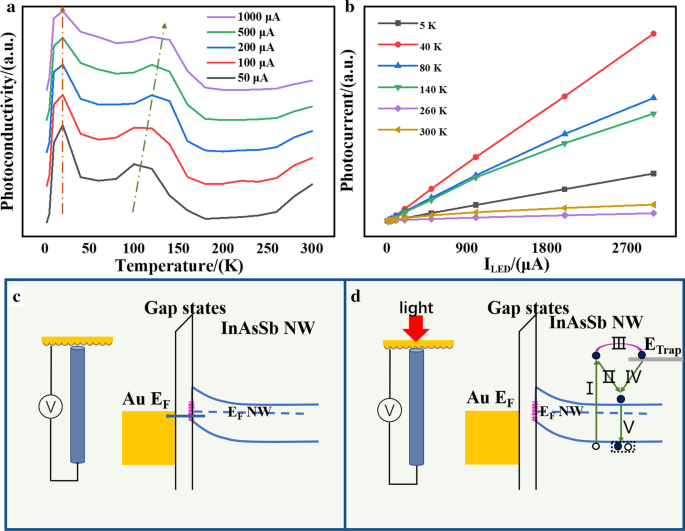
一 ΔG的温度依赖性 用不同的光强测量。 b ΔG 的功率依赖性 在不同温度下测量。 c 带有偏置电压的器件的能带结构。 d 光照射装置的能带结构
光电流可表示为 [28]
$${I}_{p}=qg{V}_{\mathrm{NW}}[\tau {\mu }_{d}/l]$$ (3)其中 \(q\) 是元素电荷,\(g\) 是光载流子生成率,\({V}_{\mathrm{NW}}\) 是 NW 体积,\(\tau\) 是少数载流子寿命,\({\mu }_{d}\) 是漂移迁移率,\(l\) 是 NW 长度。该方程阐明了少数载流子寿命和漂移迁移率是光电流的两个关键参数 [43]。 InAsSb 阵列器件的光电过程如图 4c、d 所示。在光输入之前,Au 和 InAsSb NW 之间的电子转移形成暗电流。由于界面偶极子导致的间隙状态足够短,足以以足够的动量进行载流子转移。在我们的器件中,由原生孪晶结构引起的界面态和由制造引起的缺陷都可以作为俘获态。点亮后,具有足够能量和动量的多余电子将被困在界面态上,如过程 I 和 III 所示。降低的电子浓度使通道中的迁移率增加并延长光生电子的寿命。另一方面,界面态的俘获电子使沟道中的电子发生散射,使迁移率降低。释放的电子将通过过程 IV 返回导带并参与电流。具有较低能量的电子将被激发到导电带上并参与电流,如过程 II 所示。一段时间后,电子将与留在价带中的空穴重组,如过程 V 所示。 我们可以得出装置中的两种散射过程:俘获电子散射中心和通道中的电子 - 电子散射 [49] .界面态上更多的俘获电子会降低沟道中的载流子迁移率和载流子浓度。随后,电子 - 电子散射将减弱并依次作用于迁移率的增加。总之,这两个散射过程将在电流上协同并在 10-20 K 左右达到一个极端。该峰的显着特征是“尾部”结构、稳定的峰位和在超弱光照射下的持久光电导。在超弱光照射下,光子的诱导量不足以立即达到饱和光电流。因此,该器件在饱和之前显示出持续的光电流。当光强增加时,光激发载流子使电流升高并在很短的响应时间内达到极值。然而,它在更高的光强度下更复杂。饱和态上的多余载流子被困在界面态中。当俘获的电子释放到导带时,浓度再次增加。电子-电子散射的增加使电流减小,称为滞后效应,并产生“尾”结构。
对于 100-120 K 附近的第二个峰,在 Bi2Te3 薄膜中报道了类似的峰位移 [50]。我们的分析表明在该温度范围内存在重组中心。内在机制与Bi2Te3类似,都与光电流(\({I}_{\mathrm{p}}\))和暗电流(\({I}_{\mathrm{d}}\) ))。在我们的例子中,\({I}_{\mathrm{d}}\) 在整个测量温度范围内几乎是恒定的。 \({I}_{\mathrm{p}}\) 由少数载流子寿命和漂移迁移率决定。注意到 InAsSb NW 的这两个参数与温度具有相反的依赖关系。对于少数载流子寿命,热激发的暗载流子随着温度和光生载流子的复合率而增加 [51]。因此,少数载流子寿命与温度成反比。漂移迁移率与温度成正比,因为高温会在 NW 中产生热激发效应。当 \({I}_{\mathrm{p}}\) 和 \({I}_{\mathrm{d}}\) 在某个温度(大约 100–120 K)达到平衡时出现峰值. 光强越高,光生载流子越多,在较高温度下需要更多的热激发载流子以达到平衡。因此,当光强度增加时,第二个峰向更高的温度移动。图 4b 显示了 InAsSb NW 器件的光强度依赖性光电导率,其中 ΔG 值未标准化。可以看出,LED 的光强严格随输入电流线性增加(参见附加文件 1:图 S6)。 Hence, this result represents the relationship between the photoresponse and the light intensity, demonstrating the potential of the InAsSb NW array device in optical power meter.
结论
In summary, the sandwich-structured photodetector based on InAsSb NW array has achieved a splendid optical performance due to the MIGS induced by the end-bonded contact. Interface dipole and gap states suppress the dark current and enhance detection ability of the device. The native defects and the fabricated-induced defects in the device act as the interface states to modulate the optical properties. Even with the ultraweak light (4–20 nW/cm 2 ) illumination, the device shows obvious photoresponse at room temperature. The response to LEDs with different wavelengths indicated that the InAsSb NW array device has the strongest response to the infrared light (945 nm). The photoresponsivity and photodetectivity are 40 A/W and 7 × 10 11 cm Hz 1/2 W −1 , 分别。 These results confirmed that the sandwich structure in this study favors the repeatability and reliability of the NW devices, which paves a way for the fabrication of NW-based devices. Most importantly, the device may work in an ambient environment at room temperature, which is a great breakthrough for infrared detection.
数据和材料的可用性
All data are fully available without restriction. The datasets used and/or analyzed during the current study are available from the corresponding author on reasonable request.
缩写
- MBE:
-
分子束外延
- 一维:
-
一维
- 西北:
-
纳米线
- BEP:
-
Beam equivalent pressure
- VS:
-
Vapor–solid
- VLS:
-
Vapor–liquid–solid
- EBL:
-
电子束光刻
- RIE:
-
Reactive ion etching
- WZ:
-
Wurtzite
- ZB:
-
Zinc blende
- BFTEM:
-
Bright-field scanning electron microscope
- HRTEM:
-
高分辨透射电子显微镜
- SAED:
-
选区电子衍射
- EDS:
-
能量色散光谱
- MIGS:
-
Metal-induced gap state
- IDEE:
-
Interface dipole enhancement effect
- LED:
-
Light emitting diode
纳米材料
- 量子传输走向弹道
- 半导体纳米粒子
- 纳米杯可以弯曲光线
- (p-i-n) 结 GaAs 纳米线太阳能电池中的等离子体增强光吸收:FDTD 模拟方法研究
- 纳米线/量子点混合纳米结构阵列太阳能电池的光伏性能
- <100>拉伸载荷下钽单晶弹性特性的温度和压力依赖性:分子动力学研究
- 使用 AlGaAs/GaAs 异质结优化 GaAs 纳米线引脚结阵列太阳能电池
- 采用后沉积蚀刻的浸渍法制备周期性聚苯乙烯纳米球阵列及其在提高 InGaN/GaN 光提取效率中的应用LED
- 通过快速分解阳极氧化制备的二氧化钛纳米管,用于在紫外线和自然日光下对有机染料进行光催化脱色
- 使用 AI 控制光的属性 |超连续谱生成
- C# - 属性
- 远红外微波动力学电感探测器 (FIR MKID) 阵列


