基于近红外增强纳米黑硅的双四象限光电探测器
摘要
本文提出了一种纳米黑硅的制备新工艺,该工艺在HF气体气氛中,通过纳秒脉冲激光烧蚀镀有Se膜的高阻硅制备高捕获光学掺Se黑硅材料。结果表明,退火前400-2200 nm波段的平均吸收率为96.81%,600度退火后吸收率保持在81.28%。同时,采用新技术制备的黑硅用于双四象限光电探测器,结果表明,在 50 V 反向偏压下,平均单位响应度在 1060 nm 处为 0.528 A/W,在 1180 处为 0.102 A/W nm,平均暗电流在内象限为 2 nA,在外象限为 8 nA。基于近红外增强黑硅的双四象限光电探测器具有响应高、暗电流低、响应快、串扰低等优点,适用于夜视检测、医疗等一系列应用方向。领域。
介绍
与其他波长的光电探测器 [4,5,6] 相比,近红外增强型光电探测器 [1,2,3] 难以获得令人满意的性能,因为它受到响应范围、响应速率、暗电流和近红外串扰的限制。红外波段。然而,自2005年凯里研制出第一台黑硅红外探测器后,基于黑硅材料的近红外光电探测器开始迅速发展。凯瑞开发的黑硅性能远超单晶硅红外探测器。不久,一些研究人员在黑硅探测器中加入了钝化技术,以降低其暗电流。黑硅[7,8,9]以其高吸收率和宽吸收光谱成为硅基近红外增强型光电探测器的首选材料。
作为半导体行业最重要的材料之一,做好黑硅材料的加工质量管理至关重要[10,11,12,13,14]。制备具有宽光谱、高吸收和低缺陷的黑硅对于高性能近红外光电探测器至关重要。已有一些研究采用飞秒激光[15, 16]在SF6气氛下扫描制备黑硅材料[17, 18],黑硅材料在紫外至近红外波段可达到90%以上的吸收[1]。 19]。然而,在高温退火后,近红外区域的吸收降低到50%左右。同时,研究人员发现,与掺硫黑硅相比,通过退火处理显着降低了掺硒和碲黑硅的吸收,但在固态硒和碲膜的掺杂工艺下,黑硅材料制备成小山,光线捕捉不够好[20, 21]。
本文提出了一种纳米黑硅的制备新工艺,该工艺在HF气体气氛中,通过纳秒脉冲激光烧蚀镀有Se膜的高阻硅制备高捕获光学掺Se黑硅材料。结果表明,退火前400-2200 nm波段的平均吸收率为96.81%,600度退火后吸收率保持在81.28%。同时,采用新技术制备的黑硅用于双四象限光电探测器,结果表明,在 50 V 偏压下,1060 nm 处的平均单位响应度为 0.528 A/W,1180 nm 处的平均单位响应度为 0.102 A/W,并且内象限的平均暗电流为 2 nA,外象限为 8 nA。基于近红外增强黑硅的双四象限光电探测器具有响应高、暗电流低、响应快、串扰低等优点,适用于夜视检测、医疗等一系列应用方向。领域。
方法
光电探测器是通过以下过程制造和测试的。首先制备黑硅材料,将N型高阻硅片切割成5cm × 5cm的样品,样品用标准清洗程序清洗后在氮气气氛中吹干。然后以纯度为99.99%的Se粉作为蒸发源,通过真空镀膜机在Si样品表面沉积一层Se膜。飞秒激光刻蚀工艺中引入HF气体,工艺参数如下:扫描速度:1mm/s;激光功率密度:4.5 kJ/m 2 ; HF气压:9 × 10 4 Pa. 本文使用的飞秒激光器是Spectra-Physics公司生产的Ti:sapphire飞秒激光放大器。其次,利用黑硅材料制备了双四象限光电探测器,双四象限光电探测器的结构示意图和具体制作工艺如图1和图2所示。 1和2。最后,用场发射扫描电子显微镜(SEM)对黑硅的形貌进行了表征,并通过NIR2500光纤光谱仪和积分球测试了材料的光谱特性。同时测试了光电探测器的响应电流、暗电流特性、上升时间。测试时,光源为Amonics波段的激光器,暗电流是通过在探测器上加一个黑盒来测量反向偏压下的电流,通过读取光电流的变化来测量响应时间使用激光脉冲信号作用于探测器时的示波器。
<图片>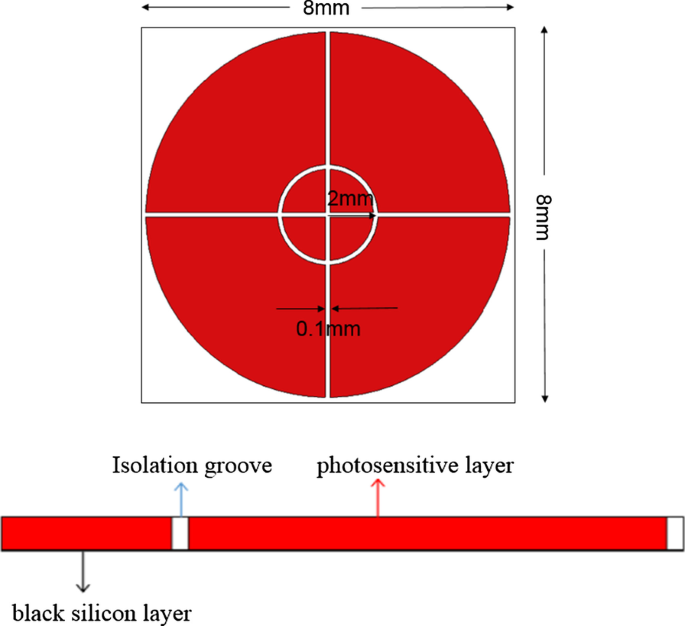
双四象限光电探测器结构示意图
<图片>
光电探测器的具体制造工艺
结果与讨论
本文采用纳秒脉冲激光烧蚀在HF气体气氛中对镀有Se膜的高阻硅进行纳秒脉冲激光烧蚀制备高俘获光学掺Se黑硅材料。一方面,由于Se涂层过饱和而不是使用传统的S掺杂硅,因此降低了退火对黑硅的影响。 S原子在Si晶格外的扩散速度比Se快;因此,退火效果较差。另一方面,HF在高温下分解为H+和F-,F离子与飞秒激光在高温下烧蚀的硅材料相互作用,产生挥发性的SiF4;这样,材料表面被不断蚀刻,形成纳米级金字塔结构,激光蚀刻产生的纳米级金字塔有效降低了黑硅的反射率。同时,表面钝化优化了少数载流子的寿命,减少了黑硅材料的缺陷密度和不必要的载流子复合。飞秒激光刻蚀简单、可重复,黑硅阵列的均匀性好,同时黑硅带隙宽度可以大大减小。通过进一步研究气体气氛、激光功率和激光扫描速度对黑硅材料性能的影响,可以得到优化的工艺流程。新工艺制备的黑硅在退火后的吸收性能有显着改善。
双四象限光电探测器采用黑硅材料在新工艺下制造;本文提出的结构示意图如图 1 所示。提出的光电探测器由光敏层、隔离槽和黑硅层组成。感光面外径为8mm,内径为2mm,感光区之间通过隔离槽隔开。所提出的光电探测器可以根据不同的象限探测结果确定目标相对于光轴的偏移大小和方位,从而实现精确定位。
通过商业软件COMSOL Multiphysics 5.4a对光电探测器的响应电流、暗电流特性、上升时间和串扰特性进行仿真,设计出最优结构。光电探测器的响应电流、暗电流特性、上升时间可由式(1)求出。 1-3。可以看出,在确定面积、入射功率和材料参数时,响应电流、暗电流和响应时间与I层厚度和偏置电压密切相关;因此,主要是模拟这些参数。
$${\text{I}}_{{\text{p}}} =\frac{{qP\left( {1 - R} \right)}}{hv} \cdot \left( {1 - \ frac{{e^{ - \alpha W} }}{{1 + \alpha \sqrt {D\tau } }}} \right) + qP\frac{D}{{\sqrt {D\tau } }} $$ (1) $${\text{I}}_{D} =\sqrt {Aqn\frac{W}{2\tau }} + \left( {\frac{2m}{{E_{g} }}} \right)^{\frac{1}{2}} \left( {q^{3} E\frac{v}{{4\pi^{2} \hbar^{2} }}} \right)Ae^{{\left( { - \frac{4}{3qE\hbar }\sqrt {2mE_{g}^{3} } } \right)}}$$ (2) $$T =\ sqrt {\left( {2.2t_{RC} } \right)^{2} + t_{d}^{2} + \tau_{d}^{2} }$$ (3)其中P代表入射功率,R代表反射率,α代表吸收系数,W代表层I的厚度,D代表空穴扩散系数,τ代表载流子寿命。 E \(\propto\) 偏置电压,tRC 代表电路时间常数,主要由等效电阻和电容决定。 td 为扩散时间,τd 为传输时间。
反向偏置电压对上述参数的影响如图3所示,可以看出随着偏置电压的增加,响应电流和暗电流也会增加;但是,上升时间会减少。因此,需要平衡响应电流、上升时间和暗电流随偏压增大的矛盾,根据需求选择合适的偏压。同样,对决定光电探测器厚度的PIN结构I层厚度也进行了模拟,结果如图4所示。同时,图5给出了隔离槽宽度对光电探测器的影响,可以看出,当隔离槽宽度增加到100 μm时,串扰率基本稳定。根据仿真结果得到最佳响应电流、暗电流和上升时间,具体器件参数如表1所示。
<图片>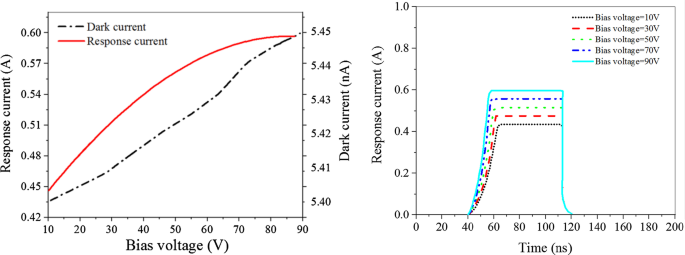
不同反向偏压下光电探测器响应电流、暗电流特性及上升时间变化曲线
<图片>
不同I层厚度下光电探测器响应电流、暗电流特性及上升时间变化曲线
<图片>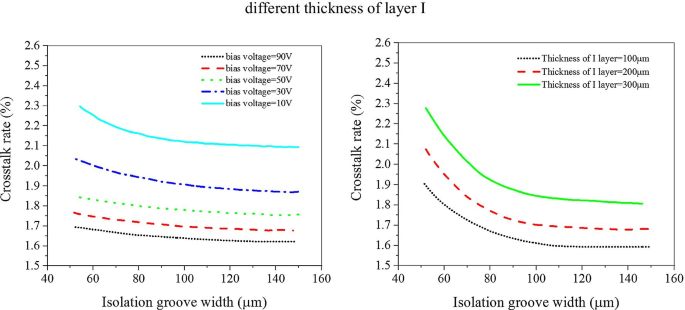
隔离槽宽度对串扰率的影响
为了实现光电探测器的高响应、快速响应速度和高稳定性,一些制造工艺也进行了优化[22,23,24]。首先,隔离槽和阻挡环的设计目的是减少相邻感光区之间的串扰。其次,采用晶圆减薄和抛光工艺来降低耗尽层厚度,以提高器件响应速度。第三,一步飞秒激光烧蚀制备黑硅是获得黑硅材料良好重复性和稳定性的关键。最后,通过对黑硅层进行亚表面钝化处理,降低和调节表面缺陷态密度,减少光生载流子的自重化合物,实现光电探测器的高响应性。光电探测器的具体制造工艺如图2所示。最终的器件示意图如图2j所示,其中I层厚度为180 μm,PN层厚度为10 μm,P + 由B在P型硅上重掺杂形成,N + 通过P的扩散形成接触电极,通过热蒸发沉积接触电极。
图6为高缺口光敏掺硒黑硅高温退火后表面形貌和光电性能的变化,具体加工参数如下:扫描速度:1mm/s;激光功率密度:4.5 kJ/m 2 ; HF气压:9 × 10 4 Pa. 从图中可以看出,高温退火前后的表面形貌在纳米级锥形黑硅阵列上分布较为均匀,无明显变化。在吸收光谱方面,本文新工艺制备的黑硅退火后的平均吸收率达到83.12%,与掺硫黑硅退火后的吸收率50%左右相比,耐火性能有显着提高。 .此外,还测试了飞秒激光脉冲扫描速度对黑硅材料性能的影响,结果如图7所示。可以看出,随着速度的降低,Se元素的掺杂量不断增加,导致黑硅尖锥形状更明显,吸收率更高。
<图片>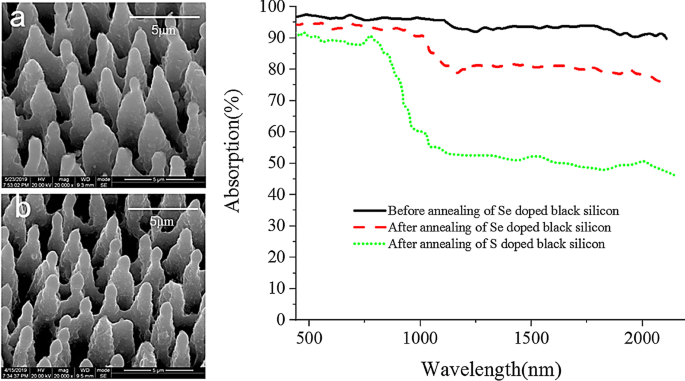
高温退火后材料表面形貌和光电性能的变化
<图片>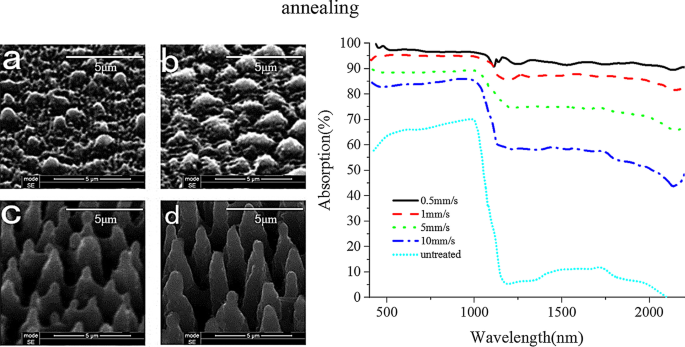
不同扫描速度下材料的表面形貌和吸收光谱a 10 毫米/秒,b 5 毫米/秒,c 2 毫米/秒,d 1 毫米/秒
根据Tauc映射理论,材料的带隙可以通过其吸收光谱的变换得到[25]:
$${\text{F}}\left( {{\text{R}}\infty } \right) \approx \frac{{{\text{A}}^{{2}} }}{{{ \text{2R}}}}$$ (4) $$\left( {{\text{h}}\nu \alpha } \right)^{{\frac{{1}}{{\text{n }}}}} ={\text{K}}\left( {{\text{h}}\nu - {\text{Eg}}} \right)$$ (5) $${\text{h }}\nu =\frac{{{1239}{\text{.7}}}}{\lambda }$$ (6) $$\left( {{\text{h}}\nu {\text{ F}}\left( {{\text{R}}\infty } \right)} \right)^{{\frac{{1}}{{2}}}} ={\text{K}}\ left( {{\text{h}}\nu - {\text{Eg}}} \right)$$ (7)其中A代表光谱吸收,R代表反射。通过计算hv-(hvF(R∞)) 1/2 的一阶导数得到拐点(一阶导数的最大点) 曲线,曲线的切线就在这一点上。切线与X轴交点的横坐标值就是样品的带隙。黑硅材料在不同扫描速度下的等效带隙宽度结果如表 2 所示,随着扫描速度的降低和 Se 掺杂浓度的增加,带隙宽度与传统硅材料的 1.12 eV 相比有所减小,并且光谱带在增加。
双四象限光电探测器的PIN结在不同材料的带隙下模拟。仿真结果如图 8 所示;结果表明,随着带隙宽度的减小,光电流吸收峰向近红外波段移动。因此,综合考虑仿真结果和光电探测器的光电性能,可以选择最佳扫描速度。
<图片>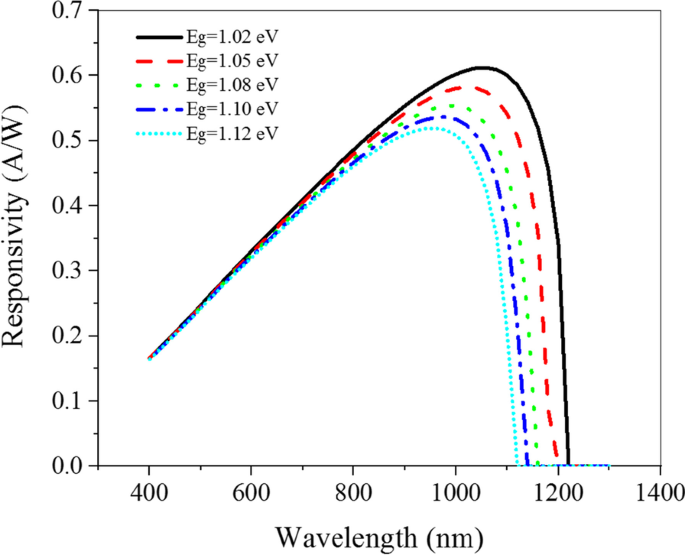
不同带隙对黑硅的响应度
使用相同的模拟过程来确定不同实验条件下的最佳材料制备参数,例如光功率密度和 HF 空气压力,如图 1 和图 5 所示。 9 和 10。
<图片>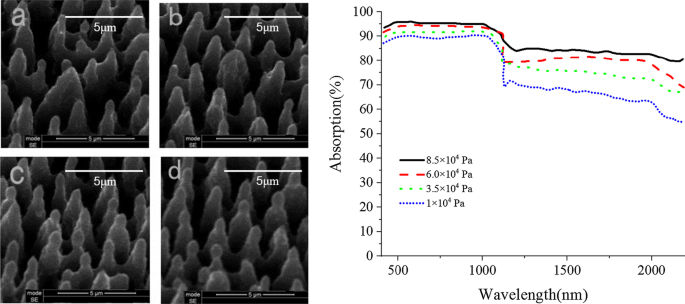
不同HF气压下材料的表面形貌和吸收光谱a 1 × 10 4 爸爸,b 3.5 × 10 4 帕,c 6 × 10 4 爸爸,d 8.5 × 10 4 帕
<图片>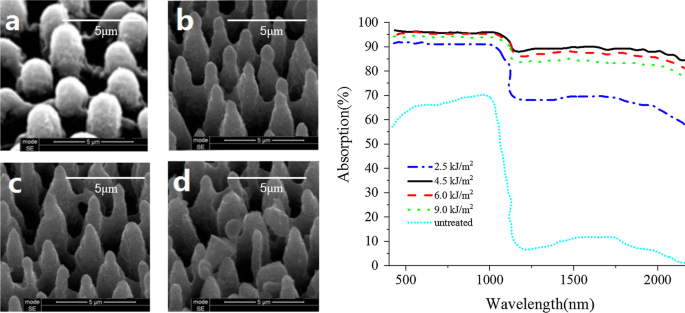
不同光功率密度下材料的表面形貌和吸收光谱a 2.5 kJ/m 2 , b 4.5 kJ/m 2 , c 6.0 kJ/m 2 , d 9.0 kJ/m 2
具体加工参数如下:扫描速度:1mm/s;激光功率密度:4.5 kJ/m 2 ; HF气压:9 × 10 4 Pa,在上述实验参数下,采用新技术制备黑硅材料,制成双四象限光电探测器。光电探测器的实物图和测试结果如图 11、表 3 和表 4 所示,响应度的结果是按 2 mW 层测量的。结果表明,在 50 V 反向偏压下,1060 nm 处的平均单位响应度为 0.528 A/W,1180 nm 处为 0.102 A/W,响应带范围为 400 至 1200 nm,与模拟基本相同结果。平均光谱吸收率90%以上,平均暗电流小于8 nA,暗电流是通过在探测器上加一个黑盒测量反向偏压下的电流,暗电流结果为比模拟结果稍大,因为实际加工中光敏区结的深度均匀性并不理想。同时,通过示波器读取激光脉冲信号作用于探测器时的光电流变化来测量响应时间,平均上升时间小于12 ns,符合预期的仿真结果。因此,本文制作的光电探测器不仅实现了四象限精确定位,而且探测带宽、暗电流低、响应快。
<图片>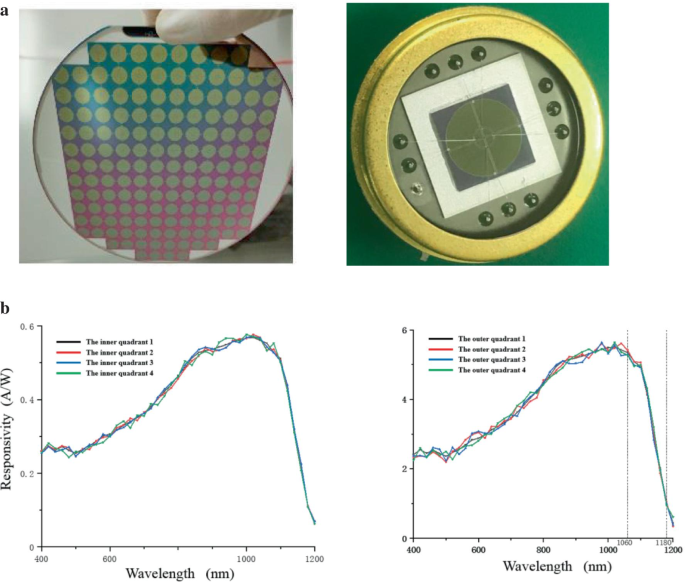
a 双四象限光电探测器的实物图。 b 不同双四象限光电探测器样品的响应度
结论
本文提出了一种新的黑硅制备工艺,该工艺通过飞秒激光烧蚀在HF气体气氛中对镀有Se膜的高阻硅进行飞秒激光烧蚀制备高捕获光学掺Se黑硅材料。结果表明,退火前400-2200 nm波段的平均吸收率为96.81%,600度退火后吸收率保持在81.28%。同时,采用新技术制备的黑硅用于双四象限光电探测器,结果表明,在 50 V 偏压下,1060 nm 处的平均单位响应度为 0.528 A/W,1180 nm 处的平均单位响应度为 0.102 A/W,并且内象限的平均暗电流为 2 nA,外象限为 8 nA。基于近红外增强黑硅的双四象限光电探测器具有响应高、暗电流低、响应快、串扰低等优点,适用于夜视检测、医疗等一系列应用方向。领域。
数据和材料的可用性
本研究中使用或分析的数据集可向相应作者索取。
缩写
- SEM:
-
扫描电镜
- 近红外:
-
近红外
纳米材料


