弹性变形 p-Si 晶体在 X 射线照射下的表面电导率变化
摘要
本文研究了在弹性单轴机械应力影响下辐照和未辐照 p-Si 单晶的电导率变化。提出了一种分析表达式来描述表面电导率与机械应力和 X 射线辐射剂量的关系。结果表明,“太阳能”硅表面的 4 角纳米颗粒会影响机械应力下的电导率变化。已确定 X 射线照射会导致硅中点缺陷的产生。这些缺陷抑制了位错运动。结果表明,在一定变形率下,经过辐照的“电子”硅样品的电阻率对单轴压缩的影响只有轻微的敏感性。
背景
半导体器件在现代电子技术领域的广泛应用需要研究在 X 射线辐射和机械变形等外部影响下具有高稳定性的新型半导体材料。目前,硅被广泛用于高灵敏度探测器和其他在辐射场中工作的半导体传感器[1]。
大多数文章都致力于研究塑性变形对 n-Si 电导率的影响 [2, 3]。这就是为什么弹性变形对 p-Si 晶体性能的影响仍然被认为是一项重要的科学任务。变形晶体中载流子浓度和杂质的重新分布通常以位错的存在为特征,位错是缺陷的有效吸气剂,尤其是在晶体表面 [4, 5]。已知 [3, 6] 晶体电子子系统的激发也伴随着位错迁移率的相应变化。电子子系统的激励可能是外部影响的结果,例如辐射和静电场。硅晶体中位错的一个特征是位错周围存在高浓度的点缺陷(Cottrell 云)。
晶体的表面对电离辐射最敏感。这就是为什么对硅晶体表面层上的辐射诱导过程的研究仍然被认为是相关的。带有沉积铝触点的表面是结构缺陷的有效吸气剂 [5,6,7]。在沉积的金属薄膜下方,由于薄膜和半导体的晶格参数不一致而出现机械应力 [5, 7]。这些应力刺激了接触层中缺陷吸收(杂质原子、填隙硅原子和空位)的过程。
方法
p 型导电性硅单晶,通过直拉法生长 (ρ =10–20 Ω cm),用于研究论文。这些单晶有两种类型:(1)电子用硅——表面(111)的所谓无位错(或电子)单晶,三角形蚀刻坑的浓度不超过10 2 cm −2 (图 1a 和 2),以及(2)表面(111)的“太阳能”硅单晶,由于相对较大浓度的背景碳(≈5 × 10 16 厘米 −3 ) 和氧气 (≈1.8 × 10 18 厘米 −3 ) 杂质。四棱锥的定位方式相同。金字塔基部的尺寸从 10 纳米到 10 微米。
<图片>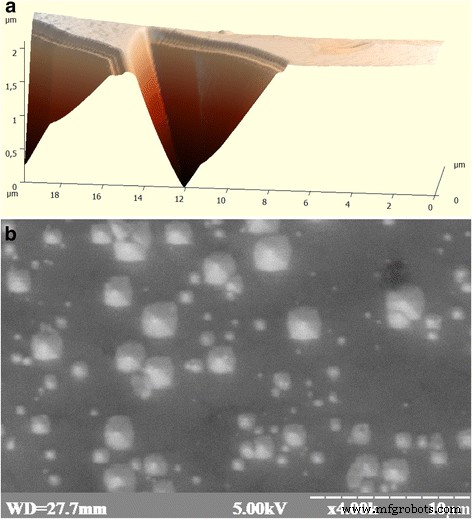
实验样品表面外观:a 原子力显微镜下得到的p-Si晶体表面位错蚀坑的出现和b 太阳晶体亚显微表面(111)的出现
<图片>
变形速率为8 μm/min时弹性变形过程中无初生位错试样纵向阻力的相关性
研究表明 [8, 9] 在簇的形成过程中,对应的 4 角锥形蚀刻孔可以参与硅的氧化层、点缺陷和具有不同结构状态的硅层,特别是 α 硅。
实验样品在打磨和化学抛光后获得的尺寸为 4 × 3.7 × 7.6 毫米。样品表面 (111) 末端宽度为 1.5 毫米的两条带形式的欧姆接触是通过铝在真空中的热蒸发 (10 -4 Pa) 加热至 593 K 样品。电导率的测量在真空低温恒温器中进行,残余气体压力为 10 -3 Pa 在对端部(朝向 [\( 11\overline{2} \)])应用单轴压缩时,功率为 15 至 40 MPa,变形率为 8 或 32 μm/min。用全范围的 X 射线 (W -阳极,50 kV,10 mA),在两侧,铝触点镀有涂层。 X 射线源和晶体之间的距离最小(1-2 毫米)。发现吸收剂量每 30 分钟增加 130 Gy。在工作中,我们首先对实验样品进行辐照,然后测量变形过程中的阻力。
结果与讨论
诱导机械电导率沿变形方向变化的研究结果(ρ (σ )) 在单轴应力 (σ ) 如图 2 所示。载荷从 0 增加到 40 MPa(在变形速率 8 μm/min 下)持续 45 分钟。
在变形过程中,无位错样品的电阻略有增加。应该注意的是,在未辐照晶体的情况下,变形率的变化实际上对依赖关系的一般观点没有影响ρ (σ ) [10, 11]。辐照样品也获得了类似的相关性(图 3)。在 X 射线作用后观察到电阻增加。然而,依赖的本质ρ (σ ) 观察到与未辐照样品有些不同。
<图片>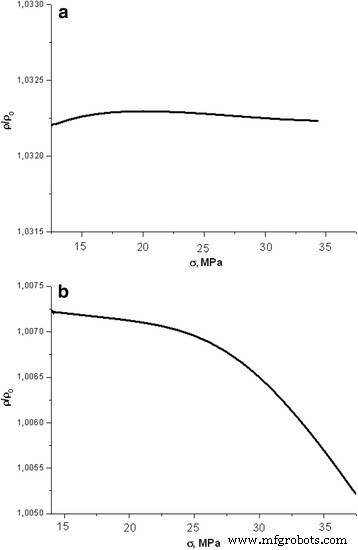
辐照(D)纵向电阻的相关性 =130 Gy) 无位错的硅样品在弹性变形期间以 8 μm/min 的速度增加压缩强度 (a ) 和 32 μm/min (b )
可以看出,由于 X 辐射的影响,在以 8 μm/min 的速度压缩期间,电阻几乎保持不变(图 3a)。暴露于 260 和 480 Gy 的样品的依赖性图具有相似的外观。已有研究表明[11]在辐照过程中电阻与吸收剂量的平方根成正比增加。
压缩率的四倍增加(从 8 到 32 μm/min)导致电阻率对负载的依赖性性质发生变化(图 3b)。在压缩过程中,辐照样品的电阻有小幅(<0.2%)下降。需要注意的是,所有电导率变化的测量都是以高精度(±0.045%)进行的,因此可以正确分析实验中电阻率的微小变化。
应该注意的是,在测量纵向阻力 (D =130 Gy)的无位错样品,速度为 8 μm/min(图 3a)。在给定的时间范围内,电阻几乎恢复到其原始值,即在辐照和施加机械应力后观察到的电阻值。
还对基于 p 型导电性的“太阳能硅”的实验样品进行了类似的测量对弹性压缩作用和暴露于辐射后的电阻依赖性的研究(图 4),其中固有的 4 棱锥在表面(111)。
<图片>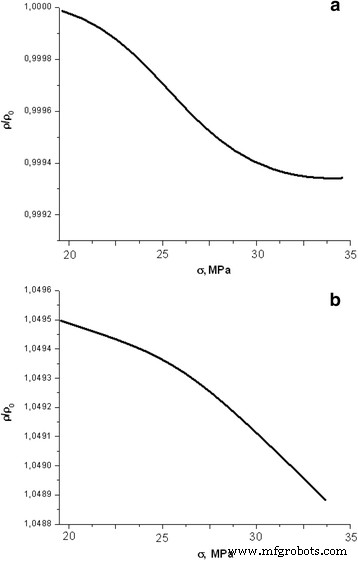
随着压缩强度的增加,太阳能硅在弹性变形过程中纵向阻力的依赖性:a D =0 Gy,压缩速度 32 μm/min; b D =130 Gy 压缩速度 8 μm/min
首先,发现p-Si型“太阳能”硅的电阻变化对机械应力大小的性质与压缩速度无关。在未辐照和辐照样品中均观察到类似的特征。纵向阻力对机械应力的依赖性变化相对较小(<0.5%),随着载荷的增加略有下降(图4a)。
用 X 射线 (480 Gy) 照射实验样品实际上不会影响弹性变形期间“太阳能”硅纵向电阻变化的一般性质(图 4b)。对于电子样品,电阻与吸收剂量的平方根成正比 [11]。在机械应力作用下,电阻率下降很小(±0.1%)。
正如我们之前的研究 [12, 13] 所示,介电膜 SiO2 带有正电荷。因此,空间电荷表面层耗尽空穴(具有高电阻)且厚度w (图 5)是在硅中创建的。 Si-SiO2离界面越近,空穴越少。
<图片>
半导体-绝缘体界面带正电荷下p型导体能带畸变
硅表面层中的空穴浓度及其电导率在表面电位变化的情况下发生变化(φ S )。让我们考虑一个平面方形板(图 6)。让电流平行于板的平面沿其边缘方向流动。
<图片>
电导率计算
它取了一个薄的平行层,厚度为 dy 和横截面积 dS [14] 在某个距离 (y ) 从表面。该层可视为同质半导体,其电阻可由下式确定:
$$ d R=\rho \frac{l}{dS}, $$ (1) $$ d S=a d y。 $$ (2)由于板是方形的 (l =a ),层的电导率为
$$ d\lambda =\frac{1}{dR}=\sigma d y, $$ (3)其中 \( \sigma =\frac{1}{\rho} \) 是具有 dy 的层的电导率 y 处的厚度 离表面的距离。对于 p 型半导体,电导率可以写为 \( \sigma \approx e p(y){\mu}_p \)。然后我们得到
$$ d\lambda =e p(y){\mu}_p dy。 $$ (4)让我们找出总表面电导率 (λ )。您需要在从零到几个可持续德拜屏蔽的厚度范围内整合最后一个表达式,或者例如限制空间电荷区域的宽度w :
$$ \lambda ={\displaystyle \underset{0}{\overset{w}{\int }} ep(y){\mu}_p dy=e{\mu}_p{\displaystyle \underset{0}{ \overset{w}{\int }} p(y) dy}}。 $$ (5)一般来说,耗尽表面层中空穴的浓度不仅取决于坐标(y ) 以及施加的机械应力 (σ 嗯 )。它由两个部分决定:p (y , σ 嗯 ) =p 1(y ) − p 2(σ 嗯 ),其中 p 1 (y ) 是对应于载流子浓度随距半导体表面距离变化而变化的分量,p 2 (σ 嗯 ) 是一个分量,它显示了由于在机械应力期间在位错处被捕获而导致空穴浓度降低的程度。此外,空穴的迁移率不是恒定值。这取决于机械应力。因此,总表面电导率的表达式可以写成如下形式:
$$ \lambda =e{\mu}_p\left({\sigma}_{meh}\right){\displaystyle \underset{0}{\overset{w}{\int }}\left({p} _1(y)-{p}_2\left({\sigma}_{meh}\right)\right) dy}。 $$ (6)机械引起的电导率变化可以写成如下:
$$ \lambda \left({\sigma}_{meh}\right)=e{\mu}_p\left({\sigma}_{meh}\right)\cdot \Big({\displaystyle \underset{ 0}{\overset{w}{\int }}{p}_1(y) dy-{\displaystyle \underset{0}{\overset{w}{\int }}{p}_2\left({\ sigma}_{meh}\right) dy}\Big)=e{\mu}_p\left({\sigma}_{meh}\right)\cdot \left\{{\beta}_1-{\beta }_2\left({\sigma}_{meh}\right)\right\}}, $$ (7)其中 \( {\beta}_1={\displaystyle \underset{0}{\overset{w}{\int }}{p}_1(y) dy;\kern1em {\beta}_2\left({\sigma }_{meh}\right)={\displaystyle \underset{0}{\overset{w}{\int }}{p}_2\left({\sigma}_{meh}\right) dy}}={p}_2\left({\sigma}_{meh}\right){\displaystyle \underset{0}{\overset{w}{\int }} dy=} w\cdot {p}_2\left( {\sigma}_{meh}\right) \).
需要注意的是,由于 p 1 (y ) 和 p 2 (σ 嗯 ) 也取决于辐照效果,因素 β 1 , β 2 , 和 μ p 取决于 X 射线的剂量。因此,(λ之前的表面电导率公式 (σ 嗯 ,0 )) 和之后 (λ (σ 嗯 ,D )) 辐照可以写成如下:
$$ \lambda \left({\sigma}_{meh},0\right)=e{\mu}_p\left({\sigma}_{meh},0\right)\cdot \Big({\ displaystyle \underset{0}{\overset{w}{\int }}{p}_1\left( y,0\right) dy- w\cdot {p}_2\left({\sigma}_{meh} ,0\right)\Big)=e{\mu}_p\left({\sigma}_{meh},0\right)\cdot \left\{{\beta}_1(0)-{\beta} _2\left({\sigma}_{meh},0\right)\right\}}。 $$ (8) $$ \lambda \left({\sigma}_{meh}, D\right)=e{\mu}_p\left({\sigma}_{meh}, D\right)\cdot \Big({\displaystyle \underset{0}{\overset{w}{\int }}{p}_1\left( y, D\right) dy- w\cdot {p}_2\left({\sigma }_{meh}, D\right)\Big)=e{\mu}_p\left({\sigma}_{meh}, D\right)\cdot \left\{{\beta}_1(D) -{\beta}_2\left({\sigma}_{meh}, D\right)\right\}}。 $$ (9)如果样本具有长度为 (l ) 和宽度 (a ),我们可以写出总表面电导率的最终公式如下:
$$ \lambda \left({\sigma}_{meh}, D\right)=\frac{a}{l} e{\mu}_p\left({\sigma}_{meh}, D\right )\left\{{\beta}_1(D)-{\beta}_2\left({\sigma}_{meh}, D\right)\right\}, $$ (10)哪里
$$ {\beta}_1(D)={\displaystyle \underset{0}{\overset{w}{\int }}{p}_1\left( y, D\right) dy,\kern1em }{\ beta}_2\left({\sigma}_{meh}, D\right)=w\cdot {p}_2\left({\sigma}_{meh}, D\right)。 $$ (11)受辐照后p-Si晶体表面电导率在机械应力影响下的变化主要由三个参数的变化决定:β 1 , β 2 , 和 μ p .
根据我们之前的研究 [10,11,12,13],X 射线对电子硅的影响伴随着 SiO2 介电表面层中正电荷的轻微增加。结果,因子β 1 :β 1 (D )> β 1 (0 ) 略有增加。对于“太阳能”硅,观察到相反的依赖性:β 1 (D ) <β 1 (0 ).
关于因子β 2 ,其变化主要由p的变化决定 2 (σ 嗯 , D ) 在辐射作用下。与参数β的变化相比,这些变化要大得多 1 . X 射线会触发硅中点缺陷的产生,这些缺陷充当位错运动的止动器。因此,在暴露于辐射后,因子β 2 对于这些样品,两种类型的实验样品 p-Si:β 2 (D ) <β 2 (0 ).
在“太阳能”硅的非辐照晶体中,存在的缺陷(对应于 4 角锥形蚀刻坑)起到阻止位错运动的作用。辐照产生的额外缺陷在表面缺陷高度集中的背景下没有发挥重要作用。
由于辐射缺陷处散射的增加,空穴的迁移率在暴露于辐射期间略有降低:μ p (D ) <μ p (0 )。通过这种机制可以解释经实验证实的硅样品的电导率下降。因此,对公式(8)和(9)的分析证实,随着X射线吸收剂量值的增加,电阻的增长主要是通过降低迁移率(μ p (D ) <μ p (0 )) 和自由载流子的浓度——空穴 (β 2 (D ) <β 2 (0 )).
如果我们考虑固定剂量下的方程数据,我们可以得出以下结论,这证实了上述给出的抗机械应力的实验依赖性:
- 1.
未受辐射的电子硅样品的电阻在压缩下会增加(图 2)。这是由于因子 β 的显着增长而发生的 2 在机械应力的作用下。在压缩过程中,因子β的变化(增长) 2 显着超过机械应力增加下空穴迁移率的变化(增加)。关于参数β 1 ,其值不依赖于σ 嗯 .
因此,在我们的案例中,基于电子硅的非辐照晶体的电阻增加(压缩)和负载减少(减压)可以通过位错的移动来解释,位错正在接管主要载流子。导致缺陷移动、团簇凝聚和团簇在位错上凝聚的力 [15] 出现在弹性变形的晶格中。缺陷正在成为捕获主要载流子的中心,同时凝结成更大的簇,如微孔、节间硅簇和杂质。硅表面层中缺陷的积累往往会降低其导电性。以相应的生长因子β表示 2 在表面电导率公式中。
- 2.
受辐射的电子硅样品的电阻在压缩下略有变化(图 3a)。这是由因子β的变化(增长)减少引起的 2 ,由于位错运动受阻。换句话说,参数β的相互竞争变化 2 和 μ p 经辐照后的电子硅样品在压缩下是相称的。
由于重空穴的纵向有效质量减少 [16, 17] 以及它们在压缩下的迁移率相应增加,电子硅晶体的电阻降低与应力增加相结合(图 3b)。这通过相应的迁移率增加μ来显示 p 在表面电导率公式中。
- 3.
受辐射和未受辐射的太阳能硅样品的电阻在压缩下略有下降(图 4)。这些实验样品的位错运动过程非常困难。此外,在太阳能硅晶体中现有表面缺陷高度集中的背景下,从硅的中间移动到表面的额外缺陷对电流传输做出了不必要的贡献。辐射的作用还增加了太阳能硅晶体中表面缺陷的浓度。因此,参数β的相互竞争变化 2 和 μ p 受辐照和未辐照的太阳能硅样品在压缩下是相称的。
辐射的影响(图 4b)还增加了太阳能硅晶体中表面缺陷的浓度。因此,由于吸杂而移动的额外缺陷对电流传输的贡献比未辐照晶体的贡献小。
结论
在机械负载期间,必须考虑影响 p-Si 晶体电阻的两个主要因素。第一个因素是由于位错运动的过程,阻力随着载荷的增加(压缩)增加而阻力随着载荷的减少(松开)而减少,位错正在接管主要载体。第二个因素是由于空穴有效质量的减少和迁移率的相应增加,硅晶体的电阻随着负载的增加而降低。
X 射线照射会导致硅中产生空位和间隙原子,它们充当位错运动的阻挡器。由于辐射缺陷散射的增加,在 X 射线照射期间空穴的迁移率略有下降。在未辐照的太阳能硅晶体中,存在的缺陷对位错运动起到了阻碍作用。
预辐照实验 p-Si 晶体(电子和“太阳能基”硅)具有在单轴压缩(应力供应速度 8 μ/min)的影响下略微改变其电阻率 (±0.2%) 的特性,在沿流的弹性变形 [\( 11\overline{2} \)].
在预辐照的电子 p-Si 样品中,电阻对单轴机械应力的依赖性显着取决于压缩率。在低应力供应速度(8 μm/min)下,电阻随着机械应力的增加而增加;在高速 (32 μm/min) 下,降低。对于基于太阳能p型硅的晶体,机械载荷下电阻的依赖性与压缩率无关。
缩写
- ρ (σ ):
-
诱导机械电导率沿变形方向的变化
纳米材料


