不同温度下量子阱宽度对 AlGaN 深紫外发光二极管电致发光特性的影响
摘要
研究了不同温度下量子阱 (QW) 宽度对 AlGaN 深紫外发光二极管 (DUV LED) 电致发光性能的影响。 3.5 纳米 QW 的 LED 与 2 纳米的最大外量子效率 (EQE) 比从室温 (RT) 下的 6.8 增加到 5 K 时的 8.2。然而,3.5 纳米 QW 的 LED 与 5 纳米的 LED 的比率QW 从 RT 时的 4.8 下降到 5 K 时的 1.6。 EQE 比的不同变化归因于非辐射复合的减少和活性区体积的增加。从理论分析来看,由于量子限制效应,具有 2 nm 阱的 LED 具有最浅的电子溢出势垒,而具有 5 nm 阱的 LED 由于较大的内场而显示出电子和空穴的重叠最少。因此,具有 3.5 nm QW 的 LED 在相同温度下具有最高的最大 EQE。随着温度的降低,所有 LED 的最大 EQE 电流都降低,这被认为是由于从 QW 溢出的电子增加和空穴浓度的降低。该结果有助于理解DUV LED中极化效应和电子溢出的组合。
背景
AlGaN基深紫外发光二极管(DUV LED)可广泛应用于固态照明、医学、生物化学等领域。因此,越来越多的努力致力于提高材料的晶体质量 [1,2,3,4]、p 型掺杂技术以及器件结构的优化 [5,6,7,8, 9]。三宅等人。表明通过高温退火可以显着提高 AlN 晶体质量 [3]。通过提高生长温度,Sun 等人。在蓝宝石上获得了高质量的 AlN 厚膜 [2]。最近,蒋等人。研究了 AlN 同质外延生长中的缺陷演变 [1]。他们的结果有助于理解 AlN 同质外延机制,并为提高晶体质量提供关键技术。此外,人们提出了许多方法来改善光提取,例如光子晶体和纳米结构以及表面等离子体 [10,11,12]。在过去的几十年里,这种 LED 取得了很大的进步,Li 等人对其进行了全面的回顾。 [13]。然而,由于外量子效率低,器件的性能离实际应用还很远。众所周知,III族氮化物具有纤锌矿结构,其中大的自发和压电场将导致倾斜的能带图。这些倾斜的波段对基于 III 族氮化物的器件有很大影响,例如 LED、LD [14, 15] 和 UV 检测器 [16, 17]。平山等人。报道了量子阱 (QW) 宽度对基于 AlGaN 的单 QW DV LED 光致发光 (PL) 特性的影响 [18]。他们发现当 QW 宽度小于 1.5 nm 时,QW 宽度为 1.5-1.7 nm 的 LED 表现出更高的发光强度,PL 强度降低,这归因于异质界面上非辐射复合的增加。在这项工作中,我们制造了具有不同量子阱 (QW) 宽度的 DUV LED,并研究了 QW 宽度和温度对电致发光 (EL) 特性的影响。我们发现 QW 宽度为 3.5 nm 的 LED 表现出最高的最大外部量子效率 (EQE)。随着温度的降低,所有LED的最大EQE电流都减小,这被认为是由于空穴浓度的降低和溢出电子电流的增加所致。
方法
LED 是通过金属有机化学气相沉积在 (0001)-蓝宝石衬底上生长的,使用 1.0 微米的 AlN 缓冲层,然后是 0.5 微米厚的未掺杂 Al0.6Ga0.4N 和 1.0 微米厚的 n-Al0 .6Ga0.4N 模板。模板的位错密度约为6 × 10 9 cm − 2 通过透射电子显微镜测量。然后生长 Al0.49Ga0.51N/Al0.58Ga0.42N 多个 QW (MQW) 作为有源区。阻挡层的厚度为 5.0 纳米。 p-Al0.3Ga0.7N (25 nm)/Al0.6Ga0.4N (25 nm) 用作 p 型层。最后,沉积 200 nm p-GaN 接触层。基于上述结构,分别以 2.0、3.5 和 5.0 nm 的 QW 宽度生长了三个样品,分别称为 LED A、B 和 C。
500 μm × 500 μm 方形几何 p -n 使用标准光刻技术制造结器件以定义特征和反应离子蚀刻以暴露 n -Al0.6Ga0.4N 欧姆接触层。 Ti/Al/Ni/Au (15/80/12/60 nm) 的 n 型欧姆接触通过电子束蒸发沉积,并在氮气环境中在 900°C 下使用快速热退火系统退火 30 秒。对于透明 p -触点,Ni/Au (6/12 nm) 层是电子束沉积的,并在 600 °C 的空气环境中退火 3 分钟。该器件通过沉积 Ni/Au (5/60 nm) p 完成 接触。 EL 光谱是使用 Jonin Yvon 的 Symphony 紫外增强液氮冷却电荷耦合器件检测器从 5 K 到室温 (RT) 测量的。为避免热效应的影响[19],EL测量采用1 μs电流脉冲0.5%的脉冲注入。
结果与讨论
图 1a 显示了在室温 (RT) 下测量的 LED A、B 和 C 在 100 mA 直流电下的 EL 光谱,其中所有光谱都归一化为带间发射。 LED A、B 和 C 的 EL 峰值分别约为 261、265 和 268 纳米。显然,随着 QW 宽度的增加,EL 峰显示出红移。此外,应该注意到 LED A 的 EL 光谱中存在 304 nm 附近的弱寄生峰,这已被澄清与电子溢出有关 [20]。图 1b 显示了所有 LED 的相对 EQE 作为脉冲电流的函数。所有值均归一化为 LED B 的最大 EQE。LED B 的最大 EQE 分别约为 LED A 和 C 的 6.8 倍和 4.8 倍。
<图片>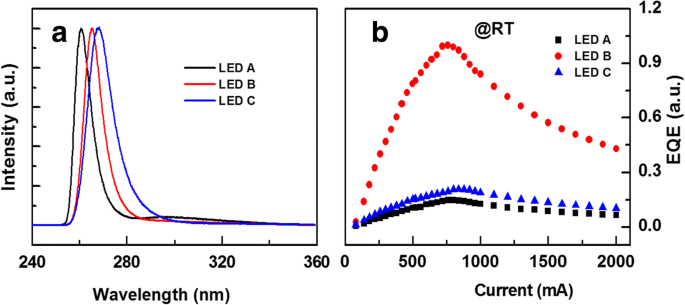
一 LED A、B 和 C 在 100 mA 直流电流下的 RT EL 光谱。所有光谱都归一化为带间发射。 b 作为脉冲电流函数的相对 EQE
为了理解其中的原因,使用APSYS来模拟载流子的能级和波函数。图 2a-c 分别显示了 LED A、B 和 C 在 100 mA 电流下在一个 QW 中的能带结构、基态电平和载波函数。由于极化效应引起的大内场和施加的正向偏压,QW的能带结构呈倾斜形状,电子和空穴的波函数空间重叠随着QW宽度的增加而减少,这是由于量子限制斯塔克效应 (QCSE)。 LED A、B 和 C 的基态能隙分别为 4.733、4.669 和 4.637 eV,与图 1a 所示的发射波长吻合良好。此外,应该注意到 QW 对载流子的约束能力随着 QW 宽度的减小而降低。量子限制效应导致基态能级随着 QW 宽度的减小而增加。 LED A、B 和 C 的势垒高度值分别为 0.030、0.057 和 0.069 eV。因此,由于电子电流溢出,LED A 的 EQE 小于 LED B,这可以通过图 1a 中显示的明显寄生峰来证实。尽管 LED C 在所有器件中的电子溢出势垒最高,但由于 QCSE,其 EQE 仍低于 LED B。
<图片>
在 100 mA 电流下,(a ) LED A, (b ) LED B, 和 (c ) LED C
测量低温下的 EQE 以评估器件性能。图 3a 显示了在 5 K 下测量的相对 EQE。所有值都归一化为 LED B 的最大 EQE。显然,与所有器件在 RT 时的注入电流相比,最大 EQE 的注入电流显着降低。 LED B 的最大 EQE 分别约为 LED A 和 C 的 8.2 倍和 1.6 倍。电流相关的 EQE 在不同温度下测量。图 3b 显示了 LED B 在不同温度下的电流相关相对 EQE。所有值都归一化为 10 K 时的最大 EQE。可以看出,最大 EQE 的电流随着温度的降低而降低。所有三个 LED 都发现了相同的现象。众所周知,在块状材料中,由于 p-AlGaN 中 Mg 的高电离能,空穴浓度会随着温度的降低而迅速降低。在我们的结构中,证明空穴浓度也随着温度的降低而降低 [21]。我们还模拟了不同温度下的孔分布。图 4 显示了 LED B 在 100 和 300 K 时在 100 mA 注入下的有源区空穴浓度。显然,空穴浓度随着温度的降低而降低。此外,从QW溢出的电子电流可以表示为[22]。
<图片>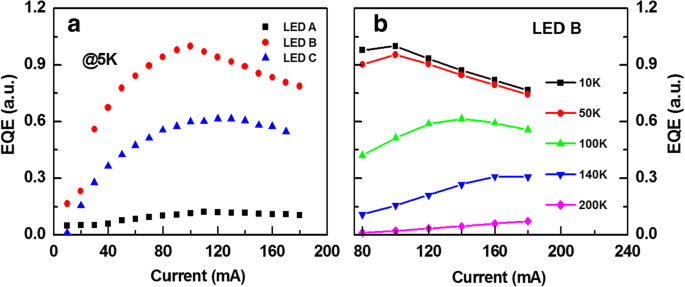
一 5 K 时的相对 EQE 和 (b ) LED B 在不同温度下的电流相关相对 EQE
<图片>
100 mA注入下LED B在100和300 K有源区空穴浓度
\( {J}_{\mathrm{overflow}}=D{\left(\frac{\Delta E}{kT}\right)}^3 qBl \)
其中 D 是一个常数,ΔE 是费米能级和量子阱带边的差值,K 是玻尔兹曼常数,T 是温度,q 是电子电荷,B 是双分子辐射复合系数,l 是 MQW 的厚度。对于某个 LED,ΔE 变化的贡献 J 与 T 相比可以忽略溢出 随着温度的降低。因此,J 与 RT 相比,在 5 K 时溢出显着增加,这被认为是达到最大 EQE 时注入电流减小的主要原因。 J 随着温度的升高,溢出减少,导致最大 EQE 的注入电流增加,如图 3b 所示。在低温下,由于位错等非辐射中心的冻结,内部效率会增加,这有利于有源区体积最大的LED C。这是 LED B 与 LED C 的 EQE 比在 5 K 时比在 RT 时降低的最可能原因。同样,与 RT 相比,LED B 与 LED A 的 EQE 比在 5 K 时增加。
结论
我们研究了 QW 宽度对不同温度下 AlGaN DUV LED EL 特性的影响。随着 QW 宽度的增加,EL 光谱显示红移。 QW 宽度为 3.5 纳米的 LED 的最大 EQE 分别是室温下 2 和 5 纳米 LED 的 6.8 和 4.8 倍。但是,这些值在 5 K 时分别变为 8.2 和 1.6。最大EQE比的不同变化归因于非辐射复合的减少和有源区体积的增加。从理论分析来看,由于量子限制效应,具有 2 nm 阱的 LED 显示出最浅的电子溢出势垒,而具有 5 nm 阱的 LED 由于较大的内场而显示出电子和空穴的重叠最少。因此,具有 3.5 nm QW 的 LED 显示出最高的最大 EQE。随着温度的降低,所有 LED 的最大 EQE 电流都降低,这被认为是由于从 QW 溢出的电子增加和空穴浓度的降低。 QW 宽度为 3.5 nm 的 LED 的最大 EQE 在 5 K 时分别约为 2 和 5 nm 的 8.2 倍和 1.6 倍,这被认为是由于非辐射复合中心的减少和体积的增加活动区域。
缩写
- DUV LED:
-
深紫外发光二极管
- EL:
-
电致发光
- EQE:
-
外量子效率
- MQW:
-
多量子阱
- PL:
-
光致发光
- QCSE:
-
量子限制斯塔克效应
- QW:
-
量子阱
- RT:
-
室温
纳米材料
- 银的抗菌特性
- 2020 年的深度技术:范式会有多大不同?
- 紫外线照射对 4H-SiC PiN 二极管特性的影响
- Pd/SnO2 纳米材料形成条件对氢传感器性能的影响
- 水对微晶和纳米纤维素结构和介电性能的影响
- 探测 Ag n V (n =1-12) 簇的结构、电子和磁特性
- 具有专门设计的超晶格 p 型电子阻挡层以实现高 Mg 掺杂效率的几乎无效率下降的基于 AlGaN 的紫外发光二极管
- 不同 CH3NH3PbI3 形态对钙钛矿太阳能电池光伏特性的影响
- 嵌入TiO2致密层的不同尺寸和浓度的Ag纳米颗粒对钙钛矿太阳能电池转换效率的影响
- 基材对 LSP 耦合波长和强度的影响
- 关于用于基于 AlGaN 的深紫外发光二极管的 p-AlGaN/n-AlGaN/p-AlGaN 电流扩展层
- 铜的抗菌特性


