InGaAs/InAlAs 单光子雪崩光电二极管的理论分析
摘要
报告了 InGaAs/InAlAs 雪崩光电二极管 (APD) 和单光子 APD (SPAD) 的理论分析和二维模拟。研究了InGaAs/InAlAs APDs和SPADs的电场分布和隧道效应。 InGaAs/InAlAs SPADs在盖革模式下工作时,电场在吸收层线性增加,在倍增层偏离线性关系。考虑到倍增层中的隧道阈值电场,倍增层的厚度应大于 300 nm。此外,SPADs可以在大偏压下工作,避免电荷层掺杂浓度高的吸收层发生隧穿。
背景
In0.53Ga0.47As/In0.52Al0.48As(以下简称InGaAs/InAlAs)和InGaAs/InP雪崩光电二极管(APD)是最重要的短波红外探测光电探测器。近年来,量子密钥分配的研究进展很快,现在InGaAs/InAlAs和InGaAs/InP APDs可以像单光子APDs(SPADs)一样实现单光子计数和计时[1]。与其他 SWIR 波长范围内的单光子探测器,如光电倍增管相比,InGaAs 单光子雪崩二极管具有高性能、高可靠性、低偏置、小尺寸、时间分辨率好、操作简便等显着优势。 2, 3]。因此,InGaAs/InAlAs 和 InGaAs/InP APD 引起了相当多的关注 [4, 5]。与在线性模式下工作的 APD 相比,APD 在盖革模式下工作,因为 SPAD 被施加超过击穿电压的反向偏压 [6]。 SPADs在倍增层实现了高增益,单个光子可以触发宏观电流脉冲,提供了准确感知单个光子到达探测器的能力[7]。因此,SPAD 可以检测波长为 1550 nm 的单光子 [8]。同时,吸收层的材料可以控制吸收波长[9]。
与基于 InAlAs 的 SPAD 相比,基于 InP 的 SPAD 的理论和仿真研究更加全面 [2, 10,11,12]。然而,越来越多地使用基于 InAlAs 的 APD 代替基于 InP 的 APD,因为它们可以提高 APD 和 SPAD 的性能 [13]。 InAlAs 中电子 (α) 与空穴 (β) 的电离系数比大于 InP,从而导致 InAlAs 基 APD 中的低过量噪声因子和高增益带宽积 [14]。 InAlAs 的较大带隙可以改善击穿特性并降低 SPAD 中的暗计数率 (DCR) [15]。 InAlAs 基 APD 具有高电子迁移率,响应时间比 InP 基 APD 快 [16]。此外,InAlAs APD 的电离系数比对 InP 基 APD 的温度变化不太敏感 [17]。因此,InGaAs/InAlAs APD 可以在击穿特性、DCR、过量噪声、增益带宽、响应时间和温度特性方面实现高性能。
InGaAs/InAlAs APD 的研究主要集中在提高单光子检测效率 (SPDE) 和降低 SPAD 中的 DCR。卡维等人。展示了第一个 InGaAs/InAlAs SAPD,其在 130 K [18] 下的 SPDE 为 16%。中田等人。提高了 SPAD 的温度性能,在 213 K [19] 下实现了 10% 的 SPDE。赵等人。设计了一种自淬火和自恢复 InGaAs / InAlAs SPAD,在 160 K 时 SPDE 为 11.5%;同时,观察到 3.3 M Hz 的 DCR [20]。孟等人。设计了一种台面结构 InGaAs/InAlAs SPAD,在 260 K [21] 下实现了 21% 的 SPDE。然后,他们在类似的结构中应用了厚的吸收和倍增层,在 210 K 时将 SPDE 提高到 26%,并将 DCR 降低到 1 × 10 8 赫兹 [22]。然而,在这些研究中,InGaAs/InAlAs SPADs 的 DCRs 与 InGaAs/InP SPADs 相比过高(在最近的 InP SPADs 中,DCRs 是典型的<10 4 赫兹)[23]。 InGaAs/InAlAs SPAD 中的高 DCR 归因于隧道电流,这是由过偏压下的高场引起的 [21, 22, 24]。因此,减少隧道相关机制对于 InGaAs/InAlAs SPAD 很重要,并且这些机制与 SAPD 中的电场分布有关。从文献[1。 9],隧穿阈值电场为2.0 × 10 5 吸收层中的 V/cm (InGaAs) 和 6.8 × 10 5 倍增层 (InAlAs) 中的 V/cm。因此,合适的电场分布对于 InAlAs SPAD 很重要,这由电荷层和倍增层厚度决定。考虑到 InAlAs APD 的电荷层,Kleinow 等人。研究了该层中掺杂浓度的影响,发现掺杂浓度对 InGaAs/InAlAs APD 的性能更为重要 [25, 26]。陈等人。通过理论分析和模拟,研究了电荷和倍增层对穿通和击穿电压的影响 [27]。这些研究集中在线性模型下 InAlAs APD 的性能。然而,在盖革模式下,InAlAs SPADs的性能尚未完全了解。
本文通过理论分析和仿真来研究 InGaAs/InAlAs SPAD 中的隧道效应和电场分布。考虑盖革模式下的隧穿阈值电场,优化SPADs的设计标准,避免隧穿效应。
方法
使用 TCAD [28] 对前照式 SAGCM InGaAs/InAlAs APD 进行了数值模拟。用于仿真的物理模型如下所示。 Selberherr 碰撞电离模型模拟 InAlAs 中的雪崩倍增。电场分布和扩散电流由漂移扩散模型描述,该模型包括泊松和载流子连续性方程。带间和陷阱辅助隧道模型用于隧道电流。其他基本模型,包括 Fermi-Dirac 载流子统计、俄歇复合、载流子浓度相关性、Shockley-Read-Hall 复合、低场迁移率、速度饱和、碰撞电离和射线追踪方法,用于模拟。用于模拟的前照式APD外延结构截面示意图如图1所示。
<图片>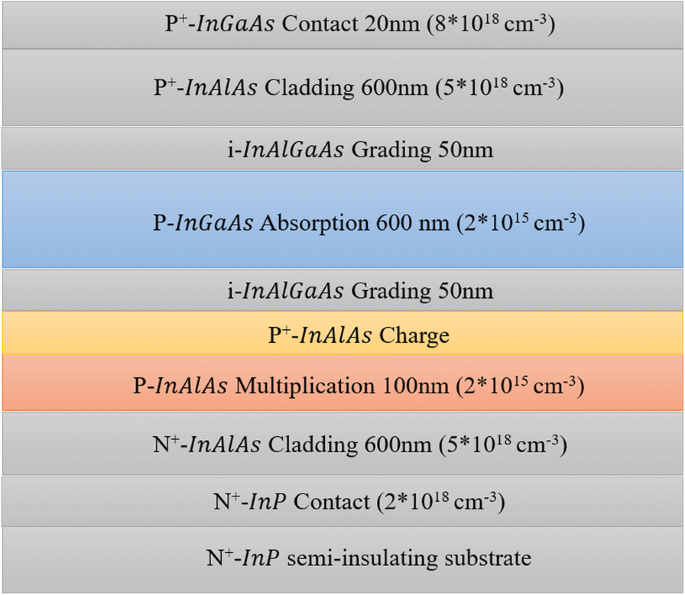
前照式 SAGCM APD 的横截面示意图。展示了顶部照明的 SAGCM InGaAs/InAlAs APD 的横截面示意图。它包括结构、材料、掺杂和厚度。从下到上依次为基板、接触层、包覆层、倍增层、电荷层、渐变层、吸收层、渐变层、包层、接触层
从下到上依次为基板、接触层、包覆层、倍增层、电荷层、渐变层、吸收层、渐变层、包层、接触层。在吸收层中诱导的光生载流子漂移到倍增层,在那里触发雪崩击穿。吸收中的电场使用电荷层控制进行调整,并且仅在倍增层中保持高场。在电荷层和吸收层之间,InAlGaAs 渐变层避免了 InGaAs-InAlAs 异质结处的电子堆积。我们模拟中的器件结构类似于参考文献中的实验结构。 [21].
SAGCM APD 中的电场分布可以用泊松方程、PN 耗尽层模型和边界条件方程求解[29]。泊松方程为
$$ \frac{d\xi}{d x}=\frac{\rho }{\varepsilon }=\frac{q\ast N}{\varepsilon }。 $$ (1)边界条件方程为
$$ Vbias+ Vbi=-{\int}_0^w\xi \left(x,\mathrm{w}\right) dx。 $$ (2)在这些方程中,ρ 等于掺杂离子 q × N 在耗尽层中,ε 是材料的介电常数,V 偏见 是 APD 上的偏置电压,V 双 是内建势,w 是耗尽层厚度。当耗尽层的边界到达器件中的接触层时,电场分布和偏置电压之间的数学关系可以使用方程推导出来。 (1)和(2)。
隧穿电流由带间隧穿和陷阱辅助隧穿组成。带间隧道电流取决于材料中的场,并成为高场下暗电流的主要成分 [24, 30]。带间隧道的产生率如[31]所示。
$$ {G}_{\mathrm{btb}}={\left(\frac{2{m}^{\ast }}{E_g}\right)}^{1/2}\frac{q^2E }{{\left(2\pi \right)}^3\mathrm{\hslash}}\exp \left(\frac{-\pi }{4q\mathrm{\hslash}E}{\left(2{ m}^{\ast}\ast {E}_g^3\right)}^{\raisebox{1ex}{$1$}\!\left/ \!\raisebox{-1ex}{$2$}\right. }\right) $$ (3)在上面的等式中,E g 是 InGaAs (0.75 eV) 或 InAlAs (1.46 eV) 的能带隙,m* (等于 0.04 m e 在 InGaAs 和 0.07 m e InAlAs) 是有效减少的质量,E 是最大电场。 G btb 取决于电场 E 和能带隙 E g , w 隧道被假定为隧道开挖过程的有效厚度,A 假定为设备的面积。因此,带间隧道的隧道电流为[13]。
$$ {I}_{\mathrm{tunnel}}/A={G}_{\mathrm{btb}}\ast q\ast {w}_{\mathrm{tunnel}} $$ (4)I的计算结果 隧道 /A (w 隧道 =1 μm) 显示在图 2 中。I 隧道在 2.0 × 10 5 时变得显着 V/cm InGaAs 和 6.9 × 10 5 分别为 InAlAs 的 V/cm。我们发现这些计算值与隧穿阈值电场(2.0 × 10 5 V/cm, InGaAs) 和 (6.8 × 10 5 V/cm, InAlAs) 参考。隧道电流可以充分影响SPAD在高场下的性能。因此,SPAD 的 InGaAs 和 InAlAs 中的场都应调整为低于隧穿阈值。表 1 显示了模拟中使用的参数。
<图片>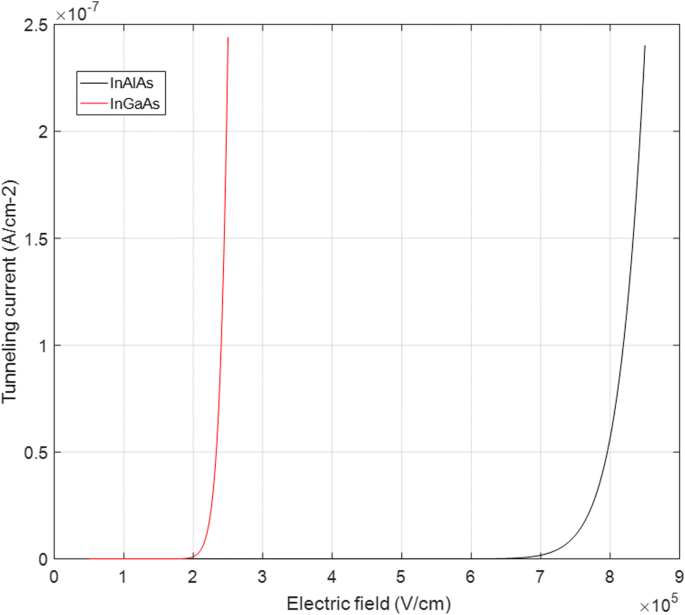
我之间的关系 隧道/A InGaAs 和 InAlAs 中的电场。显示 I 的计算结果 隧道/A . 我 隧道在 2.0 × 10 5 时变得显着 V/cm InGaAs 和 6.9 × 10 5 分别为 InAlAs 的 V/cm
结果与讨论
本节对理论分析和结论进行了仿真研究。首先,在A部分研究了盖革模式下的电场分布。然后,考虑盖革模式下的隧道阈值电场,优化SPAD的设计标准,以避免B部分的隧道效应。 典型器件参考文献[22]中的结构用于测试仿真模型。在这个模拟中,我们使用了与参考文献 [28] 相同的模拟引擎,电流-电压曲线以及增益与电压曲线如图 3 所示。可以发现,在击穿电压和电压之后增益逐渐增加。击穿电压突然升高。
<图片>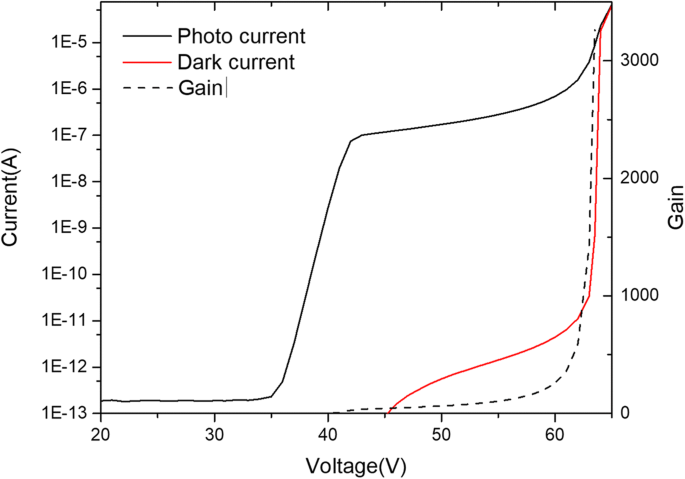
InGaAs/InAlAs APD 的电流-电压曲线以及增益与电压的关系。给出了一些典型器件结构的 i-v 曲线以及增益与电压曲线图
盖革模式下的电场分布
我们发现器件性能受电场分布的影响很大。为了保持高增益和小暗电流,正确控制倍增层和吸收层中的电场很重要。从参考。 [32],InGaAs/InAlAs APD 中合适的场分布应符合这些规则。保证Vpt(穿通电压)
图 4 和图 5 分别显示了盖革模式下倍增层和吸收层中的模拟场电压特性。在盖革模式下运行的 APD 作为 SPAD 被施加超过模拟中击穿电压 1~6 V 的反向偏压。电荷层的厚度(W 电荷)为 50 纳米,倍增层的厚度 (W 倍增)分别为 100、200 和 300 nm。
模拟结果电场在盖革模式下倍增。 W 的值 倍增是 100 nm(黑色方块)、200 nm(黑色三角形)、300 nm(黑色圆圈)。图 3 显示了盖革模式下乘法层中的模拟场电压特性。电荷层厚度为50纳米,倍增层厚度分别为100、200和300纳米
模拟结果在盖革模式下吸收电场。 W 的值 倍增是 100 nm(黑色方块)、200 nm(黑色三角形)、300 nm(黑色圆圈)。图 4 显示了在盖革模式下吸收层中的模拟场电压特性。电荷层厚度为50 nm,倍增层厚度分别为100、200和300 nm。
当 InGaAs/InAlAs SPAD 在线性模型 (APD) 下运行时,吸收层和倍增层中的电场随着偏置电压的增加而线性增加。然而,在盖革模式下,当偏置电压超过击穿电压时,吸收层中的电场一如既往地线性增加,而倍增层中雪崩电场的增加变得缓慢。与工作在线性模式下的 InGaAs/InAlAs APDs 相比,InGaAs/InAlAs SPADs 在具有更高雪崩场的倍增层中实现了高增益,并且单个光子可以触发宏观电流脉冲。同时,盖革模式下的吸收场大于线性模型下的吸收场。隧道电流成为高场暗电流的主要成分,单个光子可以触发宏观电流脉冲,雪崩增益远大于线性模式。
我们知道 SAPD 在饱和模式下工作。为了保持高增益和小暗电流,倍增层和吸收层中的电场控制很重要。如果吸收场小于隧道阈值场,则可以在倍增层中保持高雪崩电场并避免隧道电流。因此,SPADs应适当设计各层的浓度和厚度。
图 2 显示,由于倍增层和吸收层中的高场超过了隧道阈值电场,SPAD 有可能产生较大的隧道效应。因此,应将 InGaAs 吸收和 InAlAs 倍增中的电场调整为低于隧道阈值。理论分析表明,乘积的雪崩电场因N的乘积而减小 充电和w 收费 [28]。因此,电荷层可以控制吸收场;然而,倍增层的雪崩电场由w决定 乘法。图 6 显示了当器件经历雪崩击穿时不同倍增厚度(100-500 nm)的模拟场电压特性。倍增层和吸收层的背景掺杂量为2 × 10
15
厘米
−3
,这是分子束外延 (MBE) 的本征浓度。仿真结果表明,倍增层中的雪崩电场随着倍增层厚度的增加而减小。因此,较厚的倍增层可以避免倍增时通过低雪崩电场产生隧穿效应的可能性。
不同W的倍增层电场 乘法。图 5 显示了器件经历雪崩击穿时不同倍增厚度(100-500 nm)的模拟场电压特性
为避免盖革模式下倍增时雪崩电场超过隧穿阈值,倍增厚度应> 300 nm,雪崩电场低于6 × 10
5
V/cm 甚至超过图 4 中的击穿电压。因此,厚的倍增层可以避免盖革模式下 SPAD 中的隧道效应。这就是SPADs中DCR低的原因,乘法很厚。
如 A 部分所述,吸收层中的电场在盖革模式下线性增加。偏置电压的增加对吸收层中的电场有显着影响,导致电场有很大的概率超过2.0 × 10
5
伏/厘米。图 7 显示了电荷层中不同掺杂浓度的模拟电场分布 (w 电荷=50 纳米)。我们发现较高的掺杂浓度在吸收层中具有较低的电场,甚至在盖革模式下超过 5 V 的击穿电压;然而,在较低的掺杂浓度下,隧道阈值电场很快就会实现。因此,电荷层中较小的掺杂浓度导致较早的隧道效应开始。为了在盖革模式下获得足够的工作偏置电压,N SPAD 的电荷大于 N 负责 APD。与较低的N相比 SPAD 的电荷数越高 N SPADs电荷可以在大偏置电压下工作,避免隧道效应,在倍增层中获得高增益。
具有不同N的吸收层中的场 收费。 N 的值 充电为 4.5*10
17
cm
− 3
(黑色方块), 6.8*10
17
厘米
−3
(黑色三角形)。图 6 给出了电荷层中不同掺杂浓度的吸收电场分布(W 电荷 =50纳米)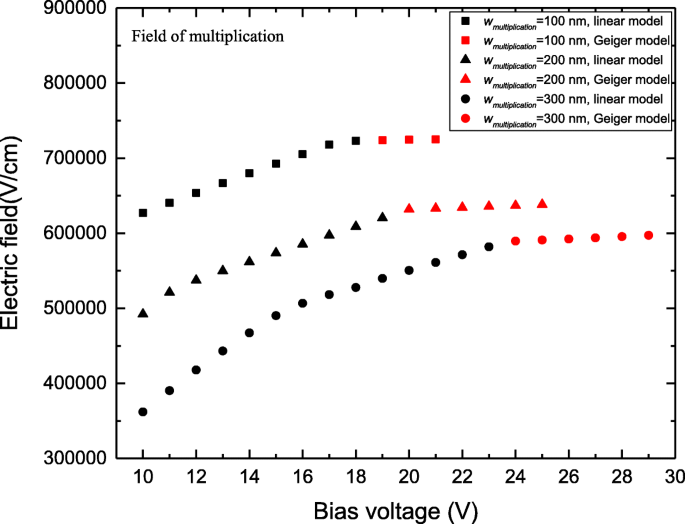
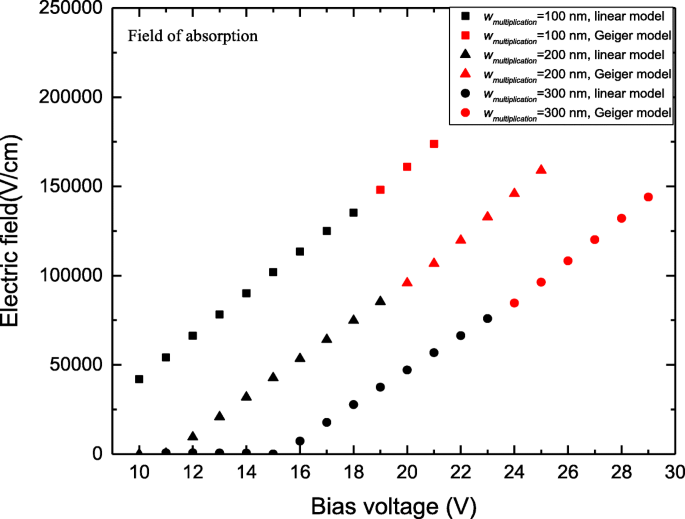
SPAD 的设计考虑

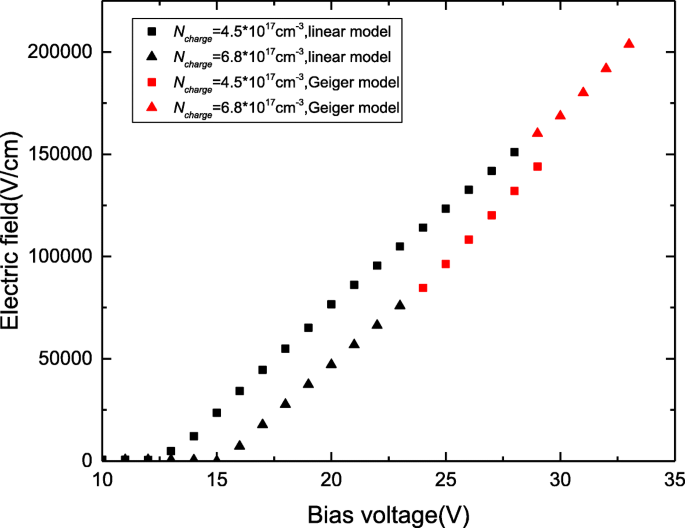
结论
我们通过理论分析和仿真研究了 InGaAs/InAlAs APD 和 SPAD 的电场分布和隧道效应。 InGaAs/InAlAs SPADs在盖革模式下工作时,吸收层中的电场线性增加并偏离其线性关系。考虑到倍增层中的隧道阈值电场,倍增层的厚度应大于 300 nm。此外,SPADs可以在大偏压下工作,避免电荷层掺杂浓度高的吸收层发生隧穿。
缩写
- 二维:
-
二维
- APD:
-
雪崩光电二极管
- DCR:
-
暗计数率
- SAGCMAPD:
-
独立的吸收、分级、电荷和倍增雪崩光电二极管
- SPAD:
-
单光子雪崩光电二极管
- SPDE:
-
单光子探测效率
纳米材料
- 分析选项
- 聚合物纳米结构上 U2OS 细胞中肌动蛋白和焦点粘附组织的分析
- 在蓝宝石上生长的外延 n 型掺杂 GaN 层的红外反射分析
- 基于微柱中 InAs 双层量子点的 1.3 μm 明亮单光子源
- 双轴拉伸应变锗纳米线的理论研究
- 石墨烯集成硅微环谐振器的拉曼映射分析
- CA/TPU 螺旋纳米纤维的制备及其机理分析
- 1.3–1.55-μm 窗口中变质 InAs/InGaAs 量子点的带间光电导率
- InGaAs/InAlAs SAGCM 雪崩光电二极管的理论研究
- Si、Ge 和 Si/Ge 超晶格对低能辐射的辐射响应的理论模拟
- 通过像差校正 HAADF-STEM 分析外延 GaAsBi 中的 Bi 分布
- InGaAs/InP 核壳纳米线的自种 MOCVD 生长和显着增强的光致发光


