InGaAs/InP 核壳纳米线的自种 MOCVD 生长和显着增强的光致发光
摘要
我们报告了通过金属有机化学气相沉积 (MOCVD) 在 Si-(111) 衬底上生长和表征 InGaAs/InP 核壳纳米线。 InGaAs 核和 InP 壳材料之间的大晶格失配引起的核壳界面应变对 InP 壳的生长行为有很大影响,导致 InP 壳在 InGaAs 核周围不对称生长,甚至导致纳米线的弯曲。透射电子显微镜 (TEM) 测量表明 InP 壳与 InGaAs 核相干,没有任何错配位错。此外,77 K 的光致发光 (PL) 测量表明,由于表面状态的钝化和有效由 InP 壳层引起的载流子限制。此处获得的结果进一步加深了我们对应变核壳异质结构纳米线生长行为的理解,并可能为基于 InGaAs/InP 异质结构纳米线的 Si 平台光电器件的应用开辟新的可能性。
背景
III-V 半导体纳米线因其独特的电子、光学和几何特性而被认为是下一代纳米器件的有前途的候选材料 [1,2,3,4]。在 III-V 族半导体材料中,三元 InGaAs 纳米线由于其优异的物理性质,如直接带隙可控范围大、载流子有效质量小和载流子迁移率高,在光子学和光电应用中极具吸引力。此外,已经深入研究了 III-V 族材料与 Si 平台的集成,这使得 III-V 族材料独特的物理性质的优势与成熟的互补金属氧化物半导体 (CMOS) 技术相结合。由于占地面积小,纳米线为 III-V 族材料与 Si 的集成提供了机会,而忽略了材料之间晶格参数的巨大差异 [5, 6]。迄今为止,基于三元 InGaAs 纳米线的各种器件已在 Si 衬底上制造,包括低功率高速晶体管 [7, 8]、基于隧道的器件 [9, 10]、发光二极管 (LED) [11 ]、光子器件 [12, 13] 和太阳能电池 [14, 15]。
然而,由于一维纳米线的高表面积与体积比,众多的表面状态已成为实现高性能纳米线光电器件的主要限制。一方面,这些表面状态会通过散射和非辐射复合过程大大降低 III-V 族材料的电子和光学特性 [16,17,18,19,20]。另一方面,对于一些窄带隙材料(如 InAs、In-rich InGaAs)的纳米线,表面态的高密度会导致纳米线表面附近的电子能带结构发生弯曲(表面费米能级钉扎效应) )。这种非平带结构将进一步导致电荷载流子重新分布,这会严重阻碍基于光学纳米线的器件的性能 [21]。因此,消除这些表面状态是非常必要的。对于具有较高 In 成分的三元 InGaAs 纳米线,InP 是一种理想的表面钝化层,因为该材料体系形成 I 型带隙排列,可以有效地将载流子限制在 InGaAs 中。此外,对于在平面结构中得到广泛研究的InGaAs/InP材料体系,其发射波长可在1.31-1.55 μm范围内可调,在光纤通信中具有广阔的前景。
在这项工作中,我们使用金属有机化学气相沉积 (MOCVD) 在 Si-(111) 衬底上进行了 InGaAs/InP 核壳纳米线的生长和表征。研究发现,核壳材料之间的大晶格失配导致核壳界面处的应变对 InP 壳的生长行为有很大影响。核壳材料之间的大晶格失配会导致 InGaAs 核纳米线周围的 InP 涂层不均匀成核,甚至导致纳米线弯曲。通过优化生长条件,可以获得具有良好形貌的 InGaAs/InP 核壳纳米线。此外,77 K 的光致发光 (PL) 测量表明,由于表面状态的钝化和通过 InP 涂层的有效载流子限制,来自 InGaAs/InP 核壳纳米线的 PL 峰值强度与裸 InGaAs 纳米线相比增强了约 100 倍层。
方法/实验
纳米线增长
InGaAs/InP 核壳纳米线通过紧密耦合的喷头 MOCVD 系统(AIXTRON Ltd.,德国)在 133 mbar 下生长。三甲基铟 (TMIn) 和三甲基镓 (TMGa) 用作 III 族前体,砷化氢 (AsH3) 和膦 (PH3) 用作 V 族前体。以超高纯氢气(H2)为载气,H2总流量为12slm。在生长之前,Si-(111) 衬底被加热到 635 °C 进行退火,然后在 AsH3 通量下冷却到 400 °C 以形成 (111)B 类表面 [22]。 InGaAs 核心纳米线在 565°C 下生长 15 分钟。在生长过程中,TMIn和AsH3的流速为0.8 × 10 − 6 mol/min 和 1.0 × 10 − 4 mol/min,而 TMGa 流速是变化的。 TMGa 气相组成 Xv,定义为流速 TMGa/(TMGa+TMIn) 的比率,从 30% 到 40% 变化。 InP 壳在 565°C 下生长 10 分钟,TMIn 和 PH3 流速为 2 × 10 - 6 mol/min 和 8.0 × 10 − 4 摩尔/分钟,分别。生长后,样品以PH3为保护剂冷却至室温。
表征方法
通过扫描电子显微镜 (SEM) (Nova Nano SEM 650) 和透射电子显微镜 (TEM) (JEM2010F TEM; 200 kV) 结合 X 射线能量色散光谱 (EDS) 表征纳米线的形貌。分别研究晶体结构和成分。对于 TEM 观察,纳米线从样品机械转移到涂有碳膜的铜网格。为了研究生长的纳米线的光学特性,使用 532 nm 波长激光作为激发源进行光致发光 (PL) 测量。样品在直径约 150 μm 的光斑尺寸上用~ 100 mW 的激光功率激发。 PL 信号直接送入傅里叶变换红外 (FTIR) 光谱仪,并由液氮冷却的 InSb 检测器记录。 FTIR 光谱仪中的移动镜以快速扫描模式运行 [23],不同于在中红外区域对 InAs 纳米线进行步进扫描调制 PL 测量 [24]。
结果与讨论
图 1 显示了 InGaAs/InP 核壳纳米线在 Si-(111) 衬底上生长的示意图以及用于纳米线生长的源极供应序列。 InGaAs 纳米线通过自催化机制生长 [25]。请注意,In 液滴将在 AsH3 气氛下被消耗(如图 1 中的区域 3 所示)。 InP壳的过度生长是通过将AsH3转换为PH3通量并同时打开TMIn通量来启动的。
<图片>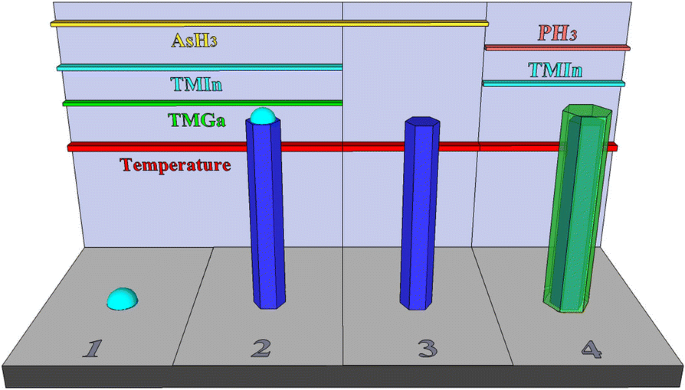
InGaAs/InP核壳纳米线的生长示意图和纳米线生长的源极供应序列
图 2a、b 分别显示了裸 InGaAs 和 InGaAs/InP 核壳纳米线的典型 SEM 图像,其中 Xv =30%。所有 InGaAs 纳米线都垂直排列在 Si 衬底上,沿整个长度具有均匀的直径。 InP 壳层后续生长后,纳米线仍具有光滑的侧面,表明生长参数得到了优化。从裸 InGaAs 和 InGaAs/InP 核壳纳米线的直径统计分布来看,InP 壳层生长后,纳米线的平均直径从 ~ 65 nm 增加到 ~ 95 nm,这表明平均 InP 壳层厚度约为 15纳米。然而,图 2b 中的 InGaAs/InP 核壳纳米线明显弯曲,这是由 InP 壳对 InGaAs 核纳米线的应力引起的,这是由于核壳材料之间的晶格失配较大。图 2c、d 显示了 Xv 分别为 35% 和 40% 的 InGaAs/InP 核壳纳米线的 SEM 图像。与图 2b 中的纳米线相比,Xv 为 35% 的 InGaAs/InP 核壳纳米线的弯曲大大减少(图 2c)。进一步将 Xv 增加到 40%,纳米线是直的,没有可见的弯曲(图 2d)。这种现象可以归因于随着 Ga 成分的增加 InGaAs 核和 InP 壳材料之间的晶格失配减少。此外,从InGaAs/InP核壳纳米线直径的统计分布来看,随着Ga成分的增加,纳米线的直径同时增加,这也可以阻碍InGaAs核壳纳米线在InP涂层后弯曲。
<图片>
一 InGaAs 纳米线和 InGaAs/InP 核壳纳米线与 Xv 的 30° 倾斜 SEM 图像,b 30%,c 35% 和 d 40%
为了研究生长的纳米线的晶体结构并确认生长 InP 壳后核壳结构的存在,进行了详细的 TEM 测量。如图 3a 所示,Xv 为 35% 的 InGaAs 纳米线的晶体结构由纤锌矿 (WZ) 和闪锌矿 (ZB) 的多型结构组成,沿其生长具有大量堆垛层错 (SF)方向,并且由于 WZ 和 ZB 结构与结构缺陷共存,相应的选区电子衍射(SAED)斑点分裂并沿生长方向略微拉长(图 3a 中的插图)。这些平面缺陷通常在没有外来催化剂的情况下通过 MOCVD 生长 InAs 或 InGaAs 纳米线 [26,27,28]。图 3b 显示了 Xv 为 35% 的典型 InGaAs/InP 核壳纳米线的明场 (BF) 低分辨率 TEM 图像(如图 2c 所示)。 InP 涂层后,纳米线仍然很直,没有变细。相应的高分辨率 (HR) TEM 图像如图 3c 所示。可以观察到 InGaAs 核和 InP 壳之间的清晰界面。此外,在核壳界面处遵循 {111} 平面没有发现错配位错。因此,生长的 InP 壳与 InGaAs 核相干。此外,由于 InP 涂层的相干外延生长,InP 壳的晶体结构将完全继承 InGaAs 核纳米线的晶体结构,如图中 InGaAs/InP 核壳纳米线的混合 WZ/ZB 结构所证实. 3c.这种现象已在其他材料系统的核壳纳米线中观察到 [29,30,31],这种行为凸显了提高自催化 InGaAs 纳米线晶体质量的必要性。
<图片>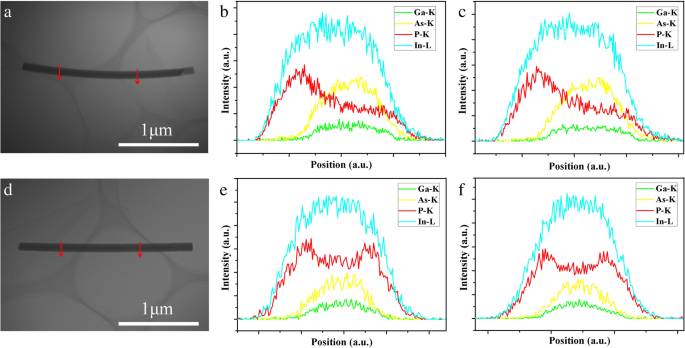
一 从 <110> 区轴获取的裸 InGaAs 纳米线 (Xv =35%) 的 HRTEM 图像。插图是相应的选区电子衍射 (SAED) 图案。 b InGaAs/InP 核壳纳米线的低倍 TEM 图像(Xv =35%)。 c 从 <110> 区轴观察的纳米线的 HRTEM 图像。红色虚线表示核壳界面
图 4a-c 显示了图 2b 中所示的典型 InGaAs/InP 核壳纳米线的低倍率 TEM 图像和 EDS 分析。根据穿过纳米线的 EDS 线扫描,可以在光谱中明显识别出 P 信号,表明 InGaAs 核周围存在 InP 壳层。而 P 信号的 EDS 谱是不对称的,这意味着 InP 壳层的过度生长在 InGaAs 核纳米线周围是不均匀的。我们推测这种现象可能主要是由核壳材料之间相对较大的晶格失配引起的,InP壳层的这种非均匀成核将进一步导致纳米线的弯曲。相比之下,对于图 2c 中的直线 InGaAs/InP (Xv =35%) 核壳纳米线,图 4e-f 中的 EDS 分析显示了整个纳米线中 P 信号的对称分布,表明 InP 壳周围的均匀性提高了此处Ga含量增加的InGaAs磁芯。
<图片>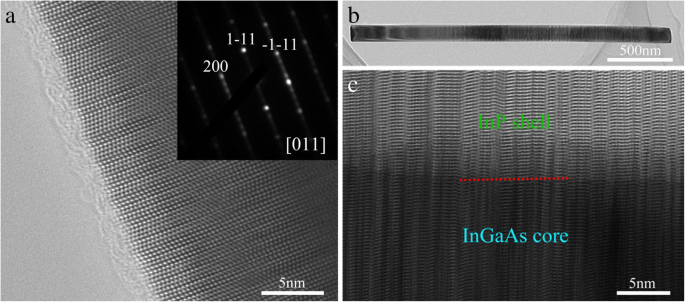
一 InGaAs/InP (Xv =30%) 核壳纳米线的低倍率 TEM 图像。 b , c EDS 线沿着 a 中标记的两条红线进行扫描 . d InGaAs/InP (Xv =35%) 核壳纳米线的低倍率 TEM 图像。 e , f EDS 线沿着 (d )
为了研究生长的纳米线的光学特性,进行了光致发光 (PL) 测量。图 5 比较了裸 InGaAs 和 InGaAs/InP (Xv =30%) 核-壳纳米线在 77 K 时的典型 PL 光谱。裸 InGaAs 纳米线的 PL 光谱显示出更弱的发射,峰值为 ~ 0.73 eV(蓝线图 5),而 InGaAs/InP 核壳纳米线的 PL 光谱表现出非常强的发射峰值在 ~ 0.78 eV(图 5 中的红线),并且 PL 峰值强度显示 ~ 100 倍增强到裸 InGaAs 纳米线。由于来自不同样品的纳米线密度具有可比性,我们认为 InGaAs/InP 核壳纳米线的如此显着的 PL 发射增强是由 InP 涂层有效抑制表面态和载流子限制引起的。
<图片>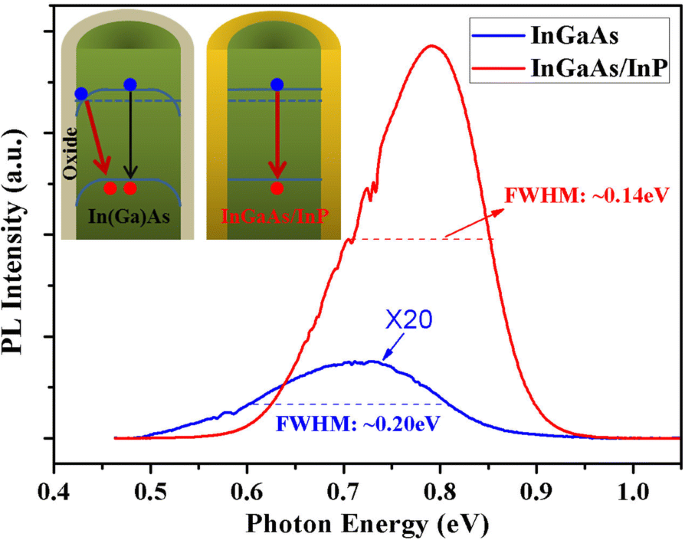
裸 InGaAs 和 InGaAs/InP (Xv =30%) 核壳纳米线在 77 K 的 PL 光谱。插图是裸富 InGaAs 和 InGaAs/InP 核壳纳米线的能带结构示意图
另一个有趣的特征是与裸 InGaAs 纳米线相比,InGaAs/InP PL 峰 (∼ 50 meV) 的轻微蓝移。首先,我们将这种不同的行为归因于当 InGaAs 核涂有 InP 壳时主要载流子复合路径的变化。通常,对于具有天然氧化物覆盖表面的裸 InAs 或富 InGaAs 纳米线,表面费米能级被固定在由众多表面状态引起的导带中,这将导致纳米线表面附近的带向下弯曲。然后,这种非平带结构将导致载流子重新分布,其中电子在纳米线表面附近积累,而空穴则留在纳米线的中心。在光照下,具有较低能量的空间间接电子-空穴对跃迁将是首选,如图 5 中的插图所示。对于裸 InAs 纳米线,据报道,近带边发射和表面相关的能量差异发射约为 ~ 35–45 meV [21]。然而,对于 InGaAs 纳米线,由于表面能带弯曲随着 Ga 成分的增加而显着降低,这种能量差异将同时减小,然后电子在纳米线表面附近的约束较少,空穴较少地集中在纳米线中心。因此,我们认为裸 InGaAs 纳米线的 PL 光谱是表面相关发射和近带边发射的混合。由于空间分离,表面介导的过渡概率非常低。此外,众多的表面态可能会通过非辐射复合过程消耗额外的电子-空穴对。因此,裸InGaAs纳米线的PL强度极弱。
然而,当 InGaAs 核纳米线被 InP 壳包覆时,情况会发生变化。由于核心纳米线的表面状态被有效去除,并且 InP 壳充当有效地将载流子限制在 InGaAs 纳米线的能垒,因此具有更高跃迁概率的带边附近的直接跃迁成为主导,正如 PL 发射的显着增强所证实的那样。此外,由于消除了表面相关发射,与裸 InGaAs 纳米线相比,InGaAs/InP 核壳纳米线的 PL 光谱显示出更窄的半峰全宽 (FWHM)。如前所述,由于此处获得的 InGaAs 纳米线的表面带弯曲有所减轻,因此近带边发射和表面相关发射之间的能量差应远低于此处获得的 ~ 50 meV。因此,除了这种影响,我们推测应变是观察到的蓝移的主要来源。由于 InP 壳层在 InGaAs 核上相干生长,界面处没有错配位错,InGaAs 核处于压缩应变下,这会导致 InGaAs 核纳米线的带隙加宽并解释 PL 峰值发射的蓝移。 32, 33]。因此,通过生长InP涂层,InGaAs纳米线的PL峰值能量应该呈现蓝移,其PL发射强度可以大大提高。
图 6a 显示了在 77 K 下具有不同 Xv 的 InGaAs/InP 核壳纳米线的归一化 PL 光谱。PL 峰值能量显示连续蓝移(从 ~ 0.78 eV 到 ~ 0.86 eV)随着 Xv 在 30 到 40 范围内的增加%。此外,根据室温下的 PL 测量,InGaAs/InP 核壳纳米线的发射在 1.49-1.68 μm 的波长范围内达到峰值,这在光纤通信中具有最小的功率衰减(~ 1.55 μm 区域)。图 6b 显示了 InGaAs/InP 核壳纳米线样品的温度相关 PL 光谱,其中 Xv =40%,插图显示了 PL 峰值能量的相应温度相关偏移。通常,在单晶块体材料中,根据 Varshni 方程,发光的温度依赖性随着温度的升高而显示出连续的红移。有趣的是,从图 6b 的插图中,只能在 60-290 K 的温度范围内观察到红移。当温度低于 60 K 时,PL 峰值能量几乎保持不变。考虑到生长的纳米线中结构缺陷的高密度,我们推测这种现象很可能是由带边缘附近的局部陷阱态引起的 [34]。在低温下,发射以陷阱辅助为主。随着温度的升高,被捕获的载流子从低能陷阱态被激发到能带边缘。因此,低温区的PL峰值能量不遵循通常观察到的随温度连续红移,与精确的带边相比往往被低估。
<图片>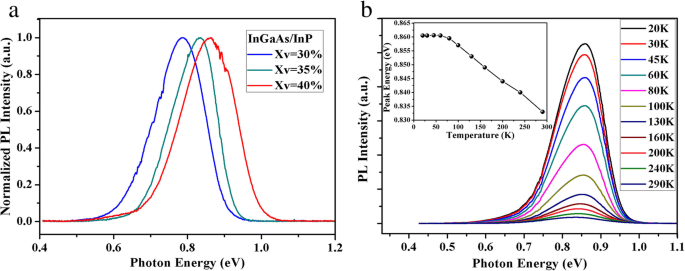
一 具有不同 Xv(Xv =30%、35% 和 40%)的 InGaAs/InP 核壳纳米线在 77 K 下的归一化 PL 光谱。b InGaAs/InP 核壳纳米线的温度相关 PL 光谱,其中 Xv =40%。插入 b 显示相应的 PL 峰值能量随温度变化
结论
总之,我们已经介绍了使用 MOCVD 在 Si-(111) 衬底上生长和表征 InGaAs/InP 核壳纳米线。核壳材料大晶格失配引起的核壳界面应力对InP壳层的生长行为有很大影响,导致InP壳层围绕InGaAs核不对称生长,甚至导致InGaAs核的弯曲纳米线。 TEM 测量显示 InP 壳在 InGaAs 核上相干生长,没有任何错配位错。从 77 K 的 PL 测量结果来看,InGaAs/InP 核壳纳米线的 PL 峰值强度与裸 InGaAs 纳米线相比提高了约 100 倍,这是由于表面状态的钝化和 InP 涂层的有效载流子限制。 InP 封端的纳米线的这种显着的发射增强使我们即使在室温下也能观察到发射。总的来说,这里获得的结果进一步加深了我们对应变核壳异质结构纳米线生长行为的理解,并可能为基于InGaAs纳米线的光电器件的制备奠定基础。
缩写
- BF:
-
明场
- CMOS:
-
互补金属氧化物半导体
- EDS:
-
能量色散光谱
- FTIR:
-
傅里叶变换红外
- FWHM:
-
半高全宽
- LED:
-
发光二极管
- MOCVD:
-
金属有机化学气相沉积
- PL:
-
光致发光
- SAED:
-
选区电子衍射
- SEM:
-
扫描电镜
- TEM:
-
透射电子显微镜
- TMGa:
-
三甲基镓
- TMIn:
-
三甲基铟
- ZB:
-
闪锌矿
纳米材料
- 材料科学家教纳米线如何“跳舞”
- 用于增强药物递送的纳米纤维和细丝
- Sb/坡缕石 (PAL) 纳米颗粒的制备和增强催化氢化活性
- 通过金属有机化学气相沉积在 InAs 茎上自催化生长垂直 GaSb 纳米线
- 化学蚀刻制备的硅纳米线的光学和电学特性
- 水溶性α-NaGdF4/β-NaYF4:Yb,Er核壳纳米粒子的合成和发光特性
- 用于最大太阳能收集的高效且有效的 InP 纳米线设计
- 氧化铝支撑层热稳定性增强对垂直排列单壁碳纳米管生长的影响及其在纳滤膜中的应用
- 固体源两步化学气相沉积法制备 InGaAs 纳米线的形成机制
- Mg 掺杂对用于增强光催化评估和抗菌分析的 ZnO 纳米颗粒的影响
- 通过水热法制备的 ZnO 纳米矛阵列的微观结构和掺杂/温度相关的光致发光
- 5G 和指数数据增长的挑战


