锗负电容场效应晶体管:Hf1−xZrxO2 中 Zr 成分的影响
摘要
在 Hf1−x 中具有各种 Zr 成分的锗 (Ge) 负电容场效应晶体管 (NCFET) Zrx 氧气 (x =0.33、0.48 和 0.67) 被制造和表征。对于每种 Zr 成分,NCFET 在亚阈值摆动 (SS) 的某些点表现出突然下降,这是由 NC 效应引起的。驱动电流I DS随着退火温度的升高而增加,这应该是由于源/漏电阻的降低和载流子迁移率的提高。通过多次直流扫描测量,陡峭的 SS 点是可重复和稳定的,证明它们是由 NC 效应引起的。栅极电压V的值 GS 对应陡峭 SS 一致且顺时针I DS-V GS 通过多次 DC 扫描保持。在固定退火温度下,含 Hf0.52Zr0.48O2 的 NC 器件实现了更高的 I DS 但与其他组合物相比滞后更大。具有 Hf0.67Zr0.33O2 的 NCFET 可以获得具有无滞后曲线和高 I 的优异性能 数据。
背景
将铁电薄膜插入栅极堆叠的铁电负电容场效应晶体管 (NCFET) 是低功耗应用的有希望的候选者,因为它能够克服传统金属的亚阈值摆幅 (SS) 的基本限制。氧化物半导体场效应晶体管 (MOSFET) [1]。 NCFET 中的负电容 (NC) 现象已在不同通道材料中得到广泛研究,包括硅 (Si) [2, 3]、锗 (Ge) [4]、锗锡 (GeSn) [5]、III-V [6] 和二维材料 [7]。此外,NC 特性已在具有各种铁电体的 NCFET 中得到证明,例如 BiFeO3 [8]、PbZrTiO3 (PZT) [9]、PVDF [10] 和 Hf1-x Zrx 氧气 [11]。与其他铁电体相比,Hf1−x ZrxO2 具有兼容 CMOS 集成的优点。实验研究表明,可以通过改变 Hf1−x 的厚度和面积来优化 NCFET 的电气性能 Zrx O2,影响MOS电容(C MOS) 和铁电电容 (C FE) [12, 13]。预计 Hf1−x 中的 Zr 成分 Zrx O2 对 NCFET 的性能也有很大影响,因为它决定了 Hf1−x 的铁电特性 Zrx 氧气。然而,Zr成分对NCFETs电学特性的影响还缺乏详细的研究。
本文综合研究了退火温度和Zr成分对Ge NCFET性能的影响。
方法
在 Hf1−x 中制造具有不同 Zr 成分的 Ge p 沟道 NCFET 的关键工艺步骤 Zrx O2 如图 1(a) 所示。在预栅极清洁之后,将 n-Ge (001) 衬底装入原子层沉积 (ALD) 室。沉积了一层薄的 Al2O3(25 循环)薄膜,然后进行 O3 钝化。然后,Hf1-x Zrx 使用 [(CH3)2N]4Hf (TDMAHf)、[(CH3)2N]4Zr (TDMAZr) 和 H2O 作为 Hf、Zr 和 O,在同一 ALD 室中沉积 O2 膜(x =0.33、0.48 和 0.67)前体,分别。之后,使用反应溅射沉积 TaN 金属栅极。栅极图案化和蚀刻后,硼离子 (B + )以20 keV的能量和1 × 10 15 的剂量注入源/漏(S/D)区 cm −2 .非自对准 S/D 金属是通过剥离工艺形成的。最后,在不同温度下进行快速热退火 (RTA) 以进行掺杂激活、S/D 金属化和 Hf1−x 的结晶 Zrx O2膜。还制备了具有 Al2O3/HfO2 叠层的 Ge 控制 pMOSFET。
<图片>
(a ) 在 Hf1−x 中制备具有不同 Zr 成分的 Ge NCFET 的关键工艺步骤 Zrx O2铁电体。 (b ) 制造的 NC 晶体管的示意图。 (c ) NC 器件栅叠层的 TEM 图像,显示了 7 nm H0.52Zr0.48O2 层和 2 nm Al2O3 层
图 1(b) 显示了制造的 NCFET 的示意图。图 1(c) 中的高分辨率透射电子显微镜 (HRTEM) 图像显示了具有 Hf0.52Zr0.48O2 铁电体的器件 Ge 通道上的栅极堆叠。 Al2O3和Hf0.52Zr0.48O2层的厚度分别为2 nm和7 nm。
确认 Hf1−x 的化学计量 Zrx O2,进行 X 射线光电子能谱 (XPS) 测量。图 2(a) 和 (b) 显示了 Hf4f 和 Zr3d 分别为 Hf0.67Zr0.33O2、Hf0.52Zr0.48O2 和 Hf0.33Zr0.67O2 薄膜的光电子核心能级光谱。根据峰面积比和相应的灵敏度因子计算材料组成。 Zr3d的两个峰 5/2 和 Zr3d 3/2 具有 2.4 eV 的自旋轨道分裂,这与 Refs. [14, 15]。随着 Hf1−x 中 Zr 成分的增加 Zrx O2, Zr3d , 和 Hf4f 峰向低能量方向移动。
<图片>
(a ) Hf 4f 和 (b ) Zr 3d Hf1−x 的核心能级谱 Zrx 不同Zr成分的O2样品
Hf1−x 的铁电特性 ZrxO2 薄膜 (x =0.33、0.48 和 0.66) 的特点是极化 P 与驱动电压 V 磁滞回线测量。 P -V 循环记录在原始设备上。图 3 显示了 P 的曲线 对比 V 对于 TaN/Hf1−x Zrx 一系列驱动电压下的 O2(10 nm)/TaN 样品。随着后退火温度从 500 升高到 550 °C,P -V Hf1−x 的曲线 Zrx O2 在子回路状态中趋于饱和。随着Zr成分的增加,薄膜的剩余极化明显改善,并且观察到零偏压下磁滞回线变薄,这在现象学上可以最好地描述为叠加的类反铁电特性[16, 17]。
<图片>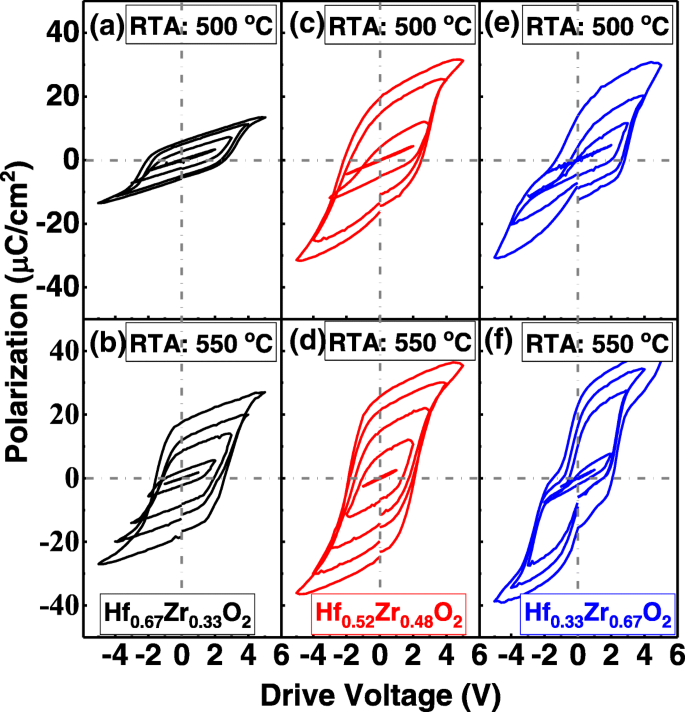
不同Zr成分的Hf1-xZrxO2薄膜在500和550 o 退火后的P-V曲线实测 C. (a ) 和 (b ) 是在 500 和 550 o 退火的 Hf0.67Zr0.33O2 薄膜 C、分别。 (c ) 和 (d ) 是在 500 和 550 o 退火的 Hf0.52Zr0.48O2 薄膜 C、分别。 (e ) 和 (f ) 是在 500 和 550 o 退火的 Hf0.33Zr0.67O2 薄膜 C、分别。随着后退火温度从 500 升高到 550 o C,Hf1-xZrxO2 的 P-V 曲线在子回路状态下趋于饱和。随着Zr成分的增加,观察到铁电向类反铁电行为的演变
结果与讨论
图 4(a) 显示了具有不同退火温度的 Hf0.52Zr0.48O2 铁电体和具有 Al2O3/HfO2 叠层电介质的控制装置的 Ge NCFET 的测量转移特性。控制装置在 500 °C 下退火。所有器件的栅极长度为 L G 为 2 μm。正向和反向扫描分别由空心符号和实心符号表示。与控制设备相比,NCFET 具有更高的驱动电流。可以看出,随着退火温度从 450 升高到 550 °C,阈值电压 V NC 设备的 TH 移至正 V GS 方向。 NCFET 表现出很小的滞后,随着 RTA 温度的升高,滞后变得可以忽略不计。诱捕效应也会导致滞后,但这会产生逆时针 I DS-V GS 回路,与铁电开关引起的结果相反 [18]。点 SS vs. I 图 4(b) 中的 DS 曲线表明 NC 晶体管在 SS 的某些点表现出突然下降,对应于 I 的突然变化 由 NC 效应引起的 DS [19]。据观察,与控制装置相比,NCFET 实现了改进的 SS 特性。我们发现器件在不同退火温度下的突然下降点是一致的。测量的 I DS-V Hf0.52Zr0.48O2 铁电体在不同温度下退火的 NCFET 的 DS 曲线如图 4(c)所示。 我 DS-V NC晶体管的DS曲线表现出明显的NDR现象,这是NC晶体管的典型特征[20,21,22,23]。图 4(d) 是 I 的图 具有 Hf0.52Zr0.48O2 铁电层的 Ge NCFET 的 DS,分别在 450、500 和 550°C 下在 V 下退火 DS =− 0.05 V 和 - 0.5 V,和 |V GS - V TH| =1.0 V。这里,V TH 定义为 V I 处的 GS DS 为 10 −7 A/微米。 我 DS随着RTA温度的升高而增加,这是由于在较高的退火温度下源/漏电阻降低和载流子迁移率提高。
<图片>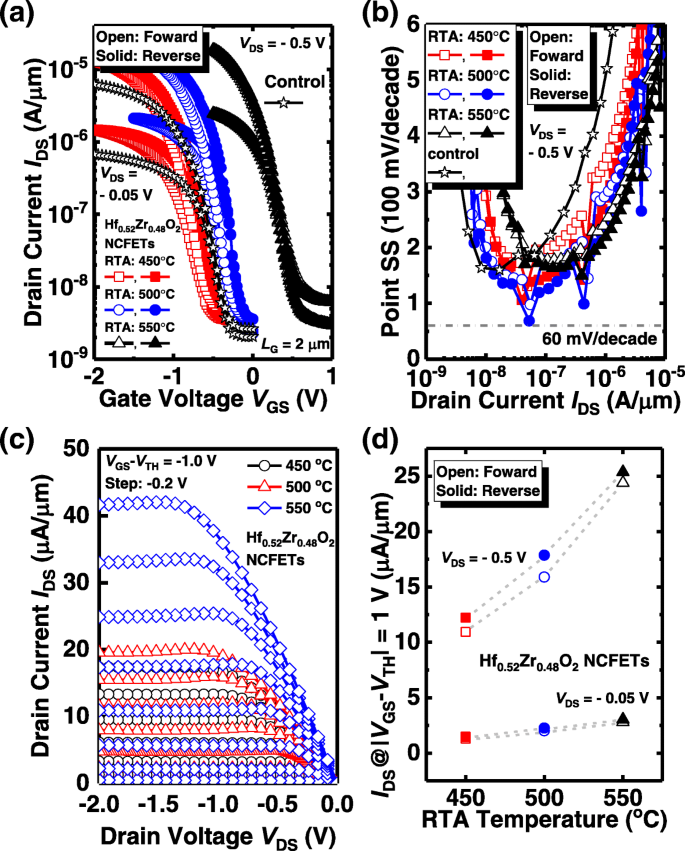
(a ) 测量 I DS-V 带有 Hf0.52Zr0.48O2 铁电和控制装置的 NCFET 的 GS 曲线。 (b ) 点 SS vs. I DS 曲线显示,与控制 MOSFET 相比,NCFET 具有更陡峭的 SS。 (c ) 我 DS-V NCFET 的 DS 曲线展示了典型的 NDR 现象。 (d ) I 的比较 NCFET 的 DS 在不同温度下退火,栅极过驱动为 1 V
除了 Hf0.52Zr0.48O2 铁电晶体管,我们还研究了具有 Hf0.33Zr0.67O2 铁电体的 Ge NC 晶体管的电气特性。图 5(a) 展示了 I DS-V V不同退火温度下Hf0.33Zr0.67O2器件的GS特性 DS =− 0.05 V 和 - 0.5 V. 与 Hf0.52Zr0.48O2 NC 晶体管相比,获得了更小的滞后。类似于 Hf0.52Zr0.48O2 NC 晶体管,随着退火温度从 450 增加到 550 °C,V 在 V 处的正向扫描中,器件的 TH 从 - 0.63 V 增加到 0.51 V DS =− 0.05 V. 点 SS 作为 I 的函数 Hf0.33Zr0.67O2 铁电 NCFET 的 DS 特性如图 5(b)所示。此外,与550 °C退火的晶体管相比,450 °C和500 °C退火温度的器件获得了更明显的SS突然下降。不同退火温度下的突然下降点发生在相同的栅极电压下。图 5(c) 展示了正向和反向 I Hf0.33Zr0.67O2 NCFET 在 V 处的 DS DS =− 0.05 V 和 - 0.5 V,和 |V GS-V TH| =1.0 V. 无论是正向扫描还是反向扫描,I DS随着退火温度的升高而增加,这与Hf0.52Zr0.48O2器件的特性一致。
<图片>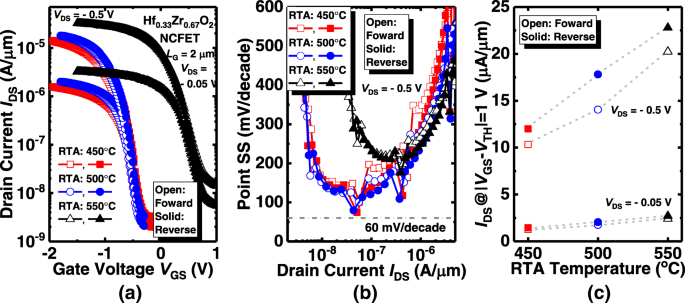
(a ) 测量的 Hf0.33Zr0.67O2 NC Ge pFET 在 450 至 550 °C 下退火的传输特性。 (b ) 点 SS 作为 I 的函数 Hf0.33Zr0.67O2 器件的 DS。 (c ) 我 1 V 栅极过驱动下不同退火温度的铁电 NC 晶体管的 DS
我们还研究了具有较小 Zr 成分的 Ge NCFET 的电气性能。在不同退火温度下退火的 Hf0.67Zr0.33O2 NCFET 的传输特性如图 6(a)所示。没有观察到滞后现象。与 Hf0.33Zr0.67O2 和 Hf0.52Zr0.48O2 器件相比,V 在 Hf0.67Zr0.33O2 NCFET 中,由改变退火温度引起的 TH 偏移不太明显。点 SS vs. I 图 6(b) 中的 DS 曲线表明 Hf0.67Zr0.33O2 NC 晶体管在 V 处 NC 晶体管的某些点 SS 出现突然下降 DS =− 0.05 V。图 6(c) 显示了 I Hf0.67Zr0.33O2 Ge NCFET 的 DS 在 450 °C、500 °C 和 550 °C、V 下退火 DS =− 0.05 V 和 - 0.5 V,和 |V GS-V TH| =1.0 V。同样,I DS随着RTA温度的升高而增强。
<图片>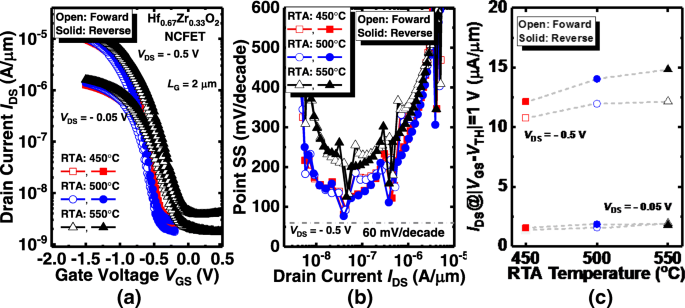
(a ) 测量 I DS-V Hf0.67Zr0.33O2 NC Ge pFET 的 GS 在 450 °C、500 °C 和 550 °C 下退火。 (b ) 点 SS 与设备的 IDS 特性。 (c ) 我 1 V栅极过驱动下不同退火温度的铁电NC晶体管的DS
由 Hf0.52Zr0.48O2 NCFET 的铁电层引起的 NC 效应的稳定性通过多次 DC 扫描测量得到验证。测量的 I DS-V 图 7(a) 显示了 100 个直流扫描周期内的 GS 曲线。可以看出,V 的值 GS 对应陡峭的 SS 是一致的。此外,顺时针I-V 通过多次 DC 扫描保持环路。陡峭的 SS 点通过多次 DC 扫描是可重复和稳定的,这进一步证明它们是由 NC 效应引起的。图 7(b) 显示了扫描周期数中的最佳点 SS 和驱动电流。图 7(c) 显示了作为 DC 扫描周期数的函数的滞后特性。稳定的I-V 可见~ 82 mV的滞后窗口。
<图片>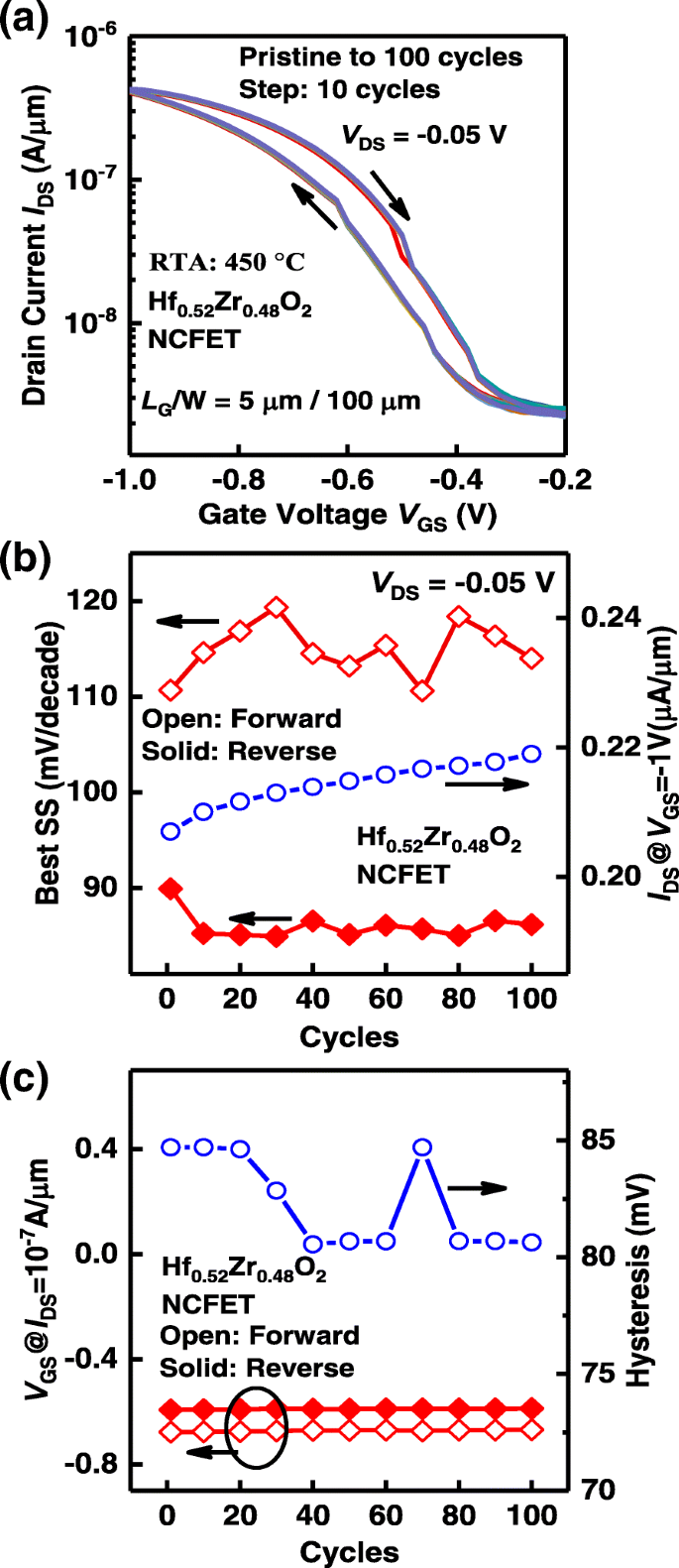
(a ) 测量 I DS-V Hf0.52Zr0.48O2 NC Ge pFET 在 100 个直流扫描周期内的 GS 曲线。 (b ) 最佳点 SS 和 I DS 与周期数。 (c ) 作为直流扫描周期数的函数的迟滞特性
我们总结了在 Hf1−x 中具有不同 Zr 成分的 Ge NCFET 的滞后和驱动电流特性 Zrx 图 8 中的 O2。如图 8(a) 所示,对于具有 x 的器件,滞后值为 70、148 和 106 mV =0.33、0.48 和 0.67,分别为 V DS of – 0.5 V。随着成分从0.33增加到0.48,NC设备的滞后显着增加。随着Zr成分的进一步增加,滞后迅速减小。 我 在 450 °C 下退火的 NCFET 的 DS 绘制在图 8(b) 中,在 V DS =− 0. 5 V 和 V GS - V TH =− 1. 0 V. Open和solid分别代表正向和反向扫描。含 Hf0.52Zr0.48O2 的 NC 装置达到最高 I DS,但它的滞后现象很严重。具有 Hf0.67Zr0.33O2 的 NCFET 可以获得优异的性能,无滞后曲线和高 I DS。随着 Zr 成分的增加,铁电电容 C fe (=0.3849*P r/(E c*t fe) [24]) 随着 P 的增加而增加 r,同时,MOS 电容 (C 由于 HZO 膜的介电常数增加,MOS) 也上升。 我 DS 和滞后由 |C 确定 铁|和 C 晶体管的MOS。随着 Zr 组成从 0.33 增加到 0.48,|C 铁|推测比 C 慢 MOS,导致滞后扩大。尽管如此,较大的C MOS 产生更高的 I DS。随着Zr成分的进一步增加,|C 铁|比 C 快 MOS,可能提供 |C 铁| ≥ C MOS,降低NCFET的迟滞。
<图片>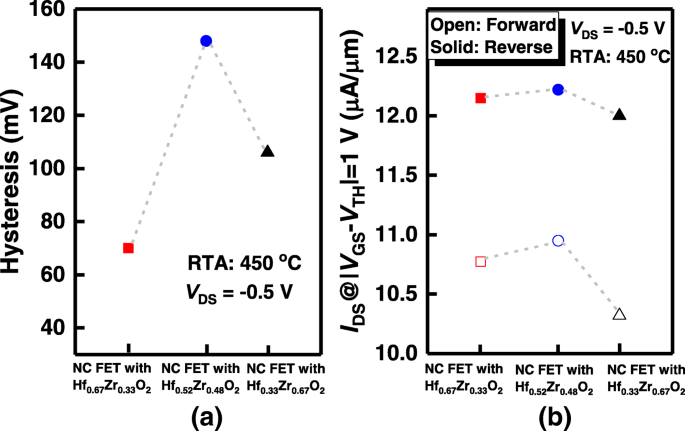
(a 的统计图 ) 滞后和 (b ) 我 具有 Hf1−x 的 Ge NCFET 的 DS Zrx 氧气 (x =0.33、0.48 和 0.67)
结论
退火温度和Zr成分对Hf1-x的影响 Zrx 实验研究了 O2 对 Ge NCFET 电性能的影响。 Hf1−x的化学计量学和铁电性质 Zrx O2 经 XPS 和 P-V 确认 分别测量。 NCFET 展示了陡峭点 SS 和改进的 I DS相比控制装置,由于NC效应。 V TH 和 I Hf1−x 的 DS Zrx O2 NCFET 受退火温度的影响很大。多次 DC 扫描测量表明,在 NCFET 中实现了铁电层引起的 NC 效应的稳定性。 Hf0.67Zr0.33O2 NCFET比具有较高Zr成分的器件更容易实现无滞后特性。
缩写
- Al2O3 :
-
氧化铝
- ALD:
-
原子层沉积
- BF2 + :
-
硼氟离子
- DC:
-
直流电
- 哥:
-
锗
- GeOx :
-
氧化锗
- 高频:
-
氢氟酸
- HfO2 :
-
二氧化铪
- HRTEM:
-
高分辨透射电子显微镜
- MOSFET:
-
金属氧化物半导体场效应晶体管
- NC:
-
负电容
- Ni:
-
镍
- SS:
-
亚阈值摆动
- TaN:
-
氮化钽
- TDMAHf:
-
四(二甲基酰胺基)铪
- TDMAZr:
-
四(二甲基酰胺基)锆
纳米材料


