具有改进的漏极电流密度和高击穿电压的高性能 AlGaN 双通道 HEMT
摘要
在这项工作中,提出并通过金属有机化学气相沉积 (MOCVD) 生长 AlGaN 双通道异质结构,并制造和研究了高性能 AlGaN 双通道高电子迁移率晶体管 (HEMT)。双通道特征的实现有效地提高了AlGaN通道异质结构的传输特性。一方面,由于沿垂直方向的双势阱和增强的载流子限制,提高了总二维电子气(2DEG)密度。另一方面,由于载流子-载流子散射效应的抑制,每个通道中的平均2DEG密度降低,迁移率升高。结果,最大漏电流密度 (I 在栅极电压为 0 V 的情况下,AlGaN 双通道 HEMT 的 max) 达到 473 mA/mm。此外,AlGaN 双通道 HEMT 的优异击穿性能也得到了证明。这些结果不仅表明了AlGaN双通道HEMT在微波功率电子学中的巨大应用潜力,而且为III族氮化物基电子器件的研究开辟了新思路。
介绍
III 族氮化物基高电子迁移率晶体管 (HEMT) 因其快速开关速度和低开关损耗而被确定为下一代微波功率电子器件最有希望的候选材料 [1,2,3,4,5] .近来,最先进的氮化物 HEMTs 已经实现了高达 650 V 的初步商业化。然而,随着器件制造技术的成熟,进一步扩大击穿电压 (V b) 提高器件在高温下的可靠性。因此,鉴于 AlGaN 比 GaN 具有更大的带隙和优异的热稳定性,AlGaN 沟道器件被认为是进一步提高氮化物 HEMT 在高压和高温应用中的性能极限的有希望的候选者 [6,7,8 ,9,10,11,12,13,14,15]。
南乔等人。证明了 AlGaN 沟道 HEMT 显着的击穿电压增强,并且在栅漏距离为 10 μm 的 Al0.53Ga0.47N/Al0.38Ga0.62N HEMT 中获得的最大击穿电压为 1650 V [6]。之后,Nanjo 等人。进一步将 Al0.40Ga0.60N/Al0.15Ga0.85N HEMT 的击穿电压提高到 1700 V [8]。张等人。制造了具有新型欧姆/肖特基混合漏极触点的 AlGaN 沟道 HEMT,AlGaN 沟道 HEMT 获得了超过 2200 V 的创纪录高击穿电压 [11]。肖等人。提出了具有807 cm 2 的高2DEG迁移率的AlGaN沟道异质结构 /V·s,以及所制造的 AlGaN 沟道 HEMT [14] 的最大漏电流和 Ion/Ioff 比的记录。此后,肖等人。首次提出了具有超晶格AlGaN沟道层的常关HEMT,所制造的器件显示出击穿电压超过2000 V,导通电流密度高达768 mA/mm,阈值电压(V T) 为 1.0 V [15]。最近,Baca 等人。评估了具有 80 纳米长栅极的 AlGaN 沟道 HEMT 的射频 (RF) 性能。 28.4 GHz 的 fT 和 18.5 GHz 的 fMAX 是通过小信号 S 参数测量确定的 [12]。这些结果说明了 AlGaN 沟道 HEMT 在射频功率应用中的前景。
然而,之前报道的 AlGaN 沟道器件的局限性同样明显。一方面,由于三元合金无序散射效应,AlGaN沟道中的二维电子气(2DEG)迁移率远低于GaN沟道。因此,AlGaN沟道器件的电流驱动能力远低于传统GaN沟道器件。另一方面,为了在AlGaN沟道中诱导出相同数量的2DEG,AlGaN势垒层中的AlN成分应高于常规GaN沟道异质结构的AlN成分,这会增加材料生长过程的难度。这些矛盾严重制约了AlGaN沟道器件的广泛应用,迫切需要异质结构布局优化。
双通道技术是一种有趣的方法,可以提高氮化物基异质结构的通道载流子密度,而不会对电子迁移率产生任何不利影响,并且器件的电流传导能力将得到改善 [16,17,18]。然而,迄今为止,关于AlGaN双通道异质结构或电子器件的报道很少。在这项工作中,首次提出并生长了AlGaN双沟道异质结构,以解决电流驱动能力与氮化物基电子器件击穿性能之间的矛盾。此外,还详细研究了基于新型异质结构的高性能AlGaN双通道HEMTs。
方法
AlGaN双沟道异质结构的横截面示意图如图1a所示,生长过程可总结如下。首先,在蓝宝石衬底上生长 1600 nm GaN 缓冲层。然后生长500 nm渐变AlGaN缓冲层,AlN成分从0%增加到10%,有利于抑制寄生沟道的形成。此后,100 nm下AlGaN沟道、1 nm AlN中间层和23 nm下AlGaN势垒相继生长,沟道层和势垒层中的AlN成分分别为10%和31%。最后,生长30 nm上AlGaN沟道、1 nm AlN中间层和23 nm上AlGaN势垒层,其成分与下层相同。 AlGaN双通道异质结构的导带图可以通过自洽求解一维泊松-薛定谔方程来计算,该方程采用非均匀网格尺寸的有限差分方法[19]。 AlGaN双通道异质结构的导带图和提取的电子密度分布如图2a所示,AlGaN单通道异质结构的结果也在图2b中提供了成分。在AlN中间层和Al0.10Ga0.90N沟道层的界面处形成两个深势阱,用于AlGaN双沟道异质结构,对应双2DEG沟道。另外,可以观察到上通道的2DEG密度高于下通道,这可以从两个方面来解释。一方面,下部AlGaN势垒充当上部沟道的背势垒,有利于促进上部沟道的2DEG限制。另一方面,氮化物异质结构中沟道2DEG的主要供给源是类施主表面态[20],其更靠近上部沟道。
<图片>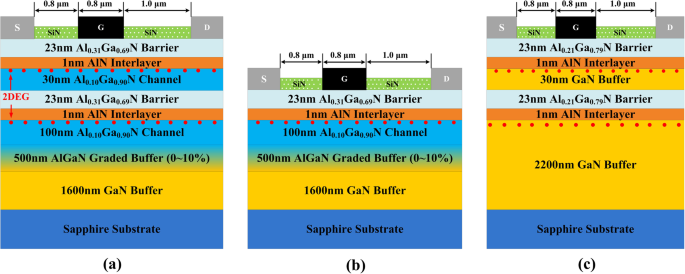
a 的横截面图(未按比例) AlGaN 双通道,b AlGaN单通道和c GaN双通道异质结构(HEMTs)
<图片>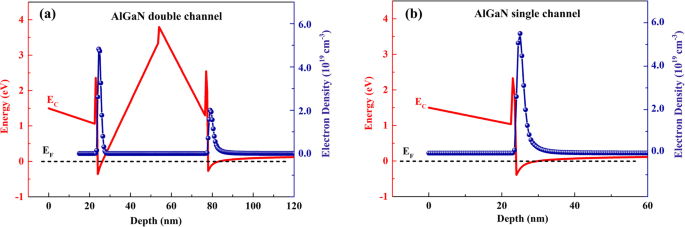
AlGaN双通道和单通道异质结构的导带图和电子密度分布
结果与讨论
图 3 显示了对称 (0004) 反射的 AlGaN 双通道异质结构的高分辨率 X 射线衍射 (HRXRD) ω-2θ 扫描结果。可以观察到来自 AlN 成核层、GaN 缓冲层、AlGaN 渐变缓冲层、AlGaN 通道和 AlGaN 势垒层的衍射强度。此外,为清楚起见,图 2b 中显示了从 71.0 到 73.2° 的光谱扫描,并放大了,并应用了洛伦兹函数来拟合多峰。 GaN缓冲层、AlGaN沟道和AlGaN势垒的衍射峰位于71.6°、72.2°和72.8°,AlGaN梯度缓冲层在GaN缓冲层和AlGaN沟道峰之间形成平台。这些结果表明独特的多层结构和生长过程的精密控制,可以提取AlGaN沟道和势垒中10%和31%的AlN成分。
<图片>
AlGaN双通道异质结构的HRXRD(0004)面ω-2θ扫描
使用汞探针配置进行电容-电压 (C-V) 测量以研究异质结构的双通道特性。如图 4 的插图所示,可以在 - 2.5 V 和 - 10 V 左右观察到两个不同的电容阶跃,施加的电压从 0 到 - 15 V,对应于 AlN/Al0.10Ga0 处 2DEG 的耗尽.90 接口。此外,载流子分布特性可以从C-V曲线中提取出来,结果如图4所示。两个载流子浓度峰位于24和78 nm处,值为6.1×10 19 和 2.5 × 10 19 厘米 −3 ,这与计算结果一致,如图2所示。特别是,直到测试深度达到1 μm才可以观察到寄生传导通道,表明异质结构的双通道特性成功实现。此外,2DEG 片密度和迁移率确定为 1.3 × 10 13 cm −2 和 1130 cm 2 /V∙s 由霍尔效应测量。
<图片>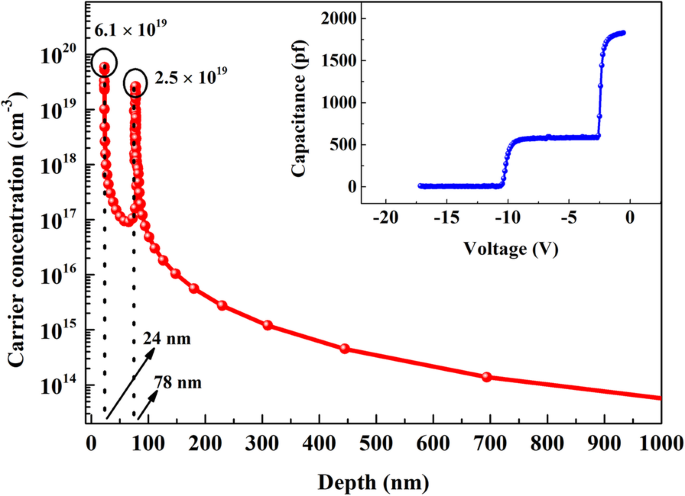
AlGaN双沟道异质结构的C-V特性及电子分布曲线
标准 HEMT 制造工艺是在 AlGaN 双通道异质结构上进行的。器件制造过程开始于通过电子束蒸发沉积的 Ti/Al/Ni/Au 多层金属叠层形成欧姆接触,然后在 N2 气氛中在 850 °C 下快速热退火 30 s。然后,通过Cl2/BCl3电感耦合等离子体蚀刻进行台面隔离,深度为200 nm,并通过等离子体增强化学气相沉积形成100nm厚的SiN钝化层。之后,一个长度为 (L G) 0.8 μm是在用CF4等离子体蚀刻顶部SiN之后通过光刻定义的,然后沉积Ni/Au肖特基栅电极。栅源 (L GS) 和栅漏 (L GD) 距离分别为 0.8 和 1 μm。为了进行比较,还制造了两个基于传统 AlGaN 单通道和 GaN 双通道异质结构的额外 HEMT 样品,横截面示意图如图 1b 和 c 所示。附加HEMTs样品的器件工艺和特性参数与AlGaN双通道HEMTs完全相同。采用Keithley 4200半导体参数分析仪对器件的输出和传输特性进行分析,采用Agilent B1505A高压半导体分析仪系统进行击穿特性分析。
HEMT 的典型输出特性如图 5 所示,其中 VGS 和 VDS 从 0~− 10 V 和 0~10 V 扫描。最大漏电流密度 (I max) 和微分导通电阻 (R AlGaN 单通道样品的 on) 分别为 265.3 mA/mm 和 27.1 Ω∙mm。这些结果与之前的报道一致,表明 AlGaN 沟道 HEMT 在当前驱动能力方面存在不足。对于 AlGaN 双通道 HEMT,I max 急剧增加至 473 mA/mm,是 AlGaN 单通道 HEMT 的 1.8 倍。我们将改进归因于 I 最大限度地发挥 AlGaN 双通道异质结构的卓越传输特性。一方面,双通道结构沿垂直方向具有两个势阱,提升了AlGaN传导通道的载流子存储能力。另一方面,虽然总通道载流子密度增加,但每个通道中的平均电子密度降低。结果,抑制了载流子-载流子散射效应,提高了沟道电子迁移率。然而,可以观察到 R AlGaN 双通道 HEMT 的电阻为 12.5 Ω∙mm,仍大于 GaN 双通道 HEMT。这种现象与 AlGaN 势垒层的大接触势垒高度有关,AlN 成分高达 31%。由于高功耗引起的自热效应,当 V GS>− 4 V 和 V DS> 6 V。然而,对于AlGaN沟道HEMT(单沟道和双沟道),这种负微分电阻效应被显着抑制,体现了AlGaN沟道HEMT在高温条件下的优越性能。
<图片>
AlGaN双通道、AlGaN单通道和GaN双通道HEMT的输出特性
图 6 说明了具有 V 的 HEMT 的典型转移特性 DS 为 10 V。AlGaN 单通道 HEMT 表现出阈值电压 (V T) 为 − 3.8 V,以及较低的峰值外跨导 (G m,max) 在 V 附近为 80.5 mS/mm GS =− 1.5 V. 对于 AlGaN 双通道和 GaN 双通道 HEMT,V T 显着降低至 - 9.2 和 - 11.2 V,这是由于高沟道载流子密度和从栅电极到下部 2DEG 沟道的相对长距离造成的。高 V T 可能导致器件在关断状态下的高功率损耗,可以通过进一步优化双通道结构的生长参数来改善这个问题,例如适当减小势垒层和上通道层的厚度。特别地,可以观察到 AlGaN 双通道和 GaN 双通道 HEMT 的跨导曲线的双峰特性。对于 AlGaN 双通道 HEMT,可以在 V 处提取 97.9 和 42.5 mS/mm 的两个峰值 G =− 1.0 和 − 6.0 V。亚峰值达到 Gm,max 的 43%,表明 AlGaN 双通道 HEMT 具有良好的栅极控制能力和线性度。此外,基于我们之前的研究成果[21],可以通过调节AlGaN双通道的厚度和成分等结构参数来进一步改善结果,双通道与器件线性度之间的耦合效应可以得到增强。
<图片>
AlGaN双通道、AlGaN单通道和GaN双通道HEMT的传输特性
测量了基于不同异质结构的 HEMT 的断态击穿特性,如图 7 所示。V b 由漏电流达到 5 μA/mm 的标准定义。可以观察到,三个样品均呈现硬击穿特性,AlGaN沟道HEMTs的击穿性能明显优于GaN沟道HEMTs。 V AlGaN 双通道 HEMT 的 b 为 143.5 V,是 GaN 双通道 HEMT 的两倍多。取 L 考虑到 GD =1 μm,V b、标准(由V定义 b/L 对于 AlGaN 双通道 HEMT,GD) 高达 143.5 V/μm。 我 最大值和 V b,本工作中 AlGaN 双通道 HEMT 的标准结果与图 8 中其他组报告的 GaN 通道和 AlGaN 通道 HEMT 以及耗尽模式 (DM) 和增强模式 (EM) 器件的结果进行了对比区分。此外,在之前的报告和这项工作中,AlGaN 沟道 HEMT(异质结构)的核心指标总结在表 1 中。 如图 8 所示,很明显,AlGaN 沟道 HEMTs 的击穿性能普遍优于 GaN通道 HEMT,伴随着 I 的恶化 最大限度。值得注意的是,I 本工作中 AlGaN 双通道的最大值与 GaN 通道 HEMT 的大多数结果相当。此外,需要注意的是I 这项工作的最大值在 V 处获得 GS =0 V,这是保守的,可以通过施加正栅极电压进一步改善。因此,这些结果令人信服地证明了AlGaN双通道HEMT在微波功率器件应用中的巨大潜力。
<图片>
AlGaN双通道、AlGaN单通道和GaN双通道HEMT的击穿特性
<图片>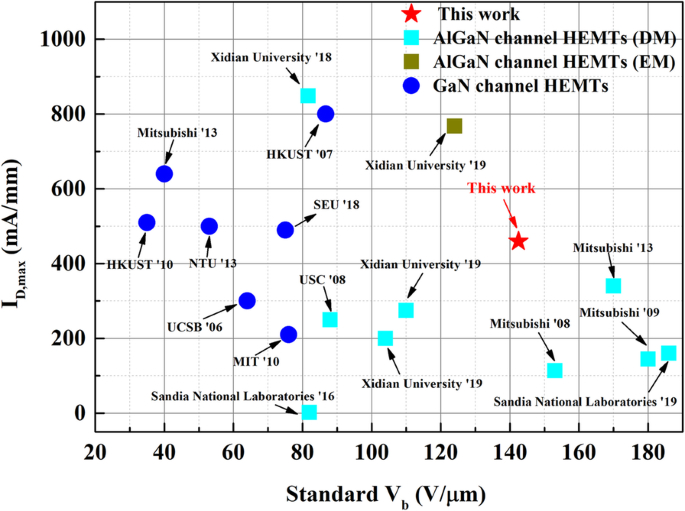
I 的基准 最大值和 V b、AlGaN沟道和GaN沟道HEMT标准
结论
总之,提出了 AlGaN 双通道异质结构来制造高性能 HEMT。揭示了 AlGaN 双通道异质结构的优异传输特性,从而提高了 HEMT 的电流驱动能力。此外,还展示了 AlGaN 双通道 HEMT 的出色击穿性能。此项工作的结果显示了AlGaN双通道器件在未来微波功率应用中的巨大潜力。
数据和材料的可用性
本研究期间生成或分析的所有数据均包含在这篇已发表的文章及其补充信息文件中。
缩写
- MOCVD:
-
金属有机化学气相沉积
- HEMT:
-
高电子迁移率晶体管
- 2DEG:
-
二维电子气
- I 最大:
-
最大漏电流密度
- V 乙:
-
击穿电压
- V :
-
阈值电压
- RF:
-
射频
- HRXRD:
-
高分辨率X射线衍射
- C-V:
-
电容-电压
- L :
-
浇口长度
- L 高:
-
门源距离
- L 广东:
-
栅漏距离
- R 上:
-
导通电阻
- G 米:
-
跨导
- DM:
-
耗尽型
- EM:
-
增强模式
纳米材料


