Ge 掺杂垂直 GaN 肖特基势垒二极管的恢复性能
摘要
垂直 GaN 肖特基势垒二极管 (SBD) 是在掺 Ge 的自支撑 GaN 衬底上制造的。 SBDs的晶体质量通过阴极发光测量表征,位错密度确定为~ 1.3 × 10 6 cm − 2 .进行电气性能测量后,SBD 显示出低导通电压 V 在 (0.70~0.78 V) 和高电流 I 在/我 关闭比 (9.9 × 10 7 ~1.3 × 10 10 )。研究了反向恢复特性。对于 100-、200-、300-、400- 和 500-μm 直径的 SBD,反向恢复时间分别为 15.8、16.2、18.1、21.22 和 24.5 ns。同时,反向恢复时间和反向恢复电荷均与电极面积呈显着正相关。
介绍
近来,具有先天优势的宽带隙半导体——如GaN——引起了下一代电子器件的极大研究关注,特别是在高频、大功率和高性能领域[1,2,3 ,4,5,6]。同时,由于氢化物气相外延(HVPE)的发展,低位错密度(≤ 10 6 cm − 2 ) GaN 衬底现已上市 [7,8,9,10]。与横向器件相比,用这些衬底制造的垂直型器件被认为是一种更先进的结构,有利于实现更大的电流、更少的泄漏路径和更好的系统可靠性[11, 12]。其中,GaN基肖特基势垒二极管(SBD)是开关器件中的重要元件。与双极二极管不同,SBD 的单极特性大大降低了少数载流子存储效应,相应地提供了高开关速度和低反向恢复损耗。然而,很少有团队对垂直 GaN SBD 的反向恢复特性进行系统研究 [13,14,15,16,17],其中研究更多地集中在不同结构器件的开关时间比较上。因此,仍然迫切需要深入研究GaN SBD的恢复性能机制,特别是垂直的。
同时,由于许多已发表的论文 [18] 不断探索欧姆接触技术来提高器件性能,因此重掺杂 n 型 GaN 是制造氮化物器件的关键环节。最近,Ge 被提议作为 GaN 中 Si 掺杂剂的替代品,因为它们都具有相似的浅能级杂质特性(据报道,Ge 和 Si 的活化能分别为 20 和 17 meV)以及引起的晶格畸变由于它们的离子半径更近,Ge 原子取代 Ga 位点会更小 [19, 20]。据信,Ge 掺杂可形成更光滑的表面,缺陷更少 [21, 22]。此外,由于较低的晶格畸变和薄膜应力,这种掺杂也显示出在更强调热稳定性的高温电子设备中的前景。尽管已经在理论上研究了掺 Ge GaN,但有必要研究对相关器件的实际影响。在本文中,提出了在 Ge 掺杂的自支撑 (FS) GaN 衬底上制造的新型垂直 GaN SBD。垂直 GaN SBD 表现出优异的晶体质量和电子特性。同时,系统地研究了垂直 SBD 的恢复性能。反向恢复时间和反向恢复电荷最终与电极面积呈显着正相关。
方法与实验
制造的 SBD 的器件结构示意图如图 1a 所示,主要由 390-μm FS n + -GaN衬底和9-μm n - -GaN漂移层。在这项工作中,Ge浓度为1 × 10 18 的(0001)取向GaN衬底层 cm − 3 位错密度为1 × 10 6 cm − 2 由 HVPE 种植。并且该衬底上的未掺杂外延层通过金属有机化学气相沉积生长,生长速率为~ 2 μm/h。对于 SBD 制造,在 GaN 衬底的背面形成 Ti/Al/Ni/Au 欧姆接触。 Ni/Au 肖特基电极形成在外延层的前表面,具有五种不同的直径(100、200、300、400 和 500 μm),如图 1b 所示。更多关于制造过程的信息可以在我们之前的报告中找到[23, 24]。
<图片>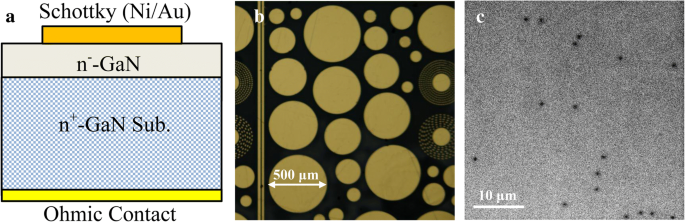
一 制造的垂直 SBD 的横截面示意图。 b 不同电极的光学显微镜图像。 c 外延层全色CL图像
使用 Quanta 400 FEG 扫描电子显微镜 (SEM) 获得阴极发光 (CL) 图像,加速电压为 10 kV,以研究外延层位错密度的空间分布。电容-电压 (C-V ) 和电流-电压 (I-V ) 使用 Keithley 4200 半导体参数分析仪进行测量,以评估 SBD 的电子特性。并使用定制的实验装置在 300 到 500 K 的范围内进行温度相关测量。
结果与讨论
外延层的 CL 结果如图 1c 所示。由于位错被认为是一个非辐射复合中心,它以暗点的形式出现在 CL 图像上。由于没有观察到明显的空间分布差异,位错密度的平均值计算为~ 1.3 × 10 6 cm − 2 ,在几个不同区域进行 CL 测量。该结果表明垂直SBD获得了高质量的外延层。
由于垂直 SBD 以并联模式为特征,C-V 和 G-V 曲线是在 1 MHz 频率下获得的。 SBD 的结果分别显示在图 2a 和 b 中,其中 (1/C 2 ) 与外加电压 V 绘制在插图中。这里,载流子浓度N d 可以用表达式计算:\( {N}_d=\frac{-2}{A^2 q\varepsilon \left[d\left(1/{C}^2\right)/ dV\right]} \),其中 A 是肖特基电极的面积,q 是电子电荷 (1.602 × 10 − 19 C) 和 ε 是 GaN 的介电常数 (8.854 × 10 − 11 调频)。因此,N d 外延层的厚度确定为~ 6.2 × 10 15 cm − 3 .和相位角θ 也可以通过以下等式计算:\( \theta ={\tan}^{-1}\left(\frac{2\pi fC}{G}\right) \),其中 f 是应用频率,C 是电容,G 是测得的电导(栅极泄漏)。由于不同直径的结果相似,计算出的角度θ 与外加电压 V 作为示例,图 2b 的插图中显示了 300 微米直径的 SBD。注意θ 非常接近 90°,这证实了在本研究中实现了具有低泄漏路径的出色肖特基栅极。 J-V 特性也显示在图 2c 中。很明显,I 在/我 关闭比率为 3.8 × 10 9 , 5.9 × 10 8 , 1.3 × 10 10 , 6.5 × 10 8 , 和 9.9 × 10 7 分别为 100-、200-、300-、400- 和 500-μm 直径的 SBD,其中 I 在和我 off 分别定义为栅极电压为 1.6 和 − 2 V 时的电流。线性拟合后,导通电压V 随着电极直径从 100 增加到 500 μm,垂直 SBD 的 on 分别确定为 0.70、0.76、0.72、0.70 和 0.78 V。这些结果表明垂直SBDs获得了良好的电子特性。
<图片>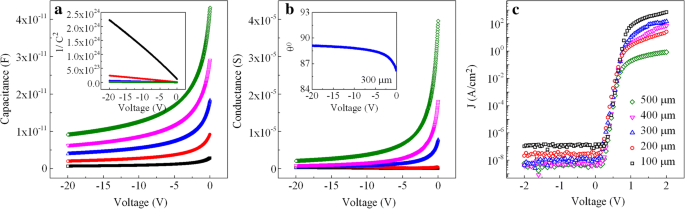
一 室温 C-V 频率为 1 MHz 时,每个不同电极的垂直 SBD 曲线。插图是 (1/C 2 ) 与电压 V . b G-V 每个不同电极的垂直 SBD 曲线。插图是相位角 θ 的图 对电压 V 对于 300 微米直径的 SBD。 c J-V 每个不同电极的垂直SBD曲线
典型的测试电路用于测量垂直 SBD 的反向恢复特性,如图 3a 所示。周期性方波电压信号(从 + 20 到 - 20 V)依次施加到被测器件 (DUT),其中寄生电感器将存储磁能并影响电流。当电压信号发生变化时,在此期间可能会产生振荡电流。配备泰克 MDO 4104-3 示波器的高速电流探头用于检测垂直 SBD 中的瞬态电流变化。由于反向恢复电流的波形示意图如图 3b 所示,在本研究中,t 一 定义为 t 时的存储时间 b 定义为反向电流延迟时间。和反向恢复时间T rr 定义为反向电流恢复到最大反向恢复电流10%的时间I RM ,这是 t 的总和 一 和 t b .和反向恢复电荷Q rr 通过对反向电流积分直到 T rr 对应于二极管中的累积电荷。
<图片>
一 用于测量垂直 SBD 反向恢复特性的测试电路。 b 垂直SBD反向恢复特性波形示意图
图 4 显示了当施加的电压从 + 20 切换到 - 20 V 时,每个电极直径的垂直 SBD 的反向恢复曲线。这里,对于 100-、200-、300-、400- 和 500-μm 直径的 SBD ,T rr 获得的值为 15.8、16.2、18.1、21.22 和 24.5 ns,而 Q rr 积分值分别为 0.0127、0.0536、0.150、0.280 和 0.405 nC。这些垂直器件都表现出快速的开关时间(小于 25 ns)。结果中还观察到相当低的反向电流,这可能是由于 SBD 中存储的电荷量较小 [13]。同时,也清楚地看出T的值 rr 和 Q rr 均随着电极直径的增大而增大,最小的T最快 rr 15.8 ns。
<图片>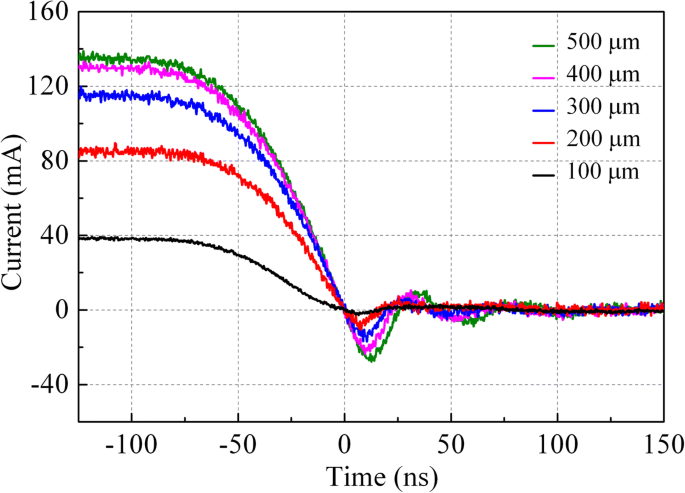
不同电极垂直SBD的反向恢复电流
为了进一步研究这些变化背后的机制,当电压从 + 10 切换到 - 10 V 时,还测量了垂直 SBD。作为反向恢复时间 T rr 与二极管直径 d 绘制在图 5 中,T 的值 rr 每个二极管都没有明显改变。反向恢复电荷Q rr 与 d 对比 同时显示在图 6 中,其中两条曲线的数据指向相同的趋势。同时,值得注意的是 Q rr 两个测试的结果都显示出与 d 的显着正相关 2 ,即电极面积。
<图片>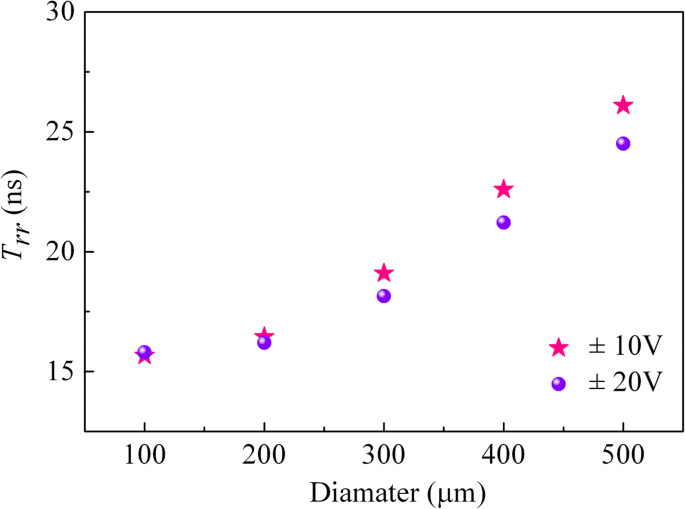
反向恢复时间T rr 与电极直径 d
<图片>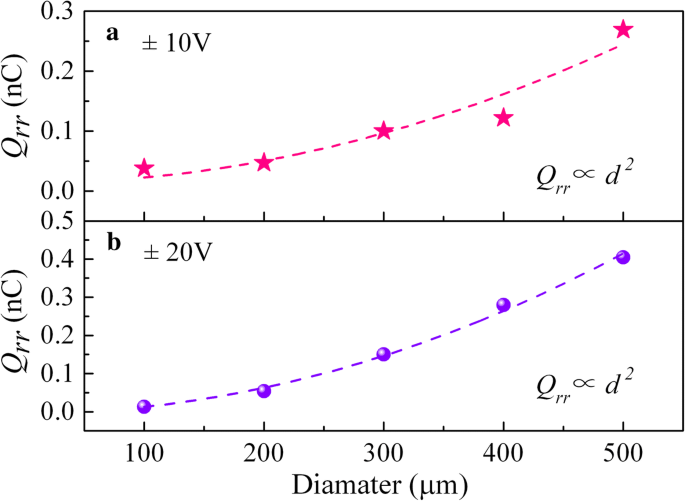
反向恢复电荷Q rr 与电极直径 d
事实上,据报道,反向恢复效应应该主要来自SBD的寄生电感和界面陷阱[25, 26]。考虑到寄生电感的贡献表现为振荡电流的形式,这在这些反向恢复曲线中并不明显,因此,反向恢复时间和反向恢复电荷的变化应该是由陷阱引起的[27, 28]。由于垂直 SBD 中陷阱的浓度是均匀的,Q rr 将取决于器件的接触面积,最终随着电极面积的增加而增加,如图 6 所示。因此,陷阱在界面中充当电场阻止器。在 t 期间 一 期间,延迟受到肖特基结中载流子俘获的强烈影响,而在 t b 期间,反向恢复速度也因将存储的电荷扫出结的时间而减慢。这些结果与我们之前的报告 [29] 一致,该报告表明 RC 时间常数随着器件直径的增加而增加,并且与反向恢复时间具有良好的相关性。这些器件中更小的电极或更薄的漂移层有望进一步提高反向恢复特性。
此外,进一步研究了在更高温度下垂直 SBD 的恢复性能。图 7 显示了分别在 300、400 和 500 K 下测量的 500 μm 直径 GaN SBD 的反向恢复电流。反向恢复时间和反向恢复电荷均未观察到随温度升高而变化。这些结果与上述分析一致,因为捕集阱的浓度对温度不是很敏感。相反,据报道,随着温度从 300 升高到 425 K,Si 基 SBD 的反向恢复时间将增加 191% [17]。在这里,由于载流子寿命短和带隙更宽,GaN SBD 显示出在电流处理能力、反向恢复和能量损失方面提供了实质性的改进。由于GaN基SBD的热稳定性优于传统的窄带隙半导体[30],因此可以得出结论,GaN也是应用于高温环境的开关器件的合适材料。
<图片>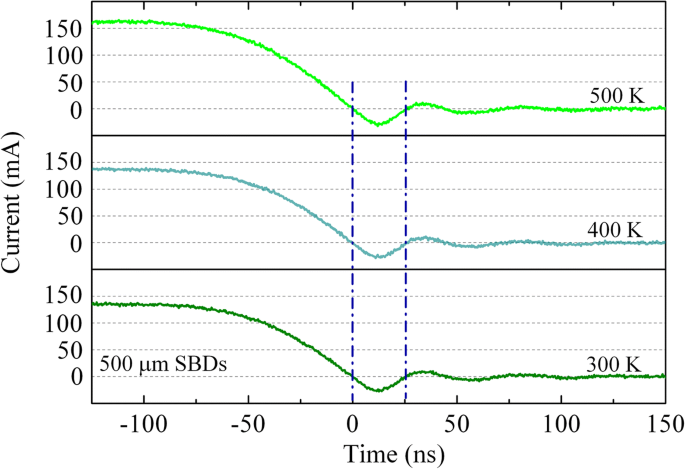
分别在 300、400 和 500 K 下测量的 500 μm 直径 SBD 的反向恢复特性
结论
总之,我们在 HVPE 生长的掺 Ge FS GaN 衬底上制造了垂直 GaN SBD。通过进行材料表征和电流电压测量,表明垂直 SBD 获得了优异的晶体质量和电子特性。系统地研究了反向恢复特性。对于直径为 100、200、300、400 和 500μm 的二极管,反向恢复时间分别为 15.8、16.2、18.1、21.22 和 24.5 ns。同时,反向恢复时间和反向恢复电荷均与电极面积呈显着正相关。我们的研究结果可为进一步提高GaN基SBDs的恢复性能提供参考。
缩写
- CL:
-
阴极发光
- C-V :
-
电容-电压
- DUT:
-
被测设备
- FS:
-
独立式
- 氮化镓:
-
氮化镓
- HVPE:
-
氢化物气相外延
- I-V :
-
电流-电压
- SBD:
-
肖特基势垒二极管
- SEM:
-
扫描电子显微镜
纳米材料


