在 III 族氮化物纳米棒/Si (111) 异质结太阳能电池中,光捕获引起的高短路电流密度
摘要
对于外延生长的 p-GaN/i-InGaN/n-GaN 二极管阵列,不包括栅极金属接触区域和在 1 太阳、AM 1.5G 条件下的功率转换有效面积光伏效率为 1.27%。 (111)-硅。短路电流密度为14.96 mA/cm 2 并且开路电压为 0.28 V。通过在无应变和无缺陷的 III 族氮化物纳米棒阵列结构内的多次反射获得增强的光捕获,以及由宽带隙 III 族氮化物成分增强的短波长响应被认为有助于观察到设备性能的增强。
介绍
随着能源危机的加剧,绿色能源的发展变得越来越重要,发光二极管(LED)和太阳能电池产业发展迅速。在过去的几十年中,III 族氮化物半导体已成功应用于 LED 器件 [1,2,3],带来了可观的商业利益。目前,许多科学家寻求利用 III 族氮化物在光伏应用方面的研究潜力 [4, 5]。 III-V族氮化物材料对于光伏系统具有许多优点,例如具有大吸收系数的直接带隙[4, 6],通过能带工程覆盖大部分太阳光谱的宽带隙范围[4, 6, 7],高载流子迁移率 [7] 和优异的耐辐射性 [8]。基于这些卓越的特性,模拟了几种器件结构设计,例如 InGaN/Si 串联电池 [9,10,11,12,13,14]、热载流子太阳能电池 [15]、肖特基太阳能电池 [16, 17,18]、单 [19,20,21,22,23,24] 和多 [25, 26] 结太阳能电池,以及极化对太阳能电池性能的影响 [9, 23, 27]。根据不同的模拟模型,模拟预测 InGaN/Si 异质结构串联电池的效率可高达 21-36% [10, 11, 13]。具有四种不同 In 成分的 InGaN 同质结构串联太阳能电池的功率转换效率 (PCE) 在 1 太阳辐照度下为 51%,在 250 太阳聚光条件下为 58% [26]。然而,在低温 InGaN 薄膜生长条件下,杂质和非辐射复合问题变得越来越重要 [28,29,30]。由于晶格失配导致的显着堆垛层错和位错密度导致载流子扩散长度的减少和太阳能电池 PCE 的限制 [31,32,33,34]。因此,实现高效III族氮化物光伏器件的潜在能力仍存在诸多挑战。
在过去的十年中,许多相关的研究课题,如独立式 GaN 衬底上的高 In InGaN 晶体生长方法 [34]、p 型 InGaN 掺杂 [35]、量子阱设计 [36,37,38,39,40]、电极设计 [41,42,43,44]、聚光器光伏 [37、41、45]、中带太阳能电池 [46] 和减少反射的结构 [47,48,49] 已被研究。此外,研究了非极性氮化物基太阳能电池的极化效应 [50, 51]。达哈尔等人。证明了在更长的波长(> 420 nm)下运行高于 30%-In InGaN 多量子阱太阳能电池 [38],并说明在高达 30 太阳光的光照强度下效率为 3.03% [37]。森等人。研究了基于聚光器的氮化物太阳能电池 [45] 并解决了 4% 的最高 PCE,在高达 300 太阳的高光强度下运行 [41]。尽管几个研究小组提供了不同的结构或光学设计并改进了生长技术,但 III 族氮化物太阳能电池的 PCE 并没有取得太大进展。另一方面,Reichertz 等人。通过在 p-n 结 Si 衬底上外延生长 p-n 结 GaN,证明串联太阳能电池是可行的 [14]。他们的结果表明,Si 衬底有助于长波长效率,而氮化物有助于短波长效率。硅衬底不仅提供了低成本的解决方案,而且还提供了 PCE 增强和良好的导热性 [52]。
通常,对于太阳能电池的生长,连续的薄膜层会在彼此的顶部生长,这会导致高位错密度。然而,当 III 族氮化物在纳米结构中生长时,与衬底接触的底部区域很小,因此减少了穿透位错并且应变也可以最小化。特萨雷克等人。据报道,随着直径减小到 200 nm,GaN 纳米棒的位错消失了 [53]。因此,作为硅衬底上薄膜生长的替代方案,生长III族氮化物纳米棒太阳能电池将是降低成本、提高晶体质量和提高电池效率的首选。此外,纳米棒/纳米线在光伏应用方面具有很大的容量,因为光生电子可以在它们与空穴复合之前更有效地被收集起来,因为它们可以直接通向电极,并且纳米棒结构可以改善光捕获以增强光子吸收 [54, 55]。几个小组已经展示了基于 III 族氮化物纳米棒 [55] 的光电探测器 [56, 57]、纳米激光器 [58, 59]、纳米 LED [60, 61] 和光电化学水分解应用 [62]。尽管如此,纳米棒太阳能电池的缺点是由于表面缺陷,光生电子-空穴对在丰富的载流子俘获中心复合。此外,纳米棒太阳能电池的器件制造工艺比薄膜器件更复杂。然而,如 Wallentin 等人所示,克服上述这些问题导致 PCE 增加了近三倍。其中 InP 纳米棒阵列的 PCE 为 13.8%,来自纳米棒直径和顶部 n 段长度的优化 [54, 63]。克罗格斯特鲁普等人。表明由于光集中增强了一个以上数量级的光吸收,在单核 - 壳 GaAs 纳米线结构中获得了高短路电流密度(Jsc)[64]。维勒等人。 [65],Cansizoglu 等。 [66] 和 Nguyen 等人。 [31] 在 GaN 模板和 Si 衬底上展示了不同类型的氮化物纳米棒阵列太阳能电池。最近的纳米棒/纳米线光伏研究的比较列在补充信息中:表 S1。然而,目前尚未系统地讨论不同In含量InGaN纳米棒集成光伏器件在低成本Si(111)衬底上的光电转换贡献。
在这项研究中,通过等离子体辅助分子束外延(PA-MBE,Veeco EPI930)。通过高分辨率 X 射线衍射(HR-XRD,Bede D1)测量来估计结构特性和铟含量。通过高分辨率透射电子显微镜(HR-TEM,FEI E.O Tecnai F20 G2)分析纳米棒的精细结构。氮化物太阳能电池的电流密度与电压 (J-V) 特性在 1 太阳、AM 1.5G 照明 (Newport 94023A) 下进行了讨论。测量外部量子效率(EQE,Enli Technology Co., Ltd.,QE-R3018)以研究光谱响应。还研究了能带图对齐和模拟以解释电子和空穴传输。
实验方法
生长技巧
Si:GaN 和 Mg:GaN/InGaN/Si:GaN 纳米棒的生长基于等离子体辅助分子束外延 (PA-MBE) 技术。所有样品均通过配备 6N 氮等离子体源 (Veeco, UNI-Bulb) 的 Veeco GEN930 PA-MBE 系统生长。将电阻率为 0.001-0.005 Ω cm 的 n 型 Si(111)衬底在超声波浴中用丙酮、异丙醇和去离子水清洗 5 分钟,以去除残留的有机污染物,然后在48–51% HF:H2O =1:5 溶液 5 分钟以去除天然氧化物。在化学清洗/蚀刻过程之后,用氮气吹干硅衬底。 Si衬底被引入缓冲室,然后通过磁耦合转移臂转移到生长室。在纳米棒生长之前,衬底在 900 °C 下热清洗 30 分钟以去除残留的天然氧化物,以获得干净且有序的 7×7 重构硅表面。活化的氮原子由等离子枪产生,其通量和纯度通过高分辨率质量流量控制器(HORIBA STEC,SEC-7320 M)和氮净化器(Entegris,CE35KFI4R)控制。高纯度(6N 或更高)Ga、In、Si 和 Mg 源由固体源渗出池提供。 III 族金属和 N2 等离子束等效压力 (BEP) 用束流计测量。通过将 III/V 通量比控制为富氮条件,可以获得纳米棒。首先,自组装的 Si:GaN 纳米棒在 760 °C 下生长 82 分钟。 InN 的解吸在升高的温度下至关重要,因为铟会从样品表面蒸发。为了将铟保留在纳米棒中,使用了金属调制外延 (MME) 技术 [67, 68]。 MME 涉及定期打开和关闭金属百叶窗以调节金属通量,而 N2 百叶窗保持打开状态。为了调整 In 浓度,In 和 Ga 原子的两个不同循环时间交替撞击衬底 20 s/30 s(样品 B)和 30 s/30 s(样品 C),在 550 °C 下有 50 个周期。最后,Mg:GaN 层在 600 °C 下生长。样品在 9.25 × 10 -6 torr 活性氮 BEP 等离子体功率 450 W, 2.42 × 10 −8 torr 在 BEP 和 1.93 × 10 −8 torr Ga BEP。此外,在相同条件下还制备了单层Si:GaN纳米棒(样品A)作为对照组。
设备制造
在纳米棒生长之后,器件制造过程包括以下步骤。 (1) 器件面积350×350 μm 2 基于反应离子蚀刻技术(Advanced System Technology,Cirie-200),使用光刻胶(Microchemicals GmbH,AZ1400)作为掩模,通过使用四氟甲烷(CF4)蚀刻到n型Si来定义台面。 (2) 使用带有去离子水的超声波浴清除装置上除台面区域外的松散纳米棒。 (3) 在 60 °C 下将样品浸入 (NH4)2S 中 1 分钟,以钝化氮化物表面,以抑制天然氧化物和非辐射复合还原 [69,70,71,72,73]。 (4) 通过溅射 (Advanced System Technology, Psur-100HB) 伴随光刻 (M&R Nano Technology , AG350-6B) 和剥离技术。 (5) 通过电子束蒸发(Advanced System Technology)在ITO薄膜和n型Si衬底上制备多层Ti/Al/Ti/Au(20 nm/300 nm/20 nm/50 nm)栅极金属触点, Peva-600E) 使用光刻和剥离技术。 (6) 所有栅极金属触点均通过快速热退火系统(Advanced System Technology, FA04)在氮气中在 800 °C 下退火 30 s 以获得欧姆触点。
TEM 样品制备
为了进一步研究晶体结构,样品 B 和 C 的单个纳米棒在乙醇中通过超声处理提取。超声处理 30 分钟后,将几滴乙醇溶液滴加到铜网 (Ted Pella) 上,并在室温下蒸发乙醇。测量前,样品在150 °C下烘烤以去除游离有机溶剂。
结果与讨论
形态和结构特性
扫描电子显微镜(SEM)图像的俯视图和横截面图如图 1a-f 所示,说明了生长的纳米棒的形态。从左到右,图 1a-c 表示 Si:GaN(样品 A)和 Mg:GaN/InGaN/Si:GaN 的表面形貌的变化,In/Ga 原子撞击周期为 20 s/30 s(样品 B)和 30 s/30 s(样品 C)在 50 个周期的 InGaN 生长过程中。 Si:GaN 和 Mg:GaN/InGaN/Si:GaN 纳米棒的直径分别为 30–100 nm 和 80–150 nm,而面密度约为 7 × 10 9 cm −2 .纳米棒的横截面图像如图 1d-f 所示,表明样品 A 到 C 的纳米棒长度约为 700 nm。显示了 Mg:GaN/InGaN/Si:GaN 样品的示意性结构图1g。
<图片>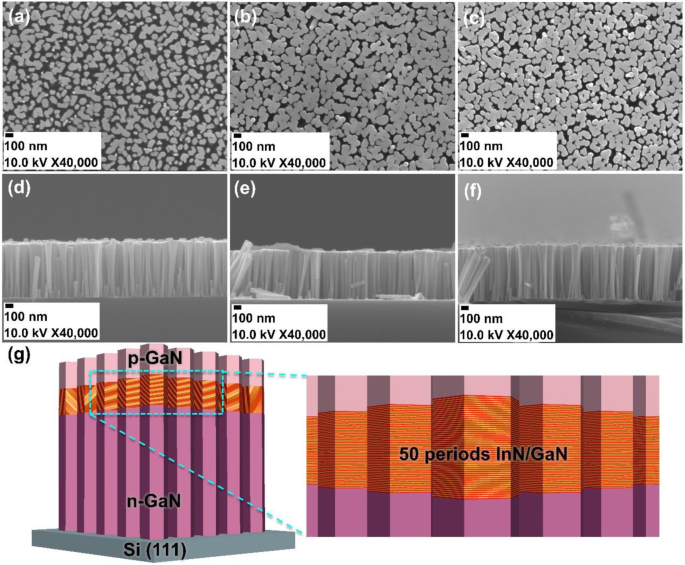
a 的 SEM 俯视图 n-GaN(样品 A),p-GaN/InGaN/n-GaN,In 和 Ga 原子撞击循环时间 b 20 s/30 s(样本B)和c 30 s/30 s(样本 C)。 d 的 SEM 截面图 样本 A,e 样本 B 和 f 示例 C。g p-GaN/InGaN/n-GaN纳米棒结构示意图
图 2a 记录了 X 射线 theta-2theta 衍射测量,聚焦于不同的源撞击周期时间样本。位于 28.44° 的最强峰来自 Si 衬底。 34.56° 处的清晰峰值对应于 GaN (0002) 衍射,表明对来自 InGaN 层的相混合的良好抑制。在样品 B 的 34.22° 和样品 C 的 34.13° 的 GaN (0002) 峰的下 2θ 侧的峰是 InGaN (0002)。 c InN 和 GaN 的晶格常数分别为 5.760 Å 和 5.185 Å [74]。根据布拉格定律,c InGaN (0002) 的晶格常数计算为样品 B 的 5.23 Å 和样品 C 的 5.25 Å。导入 c InGaN (0002) 的晶格常数符合 Vegard 定律,在不考虑应变的情况下,样品 B 的 In 浓度可以估计为 8%,样品 C 为 11%。图2b为样品C的低倍TEM像及其结构示意图。区域1和区域2分别是n-GaN和InGaN区域。在区域 1 处获得的选择性区域电子衍射 (SAED) 图案表明 [0001] 方向平行于纳米棒的长轴和氮化物纳米棒的共同生长方向。此外,在晶体中没有发现位错。在图 2 c 和 d 中,原子分辨率的 TEM 图像产生了 c GaN 和 InGaN 的晶格常数分别为 5.19 Å 和 5.25 Å,与布拉格定律通过 XRD theta-2theta 扫描计算的结果相同。此外,c 通过补充信息中显示的原子分辨率 TEM 图像,样品 B 的 InGaN 的晶格常数为 5.23 Å:图 S1。此外,高角度环形暗场 (HAADF) 图像和能量色散 X 射线光谱 (EDS) 线扫描,表明铟分布,包含在补充信息中:图 S2。
<图片>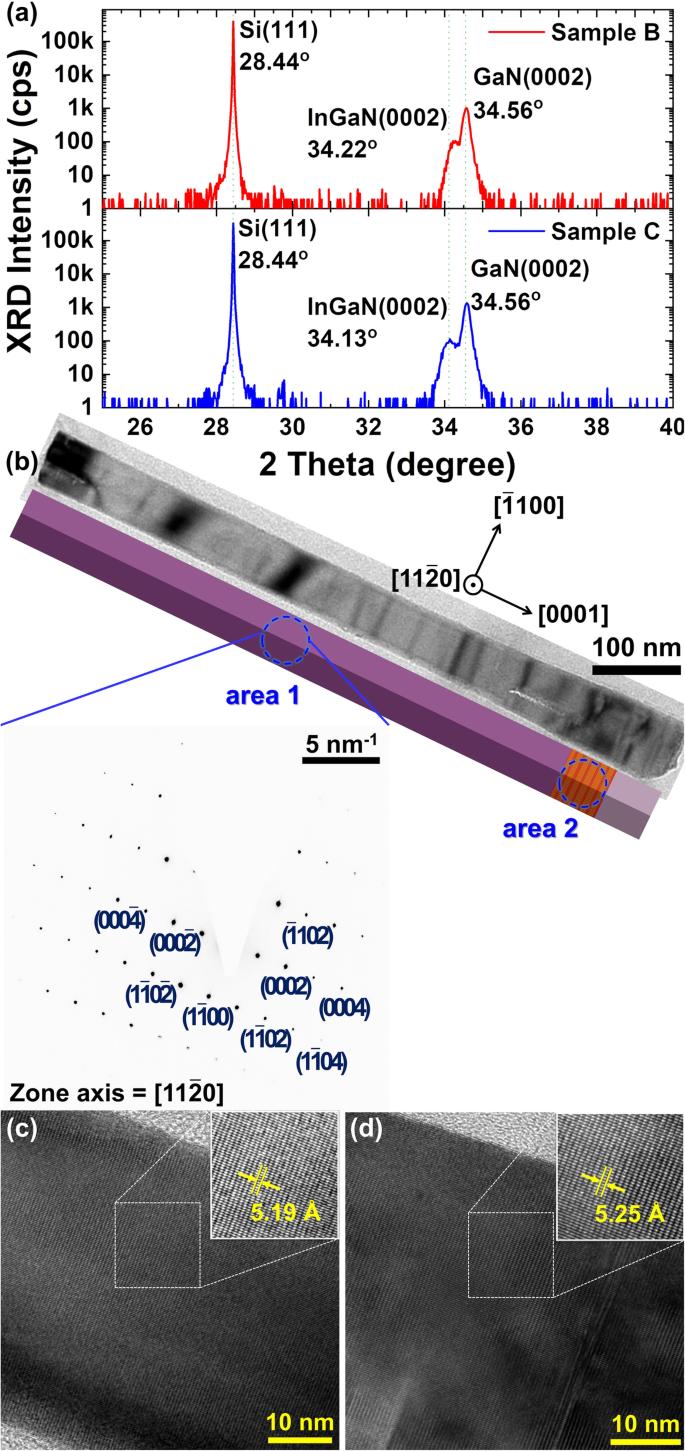
一 theta-2theta 扫描的 HR-XRD 光谱。根据 Vegard 定律,InGaN 材料的铟含量估计为样品 B(红色曲线)的 8% 和样品 C(蓝色曲线)的 11%。 b n-GaN 区域的无位错氮化物纳米棒 TEM 图像和 SAED 图案。图像下方的单个纳米棒示意图服从结构相对比例。 c的原子分辨率TEM图像 区域 1 和 d 中的 n-GaN 区域 2 中的 InGaN 显示无位错及其 c 晶格常数
电光特性分析
电流密度与电压的测量由 Keithley 2400 源表执行。图3a为纳米棒组装太阳能电池示意图。器件总面积为 0.12 mm 2 光照下不包括接触金属的有效面积为0.0924 mm 2 .为了收集光子产生的电子,在 p-GaN 顶部沉积 100 nm 透明导电 ITO 薄膜以连接纳米棒和 Ti/Al/Ti/Au (20 nm/300 nm/20 nm/50 nm ) 手指电极。该器件的光电特性分析也在 1 个太阳、AM 1.5G 条件下用太阳模拟器进行,如图 3b-d 所示。串联电阻R 从图 3b-d 确定的 s 值为 83 Ω、250 Ω 和 2.5 kΩ 以及分流电阻 R 样品 A、B 和 C 的 sh 值分别为 413 kΩ、550 kΩ 和 2 MΩ。 In0.08Ga0.92N器件(样品B)和In0.11Ga0.89N器件(样品C)在零电压下的光电流密度Jsc为7.77 mA/cm 2 和 14.96 mA/cm 2 分别。通过 Jsc 比较证明了随着 In 浓度增加的光电流增强。此外,Krogstrup 等人。说明纳米棒太阳能电池的聚光特性可以增强光吸收并提供高光电流[64]。样品 C 的开路电压 (Voc) 和填充因子 (FF) 分别为 0.28 V 和 30%。几个小组还展示了具有较低 Voc 的纳米棒结构 [72, 75, 76]。为了阐明实际照明区域中的真实光伏性能,有效面积 PCE,PCEeff,基于不包括栅极面积的有效面积建立了效率,而总面积 PCE,PCEtot,则考虑了整个器件面积。值得注意的是,PCEtot 和 PCEeff 值分别为 0.98% 和 1.27%,这表明氮化物纳米棒太阳能电池的 PCE 更高。主要贡献来自高 Jsc,尽管 Voc 低于其他 III 族氮化物纳米棒太阳能电池 [65, 77]。低 Voc 有两个可能的原因,包括准费米能级限制在 p-n Si 结处,即基于能带图 Si 带隙为 1.12 eV,并且可能由于表面费米能级钉扎而产生受限电流路径 [66]。表1总结了三个样品的Jsc、Voc、FF和PCE比较。
<图片>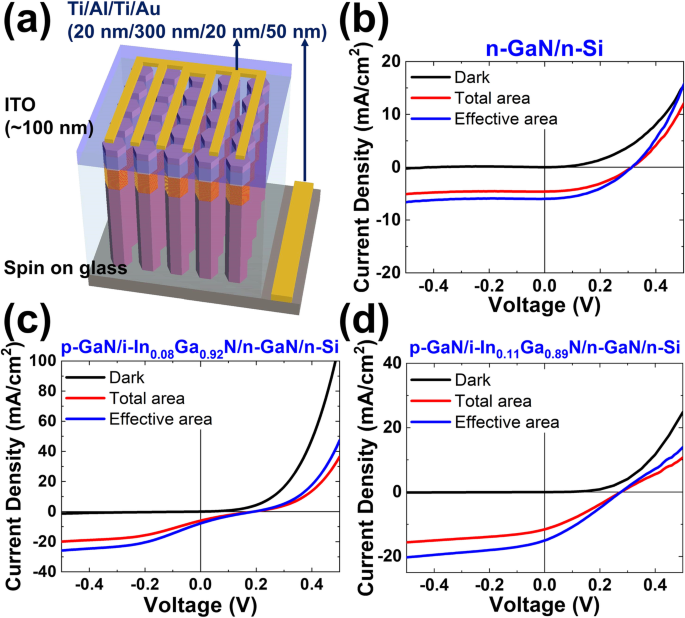
一 纳米棒组装太阳能电池示意图。 b的电流密度-电压曲线 n-GaN/n-Si, c p-GaN/In0.08Ga0.92N/n-GaN/n-Si 和 d p-GaN/In0.11Ga0.89N/n-GaN/n-Si纳米棒组装太阳能电池在1个太阳下测量,AM 1.5G太阳模拟器
为了了解物理和电气特性,能带图是通过使用 1D-DDCC(一维泊松、漂移-扩散和薛定谔求解器)程序计算的 [78]。所使用的 ITO、Si 和 GaN 的电子亲和性分别为 4.40 eV、4.05 eV 和 4.1 eV。图4a和b分别显示了无偏压的ITO/n-GaN/n-Si能带图和黑暗下的J-V曲线。它说明 ITO/n-GaN/n-Si 结构没有整流效应,并显示出线性 J-V 分布。异质界面的势垒可以忽略载流子传输,因为 Si 和 GaN 之间的导带偏移预计为 50 meV 的小值。这种类似电阻的线性J-V曲线与实验结果相矛盾。
<图片>
一 ITO/n-GaN/n-Si能带图,b ITO/n-GaN/n-Si J-V 曲线,c ITO/n-GaN/p-Si/n-Si能带图和d 一维-DDCC程序模拟ITO/n-GaN/p-Si/n-Si的J-V曲线
J-V 曲线结果的一个可能解释是 Ga 扩散在 GaN/Si 界面处引起 p-Si 并产生 p-n 结。 Reichertz 等人。 [14] 和 Neplokh 等人。 [76] 已经验证了在氮化物层的生长过程中铝扩散到硅衬底中。硼、铝和镓是 IIIB 族元素,可以作为 p-Si 层形成的掺杂剂。然而,Ga 扩散速率在 700 °C 时为 8 nm/天 [79]。图 4c 显示了一个能带图,其中包括在 n-GaN 和 n-Si 界面之间的非常薄 (1 nm) 的 p-Si 层。在 p-n Si 结中产生一个小的内置电场,可以将电子驱动到 n-Si 衬底并将空穴驱动到 ITO 接触层。厚度相关的 J-V 曲线表明,当图 4d 中 p-Si 层的厚度变薄时,二极管导通电压降低。超薄 p-Si 将限制准费米能级分离并降低太阳能性能的 Voc。包含 p-Si 层的模拟电性能更接近于该研究结果。因此,可以将 Mg:GaN/InGaN/Si:GaN/p-Si/n-Si 结构的能带图构建为图 5 中的模型。从顶部照射 AM 1.5G 光导致吸收能量高于 InGaN 带隙的光子。当光通过棒和棒之间的空间照射到Si上时,能量大于Si带隙的光子也可以被p-n Si衬底吸收并产生光电流。同时,短波长光在氮化物区产生的电子-空穴对被p-i-n结内建电场分离。最后,可以通过顶部的氧化铟锡 (ITO) 触点与 Mg:GaN 和底部的 Si n 触点收集光生载流子。基于该结构模型并考虑ITO接触引入的肖特基势垒,J-V曲线仿真如图5b所示。模拟的 J-V 曲线表明 S 形是由 p 接触的非欧姆行为引起的。这是解释图 3c 和 d 中 Mg:GaN/u-InGaN/Si:GaN(样品 B 和 C)存在 S 形的可能原因。因此,表 S2 中记录了 S 形变平的负偏压(J负偏压(- 0.5 V))下的电流密度。 J负偏差可以作为进一步优化的检查点和目标值。
<图片>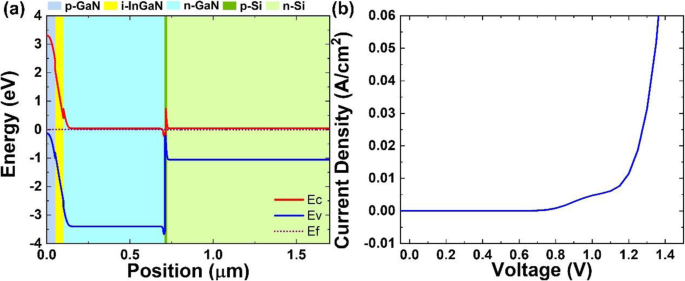
一 1D-DDCC程序模拟的p-n Si太阳能电池能带图上的p-i-n氮化物纳米棒。 b p-n Si太阳能电池上p-i-n氮化物纳米棒的J-V曲线模拟
没有光偏置(额外的未调制光)的 EQE 测量结果如图 6a 所示,它比较了 Si:GaN/n:Si(样品 A)、Mg:GaN/u-In0.08Ga0.92N/Si 的 EQE: GaN(样品 B)和 Mg:GaN/u-In0.11Ga0.89N/Si:GaN(样品 C)。样品 C 具有较高的 In 浓度,这可能是由于 InGaN 层中的吸收而导致短波长处较高值的原因。样品 A、B 和 C 中的最大 EQE 分别为 32%、55% 和 63%。与图 6b 所示的 Si 晶片、样品 A、B 和 C 的反射光谱相比,EQE 和反射光谱的振荡是由于来自不同层的干扰。由于其平坦的表面,裸硅晶片具有最高的反射率。样品 A、B 和 C 具有较低的反射率,因为纳米棒结构具有光捕获效应。发现样品 C 在长波长处具有最高的 EQE,并且由于最高的光捕获效应而具有最低的反射率。该结果可以解释样品 C 中产生的较高光电流。样品 B 和样品 C 的室温(RT,300 K)光致发光(PL)光谱如图 6c 所示。位于 3.40 eV 的最高峰是 GaN 近带边 (NBE) 发射。位于 3.09 eV 和 3.03 eV 的峰值是由于 In0.08Ga0.92N 和 In0.11Ga0.89N NBE 发射。结果类似于弓形方程计算得出的值,在 RT [4] 下 3.1 eV 和 3.0 eV。它还显示出与 EQE 和反射光谱相同的强法布里-珀罗振荡(以星号标记),代表每层/表面之间的光滑界面。
<图片>
一 三个氮化物纳米棒/Si 样品的外量子效率谱。 b 裸硅晶片和三个氮化物纳米棒/硅样品的反射光谱。 c 两种InGaN样品的室温光致发光光谱
结论
成功展示了通过等离子体辅助分子束外延在 n-Si 上生长的高质量 Mg:GaN/InGaN/Si:GaN 和 Si:GaN 纳米棒。光伏测量显示 1.27% 的 PCEeff 和 0.98% 的 PCEtot 在 1 个太阳、AM 1.5G 照明下,Mg:GaN/u-In0.11Ga0.89N/Si:GaN 具有更高的 In 浓度和更高的光捕获效果诱导高光电流。尽管 n-Si 器件上的 Si:GaN 纳米棒可能没有明显的 p-n 结内置场,但适当的异质结结构设计有助于将光载流子驱动到顶部和底部触点并提高电池性能。
数据和材料的可用性
作者声明所有材料和数据可供读者使用,本文中的所有结论均基于本文提供和展示的数据。
缩写
- LED:
-
发光二极管
- PCE:
-
电源转换效率
- Jsc:
-
短路电流密度
- PA-MBE:
-
等离子体辅助分子束外延
- HR-XRD:
-
高分辨率X射线衍射
- HR-TEM:
-
高分辨透射电子显微镜
- EQE:
-
外量子效率
- BEP:
-
梁等效压力
- MME:
-
金属调制外延
- ITO:
-
氧化铟锡
- Voc:
-
开路电压
- RT:
-
室温
- PL:
-
光致发光
- NBE:
-
近带边缘
纳米材料


