通过角分辨 X 射线光电子能谱研究 Al2O3 封端的 GaN/AlGaN/GaN 异质结构的表面极化
摘要
通过角分辨 X 射线光电子能谱 (ARXPS) 研究 Ga 面氮化镓 (GaN) (2 nm)/AlGaN (22 nm)/GaN 通道 (150 nm)/缓冲层/Si 与 Al2O3 覆盖层的表面极化)。发现界面区域的能带从向上弯曲变为向下弯曲,这被认为与极化变化相对应。由于在通过原子层沉积 (ALD) 沉积 Al2O3 期间发生 Ga-N 键断裂和 Ga-O 键形成,在顶部 GaN 和 Al2O3 之间形成界面层。该界面层被认为消除了 GaN 极化,从而减少了极化引起的负电荷。此外,该界面层对于引入导致能带向下的正电荷起着关键作用。最后,观察到在 400°C 下进行 N2 退火可增强界面层的生长,从而增加正电荷的密度。
背景
氮化镓 (GaN) 被认为是从 LED 行业到电力电子行业的许多领域中最具吸引力的半导体材料之一 [1, 2]。其受欢迎的原因在于硅具有许多优点:高击穿电场、高电子迁移率和出色的热稳定性 [3, 4]。 GaN 高电子迁移率晶体管 (HEMT) 被广泛研究用于高功率和高频应用 [1, 5, 6]。在 HEMT 中,如果采用肖特基栅极,该栅极界面会带来大的界面态,从而加剧了大漏电流和低击穿场 [7]。作为表面钝化层和栅极电介质的绝缘体可以帮助缓解上述问题[8,9,10]。
与 Ga2O3 相比,Al2O3 具有大的带隙、高介电常数和更多的负吉布斯自由能,因此更适合这种绝缘体应用,因此认为 Al2O3 可以钝化表面状态并改善击穿场 [5]。然而,在沉积 Al2O3 之后,在 GaN/Al2O3 界面上不可避免地会形成界面层 [11, 12]。该界面层被认为与阈值电压的可靠性和二维电子气(2DEG)的性质有关,并在控制能带弯曲中起关键作用[2, 13,14,15,16]。
虽然界面层已经被多个研究小组研究过,但界面层所起的作用还没有被深入开发 [12, 17]。因此,在本文中,我们使用角分辨X射线光电子能谱(ARXPS)来检测能带弯曲的逐渐变化并获得界面层的原子结构[11]。通过原子层沉积 (ALD) 在 GaN 样品上沉积不同厚度的 Al2O3。 ALD 利用低温逐层沉积技术,限制了 GaN 和 Al2O3 之间的热反应。因此,ALD 因其高一致性和均匀性、厚度控制精度、高薄膜质量和低缺陷密度而受到工业界的青睐,用于沉积高 k 电介质 [4]。这可以实现平滑和低缺陷的 Al2O3/GaN 界面。在 Al2O3 沉积之后,还准备了 400 °C 的沉积后退火 (PDA) 样品,以加强界面层反应,促进界面层的形成。基于 ARXPS 结果,发现由于极化引起的负电荷,带最初从 GaN 衬底向上弯曲到近界面。然而,随着检测角θ的增加 ,由于正电荷的形成,带逐渐向下弯曲[5, 11,12,13]。
方法
Ga 面 GaN/AlGaN/GaN-on-Si(111) 晶片购自商业公司 (Enkris.com)。外延纤锌矿结构包括在 22-nm AlGaN 层顶部的 2-nm GaN 层,并且两个外延层生长在 150-nm i-GaN 层上。缓冲层用作连接 GaN 外延层和 Si 衬底的过渡层。制备三个样品,S1、S2 和 S3。所有样品首先在丙酮中减少 5 分钟,然后浸入异丙醇中并在流动的去离子 (DI) 水中冲洗。然后通过将其浸入稀 HCl 溶液 (HCl:H2O =1:10) 约 1 分钟来蚀刻掉天然氧化物,然后在去离子水中冲洗。 Al2O3 通过 ALD 沉积在 GaN 顶部,三甲基铝 (TMA) 和 H2O 分别作为金属前体和氧化剂。样品 S1 的 Al2O3 厚度为 1 nm,样品 S2 和 S3 的 Al2O3 厚度为 3 nm。厚度由椭偏仪测量。此外,S3 在 N2 中于 400 °C 下进行 PDA 处理 5 min。
ARXPS 测量在配备单色微聚焦 Al Kα (1486.6 eV) X 射线源和半球形电子能量分析仪的 Thermo Fisher Scientific Theta Probe 系统中进行。结合能 (BE) 校准是使用纯 Ni、Au、Ag 和 Cu 标准样品通过设置 Ni Fermi 边缘,Au 4f 进行的 7/2, Ag 3d 5/2 和 Cu 2p 3/2 峰值分别位于 0.00 ± 0.02、83.98 ± 0.02、368.26 ± 0.02 和 932.67 ± 0.02 eV。给定组分光谱的 FWHM 只允许在窄范围内变化 (± 0.1 eV)。使用最少数量的成分光谱来获得可接受的低残留值 [11]。在不同的检测角度(θ ),范围为 27.5° 到 72.5°,相对于样品法线平行,不倾斜样品。为了消除可能的正电荷引起的 BE 偏移,获得的 XPS 光谱参考了 C 1s 峰值为 285.0 eV。使用嵌入在 Avantage 软件中的相对灵敏度因子和算法进行定量分析,包括元素/键比的测定 [11]。
结果与讨论
Ga 3d S1-S3 在不同光电子检测角度的核心级光谱分别如图 1a-c 所示。对于 S1,每个 Ga 3d 光谱可以拟合两个峰,对应于 Ga-N 和 Ga-O 键。 Ga-O 键是由于 ALD 中暴露于氧化剂而形成的氧化物,并且氧化剂渗透到最初的薄 Al2O3 层中 [3]。对于 S2 和 S3,可以识别三个峰,记为 Ga-N、Ga-O 和 O 2s , 分别。 O 2s 峰归因于 Ga-O 和 Al-O 键,并且当检测角变大时变得明显。由于本文不关注该峰,因此不再进一步讨论。图 2 显示了 Ga-N 峰的 BE 作为 θ 的函数 对于 S1-S3。从 θ 获得 0.2-eV 的降低 =S1 为 27.5° 至 72.5°。它表明带向上弯曲,这与出版物 [3, 11] 一致。对于 S2,BE 呈现 0.1 eV 的降低,表明与 S1 相比,界面附近有温和的向上带弯曲,或者考虑到实验误差,没有带弯曲的平坦能带。然而,对于 S3,BE 增加了 0.2-eV,这与样品 S1 和 S2 形成对比,建议向下弯曲带。图3记录了Al 2p 所有样品的光谱,BE 没有变化。此外,峰被记录为 Al-O 键,因此,AlGaN 层对 Ga-N BE 变化的影响可以忽略不计。表 1 总结了 Ga 3d 的 BE 和 Al 2p 所有样品在不同检测角度下,误差为± 0.1 eV。

XPS Ga 3d a 的核心级光谱 S1,b S2 和 c S3

Ga-N 谱峰的 BE 作为检测角的函数 θ (相对于正常)S2。误差线为± 0.1 eV

XPS Al 2p a 的核心级光谱 S1,b S2 和 c S3,峰表示 Al-O 键。此外,没有显着的BE变异
<图>表 2 中给出了所有样品的 Ga-O 与 Ga-N 峰的比率。样品 S1 和 S2 的比率约为 0.2,这与之前的结果一致 [3]。然而,在PDA处理后,该比率增加到~ 0.3并且表示GaO x 的增加 界面层。此外,Ga/N比值也列于表2中。该比值是通过比较Ga 3d的积分强度来计算的 和 N 1s 具有原子灵敏度因子的峰值 [18]。对于样品 S1 和 S2,大约 1.7 的比率表明富含 Ga 的界面层。然而,在 N2 退火后,该比率降低到~ 1.0。此外,每个角度的采样深度也在表2中给出。由于光电子的指数衰减,63% 和 95% 的检测到的电子分别来自表面的 1λ(即,λ 表示电子的非弹性平均自由程 (IMFP))和 3λ 的距离内。因此,XPS 采样深度定义为样品表面下方 3λ 纳米。在我们的例子中,Al2O3 是覆盖层,Ga 3d 的 λ Al2O3 中的光电子估计为 ~ 3.4 nm。对于粗略估计,不同角度的采样深度为 3λcosθ .但是实际的Ga-N BE采样深度要考虑Al2O3的厚度,所以采样深度估计为3λcosθ 减去封盖 Al2O3 厚度。因为 GaO x 层位于 GaN 异质结构的顶部,该层的信号包含在每个检测角度。然而,随着探测角度的增加,Ga-N键的信号强度降低,导致Ga-O/Ga-N比值增加。比较 S2 和 S3,Ga-O/Ga-N 比的增加和 Ga/N 比的降低表明富 Ga 层已被氧化形成 GaO x .
<图>为了说明此处提供的实验数据,图 4 中示意性地提出了一个模型。在 XPS 测量期间,GaN/AlGaN/GaN 衬底的费米能级被校准为 0 eV [19]。给出了导带最大值 (CBM)、价带最大值 (VBM) 和核心能级。 BE 是核能级和费米能级之间的能量差。在 ALD 沉积中,氧化剂中的 O 可以代替 Ga-N 键中的 N 来氧化 GaN,周围的 N 原子可以形成 N2 分子 [20],从而形成富 Ga 层和氧化镓(GaO x ) 界面层 [11, 18]。这得到表 2 中大于 1 的 Ga/N 比率的支持。该比率表明 GaN 化学计量的变化,GaN 的固有自发极化效应应该消失 [21,22,23]。结果,富含Ga的层,作为GaN-to-GaO x 过渡层,消除极化引起的负电荷,导致平坦的导带[11],如图4所示。
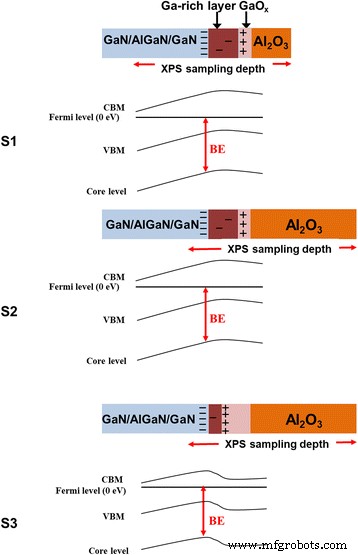
在界面区域,O 取代 Ga-N 键中的 N 形成富 Ga 层和 GaO x 层。富含 Ga 的层充当 GaN-to-GaO x 过渡层。 Ga-O 形成消除了 GaN 的极化并充当正电荷。结果,导带逐渐从上向下弯曲,BE相应变化
此外,在退火过程中,富含Ga的表面被氧化形成更厚的GaOx 层。因为氧化是动力学受限的反应,并且仅限于大约两个表面单层,所以主体不会受到强烈干扰 [24]。因此,Ga-N 键信号主要来自未氧化的底层体,导致 S3 的 Ga/N 化学计量比为 1。 GaO x 据报道,该层会带来正电荷,这些正电荷可能是界面固定电荷,其能态介于天然氧化物和 GaN 的导带最小值之间,这会使带向下弯曲 [4, 11, 13, 14]。因此,在 GaO x 附近的区域,Ga 富集层的导带开始减小 层。较厚的 GaO x 预计会带来更大密度的正电荷。关于 S3 中 Ga-O 和 Al-O 的常数 BE,表明正电荷应位于富 Ga 层/GaO x 的界面 层。正电荷和极化引起的负电荷建立了一个内部电场,将带弯曲从向上带弯曲修改为向下带弯曲,如图4所示。由于向下带弯曲,BE随着检测角度的增加而增加.
GaO x 界面层带来正电荷,增加界面势垒高度 ɸb。 ɸb 被定义为费米能级与表面或界面处导带最小值之间的能量差 [25]。结果,A2O3沉积后,2DEG的迁移率增加,2DEG的电子密度降低[16,25,26]。
随着 Al2O3 厚度的增加,XPS 信号更多地反映在封端的 Al2O3 和 GaN/AlGaN/GaN 之间的界面区域,这由表 2 所示的 XPS 采样深度验证。这解释了只有部分能带弯曲可以检测到 S2 [27] 的配置文件。结果,BE 变化为 0.1 eV,小于 S1 的 0.2 eV。对于S3,界面层较厚,正电荷密度增加,导致能带向下弯曲。
结论
总之,通过 ARXPS 研究了 Al2O3 封端的 GaN/AlGaN/GaN 的界面极化。由于富含 Ga 层和 GaO x,GaN 的本征极化被消除 层形成。此外,来自 GaO x 的 Ga-O 键 层带来正的界面固定电荷。由于这种极化变化,能带在界面区域从向上弯曲变为向下弯曲。
纳米材料
- 5G 和 GaN:未来创新
- 表面状态和铝摩尔分数对 AlGaN/GaN HEMT 中表面电位和 2DEG 的影响
- 在蓝宝石上生长的外延 n 型掺杂 GaN 层的红外反射分析
- 使用多功能 GaN/Fe 纳米颗粒靶向内皮细胞
- 通过界面层设计调整 ZnO 薄膜的表面形貌和特性
- 生长序列中量子势垒的最佳硅掺杂层形成八周期 In0.2Ga0.8N/GaN 蓝色量子阱的软限制势LED
- 背面有黑硅层的晶体硅太阳能电池的研究
- 了解机械剥离石墨上 GaN 外延层的生长机制
- 硅衬底上 InGaN/GaN 多量子阱中的应变控制复合
- 在 c 面 GaN 上沉积的 AlN 原子层中界面和电特性的厚度依赖性
- Ti3C2Tx MXene 的原位高压 X 射线衍射和拉曼光谱研究
- 独立式 GaN 衬底上的 Mg 注入和 Mg 掺杂 GaN 层缺陷的比较分析


