GaAs/AlAs 超晶格点缺陷的第一性原理研究:相稳定性以及对能带结构和载流子迁移率的影响
摘要
先进的半导体超晶格在航空航天、高能物理、引力波探测、天文学和核相关领域等关键的未来高科技应用中发挥着重要作用。在高辐射环境等极端条件下,这些半导体超晶格往往会产生各种缺陷,最终可能导致器件失效。然而,在像GaAs/AlAs这样的超晶格中,点缺陷的相位稳定性和对器件性能的影响目前还不清楚。目前的计算表明,在 GaAs/AlAs 超晶格中,反位缺陷在能量上比空位和间隙缺陷更有利。 AsX(X =Al 或 Ga)和 XAs 缺陷总是诱发 GaAs/AlAs 超晶格的金属丰度,而 GaAl 和 AlGa 反位缺陷对电子结构的影响很小。对于具有间隙或空位缺陷的 GaAs/AlAs 超晶格,发现带隙或诱导金属丰度显着降低。进一步的计算表明,填隙和空位缺陷显着降低了电子迁移率,而反位缺陷的影响相对较小。该结果促进了对GaAs/AlAs超晶格辐射损伤效应的理解,从而为设计用于极端环境应用的高度稳定和耐用的半导体超晶格电子和光电子学提供了指导。
背景
超晶格 (SL) 是一种人造材料,由两种或多种不同成分的交替薄层组成。 (GaAs)n/(AlAs)m 是自几十年前高电子迁移率晶体管 (HEMT) 和量子级联激光器 (QCL) 发展以来最重要的 SL 之一 [1,2,3,4,5, 6]。最近,随着薄膜外延和纳米制造技术的进步,基于 (GaAs)n/(AlAs)m 的 SLs 和 (n + m) 范围为 2 到 10 的纳米器件已经证明了与发光和光吸收相关的令人兴奋的物理特性,两个-声子吸收、拉曼以及红外光谱,因此在光电子、传感、LED、能源和激光相关的民用和工业领域具有广阔的应用前景 [7,8,9,10,11,12]。同时,对于其他关键的高科技应用,如航空航天、高能物理、引力波探测、天文学、太空旅行、核能和国家安全相关领域,半导体 SL 和器件暴露在不同的辐射环境中,即 X-射线、中子、电子、离子等,这可能导致包含杂质、空位、间隙、反位及其复合物的缺陷的产生。由于半导体材料和相关物理特性在这些电子设备和集成电路的运行和运行中起着重要作用,少量缺陷可能会极大地改变它们的光学和传输特性,尤其是在多层系统中[13]。
在过去的几十年中,外来杂质或本征缺陷对半导体 SL 及其组成材料的影响已得到广泛研究。佐洛等人。已经采用密度泛函理论(DFT)方法研究了 GaAs 中点缺陷的稳定性,发现反位缺陷更有利[14]。卡哈利等人。通过 DFT 方法研究了 GaAs/AlAs SL 结构,发现界面处和附近的砷空位 (VAs) 缺陷导致绝缘介质砷化物之间的导电准 2-DEG [7]。斯帕索夫等人。研究了氮杂质对 GaAs/AlAs SL 二极管中载流子传输和电子空穴复合的影响 [9]。他们报告说,N 杂质改变了电子微带的能量并阻碍了电子通过 SL 微带的扩散,这可能导致电子-空穴对的强辐射复合 [9]。王等人。使用 ab initio 研究了由 Zn 杂质在 GaAs/AlAs SL 结构中引起的相互扩散 分子动力学(AIMD)方法[15]。他们的结果表明,Zn 扩散受到 III 族元素的辅助,这些元素被喷射到间隙通道中并迅速扩散,从而使超晶格无序 [15]。 Mitra 和 Stark 发现空位的存在增强了 GaAs/AlAs SL 中 Ga/Al 的混合,这是由于提出的双原子环扩散机制 [16]。最近,已经进行了 GaAs/AlAs SL 辐射响应的 AIMD 模拟 [17],其中确定了每个原子从其晶格位置永久位移的最小能量,并提供了缺陷产生的途径,并且已经确定了所产生缺陷的类型。结果表明,所产生的Ga(或Al或As)Frenkel对和AsGa-GaAs反位对对GaAs/AlAs SL的态分布密度和能带结构具有深远的影响[17]。
到目前为止,SL结构中点缺陷的稳定性和载流子迁移率等传输特性仍然未知。因此,研究空位、间隙和反位缺陷的存在如何影响 GaAs/AlAs SL 的结构稳定性和电性能至关重要。在这项研究中,研究了单个 Ga(或 Al 或 As)空位、单个 Ga(或 Al 或 As)间隙和单个 GaAs(或 AlAs 或 AsGa 或 AsAl)反位缺陷的相稳定性。结果表明,反位缺陷在能量上比空位和间隙缺陷更有利。这些缺陷态的能带结构已经通过混合 DFT 方法进行了研究,该方法结合了 Hartree-Fock 理论的一部分精确交换和来自其他来源的其余交换相关能量(ab initio 或经验)[18],并有望提供比标准 DFT 更准确的半导体材料电子结构描述。特别地,已经预测了电子迁移率。结果表明,填隙和空位缺陷显着降低了电子迁移率,而反位缺陷的影响相对较小。这项工作将促进对半导体超晶格辐射损伤效应的理解,并为设计用于极端环境应用的高度稳定和耐用的基于半导体超晶格的电子和光电子学提供指导。
方法
在这项研究中,结构松弛是在标准 DFT 框架内进行的,能带结构是在 Heyd-Scuseria-Emzefhof (HSE) [19] 框架中基于松弛结构通过混合 DFT 计算的。所有计算均采用 Vienna Ab Initio 模拟包 (VASP) [20]。投影仪增强波赝势用于描述离子和电子之间的相互作用,并使用 Ceperley-Alder 参数化中的局部密度近似处理交换相关效应 [21]。总能量和力的收敛标准是 10 −4 eV 和 10 −3 eV/Å,分别。 AlAs和GaAs晶体的原点群是T d 闪锌矿组,如图1a所示。图 1b 中提供了所考虑的点缺陷的说明。在本研究中考虑了包含两个单层 GaAs 和两个单层 AlAs 交替的 GaAs/AlAs SL,其几何配置以及所考虑的点缺陷如图 2 所示。
<图片>
a的几何结构示意图 XAs (X =Ga 或 Al); b XA 中的缺陷。 V X :(X =Ga、Al 或 As) X 空位; X 内部 :X 插页式; X 作为 :X 占据 As 晶格位点; 作为 X :由于占据X格位。黄色和紫色球体分别代表空位和间隙缺陷
<图片>
a的几何结构示意图 理想的 GaAs/AlAs 超晶格; b 和 c 具有不同点缺陷的 GaAs/AlAs 超晶格。 X 是 :(X, Y =Ga, Al, or As) X 占据 Y 晶格位点; V X :X 空缺; X 内部 :X 插页式广告。黄色和胭脂红球分别代表空位和间隙缺陷
结果与讨论
GaAs 和 AlAs 的基态特性
如表 1 所示,体块 GaAs 和 AlAs 的晶格常数分别确定为 5.61 和 5.63 Å,这与实验值和其他理论值非常吻合 [22,23,24]。 GaAs 和 AlAs 之间的晶格失配似乎很小,GaAs/AlAs SL 的晶格常数设置为 5.62 Å 的中间值。体积模量由 \( B=\frac{1}{3}\left({C}_{11}+2{C}_{12}\right) \) [25] 计算,其中 C11 和C12代表弹性常数。 GaAs 的体积模量计算为 76.3 GPa,接近于 AlAs 的 76.5 GPa 的结果。这些结果与理论和实验数据具有合理的一致性[22, 26, 27]。
GaAs/AlAs 超晶格中的缺陷形成能
对于 GaAs/AlAs SL 和体态,缺陷形成能量的计算公式为 \( {E}_f={E}_{def}-{E}_{undef}+\sum \limits_i\Delta {n}_i{ \mu}_i \) [28]。在这里,E 定义 是弛豫后缺陷模拟单元的总能量,E 未定义 是松弛的理想超胞的总能量,Δn 我 是物种i数量的变化 (i =Ga、Al 或 As) 和 μ 我 是物种 i 的化学势 [28].
对于块体 XAs(X =Al 或 Ga),As 和 X 的化学势服从以下约束:\( {\mu}_X\le {\mu}_X^{bulk} \), \( {\mu} _{As}\le {\mu}_{As}^{bulk} \) 和 \( {\mu}_{As}+{\mu}_X={\mu}_{XAs}^{bulk } \),其中 \( {\mu}_X^{bulk} \)、\( {\mu}_{As}^{bulk} \) 和 \( {\mu}_{XAs}^{bulk } \) 分别对应于体 X、体 As 和体 XAs 的总能量。 X-rich 条件下的缺陷形成能,即 \( {\mu}_X={\mu}_X^{bulk} \) 和 \( {\mu}_{As}={\mu}_{XAs }^{bulk}-{\mu}_X^{bulk} \),以及 As-rich 条件,即 \( {\mu}_{As}={\mu}_{As}^{bulk} \ ) 和 \( {\mu}_X={\mu}_{XAs}^{bulk}-{\mu}_{As}^{bulk} \),总结在表 2 中。对于 GaAs,在 As-在丰富的条件下,发现 AsGa(As 占据 Ga 晶格位点)反位缺陷在能量上是最有利的,如 1.57 eV 的最小形成能所示。下一个有利的缺陷是 GaAs(Ga 占据 As 晶格位)反位缺陷,形成能为 2.31 eV。 As 间隙 (Asint) 的最大形成能为 5.20 eV,表明它比其他考虑的点缺陷更难形成。在富Ga条件下,与富As条件相比,VGA、Asint和AsGa缺陷具有较大的形成能,而VAs、Gaint和GaAs缺陷具有较小的形成能。显然,缺陷稳定性取决于化学环境。与 GaAs 相比,AlAs 中的缺陷形成能通常更大,除了 Asint 和 AsX(X =Al 或 Ga)在富 As 条件下的情况。 AsAl 和 AlAs 反位缺陷被确定为分别在富 As 和富 Al 条件下最有利的缺陷。与 GaAs 的情况类似,Asint 在 AlAs 中也是不利的。图 3 绘制了块体 XAs 在富 As 和富 X(X =Ga 或 Al)条件下的缺陷形成能。图 3a 显示 AsGa 和 GaAs 反位缺陷在富 As 和 Ga-条件丰富,分别。值得注意的是,在大多数情况下,最好使用 AsAl 反位缺陷(见图 3b)。在富铝条件下,AlAs、VAs 和 AsAl 缺陷的相稳定性相互接近,形成能分别为 3.0、3.16 和 3.24 eV。此外,我们发现在 GaAs 和 AlAs 中,Asint 的不利性与化学环境无关。佐洛等人。对GaAs进行第一性原理计算,DFT结果表明AsGa和GaAs的形成能小于空位和间隙缺陷的形成能[14],与我们的结果一致。
<图片>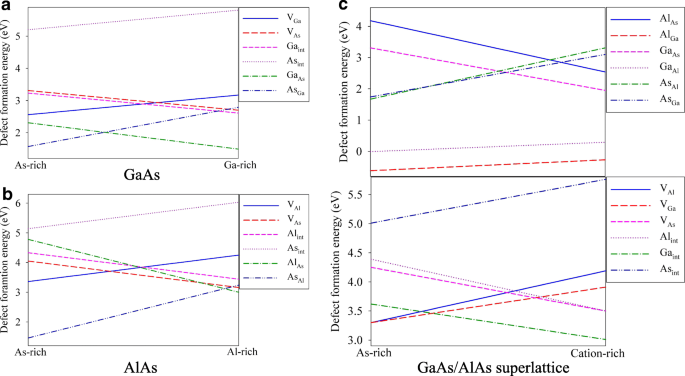
a中富As和富阳离子条件下的缺陷形成能 砷化镓,b AlAs 和 c GaAs/AlAs 超晶格。 X 是 :(X, Y =Ga, Al, or As) X 占据 Y 晶格位点; V X :X 空缺; X 内部 :X 插页式
E f GaAs/AlAs SL 结构中的 SL 结构也在富 As 条件下计算,即 \( {\mu}_{As}={\mu}_{As}^{bulk} \), \( {\mu}_ {Al}={\mu}_{Al As}^{bulk}-{\mu}_{As}^{bulk} \) 和 \( {\mu}_{Ga}={\mu}_ {Ga As}^{bulk}-{\mu}_{As}^{bulk} \),以及富阳离子条件,即\( {\mu}_{Al}={\mu}_{Al }^{bulk} \),\( {\mu}_{Ga}={\mu}_{Ga}^{bulk} \) 和 \( {\mu}_{As}=\left({\ mu}_{SL}^{bulk}-{n}_{Al}\times {\mu}_{Al}^{bulk}-{n}_{Ga}\times {\mu}_{Ga} ^{bulk}\right)/{n}_{As} \),其中 n 阿尔 , n 嘎 , 和 n 作为 分别代表模拟单元中 Al、Ga 和 As 原子的数量。如表3所示,AlGa缺陷在富As和富阳离子条件下具有负形成能,即- 0.62和- 0.27 eV,表明AlGa反位缺陷的形成是一个放热过程。对于GaAl缺陷,在富As条件下形成能小至- 0.01 eV,在富阳离子条件下为0.29 eV。显然,在 GaAs/AlAs SL 结构中形成 AlGa 和 GaAl 反位缺陷比其他点缺陷容易得多。在富 As 条件下,AsGa 和 AsAl 的第二个有利缺陷的形成能分别为 1.67 和 1.74 eV。对于间隙,在富As和富阳离子条件下,相稳定性均遵循Gaint> Alint> Asint的趋势。 GaAs/AlAs SL 结构中的缺陷形成能量也绘制在图 3c 中。与块状 GaAs 相比,GaAs/AlAs SL 中的点缺陷通常更难形成,除了 Asint 的情况(见图 3a、c)。在富As和富Ga条件下,块体GaAs中Asint的形成能分别为5.20和5.81 eV,略大于GaAs/AlAs SL中相应的5.01和5.76 eV值。如图 3b 和 c 所示,块状 AlAs 和 SL 结构中点缺陷的稳定性表现出不同的特征。 AlAs 和 Asint 缺陷在 GaAs/AlAs SL 中比块体 AlAs 在能量上更有利,而 VAs 缺陷在块体 AlAs 中比 SL 结构更可取。值得注意的是,在富含 As 和 Al 的条件下,Alint 在块状 AlAs 中的形成能与在 GaAs/AlAs SL 中的形成能相当。与 Alint 的情况类似,块体 AlAs 和 SL 结构中的 VAl 缺陷显示出相似的有利性,如可比较的形成能所示。在AsAl缺陷的情况下,SL结构中富As条件下的形成能较小(1.46 eV),而在富阳离子条件下,块状AlAs中的值较小(3.10 eV),表明AsAl的稳定性取决于化学环境。
比较块体 AlAs、GaAs 和 GaAs/AlAs SL 中的缺陷稳定性,我们发现反位缺陷总是比空位和间隙更可取,特别是对于 GaAs/AlAs SL 中的 GaAl 和 AlGa 的情况。还注意到,在富As和富阳离子条件下,Asint缺陷在体态和GaAs/AlAs SL结构中最难形成。
点缺陷对 GaAs/AlAs 超晶格能带结构的影响
GaAs/AlAs 超晶格的原始状态
块体 GaAs、AlAs 和 GaAs/AlAs SL 的带隙总结在表 4 中,它们的带结构如图 4 所示。混合 DFT 计算确定 GaAs 的直接带隙为 1.44 eV(见图 4a) ),这与 1.52 eV [29] 和其他计算 [24] 的实验值非常吻合。相比之下,标准 DFT 预测的带隙值为 0.5 eV,这在很大程度上低估了 GaAs 的带隙。对于 AlAs,能带结构具有间接特征,混合 DFT 带隙为 2.16 eV(见图 4b),比 DFT 结果大 0.85 eV,与 2.22 eV 的实验值非常吻合 [23]。如图 4c 所示,GaAs/AlAs SL 的带隙被确定为直接的,这与 Botti 等人的研究一致,他们发现了 (GaAs)m/(AlAs)m SL 的带隙( m ≥ 2) 直接在 Γ 点 [3]。在我们的计算中,通过混合 DFT 方法确定 GaAs/AlAs SL 的直接带隙为 2.06 eV,这与 2.10 eV 的实验值一致 [30]。
<图片>
a的能带结构 砷化镓,b AlAs 和 c GaAs/AlAs 超晶格。混合 DFT 值绘制在左侧面板中,DFT 结果绘制在右侧面板中
反位缺陷对 GaAs/AlAs 超晶格能带结构的影响
在 GaAs/AlAs SL 结构中,GaAl 和 AlGa 反位缺陷比其他点缺陷在能量上更有利。如图 5a 和 b 所示,GaAl 和 AlGa 缺陷态的能带结构与原始态的能带结构非常相似,带隙分别确定为 1.98 和 2.01 eV。这应该是由于Al和Ga化学元素具有相似的价电子构型,即3s 2 3p 1 对于 Al 和 4s 2 4p 1 对于 Ga,在形成 GaAl 和 AlGa 反位缺陷时不会引入额外的电子或空穴。 AsGa 和 AsAl 缺陷状态的能带结构如图 5c 和 d 所示。事实证明,这两种缺陷极大地改变了 GaAs/AlAs SL 的能带结构。 AsGa 和 AsAl 反位缺陷都会引入额外的电子并充当 n 型掺杂剂。发现杂质能级远离价带并穿过费米能级,如图 5c 和 d 所示。这些深缺陷水平可能成为载流子的复合中心。
<图片>
具有不同反位缺陷的缺陷 GaAs/AlAs 超晶格的能带结构。 一 :Ga占据Al晶格位点; b :Al占据Ga晶格位点; c :由于占据Ga晶格位点; d :由于占据Al晶格位置
图 6 显示了具有 GaAs 和 AlAs 缺陷的缺陷 SL 的能带结构和部分态密度 (PDOS)。如图 6a 所示,GaAs 缺陷 SL 的能带结构具有自旋分裂特性。在自旋下降子带中,费米能级穿过由 GaAs 缺陷引入的缺陷能级,表明有缺陷的 SL 具有半金属特性。根据半金属间隙的定义[31],GaAs 缺陷态的带隙约为 0.10 eV。如 GaAs 缺陷 SL 的 PDOS 所示,费米能级附近的自旋向下子带主要由 p 贡献 部分波。由于 Ga 和 Al 原子之间的价电子构型相似,计算出的 AlAs 缺陷态的自旋向上和自旋向下带结构(见图 6b),带隙计算为 0.15 eV。总的来说,AlGa 和 GaAl 反位缺陷对 GaAs/AlAs SL 的电子结构的影响可以忽略不计。还注意到具有AsAl和AsGa缺陷的缺陷SL显示出金属性,而具有GaAs和AlAs缺陷的SL是半金属性的。
<图片>
具有a的缺陷GaAs/AlAs超晶格的能带结构和部分态密度 GaAs 和 b AlAs反位缺陷。 X 作为 (X =Ga 或 Al) X 占据 As 晶格位
空位缺陷对 GaAs/AlAs 超晶格能带结构的影响
具有不同空位的SL结构的能带结构绘制在图7中,其相应的PDOS如图8所示。在具有VGA和VAl缺陷的缺陷SL的情况下也发现了能带结构的自旋分裂特征,如图 7a 和 b 所示。事实上,从原来的位置去除原子会留下四个与 sp 相关的悬空键 3 轨道。在结构弛豫期间,空位周围最近的原子均等地向空晶格位点移动,这导致由四方 D 定义的位点对称 2d 点群。诱导缺陷能级出现在价带附近并位于 GaAs/AlAs SL 的禁区。对于具有 VGA 和 VAl 缺陷的 SL,带隙分别确定为 0.47 和 0.44 eV。如具有 VGA 和 VAL 的缺陷 SL 的 PDOS 所示(见图 8a 和 b),III 族空位的主要影响是对 p 状态。如图 7c 所示,具有 VAs 缺陷的缺陷 SL 的能带结构分裂为自旋向上和自旋向下部分,缺陷能级出现在导带附近。由于 VAs 缺陷充当 n 型掺杂剂,费米能级转移到更高的能量并穿过缺陷能级边缘。卡哈利等人。研究了 GaAs-AlAs 异质界面的电性能,发现界面处的 VAs 缺陷导致准 2-DEG [7],这与我们的结果一致。我们的计算表明,空位对GaAs/AlAs SL的能带结构有不同的影响,即VAs缺陷诱导了GaAs/AlAs SL的金属丰度,而VGA和VAl缺陷显着降低了SL结构的带隙。
<图片>
具有a的缺陷GaAs/AlAs超晶格的能带结构 VGA,b VAL 和 c VAs空位缺陷。 V X (X =Ga、Al 或 As) X 空位
<图片>
a 缺陷 GaAs/AlAs 超晶格的部分态密度 VGA,b VAL 和 c VAs空位缺陷。 V X (X =Ga、Al 或 As) X 空位
间隙缺陷对 GaAs/AlAs 超晶格能带结构的影响
图 9 显示了具有间隙缺陷的 SL 结构的能带结构。值得注意的是,费米能级转变为高能量并穿过导带边缘(见图 9a 和 b),这是由于 III 族间隙是类施主缺陷的事实。因此,带有 Gaint 和 Alint 的有缺陷的 SL 显示出金属特性。如图 9c 所示,在能带结构的自旋向上和自旋向下部分,杂质能级出现在导带附近,费米能级穿过杂质能级边缘,表明缺陷 GaAs/AlAs SL 的诱导金属丰度与阿辛。显然,间隙缺陷显着改变了GaAs/AlAs SL的电子结构,并普遍诱导了缺陷SL结构的金属丰度。
<图片>
具有a的缺陷GaAs/AlAs超晶格的能带结构 增益缺陷,b 阿林特缺陷和c Asint缺陷。 X 内部 (X =Ga、Al 或 As) X 间隙
将 GaAs/AlAs SL 的能带结构和代表性 PDOS 与反位、空位和间隙进行比较,我们发现这些缺陷显着改变了电子结构,除了 GaAl 和 AlGa 反位缺陷的情况。此外,还会导致带隙变窄甚至金属丰度,这将严重影响GaAs/AlAs SL的性能。
点缺陷对 GaAs/AlAs 超晶格电子迁移率的影响
0 K 时的电子迁移率可以从方程 μ 计算 =eτ /米 * , 其中 e 是电子电荷,τ 是弛豫时间,m * 是载体的有效质量[32]。电子有效质量可以从能带结构的曲率通过关系 \( {m}^{\ast }={\mathrm{\hslash}}^2{\left(\frac{d^2\varepsilon }{dk^2}\right)}^{-1} \) [32],其中 ℏ 是约化的普朗克常数,k 是波矢,ε 是导带能量最小值。如图 4a 和 b 所示,我们得到 m * =0.057 m e 表示 GaAs 和 m * =0.19 m e 为 AlAs,与实验值 0.057 m 吻合良好 e 对于 GaAs [33] 和 0.124 m e 对于 AlAs [34],其中 m e 是静态电子质量。假定 AlAs 和 GaAs 的弛豫时间分别为 0.17 和 0.48 ps [35]。 GaAs和AlAs在0 K时的电子迁移率计算为1.48 × 10 4 厘米 2 /Vs 和 1.57 × 10 3 厘米 2 /Vs,分别与0.94 × 10 4 的实验值相当 厘米 2 GaAs [36] 的 /Vs 和 0.28 × 10 3 厘米 2 /Vs 为 AlAs [37]。
如表5所示,确定Г点(\( {m}_{\Gamma}^{\ast } \))处的电子有效质量为0.113 m e 对于原始 GaAs/AlAs SL 和弛豫时间 τ 假定为 0.4 ps [38]。沿 z 方向的电子迁移率,即布里渊区中的 Γ-X 方向 (μ Γ − X ) 计算为 0.623 × 10 4 厘米 2 /Vs 为理想的 GaAs/AlAs SL,与实验值 1.0 × 10 4 相当 厘米 2 /VS [38]。对于具有反位缺陷的缺陷SL,μ的值 Γ − X 除了 GaAs 和 AlAs 缺陷的情况外,与理想 SL 的情况相当。 Γ-X方向的电子迁移率确定为0.263 × 10 4 厘米 2 /Vs 和 0.311 × 10 4 厘米 2 /Vs 分别为 GaAs 和 AlAs 缺陷状态,比理想状态小得多。值得注意的是,Gaint、Alint 和 Asint 缺陷也显着降低了电子迁移率,如值 0.225 × 10 4 厘米 2 /Vs for Gaint,0.243 × 10 4 厘米 2 /Vs for Alint 和 0.315 × 10 4 厘米 2 /Vs 代表 Asint。与反位点和间隙缺陷相比,空位的影响最为深远。对于 VGA 和 VAl 缺陷,μ 的值 Γ − X 大约比原始状态小六倍。 VAs 缺陷也显着降低了电子迁移率,如 0.127 × 10 4 厘米 2 /对。田中等人。研究了电子辐照对 GaAs/AlGaAs 异质结构电性能的影响,他们发现电子迁移率在剂量大于 5 × 10 20 时降低 cm −2 [10]。特别是,GaAs 沟道区中的缺陷产生,而不是 n-AlGaAs 层,被认为是迁移率下降的主要原因 [10]。最近,有人提出电子可能被缺陷或杂质捕获并产生伴随晶格弛豫的亚稳态[39]。因此,GaAs/AlAs SL 的电子结构和载流子迁移率受到点缺陷的显着影响。因此,有必要提高GaAs/AlAs SL的辐射耐受性,以提高其在辐射环境下的电子性能。
结论
在这项工作中,进行了混合密度泛函理论研究,以研究点缺陷对 GaAs/AlAs 超晶格 (SL) 电性能的影响。计算的缺陷形成能表明,反位缺陷在块体 GaAs 和 AlAs 中最有利。在GaAs/AlAs SL结构中,反位缺陷总是在富阳离子和富As条件下占主导地位,并且在整个化学势范围内很难形成间隙缺陷。结果表明,不同的点缺陷对 GaAs/AlAs SL 的电子结构有不同的影响。 AsX(X =Al 或 Ga)和 XAs 反位缺陷总是诱导金属丰度,尽管具有 XAs 反位的缺陷 SL 显示自旋分裂。至于空位,具有VAs的缺陷SL显示出金属丰度特征,III族空位缺陷显着降低了超晶格的带隙。在具有间隙缺陷的有缺陷的 GaAs/AlAs SL 中也发现了金属丰度。 The further carrier mobility calculations show that the interstitial and vacancy defects reduce the electron mobility significantly, while the antisite defects have relatively smaller influence.
缩写
- 2-DEG:
-
Two-dimensional electron gas
- AIMD:
-
Ab initio molecular dynamics
- Al:
-
Aluminum
- AlAs:
-
Aluminum arsenide
- As:
-
Arsenic
- AsX :
-
As occupying the X lattice site
- DFT:
-
密度泛函理论
- Ga:
-
Gallium
- GaAs:
-
Gallium arsenide
- HEMT:
-
High electron mobility transistors
- HSE:
-
Heyd-Scuseria-Emzefhof
- LED:
-
Light-emitting diode
- N:
-
Nitrogen
- PDOS:
-
Partial density of state
- QCLs:
-
Quantum cascade lasers
- SL:
-
超晶格
- VASP:
-
Vienna Ab Initio Simulation Package
- VX (X =Ga, Al or As):
-
X vacancy
- XAs :
-
X occupying the As lattice site
- Xint :
-
X interstitial
- Zn:
-
Zinc
纳米材料
- 揭示叠杯碳纳米纤维的原子和电子结构
- 超窄带完美吸收体及其在可见光区域中作为等离子体传感器的应用
- 硼烯稳定性和STM图像的第一性原理研究
- 原位退火处理对基于 TIPS-并五苯的有机场效应晶体管的迁移率和形态的影响
- Li/Nb 比对 Li-Nb-O 化合物制备和光催化性能的影响
- 水对微晶和纳米纤维素结构和介电性能的影响
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- TiO2-水纳米流体在螺旋槽管中的流动和传热特性的实验研究
- 超材料中表面等离子体激元和磁偶极子共振的耦合效应
- Pt/Nd:SrTiO3结中多级电阻开关记忆和记忆状态相关光电压的研究
- 通过尺寸、修饰、缺陷和掺杂设计和调整石墨烯功函数:第一性原理理论研究
- 天然和合成纳米材料的电化学、生物医学和热特性的比较研究


