通过微波退火增强原子层沉积的 Al2O3/ZrO2/Al2O3 MIM 电容器的介电增强
摘要
对于应用于射频、DRAM 和模拟/混合信号集成电路领域的金属-绝缘体-金属 (MIM) 电容器,随着器件特征尺寸的缩小,高电容密度势在必行。在这项工作中,研究了微波退火技术以提高基于 Al2O3/ZrO2/Al2O3 的 MIM 电容器的介电特性。结果表明,在 1400 W 下微波退火 5 分钟后,ZrO2 的介电常数增加到 41.9(增强~ 40%)。基板温度低于400 °C,与后端制程兼容。漏电流密度为1.23 × 10 −8 和 1.36 × 10 −8 A/cm 2 分别为沉积态样品和 1400 W 样品,表明泄漏性能没有恶化。传导机制被证实为场辅助隧穿。
背景
金属-绝缘体-金属(MIM)电容器已广泛应用于射频(RF)、动态随机存取存储器(DRAM)和模拟/混合信号集成电路领域。随着器件特征尺寸的缩小,需要获得更高的电容密度。例如要求电容密度大于10 fF/μm 2 根据国际半导体技术路线图 (ITRS) [1] 的 2020 节点。因此,已经研究了大量高κ材料,例如HfO2 [2,3,4,5,6],ZrO2 [7,8,9,10,11,12,13,14], Ta2O5 [15,16,17,18] 和 TiO2 [19,20,21,22,23,24]。在这些高κ材料中,ZrO2的介电常数(κ)为16~25(单斜相),带隙为5.8 eV。然而,当 ZrO2 分别结晶成立方相和四方相时,其 κ 值可以提高到 36.8 和 46.6 [25]。因此,可以进一步增加电容密度。微波退火 (MWA) 技术在硅中的掺杂激活 [26,27,28] 和硅化物的形成 [29, 30] 中得到了广泛的研究,因为与传统的热处理技术相比,微波退火 (MWA) 技术的工艺温度较低。此外,Shih 等人。 [31] 研究了 MWA 对 TiN/Al/TiN/HfO2/Si MOS 电容器电气特性的影响。等效氧化层厚度、界面态密度、漏电流密度等关键参数均得到改善。
在这项工作中,研究了 MWA 对 TaN/Al2O3/ZrO2/Al2O3/TaN (TaN/A/Z/A/TaN) MIM 电容器电性能的影响。随着MWA的使用,ZrO2的介电常数显着提高,漏电流密度略有增加。此外,还研究了潜在的传导机制。
方法
首先,通过PECVD在Si衬底上生长500nm厚的SiO2薄膜,然后沉积TaN(20 nm)/Ta(100 nm)薄膜,并通过在N2/Ar等离子体中溅射Ta靶来生长TaN。随后,将涂有 TaN/Ta 薄膜的 Si 晶片转移到 ALD 室中,并在 250 °C 下沉积 Al2O3 (2 nm)/ZrO2 (20 nm)/Al2O3 (2 nm) 的纳米堆叠。 Al2O3 和 ZrO2 薄膜分别由 Al (CH3)3/H2O 和 [(CH3)2N]4Zr/H2O 生长而成。值得一提的是,在底部 TaN 电极和 ZrO2 层之间插入了超薄的 Al2O3 层,以抑制 ALD 和沉积后退火过程中界面层的形成。之后,样品进行微波退火。 MWA 在 DSGI 八角室中以 5.8 GHz 频率进行。在退火期间,样品被放置在室的中间,在那里电磁场是最均匀的。样品的原位温度由面向样品背面的 Raytek XR 系列红外高温计监测。功率从 700 W 到 1400 W 不等,退火时间固定为 5 分钟。最后,通过反应溅射、光刻和反应离子蚀刻依次形成100 nm厚的TaN顶部电极。
ALD 薄膜厚度用椭偏仪 (SOPRA GES 5E) 测量并通过透射电子显微镜 (TEM) 确认。电容-电压 (C-V ) 由精密阻抗分析仪 (Agilent 4294A) 测量,幅度为 50 mV AC。电流-电压 (I-V ) 测量是在暗箱中使用半导体器件分析仪 (Agilent B1500) 进行的。偏压施加到顶部电极。
结果与讨论
基于 A/Z/A 的 MIM 电容器和 MWA 室的示意性结构分别如图 1a 和 b 所示。图 1c 展示了基于 A/Z/A 的 MIM 电容器的横截面 TEM 图像,该电容器在 1400 W 下经受 MWA 5 分钟。观察到 ZrO2 层完全结晶,堆叠层可以清楚地区分,见插图。图 2a 显示了不同退火功率下电容密度的累积概率图。结果表明,MIM电容器的电容密度分别为7.34、8.87、8.96和9.06 fF/μm 2 分别为 0、700、1050 和 1400 W,累积概率为 50%。因此,电容密度在微波的作用下增加。具有 MWA 的 A/Z/A 堆叠 MIM 电容器的电容密度分布非常窄,表明退火均匀性非常好。图 2a 中的插图展示了所有样品的典型 CV 曲线。排除 Al2O3 (κ ≈ 8) 的影响,ZrO2 薄膜的介电常数在 0、700、1050 和 1400 W 下分别提取为 28.3、40.1、41 和 41.9,如图 2b 所示。对于 1400 W 的微波功率,ZrO2 薄膜的介电常数与沉积样品相比增加了 40%。 ZrO2 介电常数的显着提高可归因于微波退火过程中的高度结晶,如图 1c 所示。如上所述,当 ZrO2 分别结晶为立方相和四方相时,其介电常数可以提高到 36.8 和 46.6 [25]。因此,进行XRD测量以进一步研究介电常数增强的机制。如图 2b 的插图所示,在 1400 W 的 MWA 处理后,峰值存在于 ~ 30. 7°,表明在 ZrO2 中出现了四方相 (111) [32, 33]。这种四方相的存在导致介电常数从28.3提高到40以上。
<图片>
一 Al2O3/ZrO2/Al2O3基MIM电容器结构示意图。 b MWA室的结构示意图。 c Al2O3/ZrO2/Al2O3基MIM电容器的TEM图,MWA为1400 W,5 min
<图片>
一 不同样品电容密度的累积概率图;插图显示了相对于偏置的电容密度。 b 不同样品ZrO2介电常数的累积概率图;插图展示了沉积态和 1400 W 样品的 XRD 谱
由于 MIM 电容器是在集成电路的后端 (BEOL) 中制造的,因此工艺温度必须低于 400 °C [34]。如图 3 所示,MWA 的温度曲线表明,对于 700、1050 和 1400 W,基板的最高温度分别为 260、350 和 400 °C。因此,从工艺温度的角度来看,MWA 与 CMOS 工艺兼容。此外,在之前的工作 [13] 中,基于 Al2O3 (2 nm)/ZrO2 (20 nm) 的 MIM 电容器在 N2/H2 环境中在 420 °C 下进行 10 分钟的快速热退火 (RTA) 和由此产生的电介质ZrO2 的常数被评估为 40。对于 RTA,退火时间保持恒定在 420 °C,持续 10 分钟,因此与 MWA 相比,热预算要大得多。对于 MWA [35, 36],偶极极化被认为是分子水平上能量转移的最重要机制。当接触的材料具有不同的介电特性时,微波将选择性地与介电损耗较高的材料耦合。相比之下,传统的 RTA 将热量最有效地传递给具有高电导率的材料。
<图片>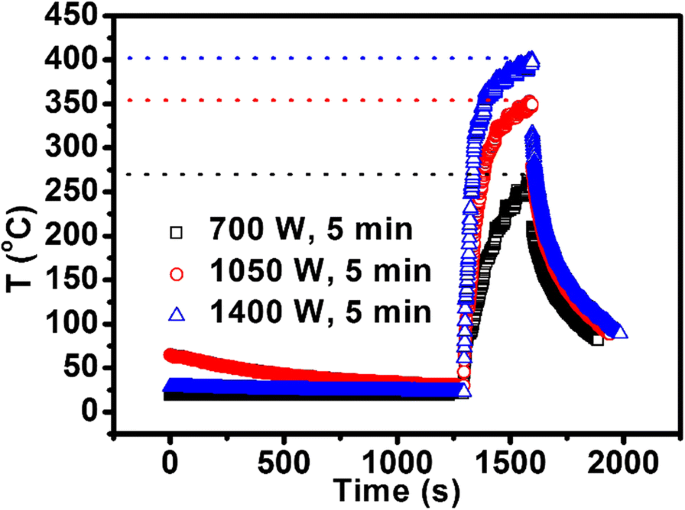
不同样品在微波退火过程中的衬底温度曲线
漏电流是 MIM 电容器的另一个重要参数。如图 4a 所示,由于存在明显的转折点,所有样品的漏电流曲线可以分为两部分,表明不同的电子传导机制。对于经过 MWA 处理的样品,与沉积态样品相比,转折点对应的电压更小。表 1 列出了所有样品在 ± 4 V 处的漏电流密度。以4 V为例,漏电流密度从1.06 × 10 −7 到 1.92 × 10 −5 A/cm 2 , 即当微波功率从 0 增加到 1400 W 时,幅度增强了两个数量级。由于 ZrO2 薄膜的高度结晶,将出现大量晶界并作为泄漏路径,从而增强电子传导在高电场下。然而,考虑到工作电压为 2 V,漏电流密度为 1.23 × 10 −8 和 1.36 × 10 −8 A/cm 2 分别为沉积态样品和 1400 W 样品。显然,微波退火对低电场下的泄漏性能影响不大。此外,击穿电压是从 I -V 测试并绘制在图 4b 中。对于沉积态样品,击穿电压约为 9.8 V,累积概率为 50%。随着MWA的应用,击穿电压降低到~ 9 V。这种击穿电压的降低可能与ZrO2微观结构的变化有关。
<图片>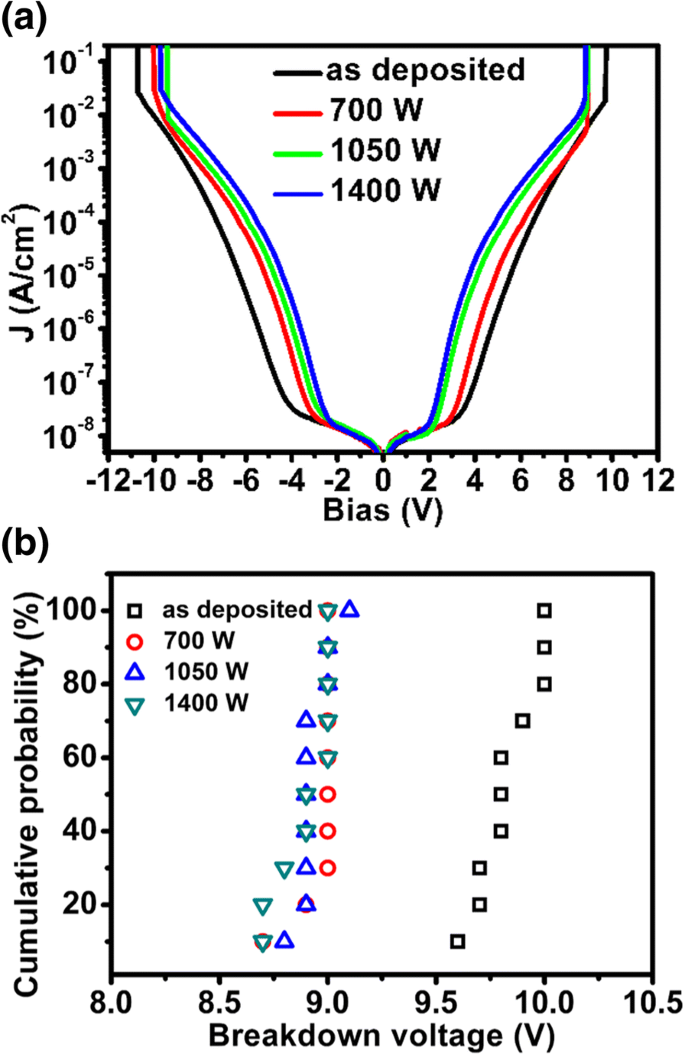
一 漏电流密度图 (J ) 与偏差和 b 不同样品击穿电压的累积概率图
为了进一步了解 MWA 对漏电流的影响,研究了 MIM 电容器的传导机制。基于之前对基于 Al2O3 (2 nm)/ZrO2 (20 nm) 的 MIM 电容器的研究 [13, 14],在高电场中的主要导电机制被证实为场辅助隧穿 (FAT)。对于陷阱相关隧穿的 FAT,电子首先被绝缘体中的陷阱捕获,然后直接隧穿到绝缘体的导带 [37]。在目前的工作中,A/Z/A 基 MIM 电容器中的 Al2O3 和 ZrO2 薄膜是在相同的条件下沉积的,因此泄漏电流可能也以 FAT 为主。 FAT 模型可以用公式表示。 (1) [37]
$$ J={AE}^2\exp \left(-\frac{8\pi \sqrt{2{m}^{\ast }q{\varphi}_t^3}}{3 hE}\right) $$ (1)其中 A 是一个常数,E 是电场,q 是电子电荷,m * 代表有效电子质量(约 0.25 m 0,其中 m 0 是自由电子质量),k 是玻尔兹曼常数,φ t 是将陷阱与导带分开的能垒,h 是普朗克常数。
就堆叠电介质而言,由于介电常数和厚度不同,施加到每一层的电场彼此不同。因此,在讨论传导机制时,使用整个堆栈的平均电场会带来严重的错误。因此,必须准确提取穿过 ZrO2 层的电场。 ZrO2上的电场为3.125 × 10 7 × V 堆栈,2.5 × 10 7 × V 堆栈,2.47 × 10 7 × V 堆栈,2.44 × 10 7 × V 根据高斯定律和基尔霍夫电压定律 [38, 39],分别为沉积态、700 W、1050 W 和 1400 W 样品堆叠:
$$ \left\{\begin{array}{c}{k}_A{E}_A={\kappa}_Z{E}_Z\\ {}{d}_A{E}_A+{d}_Z{E }_Z={V}_{stack}\end{array}\right. $$ (2)其中 k A 和 κ Z分别代表Al2O3和ZrO2的介电常数; E A 和 E Z 分别表示穿过 Al2O3 和 ZrO2 的电场; d A 和 d Z 分别等于 Al2O3 和 ZrO2 的厚度;和 V 堆栈是施加到堆栈的电压。因此,Ln (J /E Z 2 ) 与 1/E Z 在图 5 中任意绘制,其中在电子底部注入(参见图 5a)或电子顶部注入(参见图 5b)下的每个样品的高场区域中实现了直线拟合。这意味着 FAT 机制在高电场下占主导地位。提取的φ 对于沉积态、700 W、1050 W 和 1400 W 的电子底部注入样品,t 分别为 0.73、0.51、0.38 和 0.35 eV。在电子顶注入方面,相应的φ t 分别为 0.82、0.53、0.47 和 0.43 eV。因此,MWA 诱发了一些浅陷阱。据报道,浅陷阱是由晶界缺陷引起的,这些缺陷可以在导带附近引入额外的电子态 [40]。此外,低场下的传导机制很可能是陷阱辅助隧穿(TAT)。
<图片>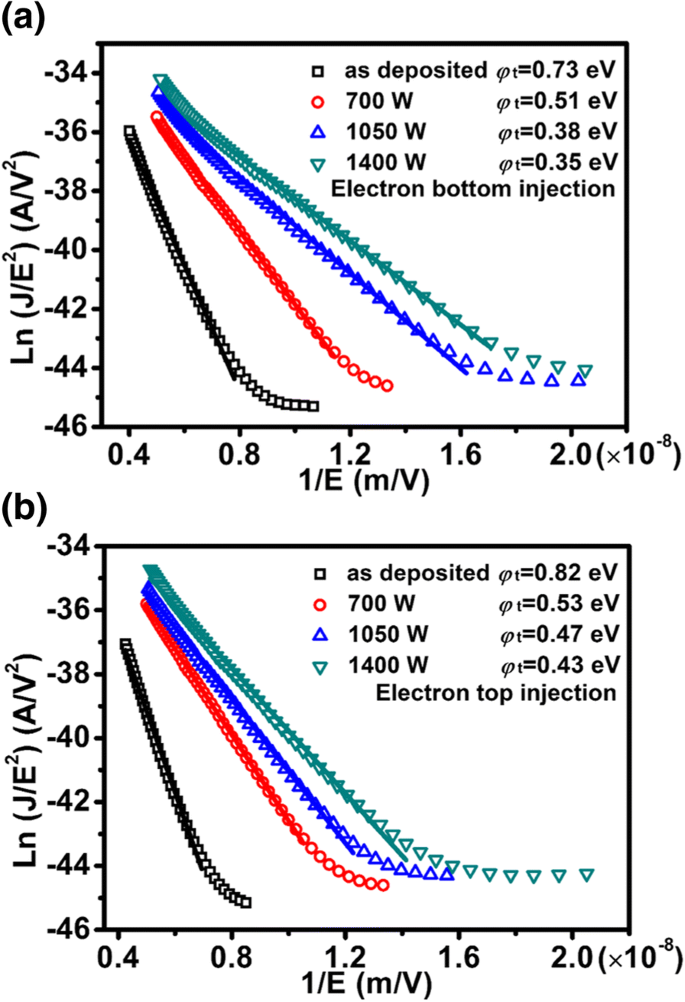
Ln (J /E 2 ) vs 1/E 对于不同的样品。 一 电子底注入和b 电子顶注入
结论
原子层沉积的 Al2O3/ZrO2/Al2O3 纳米堆叠用作 MIM 电容器的绝缘体。随着MWA在1400 W下5 min的影响,电容密度增加到9.06 fF/μm 2 , 大约 23.4% 的电容增强。去除 Al2O3 的影响,1400 W 样品的介电常数推导出为 41.9(介电常数增加~ 40%)。这种介电常数的提高源于 ZrO2 膜的高度结晶。此外,基板温度低于400 °C,使MWA与BEOL工艺兼容。这种较低的基板温度可归因于对 MWA 材料的选择性加热。工作电压为2 V时,漏电流密度为1.23 × 10 −8 和 1.36 × 10 −8 A/cm 2 分别为沉积态样品和 1400 W 样品。高电场中的主导传导机制被证实为 FAT 过程。低电场中的漏电流可能由 TAT 决定。综上所述,微波退火是CMOS工艺中一种很有前途的提高MIM电容器介电性能的技术。
缩写
- A/Z/A:
-
Al2O3/ZrO2/Al2O3
- ALD:
-
原子层沉积
- BEOL:
-
行尾
- C-V :
-
电容-电压
- DRAM:
-
动态随机存取存储器
- FAT:
-
场辅助掘进
- ITRS:
-
国际半导体技术路线图
- I-V :
-
电流-电压
- MIM:
-
金属-绝缘体-金属
- MWA:
-
微波退火
- PECVD:
-
等离子体增强化学气相沉积
- RF:
-
射频
- RTA:
-
快速热退火
- TAT:
-
陷阱辅助掘进
- TEM:
-
透射电子显微镜
纳米材料
- AVX 发布用于高性能微波和射频应用的新型超微型薄膜传输线电容器
- 液体中二维原子晶体上的原子成像
- 在原子尺度上成像的海洋碳
- 无合规性 ZrO2/ZrO2 − x /ZrO2 具有可控界面多态切换行为的电阻式存储器
- 基于苯基三甲氧基硅烷改性氧化铝纳米颗粒的 Al2O3:SiOC 纳米复合材料的形成和发光特性
- 双层厚度对 Al2O3/ZnO 纳米层压材料的形态、光学和电学特性的影响
- 基于介电纳米棱镜的等离子体传感器
- 基于单个 CdSSe 纳米带的波长控制光电探测器
- 后热退火对 InP/ZnS 量子点薄膜光学性能的影响
- 具有低工作电压的基于原子层沉积的 HfAlOx 的 RRAM,用于计算内存应用
- 调制激光辐照对 Al2O3 纳米流体热扩散率的光热效应
- 原子层沉积基于 Hf0.5Zr0.5O2 的具有短/长期突触可塑性的柔性忆阻器


